Микроэлектроника, 2022, T. 51, № 6, стр. 457-465
Компьютерный анализ резистивных переключений в структуре на основе микрокристалла селенида висмута
В. В. Сироткин 1, *, А. В. Зотов 1, В. А. Тулин 1
1 Федеральное государственное бюджетное учреждение науки Институт проблем
микроэлектроники и особочистых материалов Российской академии наук
142432 Московская область, Черноголовка, ул. Академика Осипьяна, 6, Россия
* E-mail: sirotkin@iptm.ru
Поступила в редакцию 01.06.2022
После доработки 12.07.2022
Принята к публикации 12.07.2022
- EDN: CJGQGH
- DOI: 10.31857/S0544126922700144
Аннотация
Ранее предложенная модель “критического поля” применена для анализа результатов экспериментальных исследований резистивных переключений в структуре на основе микрокристалла (“чешуйки”) селенида висмута. Данная структура имеет несколько высокорезистивных состояний. При этом переключающие напряжения лежат в диапазоне от –0.8 до +0.8 В. При анализе, как и в других работах, посвященных мемристивным структурам на основе селенида висмута, изменения резистивного состояния рассматриваемой структуры полагаются связанными с формированием или разрушением проводящих каналов через высокоомный поверхностный слой. Кроме того, сделано предположение о том, что в этой структуре основными источниками проводящих каналов могут служить многочисленные металлические нановыступы, внедренные в поверхностный слой в зоне его контакта с прижимным управляющим электродом (тонким острием серебряной проволоки). С помощью моделирования показано, что принятые предположения позволяют объяснить как наличие у исследуемой структуры нескольких высокорезистивных состояний, так и особенности переходов в эти состояния.
1. ВВЕДЕНИЕ
Все более интенсивные исследования различных структур, проявляющих мемристивные свойства, обусловлены перспективой их использования в качестве нового поколения энергонезависимой памяти, а также (что стало особенно актуально в последнее время) основы для построения нейроморфных вычислительных систем [1, 2]. Важным направлением подобных исследований является поиск материалов, функциональные характеристики которых позволяют формировать мемристивные структуры, имеющие несколько низкорезистивных (НРС) и/или высокорезистивных состояний (ВРС), а также работающих при небольших (менее вольта) переключающих напряжениях.
Ранее в работах [3–5] была продемонстрирована возможность создания мемристивных структур на основе селенида висмута (Bi2Se3). В работе [6] было показано, что в структуре, которая представляет собой микрокристалл Bi2Se3 (“чешуйку” толщиной ~600 нм), зажатый между тонким острием серебряной проволоки (диаметр острия ~100 мкм) и широким медным основанием, могут реализовываться несколько ВРС. При этом величины напряжений, меняющих резистивное состояние этой структуры, лежат в диапазоне от –0.8 до +0.8 В. Проведенные в [6] эксперименты выявили некоторые особенности переходов структуры из НРС в ВРС. Эти особенности требуют подробного теоретического анализа, поскольку их адекватная интерпретация позволит оптимизировать исследуемую структуру для ее возможного практического применения.
Резистивные переключения в структурах на основе Bi2Se3, полагаются связанными с образованием или разрушением проводящих (перколяционных) каналов через тонкий поверхностный слой, имеющий более высокое сопротивление, чем исходный материал [3–5]. Предполагается, что поведение проводящих каналов управляется эффектом Пул–Френкеля и электродиффузией ионов селена.
В работе [7] с помощью моделирования было продемонстрировано, что в случае планарной структуры на Bi2Se3 с напыленным металлическим микроразмерным электродом инициировать образование проводящих каналов может не только край этого электрода, но и нановыступы на нем, направленные вглубь поверхностного слоя. Это объясняется тем, что вокруг таких нановыступов, как и у края электрода, формируются зоны с сильным локальным повышением напряженности электрического поля. В подобных зонах указанные выше процессы должны протекать наиболее интенсивно.
В [7] в качестве рабочего инструмента использовалась модель “критического поля” (МКП) [8, 9]. В этой модели полагается, что изменение проводимости поверхностного слоя происходит в тех его областях, где напряженность электрического поля превышает некоторое критическое значение EC. В зависимости от полярности приложенного напряжения удельная проводимость таких областей либо возрастает до величины σНРС, либо возвращается к исходному низкому значению σВРС. Основой МКП служит уравнение, описывающее растекание тока в рассматриваемой структуре и связывающее распределение в ней удельной проводимости σ с распределением электрического потенциала ϕ:
Расчеты резистивных переключений в МКП происходят пошагово. На каждом шаге по текущему распределению удельной проводимости с помощью (1) определяется распределение электрического потенциала. Далее, если в структуре обнаруживаются области, в которых согласно алгоритму МПК значение σ изменилось, то происходит переход к следующему шагу. В противном случае процесс переключения полагается завершенным.
В данной статье подход, развитый в [7], применяется для анализа и интерпретации экспериментальных результатов, полученных в [6].
2. ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ
Рис. 1 демонстрирует изменение сопротивления R структуры, содержащей микрокристалл Bi2Se3, при подаче пилообразного напряжения U(t) (см. также [6], рис. 4). Скорость изменения напряжения равна 80 мВ/с. В качестве управляющего электрода выступает серебряная проволока. Видно, что при прохождении положительной части управляющего сигнала с максимальным значением Uset = 0.4 В сопротивление структуры возрастает с исходных ~5 до ~28 Ом. После воздействия отрицательной части “пилы” с минимальным значением напряжения Ureset = –0.8 В сопротивление структуры возвращается к исходной величине.
Рис. 1.
Изменение сопротивления R структуры, содержащей микрокристалл Bi2Se3, при подаче пилообразного напряжения U (кривые 1 и 2, соответственно).

Важно обратить внимание на то, что если переход структуры из ВРС в НРС полностью завершается после прохождения переднего фронта отрицательной части пилообразного напряжения, то переход из НРС в ВРС происходит как при нарастании положительного управляющего сигнала, так и при его убывании.
Более подробно особенности перехода структуры из НРС в ВРС представлены на рис. 2а. На рисунке показаны зависимости R(t) для двух разных значений Uset: 0.4 и 0.52 В. На приведенных зависимостях можно выделить три характерных участка, следующих друг за другом. На участке I 0 ≤ U(t) ≤ Us (Us ~ 0.25 В) сопротивление структуры меняется незначительно. Участок II, на котором R быстро увеличивается, завершается после прохождения “пилой” максимума (т.е. значения Uset). На участке III повышение сопротивление структуры продолжается, но с меньшей скоростью. Этот участок заканчивается при достижении напряжения Uf ~ 0.1 В.
Рис. 2.
(а) Переход структуры, содержащей микрокристалл Bi2Se3, из НРС в ВРС (кривые 1 и 2) при подаче пилообразного напряжения, имеющего разные максимальные значения: 0.4 и 0.52 В (кривые 3 и 4, соответственно). (б) Максимальный перегрев структуры δT (кривые 1 и 2) при прохождении управляющих сигналов, таких же, как на рисунке слева. Данные получены с помощью упрощенной одномерной модели, описанной в [6].

Здесь следует отметить, что изменение величины Uset с 0.4 до 0.52 В привело к увеличению сопротивления структуры в ВРС с ~28 до ~56 Ом. Таким образом, с помощью варьирования в небольших пределах значения Uset можно получить несколько хорошо отличимых ВРС структуры (подробности см. в [6]).
На зависимостях R(t), приведенных на рис. 2а, интерес для теоретического анализа и интерпретации представляют следующие особенности. (А) Процесс быстрого увеличения сопротивление структуры начинается после достижения некоторого порогового напряжения Us. (Б) Скорость роста R в пределах участка II меняется слабо, в то время как U варьируется в достаточно широких пределах. (В) На участке III продолжается плавное повышение сопротивления структуры, несмотря на снижение напряжения, прикладываемого к структуре. При этом скорость изменения R зависит от величины Uset. Она тем выше, чем больше Uset. (Г) Процесс роста R прекращается при напряжении Uf, заметно меньшем, чем Us.
3. МЕТОДИКА МОДЕЛИРОВАНИЯ
При моделировании использовались значения параметров, которые были подобраны, опираясь на данные ранее выполненных работ, посвященных исследованию резистивных переключений в структурах на основе Bi2Se3 [3–7]. Толщина структуры (zS) полагалась равной 600 нм. Толщина поверхностного слоя (zL) составляла 32 нм. Задавались следующие величины удельных сопротивлений: исходного (объемного) Bi2Se3 – 1.4 × 10–3 Ом см, поверхностного слоя (ρL) – 5 × 103 Ом см. Удельное сопротивление проводящих каналов (ρcc) менялось от варианта к варианту. При этом соотношение δcc = ρL/ρcc могло принимать значения: 50, 100, 200 и 400. Варьирование величины ρcc отражало тот факт, что поверхностный слой является дефектным и, следовательно, как его свойства, так и свойства образующихся в нем проводящих каналов могут заметно меняться от одного участка структуры к другому. Величина критической напряженности электрического поля EC в МКП была равна 2 × 105 В/см.
Металлические нановыступы, внедренные в поверхностный слой в зоне его контакта с управляющим электродом, считались распределенными равномерно по этой зоне и идентичными друг другу. Это позволило при моделировании явно отследить зависимость характеристик резистивных переключений от размеров нановыступов.
Для исключения взаимного влияния нановыступов при резистивных переключениях, расстояние между ними выбиралось равным 3zL. Таким образом, подразумевалось, что в случае управляющего электрода с диаметром dsc, имеющем величину ~100 мкм, в поверхностный слой внедрен примерно миллион нановыступов (Nnp ~ 106). Предварительно проведенные расчеты показали, что такое большое число нановыступов (источников проводящих каналов) позволяет не рассматривать вклад, который вносит в изменение сопротивления структуры кольцеобразный проводящий канал, формирующийся на краю управляющего электрода. Величина Nnp, в сочетании с соотношением dsc $ \gg $ zS, также сделала возможным пренебречь влиянием на результаты моделирования разного расположения нановыступов относительно края управляющего электрода.
На основе выше сказанного, моделирование всей структуры было сведено к рассмотрению лишь небольшой “элементарной” ячейки, имеющей вид прямоугольного параллелепипеда с латеральными размерами 3zL × 3zL. Вертикальный размер ячейки соответствовал толщине микрокристалла Bi2Se3. На верхней грани ячейки устанавливалось управляющее напряжение. В центре этой грани находился тестируемый нановыступ. Нижняя грань полагалась заземленной. На боковых гранях задавались однородные условия Неймана.
В качестве тестовых использовались нановыступы четырех размеров: три кубических с длиной ребра 1, 2 и 3 нм, а также один в виде прямоугольного параллелепипеда со сторонами 3 × 3 × 1 нм3. Далее эти нановыступы обозначаются: P1, P2, P3 и P4, соответственно.
Переходы структуры в НРС моделировались при напряжении на управляющем электроде UНРС = –0.4 В, переходы в ВРС – при UВРС = 0.4 В (если не указано иначе).
Расчеты осуществлялись с помощью компьютерной программы, которая являлась модификацией программы, ранее использованной в [7].
4. РЕЗУЛЬТАТЫ МОДЕЛИРОВАНИЯ И ОБСУЖДЕНИЕ
Результаты расчетов по МКП для “элементарной” ячейки с нановыступом P1 при δcc = 400 представлены на рис. 3. Сверху показаны двумерные сечения центральной части ячейки плоскостью XZ, проходящей через середину нановыступа, снизу – ее 3D проекции. Рис. 3а демонстрирует процесс перехода ячейки из исходного состояния в НРС. Кривые, приведенные на рисунке, отражают этапы развития проводящего канала (шаги в рамках МКП). Канал зарождается у нановыступа. По мере продвижения вглубь канал расширяется. После достижения каналом нижней границы поверхностного слоя происходит значительное утолщение его верхней части. В результате, как уже отмечалось в [7], сформировавшийся проводящий канал имеет поперечные размеры, намного превышающие размеры нановыступа (рис. 3а и 3в). В данном случае наименьший поперечный размер канала (наблюдаемый в его средней части) равен примерно 30 нм.
Рис. 3.
Результаты расчетов по МКП для “элементарной” ячейки с нановыступом P1 при δcc = 400. Слева – состояние поверхностного слоя после перехода ячейки из исходного состояния в НРС, справа – после последующего перехода в ВРС. Сверху – двумерные сечения центральной части ячейки плоскостью XZ, проходящей через середину нановыступа. Снизу – ее 3D проекции. См. также дополнительную информацию в тексте.

Образование проводящего канала вызывает уменьшение сопротивления “элементарной” ячейки с нановыступом P1 при δcc = 400 с исходных 96.9 до 6.12 МОм. Для структуры, содержащей примерно миллион таких ячеек, это эквивалентно изменению сопротивления в пределах, которые установлены в экспериментах, выполненных в [6].
На рис. 3б и 3г показано состояние поверхностного слоя в окрестностях нановыступа P1 после завершения перехода ячейки из НРС в ВРС. На рисунках видно, что после перехода верхняя и нижняя части проводящего канала остались не разрушенными. Для наглядности на рис. 3б серыми кривыми очерчены контуры канала до разрушения. Частичное сохранение канала в ВРС объясняется следующим образом. При выбранных параметрах в рамках формализма МКП разрушение канала происходит там, где из-за искривления его поверхности возникают зоны, в которых напряженность электрического поля равна или превышает критическое значении EC. На рис. 3б пунктиром показано состояние проводящего канала на третьем расчетном шаге моделирования рассматриваемого перехода. Видно, что в обсуждаемом случае на начальной стадии перехода зоны критического поля формируются в средней части канала, о чем говорит образование в этом месте каверн. Поскольку каверны вызывают еще большее искривление поверхности проводящего канала, процесс его дальнейшего разрушения продолжает интенсивно развиваться именно в этой области. После размыкания канала на нижнюю и верхнюю части процесс разрушения существенно замедляется из-за резкого изменения конфигурации электрического поля. Разрушение канала останавливается после сглаживания оставшихся частей до состояния, исключающего присутствие на их поверхности зон критического поля.
Расчеты показали, что повышение переключающего напряжения (в диапазоне от выбранных 0.4 В до максимальных 0.8 В) приводит к уменьшению остаточных частей проводящего канала вплоть до их полного исчезновения. Таким образом, если при UВРС = 0.4 В сопротивление “элементарной” ячейки в конце перехода равно 95.1 МОм, то при UВРС = 0.8 В оно возвращается к исходному значению 96.9 МОм.
На рис. 4 представлены варианты проводящего канала, сформировавшиеся при переходе “элементарной” ячейки из исходного состояния в НРС при разных сочетаниях значений δcc и размеров нановыступов. Вариации указанных параметров имеют следствием заметные изменения как размеров проводящего канала, так и его формы. Уменьшение δcc при сохранении размеров кубического нановыступа вызывает сужение либо канала целиком, либо отдельных его частей (ср. рис. 3в, 4а, 4в и 4д). Увеличение кубического нановыступа при неизменном δcc сначала приводит к уменьшению размеров канала (ср. рис. 3в и 4б), а затем к их росту (ср. рис. 4б и 4г). Переход от кубического нановыступа P3 к “сплющенному” P4 заметней сказывается на форме канала, чем на его размерах (ср. рис. 4г и 4е). Соответственно отмеченным изменениям проводящего канала и вариациям соотношения δcc меняется сопротивление “элементарной” ячейки в НРС (табл. 1). Кроме того, это влечет за собой изменение минимального значения напряжения UВРС, гарантирующего запуск процесса разрушения канала при последующем переходе из НРС в ВРС (табл. 2).
Рис. 4.
Варианты проводящего канала, сформировавшиеся при переходе “элементарной” ячейки из исходного состояния в НРС при разных сочетаниях значений δcc и размеров нановыступов. Слева – варианты с нановыступом P1 при δcc равном: (а) 200, (в) 100 и (д) 50. Справа – варианты при δcc = 400 с нановыступами: (б) P2, (г) P3, (е) P4.

Таблица 1.
Сопротивление “элементарной” ячейки [МОм] после ее перехода из исходного состояния в НРС при разных сочетаниях значений δcc и размеров нановыступов (см. дополнительную информацию в тексте)
| δcc | P1 | P2 | P3 | P4 |
|---|---|---|---|---|
| 50 | 54.6 | 51.0 | 41.0 | 43.7 |
| 100 | 27.3 | 26.8 | 21.7 | 26.8 |
| 200 | 16.2 | 11.5 | 9.77 | 9.96 |
| 400 | 6.12 | 11.4 | 4.17 | 4.67 |
Таблица 2.
Минимальное значение напряжения UВРС [В], которое гарантирует запуск процесса разрушения проводящего канала, образовавшегося после перехода “элементарной” ячейки из исходного состояния в НРС, при разных сочетаниях значений δcc и размеров нановыступов (см. дополнительную информацию в тексте)
| δcc | P1 | P2 | P3 | P4 |
|---|---|---|---|---|
| 50 | 0.365 | 0.392 | 0.337 | 0.402 |
| 100 | 0.345 | 0.356 | 0.382 | 0.360 |
| 200 | 0.372 | 0.363 | 0.400 | 0.339 |
| 400 | 0.371 | 0.405 | 0.344 | 0.368 |
Экспериментальные данные, приведенные в [6], получены для структуры, которая в процессе измерений многократно переводилась из одного резистивного состояния в другое. Моделирование показало, что даже повторные переходы “элементарной” ячейки сначала в НРС, а затем в ВРС, которые следуют за начальным циклом переключений исходное состояние – НРС–ВРС, могут приводить к существенно различающимся результатам для однотипных резистивных состояний (ср. рис. 3 и 5). В “повторном” НРС проводящий канал имеет заметно большие размеры и более сложную форму (ср. рис. 3в и 5а). А в “повторном” ВРС осталась неразрушенной только нижняя часть канала (ср. рис. 3г и 5б).
Рис. 5.
Состояние поверхностного слоя в “элементарной” ячейке с нановыступом P1 при δcc = 400: (а) после завершения переходов исходное состояние – НРС – ВРС – НРС, (б) после последующего перехода в ВРС.
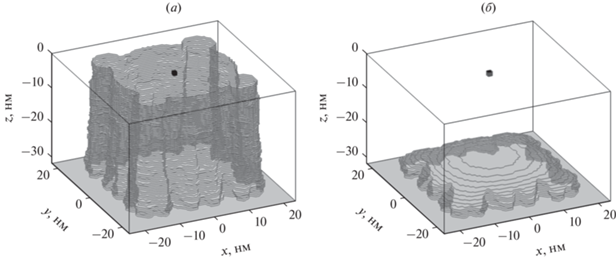
На рис. 6 представлено пошаговое изменение сопротивления “элементарной” ячейки с нановыступом P1 при δcc = 400 во время ее перехода в ВРС после предшествовавшего перехода исходное состояние – НРС. Сравниваются первые шесть шагов реализации МКП, при которой используется набор ранее оговоренных значений входных параметров, и реализаций, у которых набор этих значений изменен тем или иным образом.
Рис. 6.
Пошаговое изменение сопротивления “элементарной” ячейки с нановыступом P1 при δcc = 400 во время ее перехода в ВРС после предшествовавшего перехода исходное состояние – НРС. Представлены первые шесть шагов реализаций МКП, отличающихся значениями входных параметров. (а) При реализации МКП с некоторого шага меняется UВРС. Кривая 1 – все шаги выполнены при 0.4 В. Кривая 2 – первые два шага выполнены при 0.4 В, остальные при 0.35 В. Кривая 3 – первые четыре шага выполнены при 0.4 В, остальные при 0.35 В. Кривая 4 – первые четыре шага выполнены при 0.4 В, остальные при 0.3 В. (б) При реализации МКП меняются значения UВРС и EC. Кривая 1 – UВРС = = 0.4 В и EC = 2 × 105 В/см. Кривая 2 – UВРС = 0.35 В и EC = 1.8×105 В/см. Кривая 3 – UВРС = 0.35 В и EC = 1.7 × 105 В/см.

Данные на рис. 6а позволяют оценить влияние формы (кривизны поверхности) проводящего канала на величину UВРС, достаточную для протекания процесса его разрушения. Для ориентира приведен график, полученный при ранее выбранном значении 0.4 В (кривая 1). Необходимо отметить, что в рассматриваемых условиях процесс разрушения канала не стартует при значениях меньших 0.371 В (табл. 2). Однако, после запуска этого процесса при 0.4 В и образования каверн на поверхности канала (рис. 3б) дальнейшее его разрушение становиться возможным при значении 0.35 В (кривые 2 и 3) или даже при 0.3 В (кривая 4). Из рисунка следует вывод о том, что чем позже происходит снижение UВРС (т.е. чем более многочисленны и развиты каверны), тем меньше это снижение сказывается на темпе роста сопротивления “элементарной” ячейки (ср. кривые 1, 2 и 3) и тем более значительным оно может быть (см. кривые 1, 3 и 4).
Рис. 6б демонстрирует пошаговые изменения сопротивления анализируемой “элементарной” ячейки при разных сочетаниях значений UВРС и EC. Кривая 1, полученная при исходном наборе значений входных параметров, опять выступает в роли эталона для сравнения. Видно, что снижение критической напряженности электрического поля на 10% (с 2 × 105 до 1.8 × 105 В/см) позволяет процессу разрушения проводящего канала осуществляться при пониженном напряжении переключения – 0.35 В (кривая 2). Правда, при этом разрушение канала замедляется (ср. кривые 1 и 2). При снижении EC на 15% и при том же значении UВРС процесс разрушения канала уже происходит намного интенсивней, чем в “эталонном” варианте (ср. кривые 1 и 3).
Заканчивая изложение результатов моделирования, следует подчеркнуть, что, несмотря на небольшое число рассмотренных вариантов (очевидно, что разнообразие конфигураций нановыступов в реальной структуре несравненно выше), выявленные с помощью МКП закономерности позволяют приступить к анализу особенностей экспериментальных данных из [6], на которые было обращено внимание в начале этой статьи (см. раздел ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ).
Наличие некоторого порогового значения управляющего напряжения, при превышении которого начинается быстрое увеличение сопротивления исследуемой структуры при ее переходе из НРС в ВРС (особенность А), хорошо согласуется с данными, полученными с помощью МКП. Из табл. 2 следует, что минимальные величины напряжения UВРС, которые гарантируют запуск процесса разрушения различных вариантов проводящего канала, довольно плотно сконцентрированы вокруг среднего для этой таблицы значения 0.3688 В. У одиннадцати вариантов (из шестнадцати) отклонение от этого значения составляет ±0.025 В (±6.8%), у пяти – ±0.005 В (±1.4%).
Слабое изменение скорости роста сопротивления структуры в пределах участка II, выделенного на зависимостях R(t) при анализе рис. 2, при довольно заметном варьировании управляющего сигнала (особенность Б) можно объяснить, исходя из двух очевидных предположений: из-за шероховатости прижимного электрода формируется огромное количество проводящих каналов; эти каналы имеют большое разнообразие размеров, форм и, соответственно, значений сопротивления (в качестве примеров см. рис. 3, 4 и табл. 1). Таким образом, при переходе из НРС в ВРС длительность разрушения каналов может быть заметно разной. Кроме того, также сильно может отличаться вклад разрушаемых каналов в процесс роста общего сопротивления структуры. А вовлеченность в этот процесс очень большого числа каналов может сделать его относительно плавным.
Выше приведенные факторы, дополненные сделанным на основе данных рис. 6а выводом о возможности продолжения разрушения проводящих каналов при заметном снижении напряжения в случае достаточно большой кривизны некоторой части их поверхности (из-за многочисленных и развитых каверн), могут объяснить сохранение плавного роста сопротивления структуры в условиях спада положительного управляющего сигнала (особенность В). Отмеченная при этом зависимость скорости роста R от величины Uset может быть связана с разогревом структуры в процессе перехода структуры из НРС в ВРС. На рис. 2б представлены результаты, полученные с помощью упрощенной одномерной модели, описанной в [6]. Видно, что максимальный перегрев структуры δT меняется вслед за управляющим сигналом. И чем большего значения достигает управляющий сигнал, тем больше величина δT. Учитывая характер процессов, которые, как считается, ответственны за поведение проводящих каналов (см. ВВЕДЕНИЕ), можно предположить, что разогрев структуры должен снижать величину критической напряженности электрического поля EC. В свою очередь, снижение EC должно приводить к уменьшению значений управляющего сигнала, при которых возможно разрушение проводящих каналов, а также повышать интенсивность этого процесса (см. рис. 6б).
Утверждения, использованные для объяснения особенности В, могут быть применены и для объяснения того, что процесс заметного роста сопротивления структуры прекращается при напряжении, существенно меньшем, чем напряжение, при котором этот процесс начинается (особенность Г).
В завершение анализа важно подчеркнуть, что все перечисленные выше факторы в совокупности могут объяснить и самый главный экспериментальный результат из [6] – наличие у рассматриваемой структуры нескольких ВРС.
ЗАКЛЮЧЕНИЕ
В статье с помощью компьютерного моделирования был выполнен анализ результатов экспериментальных исследований резистивных переключений в структуре на основе микрокристалла (“чешуйки”) селенида висмута [6]. Эта структура характеризуется наличием у нее несколько высокорезистивных состояний, а также тем, что переключающие напряжения не превышают ±0.8 В.
Интерпретация экспериментальных данных была проведена в рамках модели “критического поля”, предложенной в [8, 9]. При этом были использованы два предположения, которые в том или ином виде ранее уже рассматривались в работах [3–7], посвященных мемристивным структурам на основе селенида висмута: (1) резистивные переключения в исследуемой структуре связаны с образованием или разрушением проводящих каналов через тонкий высокоомный поверхностный слой; (2) источниками зарождения проводящих каналов являются многочисленные нановыступы, внедренные в поверхностный слой в зоне его контакта с прижимным управляющим электродом (тонким острием серебряной проволоки).
С помощью моделирования было продемонстрировано, что как существование у исследуемой структуры нескольких высокорезистивных состояний, так и особенности, наблюдаемые при переходах в эти состояния, могут быть обусловлены тем, что процесс разрушения проводящих каналов в данном случае может быть преимущественно связан с эволюцией каверн, первоначально формирующихся на наиболее искривленных участках поверхности этих каналов. Именно специфическим поведением этих каверн, выявленным при компьютерном анализе, и возможным изменением свойств поверхностного слоя, вызванным разогревом структуры во время переходов, можно объяснить экспериментально наблюдаемые результаты.
Авторы выражают свою признательность Н.А. Тулиной за плодотворное обсуждение материала данной статьи.
Выполнение данной работы финансировалось за счет гранта РФФИ № 19-29-03011мк.
Список литературы
Li Y., Wang Z., Midya R., Xia Q., Yang J.J. Review of memristor devices in neuromorphic computing: materials sciences and device challenges // J. Phys. D. Appl. 2018. V. 51. № 50. P. 503002.
Lee S.H., Zhu X., Lu W.D. Nanoscale resistive switching devices for memory and computing applications // Nano Res. 2020. V. 13. № 5. P. 1228–1243.
Tulina N.A., Rossolenko A.N., Shmytko I.M., Kolesnikov N.N., Borisenko P.N., Bozhko S.I., Ionov A.M. Rectification and resistive switching in mesoscopic heterostructures based on Bi2Se3 // Materials Letters. 2015. V. 158. P. 403–405.
Тулина Н.А., Россоленко А.Н., Шмытько И.М., Колесников Н.Н., Борисенко Д.Н., Сироткин В.В., Борисенко И.Ю. Частотные свойства гетероструктур на основе селенида висмута в эффектах резистивных переключений: эксперимент, численное моделирование // Известия РАН, сер. Физическая. 2016. Т. 80. № 6. С. 741–743.
Тулина Н.А., Россоленко А.Н., Шмытько И.М., Колесников Н.Н., Борисенко Д.Н., Сироткин В.В., Борисенко И.Ю., Тулин В.А. Исследование динамических эффектов в мемристорных структурах на основе селенида висмута. Нужен ли мемристору “хвост шаттла” // Известия РАН, сер. Физическая. 2019. Т. 83. № 6. С. 813–817.
Zotov A.V., Sirotkin V.V., Il’in A.I., Trofimov O.V., Borisenko P.N., Kolesnikov N.N., Tulin V.A. Multilevel memristive structures based on bismuth selenide microcrystals // Chaos, Solitons and Fractals. 2021. V. 143. P. 110542.
Сироткин В.В. Компьютерное исследование влияния неоднородностей металлического контакта на резистивные переключения в гетероструктуре на основе селенида висмута // Микроэлектроника. 2021. Т. 50. № 5. С. 363–369.
Тулина Н.А., Сироткин В.В., Борисенко И.Ю., Иванов А.А. Моделирование резистивных переключений в гетероструктурах на основе оксидных соединений // Известия РАН, сер. Физическая. 2013. Т. 77. № 3. С. 297–299.
Tulina N.A., Borisenko I.Yu., Sirotkin V.V. Bipolar resistive switchings in Bi2Sr2CaCu2O8+δ // Solid State Communications. 2013. V. 170. № 1. P. 48–52.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


