Российские нанотехнологии, 2020, T. 15, № 2, стр. 188-193
МОЩНЫЕ НИТРИД-ГАЛЛИЕВЫЕ СВЧ-ТРАНЗИСТОРЫ НА ПОДЛОЖКАХ КРЕМНИЯ
Ю. В. Храповицкая 1, *, М. Я. Черных 1, И. С. Езубченко 1, Ю. В. Грищенко 1, И. О. Майборода 1, И. А. Черных 1, А. А. Андреев 1, П. А. Перминов 1, А. Н. Цоцорин 2, М. И. Черных 2, М. Л. Занавескин 1, И. В. Семейкин 2
1 Национальный исследовательский центр “Курчатовский институт”
Москва, Россия
2 АО “Научно-исследовательский институт электронной техники”
Воронеж, Россия
* E-mail: khrapovitskaya.julia@mail.ru
Поступила в редакцию 09.06.2020
После доработки 23.06.2020
Принята к публикации 26.06.2020
Аннотация
Методом газофазной эпитаксии из металлоорганических соединений выращены нитрид-галлиевые гетероструктуры на подложках кремния. На их основе созданы транзисторы с суммарной шириной затвора 7.92 мм. Изучено влияние архитектуры буферных слоев на характеристики гетероструктур и тестовых транзисторов, созданных на их основе. Получены мощные транзисторы с выходной импульсной мощностью, равной 45 Вт на частоте 1 ГГц при напряжении питания 28 В. Максимальный коэффициент полезного действия транзистора составил 55%.
ВВЕДЕНИЕ
Уникальные физические свойства нитридов алюминия, галлия и их тройных соединений позволяют создавать на их основе транзисторы с широким рабочим диапазоном частот и высокой удельной мощностью [1–3]. Данные преимущества определяют интенсивное развитие рынка устройств на основе гетероструктур нитрида галлия и стремительное вытеснение ими устройств на основе кремниевой МОП-технологии (металл–оксид–полупроводник) с боковой диффузией (LDMOS-транзисторы) и арсенида галлия [4–7].
В качестве подложек для GaN-транзисторов могут быть использованы пластины карбида кремния и кремния. Параметры кристаллических решеток SiC и GaN различаются незначительно, что позволяет выращивать гетероструктуры высокого кристаллического качества, а высокая теплопроводность карбида кремния обеспечивает эффективный теплоотвод из активной области транзисторов. Поэтому многие производители, такие как Infineon Technologies, Microsemi, Cree, используют в качестве подложек карбид кремния. Однако подложки SiC обладают существенными недостатками – высокая стоимость, отсутствие пластин диаметром больше 150 мм, сложность постростового процессинга пластин. Вследствие этого ряд производителей рассматривает в качестве альтернативы недорогие пластины кремния большого диаметра. Выращивание гетероструктур на подложках кремния является более сложной задачей из-за значительного различия параметров решетки и коэффициентов теплового расширения. Однако выбор кремния в качестве подложек для GaN-транзисторов позволяет существенно снизить стоимость изготовления транзисторов за счет совместимости со стандартным оборудованием для кремния, а также использования пластин диаметром 200 мм и более [3, 8, 9].
Многие научные коллективы активно занимаются разработкой технологии “GaN на кремнии”. Исследуется влияние кремниевой подложки на СВЧ-характеристики GaN-транзисторов [10], ведется поиск решений по улучшению теплоотвода для улучшения характеристик GaN-транзисторов на кремнии [11], рассматриваются особенности GaN-технологии на подложках кремния [3].
На сегодняшний день серийным выпуском GaN-транзисторов на подложках кремния занимается компания MACOM (США). Удельная мощность поставляемых на рынок транзисторов составляет 4–6 Вт на миллиметр ширины затвора, максимальная выходная мощность дискретных транзисторов – более 100 Вт в L-, S-диапазонах частот [12]. Представленные характеристики вполне сопоставимы с характеристиками GaN-транзисторов на подложках из карбида кремния [13]. В России работы по исследованию и разработке в области создания GaN-транзисторов на кремниевых подложках практически отсутствуют и представлены единичными работами [14, 15].
В НИЦ “Курчатовский институт” последние несколько лет активно ведутся работы по совершенствованию GaN-технологии на кремнии [16–18]. Высокие удельные характеристики, полученные в [18], свидетельствуют как о высоком кристаллическом совершенстве гетероструктур, так и о высоком уровне развития технологии создания транзисторных кристаллов. Достигнутые результаты позволили перейти к созданию мощных транзисторов.
Существенной проблемой технологии “GaN на кремнии” является наличие проводящего канала на гетерогранице кремний/гетероструктура, приводящего к формированию паразитных емкостей, понижающих рабочие частоты и производительность, а также осложняющих согласование элементов усилителя мощности на основе мощных транзисторов [19]. В [17] был предложен подход по формированию гетероструктур на основе нитрида галлия на подложках кремния при пониженных температурах роста для снижения данного эффекта.
Целью представленной работы является дальнейшее изучение особенностей формирования буферного слоя AlN при пониженных температурах и его влияния на характеристики гетероструктуры и малосигнальные параметры транзисторов, а также создание мощных нитрид-галлиевых СВЧ-транзисторов и изучение их характеристик.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Эпитаксиальные нитридные гетероструктуры выращены методом газофазной эпитаксии из металлоорганических соединений (MOCVD) на установке AIXTRON 2600 G3 на 2´´-подложках монокристаллического кремния Si(111) толщиной 500 мкм. Подложку подвергали предварительной очистке от естественного оксида кремния в водном растворе плавиковой кислоты и отжигали в атмосфере водорода перед ростом в реакторе в течение одной минуты при температуре 950°С. Рост начинался с предварительной подачи триметилалюминия (TMAl). Были сформированы структуры с различной толщиной буферного слоя AlN: 50 нм (A), 100 нм (B), 200 нм (C). Остальная архитектура гетероструктуры была идентична для всех образцов: поверх AlN были выращены три слоя AlGaN толщиной 270, 350 и 350 нм и процентным содержанием Al 80, 50 и 30% соответственно, канальный слой GaN толщиной 1.3 мкм с включением низкотемпературной вставки AlN и барьерный слой AlN толщиной 4.5 нм.
Измерение абсолютной кривизны подложки проводили с использованием контактного профилометра DektakXT Advanced System (Bruker).
Для определения влияния толщины буферного слоя AlN на образование паразитного канала на гетерогранице AlN/Si были сформированы тестовые транзисторы с длиной затвора 0.45 мкм и шириной затвора 240 мкм и проведены исследования их малосигнальных характеристик. Измерения малосигнальных СВЧ-характеристик проводили на зондовой станции Cascade PM5 с зондами Z-probe 67 GHz и сетевым анализатором Agilent E8361C. Измерение слоевого сопротивления гетероструктур осуществляли методом длинной линии.
По результатам проведенных измерений выбрана гетероструктура А, на которой была сформирована топологическая схема мощного СВЧ-транзистора гребенчатой структуры. Элементарная ячейка транзисторного кристалла содержит четырехпальцевый затвор шириной 0.88 мм, а транзистор содержит девять ячеек с суммарной шириной затвора 7.92 мм. Изготовление транзисторов включало в себя следующие операции: циклы формирования невжигаемых контактов, формирование межприборной изоляции методом плазмо-химического травления, электроннолучевая литография формирования грибообразных затворов длиной 0.45 мкм, затворная металлизация Ni(50 нм)/Au(500 нм), формирование полевого электрода истока, формирование электрических межсоединений второго уровня, включая воздушные мостики с гальванически осажденными толстыми (2–4 мкм) слоями металлизации. Пассивацию поверхности транзисторных структур проводили посредством плазмохимического осаждения слоя SiNх толщиной 0.1 мкм. Изображение поперечного среза транзистора, полученное методом растровой электронной микроскопии (РЭМ), представлено на рис. 1.
После формирования топологии транзистора выполняли утонение пластины до толщины 100 мкм, плазмохимическое травление сквозных отверстий, гальваническую металлизацию сквозных отверстий и обратной стороны пластины, резку на кристаллы и сборку в корпус. Транзисторные кристаллы напаивали в металлокерамические позолоченные корпусы типа КТ-81-С. Соединение транзисторного кристалла с выводами корпуса формировали ультразвуковой сваркой с помощью золотой проволоки диаметром 50 мкм. Внешний вид полученного корпусированного транзистора представлен на рис. 2.
Измерения статических параметров проводили на зондовой станции Cascade PM5 с помощью двухканального источника-измерителя Keithley 2636B при комнатной температуре на постоянном токе.
После монтажа кристаллов в корпусы транзисторов энергетические характеристики измеряли с помощью специализированного стенда в НИИЭТ, г. Воронеж. Стенд включал в себя источник питания Keithley 22869, измеритель мощности Rohde Schwarz NRP, автоматические тюнеры Maury Microwave mt981-bl10, тестовую оснастку Maury Microwave MT964D1, усилитель мощности, генератор Г7М-20А. Для калибровки тюнеров использовали векторный анализатор Rohde Schwarz ZVA8. Измерения проводили в импульсном режиме с длительностью импульса 10 мкс при скважности S = 10. Настройку импеданса проводили с помощью тюнеров по критерию максимальной выходной мощности. Измерения проводили на частоте 1 ГГц. При этом оптимальный импеданс источника был определен как 0.97 + j3.64, оптимальный импеданс нагрузки – как 2.57 + j1.24.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Существенное различие в параметрах решеток и коэффициентах теплового расширения Si и GaN осложняет задачу роста гетероструктур приборного качества, которая была решена путем тщательного подбора архитектуры и толщин буферных слоев. Использование AlN в качестве первого буферного слоя обусловлено невозможностью прямого роста GaN на кремнии из-за активного травления галлием материала подложки. Использование именно этого материала в качестве слоя, подавляющего реакцию между Ga и Si, является наиболее простым из доступных способов, так как не требует подключения к установке MOCVD дополнительного оборудования или использования других установок. Подход пре-запуска паров TMAl в реактор за некоторое время до открытия клапана аммиака использовали для предотвращения образования нитрида кремния, нарушающего эпитаксиальный рост пленок, при реакции кремния с аммиаком (источника азота при росте нитридов). Многоступенчатый подход формирования буферных слоев AlGaN и введение низкотемпературной вставки при росте GaN позволили обеспечить накопление необходимых компенсирующих напряжений при росте структуры. Из-за сильных поляризационных свойств AlN толщины барьерного слоя 4–5 нм достаточно для формирования канала с концентрацией носителей более 1013 см–2. При больших толщинах происходит растрескивание барьерного слоя из-за различия в параметрах решетки между AlN и GaN при релаксации возникающих напряжений.
Благодаря примененным подходам все сформированные гетероструктуры не имели трещин на поверхности и обладали высоким качеством со слоевым сопротивлением двумерного электронного газа менее 500 Ом/□ (табл. 1). Отметим, что увеличение толщины буферного слоя AlN приводит не только к улучшению качества гетероструктуры и снижению слоевого сопротивления, но и к более эффективному накоплению сжимающих напряжений, что характеризуется меньшей абсолютной кривизной гетероструктуры после остывания и обусловлено непосредственно улучшением кристаллического качества самого буферного слоя AlN.
Таблица 1.
Характеристики гетероструктуры и малосигнальные параметры тестовых транзисторов
| Образец | Толщина буферного слоя AlN, нм | Абсолютная кривизна подложки, мкм | Слоевое сопротивление дву-мерного газа электронов, Ом/□ | Точка К (переход MSG в MAG), ГГц |
|---|---|---|---|---|
| A | 50 | 26 | 463 | 11.5 |
| B | 100 | 18 | 397 | 6 |
| C | 200 | 11 | 346 | 4.8 |
Для последующего создания транзисторов на основе нитридных гетероструктур существенной является проблема образования проводящего канала на границе AlN/Si, связанная с полярной природой AlN и диффузией атомов Al в кремний во время роста. Для выявления влияния этих эффектов на проводящий канал с изменением толщины буферного слоя AlN были проведены исследования малосигнальных параметров тестовых транзисторов при напряжении сток–исток, равном 5 В. Как видно из табл. 1, точка перехода максимально стабильного коэффициента усиления по мощности (MSG – maximum stable gain) в максимально достижимый коэффициент усиления по мощности (MAG – maximum available gain), характеризующая частотную зависимость коэффициента усиления, смещается в низкочастотную область с увеличением толщины буферного слоя AlN. Это указывает на то, что с ростом толщины AlN увеличивается паразитная емкость. Поскольку наибольшее увеличение емкости происходит при увеличении толщины AlN с 50 до 100 нм, наиболее вероятным механизмом для этих толщин пленки является эффект допирования подложки атомами Al, который существенно подавляется при дальнейшем увеличении толщины. В дальнейшем повышение емкости осуществляется в основном за счет усиления поляризационных эффектов. Несмотря на то что для всех гетероструктур характерно расположение точки перехода MSG/MAG в области выше 2 ГГц, наличие межсоединений (дополнительных паразитных емкостей), возникающих при создании мощных СВЧ-транзисторов, будет дополнительно приводить к смещению данной точки в более низкочастотную область. Таким образом, именно образец A был выбран для дальнейшего формирования мощных СВЧ-транзисторов, так как он обладает наименьшей паразитной емкостью.
Статические характеристики транзистора с периферией затвора 7.92 мм представлены на рис. 3. Максимальный ток насыщения транзистора был равен 8.5 А (более 1 А/мм) (рис. 3б). Крутизна транзистора составила более 200 мС/мм при напряжении на затворе –4 В, напряжение отсечки – –6 В. Пробивное напряжение транзистора определяли по критерию остаточного тока стока 1 мА, оно превышало верхний порог измерений (>120 В).
Рис. 3.
Статические характеристики транзистора с периферией затвора 7.92 мм: а – вольт-амперная характеристика транзистора (напряжение на затворе Vg от +2 до –6 В с шагом 0.5 В), б – стоко-затворная характеристика транзистора.
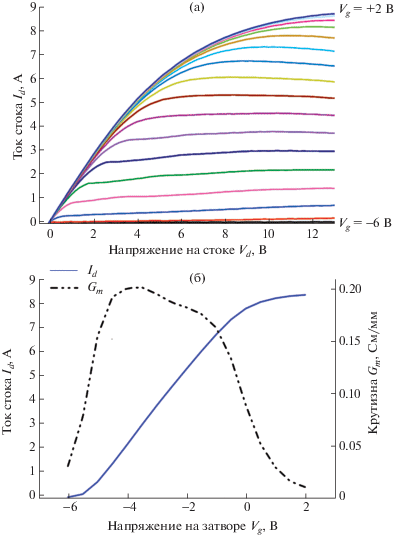
Мощностные характеристики транзистора представлены на рис. 4. Слабосигнальное усиление транзистора составило 21 дБ. Выходная мощность транзистора при компрессии 3 дБ достигла значения 40 Вт, максимальная выходная мощность составила 45 Вт при компрессии 4 дБ. Максимальный КПД транзистора равен 55%. Отметим, что высоких уровней удельной выходной мощности удалось достичь, в том числе, благодаря наличию подзатворного диэлектрика. Подзатворный диэлектрик Si3N4 играет защитную роль для гетероструктуры в агрессивных постростовых процессах, что особенно важно для тонких барьерных слоев AlN, используемых в настоящей работе. Применение родственного материала Si3N4 позволяет защитить барьерный слой от возможного окисления и создать безоксидную гетерограницу, что невозможно гарантировать при создании затвора Шоттки [20].
Зависимость усиления от входной мощности носит убывающий характер, свойственный для данного класса приборов. Выходная мощность транзистора выходит в насыщение, начиная с уровня входной мощности порядка 30 дБм, что обусловлено токовым насыщением транзистора. Тестовый усилительный каскад был настроен на работу в классе В, и относительно невысокое КПД для простейшего усилительного каскада такого режима работы может говорить о необходимости дальнейшей оптимизации структуры транзистора с целью снижения паразитных емкостей структуры.
ЗАКЛЮЧЕНИЕ
В работе изучены влияние толщины буферного слоя AlN на образование канала на гетерогранице AlN/Si, характеристики гетероструктуры и частотные характеристики транзисторов. Показано, что с увеличением толщины буферного слоя AlN наблюдаются улучшение кристаллического качества гетероструктуры и более эффективное накопление сжимающих напряжений, а также увеличение паразитной емкости канала. Сделано предположение, что для толщин AlN менее 100 нм основное влияние на повышение паразитной емкости оказывает допирование кремния атомами Al, а для толщин более 100 нм – полярязационные эффекты.
На гетероструктуре с наименьшей паразитной емкостью созданы мощные транзисторы по технологии нитрид галлия на кремнии с периферией затвора 7.92 мм. Измерения проводились на корпусированных транзисторных кристаллах, истоки транзисторов были заземлены к корпусу через сквозные отверстия. Максимальный удельный ток насыщения транзисторов составил более 1 А/мм, крутизна – более 200 мС/мм. Мощность насыщения достигла 45 Вт при напряжении питания 28 В (удельная мощность – более 5.5 Вт/мм). Максимальный коэффициент полезного действия транзистора равен 55%. Продемонстрированные характеристики соответствуют лучшим мировым результатам для транзисторов, созданных по технологии нитрида галлия на подложках кремния [12].
Работа выполнена при финансовой поддержке Министерства науки и высшего образования Российской Федерации (Соглашение № 05.604.21.0214, Уникальный идентификатор Соглашения RFMEFI60419X0214).
Список литературы
Кулиев М.В. // Электронная техника. 2017. Т. 245. Вып. 2. С. 18.
Jones K.A., Wraback M., Chow T.P. et al. // J. Mater. Sci. 2015. V. 50. P. 3267.
Chen K.J., Häberlen O., Lidow A. et al. // IEEE Trans. Electron Devices. 2017. V. 64. № 3. P. 779.
Кузьмин С. // Вестн. электроники. 2015. Т. 51. № 1. С. 6.
Викулов И.К. // Новые технологии. 2017. № 1. С. 106.
Ueda T., Inshida M., Tanaka T., Ueda D. // Jpn J. Appl. Phys. 2014. V. 53. P. 100214.
Custer J., Formicone G., Walker J.L.B. // 21st International conference on microwave, radar and wireless communications (MIKON) Japanese journal of applied physics. 9-11 may 2016. Krakov, Poland.
Cheng J., Yang X., Sang L. et al. // Sci. Rep. 2016. V. 6. P. 23020.
Semond F. // MRS Bull. 2015. V. 40. P. 412.
Chandrasekar H. // Int. J. High Speed Electronics Systems. 2019. V. 28. № 1. P. 1940001.
Mohanty S.K., Chen Y., Yeh P., Horng R. // Sci. Rep. 2019. V. 9. P. 19691.
https://www.macom.com/products/product-detail/NPTB00004A
Quay R., Schwantuschke D., Ture E. et al. // Phys. Status Solidi. A. 2018. V. 215. № 9. P. 1700655.
Алексеев А.Н., Александров С.Б., Бырназ А.Э. и др. // Письма в ЖТФ. 2008. Т. 34. Вып. 7. С. 58.
Арендаренко А.А., Орешкин В.А., Свешников Ю.Н., Цыпленков И.Н // Изв. вузов. Материалы электронной техники. 2015. Т. 18. № 1. С. 5.
Андреев А.А., Грищенко Ю.В., Езубченко И.C. и др. // Письма в ЖТФ. 2019. Т. 45. Вып. 4. С. 52.
Езубченко И.С., Черных М.Я., Андреев А.А. и др. // Российские нанотехнологии. 2019. Т. 14. № 7–8. С. 77.
Черных И.А., Романовский С.М., Андреев А.А. и др. // Письма в ЖТФ. 2020. Т. 46. Вып. 5. С. 11.
Pattison L., Boles T., Tuffy N., Lopes G. // Proceedings of the 9th European Microwave Integrated Circuits Conference. 6–7 Oct 2014, Rome, Italy.
Hashizume T., Nishiguchi K., Kaneki S. et al. // Mater. Scie. Semicond. Proc. 2018. V. 78. P. 85.
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии