Российские нанотехнологии, 2020, T. 15, № 6, стр. 775-780
НАНОКРИСТАЛЛИЧЕСКИЕ ПЛЕНКИ НА ОСНОВЕ ОКСИДА ЦИНКА, ПОЛУЧЕННЫЕ В ЕДИНОМ ВАКУУМНОМ ЦИКЛЕ
А. К. Ахмедов 1, А. Х. Абдуев 1, А. Ш. Асваров 1, 2, *, А. Э. Муслимов 2, В. М. Каневский 2
1 Институт физики им. Х.И. Амирханова Дагестанского научного центра РАН
Махачкала, Россия
2 Институт кристаллографии им. А.В. Шубникова ФНИЦ “Кристаллография и фотоника” РАН
Москва, Россия
* E-mail: abil-as@list.ru
Поступила в редакцию 15.07.2020
После доработки 21.07.2020
Принята к публикации 21.07.2020
Аннотация
Известно, что микроструктура и функциональные свойства магнетронных слоев оксида цинка зависят от ряда факторов: температуры подложек, взаимного расположения мишени и подложек, состава и давления остаточных и рабочих газов, мощностных характеристик разряда, степени выработки мишени, скорости осаждения слоев и т.д. В настоящее время для исследования влияния тех или иных факторов на структуру и свойства слоев используется метод последовательного осаждения серии слоев со ступенчатым изменением одного из контролируемых параметров. При этом ввиду большого количества действующих факторов, а также комплексного характера их воздействия, выделение вклада каждого отдельного фактора является сложной и нетривиальной задачей. Исследовано влияние температуры подложек и расстояния “мишень–подложка” на структуру и свойства слоев оксида цинка. При этом для минимизации влияния прочих факторов с помощью оригинальной системы нагрева и позиционирования подложек реализована концепция осаждения слоев на подложки всей серии с изменением только одного контролируемого фактора. Такая концепция осаждения в едином вакуумном цикле существенно снижает требования к точности контроля технологических параметров процесса, уменьшает влияние на конечный результат случайных неучтенных факторов, а также ускоряет процесс подготовки всей серии исследуемых тонкопленочных образцов.
ВВЕДЕНИЕ
Оксид цинка, обладая уникальной совокупностью физических свойств и многообразием форм, остается объектом пристального внимания многих исследовательских групп на протяжении нескольких десятилетий. Функциональные нанокристаллические материалы на основе ZnO в виде тонких пленок и разнообразных наноструктур находят все большее применение в оптоэлектронике, сенсорике и преобразователях различных видов энергии в электрическую [1–5]. В частности, прозрачные проводящие тонкие пленки на основе ZnO, легированного элементами III группы таблицы Менделеева, рассматриваются в качестве альтернативы прозрачным электродам на основе двойного оксида индия-олова, традиционно применяемого в системах отображения информации и преобразователях солнечной энергии [1, 6]. В свою очередь, высокоомные текстурированные пленки ZnO с высокой степенью преимущественной ориентации оси кристаллитов по нормали к поверхности роста могут применяться в качестве пьезоэлектрических слоев в приборах на поверхностных акустических волнах [7, 8].
Среди многочисленных методов синтеза тонких пленок ZnO наиболее широкое применение нашел метод магнетронного распыления, обеспечивающий высокую адгезию пленок при относительно низких температурах подложек и относительную простоту контроля условий роста пленок [9, 10]. Известно, что физические и морфологические свойства тонких пленок ZnO сильно зависят от скорости роста слоев и энергии распыленных частиц, которые в свою очередь задаются такими технологическими параметрами, как мощность распыления, давление и состав рабочего газа, температура подложки, геометрия расположения подложки относительно мишени [7, 11–16]. Это обусловливает значительное количество исследований, направленных на оптимизацию процесса получения функциональных пленок на основе ZnO.
Обычно для установления зависимости структуры и свойств слоев от условий осаждения используется метод последовательного осаждения серии слоев при изменении одного из контролируемых параметров. В то же время использование в исследовательских установках многопозиционного держателя подложек с возможностью индивидуального задания температуры каждой подложки и ее пространственного расположения обеспечивает возможность одновременного осаждения слоев в абсолютно идентичных условиях на несколько подложек. При этом подложки находятся при различной температуре и/или различном расположении подложек относительно распыляемой мишени, что не только сокращает временные и энергетические затраты на исследования и оптимизацию режимов осаждения, но и в силу полной идентичности условий осаждения повышает достоверность полученных результатов.
В данной работе представлены результаты исследования влияния расстояния “мишень–подложка” и температуры подложки на микроструктуру и функциональные свойства тонкопленочных слоев оксида цинка, полученных в едином цикле осаждения с использованием многопозиционного держателя подложек.
ОПИСАНИЕ ЭКСПЕРИМЕНТА
Функциональная схема и конструкция использованной многопозиционной системы нагрева и позиционирования подложек барабанного типа подробно описаны в [17]. Установка магнетронного распыления оснащена турбомолекулярным насосом, обеспечивающим предельное остаточное давление не хуже 2 × 10–4 Па, и двумя планарными магнетронными узлами для распыления мишеней диаметром 51 мм. На одном магнетроне установлена мишень из чистого ZnO, а на другом – электропроводящая мишень из ZnO:3 ат. % Ga (легированный галлием оксид цинка). Обе мишени диаметром 51 мм и толщиной 5 мм изготовлены методом искрового плазменного спекания [18]. На каждый держатель подложек были установлены по две подложки: стеклянная подложка (Corning 2947) размером 30 × 25 × 1.1 мм для исследования структуры, фазового состава, электрических и оптических характеристик и термически окисленная с кремниевой поверхностью – размером 10 × 25 × 0.5 мм для исследования морфологии методом сканирующей электронной микроскопии.
Первая серия образцов получена при высокочастотном распылении мишени нелегированного ZnO на подложках, закрепленных на трех держателях, установленных на различном расстоянии от оси вращения барабана. При вращении барабана подложки проходили над зоной эрозии мишени на расстоянии 5, 6 и 7 см. Распыление проводили в газовой смеси аргона (чистотой 99.999%) и кислорода (чистота 99.999%) с соотношением Ar/O2 = 14:1 при рабочем давлении P = = 1 Па и подводимой мощности 110 Вт. Осаждение слоев проводили при комнатной температуре. Скорость вращения барабана с подложками составляла 10 об./мин, длительность процесса осаждения – 180 мин.
Вторая серия образцов – прозрачные проводящие слои на основе ZnO – получена при магнетронном распылении мишени ZnO:Ga на постоянном токе. Подложки фиксировали на четырех держателях, симметрично расположенных относительно оси вращения (расстояние “мишень–подложка” LМ–П составляло 10 см). При этом один из держателей не нагревался, а температура остальных трех поддерживалась с помощью ПИД-регуляторов температуры (ОВЕН ТРМ10) на уровне 120, 180 и 240°С соответственно. Распыление проводили в атмосфере аргона чистотой 99.999% при рабочем давлении 0.15 Па, в режиме стабилизации тока. Ток разряда составлял 120 мА. Скорость вращения барабана с подложками – 10 об./мин, длительность процесса осаждения – 180 мин.
Морфологию полученных тонкопленочных образцов исследовали с использованием сканирующей электронной микроскопии (SEM Leo-1450). Скорость роста оценивали из данных электронной микроскопии при исследовании поперечного скола образцов. Метод рентгеновской дифракции (XRD) использовали для изучения фазового состава и структуры осажденных пленок (порошковый рентгеновский дифрактометр PANalytical X’PERT PRO MPD с длиной волны излучения (CuKα) λ = 0.15418 нм). Параметр кристаллической решетки с рассчитывали из положения рефлекса 004 ZnO, а область когерентного рассеяния оценивали по данным рефлекса 002 ZnO [19].
Электрические и оптические характеристики прозрачных проводящих тонких пленок ZnO:Ga оценивали с использованием стандартного четырехзондового метода (ИУС-3) и оптической спектрометрии (Shimadzu UV-3600) соответственно.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Все тонкопленочные образцы, полученные при распылении керамической мишени ZnO в среде Ar–O2, характеризуются высоким удельным сопротивлением (ρ >105 Ом см) и прозрачностью без цветовой окраски в проходящем свете. Это указывает на то, что данные условия роста препятствуют формированию в пленках межузельных атомов Zn, основного вида собственных дефектов n-типа в ZnO [20, 21].
Рис. 1.
Микрофотографии тонких пленок ZnO, осажденных в едином вакуумном цикле при различных расстояниях “мишень–подложка”: а – 7, б – 6, в – 5 см.
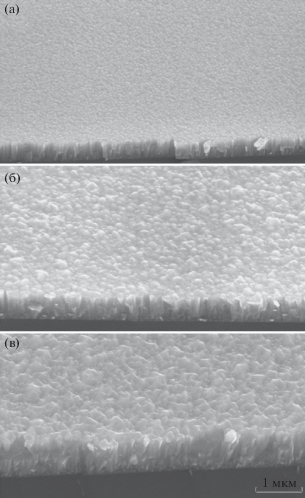
На рис. 1 приведены данные сканирующей электронной микроскопии (СЭМ) тонкопленочных образцов ZnO, напыленных при различном расстоянии “мишень–подложка”. Можно видеть, что с изменением LМ–П морфология поверхности значительно видоизменяется. С уменьшением LМ–П наблюдается увеличение латерального размера зерен на поверхности пленки и ее рельеф становится более развитым. Все пленки имеют характерную столбчатую структуру. Поперечный диаметр столбов увеличивается с уменьшением LМ–П. Оценка скорости роста из данных СЭМ показала более чем двухкратное уменьшение скорости осаждения при увеличении расстояния LМ–П с 5 до 7 см (табл. 1).
Согласно данным XRD все образцы имеют ярко выраженную текстуру с ориентацией оси с кристаллитов ZnO, имеющих структуру вюрцита, по нормали к поверхности роста. На рис. 2 приведен участок дифрактограмм с рефлексом 002 ZnO для образцов, полученных при различном LМ–П.
Рис. 2.
Участок дифрактограмм с рефлексом 002 ZnO для тонких пленок, осажденных при различном расстоянии “мишень–подложка”: 1 – 7, 2 – 6, 3 – 5 см. Штриховой линией на оси абсцисс отмечено положение рефлекса 2θ0 = 34.42°, соответствующее табличному значению параметра с0 = 0.5207 нм гексагональной кристаллической решетки ZnO со структурой вюрцита (карта PDF № 00-036-1451).

Отметим, что с уменьшением LМ–П наблюдается заметное увеличение интенсивности рефлекса, сдвиг положения рефлекса в сторону больших углов 2θ и некоторое увеличение интегральной ширины рефлекса. Рост интенсивности рефлекса коррелирует с данными по толщине пленок ZnO. Сдвиг рефлекса в сторону табличного для ZnO значения (2θ0 = 34.42°; PDF № 00-036-1451) указывает на снижение сжимающих макронапряжений в плоскости пленки ZnO при уменьшении LМ–П [22]. В свою очередь, наблюдаемое при этом увеличение интегральной ширины β, свидетельствующее об уменьшении среднего размера кристаллитов D002, указывает на то, что характер изменения микроструктуры пленок ZnO с изменением расстояния “мишень–подложка” обусловлен несколькими конкурирующими явлениями [23]. При малых расстояниях между мишенью и подложкой распыленные частицы (атомы, молекулы, кластеры) вблизи подложки обладают более высокой энергией и, следовательно, более высокой подвижностью на поверхности растущей пленки, что должно способствовать формированию менее дефектной, свободной от напряжений пленки. В то же время высокие скорости роста и усиление ионной и электронной бомабардировки растущей поверхности при малых расстояниях LМ–П должны ухудшать кристалличность формируемой пленки. Из данных табл. 1, в которой обобщены основные характеристики высокоомных пленок ZnO, напыленных при различных расстояниях “мишень–подложка” с использованием многопозиционного держателя подложек, можно сделать вывод, что для получения высокоориентированных пленок ZnO с высокой скоростью на неподогреваемых подложках необходимо снижать расстояние между мишенью и подложкой [24].
Известно, что для достижения низких удельных сопротивлений в прозрачных проводящих пленках на основе ZnO необходимо вести процесс напыления при минимально возможном давлении инертного рабочего газа [11, 25]. При этом напыляемые пленки характеризуются высокой концентрацией свободных носителей заряда, значительная доля которых обусловлена собственными дефектами n-типа [20, 26]. В связи с этим при исследовании влияния температуры подложки на функциональные характеристики прозрачных проводящих пленок процесс напыления был проведен при давлении Ar порядка 0.15 Па. Для достижения однородности пленки по толщине на всей поверхности подложки расстояние между мишенью и подложкой LМ–П было увеличено до 10 см.
Таблица 1.
Характеристики тонких пленок ZnO в зависимости от растояния “мишень–подложка” LМ–П
| LМ–П, см | d, нм | $v$, нм/мин | 2θ002, град | β002, град | с, нм | D002, нм |
|---|---|---|---|---|---|---|
| 7 | 520 | 2.89 | 34.156 | 0.243 | 0.5252 ± 0.0001 | 36 |
| 6 | 710 | 3.94 | 34.176 | 0.248 | 0.5249 ± 0.0001 | 35 |
| 5 | 1100 | 6.11 | 34.204 | 0.270 | 0.5245 ± 0.0001 | 32 |
На рис. 3 приведены микрофотографии поверхности и поперечного скола тонких пленок ZnO:Ga, напыленных в единном цикле на подложки, находящиеся при разных температурах. Можно видеть, что с ростом температуры подложки снижается рельеф поверхности пленок и морфология поверхности и поперчного скола становится более однородной. Результаты измерения толщины слоев приведены в табл. 2. Примечательно, что с ростом температуры подложки, наблюдается увеличение скорости осаждения пленки. Это может быть обусловлено наличием в составе потока реагентов значительной доли неокисленного цинка, вероятность окисления которого на поверхности роста увеличивается с увеличением температуры подложек [27].
Рис. 3.
Микрофотографии поверхности тонких пленок ZnO:Ga, полученных при различной температуре подложки: а – без нагрева (RT); б – 120, в – 180, г – 240°С. На вставках приведены микрофотографии поперечных сколов тонких пленок.
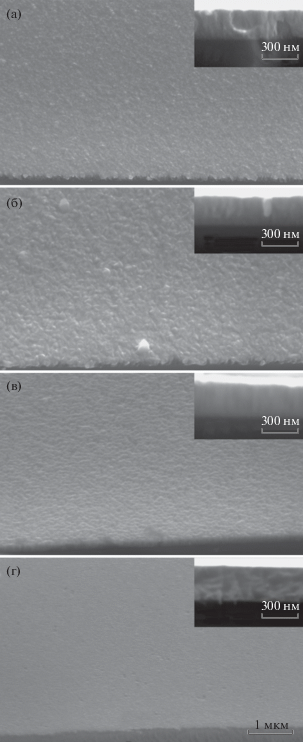
Таблица 2.
Характеристики тонких прозрачных проводящих пленок ZnO в зависимости от температуры подложки Tп
| Tп, °С | d, нм | $v$, нм/мин | с, нм | D002, нм | R, Ом/см2 | ρ, Ом см | T% |
|---|---|---|---|---|---|---|---|
| без нагрева | 260 | 1.44 | 0.5290 ± 0.001 | 4 | 348 | 9.1 × 10–3 | 90.44 |
| 120 | 270 | 1.50 | 0.5286 ± 0.001 | 5 | 210 | 5.7 × 10–3 | 91.18 |
| 180 | 300 | 1.67 | 0.5289 ± 0.001 | 10 | 63 | 1.9 × 10–3 | 90.23 |
| 240 | 310 | 1.72 | 0.5229 ± 0.0001 | 44 | 14.2 | 4.3 × 10–4 | 94.55 |
Примечание. d – толщина пленки, $v$ – скорость осаждения пленки, c – параметр кристаллической решетки ZnO, D002 – средний размер нанокристаллитов ZnO в пленке, R – поверхностное сопротивление, ρ – удельное сопротивление, T% – средний коэффициент оптического пропускания в видимой области спектра (400–700 нм).
Анализ XRD показал, что температура подложки играет существенную роль в формировании кристаллической фазы в пленке ZnO:Ga. В отсутствие нагрева подложки формируются поликристаллические слои низкого структурного совершенства с параметром решетки c = = 0.5293 нм, сильно увеличенным по сравнению с табличным значением (с0 = 0.5207 нм; PDF № 00-036-1451), и средним размером кристаллитов D002 = 4 нм. С увеличением температуры подложки до 180°С параметр с почти не изменяется, а средний размер кристаллитов увеличивается до значения D002 = 10 нм. Радикальное изменение параметра c в сторону табличного значения наблюдается при температуре подложки выше 200°С. Средний размер кристаллитов при этом увеличивался до 44 нм.
Высокая степень аморфизации тонких пленок, напыленных на подложки при температурах ниже 200°С, может быть связана с двумя факторами: внедрением цинка в междоузлия решетки ZnO [15] и замораживанием радиационных дефектов, обусловленных бомбардировкой растущей поверхности высокоэнергетичными заряженными частицами [26]. С ростом температуры синтеза влияние обоих факторов снижается из-за включения механизма поверхностной диффузии, при 300°С наблюдаются существенное улучшение кристалличности пленок и рост среднего размера кристаллитов ZnO. Этот результат находится в хорошем согласии с результатами измерения электрических характеристик (табл. 2).
Согласно данным оптической спектрометрии (рис. 4) все тонкопленочные образцы ZnO:Ga демонстрируют высокую прозрачность, средний коэффициент оптического пропускания T% в видимой области спектра (400–700 нм) выше 90%. При этом в коротковолновой области спектра с ростом температуры подложки наблюдается сдвиг края поглощения, обусловленный эффектом Бурштейна–Мосса.
ЗАКЛЮЧЕНИЕ
С использованием многопозиционной системы нагрева и позиционирования подложек барабанного типа, предусматривающей возможность индивидуального задания положения и температуры каждого держателя, реализована концепция одновременного осаждения в идентичных условиях серии слоев при изменении только одного контролируемого параметра. Такая концепция уменьшает влияние на конечный результат случайных неучтенных факторов, а также ускоряет процесс подготовки всей серии исследуемых тонкопленочных образцов. В качестве примера применения данного подхода при оптимизации режимов осаждения полупроводниковых тонких пленок функционального назначения исследованы зависимости скорости осаждения, морфологии, структуры, электрических и оптических характеристик нанокристаллических пленок на основе ZnO от расстояния “мишень–подложка” и температуры осаждения. Монотонность и взаимная корреляция полученных зависимостей свидетельствуют об идентичности условий осаждения и, как следствие, минимизации влияния неучтенных случайных факторов. Предложенный подход может быть использован при формировании нанокристаллических пленок самого широкого класса соединений.
Работа проведена при поддержке Министерства науки и высшего образования РФ в рамках выполнения Государственных заданий Дагестанского федерального исследовательского центра РАН и Федерального научно-исследовательского центра “Кристаллография и фотоника” РАН, а также при поддержке Российского фонда фундаментальных исследований (гранты № 20-07-00760 А, 18-29-12099 мк). Работа выполнена с использованием оборудования ЦКП ФНИЦ “Кристаллография и фотоника” при поддержке Минобрнауки (проект RFMEFI62119X0035) и Аналитического центра коллективного пользования Дагестанского федерального исследовательского центра.
Список литературы
Ponja S.D., Sathasivam S., Parkin I.P., Carmalt C.J. // Sci. Rep. 2020. V. 10. P. 638. https://doi.org/10.1038/s41598-020-57532-7
Асваров А.Ш., Абдуев А.Х., Ахмедов А.К. и др.// Кристаллография. 2018. Т. 63. № 6. С. 952. https://doi.org/10.1134/S0023476118060036
Shiryaev M.A., Jin Y.J., Bong H.C., Baranov A. // Nanotechnologies in Russia 2017. V. 12. P. 613. https://doi.org/10.1134/S199507801706009X
Lee Y.-P., Lin Ch.-Ch., Hsiao Ch.-Ch. et al. // Micromachines. 2020. V. 11. P. 14. https://doi.org/10.3390/mi11010014
Tseng Z., Chiang C., Wu C. // Sci. Rep. 2015. V. 5. P. 13211. https://doi.org/10.1038/srep13211
Varanytsia A., Weng L., Lin T. et al. // J. Disp. Technol. 2016. V. 12. P. 1033. https://doi.org/10.1109/JDT.2016.2584779
Costa J., Peixoto T., Ferreira A. et al. // J. Biomed. Mater. Res. A. 2019. V. 107. P. 2150. https://doi.org/10.1002/jbm.a.36725
Huang H.-Y., Chiang H.-J., Wu C.-Z. et al. // Micromachines. 2019. V. 10. P. 434. https://doi.org/10.3390/mi10070434
Tan X.-Q., Liu J.-Y., Niu J.-R. et al. // Materials. 2018. V. 11. P. 1953. https://doi.org/10.3390/ma11101953
Akhmedov A.K., Abduev A.K., Kanevsky V.M. et al. // Coatings. 2020. V. 10. P. 269. https://doi.org/10.3390/coatings10030269
Jahed N.M.S., Mahmoudysepehr M., Sivoththaman S. // Highly conductive TCO by RF sputtering of Al:ZnO for thin film photovoltaics. 2015 IEEE 42nd Photovoltaic Specialist Conference (PVSC), New Orleans, LA, 2015. P. 1–4. https://doi.org/10.1109/PVSC.2015.7356300
Zhou H.B., Zhang H.Y., Tan M.L. et al. // Mater. Res. Innov. 2012. V. 16. № 6. P. 390. https://doi.org/10.1179/1433075X12Y.0000000002
Bittau F., Abbas A., Barth K.L. et al. // Thin Solid Films 2017. V. 633. P. 92. https://doi.org/10.1016/j.tsf.2016.10.068
Abduev A., Akhmedov A., Asvarov A., Belyaev V. // SID Symposium Digest of Technical Papers. 2019. V. 50. P. 977. https://doi.org/10.1002/sdtp.13089
Toma M., Marconi D., Pop M. et al. // Anal. Lett. 2019. V. 52. № 14. P. 2227. https://doi.org/10.1080/00032719.2019.1606819
Исмаилов А.М., Эмирасланова Л.Л., Рабаданов М.Х. и др. // Письма в ЖТФ. 2018. Т. 44. № 12. С. 52. https://doi.org/10.21883/PJTF.2018.12.46291.16792
Akhmedov A.K., Asvarov A.S., Muslimov A.E. et al. // Coatings. 2020. V. 10. P. 1076. https://doi.org/10.3390/coatings10111076
Асваров А.Ш., Муслимов А.Э., Ахмедов А.К. и др. // Приборы и техника эксперимента. 2019. № 5. С. 138. https://doi.org/10.1134/S0032816219050033
Muchuweni E., Sathiaraj T.S., Nyakotyo H. // Heliyon 2017. V. 3. P. e00285. https://doi.org/10.1016/j.heliyon.2017.e00285
Ellmer K., Bikowski A. // J. Phys. D. 2016. V. 49. P. 413002. https://doi.org/10.1088/0022-3727/49/41/413002
Rotella H., Mazel Y., Brochen S. et al. // J. Phys. D. 2017. V. 50. P. 485106. https://doi.org/10.1088/1361-6463/aa920b
Chaabouni F., Belgacem J.B., Abaab M. // Chin. J. Phys. 2014. V. 52 (1-I). P. 272. https://doi.org/10.6122/CJP.52.272
Huafu Z., Hanfa L., Aiping Z., Changkun Y. // J. Semicond. 2009. V. 30 (11). P. 113002. https://doi.org/10.1088/1674-4926/30/11/113002
Lu W.M., Zhang J., Diao H.W. et al. // Mater. Sci. Forum. 2011. V. 685. P. 134. Doi:10.4028/www.scientific.net/msf.685.134
Chaves M., Ramos R., Martins E. et al. // Mater. Res. 2019. V. 22 (2). P. e20180665. https://doi.org/10.1590/1980-5373-mr-2018-0665
Bikowski A., Welzel T., Ellmer K. // Appl. Phys. Lett. 2013. V. 102. P. 242106. https://doi.org/10.1063/1.4811647
Ghorannevis Z., Hosseinnejad M.T., Habibi M., Golmahdi P. // J. Theor. Appl. Phys. 2015. V. 9. P. 33. https://doi.org/10.1007/s40094-014-0157-1
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии