Российские нанотехнологии, 2021, T. 16, № 6, стр. 873-876
ОСОБЕННОСТИ СОЗДАНИЯ НАНОСТРУКТУРИРОВАННЫХ СЛОЕВ TiO2–Al2O3 ДЛЯ СВЕРХПЛОТНЫХ ЗАПОМИНАЮЩИХ СРЕД С СИСТЕМОЙ АДРЕСАЦИИ НА ОСНОВЕ ПЕРЕКРЕСТНЫХ ШИН
А. Н. Белов 1, *, Ю. А. Демидов 2, Д. В. Локтев 3, Г. Н. Пестов 1, А. В. Солнышкин 4
1 Национальный исследовательский университет “МИЭТ”
Москва, Зеленоград, Россия
2 ООО НПП “НаноИнТех”
Москва, Зеленоград, Россия
3 ООО “Микродатчик”
Москва, Зеленоград, Россия
4 Тверской государственный университет
Тверь, Россия
* E-mail: nanointech@mail.ru
Поступила в редакцию 07.07.2021
После доработки 29.07.2021
Принята к публикации 29.07.2021
Аннотация
Представлены результаты исследования процесса самоорганизации мемристивных ячеек TiO2–Al2O3 методом анодного окисления структуры алюминий–титан. Оригинальные подходы к этому процессу позволяют точно контролировать толщины функциональных слоев оксидов алюминия и титана. Для формирования верхнего электрода предлагается использовать метод каталитического химического осаждения, позволяющий заполнить пористую структуру и организовать на поверхности массив проводящих шин. Проведенные измерения индивидуальных и групповых электрофизических свойств мемристивных ячеек подтвердили работоспособность таких структур в составе устройств с адресацией кроссбар.
ВВЕДЕНИЕ
Интерес к явлению резистивного переключения в тонких металлических и полупроводниковых пленках проявляют ученые всего мира. Это связано с возможностью масштабирования мемристивных ячеек в глубокую субмикронную область при применении систем адресации типа кроссбар [1, 2]. Другим их немаловажным качеством является их энергонезависимость. Однако подобные структуры, содержащие между проводящими шинами только мемристивные ячейки, характеризуются одним большим недостатком: наличием ошибок при чтении и записи состояния ячейки [3]. Это связано с протеканием паразитных токов через три соседние ячейки, характеризующиеся более низким электрическим сопротивлением [4]. Для решения этой проблемы можно использовать сложные высокочувствительные схемы электронной обработки, однако это сводит на нет преимущества миниатюризации мемристивной сборки. Для обеспечения индивидуальной адресации многие используют связку один мемристор–один транзистор (1T1R RRAM) [5]. Однако такой подход увеличивает количество используемых элементов вдвое и значительно усложняет архитектуру полученного устройства. Более привлекательным является использование связок один мемристор–один диод (1D1R RRAM). Подобные структуры были предложены исследователями в 2003 г. для реализации памяти на основе классической микроинтегральной технологии [6, 7]. Интересным решением является интеграция в каждую мемристивную ячейку диода Шоттки [8]. Такой подход позволяет избавиться от прохождения паразитных токов через соседние ячейки и обеспечивает корректность операций записи и считывания. Недостатками являются ограничение количества шин в сетке кроссбар, а также сложности при использовании двухполярного питания. Наиболее применимым методом обеспечения корректной работы мемристивного кроссбар является использование диодов, работающих на эффекте квантово-механического туннелирования [9]. Они представляют собой сплошные слои диэлектрика толщиной от 1 до 2 нм. Такие слои формируют методом атомно-слоевого осаждения [10] или, например, магнетронным распылением [11].
В рамках данной работы предлагается оригинальное решение по самоорганизации мемристивных структур с нелинейными вольт-амперными характеристиками (ВАХ) методом анодного окисления структур алюминий–титан. Это простой и дешевый процесс получения оксидов металлов, проводимый при комнатной температуре и позволяющий точно контролировать геометрию и состав получаемых пленок.
ЭКСПЕРИМЕНТ
Мемристивные структуры Ni/Al2O3/TiO2/Ti формировали следующим образом. На поверхности кремниевой пластины КДБ-12 ориентации (100) методом термического окисления формировали слой SiO2 толщиной 0.4 мкм. На его поверхность методом магнетронного распыления наносили слой титана толщиной 0.3 мкм. Методом фотолитографии титановый слой модифицировали в массив проводящих шин шириной 4 мкм с контактными площадками. На поверхность титановых шин наносили слой алюминия толщиной 2 мкм. Анодное окисление проводили в серной кислоте в гальваностатическом режиме при плотности тока 2 мА/см2. Для упорядочивания структуры, а также обеспечения одинаковой формы пор по всей толщине оксида применяли метод двойного анодирования [12] и температурной компенсации напряжения [13]. Остатки алюминия на поверхности удаляли травителем, представляющим собой хлорид меди, разведенный в водном растворе соляной кислоты. Для организации верхних проводящих шин в поры оксида алюминия и на его поверхность методом химического каталитического осаждения наносили слой никеля. Для этого структуры подвергали сенсибилизации в течение 1 мин в растворе 3 г/л SnCl2 ⋅ 2H2O и 3 мл/л HCl, а затем активации в течение 3 мин в растворе 0.1 г/л PdCl2 и 0.1 мл/л HCl. Слой никеля осаждали из водного раствора NiSO4 и NiCl2 с добавками ацетата и гипофосфита натрия. После этого слой никеля модифицировали методами фотолитографии и химического травления в массив проводящих шин, расположенных перпендикулярно нижним. Образцы исследовали с использованием методов атомно-силовой, просвечивающей и растровой электронной микроскопии (ПЭМ, РЭМ). Измерения электрофизических параметров проводили с использованием ранее созданной автоматизированной установки.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Известно, что при анодном окислении алюминия в электролитах на основе серной, щавелевой и ортофосфортой кислот самоорганизуются пористые упорядоченные оксидные наноструктуры [13]. В этих же условиях титан и другие вентильные металлы образуют плотные оксиды [12]. На основе таких оксидов успешно изготавливают мемристивные слои [14]. При анодном окислении двухслойных структур алюминий–титан оксид последнего проникает в поры оксида алюминия и образует массив нанопроволок. Механизм протекания этого процесса подробно описан в [12]. В рамках настоящей работы стояла задача детального исследования прохождения фронта окисления через границу раздела алюминий–титан. Для точного контроля толщин полученных оксидов фронт окисления в любой момент процесса должен быть параллелен поверхности пластины, на которую нанесены функциональные слои. Это обеспечивается неизменностью основных факторов анодного окисления: напряжения, плотности тока и температуры [13]. Для проверки корректности метода проводили процесс окисления алюминия, нанесенного на слой SiO2. На рис. 1 представлены графики распределения толщины алюминиевого слоя по поверхности пластины.
Рис. 1.
Распределение толщины слоя алюминия после селективного удаления оксида по поверхности подложки.

Схематичное представление и характерные кинетические кривые процесса, в том числе при прохождении фронта окисления через границу раздела алюминий–титан, представлены на рис. 2.
Рис. 2.
Кинетические зависимости напряжения процесса анодного окисления двухслойной структуры алюминий–титан (a), перехода фронта окисления через границу раздела (б) и ПЭМ-изображение двухнанометрового слоя оксида алюминия (в).

Как было отмечено выше, окисление алюминия сопровождается постоянным напряжением (1). При достижении фронта окисления поверхности титана наблюдается повышение напряжения (2), нарастающее с увеличением объема оксида титана (3). При этом происходит растворение барьерного слоя оксида алюминия [15]. Соприкосновение электролита с поверхностью оксида титана также отражается на поведении кривой напряжения (4). Фактически соотношение толщин слоев оксидов алюминия и титана определяется моментом остановки процесса окисления на третьем этапе.
На рис. 3 представлена микрофотография структуры Ni/Al2O3/TiO2 –x/Ti. Для моделирования функционирования ячеек в составе кроссбар были сформированы по четыре мемристивные ячейки с площадью контакта 4 × 4 мкм с различными толщинами слоя оксида алюминия. Из рисунка видно, что никель заполняет пористый слой оксида алюминия и обеспечивает стабильный электрический контакт к ячейке Al2O3/TiO2 –x. Измерения проводили как индивидуально каждого мемристора, так и в составе группы с межсоединениями. На рис. 4а показаны характерные ВАХ мемристивной ячейки без слоя Al2O3 (1) и со слоями оксида толщиной 2 (2) и 8 нм (3). Как видим, при появлении в структуре двухнанометрового оксида алюминия электрическое сопротивление структуры увеличилось как минимум на порядок, при этом характер ВАХ в целом остался неизменным. При увеличении этого слоя до 8 нм токи составляют единицы наноампер, петля гистерезиса практически не наблюдается. К подобным выводам пришли в [9] при подробном анализе потенциального барьера в туннельном диоде на основе сверхтонкой алюмооксидной пленки.
Рис. 4.
Вольтамперная характеристика (a) и зависимость резистивного состояния от количества импульсов (б) мемристивной ячейки Ni/Al2O3/TiO2 –x/Ti.
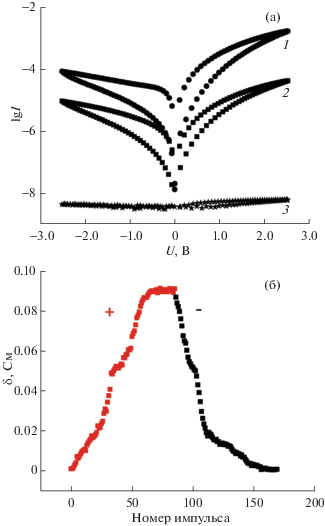
Для проверки работоспособности сформированных структур в составе кроссбар были исследованы резистивные состояния мемристивных ячеек как индивидуально, так и в составе перекрестного подключения. Для увеличения проводимости ячейки (потенциация) на нее последовательно подавали прямоугольные импульсы положительной полярности амплитудой 2 В и длительностью 5 мкс. Фронты нарастания и спада составляли 10 нс. Для уменьшения проводимости (депрессия) подавали отрицательные импульсы. Для измерения текущего состояния подавали два импульса различной полярности с задержкой 10 мкс и при этом измеряли величину силы тока. На рис. 4б представлена характерная зависимость проводимости ячейки от числа импульсов.
Для проверки стабильности состояний четыре ячейки коммутировали в минимальный кроссбар, предварительно записав в одну из них состояние ~10–5 См, а в три другие 8 × 10–5 См. Далее на шины, соответствующие высокоомной ячейке, подали 20 положительных импульсов и измерили проводимость каждой в отдельности. В результате проводимость низкоомных ячеек осталась неизменной, а у высокоомной увеличилась до 3 × × 10–5 См. В первом приближении это свидетельствует о работоспособности подобных структур и возможности применения их в устройствах памяти нового поколения, а также искусственных нейросетях.
ЗАКЛЮЧЕНИЕ
Продемонстрирован оригинальный метод самоорганизации сверхплотной запоминающей среды, содержащей массив наноразмерных мемристивных ячеек TiO2–Al2O3 с системой адресации перекрестных проводящих шин. Показана возможность управления размером сверхтонкой пленки оксида алюминия в процессе анодного окисления двухслойной структуры алюминий–титан. Для этого был детально исследован механизм анодного окисления данных структур, в частности на границе раздела металлических слоев. Предложено использовать метод химического каталитического осаждения никеля, позволяющий плотно заполнять поры алюминия и образовывать верхнюю систему металлизации. Проведенные исследования ВАХ, а также резистивных состояний ячеек позволяют утверждать о работоспособности таких систем и применимости их в устройствах энергонезависимой памяти нового поколения, а также искусственных нейронных сетях.
Исследование выполнено при финансовой поддержке Российского фонда фундаментальных исследований (проекты № 19-29-03055, 20-38-90026).
Список литературы
Тарков М.С. // Прикладная дискретная математика. Приложение. 2015. № 8. С. 151.
Никируй К.Э., Емельянов А.В., Рыльков В.В. и др. // Радиотехника и электроника. 2019. Т. 4. № 8. С. 151.
Flocke A., Noll T.G. // ESSCIRC 2007-33rd. European Solid-State Circuits Conference 2007. P. 328. https://doi.org/10.1109/ESSCIRC.2007.4430310
Linn E., Rosezin R., Kügeler C. et al. // Nature Mater. 2010. V. 9. P. 403. https://doi.org/10.1038/nmat2748
Chung-Cheng Chou, Zheng-Jun Lin, Pei-Ling Tseng et al. // 2018 IEEE Int. Sol.-St. Circ. Conf. 2018. P. 478. https://doi.org/10.1109/ISSCC.2018.8310392
Mircea R. Stan, Paul D. Franzon, Seth C. Goldstein et al. // Proc. IEEE. 2003. V. 91. № 11. P. 1940. https://doi.org/10.1109/JPROC.2003.818327
Matthew M. Ziegler, Mircea R. Stan // IEEE Trans. Nanotech. 2003. V. 2. № 4. P. 217. https://doi.org/10.1109/TNANO.2003.820804
Fatih Gül // Res. Phys. 2019. V. 12. P. 1091. https://doi.org/10.1016/j.rinp.2018.12.092
Govoreanu B., Redolfi A., Zhang L. et al. // Electr. Dev. Meet. 1988. IEDM’88. Tech. Dig.– 2013. P. 10.2.1. https://doi.org/10.1109/IEDM.2013.6724599
Giovinazzo C., Ricciardi C., Pirri C.F. et al. // Appl. Phys. A. 2018. V. 124. P. 686. https://doi.org/10.1007/s00339-018-2112-5
Finn Zahari, Felix Schlichting, Julian Strobel // J. Vac. Sci. Tech. B. 2019. V. 37. P. 061203. https://doi.org/10.1116/1.5119984
Белов А.Н., Гаврилов С.А., Демидов Ю.А., Шевяков В.И. // Российские нанотехнологии. 2011. Т. 6. № 11–12. С. 6.
Белов А.Н., Гаврилов С.А., Шевяков В.И. // Российские нанотехнологии. 2006. Т. 1. № 1–2. С. 223.
Aglieria V., Zafforaa A., Lulloa G. // Superlattices and Microstructures. 2018. V. 113. P. 135. https://doi.org/10.1016/j.spmi.2017.10.031
Lissy Berndt, Malte Kleemeier, Karsten Thiel et al. // Int. J. Electrochem. Sci. 2018. V. 13. P. 8867. https://doi.org/10.20964/2018.09.11
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии



