Российские нанотехнологии, 2021, T. 16, № 6, стр. 865-872
МЕМРИСТИВНЫЙ ЭФФЕКТ В СТРУКТУРАХ Та/ТаОх/Та, ПОЛУЧЕННЫХ ЛАЗЕРНЫМ СИНТЕЗОМ
Л. С. Паршина 1, *, Д. С. Гусев 1, О. Д. Храмова 1, А. С. Поляков 1, Н. Н. Елисеев 1, О. А. Новодворский 1
1 Институт проблем лазерных и информационных технологий РАН – филиал ФНИЦ “Кристаллография и фотоника” РАН
Шатура, Россия
* E-mail: parshinaliubov@mail.ru
Поступила в редакцию 14.06.2021
После доработки 12.07.2021
Принята к публикации 19.07.2021
Аннотация
При разработке элементов нейроморфных систем исследуются различные материалы, обеспечивающие создание энергозависимых и энергонезависимых мемристорных структур. Методом импульсного лазерного осаждения в бескапельном режиме с применением масочных технологий получены тонкие пленки TaOх, а также мемристорные структуры в кроссбар-геометрии на их основе. Тонкие пленки TaOх получены при различной (25 и 350°С) температуре подложки сапфира, давлении кислорода в вакуумной камере (от 0.5 до 80 мторр) и длине волны аблирующего излучения (248 и 532 нм). Рентгеноструктурные исследования пленок с высоким разрешением позволили определить условия получения пленок с образованием нанокристаллитов и зависимость размеров нанокристаллитов от условий получения. Методом рентгеновской фотоэлектронной спектроскопии определен состав пленок и степени окисления тантала. Двухзондовым методом исследовали вольт-амперные характеристики (ВАХ) пленок при униполярном и биполярном сканировании напряжения. Выявлен энергонезависимый мемристивный эффект в тонкопленочных структурах Ta/TaOх/Ta/с-Аl2O3 при измерениях ВАХ в плоской и кроссбар-геометрии.
ВВЕДЕНИЕ
Интерес к мемристорам вызван возможностью их применения в устройствах энергонезависимой памяти и в нейроморфных системах. На основе мемристорных структур создаются новые типы элементов искусственного интеллекта – нейристоры и синапторы, выполняющие функции искусственных синапсов и нейронов человеческого мозга [1–4]. В настоящее время ведутся активные исследования различных материалов для создания базовых элементов нейроморфных систем [5–8]. Исследуются мемристивные устройства на оксидах переходных металлов для резистивной оперативной памяти (RеRAM) и элементов нейроморфных систем [9–13]. Интерес к оксидам переходных металлов вызван тем, что они обладают относительной простотой состава и, как следствие, возможностью синтеза различными методами. Оксид тантала – один из наиболее популярных материалов, стехиометрией которого можно управлять в относительно широком диапазоне значений во время роста тонких пленок, что существенно при создании мемристора на его основе. Тонкие пленки оксида тантала могут быть получены различными методами [13–15], в том числе импульсным лазерным осаждением (ИЛО) [16]. При синтезе тонких пленок оксида тантала метод ИЛО в бескапельном режиме обеспечивает устранение попадания капель на пленку при абляции металлической мишени Ta излучением лазеров с различной длиной волны. Известно, что энергия осаждаемых частиц играет ключевую роль в кинетике роста пленки, обеспечивая усиление диффузии атомов или генерацию предпочтительных мест адсорбции [17], а метод ИЛО позволяет управлять энергией частиц факела в широком диапазоне, не доступном другим методам [18]. Энергия частиц на поверхности растущей пленки зависит также от давления буферного газа. Энергия осаждаемых частиц уменьшается при увеличении давления из-за столкновений с молекулами буферного газа [19]. Когда длина свободного пробега соизмерима с расстоянием от мишени до подложки, частицы факела не теряют энергию на столкновения с частицами буферного газа и их энергетический спектр управляется плотностью энергии лазерного излучения на мишени [18, 19]. Методом рентгеновской дифракции в [20, 21] проводились структурные исследования пленок TaOх, применяемых в качестве активной области мемристора. Обнаружены два хорошо разрешенных пика дифракции от поликристаллических пленок в диапазоне углов 2θ от 20° до 30° в пленках TaOх, полученных при температуре 700°С. В настоящей работе проведены рентгеноструктурные исследования пленок, полученных при комнатной температуре и при 350°С. Изменения сопротивления мемристоров с комбинацией энергозависимого и энергонезависимого характера поведения, вызванного окислением металлических электродов, наблюдались в [22] для пленок оксида тантала. Однако сравнительных наблюдений мемристивного поведения пленок (с использованием двух зондов) и мемристоров в кроссбар-геометрии с таким же оксидом, насколько известно, проведено не было.
Цель настоящей работы – импульсное лазерное осаждение в бескапельном режиме [23] тонких пленок TaOх и исследование резистивного переключения мемристоров на их основе в плоской и кроссбар-геометрии методом вольт-амперной характеристики (ВАХ) при униполярном и биполярном режимах прикладываемого напряжения в зависимости от длины волны аблирующего излучения при синтезе активной области мемристора, температуры подложки и степени окисления TaOх.
МЕТОДЫ
Тонкие пленки TaOх толщиной d = 20–302 нм и мемристорные структуры Та/ТаОх/Та/с-Аl2O3 получены методом ИЛО в бескапельном режиме при абляции металлической мишени Ta излучением KrF-лазера (λ = 248 нм) (Lambda Physik, Германия) и второй гармоники YAG:Nd3+-лазера (λ = 532 нм) (Линкс 2000, Россия) при температуре подложки c-Al2O3 25 и 350°С. Давление кислорода в вакуумной камере в процессе роста пленок изменялось в диапазоне от 0.5 до 80 мторр. Плотность энергии лазерного излучения на мишени составляла не менее 2.5 Дж/см2 при частоте следования импульсов 10 Гц. Подложки располагались на расстоянии 50 мм от мишени. Во избежание попадания капель на растущую пленку между мишенью и подложкой размещался механический сепаратор, устраняющий попадание капель на пленку [23]. Мемристорные структуры формировали в плоской и кроссбар-геометрии с использованием прецизионных масок (рис. 1). Поперечная площадь мемристора в кроссбар-геометрии составляла 100 × 100 мкм. Пленки Та в качестве электродов толщиной от 40 до 150 нм осаждались в вакууме ~10–7 торр, который достигался с помощью турбомолекулярного и криогенного насосов.
Рис. 1.
Схематическое изображение мемристивных устройств на подложке c-Al2O3 и схема измерения ВАХ: а – плоская геометрия Ta/TaOx/с-Аl2O3; б – кроссбар-геометрия Ta/TaOx/Ta/с-Аl2O3.
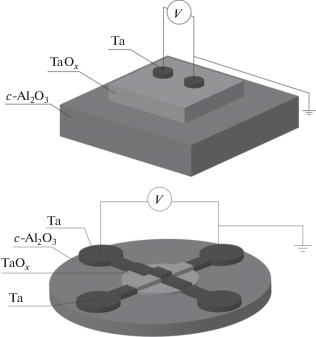
Структурные характеристики полученных пленок исследовали с помощью рентгеновского дифрактометра MiniFlex-600 (λ = 0.1541 нм) (Rigaku Corporation, Япония). Толщины синтезированных пленок измеряли с помощью модифицированного оптического интерферометра МИИ 4 (λ = 605 нм) (ЛОМО, Россия). Рентгеновские фотоэлектронные спектры (РФЭС) пленок регистрировали на фотоэлектронном спектрометре Axis Ultra DLD (AlKα) (Kratos Analytical, Великобритания). Полученные мемристоры исследовали при комнатной температуре на стенде для измерения ВАХ тонкопленочных структур с использованием двухканального генератора/измерителя Keithley 2636В (Keithley, США) со встроенным импульсным источником питания и прецизионной двухзондовой системой позиционирования DCM 210 (Cascade Microtech, США) при униполярном и биполярном режимах прикладываемого напряжения.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Пленки TaOх. Рентгеноструктурные исследования тонких пленок TaOх, полученных при одинаковой температуре 350°С и давлении кислорода 0.5, 1.0, 10.0 и 80 мторр, позволили установить логарифмическую зависимость величины пика и размера нанокристаллитов от давления буферного газа кислорода. Относительная высота пиков и размеры нанокристаллитов, полученных в результате рентгеноструктурных исследований пленок в интервале углов 2θ от 30° до 40°, приведены в табл. 1. Эта зависимость может быть связана с энергией осаждающихся частиц на поверхности растущей пленки, зависящей от давления буферного газа. Энергия осаждаемых частиц уменьшается при увеличении давления из-за столкновений с молекулами буферного газа. Известно, что энергия осаждаемых частиц играет ключевую роль в кинетике роста пленки, обеспечивая усиление диффузии атомов или генерацию предпочтительных мест адсорбции [17]. Длина свободного пробега при давлении 0.5 мторр соизмерима с расстоянием от мишени до подложки в проведенных экспериментах, и частицы факела не теряют энергию на столкновения с частицами буферного газа [18, 19]. Амплитуда рефлексов кристаллитов в пленках, полученных при комнатной температуре, также уменьшается с ростом давления [24]. Отметим, что при низкой температуре подложки сильнее проявляется зависимость величины пиков нанокристаллитов от энергии осаждающихся частиц, которая растет при увеличении длины волны аблирующего излучения. Амплитуда рефлексов от пленки ТаОх, полученной при абляции излучением 532 нм, больше, чем от пленки, полученной при абляции излучением 248 нм. При одинаковом давлении кислорода (10 мторр) проявляется влияние температуры подложки – полученная при комнатной температуре пленка рентгеноаморфна в отличие от пленки, полученной при 350°С, где имеются нанокристаллиты ТаОх. Полученные в настоящей работе размеры нанокристаллитов согласуются с результатами [25].
Таблица 1.
Размеры и относительная величина пиков нанокристаллитов в пленках ТаОх
| Пленка | Тs, °C | Р O2, мторр | пик 35.88 | пик 37.70 | пик 39.42 | |||
|---|---|---|---|---|---|---|---|---|
| d, нм | h, отн. ед. | d, нм | h, отн. ед. | d, нм | h, отн. ед. | |||
| 1 | 350 | 0.5 | 52.1 | 217 | 72.61 | 118 | 40.3 | 180 |
| 2 | 25 | 0.5 | 30.8 | 216 | 37.9 | 138 | 94 | 163 |
| 3 | 350 | 1.0 | 75.9 | 74 | ||||
| 4 | 350 | 5.0 | ||||||
| 5 | 350 | 10.0 | 88.1 | 42 | ||||
| 6 | 350 | 50.0 | 39.65 | 77 | 83.52 | 130 | ||
| 7 | 350 | 80 | 92.78 | 41 | ||||
| 8 | 25 | 5.0 | 33.3 | 43 | 43.9 | 55 | 44.5 | 22 |
| 9 | 25 | 10.0 | ||||||
| 10 | 25 | 50.0 | 22.0 | 90 | 53.87 | 148 | 26.44 | 87 |
| 11 | 25 | 0.5 | 30.84 | 150 | 39.9 | 197 | 28.1 | 207 |
| 12 | 350 | 0.5 | 93 | 85 | ||||
| 13 | 25 | 50.0 | ||||||
Методом рентгеновской фотоэлектронной спектроскопии определен состав пленок и степени окисления тантала. Условия получения пленок и РФЭС полученных пленок приведены в табл. 2. РФЭС орбитали Ta4f образцов были разложены на компоненты, отвечающие состояниям тантала в степенях окисления +1, +2, +3 и +5. Полученные результаты хорошо коррелируют с измеренными значениями удельного сопротивления пленок (табл. 2). Максимальные концентрации атомов тантала в степенях окисления +1, +2, +3 наблюдались в пленках ТаОх, полученных при давлении кислорода 0.5 мторр при абляции излучением с длиной волны как 248, так и 532 нм, причем для большей длины волны процентное содержание слабо окисленных атомов Та выше. В то же время зависимость процентного содержания различных окисленных состояний тантала от температуры подложки слабая.
Таблица 2.
Условия получения и РФЭС пленок
| Пленка | ρ, Ом см | λ, нм | Т, °C | р, мторр | d, нм | РФЭС орбитали Ta4f, % | |||
|---|---|---|---|---|---|---|---|---|---|
| Ta+ | Ta2+ | Ta3+ | Ta5+ | ||||||
| 1 | 3.6 × 10−3 | 248 | 350 | 0.5 | 168 | 6 | 11 | 9 | 74 |
| 2 | 3.4 × 10−3 | 248 | 25 | 0.5 | 95 | 2 | 10 | 11 | 77 |
| 3 | 9.9 × 10−2 | 248 | 350 | 1.0 | 122 | 0 | 1 | 2 | 97 |
| 4 | 2.59 × 101 | 248 | 350 | 5.0 | 190 | 0 | 4 | 8 | 88 |
| 5 | 5.53 × 102 | 248 | 350 | 10.0 | 138 | 0 | 0 | 0 | 100 |
| 6 | 6.85 × 104 | 248 | 350 | 50.0 | 255 | 0 | 0 | 0 | 100 |
| 7 | 5.79 × 104 | 248 | 350 | 80 | 227 | 0 | 2 | 5 | 93 |
| 8 | 1.3 × 10−1 | 248 | 25 | 5.0 | 302 | 2 | 10 | 12 | 76 |
| 9 | 2.36 × 102 | 248 | 25 | 10.0 | 287 | 0 | 2 | 8 | 90 |
| 10 | 1.0 × 104 | 248 | 25 | 50.0 | 117 | 0 | 0 | 0 | 100 |
| 11 | 9.3 × 10−4 | 532 | 25 | 0.5 | 20 | 10 | 11 | 7 | 72 |
| 12 | 7.0 × 10−3 | 532 | 350 | 0.5 | 30 | 7 | 11 | 9 | 73 |
| 13 | 2.49 × 104 | 532 | 25 | 50.0 | 30 | 0 | 0 | 0 | 100 |
Мемристоры в плоской геометрии. Мемристивное поведение ВАХ наблюдали на структурах в плоской геометрии, в которых в качестве активной области использовались пленки ТаОx с удельным сопротивлением меньше 1 Ом см.
Пленки ТаОх, полученные при одинаковом давлении кислорода 0.5 мторр и температуре 350°С независимо от длины волны аблирующего излучения, содержат большой процент ионов тантала в слабоокисленных состояниях. На рис. 2 в полулогарифмических координатах представлены униполярные ВАХ мемристоров в плоской геометрии, в которых в качестве активной области использовались пленки ТаОx, полученные при давлении 0.5 мторр и температуре 350°С излучением 248 и 532 нм (пленки 1 и 12 в табл. 2). Обе ВАХ демонстрируют мемристивный эффект энергонезависимого типа при последовательном униполярном сканировании напряжения от нуля до 3 В. Пороговое напряжение переключения обоих мемристоров находится в окрестности 1.75 В. Мемристор с активной областью, полученной излучением 248 нм, в процессе униполярного цикла переходит из высокоомного (20 кОм) в проводящее состояние (2.3 кОм), а мемристор с активной областью, полученной излучением 532 нм, в результате приложения униполярного циклического напряжения, напротив, переходит из проводящего (18 кОм) в высокоомное состояние (562 кОм). Видно, что в более тонкой пленке (пленка 12) с обедненным количеством кристаллитов исходное удельное сопротивление выше, чем в пленке 1 (табл. 2). Это сказывается на ВАХ мемристоров. Мемристор на пленке 1 переходит из высокоомного в проводящее состояние, а мемристор на пленке 12 – наоборот, и обход ВАХ имеет противоположное направление. Таким образом, размер и концентрация нанокристаллитов, присутствующих в активной области мемристора, влияют на величину и знак его резистивного переключения.
Рис. 2.
ВАХ мемристоров в плоской геометрии с активной областью, полученной при давлении 0.5 мторр и температуре 350°С излучением 248 нм (пленка 1) и 532 нм (пленка 12), при униполярном сканировании напряжения от нуля до 3 В.
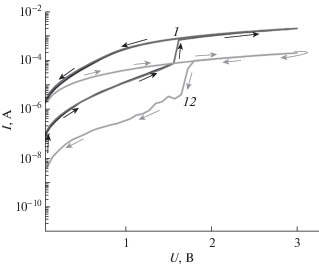
На рис. 3 приведены последовательные униполярные ВАХ мемристора на пленке ТаОx, полученной при давлении 1 мторр и температуре 350°С с незначительным отклонением от стехиометрии (пленка 3). Наблюдается слабо выраженный мемристивный эффект энергонезависимого характера. Видно, что при подаче следующего импульса напряжения изменение сопротивления начинается от предыдущего его значения, демонстрируя синаптическую пластичность мемристора энергонезависимого типа. Это связано с постепенным формированием филаментов [14, 26] и заполнением ловушек в пленке ТаОx [27]. При этом максимальный ток каждого последующего цикла возрастает. Зависимость сопротивления мемристора от времени для шести последовательных униполярных циклов представлена на вставке рис. 3.
Рис. 3.
Последовательные униполярные ВАХ мемристора на пленке ТаОx, полученной при давлении 1 мторр и температуре 350°С при сканировании напряжения в диапазоне 0–7 В. На вставке – зависимость сопротивления мемристора от времени для шести последовательных униполярных циклов.

Мемристоры в кроссбар-геометрии. В качестве активной области мемристоров Ta/TaOх/Ta/с-Аl2O3 в кроссбар-геометрии использовались пленки ТаОх толщиной 18 и 63 нм, полученные при комнатной температуре и давлении кислорода в камере 5 мторр. Биполярные ВАХ мемристора с толщиной оксидного слоя 18 нм представлены кривыми энергонезависимого типа (рис. 4). Для более толстого оксидного слоя ТаОх, полученного при таких же условиях, мемристор при биполярном сканировании напряжения демонстрирует асимметричные ВАХ (рис. 5). Направление обхода ВАХ в положительной и отрицательной области напряжений происходит против часовой стрелки. Таким образом, мемристор с классическим поведением получен только для малых толщин оксидного слоя. Для больших толщин имеем двойственность поведения мемристоров.
Рис. 4.
Биполярные ВАХ мемристора Ta/TaOx/Ta/с-Аl2O3 в кроссбар-геометрии с толщиной оксидного слоя 18 нм. Условия получения оксидного слоя – давление кислорода 5 мторр и температура 25°С. Абляция мишени излучением 248 нм.

Рис. 5.
Биполярные асимметричные ВАХ мемристора Ta/TaOx/Ta/с-Аl2O3 в кроссбар-геометрии с толщиной оксидного слоя 63 нм. Условия получения оксидного слоя – давление кислорода 5 мторр, температура 25°С. Абляция мишени излучением 248 нм.

На мемристор, выполненный в кроссбар-геометрии, оксидный слой которого осаждали излучением с длиной волны 532 нм при давлении кислорода 5 мторр и температуре 25°С, подавали униполярное циклическое напряжение, последовательно увеличивая амплитуду. Сначала подавались несколько циклов напряжения от нуля до +1 В и от +1 В до нуля. При каждом последующем цикле максимальный ток мемристора уменьшался. При амплитуде напряжения +2 В ситуация повторилась, ток при максимальном напряжении уменьшался. На рис. 6 представлены ВАХ мемристора при подаче последовательных циклов униполярного напряжения амплитудой +3 В. Изначально все они имеют энергонезависимый характер. Каждая кривая в своем начальном участке повторяла конечный участок предыдущей ВАХ. При этом с каждым циклом максимальный ток продолжал снижаться. Однако после некоторого количества циклов характер ВАХ кардинально изменился. Если все предыдущие циклы ВАХ на рис. 6 проходили по часовой стрелке, то очередной цикл начинался при увеличившемся сопротивлении. При напряжении более +2 В произошло резкое увеличение тока. ВАХ вышла на новую устойчивую ветвь – сопротивление изменилось от 18.5 кОм при 2.1 В до 2.2 кОм при 2.4 В – по которой вернулась в ноль. Направление обхода ВАХ при этом происходило против часовой стрелки в отличие от предыдущих циклов. Такое поведение можно объяснить следующим образом. Формирование филаментов в полупроводниковом слое ТаОх происходит одновременно с доокислением матрицы до Та2О5. Поэтому после очередного цикла напряжения сопротивление слоя возрастает. Оно возрастает как при увеличении прикладываемого напряжения, так и при увеличении количества циклов. Происходит также окисление граничного слоя Та электрода, который находится под положительным потенциалом. Обход всех циклов проходит по часовой стрелке. С поступлением очередной порции заряда в оксидный слой его сопротивление растет. После достижения критической концентрации филаментов в результате эффекта перколяции на очередном цикле при определенном напряжении происходит резкое уменьшение сопротивления, и мемристор переходит из высокоомного в низкоомное состояние. При этом направление обхода меняется и проходит против часовой стрелки.
Рис. 6.
Последовательные ВАХ мемристора Ta/TaOx/Ta/с-Аl2O3 в кроссбар-геометрии при подаче нескольких циклов напряжения от 0 до +3 В и от +3 В до 0. Стрелками показаны направления обхода ВАХ. Точкой (Vth) обозначено напряжение порогового переключения. Оксидный слой толщиной 30 нм осаждали излучением с длиной волны 532 нм.
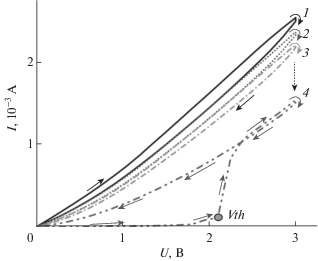
При подаче на верхний электрод отрицательного напряжения амплитудой –3 В характер поведения ВАХ сохранился. Направление обхода ВАХ также проходило против часовой стрелки. Однако напряжение перехода из высокоомного в низкоомное состояние от цикла к циклу возрастало, и эта тенденция сохранялась при увеличении амплитуды напряжения. На рис. 7 представлен один из таких униполярных циклов. При подаче биполярного циклического напряжения ВАХ мемристора демонстрирует мемристивный эффект энергонезависимого характера. Особенности поведения ВАХ мемристора Ta/TaOх/Ta в кроссбар-геометрии, по-видимому, определяются влиянием межфазных границ на внутренней поверхности реактивных электродов [11, 14]. Подобные изменения сопротивления мемристоров с комбинацией энергозависимого и энергонезависимого характера поведения наблюдались в [22]. Значения сопротивлений в состоянии ВКЛ и ВЫКЛ мемристора, ВАХ которого представлена на рис. 7, составляли 1.1 и 11.7 кОм соответственно.
ЗАКЛЮЧЕНИЕ
Методом импульсного лазерного осаждения в бескапельном режиме получены тонкие пленки TaOх и мемристоры Ta/TaOх/Ta/с-Аl2O3 на их основе в плоской и кроссбар-геометрии. Исследовано резистивное переключение полученных мемристоров методом ВАХ при униполярном и биполярном режимах прикладываемого напряжения в зависимости от длины волны аблирующего излучения при синтезе активной области мемристора, температуры подложки и степени окисления TaOх. Рентгеноструктурные исследования пленок TaOх с высоким разрешением позволили определить, что пленки, полученные при 350°С в диапазоне давлений кислорода от 0.5 до 5 мторр независимо от длины волны аблирующего излучения, являются рентгеноаморфными с наличием нанокристаллитов, размеры которых увеличиваются с ростом давления. Установлено, что независимо от размера нанокристаллитов в мемристорах на основе пленок, полученных излучением 248 нм в диапазоне давлений кислорода от 0.5 до 5 мторр при температуре подложки 350°С, наблюдается мемристивный эффект с энергонезависимым типом резистивного переключения. При этом пленки TaOх обладают удельным сопротивлением не меньше 10–1 Ом · см. Мемристоры в кроссбар-геометрии на основе пленок TaOх толщиной 18 нм, полученных излучением 248 нм при 5 мторр и комнатной температуре, обладают наименьшим порогом резистивного переключения 0.75 В. С увеличением толщины активной области мемристора до 63 нм напряжение резистивного переключения увеличивается до 1 В. Мемристоры в кроссбар-геометрии на основе пленок TaOх, полученных излучением 532 нм при 5 мторр и комнатной температуре, обладают наибольшим порогом резистивного переключения 3 В, демонстрируя переход энергонезависимого в энергозависимый тип переключения после нескольких циклов работы. Полученные результаты лазерного синтеза внесут вклад в создание мемристоров на основе оксидов тантала в качестве синапторов – нового типа элементной базы нейроморфных систем искусственного интеллекта.
Работа выполнена при поддержке Министерства науки и высшего образования в рамках выполнения работ по Государственному заданию ФНИЦ “Кристаллография и фотоника” РАН в части “выращивания тонких пленок”, Российского фонда фундаментальных исследований (проект № 19-29-03032) в части “исследования мемристивных свойств тонких пленок и наноструктур”.
Список литературы
Demin V.A., Nekhaev D.V. // Front Neuroinform. 2018. V. 12. P. 79. https://doi.org/10.3389/fninf.2018.00079
Valle J. del, Ramírez J.G., Rozenberg M.J., Schuller I.K. // J. Appl. Phys. 2018. V. 124. P. 211101. https://doi.org/10.1063/1.5047800
Emelyanov A.V., Nikiruy K.E., Serenko A.V. et al. // Nanotechnology. 2019. V. 31. P. 045201. https://doi.org/10.1088/1361-6528/ab4a6d
Erokhin V. // BioNanoSci. 2020. V. 10. P. 834. https://doi.org/10.1007/s12668-020-00795-1
Nikiruy K.E., Emelyanov A.V., Demin V.A. et al. // AIP Adv. 2019. V. 9. 6. P. 065116. https://doi.org/10.1063/1.5111083
Ielmini D., Wang Z., Liu Y.// APL Mater. 2021. V. 9. P. 050702. https://doi.org/10.1063/5.0047641
Amirsoleimani A., Alibart F., Yon V. et al. // Adv. Intell. Syst. 2020. V. 2. P. 2000115. https://doi.org/10.1002/aisy.202000115
Mikhaylov A., Pimashkin A., Pigareva Y. et al. // Front. Neurosci. 2020. V. 14. P. 358. https://doi.org/10.3389/fnins.2020.00358
Sharath S.U., Joseph M.J., VogelS. Et al. // Appl. Phys. Lett. 2016. V. 109. P. 173503. https://doi.org/10.1063/1.4965872
Goux L., Kim J.Y., Magyari-Kope B. et al. // J. Appl. Phys. 2015. V. 117. P. 124501. https://doi.org/10.1063/1.4915946
Zhou Z., Yang M., Fu Z. et al. // Appl. Phys. Lett. 2020. V. 117. P. 243502. https://doi.org/10.1063/5.0020501
Bo Y., Zhang P., Zhang Y. et al. // J. Appl. Phys. 2020. V. 127. P. 245101. https://doi.org/10.1063/5.0004139
Ryu H., Kim S. // Nanomaterials. 2020. V. 10. P. 2159. https://doi.org/10.3390/nano10112159
Sun Y.M., Song C., Yin J. et al. // Appl. Phys. Lett. 2019. V. 114. P. 193502. https://doi.org/10.1063/1.5098382
Mikhaylov A., Belov A., Korolev D. et al. // Adv. Mater. Technol. 2019. V. 5 P. 1900607. https://doi.org/10.1002/admt.201900607
Li Y., Sanna S., Norrman K. et al. // Appl. Surf. Sci. 2019. V. 470. P. 1071. https://doi.org/10.1016/j.apsusc.2018.11.153
Boughaba S., Sproule G.I., McCaffrey J.P. et al. // Thin Solid Films. 2000. V. 358. P. 104. https://doi.org/10.1016/S0040-6090(99)00703-8
Novodvorsky O.A., Parshina L.S., Khramova O.D. et al. // Chaos Soliton Fract. 2021. V. 142. P. 110457. https://doi.org/10.1016/j.chaos.2020.110457
Novodvorsky O.A., Mikhalevskii V.A., Gusev D.S. et al. // Tech. Phys. Lett. 2018. V. 44. P. 271. https://doi.org/10.1134/S1063785018030239
Srivastava S., Thomas J.P., Leung K.T. // Nanoscale. 2019. V. 11. P. 18159. https://doi.org/10.1039/C9NR06403F
Gnanarajan S., Lam S.K.H., Foley C.P. // J. Appl. Phys. 2007. V. 101. P. 063535. https://doi.org/10.1063/1.2495937
Cho D.Y., Lubben M., Wiefels S. et al. // Acs. Appl. Mater. Inter. 2017. V. 9. P. 19287. https://doi.org/10.1021/acsami.7b02921
Parshina L.S., Novodvorsky O.A., Khramova O.D. et al. // Opt. Quant. Electron. 2016. V. 48. P. 316. https://doi.org/10.1007/s11082-016-0586-y
Parshina L.S., Novodvorsky O.A., Khramova O.D. et al. // Chaos Soliton Fract. 2021. V. 142. P. 110460. https://doi.org/10.1016/j.chaos.2020.110460
Perez I., Sosa V., Perera F.G. et al. // Vacuum. 2019. V. 165. P. 274. https://doi.org/10.1016/j.vacuum.2019.04.037
Hu. Q., Fan Z., Huang A. et al. // J. Appl. Phys. 2019. V. 126. P. 065104. https://doi.org/10.1063/1.5109267
Kumar S., Graves C.E., Strachan J.P. et al. // Adv. Mater. 2016. V. 28. P. 2772. https://doi.org/10.1002/adma.201505435
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии



