Неорганические материалы, 2019, T. 55, № 4, стр. 355-360
Электролюминесценция монокристаллов p-GaSe〈РЗЭ〉
А. Ш. Абдинов 1, Р. Ф. Бабаева 2, *
1 Бакинский государственный университет
AZ 1145 Баку, ул. З. Халилова, 23, Азербайджан
2 Азербайджанский государственный экономический университет (UNEC)
AZ 1000 Баку, ул. Истиглалийят, 6, Азербайджан
* E-mail: Babayeva@unec.edu.az
Поступила в редакцию 20.03.2018
После доработки 31.10.2018
Принята к публикации 28.09.2018
Аннотация
Исследованы электролюминесцентные (ЭЛ) свойства монокристаллов p-GaSe〈РЗЭ〉 с содержанием введенной примеси N ≤ 10–1 ат. % при наличии эффекта переключения (ЭП). Установлено, что при таких значениях N параметры и характеристики ЭЛ и ЭП не зависят от химической природы введенной примеси (гадолиния и диспрозия), и при содержании РЗЭ N ≈ 10–2–10–1 ат. % обеспечивается их высокая стабильность и воспроизводимость. Рассмотрена возможность применения изучаемых монокристаллов для создания высококачественных переключателей и источников света с S‑образной ВАХ.
ВВЕДЕНИЕ
Динамичное развитие оптоэлектроники требует изучения электронных свойств и выявления возможностей практического применения полупроводниковых материалов с электролюминесцентными свойствами в видимой области оптического диапазона электромагнитного излучения. В связи с этим актуально исследование электролюминесценции, особенно инжекционной, в различных полупроводниках. В последние годы особый интерес вызывают наноматериалы (например, пористый кремний [1–5]), физические свойства которых можно варьировать в широком диапазоне путем изменения их геометрических параметров при постоянном химическом составе. Но при этом существуют определенные трудности создания источников видимого излучения на этих материалах, которые прежде всего связаны с их низким квантовым выходом, нестабильностью излучения, неоднородностью распределения интенсивности по площади, большой инерционностью, малыми сроками службы. Кроме того, подобные структуры (электролюминесцентные элементы), как правило, изготавливаются на основе различного типа электрических контактов (p–i, n–i, p–n, p–p, n–n гомо- и гетеропереходов). Однако создание таких структур в большинстве случаев ограничивается технологическими трудностями, поэтому круг материалов, применяемых для этой цели, а также диапазон излучения ограничены.
Появление новых возможностей практического применения вызывает значительный интерес к изучению особенностей электролюминесценции в давно известных полупроводниках. Одним из таких полупроводников является принадлежащий к классу слоистых соединений АIIIBVI монокристаллический p-GaSe. Этот полупроводник перспективен для создания различного типа оптоэлектронных устройств [6–8], в том числе электролюминесцентных источников света видимого диапазона, а также низкоразмерных структур с уникальными свойствами [9–15]. В частности, имеющие форму дисков толщиной в один тетраслой квантовые точки этого соединения обладают хорошей фотостабильностью и высоким квантовым выходом люминесценции. В слоях монокристаллов p-GaSe наблюдаются инжекционная электролюминесценция (ЭЛ) [16], эффекты переключения (ЭП) различного типа (пороговый и бистабильный) [17] и возможность их совмещения в одном образце [18]. Последнее делает этот полупроводник перспективным материалом для создания переключателя и источника света с S-образной ВАХ. Однако наличие различных случайных дефектов (СД), в том числе макроскопических (МД) [19], влияет на стабильность и воспроизводимость электролюминесцентных свойств чистых (нелегированных специально) монокристаллов p-GaSe, что препятствуeт их успешному практическому применению.
Для уменьшения влияния дефектов на электронные свойства монокристаллов p-GaSe применялись различные методы. Было установлено, что, помимо термообработки, радиационного облучения и т.д., его можно уменьшать также слабым (при содержаниях введенной примеси N ≤ ≤ 10–1 ат. %) легированием некоторыми РЗЭ. Предполагается, что это происходит вследствие “сплочения” МД. Исходя из этого и результатов работ [20, 21] возникла идея о возможности повышения стабильности и воспроизводимости электролюминесцентных параметров монокристаллов p-GaSe путем их легирования РЗЭ.
Целью данной работы является получение высокоэффективного (со стабильными и воспроизводимыми параметрами) материала для создания переключателя и источника света с S-образной ВАХ на основе монокристаллов p-GaSe〈РЗЭ〉 путем изучения ЭП и ЭЛ в одном образце, а также выяснения механизма влияния слабого легирования РЗЭ на эти эффекты.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Соединение GaSe было синтезировано совместным сплавлением компонентов с чистотой 99.999%. Легирование осуществляли путем введения в шихту РЗЭ – гадолиния (Gd) и диспрозия (Dy). Выбор в качестве примеси именно этих РЗЭ был обусловлен рядом причин. Во-первых, существует достаточное количество работ (см., например, [20, 21]) по получению и исследованию различных физических свойств легированных Gd и Dy монокристаллов p-GaSe, которые позволяют объяснить полученные нами экспериментальные результаты. Во-вторых, эти РЗЭ по своей электронной конфигурации, химической активности, устойчивости в сухом воздухе, электрохимическому подобию с Ga, а также значениям температуры плавления, атомного и ионного радиусов [22–24] являются эффективными для легирования GaSe. Использование же в качестве легирующих примесей двух разных РЗЭ объяснялось необходимостью выявления влияния химической природы введенной примеси на ЭЛ в исследуемом полупроводнике. Если влияние легирования на ЭЛ вызвано не процессами, непосредственно связанными с созданными введенными примесями локальными энергетическими уровнями (центрами), а изменением структуры основной матрицы исследуемого полупроводника, то не будет обнаруживаться зависимость ЭЛ от химической природы введенной примеси.
Монокристаллы, выращенные из синтезированного вещества методом Бриджмена [25], имели р-тип проводимости. Структура, фазовый и элементный состав полученных слитков, состояние поверхности по плоскости естественных сколов были определены путем проведения комплексных исследований с помощью установок: ДСК-910, ADVNCE-8D, SINTECP 21, ДРОН-4-07 (CuKα-излучение, шаг 0.05°, диапазон углов 8°–135°), СЭМ фирмы Zeiss с энергодисперционным анализатором.
Имеющие форму прямоугольного параллелепипеда образцы были сколоты из разных слитков, а также из различных участков одного и того же крупного монокристаллического слитка. Значение темнового удельного электрического сопротивления при 77 K (ρ0) чистых образцов менялось в пределах ~5 × 104–108 Ом см, а значения N и ρ0 в легированных образцах составляли 10–5–10–1 ат. % и ~5 × 103–109 Ом см соответственно. В легированных монокристаллах максимальное (~109 Ом см) и минимальное (~5 × 103 Ом см) значения ρ0 наблюдаются при N ≈ 5 × 10–4 и N ≈ 10–1 ат. % соответственно.
Электрические контакты были созданы путем припаивания индия, олова, а также нанесением серебряной пасты на свежесколотые поверхности образцов на воздухе.
Измерения проводились в области 77 ≤ Т ≤ 300 K при напряженности электрического поля до ~3.5 × × 103 В/см в диапазоне длин волн 0.30–2.00 мкм при помощи экспериментальной установки, собранной на базе видоизмененного комплекса типа КСВУ-23. Для всех исследуемых образцов в режиме генератора напряжения снимались статическая ВАХ, а также спектральное распределение и зависимости яркости электролюминесцентного свечения от напряженности электрического поля (Е), силы тока (i), протекающего через исследуемый образец, температуры (Т) при питании электрической цепи от источников постоянного тока.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
В монокристаллах p-GaSe〈РЗЭ〉 с N = 10–5–10–1 ат. %, так же как и в чистых кристаллах, при T ≤ 200 K, начиная с определенного значения напряженности электрического поля Ез (напряженности зажигания электролюминесценции), наблюдается ЭЛ. Значение Ез соответствует области ВАХ, где имеет место заметная инжекция, увеличивается с ростом Т и ρ0, а также зависит от материала электрических контактов. Наиболее низкая Ез и высокая яркость свечения (Вλ) наблюдаются в образцах с индиевыми контактами.
ЭЛ начинается в приконтактной области “отрицательного” контакта и с дальнейшим ростом Е постепенно расширяется в сторону “положительного”. Установлено, что параметры и характеристики ЭЛ (значения Eз и Вλ, а также зависимости Вλ от λ, Т, U и i) в монокристаллах p‑GaSe〈РЗЭ〉 при рассмотренных значениях N от химической природы введенной примеси не зависят. Диапазон (0.58 ≤ λ ≤ 1.10 мкм), положения основного (λ ≈ 0.60 мкм) и дополнительных (λ1 ≈ 0.67 и λ2 ≈ 0.82 мкм) максимумов спектра зависимости Вλ от λ ЭЛ в монокристаллах p-GaSe〈РЗЭ〉 совпадают с таковыми для чистых монокристаллов (рис. 1). Резкий коротковолновый спад спектра ЭЛ соответствует значению ширины запрещенной зоны ∼2.04 эВ [18], а основная и дополнительные полосы излучения – рекомбинационным центрам εr1 ≈ ευ + 0.20 эВ и εr2 ≈ ευ + 0.54 эВ соответственно. При этом яркость ЭЛ возрастает с U по степенному, а с i – по линейному законам (рис. 2). В зависимости от N меняются лишь яркость отдельных полос излучения и значение Ез; обе эти зависимости имеют немонотонный характер.
Рис. 1.
Спектры ЭЛ в чистых (1) и легированных РЗЭ (2, 3) монокристаллах р-GaSе: Т = 77 K; Е = 4Ез; i = = 30 мA; N = 10–3(2), 10–1 ат. % (3).
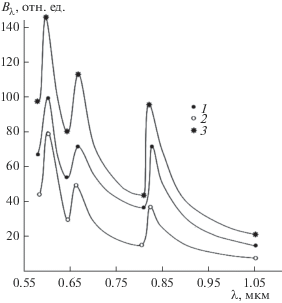
Рис. 2.
Зависимости яркости ЭЛ от напряжения (1–3) и силы тока (4–6) в монокристаллах p-GaSe〈РЗЭ〉: Т = 77 K; λ = 0.60 мкм; N = 0 (1, 4), 10–3 (2, 5), 10–1 ат. % (3, 6).

С ростом содержания РЗЭ значение Eз сначала увеличивается (при N ≤ 10–4 ат. %) на ~25–30% по сравнению со значением для самого низкоомного чистого кристалла (Ез0), а затем (при 10–4 < N ≤ 10–1 ат. %), постепенно уменьшаясь, при N ≈ 10–1 ат. % становится меньше, чем Ез0 (рис. 3, кривая 1). Значение же Вλ с ростом N сначала (при N ≤ 10–4 ат. %) на ~30–40% уменьшается по сравнению со значением в самом низкоомном чистом кристалле (ρ0 ≈ 5 × 104 Ом см), а далее (при 10–4 < N ≤ 10–1 ат. %), резко увеличиваясь, при N ≈ 10–1 ат. % в 1.5–2.5 раза превышает его (рис. 3, кривая 2). С повышением температуры сначала (в области T ≈ 160–170 K) Вλ почти не меняется, а далее происходит температурное тушение ЭЛ. Температура, при которой происходит полное тушение ЭЛ, для всех исследуемых образцов p‑GaSe〈РЗЭ〉 равна ~200 K (рис. 4).
Рис. 3.
Зависимости напряженности зажигания (1) и яркости ЭЛ (2) от содержания введенной примеси в монокристаллах p-GaSe〈РЗЭ〉: Т = 77 K, λ = 0.60 мкм.

Рис. 4.
Температурные зависимости яркости ЭЛ в монокристаллах p-GaSe〈РЗЭ〉: Е = 4Ез; i = 30 мA; λ = 0.60 мкм; N = 0 (1), 10–5 (2), 10–4 (3), 10–1 ат. % (4).

При достижении электрического напряжения, равного напряжению ЭП (U ≈ Uпер) [17, 18], помимо перехода образца в низкоомное состояние (рис. 5, кривые 1, 2), происходит скачкообразное тушение ЭЛ (рис. 5, кривые 3, 4). При этом до U ≈ Uпер, помимо ВАХ, идентичными являются также зависимости Вλ(U) для образцов с поперечными и продольными контактами. При U = Uпер яркость ЭЛ для них достигает своего максимального значения, а с момента начала ЭП ситуация резко меняется. В образцах с поперечными контактами (рис. 5, кривые 1, 3) за время τ ≤ 10–8 с образец переходит из высокоомного состояния в низкоомное, а Вλ с такой же скоростью падает до нуля. В образцах с продольными электрическими контактами в области ВАХ с отрицательным дифференциальным сопротивлением в течение процесса переключения (рис. 5, кривая 3) Вλ сначала плавно уменьшается на ~30–40% по сравнению со значением при U ≈ Uпер, а далее скачком падает до нуля – ЭЛ гаснет (рис. 5, кривая 4). В обоих случаях, пока образец находится в низкоомном состоянии, ЭЛ не наблюдается.
Рис. 5.
ВАХ (1, 2) и зависимости яркости ЭЛ от напряжения (3, 4) в монокристаллах p-GaSe〈РЗЭ〉 при бистабильном (1, 3) и пороговом (2, 4) ЭП: Т = 77 K, N = = 10–1 ат. %, λ = 0.60 мкм.
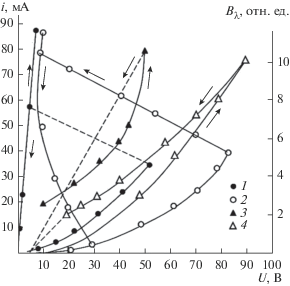
С ростом N напряженность электрического поля сначала (при N ≤ 10–4 ат. %) на ∼20–25% увеличивается по сравнению со значением в чистых кристаллах $E_{{{\text{п е р }}}}^{0},$ а далее (при 10–4 < N ≤ 10–1 ат. %) уменьшается и становится на ∼10–15% меньше, чем $E_{{{\text{п е р }}}}^{0}.$ Во всех образцах p-GaSe〈РЗЭ〉 с N ≈ ≈ 10–2–10–1 ат. % параметры и характеристики ЭП являются почти одинаковыми, стабильными и воспроизводимыми.
Степень стабильности параметров и характеристик ЭП и ЭЛ проверялась путем более чем 200-кратных испытаний одного и того же образца, а их воспроизводимость – сравнением результатов для 100 различных образцов p-GaSe〈РЗЭ〉 с N ≈ 10–1 ат. %.
Полученные результаты удовлетворительно объясняются на основе рекомбинации инжектированных неосновных носителей заряда (электронов) через r-центры рекомбинации [26] и резким уменьшением падения напряжения на исследуемом образце при ЭП [17].
Что же касается обнаруженного расхождения параметров и характеристик ЭЛ для разных образцов, их зависимости от предыстории исследуемого образца и содержания введенной примеси, то, скорее всего, это связано с наличием в p-GaSe случайных МД [19]. При легировании РЗЭ ионы введенной примеси, скапливаясь под действием внутреннего электрического поля на СД, увеличивают их размеры. Вследствие чего сначала (при N ≤ 10–4 ат. %) с ростом содержания РЗЭ пространственная неоднородность и, соответственно, влияние МД на инжекцию и генерационно-рекомбинационные процессы неравновесных носителей заряда усиливаются. Далее (при 10–4 < < N ≤ 10–1 ат. %) из-за “укрупнения” СД расстояния между соседними МД становятся сравнимы с длиной диффузии, а следовательно, и длиной свободного пробега носителей заряда. При этом МД “сплачиваются”, и, подобно сильнолегированным полупроводникам, монокристаллы p‑GaSe〈РЗЭ〉 постепенно приближаются к квазиупорядоченному состоянию [27].
Помимо этого, из-за роста доли ковалентной связи между размещенными в соседних слоях ионами РЗЭ усиливается также межслойная связь в кристалле. Оба эти процесса в свою очередь приводят к росту Вλ, а также повышению стабильности и воспроизводимости параметров и характеристик ЭЛ в p-GaSe〈РЗЭ〉. Независимость параметров и характеристик ЭЛ и ЭП от химической природы введенной примеси свидетельствует о том, что введенные при N ≤ 10–1 ат. % атомы РЗЭ, скапливаясь на СД, меняют лишь окружающую их область пространственного заряда (ОПЗ) и не создают примесные уровни. Поэтому влияние легирования РЗЭ на ЭЛ при таких содержаниях обусловлено изменением случайного электронного потенциала в исследуемом образце. В частности, при малых содержаниях введенной примеси ОПЗ соседних СД не перекрываются и случайный потенциал велик. При больших значениях N вследствие перекрытия ОПЗ соседних СД уменьшается и пространственная неоднородность структуры основной матрицы исследуемого образца [27]. В рамках этой модели внутрицентровые процессы, непосредственно связанные с электронной конфигурацией или химической природой примесного атома, а также с взаимодействием инжектированных носителей заряда с примесными центрами должны проявляться при более высоких содержаниях введенной примеси, что подтверждается и результатами [28].
Температурное тушение ЭЛ в исследуемом полупроводнике, очевидно, вызвано термическим опустошением r-центров, в результате чего уменьшается скорость рекомбинации и, соответственно, Вλ.
Тушение ЭЛ при ЭП объясняется резким уменьшением падения напряжения на образце и шнурованием тока, протекающего через него.
ЗАКЛЮЧЕНИЕ
В легированных Gd и (или) Dy с N ≤ 10–1 ат. % монокристаллах p-GaSe, так же как в чистых кристаллах этого полупроводника, в области Т ≤ 200 K наблюдаются ЭЛ и ЭП.
Возможность совмещения в одном образце p-GaSe〈РЗЭ〉 ЭП и ЭЛ позволяет создать на основе монокристаллов этого полупроводника переключатели и источники света с S-образной ВАХ с помощью простой технологии.
Параметры и характеристики ЭЛ, а также их стабильность и воспроизводимость в p-GaSe〈РЗЭ〉 при N ≤ 10–1 ат. % не зависят от химической природы РЗЭ и могут целенаправленно изменяться путем варьирования их количества.
Список литературы
Cullis A.G., Canham L.T., Calcott P.D.J. The Structural and Luminescence Properties of Porous Silicon // J. Appl. Phys. 1997. V.82. № 3. P. 909–965.
Bisi O., Ossicini S., Pavesi L. Porous Silicon: a Quantum Sponge Structure for Silicon Based Optoelectronics // Surf. Sci. Rep. 2000. V. 38. № 1–3. P. 1–126.
Koshida N., Matsumoto N. Fabrication and Quantum Properties of Nanostructured Silicon // Mater. Sci. Eng.: R: Reports. 2003. V. 40. № 5. P. 169–205.
Kanemitsu Y. Light Emission from Porous Silicon and Related Materials // Phys. Rep. 1995. V. 263. № 1. P. 1–91.
Евтух А.А., Каганович Э.Б., Манойлов Э.Г., Семененко Н.А. Механизм токопрохождения в электролюминесцентных структурах пористый кремний/монокристаллический кремний // ФТП. 2006. Т. 40. Вып. 2. С. 180–184.
Драпак С.И., Ковалюк З.Д. Эффект усиления фототока в гетероструктуре In2O3–GaSe // Письма ЖТФ. 2001. Т. 27. № 18. С. 1–7.
Manasson V.A., Kovalyuk Z.D., Drapak S.I., Katerinchuk V.N. Polarisation-Sensitive Photodiode for the 632.8 nm Spectral Region // Electron. Lett. 1990. V. 26. № 10. P. 664.
Драпак С.И., Ковалюк З.Д. Влияние буферного слоя собственного окисла селенида галлия нанометровых размеров на электрические, фотоэлектрические и излучательные свойства гетероструктур ITO-GaSe // ФТП. 2007. Т. 41. Bып. 3. С. 312–317.
Cote M., Cohen M.L., Chadi D.J. Theoretical Study of the Structural and Electronic Properties of GaSe Nanotubes // Phys. Rev. B. 1998. V. 58. № 8. P. R4277–R4280.
Gautam U.K., Vivekchand S.R.C., Govindaraj A., Kulkarni G.U., Selvi N.R., Rao C.N.R. Generation of Onions and Nanotubes of GaS and GaSe through Laser and Thermally Induced Exfoliation // J. Am. Chem. Soc. 2005. V. 127. № 11. P. 3658–3659.
Gautam U.K., Vivekchand S.R.C., Govindaraj A., Rao C.N.R. GaS and GaSe Nanowalls and Their Transformation to Ga2O3 and GaN Nanowalls // Chem. Commun. 2005. № 31. P. 3995–3997.
Balitskii O.A. Self-Organised Nanostructures, Obtained by Oxidation of III–VI Compounds // Mater. Lett. 2006. V. 60. № 5. P. 594–599.
Бахтинов А.П., Водопьянов В.Н., Слынько Е.И., Ковалюк З.Д., Литвин О.С. Самоорганизация наноструктур теллуридов свинца и олова на Ван-дер-Ваальсовой поверхности селенида галлия (0001) // Письма в ЖТФ. 2007. Т. 33. Bып. 2. С. 80–88.
Rybkovskiy D.V., Vorobyev I.V., Osadchy A.V., Obraztsova E.D. Ab Initio Electronic Band Structure Calculation of Two Dimensional Nanoparticles of Gallium Selenide // J. Nanoelectronics Optoelectronics. 2012. № 7. P. 65–67.
Rybkovskiy D.V., Osadchy A.V., Obraztsova E.D. Electronic Structure of GaSe Quantum Dots // J. Nanoelectronics Optoelectronics. 2013. № 8. P. 110–113.
Ахундов Г.А. Электролюминесценция монокристаллов GaSe // Оптика и спектроскопия. 1965. Т. 18. № 4. С. 743–745.
Ахундов Г.А., Абдинов А.Ш., Мехтиев Н.М., Кязым-заде А.Г. Об эффекте переключения в р-GаSе // ФТП. 1973. Т. 7. № 9. С. 1830–1833.
Ахундов Г.А., Абдинов А.Ш., Кязым-заде А.Г., Мехтиев Н.М. Электро-люминесцентный переключатель из слоистого полупроводника GаSе // ФТП. 1975. Т. 9. № 5. С. 980–982.
Шик А.Я. Фотопроводимость случайно-неоднородных полупроводников // ЖЭТФ. 1975. Т. 68. С. 1859–1867.
Абдинов А.Ш., Бабаева Р.Ф., Джафаров М.А., Рзаев Р.М., Рагимова Н.А. Влияние легирования диспрозием на фотоэлектрические свойства монокристаллов селенида галлия // Неорган. материалы. 1999. Т. 35. № 4. С. 410–412.
Абдинов А.Ш., Бабаева Р.Ф. К вопросу о механизме влияния легирования редкоземельными элементами на фотолюминесценцию монокристаллов соединений А3В6 со слоистой структурой // Прикладная физика. 2004. № 5. С. 75–78.
Свойства элементов / Под ред. Дрица М.Н. Справочное издание. М.: Металлургия, 1985. 672 с.
Угай Я.А. Общая и неорганическая химия. М.: Высш. школа, 1997. 527 с.
Хенней Н. Химия твердого тела. М.: Мир, 1971. 223 с.
Kokh A., Atuchin V.V., Gavrilova T.A., Kozhukhov A., Maximovskiy E.A., Pokrovsky L.D., Tsygankova A.R., Saprykin A.I. Defects in GaSe Grown by Bridgman Method // J. Microscopy. 2014. V. 256. № 3. P. 208–212.
Воробьев Л.Е., Данилов С.Н., Зегря Г.Г., Фирсов Д.А., Шалыгин В.А., Яссиевич И.И., Берегулин Н.В. Фотоэлектрические явления в полупроводниках и размерно-квантовых структурах. Санкт Петербург: Наука, 2001. 248 с.
Шкловский Б.И., Эфрос А.Л. Электронные свойства легированных полупроводников. М.: Наука, 1979. 416 с.
Hsu Yu-Kuei, Chang Chen-Shiung, Huang Wen-Chang. Electrical Properties of GaSe Doped with Er // J. Appl. Phys. 2004. V. 96. № 3. P. 1563–1567.
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы


