Неорганические материалы, 2022, T. 58, № 9, стр. 938-944
Механические напряжения в пленках SiNx при химическом осаждении из газовой фазы в плазме высокой плотности
Н. С. Ковальчук 1, С. А. Демидович 1, Л. А. Власукова 2, *, И. Н. Пархоменко 2, Ф. Ф. Комаров 2
1 ОАО “Интеграл”
220108 Минск, ул. Казинца, 121А, Беларусь
2 Белорусский государственный университет
220045 Минск, ул. Курчатова, 5, Беларусь
* E-mail: vlasukova@bsu.by
Поступила в редакцию 25.03.2022
После доработки 01.07.2022
Принята к публикации 06.07.2022
- EDN: XBDQWB
- DOI: 10.31857/S0002337X2209007X
Аннотация
Пленки SiNx с низкими механическими напряжениями синтезированы в реакторе индуктивно-связанной плазмы (ICP) из смеси SiH4 + N2 + Ar. Обогащенные азотом пленки SiNx со сжимающими напряжениями от –10 до –50 МПа получены при [SiH4]/[N2] от 0.55 до 1.0 и мощности ICP-источника в 600 Вт. Подъем мощности источника при прочих неизменных условиях осаждения приводит к возрастанию напряжений от –125 МПа при 300 Вт до –625 МПа при 800 Вт. Варьирование температуры осаждения от 25 до 350°С существенно не влияет на уровень напряжений и показатель преломления, а также на скорость роста SiNx. Оценен дрейф остаточных напряжений в течение трех недель после осаждения, а также содержание кислорода в пленках SiNx в зависимости от режима осаждения.
ВВЕДЕНИЕ
Развитие интегральных технологий ставит задачи по поиску новых составов и свойств материалов. Это актуально и для нитрида кремния – одного из наиболее востребованных диэлектриков в технологии интегральных микросхем (ИМС) и микроэлектромеханических систем (МЭМС). Для ряда применений существенное значение имеет уровень остаточных механических напряжений в нитридных пленках. Так, для диэлектрических мембран МЭМС необходимы пленки с напряжениями ниже 200 МПа [1]. Пассивация структуры AlGaN/GaN для мощных СВЧ-транзисторов пленкой нитрида кремния позволяет уменьшить ток утечки по поверхности AlGaN на несколько порядков [2]. Однако нанесение нитрида кремния может приводить к сдвигу C–V-характеристик композита AlGaN/GaN, что негативно влияет на управляющие свойства затворов транзисторов. По данным [3, 4], сдвиг C–V-характеристик обусловлен механическими напряжениями в нитридной пленке. Нитрид кремния, получаемый химическим осаждением из газовой фазы при пониженном давлении (LPCVD-метод), характеризуется напряжениями растяжения порядка нескольких ГПа [5]. Возможность снижения напряжений в LPCVD-пленках за счет обогащения кремнием или увеличения температуры осаждения продемонстрирована в [6, 7]. В пленках, полученных плазмохимическим осаждением, значения напряжений варьируют от –108 Па (сжимающие) до +108 Па (растягивающие) в зависимости от частоты и мощности плазменного разряда, температуры, состава газовой смеси и т.д. [8].
При получении нитрида кремния химическим осаждением из газовой фазы состав пленок зависит от условий осаждения и может существенно отличаться от стехиометрического Si3N4. Поэтому правильнее использовать формулу SiNx. К основным недостаткам плазмохимического SiNx, полученного стандартным методом емкостно-связанной плазмы, относят нестехиометричность состава (отклонение от стехиометрического соотношения Si : N = 0.75 до ∼1.2) и высокое содержание водорода. Водород в нитридной пленке применительно к технологиям ИМС и МЭМС является нежелательным компонентом [5]. Получение нитридных пленок, близких к стехиометрическому Si3N4 по соотношению Si : N и по содержанию водорода, но при существенно более низких температурах, возможно с использованием плазмы высокой плотности (ПВП), в которой достижимы концентрации активных частиц на 1–2 порядка выше в сравнении с обычными реакторами емкостно-связанной плазмы. Высокая скорость диссоциации позволяет использовать в качестве прекурсора для осаждения SiNx азот вместо аммиака, что снижает концентрацию водорода в растущей пленке. Для создания ПВП используются реакторы электронно-циклотронного резонанса и реакторы с индуктивно-связанной плазмой. В работах [2–4] качественные пленки нитрида кремния для пассивации структур AlGaN/GaN осаждались при активации индуктивно-связанной плазмой. Как отмечено выше, напряжения в таких пленках существенно влияют на характеристики СВЧ-транзисторов на основе этих гетероструктур. В свете вышеизложенного актуальным является установление зависимости между параметрами процесса осаждения SiNx и механическими напряжениями, а также оценка возможности их регулирования.
Целью данной работы было исследование уровня механических напряжений в пленках SiNx, полученных из смеси SiH4 + N2, в зависимости от состава газовой смеси, мощности источника плазмы, температуры осаждения.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Пленки SiNx осаждались методом химического вакуумного осаждения в ICP-реакторе на установке STE ICP200D (SemiTEq, Санкт-Петербург). Пластины кремния КДБ-10 диаметром 100 мм обрабатывались в смесях КАРО и ПАР-5, а перед осаждением дополнительно очищались в реакторе в аргоне при мощности ICP-источника 300 Вт в течение 120 с. Давление в камере поддерживалось на уровне 2.5 Па. Поток моносилана (100%) варьировался в пределах 7.5–9.0 станд. см3/мин (sccm), поток азота – в пределах 4.5–14.5 станд. см3/мин. В качестве газа-носителя использовался аргон, поток которого регулировался в пределах 75–195 станд. см3/мин, или смесь Ar + He. Рабочая мощность ICP-электрода изменялась в диапазоне 300–800 Вт при частоте 13.56 МГц, температура подложкодержателя варьировалась от 25 до 350°С.
Контролировались толщина пленки, механические напряжения и показатель преломления. Толщина измерялась на оптическом тонкопленочном рефлектометре FTR, механические напряжения оценивались на хроматическом датчике белого света CWL. Измерялся радиус кривизны пластины до и после осаждения нитрида кремния. Для расчета напряжений (σ) использована формула Стоуни [9]
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
При варьировании температуры осаждения от 25 до 350°С остаточные напряжения и показатель преломления пленок изменялись незначительно. Скорость осаждения пленок при варьировании состава газовой смеси и температуры осаждения также изменялась незначительно (в пределах от 23 до 26 нм/мин). При плазменной активации температура осаждения пленок не превышает 400°С и реакции термораспада исходных реагентов не протекают. Поэтому скорость роста и свойства пленок практически не зависят от температуры осаждения, что согласуется с нашими результатами. В то же время уровень мощности ВЧ-генератора плазмы сильно влияет на скорость осаждения и свойства получаемых пленок. В данной работе исходными реагентами для осаждения SiNx являются SiH4 и N2. Термораспад моносилана начинается при температуре 450°С. Заметной термической диссоциации молекулы азота с образованием химически активного атомарного азота не наблюдается вплоть до 3000°С [10]. Активация разложения моносилана легко достижима в обычных генераторах емкостно-связанной плазмы. Для разложения молекулярного азота с образованием атомарного азота в количествах, достаточных для реализации технологически приемлемых скоростей роста нитридных пленок, необходимо использование ПВП.
На рис. 2 и 3 представлены зависимости σ и n SiNx от состава газовой смеси и мощности ICP-источника. Измерения проводились для пленок толщиной 100–120 нм, осажденных при 300°С. Все сформированные пленки характеризуются отрицательными (сжимающими) механическими напряжениями. Зависимость σ и n от соотношения расходов моносилана и азота (R) показана на рис. 2а. Как видно, R существенно влияет как на остаточные напряжения, так и на показатель преломления. При малых R – от 0.55 до 1.0 (дефицит моносилана в газовой смеси) – напряжения минимальны и варьируют от –10 до –50 МПа.
Рис. 2.
Зависимости остаточных механических напряжений и показателя преломления от отношения расходов реагирующих газов R = [SiH4]/[N2] при расходе аргона 155 станд. см3/мин (а) и от расхода аргона при R = 1.55 (б) (осаждение SiNx проводилось при мощности ICP-источника 600 Вт).
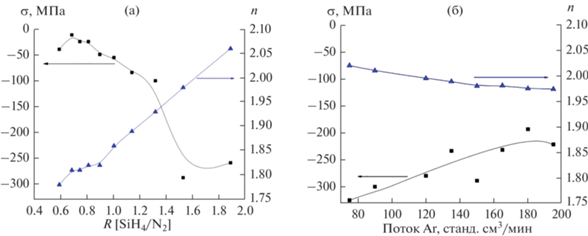
Рис. 3.
Зависимости остаточных механических напряжений и коэффициента преломления (а), скорости осаждения SiNx (б) от мощности ICP-источника (R поддерживалось равным 1.55, расход аргона составлял 155 станд. см3/мин).

С ростом содержания моносилана в газовой смеси возрастают и напряжения, достигая значений ‒250…–300 МПа при R = 1.5–1.9. Показатель преломления также увеличивается: от 1.78 при R = 0.55 до ~2.07 при R = 1.9. Значения n от 2.0 до 2.05, соответствующие стехиометрическому составу Si3N4, достигаются при R = 1.6—1.8. Уменьшение σ и n с ростом содержания азота в газовой смеси наблюдалось также в работах [3, 11], в которых изучался процесс формирования SiNx из смеси SiH4 + N2 в ICP-реакторе. Это можно связать с ростом потока активных радикалов азота, поступающих на поверхность подложки, что приводит к формированию более “рыхлой” пленки с повышенным содержанием азота и, соответственно, к снижению показателя преломления. Как видно из рис. 2б, изменение расхода аргона также влияет на уровень напряжений и показатель преломления нитрида, но в меньшей степени в сравнении с соотношением [SiH4]/[N2]. С ростом потока аргона наблюдается тенденция к снижению напряжений. Так, при [Ar] = 80 станд. см3/мин σ максимально и составляет –350 МПа. Минимальное σ (–175 МПа) наблюдается при [Ar] = 180 станд. см3/мин. Показатель преломления с увеличением расхода аргона также снижается, но незначительно (от 2.02 при расходе 80 станд. см3/мин до 1.97 при расходе 200 станд. см3/мин).
На рис. 3а представлены зависимости σ и n от мощности ICP-источника. Подъем мощности от 300 до 800 Вт приводит к пятикратному увеличению сжимающих напряжений. Сначала происходит плавное возрастание σ от –125 МПа при 300 Вт до –275 МПа при 600 Вт. При дальнейшем повышении мощности σ растет быстрее и достигает максимального значения –625 МПа при мощности 800 Вт. Для показателя преломления характерна обратная тенденция: снижение n с ростом мощности источника. При минимальном значении мощности значение n максимально и составляет 2.12. Возрастание мощности до 400 Вт приводит к снижению n до 2.02. При дальнейшем возрастании мощности n продолжает снижаться и достигает минимального значения 1.96 при 800 Вт. Скорость осаждения пленки также заметно снижается при увеличении мощности ICP-источника. Возрастание остаточных напряжений и снижение скорости роста нитридной пленки с ростом мощности ICP-источника наблюдались также в [12]. Наблюдаемые эффекты можно связать с распылением поверхности растущей пленки ионами [12, 13]. С повышением мощности источника возрастает энергия бомбардирующих ионов аргона и азота, что повышает уровень радиационных повреждений в растущей пленке и усиливает распыление нейтральных активных радикалов Si и N с поверхности. Это в свою очередь приводит к возрастанию уровня напряжений и снижению скорости осаждения. О снижении показателя преломления и соотношения Si : N в нитридной пленке при возрастании ICP-мощности сообщалось в [14]. Это объяснялось особенностями конструкции ICP-реакторов, в которых зона осаждения отделена от зоны генерации плазмы для минимизации повреждений растущей пленки от бомбардировки ионами. Моносилан подают из кольцевого источника, расположенного вблизи подложки, тогда как азот и аргон поступают сверху. В результате молекулы азота диссоциируют в объеме камеры непосредственно под действием плазмы высокой плотности. Моносилан же разлагается под воздействием активных радикалов и ионов азота. При постоянном [SiH4]/[N2] рост мощности источника приводит к бóльшей концентрации активных радикалов азота и к обогащению нитридной пленки азотом.
На рис. 4 показано изменение σ и n при варьировании соотношения [Ar]/[He] в газовой смеси и толщины осажденной пленки. Введение гелия в газовую смесь позволяет снизить уровень напряжений в нитридной пленке от –375 МПа (в отсутствие гелия) до –200 МПа при [Ar]/[He] = 1/10. Изменения n при варьировании [Ar]/[He] незначительны. Возрастание толщины пленки приводит к снижению σ от –300 МПа при толщине 100 нм до –100 МПа при 600 нм, что можно приписать частичной релаксации напряжений за счет гибкости аморфной сетки Si3N4.
Рис. 4.
Зависимости остаточных механических напряжений и коэффициента преломления от соотношения [Ar]/[He] (а) и толщины пленки SiNx (б) (R поддерживалось равным 1.55 при мощности ICP-источника 600 Вт).
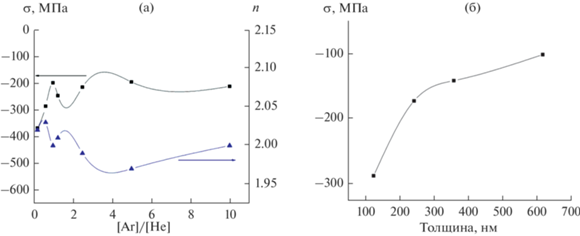
Для оценки темпорального дрейфа остаточных напряжений в течение трех недель после осаждения проводились измерения σ для двух групп образцов с различным уровнем остаточных напряжений в нитридных пленках (режимы осаждения пленок приведены в табл. 1). В промежутках между измерениями образцы хранились на воздухе при комнатной температуре. Изменения σ со временем для двух групп образцов показаны на рис. 5. Как видно, остаточные напряжения могут заметно возрастать со временем для пленок с изначально низким уровнем остаточных напряжений. Так, для пленок, полученных в режимах 2, 3, 4, 6, наблюдается дрейф напряжений до –40 МПа в первые 5–7 дней хранения. Для пленок, полученных в режимах 1 и 5 (при давлении в камере 3.5 и 2.5 МПа соответственно), темпоральные изменения незначительны. Пленки с изначально высокими остаточными напряжениями, полученные при высоком давлении в камере и/или высокой мощности ICP-источника (режимы 7, 8), не проявляют заметного дрейфа σ после трех недель хранения. Предположительно, дрейф напряжений связан с проникновением влаги и кислорода из воздуха с последующим окислением SiNx до некого предела насыщения. Изменений показателя преломления SiNx при хранении не выявлено.
Таблица 1.
Режимы осаждения пленок SiNx, для которых проводились повторные измерения остаточных напряжений
| Режим | Давление в камере, Па | Мощность ICP, Вт |
Толщина пленки, нм |
|---|---|---|---|
| 1 | 3.5 | 600 | 249 |
| 2 | 2.0 | 700 | 397 |
| 3 | 2.5 | 700 | 238 |
| 4 | 1.5 | 800 | 393 |
| 5 | 2.5 | 800 | 231 |
| 6 | 3.5 | 800 | 230 |
| 7 | 1.5 | 1000 | 227 |
| 8 | 3.5 | 1000 | 214 |
Рис. 5.
Темпоральные изменения остаточных механических напряжений для пленок, полученных в различных режимах (номера кривых соответствуют номерам режимов из табл. 1).
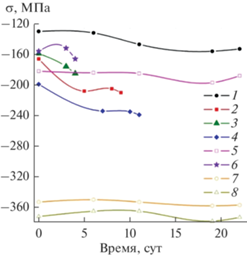
Кроме стехиометрического соотношения Si : N, важно оценить содержание в нитридной пленке примеси кислорода, который влияет на такие характеристики нитрида, как показатель преломления, устойчивость к фтористоводородной кислоте и др. [5, 11]. В табл. 2 представлены данные по содержанию кислорода в нитридных пленках, полученных в различных режимах. Измерения проводились через сутки после осаждения. Как видно, при увеличении рабочего давления и/или мощности ICP содержание кислорода в нитриде снижается. Повышение температуры подложки на уровень кислорода не влияет. Пленки с изначально высокими напряжениями, полученные в режиме 4 (режим идентичен режиму 7 из табл. 1), отличаются минимальным содержанием кислорода.
Таблица 2.
Содержание кислорода в пленках SiNx, осажденных в различных режимах
| Режим | Давление в камере, Па | Мощность ICP, Вт |
Температура осаждения, °С |
Содержание кислорода, ат. % |
|---|---|---|---|---|
| 1 | 1.5 | 700 | 150 | 4.32 |
| 2 | 1.5 | 700 | 250 | 4.19 |
| 3 | 2.5 | 700 | 150 | 2.24 |
| 4 | 1.5 | 1000 | 150 | 1.88 |
Примечание. [SiH4], [N2], [Ar], [He] – такие же, как в табл. 1.
ЗАКЛЮЧЕНИЕ
Пленки нитрида кремния с низкими сжимающими механическими напряжениями синтезированы в ICP-реакторе из смесей SiH4 + N2 + Ar и SiH4 + N2 + Ar + He. Исследованы зависимости механических напряжений и показателя преломления в SiNx от состава газовой смеси, мощности ICP-источника и температуры. Факторами, определяющими уровень напряжений и состав нитридных пленок (опосредованно оцениваемый через показатель преломления), являются соотношение R = [SiH4]/[N2] и мощность ICP-источника. При R от 0.55 до 1.0 (дефицит моносилана в газовой смеси) напряжения минимальны и варьируют от –10 до –50 МПа. При этом показатель преломления составляет 1.78–1.86, что свидетельствуют об обогащении нитрида азотом. Возрастание R приводит к повышению уровня остаточных напряжений и обогащению нитрида кремнием. Значения n от 2.0 до 2.05, соответствующие стехиометрическому составу Si3N4, достигаются при R = 1.6–1.8 и мощности ICP-источника в 600 Вт.
Подъем мощности ICP-источника от 300 до 800 Вт при прочих неизменных условиях осаждения приводит к пятикратному увеличению уровня напряжений (от –125 МПа при 300 Вт до –625 МПа при 800 Вт). Для показателя преломления характерна обратная тенденция – снижение n с ростом мощности источника. Увеличение мощности ICP-источника приводит также к заметному снижению скорости роста SiNx. Варьирование температуры осаждения от 25 до 350°С существенно не влияет на σ и n полученных пленок, а также на скорость роста нитрида.
Показано, что для пленок SiNx с низким уровнем напряжений может наблюдаться дрейф σ до –40 МПа в первые 5–7 дней хранения. Пленки с высокими σ, полученные при высоком давлении в камере и/или высокой мощности ICP-источника, не проявляют заметного дрейфа напряжений после трех недель хранения. Такие пленки характеризуются также самым низким содержанием кислорода.
Список литературы
Zheng B., Zhou C., Wang Q. et al. Deposition of Low Stress Silicon Nitride Thin Film and Its Application in Surface Micromachining Device Structures // Adv. Mater. Sci. Eng. 2013. V. 2013. ID 835942 (4 pp). https://doi.org/10.1155/2013/835942
Cho S.-J., Li X., Guiney I. et al. Impact of Stress in ICP-CVD SiNx Passivation Films on the Leakage Current in AlGaN/GaN HEMTs // Electron. Lett. 2018. V. 54. P. 947–949. https://doi.org/10.1049/el.2018.1097
Сейдман Л.А., Концевой Ю.А., Енишерлова К.Л, Миннебаев С.В. Пленки SiNx, полученные методом PECVD, в качестве пассивации AlGaN/GaN HEMT // Электронная техника. Сер. 2. 2020. Вып. 3 (258). С. 22–33. https://doi.org/10.36815/2073-8250-2020-258-3-22-33
Енишерлова К.Л., Сейдман Л.А., Темпер Э.М., Концевой Ю.А. Влияние особенностей PECVD процессов осаждения SiNx на электрические параметры структур SiNx/AlGaN/GaN // Изв. вузов. Материалы электронной техники. 2021. Т. 24. № 2. https://doi.org/10.17073/1609-3577-2021-2-00-00
Васильев В.Ю. Технология получения тонких пленок нитрида кремния для микроэлектроники и микросистемной техники. Ч. 1. Термически активированные процессы в проточных реакторах // Нано- и микросистемная техника. 2018. Т. 20. С. 287–292. https://doi.org/10.17587/nmst.20.287-296
Temple-Boyer P., Rossi C., Saint-Etienne E. et al. Residual Stress in Low Pressure Chemical Vapor Deposition SiNx Films Deposited from Silane and Ammonia // J. Vac. Sci. Technol. A. 1998. V. 16. P. 2003–2007. https://doi.org/10.1116/1.581302
Ковальчук Н.С. Пленки нитрида кремния с низкими механическими напряжениями для микроэлектромеханических систем // Докл. БГУИР. 2008. № 4. С. 60–65.
Claasen W.A.P. Ion Bombardment-Induced Mechanical Stress in Plasma-Enhanced Deposited Silicon Nitride and Oxynitride Films // Plasma Chem. Plasma Process. 1987. V. 7. P. 109–124.
Townsend P.H., Barnett D.M., Brunner T.A. Elastic Relationships in Layered Composite Media with Approximation for the Case of Thin Films on a Thick Substrate // J. Appl. Phys. 1987. V. 62. P. 4438–4444. https://doi.org/10.1116/1.581302
Некрасов Б.В. Основы общей химии. Т. 1. М: Химия, 1974. С. 388, 604.
Dergez D., Bittner A., Schalko J., Schmid U. Low-Stress and Long-Term Stable a-SiNx:H Films Deposited by ICP-PECVD // Procedia Eng. 2014. V. 87. P. 100–103. https://doi.org/10.1016/j.proeng.2014.11.392
Kshirsagar A., Nyaupanea P., Bodas D. et al. Deposition and Characterization of Low Temperature Silicon Nitride Films Deposited by Inductively Coupled Plasma CVD // Appl. Surf. Sci. 2011. V.257. P. 5052–5058. https://doi.org/10.1016/j.apsusc.2011.01.20
Besland M.-P., Lapeyrade M., Delmotte F., Hollinger G. Interpretation of Stress Variation in Silicon Nitride Films Deposited by Electron Cyclotron Resonance Plasma // J. Vac. Sci. Technol. A. 2004. V. 22 (5). P.1962–1970. https://doi.org/10.1116/1.1776179. hal-00880990
Han S.-S., Jun B.-H., No K., Bae B.-S. Preparation of a-SiNx Thin Film with Low Hydrogen Content by Inductively Coupled Plasma Enhanced Chemical Vapor Deposition // J. Electrochem. Soc. 1998. V. 145. P. 652–658.
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы



