Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 1, стр. 38-44
Наблюдение квантоворазмерных эффектов при исследовании резистивного переключения в диэлектрических пленках с наночастицами Au методом туннельной атомно-силовой микроскопииД. О. Филатов, И. А. Казанцева, Д. А. Антонов,
Д. О. Филатов 1, *, И. А. Казанцева 1, Д. А. Антонов 1,
И. Н. Антонов 1, М. Е. Шенина 1, О. Н. Горшков 1
1 Нижегородский государственный университет им. Н.И. Лобачевского,
603950 Нижний, Новгород,, Россия
* E-mail: dmitry_filatov@inbox.ru
Поступила в редакцию 07.04.2018
После доработки 22.04.2018
Принята к публикации 17.04.2018
Аннотация
Методом туннельной атомно-силовой микроскопии исследовано резистивное переключение
в тонких (5–10 нм) пленках ZrO2(Y) с наночастицами золота. На вольт-амперных характеристиках индивидуальных филаментов,
сформированных под действием потенциала зонда, наблюдались участки отрицательного
дифференциального сопротивления, связанные c резонансным туннелированием электронов
через размерно-квантованные электронные состояния c дискретным энергетическим спектром
в наночастицах золота, встроенных в филаменты.
Ключевые слова: мемристор, резистивное переключение, туннельная атомно-силовая микроскопия, металлические наночастицы, размерное квантование.
ВВЕДЕНИЕ
В настоящее время ведутся интенсивные исследования эффекта резистивного переключения
в тонких пленках диэлектриков, направленные на создание элементов энергонезависимой
памяти нового поколения (так называемой резистивной памяти) [1]. Эффект резистивного переключения заключается в обратимом бистабильном (или мультистабильном)
изменении сопротивления тонких (толщиной 10–50 нм) диэлектрических пленок, заключенных
между двумя металлическими электродами (структуры металл–диэлектрик–металл – МДМ)
или в составе структур металл–диэлектрик–полупроводник (МДП) под действием внешнего
электрического напряжения [2]. В настоящее время считается, что механизм резистивного переключения в оксидных
материалах заключается в образовании и разрушении в слое диэлектрика проводящих шнуров
(филаментов) из вакансий кислорода (VO), замыкающих электроды МДМ-структур (МДП-структур) под действием электрического поля
между электродами [3].
В последнее время для исследования резистивного переключения в тонких диэлектрических
пленках на проводящих подожках все шире применяется метод туннельной атомно-силовой
микроскопии (АСМ) [4, 5]. Типичные размеры области контакта зонда АСМ с поверхностью диэлектрика (менее 10
нм) по порядку величины соответствуют ожидаемым размерам ячеек в перспективных устройствах
резистивной памяти [6]. Таким образом, контакт проводящего зонда АСМ с диэлектрической пленкой на проводящей
подложке является модельной системой (виртуальным устройством), позволяющей изучать
процессы резистивного переключения в областях нанометрового масштаба.
В [7] методом туннельной АСМ исследовано резистивное переключение в сверхтонких (3–6 нм)
пленках ZrO2(Y)/Si. На вольт-амперных характеристиках (ВАХ) контакта зонда АСМ с индивидуальными
филаментами в слое ZrO2(Y) были обнаружены участки отрицательного дифференциального сопротивления, связанные
с резонансным туннелированием электронов через наноразмерные образования с дискретным
энергетическим спектром (изолированные VO, кластеры VO), встроенные в филаменты. В настоящей работе методом туннельной АСМ исследовано резистивное
переключение в тонких пленках ZrO2(Y) с наночастицами Au, встроенными в них, с целью улучшения параметров переключения.
Известно, что наночастицы металла являются концентраторами электрического поля в диэлектрических
пленках, что инициирует зарождение филаментов вблизи наночастиц [8]. В настоящей работе наочастицы Au играли роль искусственных нанообъектов с дискретным
энергетическим спектром (квантовых точек), встроенных в филаменты. Целью работы было
изучение эффекта резонансного туннелирования электронов через наночастицы Au в ходе
резистивного переключения.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Пленки ZrO2(Y) толщиной 5–10 нм с однослойными массивами наночастиц Au на подложках n+-Si(001) формировали методом послойного магнетронного осаждения с последующим отжигом
[9]. На поверхность подложек n+-Si(001), покрытых слоем естественного оксида SiO2 толщиной ~3 нм, методом высокочастотного магнетронного распыления спеченных порошковых
мишеней ZrO2–Y2O3 (молярная доля Y2O3 составляла ~0.12) при температуре подожки Tg ≈ 300°C осаждали подслои ZrO2(Y) толщиной 1–2 нм. На них методом магнетронного распыления на постоянном токе при
Tg ≈ 200°C осаждали островковые пленки Au номинальной толщиной ~1 нм. Сверху наносили
покровные слои ZrO2(Y) толщиной 2–8 нм в тех же условиях, что и подслои ZrO2(Y). Полученные таким образом сэндвич–структуры отжигали в атмосфере Ar при температуре
450°С в течение 1 ч. Ранее [10, 11] исследования методом просвечивающей электронной микроскопии поперечных срезов показали,
что в процессе отжига в указанных условиях пленки Au коагулируют в наночастицы диаметром
D = 2–3 нм, расположенные практически в одной плоскости на заданных расстояниях от
подожки и поверхности пленки, которые определяются толщиной нижнего и покровного слоев
ZrO2(Y).
Исследования резистивного переключения методом туннельной АСМ проводили в сверхвысоком
вакууме при 300 К в контактной моде при помощи АСМ Omicron UHVAFM/STM LF1 в составе
комплекса Omicron MultiProbe RM. Давление остаточных газов в камере АСМ/CТМ составляло
~10–10 Торр. Использовали зонды производства компании NT MDT марки NSG-11 DCP с радиусом
кривизны острия Rp ≈ 70 нм (согласно паспортным данным). Исследование резистивного переключения проводили
путем записи циклических ВАХ контакта зонд–образец при линейной развертке напряжения
Vg между зондом АСМ и подложкой n+-Si от Vmin (Vmin < VRESET, где VRESET – напряжение переключения из состояния с низким сопротивлением в состояние с высоким
сопротивлением) до Vmax (Vmax > VSET, где VSET – напряжение переключения из состояния с высоким сопротивлением в состояние с низким
сопротивлением) и обратно, от Vmax до Vmin, и так далее. Предварительно формировали филаменты (форминг) путем однократного или
многократного сканирования выбранного участка поверхности образца при Vg = Vform, где Vform > VSET – напряжение форминга. Результаты форминга контролировали путем измерения токовых
изображений поверхности модифицированного участка It(x, y), где It – сила тока через зонд АСМ, x, y – координаты зонда в плоскости поверхности при |Vg| < |VSET|, |VRESET|.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На рис. 1 приведено токовое изображение It(x, y) поверхности пленки ZrO2(Y) с наночастицами Au, измеренное при Vg = –4 В. Предварительно был проведен форминг данного участка поверхности путем трехкратного
сканирования при Vg = = –6 В. Участки с повышенными значениями It (токовые каналы) на рис. 1 связаны с протеканием электрического тока через филаменты в пленке ZrO2(Y), возникшие в ходе предварительного форминга. Латеральные размеры токовых каналов
по порядку величины соответствуют радиусу кривизны Rp острия используемых АСМ-зондов. Как показано в [12], размеры токовых изображений дефектов в диэлектрических пленках, полученных методом
туннельной АСМ, определяются размерами области контакта острия АСМ-зонда с поверхностью
пленки и не зависят от размера самих дефектов.
Рис. 1.
Токовое изображение (Vg = –4 В) участка поверхности пленки ZrO2(Y) с наночастицами Au на подложке n+-Si после форминга трехкратным сканированием при Vg = –6 В.
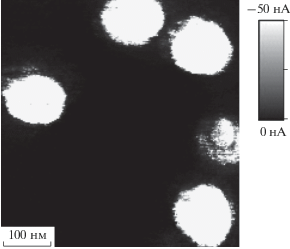
На рис. 2 показана ВАХ контакта АСМ-зонда с филаментом в пленке ZrO2(Y) с наночастицами Au. Наряду с гистерезисом, обусловленным резистивным переключением
в пленке ZrO2(Y), на ВАХ наблюдаются участки отрицательного дифференциального сопротивления, связанные
с туннелированием электронов между АСМ-зондом и подложкой n+-Si через размерно-квантованные состояния в наночастицу Au размером 2–3 нм, встроенную
в филамент (рис. 3). Как уже упоминалось выше, наночастицы Au, являющиеся концентраторами электрического
поля в диэлектрической пленке, инициируют формирование филаментов [8]. Поэтому высока вероятность того, что филаменты, сформированные в пленке ZrO2(Y) c наночастицами Au в ходе предварительного форминга, будут проходить через наночастицы
Au.
Рис. 2.
Циклическая ВАХ контакта АСМ-зонда с филаментом в пленке ZrO2(Y) с наночастицвми Au на подложке n+-Si.
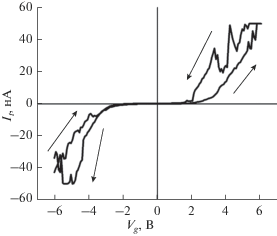
На рис. 4 приведена модельная зонная диаграмма (300 К) контакта филамента в пленке ZrO2(Y) с наночастицей Au, встроенной вблизи границы с подложкой n+-Si, покрытой слоем естественного оксида SiO2 толщиной ~3 нм, при Vg = –5 В. Данный контакт представляет собой асимметричную двухбарьерную структуру,
подобную структуре резонансно-туннельного диода [13]. В этой структуре край филамента, ближайший к наночастице Au, играет роль эмиттера.
Роль первого туннельно-прозрачного потенциального барьера играет прослойка ZrO2(Y) между краем филамента и наночастицей Au, а второго – слой естественного оксида
SiO2 на поверхности подложки n+-Si. Ранее в [14] было показано, что проводимость филаментов в HfO2 носит металлический характер (в частности, проводимость филамента уменьшается с ростом
температуры) и близка по величине к проводимости металлического Hf. Поэтому при расчете
зонной диаграммы структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si полагали, что филамент состоит из металлического Zr и эквипотенциальный в области
от контакта АСМ-зонда с поверхностью ZrO2(Y) до края филамента, т.е. падение напряжения на филаменте мало по сравнению с падением
напряжения на остальной части слоя ZrO2(Y). Толщина d1 туннельно-прозрачного барьера ZrO2(Y) между краем филамента и наночастицей Au была параметром модели. Переключение из
состояния с высоким сопротивлением в низкоомное состояние соответствовало уменьшению
d1 до ~0.5 нм, обратное переключение – увеличению d1.
Рис. 4.
Расчетная зонная диаграмма двухбарьерной структуры Zr/ZrO2(Y)(1 нм)/Au(2 нм)/SiO2(3 нм)/n+-Si. Vg = –5 В.

При построении зонной диаграммы двухбарьерной структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si учитывали падение части Vg на области пространственного заряда вблизи границы раздела SiO2–n+-Si. Уравнение баланса энергии для рассматриваемой структуры может быть записано в
виде:
(1)
$\begin{gathered} \Delta {{E}_{Z}}--e{{F}_{1}}{{d}_{1}} + \Delta {{E}_{{c1}}}--e{{F}_{2}}{{d}_{2}}-- \\ - \,\,\Delta {{E}_{c}}--\Delta {{\varphi }_{s}}--\Delta + e{{V}_{g}} = 0, \\ \end{gathered} $где ΔEZ – разность значений энергии между уровнем Ферми в Zr EFZr и дном зоны проводимости в ZrO2(Y) (рис. 4); ΔEc1 – разность между значениями энергии дна зоны проводимости в ZrO2(Y) и SiO2; ΔEc – разрыв зоны проводимости на границе Si–SiO2; F1 и F2 – напряженность электрического поля в ZrO2(Y) и в SiO2 соответственно (ε1F1 = ε2F2, ε1 и ε2 – диэлектрические проницаемости ZrO2(Y) и SiO2 соответственно); d2 – толщина слоя SiO2; Δ = Eс – EF, Eс и EF – энергия дна зоны проводимости и уровень Ферми в квазинейтральной области n+-Si; e – заряд электрона; Δφs – высота потенциального барьера области пространственного заряда на границе Si–SiO2. Ее рассчитывали на основании решения уравнения Пуассона для барьера диэлектрик–полупроводник
в приближении полного обеднения области пространственного заряда подвижными носителями
заряда. Пренебрегая влиянием заряда на поверхностных состояниях на границе полупроводник–диэлектрик,
граничное условие для электрического поля на границе Si–SiO2 можно записать в виде:
где FSi и εSi – напряженность электрического поля и диэлектрическая проницаемость Si соответственно.
Отсюда
(2)
$\Delta {{\varphi }_{s}} = \frac{{{{\varepsilon }_{0}}\varepsilon _{2}^{2}F_{2}^{2}}}{{2e{{\varepsilon }_{{{\text{Si}}}}}{{N}_{{\text{d}}}}}},$где Nd — концентрация доноров в n+-Si. С учетом (2) уравнение (1) сводится к квадратному алгебраическому уравнению относительно F2. Как видно из рис. 4, значительная часть Vg падает в области пространственного заряда вблизи границы Si–SiO2.
На рис. 5 приведен расчетный энергетический спектр туннельной прозрачности T(E) двухбарьерной структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si при Vg = –5 В. Обычно при моделировании резонансно-туннельных явлений для расчета спектра
туннельной прозрачности двух- или многобарьерных структур используют метод трансфер-матриц
[15]. Данный подход применим при условии малых напряжений V $ \ll $ Eb/e, где Eb – характерная высота потенциальных барьеров в структуре, V – падение напряжения на них. Однако он не применим для объектов, исследованных в
настоящей работе, поскольку в них туннелирование происходило в режиме сильного поля:
V ~ Eb/e. Поэтому в настоящей работе T(Е) рассчитывали на основе решения одномерного уравнения Шредингера в приближении эффективной
массы [16]. Наночастицы Au считали квазинейтральными, эффектом кулоновской блокады туннелирования
через наночастицы Au пренебрегали. Ранее подобный подход применялся для расчета спектров
туннельной прозрачности пленок SiO2/Si c внедренными наночастицами Au [17, 18].
Рис. 5.
Расчетный спектр туннельной прозрачности двухбарьерной структуры Zr/ZrO2(Y)(1 нм)/Au(2 нм)/ SiO2(3 нм)/n+-Si. Vg = –5 В.
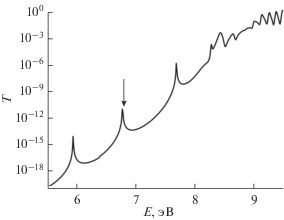
Решение уравнения Шредингера в слоях ZrO2(Y) и SiO2 выбирали в виде:
где χ(z) – огибающая волновой функции электрона; Ai и Bi – функции Эйри 1-го и 2-го рода соответственно;
(4)
$s\left( z \right) = \frac{{{{{\left( {2m} \right)}}^{{{1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}}}}{{{{{\left( {e\hbar F} \right)}}^{{{2 \mathord{\left/ {\vphantom {2 3}} \right. \kern-0em} 3}}}}}}\left[ {eF\left( {z - {{z}_{0}}} \right) - E} \right]{\text{;}}$m и F – эффективная масса электрона и напряженность электрического поля в диэлектрике;
E – энергия электрона, отсчитываемая от дна зоны проводимости в слое Zr; z0 – координата точки, в которой энергия дна зоны проводимости в слое диэлектрика Ec(z) = E; C1, C2 – нормировочные константы. Данное решение является точным и справедливо при любых
значениях F (в том числе в режиме автоэлектронной эмиссии через треугольный барьер) и при любых
E (в том числе, при надбарьерном туннелировании). В слоях Zr, Au и Si решения уравнения
Шредингера выбирали в виде:
(5)
${{\chi }_{{{\text{Zr}}}}}(z) = {\text{exp}}(i{{k}_{{{\text{Zr}}}}}z) + {{C}_{0}}{\text{exp}}(--i{{k}_{{{\text{Zr}}}}}z),$
(6)
${{\chi }_{{{\text{Au}}}}}(z) = {{C}_{{1{\text{Au}}}}}{\text{exp}}(i{{k}_{{{\text{Au}}}}}z) + {{C}_{{2{\text{Au}}}}}{\text{exp}}(--i{{k}_{{{\text{Au}}}}}z),$
соответственно, где kZr, kAu и kSi – квазиволновые векторы электрона с энергией Е в Zr, Au и Si соответственно. Для такого выбора нормировочных констант [16]
(8)
$T(E) = \frac{{{{m}_{e}}{{k}_{c}}(E)}}{{{{m}_{c}}{{k}_{e}}(E)}}{{\left| {{{C}_{c}}(E)} \right|}^{2}},$где me и mc – значения эффективной массы электрона в Zr и в Si соответственно. Значения нормировочных
констант С для заданных Е и Vg вычисляли путем численного решения методом Гаусса системы линейных алгебраических
уравнений, возникающей из условий Бастарда на границах между слоями структуры:
(9)
$\begin{gathered} {{\chi }_{1}}(z) = {{\chi }_{2}}(z), \\ {{m}_{2}}\frac{{\partial {{\chi }_{1}}}}{{\partial z}} = {{m}_{1}}\frac{{\partial {{\chi }_{2}}}}{{\partial z}}, \\ \end{gathered} $где χ1 и χ2 – огибающие волновых функций, а m1 и m2 – эффективные массы электронов в граничащих слоях. При расчетах эффективную массу
электронов вблизи уровня Ферми в Zr и Au принимали равной массе свободного электрона
m0, значения остальных параметров материалов слоев исследуемой структуры, использовавшихся
в расчетах, приведены в табл. 1.
Таблица 1.
Параметры слоев структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si, использованные в расчетах модельных ВАХ
Обозначение
Единица измерения
Величина
Значение
Источник
Nd
см–3
Концентрация доноров в n+-Si
2 × 1019
[19]
Nc
»
Эффективная плотность состояний
в зоне проводимости Si (300 К)
3.2 × 1019
»
EgSi
эВ
Ширина запрещенной зоны Si (300 К)
1.12
»
mc
m0
Эффективная масса электрона в Si
0.43
»
mZ
»
Эффективная масса электрона в ZrO2(Y)
0.6
[20]
mS
»
Эффективная масса электрона в SiO2
0.4
[21]
εSi
—
Диэлектрическая проницаемость Si
11.7
[19]
ε1
—
Диэлектрическая проницаемость ZrO2(Y)
25
[22]
ε2
—
Диэлектрическая проницаемость SiO2
3.8
»
XZ
эВ
Сродство к электрону ZrO2(Y)
2.65
»
XS
»
Сродство к электрону SiO2
0.8
»
EgZ
»
Ширина запрещенной зоны в ZrO2(Y)
5.9
»
EgS
»
Ширина запрещенной зоны в SiO2
9.0
»
AZr
»
Работа выхода электрона из Zr
4.05
[23]
EFZr
»
Энергия Ферми Zr
6.9
»
EFAu
»
Энергия Ферми Au
5.5
»
ΔЕZ
»
Высота потенциального барьера
на границе Au–ZrO2(Y)
2.5
[24]
ΔЕS
»
То же на границе Au–SiO2
4.5
[25]
ΔЕc
»
Разрыв зон проводимости на границе Si–SiO2
3.9
»
Спектр туннельной прозрачности структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si T(E) (рис. 5) немонотонный – в нем имеется ряд пиков (при Е < 8 эВ), соответствующих уровням размерного квантования в асимметричной квантовой
яме ZrO2(Y)/Au/SiO2. Средний энергетический зазор между уровнями составляет ~1 эВ. Ранее [24] методом баллистической электронной микроскопии/спектроскопии были экспериментально
измерены значения энергии уровней размерного квантования в наночастицах Au в пленках
ZrO2(Y), сформированных в тех же условиях, что и структуры, исследованные в настоящей
работе. Было установлено, что средний энергетический зазор между уровнями размерного
квантования в наночастицах Au диаметром D ≈ 2 нм вблизи уровня Ферми составляет ~0.7 эВ. Результаты баллистической электронной
микроскопии сравнивали с результатами расчетов энергетического спектра размерного
квантования наночастиц Au в матрице ZrO2(Y) по модели сферической квантовой точки с конечной высотой потенциального барьера
[16]. Было найдено удовлетворительное соответствие между результатами расчетов и эксперимента.
Таким образом, как результаты модельных расчетов, проведенных в настоящей работе,
так и данные ранних экспериментов свидетельствует о возможности проявления в исследованных
структурах эффекта резонансного туннелирования электронов при 300 К. Осцилляции Т(Е) при Е > 8 эВ обусловлены виртуальными резонансами при надбарьерном туннелировании.
На рис. 6 приведены модельные ВАХ двухбарьерной структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si для d1 = 1 нм (соответствует развертке Vg в прямом направлении в состоянии с высоким сопротивлением) и для d1 = 0.5 нм (соответствует развертке Vg в обратном направлении в состоянии с низким сопротивлением). Туннельный ток через
двухбарьерную структуру в случае инжекции электронов из филамента (Vg < 0) вычисляли по формуле [26]:
(10)
${{I}_{t}}\left( {{{V}_{g}}} \right) = \frac{{eS}}{{2\pi \hbar }}\int\limits_0^\infty {N\left( E \right)T\left( {E,{{V}_{g}}} \right)dE} ,$где
(11)
$N\left( E \right) = \frac{{{{m}_{e}}{{k}_{{\text{B}}}}T}}{{\pi {{\hbar }^{{\text{2}}}}}}{\text{ln}}\left[ {{\text{1}} + {\text{exp}}\left( {\frac{{{{E}_{{{\text{FZr}}}}} - E}}{{{{k}_{{\text{B}}}}T}}} \right)} \right],$S – эффективная площадь поперечного сечения наночастицы Au, ℏ – постоянная Планка,
kB – постоянная Больцмана, Т – абсолютная температура. Поскольку модельные расчеты проводили для области Vg < –4 В, в которой на экспериментальных ВАХ контакта АСМ-зонда с исследуемой структурой
ZrO2(Y)–наночастица-Au/SiO2/n+-Si наблюдалось отрицательное дифференциальное сопротивление, обратным током (из подложки
n+-Si в филамент) пренебрегали.
Рис. 6.
Расчетные ВАХ двухбарьерной структуры Zr/ZrO2(Y)/Au(2 нм)/SiO2(3 нм)/n+-Si для значений d1: 0.5 (1); 1 нм (×50) (2).

На модельных ВАХ (рис. 6) в области –6 В < Vg < < –4 В (т.е. в той же области напряжений, в которой в эксперименте наблюдалось
отрицательное дифференциальное сопротивление на ВАХ контакта АСМ-зонда с образцом)
присутствуют пики, обусловленные резонансным туннелированием электронов в двухбарьерной
структуре Zr/ZrO2(Y)/Au/SiO2/n+-Si. Амплитуды пиков на модельных ВАХ по порядку величины соответствуют амплитудам
пиков на экспериментальных ВАХ. Сдвиг положений максимумов It на ВАХ по оси Vg связан с различной толщиной слоя ZrO2(Y) между слоями Zr и Au d1 и, соответственно, с перераспределением напряжения между первым и вторым барьерами
двухбарьерной структуры. Таким образом, сравнение результатов моделирования и эксперимента
свидетельствует о том, что, несмотря на весьма упрощенную модель, используемую в настоящей
работе, наблюдаемые на экспериментальных ВАХ пики могут быть связаны с резонансным
туннелированием электронов между филаментом и подложкой n+-Si через размерно-квантованные электронные состояния в наночастицах Au.
Как показал расчет, наибольший вклад в общий туннельный ток вносит туннелирование
через размерно-квантованные уровни в слое Au, расположенные вблизи уровня Ферми в
Zr ЕFZr (для моделируемой структуры соответствующий пик T(E) показан стрелкой на рис. 5). При Е < ЕFZrT(Е) → 0, а при Е > ЕFZrN(Е) → 0. Общее количество резонансных пиков на ВАХ определяется количеством уровней
размерного квантования в наночастицах Au, которые пройдет уровень Ферми EF в материале филамента в ходе развертки Vg. Следует подчеркнуть, что согласно проведенным расчетам бóльшая часть Vg падает на слое SiO2 и в области пространственного заряда на границе SiO2–Si, так что в условиях настоящего эксперимента уровень Ферми филамента проходит не
более одного–двух уровней размерно-квантованных состояний в наночастицах Au.
ЗАКЛЮЧЕНИЕ
В настоящей работе в ходе экспериментального исследования процессов резистивного переключения
в тонких пленках ZrO2(Y) c внедренными наночастицами Au на подложках n+-Si(001) обнаружены участки отрицательного дифференциального сопротивления на ВАХ
контакта АСМ-зонда с поверхностью исследованных структур. Результаты моделирования
показывают, что указанные особенности ВАХ могут быть связаны с резонансным туннелированием
электронов из проводящих филаментов в ZrO2(Y), сформированных под действием потенциала АСМ-зонда, в подложку n+-Si через размерно-квантованные электронные состояния в наночастицвх Au нанометровых
размеров (диаметр 2–3 нм). Значительная часть напряжения между АСМ-зондом и подложкой
n+-Si падает в области пространственного заряда вблизи границы раздела SiO2–n+-Si.
БЛАГОДАРНОСТИ
Работа поддержана Правительством РФ (грант № 14.Y26.31.0021). Измерения методом туннельной
АСМ выполнены с использованием оборудования центра коллективного пользования – Научно-образовательного
центра “Физика твердотельных наноструктур” Нижегородского государственного университета
им. Н.И. Лобачевского.
Список литературы
Ouyang J. Emerging Resistive Switching Memories. Berlin–Heidelberg: Springer, 2016. 93 p.
Resistive Switching: From Fundamentals of Nanoionic Redox Processes to Memristive
Device Applications / Eds. Ielmini D., Waser R. Stuttgart: Wiley-VCH, 2016. 784 p.
Waser R., Dittmann R., Staikov G. et al. // Adv. Mater. 2009. V. 21. P. 2632. doi 10.1002/adma.200900375
Conductive Atomic Force Microscopy: Applications in Nanomaterials / Ed. Lanza M. Stuttgart:
Wiley-VCH, 2017. 384 p.
Lanza M. // Mater. 2014. V. 7. № 3. P. 2155. doi 10.3390/ ma7032155
Jeong D.S., Thomas R., Katiyar R.S. et al. // Rep. Prog. Phys. 2012. V. 75. № 7. P. 076502. doi 10.1088/0034-4885/75/7/076502
Filatov D., Antonov D., Antonov I. et al. // J. Mater. Sci. Chem. Engin. 2017. V. 5. P. 8. doi 10.4236/msce.2017.51002
Guan W., Long S., Jia R. et al. // Appl. Phys. Lett. 2007. V. 91. № 6. P. 062111. doi 10.1063/1.2760156
Cho S.H., Lee S., Ku D.Y. et al. // Thin Solid Films. 2004. V. 447–448. P. 68. doi 10.1016/j.tsf.2003.09.024
Gorshkov O., Antonov I., Filatov D. et al. // Adv. Mat. Sci. Engin. 2017. P. 1759469. doi 10.1155/2017/1759469
Горшков O.Н., Антонов И.Н., Филатов Д.O. и др. // Письма в ЖТФ. 2016. Т. 42. № 1. С. 72. doi 10.1134/ S1063785016010089
Лапшина M.A., Филатов Д.О., Антонов Д.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2008. № 8. С. 35.
Chang L.L., Esaki L., Tsu R. // Appl. Phys. Lett. 1974. V. 24. № 11. P. 593. doi 10.1063/1.1655067
González-Cordero G., Jiménez-Molinos F., Bautista Roldán J. et al. // J. Vac. Sci. Technol. B. 2017. V. 35. № 1. P. 01A110. doi 10.1116/1.4973372
Tsu R., Esaki L. // Appl. Phys. Lett. 1973. V. 22. № 11. P. 562. doi 10.1063/1.1654509
Ландау Л.Д., Лифшиц Е.М. Теоретическая физика. Т. 3. Квантовая механика: нерелятивистская теория. М:. Наука,
1989. 752 с.
Zenkevich A., Lebedinskii Yu., Gorshkov O. et al. // Advances in Diverse Industrial Applications of Nanocompositess / Ed. Reddy B.
Rijeka: InTech, 2011. P. 317.
Filatov D.O., Lapshina M.A., Antonov D.A. et al. // J. Phys. Conf. Ser. 2010. V. 245. P. 012018. doi 10.1088/ 1742-6596/245/1/012018
Physical Properites of Semiconductors. New Semiconductor Materials Database. http://www.matprop.ru/.
Perevalov T.E., Shaposhnikov A.V., Nasyrov K.A. et al. // Defects in HIgh-k Gate Dielectric Stacks: Nano-Electronic Semiconductor Devices
/ Ed. Gusev E.V. Berlin–Heidelberg: Springer, 2006. P. 423.
Ludeke R., Bauer A., Cartier E. // Appl. Phys. Lett. 1995. V. 66. № 6. P. 730. doi 10.1063/1.114114
Физико-химические свойства окислов. Справочник / Ред. Самсонов Г.В. и др. M.: Металлургия,
1978. 472 с.
Таблицы физических величин. Справочник. / Ред. Кикоин И.К. и др. М.: Атомиздат, 1976.
1008 с.
Filatov D., Guseinov D., Antonov D. et al. // RSC Adv. 2014. V. 4. P. 57337. doi 10.1039/C4RA10236C
Quattropani L., Maggio-Aprile I., Niedermann P., Fisher O. // Phys. Rev. B 1998. V. 57. № 11. P. 6623. doi 10.1103/PhysRevB.57.6623
Weisbuch C., Vinter B. Quantum Semiconductor Structures: Fundamentals and Applications. New York: Academic
Press, 1991. 448 p. doi 10.1002/adma.19920040619
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования
Д. О. Филатов 1, *, И. А. Казанцева 1, Д. А. Антонов 1, И. Н. Антонов 1, М. Е. Шенина 1, О. Н. Горшков 1
1 Нижегородский государственный университет им. Н.И. Лобачевского,
603950 Нижний, Новгород,, Россия
* E-mail: dmitry_filatov@inbox.ru
Поступила в редакцию 07.04.2018
После доработки 22.04.2018
Принята к публикации 17.04.2018
Аннотация
Методом туннельной атомно-силовой микроскопии исследовано резистивное переключение в тонких (5–10 нм) пленках ZrO2(Y) с наночастицами золота. На вольт-амперных характеристиках индивидуальных филаментов, сформированных под действием потенциала зонда, наблюдались участки отрицательного дифференциального сопротивления, связанные c резонансным туннелированием электронов через размерно-квантованные электронные состояния c дискретным энергетическим спектром в наночастицах золота, встроенных в филаменты.
ВВЕДЕНИЕ
В настоящее время ведутся интенсивные исследования эффекта резистивного переключения в тонких пленках диэлектриков, направленные на создание элементов энергонезависимой памяти нового поколения (так называемой резистивной памяти) [1]. Эффект резистивного переключения заключается в обратимом бистабильном (или мультистабильном) изменении сопротивления тонких (толщиной 10–50 нм) диэлектрических пленок, заключенных между двумя металлическими электродами (структуры металл–диэлектрик–металл – МДМ) или в составе структур металл–диэлектрик–полупроводник (МДП) под действием внешнего электрического напряжения [2]. В настоящее время считается, что механизм резистивного переключения в оксидных материалах заключается в образовании и разрушении в слое диэлектрика проводящих шнуров (филаментов) из вакансий кислорода (VO), замыкающих электроды МДМ-структур (МДП-структур) под действием электрического поля между электродами [3].
В последнее время для исследования резистивного переключения в тонких диэлектрических пленках на проводящих подожках все шире применяется метод туннельной атомно-силовой микроскопии (АСМ) [4, 5]. Типичные размеры области контакта зонда АСМ с поверхностью диэлектрика (менее 10 нм) по порядку величины соответствуют ожидаемым размерам ячеек в перспективных устройствах резистивной памяти [6]. Таким образом, контакт проводящего зонда АСМ с диэлектрической пленкой на проводящей подложке является модельной системой (виртуальным устройством), позволяющей изучать процессы резистивного переключения в областях нанометрового масштаба.
В [7] методом туннельной АСМ исследовано резистивное переключение в сверхтонких (3–6 нм) пленках ZrO2(Y)/Si. На вольт-амперных характеристиках (ВАХ) контакта зонда АСМ с индивидуальными филаментами в слое ZrO2(Y) были обнаружены участки отрицательного дифференциального сопротивления, связанные с резонансным туннелированием электронов через наноразмерные образования с дискретным энергетическим спектром (изолированные VO, кластеры VO), встроенные в филаменты. В настоящей работе методом туннельной АСМ исследовано резистивное переключение в тонких пленках ZrO2(Y) с наночастицами Au, встроенными в них, с целью улучшения параметров переключения. Известно, что наночастицы металла являются концентраторами электрического поля в диэлектрических пленках, что инициирует зарождение филаментов вблизи наночастиц [8]. В настоящей работе наочастицы Au играли роль искусственных нанообъектов с дискретным энергетическим спектром (квантовых точек), встроенных в филаменты. Целью работы было изучение эффекта резонансного туннелирования электронов через наночастицы Au в ходе резистивного переключения.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Пленки ZrO2(Y) толщиной 5–10 нм с однослойными массивами наночастиц Au на подложках n+-Si(001) формировали методом послойного магнетронного осаждения с последующим отжигом [9]. На поверхность подложек n+-Si(001), покрытых слоем естественного оксида SiO2 толщиной ~3 нм, методом высокочастотного магнетронного распыления спеченных порошковых мишеней ZrO2–Y2O3 (молярная доля Y2O3 составляла ~0.12) при температуре подожки Tg ≈ 300°C осаждали подслои ZrO2(Y) толщиной 1–2 нм. На них методом магнетронного распыления на постоянном токе при Tg ≈ 200°C осаждали островковые пленки Au номинальной толщиной ~1 нм. Сверху наносили покровные слои ZrO2(Y) толщиной 2–8 нм в тех же условиях, что и подслои ZrO2(Y). Полученные таким образом сэндвич–структуры отжигали в атмосфере Ar при температуре 450°С в течение 1 ч. Ранее [10, 11] исследования методом просвечивающей электронной микроскопии поперечных срезов показали, что в процессе отжига в указанных условиях пленки Au коагулируют в наночастицы диаметром D = 2–3 нм, расположенные практически в одной плоскости на заданных расстояниях от подожки и поверхности пленки, которые определяются толщиной нижнего и покровного слоев ZrO2(Y).
Исследования резистивного переключения методом туннельной АСМ проводили в сверхвысоком вакууме при 300 К в контактной моде при помощи АСМ Omicron UHVAFM/STM LF1 в составе комплекса Omicron MultiProbe RM. Давление остаточных газов в камере АСМ/CТМ составляло ~10–10 Торр. Использовали зонды производства компании NT MDT марки NSG-11 DCP с радиусом кривизны острия Rp ≈ 70 нм (согласно паспортным данным). Исследование резистивного переключения проводили путем записи циклических ВАХ контакта зонд–образец при линейной развертке напряжения Vg между зондом АСМ и подложкой n+-Si от Vmin (Vmin < VRESET, где VRESET – напряжение переключения из состояния с низким сопротивлением в состояние с высоким сопротивлением) до Vmax (Vmax > VSET, где VSET – напряжение переключения из состояния с высоким сопротивлением в состояние с низким сопротивлением) и обратно, от Vmax до Vmin, и так далее. Предварительно формировали филаменты (форминг) путем однократного или многократного сканирования выбранного участка поверхности образца при Vg = Vform, где Vform > VSET – напряжение форминга. Результаты форминга контролировали путем измерения токовых изображений поверхности модифицированного участка It(x, y), где It – сила тока через зонд АСМ, x, y – координаты зонда в плоскости поверхности при |Vg| < |VSET|, |VRESET|.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На рис. 1 приведено токовое изображение It(x, y) поверхности пленки ZrO2(Y) с наночастицами Au, измеренное при Vg = –4 В. Предварительно был проведен форминг данного участка поверхности путем трехкратного сканирования при Vg = = –6 В. Участки с повышенными значениями It (токовые каналы) на рис. 1 связаны с протеканием электрического тока через филаменты в пленке ZrO2(Y), возникшие в ходе предварительного форминга. Латеральные размеры токовых каналов по порядку величины соответствуют радиусу кривизны Rp острия используемых АСМ-зондов. Как показано в [12], размеры токовых изображений дефектов в диэлектрических пленках, полученных методом туннельной АСМ, определяются размерами области контакта острия АСМ-зонда с поверхностью пленки и не зависят от размера самих дефектов.
Рис. 1.
Токовое изображение (Vg = –4 В) участка поверхности пленки ZrO2(Y) с наночастицами Au на подложке n+-Si после форминга трехкратным сканированием при Vg = –6 В.
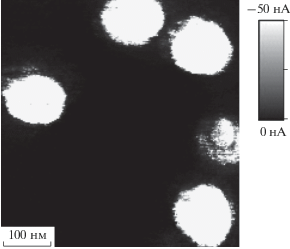
На рис. 2 показана ВАХ контакта АСМ-зонда с филаментом в пленке ZrO2(Y) с наночастицами Au. Наряду с гистерезисом, обусловленным резистивным переключением в пленке ZrO2(Y), на ВАХ наблюдаются участки отрицательного дифференциального сопротивления, связанные с туннелированием электронов между АСМ-зондом и подложкой n+-Si через размерно-квантованные состояния в наночастицу Au размером 2–3 нм, встроенную в филамент (рис. 3). Как уже упоминалось выше, наночастицы Au, являющиеся концентраторами электрического поля в диэлектрической пленке, инициируют формирование филаментов [8]. Поэтому высока вероятность того, что филаменты, сформированные в пленке ZrO2(Y) c наночастицами Au в ходе предварительного форминга, будут проходить через наночастицы Au.
Рис. 2.
Циклическая ВАХ контакта АСМ-зонда с филаментом в пленке ZrO2(Y) с наночастицвми Au на подложке n+-Si.
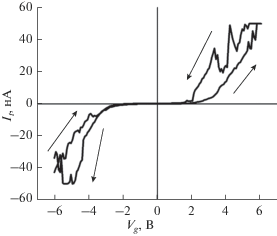
На рис. 4 приведена модельная зонная диаграмма (300 К) контакта филамента в пленке ZrO2(Y) с наночастицей Au, встроенной вблизи границы с подложкой n+-Si, покрытой слоем естественного оксида SiO2 толщиной ~3 нм, при Vg = –5 В. Данный контакт представляет собой асимметричную двухбарьерную структуру, подобную структуре резонансно-туннельного диода [13]. В этой структуре край филамента, ближайший к наночастице Au, играет роль эмиттера. Роль первого туннельно-прозрачного потенциального барьера играет прослойка ZrO2(Y) между краем филамента и наночастицей Au, а второго – слой естественного оксида SiO2 на поверхности подложки n+-Si. Ранее в [14] было показано, что проводимость филаментов в HfO2 носит металлический характер (в частности, проводимость филамента уменьшается с ростом температуры) и близка по величине к проводимости металлического Hf. Поэтому при расчете зонной диаграммы структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si полагали, что филамент состоит из металлического Zr и эквипотенциальный в области от контакта АСМ-зонда с поверхностью ZrO2(Y) до края филамента, т.е. падение напряжения на филаменте мало по сравнению с падением напряжения на остальной части слоя ZrO2(Y). Толщина d1 туннельно-прозрачного барьера ZrO2(Y) между краем филамента и наночастицей Au была параметром модели. Переключение из состояния с высоким сопротивлением в низкоомное состояние соответствовало уменьшению d1 до ~0.5 нм, обратное переключение – увеличению d1.
Рис. 4.
Расчетная зонная диаграмма двухбарьерной структуры Zr/ZrO2(Y)(1 нм)/Au(2 нм)/SiO2(3 нм)/n+-Si. Vg = –5 В.

При построении зонной диаграммы двухбарьерной структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si учитывали падение части Vg на области пространственного заряда вблизи границы раздела SiO2–n+-Si. Уравнение баланса энергии для рассматриваемой структуры может быть записано в виде:
(1)
$\begin{gathered} \Delta {{E}_{Z}}--e{{F}_{1}}{{d}_{1}} + \Delta {{E}_{{c1}}}--e{{F}_{2}}{{d}_{2}}-- \\ - \,\,\Delta {{E}_{c}}--\Delta {{\varphi }_{s}}--\Delta + e{{V}_{g}} = 0, \\ \end{gathered} $(2)
$\Delta {{\varphi }_{s}} = \frac{{{{\varepsilon }_{0}}\varepsilon _{2}^{2}F_{2}^{2}}}{{2e{{\varepsilon }_{{{\text{Si}}}}}{{N}_{{\text{d}}}}}},$На рис. 5 приведен расчетный энергетический спектр туннельной прозрачности T(E) двухбарьерной структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si при Vg = –5 В. Обычно при моделировании резонансно-туннельных явлений для расчета спектра туннельной прозрачности двух- или многобарьерных структур используют метод трансфер-матриц [15]. Данный подход применим при условии малых напряжений V $ \ll $ Eb/e, где Eb – характерная высота потенциальных барьеров в структуре, V – падение напряжения на них. Однако он не применим для объектов, исследованных в настоящей работе, поскольку в них туннелирование происходило в режиме сильного поля: V ~ Eb/e. Поэтому в настоящей работе T(Е) рассчитывали на основе решения одномерного уравнения Шредингера в приближении эффективной массы [16]. Наночастицы Au считали квазинейтральными, эффектом кулоновской блокады туннелирования через наночастицы Au пренебрегали. Ранее подобный подход применялся для расчета спектров туннельной прозрачности пленок SiO2/Si c внедренными наночастицами Au [17, 18].
Рис. 5.
Расчетный спектр туннельной прозрачности двухбарьерной структуры Zr/ZrO2(Y)(1 нм)/Au(2 нм)/ SiO2(3 нм)/n+-Si. Vg = –5 В.
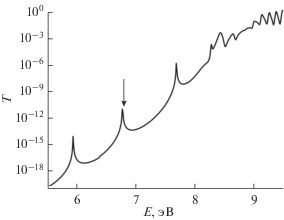
Решение уравнения Шредингера в слоях ZrO2(Y) и SiO2 выбирали в виде:
где χ(z) – огибающая волновой функции электрона; Ai и Bi – функции Эйри 1-го и 2-го рода соответственно;(4)
$s\left( z \right) = \frac{{{{{\left( {2m} \right)}}^{{{1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}}}}{{{{{\left( {e\hbar F} \right)}}^{{{2 \mathord{\left/ {\vphantom {2 3}} \right. \kern-0em} 3}}}}}}\left[ {eF\left( {z - {{z}_{0}}} \right) - E} \right]{\text{;}}$(5)
${{\chi }_{{{\text{Zr}}}}}(z) = {\text{exp}}(i{{k}_{{{\text{Zr}}}}}z) + {{C}_{0}}{\text{exp}}(--i{{k}_{{{\text{Zr}}}}}z),$(6)
${{\chi }_{{{\text{Au}}}}}(z) = {{C}_{{1{\text{Au}}}}}{\text{exp}}(i{{k}_{{{\text{Au}}}}}z) + {{C}_{{2{\text{Au}}}}}{\text{exp}}(--i{{k}_{{{\text{Au}}}}}z),$(8)
$T(E) = \frac{{{{m}_{e}}{{k}_{c}}(E)}}{{{{m}_{c}}{{k}_{e}}(E)}}{{\left| {{{C}_{c}}(E)} \right|}^{2}},$(9)
$\begin{gathered} {{\chi }_{1}}(z) = {{\chi }_{2}}(z), \\ {{m}_{2}}\frac{{\partial {{\chi }_{1}}}}{{\partial z}} = {{m}_{1}}\frac{{\partial {{\chi }_{2}}}}{{\partial z}}, \\ \end{gathered} $Таблица 1.
Параметры слоев структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si, использованные в расчетах модельных ВАХ
| Обозначение | Единица измерения | Величина | Значение | Источник |
|---|---|---|---|---|
| Nd | см–3 | Концентрация доноров в n+-Si | 2 × 1019 | [19] |
| Nc | » | Эффективная плотность состояний в зоне проводимости Si (300 К) | 3.2 × 1019 | » |
| EgSi | эВ | Ширина запрещенной зоны Si (300 К) | 1.12 | » |
| mc | m0 | Эффективная масса электрона в Si | 0.43 | » |
| mZ | » | Эффективная масса электрона в ZrO2(Y) | 0.6 | [20] |
| mS | » | Эффективная масса электрона в SiO2 | 0.4 | [21] |
| εSi | — | Диэлектрическая проницаемость Si | 11.7 | [19] |
| ε1 | — | Диэлектрическая проницаемость ZrO2(Y) | 25 | [22] |
| ε2 | — | Диэлектрическая проницаемость SiO2 | 3.8 | » |
| XZ | эВ | Сродство к электрону ZrO2(Y) | 2.65 | » |
| XS | » | Сродство к электрону SiO2 | 0.8 | » |
| EgZ | » | Ширина запрещенной зоны в ZrO2(Y) | 5.9 | » |
| EgS | » | Ширина запрещенной зоны в SiO2 | 9.0 | » |
| AZr | » | Работа выхода электрона из Zr | 4.05 | [23] |
| EFZr | » | Энергия Ферми Zr | 6.9 | » |
| EFAu | » | Энергия Ферми Au | 5.5 | » |
| ΔЕZ | » | Высота потенциального барьера на границе Au–ZrO2(Y) | 2.5 | [24] |
| ΔЕS | » | То же на границе Au–SiO2 | 4.5 | [25] |
| ΔЕc | » | Разрыв зон проводимости на границе Si–SiO2 | 3.9 | » |
Спектр туннельной прозрачности структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si T(E) (рис. 5) немонотонный – в нем имеется ряд пиков (при Е < 8 эВ), соответствующих уровням размерного квантования в асимметричной квантовой яме ZrO2(Y)/Au/SiO2. Средний энергетический зазор между уровнями составляет ~1 эВ. Ранее [24] методом баллистической электронной микроскопии/спектроскопии были экспериментально измерены значения энергии уровней размерного квантования в наночастицах Au в пленках ZrO2(Y), сформированных в тех же условиях, что и структуры, исследованные в настоящей работе. Было установлено, что средний энергетический зазор между уровнями размерного квантования в наночастицах Au диаметром D ≈ 2 нм вблизи уровня Ферми составляет ~0.7 эВ. Результаты баллистической электронной микроскопии сравнивали с результатами расчетов энергетического спектра размерного квантования наночастиц Au в матрице ZrO2(Y) по модели сферической квантовой точки с конечной высотой потенциального барьера [16]. Было найдено удовлетворительное соответствие между результатами расчетов и эксперимента. Таким образом, как результаты модельных расчетов, проведенных в настоящей работе, так и данные ранних экспериментов свидетельствует о возможности проявления в исследованных структурах эффекта резонансного туннелирования электронов при 300 К. Осцилляции Т(Е) при Е > 8 эВ обусловлены виртуальными резонансами при надбарьерном туннелировании.
На рис. 6 приведены модельные ВАХ двухбарьерной структуры Zr/ZrO2(Y)/Au/SiO2/n+-Si для d1 = 1 нм (соответствует развертке Vg в прямом направлении в состоянии с высоким сопротивлением) и для d1 = 0.5 нм (соответствует развертке Vg в обратном направлении в состоянии с низким сопротивлением). Туннельный ток через двухбарьерную структуру в случае инжекции электронов из филамента (Vg < 0) вычисляли по формуле [26]:
(10)
${{I}_{t}}\left( {{{V}_{g}}} \right) = \frac{{eS}}{{2\pi \hbar }}\int\limits_0^\infty {N\left( E \right)T\left( {E,{{V}_{g}}} \right)dE} ,$(11)
$N\left( E \right) = \frac{{{{m}_{e}}{{k}_{{\text{B}}}}T}}{{\pi {{\hbar }^{{\text{2}}}}}}{\text{ln}}\left[ {{\text{1}} + {\text{exp}}\left( {\frac{{{{E}_{{{\text{FZr}}}}} - E}}{{{{k}_{{\text{B}}}}T}}} \right)} \right],$Рис. 6.
Расчетные ВАХ двухбарьерной структуры Zr/ZrO2(Y)/Au(2 нм)/SiO2(3 нм)/n+-Si для значений d1: 0.5 (1); 1 нм (×50) (2).

На модельных ВАХ (рис. 6) в области –6 В < Vg < < –4 В (т.е. в той же области напряжений, в которой в эксперименте наблюдалось отрицательное дифференциальное сопротивление на ВАХ контакта АСМ-зонда с образцом) присутствуют пики, обусловленные резонансным туннелированием электронов в двухбарьерной структуре Zr/ZrO2(Y)/Au/SiO2/n+-Si. Амплитуды пиков на модельных ВАХ по порядку величины соответствуют амплитудам пиков на экспериментальных ВАХ. Сдвиг положений максимумов It на ВАХ по оси Vg связан с различной толщиной слоя ZrO2(Y) между слоями Zr и Au d1 и, соответственно, с перераспределением напряжения между первым и вторым барьерами двухбарьерной структуры. Таким образом, сравнение результатов моделирования и эксперимента свидетельствует о том, что, несмотря на весьма упрощенную модель, используемую в настоящей работе, наблюдаемые на экспериментальных ВАХ пики могут быть связаны с резонансным туннелированием электронов между филаментом и подложкой n+-Si через размерно-квантованные электронные состояния в наночастицах Au.
Как показал расчет, наибольший вклад в общий туннельный ток вносит туннелирование через размерно-квантованные уровни в слое Au, расположенные вблизи уровня Ферми в Zr ЕFZr (для моделируемой структуры соответствующий пик T(E) показан стрелкой на рис. 5). При Е < ЕFZrT(Е) → 0, а при Е > ЕFZrN(Е) → 0. Общее количество резонансных пиков на ВАХ определяется количеством уровней размерного квантования в наночастицах Au, которые пройдет уровень Ферми EF в материале филамента в ходе развертки Vg. Следует подчеркнуть, что согласно проведенным расчетам бóльшая часть Vg падает на слое SiO2 и в области пространственного заряда на границе SiO2–Si, так что в условиях настоящего эксперимента уровень Ферми филамента проходит не более одного–двух уровней размерно-квантованных состояний в наночастицах Au.
ЗАКЛЮЧЕНИЕ
В настоящей работе в ходе экспериментального исследования процессов резистивного переключения в тонких пленках ZrO2(Y) c внедренными наночастицами Au на подложках n+-Si(001) обнаружены участки отрицательного дифференциального сопротивления на ВАХ контакта АСМ-зонда с поверхностью исследованных структур. Результаты моделирования показывают, что указанные особенности ВАХ могут быть связаны с резонансным туннелированием электронов из проводящих филаментов в ZrO2(Y), сформированных под действием потенциала АСМ-зонда, в подложку n+-Si через размерно-квантованные электронные состояния в наночастицвх Au нанометровых размеров (диаметр 2–3 нм). Значительная часть напряжения между АСМ-зондом и подложкой n+-Si падает в области пространственного заряда вблизи границы раздела SiO2–n+-Si.
БЛАГОДАРНОСТИ
Работа поддержана Правительством РФ (грант № 14.Y26.31.0021). Измерения методом туннельной АСМ выполнены с использованием оборудования центра коллективного пользования – Научно-образовательного центра “Физика твердотельных наноструктур” Нижегородского государственного университета им. Н.И. Лобачевского.
Список литературы
Ouyang J. Emerging Resistive Switching Memories. Berlin–Heidelberg: Springer, 2016. 93 p.
Resistive Switching: From Fundamentals of Nanoionic Redox Processes to Memristive Device Applications / Eds. Ielmini D., Waser R. Stuttgart: Wiley-VCH, 2016. 784 p.
Waser R., Dittmann R., Staikov G. et al. // Adv. Mater. 2009. V. 21. P. 2632. doi 10.1002/adma.200900375
Conductive Atomic Force Microscopy: Applications in Nanomaterials / Ed. Lanza M. Stuttgart: Wiley-VCH, 2017. 384 p.
Lanza M. // Mater. 2014. V. 7. № 3. P. 2155. doi 10.3390/ ma7032155
Jeong D.S., Thomas R., Katiyar R.S. et al. // Rep. Prog. Phys. 2012. V. 75. № 7. P. 076502. doi 10.1088/0034-4885/75/7/076502
Filatov D., Antonov D., Antonov I. et al. // J. Mater. Sci. Chem. Engin. 2017. V. 5. P. 8. doi 10.4236/msce.2017.51002
Guan W., Long S., Jia R. et al. // Appl. Phys. Lett. 2007. V. 91. № 6. P. 062111. doi 10.1063/1.2760156
Cho S.H., Lee S., Ku D.Y. et al. // Thin Solid Films. 2004. V. 447–448. P. 68. doi 10.1016/j.tsf.2003.09.024
Gorshkov O., Antonov I., Filatov D. et al. // Adv. Mat. Sci. Engin. 2017. P. 1759469. doi 10.1155/2017/1759469
Горшков O.Н., Антонов И.Н., Филатов Д.O. и др. // Письма в ЖТФ. 2016. Т. 42. № 1. С. 72. doi 10.1134/ S1063785016010089
Лапшина M.A., Филатов Д.О., Антонов Д.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2008. № 8. С. 35.
Chang L.L., Esaki L., Tsu R. // Appl. Phys. Lett. 1974. V. 24. № 11. P. 593. doi 10.1063/1.1655067
González-Cordero G., Jiménez-Molinos F., Bautista Roldán J. et al. // J. Vac. Sci. Technol. B. 2017. V. 35. № 1. P. 01A110. doi 10.1116/1.4973372
Tsu R., Esaki L. // Appl. Phys. Lett. 1973. V. 22. № 11. P. 562. doi 10.1063/1.1654509
Ландау Л.Д., Лифшиц Е.М. Теоретическая физика. Т. 3. Квантовая механика: нерелятивистская теория. М:. Наука, 1989. 752 с.
Zenkevich A., Lebedinskii Yu., Gorshkov O. et al. // Advances in Diverse Industrial Applications of Nanocompositess / Ed. Reddy B. Rijeka: InTech, 2011. P. 317.
Filatov D.O., Lapshina M.A., Antonov D.A. et al. // J. Phys. Conf. Ser. 2010. V. 245. P. 012018. doi 10.1088/ 1742-6596/245/1/012018
Physical Properites of Semiconductors. New Semiconductor Materials Database. http://www.matprop.ru/.
Perevalov T.E., Shaposhnikov A.V., Nasyrov K.A. et al. // Defects in HIgh-k Gate Dielectric Stacks: Nano-Electronic Semiconductor Devices / Ed. Gusev E.V. Berlin–Heidelberg: Springer, 2006. P. 423.
Ludeke R., Bauer A., Cartier E. // Appl. Phys. Lett. 1995. V. 66. № 6. P. 730. doi 10.1063/1.114114
Физико-химические свойства окислов. Справочник / Ред. Самсонов Г.В. и др. M.: Металлургия, 1978. 472 с.
Таблицы физических величин. Справочник. / Ред. Кикоин И.К. и др. М.: Атомиздат, 1976. 1008 с.
Filatov D., Guseinov D., Antonov D. et al. // RSC Adv. 2014. V. 4. P. 57337. doi 10.1039/C4RA10236C
Quattropani L., Maggio-Aprile I., Niedermann P., Fisher O. // Phys. Rev. B 1998. V. 57. № 11. P. 6623. doi 10.1103/PhysRevB.57.6623
Weisbuch C., Vinter B. Quantum Semiconductor Structures: Fundamentals and Applications. New York: Academic Press, 1991. 448 p. doi 10.1002/adma.19920040619
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования