Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 10, стр. 69-73
Электрофизические свойства поликристаллических пленок CuIn0.95Ga0.05Se2
Т. М. Гаджиев 1, М. А. Алиев 1, А. Ш. Асваров 1, 2, *, Г. А. Алиев 3, А. Э. Муслимов 2, **, В. М. Каневский 2
1 Институт физики Дагестанского научного центра РАН
367015 Махачкала, Россия
2 Институт кристаллографии им. А.В. Шубникова
ФНИЦ “Кристаллография и фотоника” РАН
119333 Москва, Россия
3 Дагестанский государственный технический университет
367026 Махачкала, Россия
* E-mail: abil-as@list.ru
** E-mail: amuslimov@mail.ru
Поступила в редакцию 12.02.2019
После доработки 09.03.2019
Принята к публикации 08.04.2019
Аннотация
Поликристаллические пленки CuIn0.95Ga0.05Se2 получены двухстадийным методом управляемой селенизации интерметаллических слоев CuIn0.95Ga0.05. Исследовано влияние температуры селенизации и толщины интерметаллического слоя на структуру и электрофизические свойства формируемых селенидных пленок. Показано, что с ростом температуры селенизации степень дефектности поликристаллических пленок снижается, а эффективность встраивания Ga в кристаллическую решетку увеличивается. На основании результатов исследования электрофизических свойств синтезированных образцов обсуждается характер влияния микроструктуры на механизмы токопереноса в поликристаллических пленках CuIn0.95Ga0.05Se2.
ВВЕДЕНИЕ
Пленки твердых растворов CuInxGa1 –xSe2 (CIGS) со структурой халькопирита являются материалом для использования в качестве оптически активного слоя в тонкопленочных солнечных элементах [1]. Эффективность фотопреобразования структур на основе тонких пленок CIGS в настоящее время уже достигает величин η ≈ ≈ 21.7–22.3% [2, 3]. В зависимости от выбора технологии получения тонких пленок CIGS наблюдается разброс электрофизических параметров фотопреобразователей, что связано в первую очередь с формируемой в пленках микроструктурой и их фазовым составом [3–8].
Тип проводимости CIGS зависит от стехиометрии пленки в объеме и на поверхности. Для производства высококачественных солнечных батарей необходимо получить абсорбирующий слой p-типа с высокой подвижностью носителей заряда. Наиболее активными собственными дефектами являются вакансии меди (VCu), медно-индиевые и медно-галлиевые антиструктурные дефекты (Cu/In, Cu/Ga). Наличие в пленках дефектов типа антидотов индия/галлия–меди и вакансий селена (VSe) приводит к частичной компенсации собственных акцепторных центров.
Особое внимание при получении пленок CIGS методом “управляемой селенизации” [9] следует уделять вакансиям селена, которые могут приводить к изменению типа носителей заряда – электронам вместо дырок. Высокие значения давления паров селенидов индия и галлия, особенно при температурах рекристаллизационного отжига, могут привести к отклонению состава пленки от стехиометрического и, как следствие, к увеличению содержания селенидов меди, что негативно влияет на электрофизические свойства фоточувствительного слоя.
В настоящей работе представлены результаты исследования зависимости структуры и электрофизических свойств пленок CIGS, полученных двухстадийным методом управляемой селенизации интерметаллических слоев CuIn0.95Ga0.05 (CIG), от температуры селенизации и толщины интерметаллического слоя.
МАТЕРИАЛЫ И МЕТОДЫ
Интерметаллические слои CIG толщиной от 0.6 до 1.5 мкм были осаждены на предварительно очищенные подложки из стекла Corning 7059 (15 × 15 мм) методом магнетронного распыления сплавной мишени требуемого состава при следующих условиях напыления: давление рабочего газа (Ar) 0.1 Пa; плотность тока разряда 10 мA/cм2; расстояние мишень–подложка 25 мм; скорость осаждения 1.0 нм/с; температура подложки 150°С.
Пленки CIGS получали управляемой селенизацией слоев CIG двухэтапным методом в двухзонной термодиффузионной установке с участием газа-носителя (N2) реакционного компонента (Se) [9]. Температуру селенизации в зоне реакции слоев CIG с Se варьировали в области 300 ≤ ТSe ≤ ≤ 550°С.
Фазовый состав и структурные свойства выращенных пленок CIGS исследовали с использованием порошкового рентгеновского дифрактометра PANalytical Empyrean Series 2 с длиной волны излучения (CuKα) λ = 0.15418 нм в диапазоне углов 2θ от 15° до 60° с шагом 0.02°.
Тип носителей заряда определяли по знаку коэффициента термоэдс при перепаде температур ΔТ = 50 К. Температурную зависимость электропроводности и подвижности носителей заряда пленок CuIn0.95Gа0.05Se2 исследовали на установке, предназначенной для изучения электрофизических свойств полупроводниковых пленок в постоянном магнитном поле до 30 кЭ. Пленочные образцы помещали в вакуумный криостат. Точность измерения напряженности электромагнитного поля ±0.5 Э. Стабильность температуры составляла 0.1 К. В качестве контактного материала использовали пасту Ag–Pd. Область температур, в которой измеряли электропроводность и подвижность носителей заряда, составляла Т = 100–300 К.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Как показал проведенный рентгенофазовый анализ (РФА) пленок, синтезированных методом двухстадийной селенизации интерметаллических слоев толщиной 1 мкм при температуре селенизации TSe = 350–550°C, процесс образования кристаллической фазы CIGS начинается при TSe ≥ ≥ 350°С [10]. По данным РФА при TSe ≥ 350°С формируются поликристаллические пленки CIGS со структурой халькопирита, и с ростом температуры селенизации кристаллическое совершенство пленок CIGS повышается: наблюдается рост интенсивности рефлексов основной фазы, их угловой сдвиг и уменьшение интегральной ширины, а также подавление рефлексов, соответствующих вторичным фазам одинарных и двойных селенидов. На рис. 1 представлены зависимости положения максимума наиболее интенсивного рефлекса, соответствующего отражению от плоскости (112), и области когерентного рассеяния (ОКР) D112, рассчитанной по формуле Селякова–Шеррера, от температуры селенизации.
Рис. 1.
Зависимость углового расположения рефлекса 112 (2θ) и ОКР (D112) в пленках CIGS от температуры селенизации интерметаллического слоя толщиной 1 мкм.
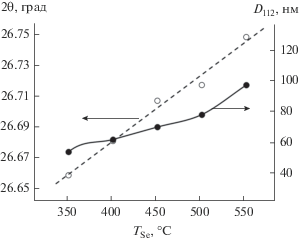
Угловое положение рефлекса 112 при 26.66°, наблюдаемого в случае пленки, полученной при TSe = 350°C, указывает на образование в первую очередь кристаллитов с составом, близким к тройному соединению CuInSe2. С ростом температуры селенизации основной пик 112 смещается в сторону больших углов 2θ, что свидетельствует об изменении параметров решетки за счет повышения вероятности встраивания галлия в кристаллическую решетку и образования четырехкомпонентного соединения CuIn0.95Gа0.05Se2 согласно закону Вегарда.
Измерения электрофизических параметров селенизированных образцов показали, что удельная электропроводность (при комнатной температуре) с ростом температуры селенизации снижается на пять порядков (рис. 2). При температуре селенизации TSe = 400°С электронный тип проводимости меняется на дырочный, что подтверждалось также измерениями температурной зависимости удельной электропроводности σ. В пленках CIGS, полученных при TSe ≤ 350°С, температурная зависимость σ(Т) носила металлический характер, в то время как в пленках CIGS, полученных при TSe ≥ 400°С, наблюдалась зависимость, характерная для дефектных полупроводников, – на зависимости σ(Т) можно было выделить две области, которые описываются законом Аррениуса, с различными значениями энергии активации проводимости [11, 12].
Рис. 2.
Удельная электропроводность σ как функция температуры селенизации интерметаллического слоя толщиной 1 мкм.
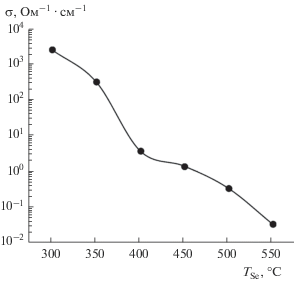
Зависимость типа проводимости от температуры селенизации можно объяснить большим количеством несвязанного интерметаллического компонента при низких температурах селенизации и, соответственно, связыванием металлических компонентов с образованием бинарных и многокомпонентных соединений при TSe = 400°С. На это указывает и резкое уменьшение электропроводности в области температур селенизации TSe ≥ 350°С. Полученные значения электропроводности и наблюдаемая смена типа проводимости в пленках CIGS находятся в согласии с литературными данными [5–8].
Были исследованы фазовый состав и структура пленок CIGS, полученных путем селенезации интерметаллических пленок различной толщины d при TSe = 550°С. Согласно данным РФА при увеличении толщины пленок помимо ожидаемого роста интенсивности основных отражений от плоскостей кристаллической фазы халькопирита наблюдалось также смещение рефлексов, видимо, связанное со снижением макронапряжений в формируемом полупроводниковом слое. Помимо этого уменьшалась их интегральная ширина, что соответствует увеличению ОКР от 82 до 142 нм (рис. 3). С ростом толщины исходного интерметаллического слоя вычисленное отношение параметров кристаллической решетки c/a плавно менялось от 2.01 для d = 0.6 мкм до 2.002 для d = = 1.5 мкм, что находится в согласии с [13].
Рис. 3.
Зависимость углового расположения рефлекса 112 (2θ) и ОКР (D112) в пленках CIGS, полученных при TSe = 550°С, от толщины селенизируемого интерметаллического слоя.

Наблюдаемое улучшение кристалличности пленок CIGS с ростом толщины селенизируемого слоя сопровождается увеличением удельной электропроводности, обусловленное в первую очередь ростом холловской подвижности µp носителей заряда (табл. 1).
Таблица 1.
Удельная электропроводность σ и холловская подвижность µp носителей заряда как функция толщины селенизируемого слоя CIG
| Толщина исходной пленки d, мкм | Удельная электропроводность σ, Ом–1 · см–1 | Холловская подвижность µp, см2 · В–1 · с–1 |
|---|---|---|
| 0.6 | 0.018 | 5.9 |
| 0.8 | 0.022 | 13.8 |
| 1.0 | 0.035 | 15.2 |
| 1.3 | 0.084 | 18.1 |
| 1.5 | 0.112 | 21.3 |
Из температурной зависимости ln σ ~ f(103/T) были вычислены значения энергии активации проводимости для низкотемпературной ветви ∆Е1 и высокотемпературной ветви ∆Е2 (табл. 2). С ростом толщины пленки ∆Е1 незначительно уменьшается, в то время как ∆Е2 растет.
Таблица 2.
Энергии активации проводимости ∆Еi и температурные диапазоны наблюдения $\Delta {{T}_{{\Delta {{E}_{i}}}}}$ как функции толщины селенизируемого слоя CIG
| Толщина пленки d, мкм | Энергия активации проводимости ∆Е1, эВ | Температурный диапазон $\Delta {{T}_{{\Delta {{E}_{1}}}}},$ К | Энергия активации проводимости ∆Е2, эВ | Температурный диапазон $\Delta {{T}_{{\Delta {{E}_{2}}}}},$ К |
|---|---|---|---|---|
| 0.6 | 0.12 | 100–150 | 0.22 | 180–300 |
| 0.9 | 0.12 | 100–150 | 0.24 | 180–300 |
| 1.0 | 0.10 | 100–150 | 0.24 | 180–300 |
| 1.3 | 0.09 | 100–180 | 0.24 | 195–300 |
| 1.5 | 0.07 | 100–210 | 0.32 | 230–300 |
На рис. 4 представлен график температурной зависимости подвижности носителей заряда в пленках CuIn0.95Gа0.05Se2 различной толщины. Как видно из рисунка, максимум μр = 36.2 см2/В · с наблюдается для пленок толщиной 1.5 мкм при температуре 220 К. Аналогичные максимумы подвижности носителей заряда наблюдаются и для пленок меньших толщин, однако они смещены в область более низких температур.
Рис. 4.
Температурная зависимость холловской подвижности µ носителей заряда в пленках CIGS толщиной: 1 – 1.0; 2 – 1.3; 3 – 1.5 мкм.

Структурные исследования показывают, что все синтезированные пленки CIGS поликристаллические. Очевидно, что зависимости электропроводности и холловской подвижности от температуры определяются суммарно проводимостью кристаллитов и рассеянием носителей заряда на межзеренных границах. В [14] уровни с малой энергией активации в пленках CuInSe2 связывали с вакансиями селена VSe, a более глубокие уровни – с межузельными дефектами меди Cui или акцепторными антиструктурными дефектами Cu(In/Ga), тогда как в [12] наличие уровней с малой энергией активации ∆Е = 0.007–0.01 эВ в поликристаллических пленках связывали с энергией активации межкристаллитных прослоек. По всей видимости, энергия активации ∆Е1 относится именно к проводимости по межзеренным границам, причем ее уменьшение с ростом толщины пленки указывает на уменьшение влияния вклада межзеренных границ на температурную зависимость электропроводности, обусловленное увеличением среднего размера кристаллитов в пленках CIGS.
Обобщение и интерпретации результатов измерений температурных зависимостей подвижности носителей заряда на поликристаллических пленках CIGS усложняются в связи с многокомпонентностью самого материала, множеством дефектных состояний, различной природой межкристаллитных прослоек, и их влияние на свойства в конкретном материале полностью не выяснено.
Рассеяние на межкристаллитных границах уменьшает подвижность носителей заряда, а также влияет как дополнительный фактор на ее зависимость от температуры. Эта зависимость в координатах ln μ ~ 1/T при температурах 100–200 К носит линейный характер, что свидетельствует о преимущественном механизме рассеяния на межзеренных границах. В этой области температур подвижность более чем на порядок меньше, чем расчетные величины, из-за рассеяния носителей заряда на заряженных и нейтральных дефектах внутри кристаллитов. Также необходимо учитывать дополнительное рассеяние на дефектных комплексах и усиление компенсации.
С ростом температуры селенизации и с увеличением толщины селенизируемого интерметаллического слоя холловская подвижность растет. Это обусловлено улучшением кристалличности формируемых слоев и, как следствие, уменьшением влияния границ зерен на общий механизм рассеяния. Уменьшение подвижности, наблюдаемое при температурах выше 220 К, обусловлено ростом вклада рассеяния на тепловых колебаниях решетки.
ЗАКЛЮЧЕНИЕ
Выполненные исследования показали, что в результате селенизации слоев CIG двухэтапным методом в двухзонной термодиффузионной установке формируются поликристаллические пленки CIGS со структурой халькопирита. С целью достижения в синтезируемых пленках CIGS электрофизических свойств, приемлемых для их использования в качестве активного фоточувствительного слоя преобразователей солнечного излучения, проведена оптимизация процесса получения пленок по температуре селенизации и толщине исходного селенизируемого интерметаллического слоя.
Исследование температурных зависимостей удельной электропроводности и холловской подвижности выявило две температурные области, характеризующиеся различной энергией активации проводимости. Предложен механизм влияния микроструктуры пленок CIGS на механизмы токопереноса.
Список литературы
Schock H.-W., Noufi R. // Progress in Photovoltaics: Research and Applications. 2000. V. 8. № 1. P. 151.
Philip J., Dimitrios H., Roland W., Oliver K., Andreas B., Theresa M.F., Michael P. // Physica Stat Sol. RRL. 2015. V. 9. № 1. P. 28.
Chantana J., Minemoto T. // AAPPS Bull. 2017. V. 27. № 2. P. 7.
Новиков Г.Ф., Гапанович М.В. // Успехи физических наук. 2017. Т. 187. № 2. С. 173.
Kim G.Y., Jo W., Jo H.-J., Kim D.-H., Kang J.-K. // Current Appl. Phys. 2015. V. 15. S. 2. P. S44.
Monsefi M., Kuo D. // J. Electronic Mater. 2014. V. 43. № 4. P. 1214.
Zhang X., Manno M., Baruth A., Johnson M., Aydil E.S., Leighton C. // ACS Nano. 2013. V. 7. № 3. P. 2781.
Huh R., Ahn H., Um Y. // New Physics: Sae Mulli. 2015. V. 65. № 8. P. 735.
Алиев М.А., Каллаев С.Н., Гаджиев Т.М., Гаджиева Р.М., Исмаилов А.М., Билалов Б.А. // Письма в ЖТФ. 2016. Т. 42. № 14. С. 1.
Гаджиев Т.М., Алиев М.А., Асваров А.Ш., Гаджиева Р.М., Билалов Б.А., Исмаилов А.М., Шомахов З.В. // Изв. вузов. Электроника. Т. 24. № 2. С. 107.
Skipetrov E.P., Zvereva E.A., Skipetrova L.A., Belousov V.V., Mousalitin A.M. // J. Cryst. Growth. 2000. V. 210. P. 292.
Колосов С.А., Клевков Ю.В., Плотников А.Ф. // Физика и техника полупроводников. 2004. Т. 38. № 3. С. 305.
Friedrich E.J., Fernández-Ruiz R., Merino J.M., León M. // Powder Diffraction. 2010. V. 25. № 3. P. 253.
Zhang S.B., Wei S.-H., Zunger A. // Phys. Rev. B. 1998. V. 57. № 16. P. 9642.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


