Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 2, стр. 82-88
Роль подрешетки углерода в компенсации проводимости n-SiС
В. В. Козловский 1, *, А. Э. Васильев 1, **, К. С. Давыдовская 2, ***, А. А. Лебедев 2, ****
1 Санкт-Петербургский государственный политехнический университет,
195251 Санкт-Петербург,, Россия
2 Физико-технический институт им. А.Ф. Иоффе РАН,
194021 Санкт-Петербург, Россия
* E-mail: kozlovski@tuexph.stu.neva.ru
** E-mail: electronych@mail.ru
*** E-mail: Davidovskaya.Klava@mail.ioffe.ru
**** E-mail: shura.lebe@mail.ioffe.ru
Поступила в редакцию 14.01.2018
После доработки 14.01.2018
Принята к публикации 14.01.2018
Аннотация
Проанализировано образование радиационных дефектов в подрешетке углерода карбида кремния при облучении протонами с энергией 15 МэВ и электронами с энергией 0.9 МэВ. Проведено численное моделирование, и получены гистограммы распределения энергии, передаваемой атомам отдачи углерода. При анализе гистограмм рассмотрены две области значений энергии. В области малых энергий создаются одиночные изолированные пары Френкеля с близко расположенными компонентами. В другой области энергия атомов отдачи достаточна для возникновения каскада смещений. С повышением энергии первично выбитых атомов увеличивается среднее расстояние между генетически родственными парами Френкеля, и, как следствие, увеличивается доля не рекомбинировавших при облучении пар. Выполнены оценки радиуса рекомбинации пары Френкеля в подрешетке углерода.
ВВЕДЕНИЕ
Известно, что облучение широкозонных полупроводников, в частности карбида кремния, приводит к уменьшению концентрации носителей заряда, вплоть до полной компенсации проводимости материла [1–4]. В [5–7] с помощью низкоэнергетического (до 200 кэВ) электронного облучения было показано, что основные радиационные дефекты, обусловливающие компенсацию проводимости n-SiC, полученного в процессе химического осаждения из газовой фазы (так называемые Z1/Z2- и EH6/7-дефекты), связаны с компонентами пары Френкеля (вакансия и межузельный атом) только в одной из подрешеток SiC, а именно в углеродной. В [8] аналогичные предположения были сделаны для объяснения результатов влияния протонного облучения на компенсацию проводимости n-SiC.
В настоящей работе для выявления количественной стороны приведенных выше предположений проведено моделирование процессов торможения электронов и протонов с энергией несколько МэВ в карбиде кремния. Главное отличие воздействия электронов от протонов заключается в структуре первично выбитых атомов (ПВА) и “первичных” пар Френкеля. Электроны передают атомам решетки малую энергию и могут создать лишь единичные близко расположенные пары Френкеля. Протоны способны передать до трети начальной энергии и вызывать каскады столкновений с активным участием ПВА в образовании “вторичных” пар Френкеля. В этом случае расстояния между компонентами пар Френкеля могут быть значительными. Поэтому в настоящей работе будем разделять скорость введения первично выбитых атомов ηПВА и полную скорость введения пар Френкеля ηПФ, в частности вакансий.
МЕТОДИКА ЭКСПЕРИМЕНТА
Для численного моделирования торможения протонов в SiC использовали пакет программ SRIM [9], основанный на теоретических моделях, описанных в [10]. Очевидно, что столкновения протона с передачей малых порций энергии (ЕПВА) будут преобладающими. Это следствие обратно квадратичной зависимости от ЕПВА дифференциального сечения (dσ) в виде dσ ∝ dЕПВА/(ЕПВА)2. В задачу входило выяснить, какую долю составляют случаи передачи энергии, достаточной для развития каскада. С этой целью строили гистограмму распределения по энергии атомов отдачи углерода для энергии протонов 15 МэВ. Выбор энергии осуществляли исходя из возможности экспериментальной проверки проведенных расчетов. Кроме того, определяли количество вакансий в подрешетке углерода в расчете на один падающий протон. Для пороговой энергии смещения атома углерода из узла подрешетки (Ed) было взято сравнительно новое в литературе значение 18 эВ [5, 6].
Для удобства сравнения с электронным облучением в случае протонного облучения будем также частично использовать аналитические оценки, не прибегая к более точным, но менее наглядным численным вычислениям с помощью метода Монте-Карло. Для сравнения электронного и протонного воздействий важны значения средней (〈ЕПВА〉) и максимальной (Emax) энергии атомов отдачи. Атому решетки с массой M (массовым числом А) при упругом взаимодействии с релятивистским электроном с энергией Ее и массой m может быть передана энергия Е, величина которой лежит в пределах от нуля до максимальной:
(1)
$\begin{gathered} {{E}_{{{\text{max}}}}} = 2{{Е }_{е }}{{({{Е }_{е }} + {\text{ }}2{{m}_{е }}{{с }^{2}})} \mathord{\left/ {\vphantom {{({{Е }_{е }} + {\text{ }}2{{m}_{е }}{{с }^{2}})} {M{{с }^{2}}}}} \right. \kern-0em} {M{{с }^{2}}}} = \\ = {{Е }_{е }}{{({{Е }_{е }} + 1.022)} \mathord{\left/ {\vphantom {{({{Е }_{е }} + 1.022)} {(469А )}}} \right. \kern-0em} {(469А )}}{\text{ [М э В ]}}{\kern 1pt} . \\ \end{gathered} $С учетом обратной квадратичной зависимости для вычисления средней энергии, которую получают атомы полупроводника при столкновении с релятивистским электроном, применима формула, полученная для упругого резерфордовского рассеяния [11]:
(2)
$\left\langle {{{Е }_{{{\text{П В А }}}}}} \right\rangle = \left( {{{{{E}_{d}}{{E}_{{{\text{max}}}}}} \mathord{\left/ {\vphantom {{{{E}_{d}}{{E}_{{{\text{max}}}}}} {\left( {{{E}_{{{\text{max}}}}}--{{E}_{d}}} \right)}}} \right. \kern-0em} {\left( {{{E}_{{{\text{max}}}}}--{{E}_{d}}} \right)}}} \right){\text{ln}}\left( {{{{{E}_{{{\text{max}}}}}} \mathord{\left/ {\vphantom {{{{E}_{{{\text{max}}}}}} {{{E}_{d}}}}} \right. \kern-0em} {{{E}_{d}}}}} \right).$Для экспериментального наблюдения радиационных дефектов были использованы протоны с энергией 15 МэВ и электроны с энергией 0.9 МэВ. Облучение проводилось на циклотроне МГЦ-20 и ускорителе РТЭ-1В при комнатной температуре [12]. Дефекты вводили равномерно по объему образцов, поскольку их толщина была значительно меньше длины пробега бомбардирующих частиц. Концентрации нескомпенсированной донорной примеси (Nd–Na) в исходных и облученных образцах определяли из вольт-фарадных характеристик (C–U) на стандартной установке с параллельной схемой замещения и синусоидальной частотой 10 кГц при комнатной температуре. Скорость изменения концентрации рассчитывали по формуле:
(3)
${{\eta }_{е }} = {{({{N}_{0}}--N)} \mathord{\left/ {\vphantom {{({{N}_{0}}--N)} D}} \right. \kern-0em} D},$РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Электронное облучение. Рассмотрим процесс образования радиационных дефектов в карбиде кремния при облучении электронами с энергией несколько МэВ, особое внимание уделив дефектам в подрешетке углерода, которые, как указано выше, и формируют компенсирующие центры в n-SiC при электронном и протонном облучении. Скорость генерации ПВА ηПВA за счет взаимодействия с налетающим электроном вычисляется как произведение сечения σd на концентрацию атомов углерода NC:
При упругом резерфордовском рассеянии сечение дефектообразования для электронного облучения можно оценивать по упрощенной формуле Мак-Кинли–Фешбаха [14]:
(5)
$\begin{gathered} {{\sigma }_{d}} = {{({1 \mathord{\left/ {\vphantom {1 {4\pi {{\varepsilon }_{0}}}}} \right. \kern-0em} {4\pi {{\varepsilon }_{0}}}})}^{2}}({{2\pi {{Z}^{2}}{{e}^{4}}} \mathord{\left/ {\vphantom {{2\pi {{Z}^{2}}{{e}^{4}}} {{{E}_{d}}M{{c}^{2}}}}} \right. \kern-0em} {{{E}_{d}}M{{c}^{2}}}}) = \\ = ({{140{{Z}^{2}}} \mathord{\left/ {\vphantom {{140{{Z}^{2}}} {А {{E}_{d}}}}} \right. \kern-0em} {А {{E}_{d}}}}[{\text{э В }}]){\text{ [б а р н ]}}. \\ \end{gathered} $В настоящей работе, как указано выше, для Ed было принято значение 18 эВ. При такой пороговой энергии сечение образования радиационных дефектов составляет 23.3 барн и практически не зависит от энергии бомбардирующих электронов в диапазоне 1–10 МэВ.
По формулам (1) и (2) были оценены Emax = 307 эВ и 〈ЕПВА〉 = 54 эВ. Такое малое значение 〈ЕПВА〉 свидетельствует о том, что при электронном облучении образуются одиночные изолированные пары Френкеля. Используя для концентрации атомов углерода значение NC = 4.8 × 1022 см–3, можно получить по формуле (4) расчетное значение скорости генерации ПВА: ηПВA = 1.1 см–1. С ростом энергии бомбардирующих электронов первично выбитый атом способен сам выбивать атом решетки: увеличивается среднее число смещенных атомов ν, приходящихся на каждый ПВА. Коэффициенты размножения ν оценивают по формуле Кинчина–Пиза [15], модифицированной Зиглером [10]:
(6)
$\nu = {{\left\langle {{{Е }_{{{\text{П В А }}}}}} \right\rangle } \mathord{\left/ {\vphantom {{\left\langle {{{Е }_{{{\text{П В А }}}}}} \right\rangle } {2.5{{Е }_{d}}}}} \right. \kern-0em} {2.5{{Е }_{d}}}}.$Из формул (2) и (5) видно, что с ростом энергии электронов сечение образования дефектов не меняется, однако растет 〈ЕПВА〉 и, следовательно, ν. В табл. 1 приведены зависимости основных энергетических параметров атомов отдачи углерода и темпа генерации пар Френкеля в подрешетке углерода от энергии бомбардирующих частиц. Так, для электронов с энергией 0.9 МэВ коэффициент размножения равен 1.2, и полная скорость образования пар Френкеля ηПФ, рассчитываемая по формуле
составляет 1.3 см–1. Отметим, что при таком облучении из полного числа пар Френкеля 85% образуются при первичных столкновениях (при взаимодействии атома углерода с налетающим электроном), и 15% – при вторичных столкновениях (при взаимодействии атома углерода с ПВА).Таблица 1.
Зависимость основных энергетических параметров атомов отдачи углерода и характеристик пар Френкеля в подрешетке углерода от энергии бомбардирующих электронов Ее и протонов Еp
| Ее, МэВ | Emax, эВ | 〈ЕПВА〉, эВ | σd, барн | ηПВA, см–1 | ν | ηПФ, см–1 |
|---|---|---|---|---|---|---|
| 0.9 | 307 | 54 | 23.3 | 1.1 | 1.20 | 1.3 |
| 1.0 | 359 | 57 | 23.3 | 1.1 | 1.26 | 1.4 |
| 2.0 | 1074 | 73 | 23.3 | 1.1 | 1.62 | 1.8 |
| 8 | 2270 | 212 | 1350 | 65 | 4.7 | 305 |
| 15 | 4260 | 223 | 720 | 35 | 5.0 | 173 |
Сравним полученные расчетные значения параметров ηПВA и ηПФ с данными эксперимента. На рис. 1 представлена зависимость концентрации (Nd–Na) от дозы облучения. Расчет скорости изменения концентрации по формуле (3) для энергии 0.9 МэВ позволил получить значение ηе ~ 0.1 см–1. Скорость удаления доноров в n-SiС на начальных стадиях облучения может служить мерой образования в подрешетке углерода “далеких” пар Френкеля, т.е. разделившихся на изолированные вакансии и межузельные атомы. При облучении электронами с энергией 0.9 МэВ скорость удаления доноров 0.1 см–1 (рис. 2), а темп генерации ПВА в подрешетке углерода 1.1 см–1, поэтому доля разделившихся (диссоциировавших) первичных пар Френкеля составляет 9%. Оценим характерную энергию ПВА углерода (Ech), при которой в высокоэнергетической части спектра оказывается 9% ПВА. На рис. 2 схематически представлен энергетический спектр ПВА (плотность распределения ПВА углерода по переданной им энергии) после облучения карбида кремния электронами с энергий 0.9 МэВ. Левой границей спектра является величина Ed (18 эВ), правой границей – величина Emax (307 эВ). При обратной квадратичной зависимости плотности распределения ПВА легко оценить их долю в правой части спектра (долю разделившихся первичных пар Френкеля):
(8)
$\begin{gathered} {{f}_{{{\text{П Ф }}}}} = {{{{\eta }_{е }}} \mathord{\left/ {\vphantom {{{{\eta }_{е }}} {{{\eta }_{{{\text{П В A}}}}}}}} \right. \kern-0em} {{{\eta }_{{{\text{П В A}}}}}}} = \\ = {{({1 \mathord{\left/ {\vphantom {1 {{{E}_{{{\text{ch}}}}}}}} \right. \kern-0em} {{{E}_{{{\text{ch}}}}}}}--{1 \mathord{\left/ {\vphantom {1 {{{E}_{{{\text{max}}}}}}}} \right. \kern-0em} {{{E}_{{{\text{max}}}}}}})} \mathord{\left/ {\vphantom {{({1 \mathord{\left/ {\vphantom {1 {{{E}_{{{\text{ch}}}}}}}} \right. \kern-0em} {{{E}_{{{\text{ch}}}}}}}--{1 \mathord{\left/ {\vphantom {1 {{{E}_{{{\text{max}}}}}}}} \right. \kern-0em} {{{E}_{{{\text{max}}}}}}})} {\left( {{1 \mathord{\left/ {\vphantom {1 {{{E}_{d}}}}} \right. \kern-0em} {{{E}_{d}}}}--{1 \mathord{\left/ {\vphantom {1 {{{E}_{{{\text{max}}}}}}}} \right. \kern-0em} {{{E}_{{{\text{max}}}}}}}} \right)}}} \right. \kern-0em} {\left( {{1 \mathord{\left/ {\vphantom {1 {{{E}_{d}}}}} \right. \kern-0em} {{{E}_{d}}}}--{1 \mathord{\left/ {\vphantom {1 {{{E}_{{{\text{max}}}}}}}} \right. \kern-0em} {{{E}_{{{\text{max}}}}}}}} \right)}}. \\ \end{gathered} $Рис. 1.
Зависимость концентрации нескомпенсированных доноров от дозы электронного (Е = 0.9 МэВ) облучения. Приведены данные для трех идентичных образцов.
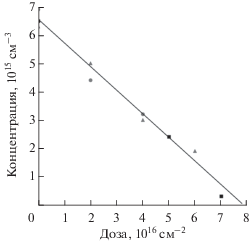
Рис. 2.
Схематическое изображение плотности распределения ПВА углерода по переданной им энергии в случае облучения образцов SiC толщиной 50 мкм электронами с энергией 0.9 МэВ (1) и протонами с энергией 15 МэВ (2). Цифры на схеме обозначают количество ПВА, попавших в данный энергетический интервал. Расчет по программе SRIM [9].
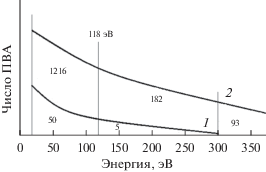
В этих условиях величина характерной энергии Ech составляет 118 эВ. Атомы отдачи углерода, получившие энергию 118 эВ и выше, будут покидать зону спонтанной рекомбинации, обеспечивая формирование стабильных радиационных дефектов, приводящих к компенсации проводимости n-SiC. На рис. 2 показана граничная энергия, которая разделяет энергетический спектр ПВА на две неравные части. Используя результаты расчетов по программе SRIM, легко оценить пробег ионов углерода с энергией 118 эВ в SiC. Этой энергии соответствует пробег ~9 Å, который можно приписать и радиусу рекомбинации. Поскольку расстояние между ближайшими атомами углерода в 4Н-SiC составляет а0 ~ 1.85 Å [16], то радиус рекомбинации ~5а0. Отметим, что при небольшом количестве пар Френеля, образованных в каскаде, переданная энергия меньше 118 эВ. Поэтому такие пары практически полностью рекомбинируют. Интересно сравнить полученное значение радиуса рекомбинации пар Френеля в подрешетке углерода SiC с литературными данными. В [17–19] указывается, что в кремнии (n-Si) при электронном облучении диссоциирует только 5% первичных пар Френеля, поэтому радиус рекомбинации оценивается величиной ~20 Å.
Приведем пример пленки карбида кремния толщиной 50 мкм, на которую упали 10 тыс. электронов с энергией 0.9 МэВ. Число ПВА, или число первичных пар Френкеля, составит 55 шт. Число “вторичных” пар Френеля, созданных ПВА, составит 11 шт. Из общего количества (66 шт.) только 5.5 пар Френеля диссоциирует на вакансию и межузельный атом. На рис. 2 схематично представлены полученные данные в случае электронного облучения (нижняя кривая). Именно эти компоненты разделенных пар Френеля и приводят к образованию Z1/Z2- и EH6/7-дефектов и к изменению электрофизических свойств материала (в частности, электропроводимости), измеряемых в эксперименте.
Протонное облучение. При таком облучении максимальная энергия, переданная атому углерода протоном, оценивается по формуле [11]:
(9)
${{E}_{{{\text{max}}}}} = {{4{{m}_{p}}M{{E}_{p}}} \mathord{\left/ {\vphantom {{4{{m}_{p}}M{{E}_{p}}} {{{{({{m}_{p}} + M)}}^{2}}}}} \right. \kern-0em} {{{{({{m}_{p}} + M)}}^{2}}}} = {{4A{{E}_{p}}} \mathord{\left/ {\vphantom {{4A{{E}_{p}}} {{{{(1 + A)}}^{2}}}}} \right. \kern-0em} {{{{(1 + A)}}^{2}}}}$(10)
$\left\langle {{{Е }_{{{\text{П В А }}}}}} \right\rangle = {{E}_{d}}{\text{ln}}({{{{E}_{{{\text{max}}}}}} \mathord{\left/ {\vphantom {{{{E}_{{{\text{max}}}}}} {{{E}_{d}}}}} \right. \kern-0em} {{{E}_{d}}}}),$Согласно этой формуле для изучаемой в настоящей работе пары протон–атом углерода, величина 〈ЕПВА〉 составляет 223 эВ. Сечение дефектообразования при протонном облучении можно оценивать по упрощенной формуле [11]:
(11)
$\begin{gathered} {{\sigma }_{d}} = {{({1 \mathord{\left/ {\vphantom {1 4}} \right. \kern-0em} 4}\pi {{\varepsilon }_{0}})}^{2}}\pi ({{{{Z}^{2}}{{e}^{4}}{{m}_{p}}} \mathord{\left/ {\vphantom {{{{Z}^{2}}{{e}^{4}}{{m}_{p}}} {M{{Е }_{p}}{{Е }_{d}}}}} \right. \kern-0em} {M{{Е }_{p}}{{Е }_{d}}}}) = \\ = {{2.6 \times {{{10}}^{{11}}}{{Z}^{2}}} \mathord{\left/ {\vphantom {{2.6 \times {{{10}}^{{11}}}{{Z}^{2}}} {({{4A{{Е }_{p}}} \mathord{\left/ {\vphantom {{4A{{Е }_{p}}} {[{\text{э В }}]}}} \right. \kern-0em} {[{\text{э В }}]}}{{Е }_{d}}[{\text{э В }}])}}} \right. \kern-0em} {({{4A{{Е }_{p}}} \mathord{\left/ {\vphantom {{4A{{Е }_{p}}} {[{\text{э В }}]}}} \right. \kern-0em} {[{\text{э В }}]}}{{Е }_{d}}[{\text{э В }}])}}\,\,[{\text{б а р н }}]. \\ \end{gathered} $Расчеты по этой формуле в рассматриваемом случае дают величину σd, равную 720 барн. То есть величину, в 30 раз большую, чем при электронном облучении. Очевидно, что в 30 раз отличаются и скорости образования первично выбитых атомов (ηПВA). Однако полные скорости образования пар Френкеля ηПФ отличаются в 130 раз за счет высоких значений коэффициентов размножения при протонном облучении. Полные значения параметров, полученные аналитическим методом для протонного облучения, представлены в табл. 1.
Основной задачей численных расчетов являлось построение и анализ гистограммы распределения по энергии атомов отдачи углерода. Анализ проводился при статистике 10 тыс. упавших на пленку протонов. Толщину пленки принимали равной 50 мкм в соответствии с используемыми в эксперименте образцами. На рис. 3 представлен энергетический спектр атомов отдачи углерода после рассеяния на них протонов с энергией 15 МэВ. Зафиксированы столкновения, приведшие к возникновению вакансий, т.е. передачи малых (по сравнению с порогом смещения атома) энергий не учитываются. Суммарное число столкновений составило 1491, что достаточно для выяснения общей конфигурации спектра. Поясним, что наблюдавшиеся в ходе моделирования акты с передачей энергии большими порциями (до десятков кэВ) в поле рис. 3 не попадают и обсуждаются ниже. Расчет показал, что плотность распределения ПВА по сообщенной им энергии близка к теоретической резерфордовской вида (ЕПВА)–2, но спадает несколько слабее в области высоких ЕПВА. При использовании рассчитанного по SRIM количества столкновений (1491 шт.), приведших к образованию ПВА в пленке известной толщины (50 мкм), была оценена скорость введения ПВА ηПВA. Она составила 30 см–1, что совпадает со значением 35 см–1, полученным аналитическими методами (табл. 1).
Рис. 3.
Основная часть энергетической гистограммы первично выбитых атомов углерода протонами с энергией 15 МэВ, полученная из расчетов по программе SRIM [9] в случае облучения образцов SiC толщиной 50 мкм. На вставке – условное разделение гистограммы на высокоэнергетическую область “жестких” столкновений и низкоэнергетическую область “мягких” столкновений.

При обработке гистограммы (рис. 3) был использован метод, предложенный в [20, 21]: гистограмма разделяется на случаи “мягких” и “жестких” столкновений. Границей раздела принята энергия ПВА, равная 118 эВ. Выбор границы, как указано выше, обусловлен пробегом, равным радиусу рекомбинации пар Френкеля. Таким образом, все отличие протонного облучения от электронного связано с правой областью энергетического спектра ПВА – областью “жестких” столкновений.
Из 1491 столкновений, приводящих к образованию первичных вакансий около 1216 (80% от общего числа) находятся в области “мягких” столкновений. В этих актах “мягких” столкновений, подобных рассеянию релятивистских электронов, рождается 1216 изолированных пар Френкеля. Для наглядности в табл. 2 приведены суммарные и средние энергии, переданные протонами атомам углерода при первичных столкновениях. Из табл. 2 видно, что при “мягких” столкновениях рассеивается суммарная энергия 52.7 кэВ. Эта энергия образует 1216 ПВА со средней энергией 43.3 эВ.
Таблица 2.
Энергия, переданная протонами с энергией 15 МэВ атомам углерода в пленке карбида кремния толщиной 50 мкм при первичных столкновениях
| Столкновения | Число ПВА | Полная энергия, кэВ | Средняя энергия ПВА, эВ |
|---|---|---|---|
| “Мягкие” (118 эВ и менее) | 1216 | 52.7 | 43.3 |
| “Жесткие” (более 118 эВ) | 275 | 192.4 | 699.5 |
В правой части спектра (“жесткие” столкновения), как показывают расчеты, рассеивается энергия 192.4 кэВ; образуется 275 результативных столкновений с образованием ПВА. Средняя энергия ПВА углерода при “жестких” столкновениях составляет 700 эВ. Для простоты всем столкновениям с передачей больше 118 эВ припишем согласно табл. 2 энергию 700 эВ. Атом углерода с энергией ~700 эВ имеет пробег в карбиде кремния 2.7 нм. И на своем пути он создает в каскаде около 14 вакансий, примерно поровну в обеих подрешетках. Это означает, что на вакансию во вторичных процессах образования ПВА расходуется 50 эВ. Суммарная энергия атомов отдачи при жестких столкновениях 192.4 кэВ обусловит появление 3847 атомов отдачи в обеих подрешетках, примерно поровну. Будем считать, что половина из них, 1923 шт., образована в подрешетке углерода. Предположим по максимуму, что все образованные в каскаде пары Френкеля диссоциируют на компоненты [22]. При учете толщины пленки SiC (50 мкм), для которой проведен SRIM-расчет, была оценена скорость введения атомов отдачи углерода (или вакансий), которая составила 38 см–1. Именно эти компоненты разделенных пар Френкеля должны приводить к образованию Z1/Z2- и EH6/7-дефектов и к изменению электропроводимости SiC. Сравним эти цифры с экспериментом.
На рис. 4 представлена зависимость концентрации (Nd–Na) от дозы облучения. Расчет скорости изменения концентрации по формуле (3) для энергии протонов 15 МэВ позволил получить значение ηе ~ 50 см–1. Полученное экспериментальное значение ηе почти на 25% превышает предельное расчетное значение ηПВA. Предположим, что в отличие от вакансий, рожденных в актах “мягких” столкновениях, подобных рассеянию электронов, вакансии, рожденные при “жестких” столкновениях уже не являются компонентами одиночных пар Френкеля. Они сосредоточены в микроскопически малом объеме, который охватывает порождающий их атом отдачи углерода с энергией 0.7 кэВ. В качестве грубой оценки объем можно определить как R3, где R = = 27 Å – пробег таких атомов. Плотность вакансий (или пар Френкеля) в этом случае по порядку величины близка к 1021 см–3. Появление таких областей – принципиальное различие в воздействии протонов и электронов. В областях c высокой плотностью вакансий возрастает вероятность образования комплексов с участием вакансий. Наиболее вероятным результатом являются комплексы с примесными атомами [23, 24]. Образование комплекса вакансия–донор, имеющего глубокий акцепторный уровень (по аналогии с известным Е-центром в кремнии [25]), может привести к двойному превышению ηПВA над ηе. При таких допущениях сходимость экспериментальных и расчетных результатов наблюдается при 20%-ном “уходе” общего числа созданных вакансий углерода на образование комплексов.
ЗАКЛЮЧЕНИЕ
Проведенные в работе аналитические расчеты показали, что результаты экспериментальной компенсации проводимости n-SiC, облученного электронами с энергией 0.9 МэВ, хорошо объясняются только генерацией точечных радиационных дефектов – пар Френкеля в подрешетке углерода. При этом виде облучения всего 9% первичных пар Френкеля избегают рекомбинации и разделяются на отдельные компоненты, входящие в состав известных Z1/Z2- и EH6/7-дефектов и к изменению электрофизических свойств материала (в частности, электропроводимости), измеряемых в эксперименте. Радиус рекомбинации пар Френкеля в подрешетке углерода по оценкам составляет ~9 Å, а энергия ПВА углерода, необходимая для получения пробега 9 Å, – 118 эВ.
Численное моделирование, проведенное в работе для протонного облучения, позволяет получить набор количественных данных и корректно учесть геометрию образца. При обработке гистограмм передаваемой атомам отдачи углерода энергии оказалось достаточно одного шага – разделения случаев передачи до 118 эВ (“мягкие” столкновения) и выше (“жесткие” столкновения).
Выяснилось, что из 1491 актов рассеяния протона с энергией 15 МэВ на атомах С с рождением в пленке вакансий только 1216 оказываются близкими по передаваемой энергии к рассеянию электронов (“мягкие” столкновения со средней передачей энергии 43 эВ). В остальных 275 актах “жестких” столкновений передается суммарная энергия, достаточная для возникновения в каскадах 1923 вакансий. Они сосредоточены в микрообластях размером ~27 Å, хаотично распределенных по объему пленки. Эти области могут являться источниками комплексов вакансий с атомами донорных примесей. Удовлетворительное совпадение экспериментальных и расчетных результатов в случае облучения n-SiC протонами с энергией 15 МэВ наблюдается при 20%-ном “уходе” общего количества созданных вакансий углерода на образование комплексов.
Список литературы
Iwamoto N., Svensson B.G. // Defects in Semiconductors / Ed. Romano L. et al. (Ser. Semiconductors and Semimetals. Vol. 91). Elsevier, 2015. P. 369.
Козловский В.В., Васильев А.Э., Лебедев А.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 3. С. 22. doi 10.7868/S0207352815030129 (Kozlovski V.V., Vasil’ev A.E., Lebedev A.A. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2015. V. 9. № 2. P. 231. doi 10.1134/S1027451015020123
Козловский В.В., Васильев А.Э., Емцев В.В., Лебедев А.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2014. № 9. С. 101. doi 10.7868/S0207352814090108 (Kozlovski V.V., Vasil’ev A.E., Emtsev V.V., Lebedev A.A. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2014. V. 8. № 2. P. 950. doi 10.1134/S1027451014050103
Emtsev V.V., Davydov V.Yu., Goncharuk I.N. et al. // Mater. Sci. Forum. 1997. V. 258–263. P. 1143.
Steeds J.W., Carosella F., Evans G.A. et al. // Mater. Sci. Forum. 2001. V. 353. P. 381.
Steeds J.W., Evans G.A., Furkert S. et al. // Diamond Related Mater. 2002. V. 11. P. 1923.
Kaneko H., Kimoto T. // Appl. Phys. Lett. 2011. V. 98. P. 262106.
Castaldini A., Cavallini A., Rigutti L. // Semicond. Sci. Technol. 2006. V. 21. № 3. P. 724.
http://www.srim.org.
Ziegler J.F., Biersack J.P., Littmark U. The Stopping and Range of Ions in Solids. N.Y.: Pergamon, 1985. 342 p.
Dienes G.J., Vineyard G.H. // Radiation Effects in Solids. N.Y.: Interscience Publishers, 1957. P. 12.
Zakharenkov L.F., Kozlovski V.V., Shustrov B.A. // Phys. Stat. Sol. A. 1990. V. 117. № 1. P. 85. doi 10.1002/ pssa.2211170107
http://cree.com/.
MacKinley W.A., Feshbach H. // Phys. Rev. 1948. V. 74. P. 1759.
Kinchin G.H., Pease R.S. // Rep. Prog. Phys. 1955. V. 18. P. 1.
Levinshtein M.E., Rumyantsev S.L., Shur M.S. Properties of Advanced Semiconductor Materials: GaN, AlN, InN, BN, SiC, SiGe. N.Y.: John Wiley & Sons Inc., 2001. 216 p.
Strel’chuk A.M., Kozlovski V.V., Savkina N.S. et al. // Mater. Sci. Engin. B. 1999. V. 61–62. P. 441. doi 10.1016/S0921-5107(98)00551-0
Emtsev V.V., Ivanov A.M., Kozlovski V.V. et al. // Semiconductors. 2012. V. 46. P. 456. doi 10.1134/ S1063782612040069
Claeys C., Simoen E. Radiation Effects in Advanced Semiconductor Materials and Devices. Berlin: Springer–Verlag, 2002. 401 p.
Strokan N.B., Ivanov A.M., Savkina N.S. et al. // Semiconductors. 2004. V. 38. P. 807. doi 10.1134/1.1777605
Lebedev A.A., Veinger A.I., Davydov D.V. et al. // Semiconductors. 2000. V. 34. № 8. P. 861. doi 10.1134/ 1.1188089
Kozlovski V.V., Emtsev V.V., Emtsev K.V. et al. // Semiconductors. 2008. V. 42. № 2. P. 242. doi 10.1134/ S1063782608020231
Holmes-Siedle A., Adams L. // Handbook of Radiation Effects. Oxford: Oxford University, 1993. P. 44.
Van Lint V.A.J. Mechanisms of Radiation Effects in Electronic Materials. N.Y.: John Wiley & Sons Inc.,1980. 359 p.
Radiation Defect Engineering. Selected Topics in Electronics and Systems. Vol. 37. / Ed. Kozlovski V., Abrosimova V. Singapore: World Scientific Publ., 2005, 264 p.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования