Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 4, стр. 65-73
Ионно-трековая модификация пленки диоксида кремния, имплантированной цинком и отожженной в атмосфере кислорода
В. В. Привезенцев 1, 2, *, А. Н. Палагушкин 2, В. А. Скуратов 3, В. С. Куликаускас 4, В. В. Затекин 4, А. В. Макунин 4, Д. А. Киселев 5, Э. А. Штейнман 6, А. Н. Терещенко 6
1 Физико-технологический институт РАН
117218 Москва, Россия
2 Научно-исследовательский институт системных исследований РАН
117218 Москва, Россия
3 Объединенный институт ядерных исследований
141980 Московская область, Дубна, Россия
4 Московский государственный университет им. М.В. Ломоносова, НИИ ядерной физики
им. Д.В. Скобельцына
119991 Москва, Россия
5 Национальный исследовательский университет науки и технологии “МИСиС”
119049 Москва, Россия
6 Институт физики твердого тела РАН
142432 Московская область, Черноголовка, Россия
* E-mail: privezentsev@mail.ru
Поступила в редакцию 28.06.2018
После доработки 25.07.2018
Принята к публикации 21.07.2018
Аннотация
Исследовано формирование фазы оксида цинка в пленке SiO2 на подложках из кремния n-типа с ориентацией (100), выращенного методом Чохральского, путем имплантации ионов 64Zn+ с энергией 50 кэВ и дозой 5 × 1016 см–2 при комнатной температуре и последующей термообработки в атмосфере кислорода при повышенных температурах. Топология поверхности исследована методами растровой электронной и атомно-силовой микроскопии. Оптические свойства изучены методом фотолюминесцентной спектроскопии при 10 К и в ходе измерений спектров отражения света. После имплантации Zn в подповерхностном слое пленки SiO2 обнаружена фаза ZnO. После низкотемпературного отжига в диапазоне 400–600°С в объеме пленки и на ее поверхности выявлены преципитаты с поперечным размером 20–50 нм, содержащие Zn. После отжига при температурах 700–800°С в подповерхностном слое образуются Zn-содержащие преципитаты состава Zn · ZnO, а после отжига при температурах 900–1000°С – фаза состава ZnO · Zn2SiO4. Образцы, полученные при оптимальной для формирования фазы ZnO температуре отжига (около 700°С), были облучены быстрыми ионами 132Xe26+ с энергией 167 МэВ. Обнаружено, что после облучения дозой 2 × 1013 см–2 фаза ZnO пропадает и формируется большое количество радиационных дефектов, дающих характерную полосу люминесценции. С ростом флуенса облучения Хе до 5 × 1014 см–2 интенсивность этой полосы возрастает.
ВВЕДЕНИЕ
В последнее время широко исследуются свойства наночастиц металлов и их оксидов в различных пропускающих свет диэлектрических матрицах, поскольку такие наноструктурированные материалы по своим свойствам сильно отличаются от аналогичных по составу объемных материалов и могут быть использованы в перспективных устройствах опто-, нано- и микроэлектроники [1]. Для формирования таких наночастиц больше всего подходит метод ионного легирования, поскольку он обладает важными особенностями: чистотой материалов на уровне 99.999% за счет масс-сепарирования, возможностью выбора имплантируемого элемента и дозы внедрения и другими преимуществами. Главное же достоинство этого метода заключается в том, что с его помощью можно получать концентрации имплантированных примесей металлов гораздо выше предела их равновесной растворимости в подложке. В этом методе термическая обработка используется не только для отжига радиационных дефектов, но и для зарождения и роста металлических и металооксидных наночастиц [2]. Поэтому исследования диэлектрических пленок, легированных примесями металлов, в частности, цинком, становятся очень важными и проводятся достаточно интенсивно [3–5].
Среди металлооксидных материалов следует отметить оксид цинка, поскольку ZnO является прямозонным материалом с шириной запрещенной зоны 3.37 эВ и имеет большую энергию связи электрона и дырки в экситоне 60 мэВ, которая позволяет получать УФ-излучение с длиной волны λ = 390 нм при температурах до 350°С. Поэтому матрицы с наночастицами ZnO смогут найти широкое применение в таких современных оптоэлектронных устройствах, как УФ-лазеры и светодиоды [6], и электролюминесцентных дисплеях [7]. Перспективно их применение в солнечных элементах [8], а также в сенсорных газовых устройствах [9]. В последнее время после открытия явления ферромагнетизма при комнатной температуре в структурированных пленках оксида цинка встал вопрос о возможном применении такого материала в устройствах спинтроники [10]. В настоящее время обсуждается вопрос о возможности применения пленок оксида цинка или преципитатов ZnO в полимерных матрицах для создания устройств энергонезависимой памяти [11].
Наночастицы оксида цинка в пленке SiO2 могут быть сформированы в процессе термообработки в окислительной атмосфере преципитатов цинка, предварительно созданных в пленке оксида кремния при легировании ионами Zn [12–14]. Как было отмечено выше, при внедрении ионов цинка можно получать исключительно большие концентрации этого элемента в пленке оксида кремния (вплоть до 25 ат. %) [15].
В настоящей работе исследованы условия формирования наночастиц оксида цинка в пленке SiО2, термически выращенной на подложке кремния n-типа с ориентацией (100), полученного методом Чохральского.
ОБРАЗЦЫ И МЕТОДИКА ЭКСПЕРИМЕНТА
Вначале на подложке из кремния n-типа с ориентацией (100), выращенного методом Чохральского, в атмосфере сухого кислорода при температуре 700°С получили пленку SiO2 толщиной 0.2 мкм. Затем проводили имплантацию ионов 64Zn+ с энергией 50 кэВ и дозой 5 × 1016 см–2 при комнатной температуре. Ионный ток поддерживали на уровне 0.55 мкА/см2, чтобы предотвратить значительный перегрев подложки по сравнению с комнатной температурой (перегрев не превышал 50°С). Далее проводили изохронный отжиг в течение 1 ч в потоке кислорода в кварцевой трубе при температурах от 400 до 1000°С с шагом 100°С.
После отжига при оптимальной для получения фазы ZnO температуре (около 700°С) образцы были облучены под углом 45° к поверхности пленки SiO2 быстрыми ионами 132Xe26+ с энергией 167 МэВ в диапазоне флуенсов (1 × 1012)–(5 × 1014) см–2. Облучение проводилось на циклотроне ИЦ-100 Лаборатории ядерных реакций ОИЯИ. Однородное, с точностью до 5%, распределение частиц по поверхности мишени достигалось за счет сканирования пучка в вертикальном и горизонтальном направлениях. Плотность потока ионов составляла 2 × 109 (см2 · с)–1. Температура образцов в процессе облучения не превышала 30°С.
Топографию поверхности образцов исследовали методом растровой электронной микроскопии (РЭМ) с помощью микроскопа TESCAN LYRA3 в режимах детектирования вторичной эмиссии электронов (топологический контраст) и обратного рассеяния электронов (Z-контраст). Микроскоп был оснащен приставкой для энергодисперсионной спектроскопии.
Поверхность образцов также визуализировали с использованием сканирующего зондового атомно-силового микроскопа (АСМ) MFP-3D (Asylum Research) в полуконтактной моде, а также в Кельвин-моде с применением кантилевера марки NSG30/Pt (Tipsnano) с жесткостью 25 Н/м и резонансной частотой свободных колебаний 330 кГц. Обработку полученных изображений осуществляли по программе Gwyddion.
Спектры фотолюминесценции (ФЛ) снимали при температуре 10 К в диапазоне длин волн 350–620 нм с использованием накачки He–Cd-лазером с длиной волны 325 нм. Также исследовали спектры отражения в диапазоне длин волн 400–800 нм и спектры отражения света в том же диапазоне для двух взаимно перпендикулярных направлений поляризации падающего света.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Исследования поверхности в растровом электронном микроскопе. По данным РЭМ на поверхности образца после имплантации ионов Zn визуализируются отдельные частицы микрометровых размеров, представляющие собой углеводородные загрязнения, поскольку в их состав входят элементы более легкие, чем элементы матрицы Si и O, а также примесь Zn. Энергодисперсионный спектр поверхности вне наблюдаемых частиц состоит из линий, соответствующих элементам оксидной пленки Si и O, имплантата Zn, а также загрязнениям С. Результаты энергодисперсионного микроанализа поверхности представлены в табл. 1. Следует отметить, что загрязнение углеводородами связано с недостаточной очисткой атмосферы вакуумной камеры от паров масла, так как для откачки рабочей камеры используют масляный насос.
Таблица 1.
Данные энергодисперсионного анализа образца после имплантации ионов Zn
| Элемент | Концентрация, мас. % | Концентрация, ат. % |
|---|---|---|
| С | 27.93 | 43.17 |
| O | 18.56 | 21.53 |
| Si | 53.32 | 35.25 |
| Zn | 0.19 | 0.05 |
| Итого | 100.00 | 100.00 |
На рис. 1 представлено РЭМ-изображение поверхности пленки SiO2 после отжига в течение 1 ч в потоке О2 при температуре 700°С. На изображении поверхности пленки SiO2 (рис. 1а), полученном в режиме детектирования вторичной эмиссии электронов (топологический контраст), видна крупная яркая частица размером около 1 мкм. На рис. 1б изображение той же частицы получено в режиме детектирования обратно рассеянных электронов (Z-контраст). На данном изображении она более светлая по сравнению с окружающим фоном. Это свидетельствует о том, что в ее состав входят более тяжелые, чем Si и O, элементы. На рис. 2 представлен энергодисперсионный спектр этой частицы, из которого следует, что она состоит из нескольких элементов. Их концентрации приведены в табл. 2. Кроме элементов оксидной пленки Si и O и имплантата Zn также зафиксированы загрязнения С. Таким образом, становится ясно, что визуализированная частица содержит Zn. Исследование фона рядом с яркой частицей показало, что энергодисперсионный спектр с точностью до 0.1 ат. %. совпадает с данными табл. 2. Очевидно, что яркая частица на рис. 1 содержит Zn. Это могут быть как частицы самого цинка, так и его оксидных соединений типа ZnO или, что реже образуется при такой температуре отжига, Zn2SiO4. Возможно также, что частица представляет их смесь.
Рис. 1.
РЭМ-изображения поверхности образца после отжига при 700°С, полученные в режиме детектирования вторичной эмиссии (а) и обратно рассеянных электронов (б).

Рис. 2.
РЭМ-изображение частицы, полученное в режиме вторичной эмиссии электронов (а) и энергодисперсионный спектр (б) по квадрату, изображенному на рис. (а).

Таблица 2.
Данные энергодисперсионного анализа образца после отжига при температуре 700°С
| Элемент | Концентрация, мас. % | Концентрация, ат. % |
|---|---|---|
| С | 7.82 | 14.43 |
| O | 21.54 | 29.87 |
| Si | 70.42 | 55.62 |
| Zn | 0.22 | 0.08 |
| Итого | 100.00 | 100.00 |
На рис. 3 представлены два РЭМ-изображения поверхности после облучения быстрыми ионами Xe с флуенсом 5 × 1014 см–2. На рис. 3а (топологический контраст) видны светлые пятна размером около 1 мкм, представляющие собой небольшие углубления на поверхности пленки SiO2. Эти углубления, по всей видимости, связаны с радиационными эффектами, вызванными облучением быстрыми ионами Xe. Сопоставление пятен с изображением на рис. 3б показывает, что эти пятна имеют более светлый оттенок по сравнению с общим фоном, т.е. углубления заполнены более легкими, чем элементы матрицы Si и O, элементами. Скорее всего, это углеводородные загрязнения.
Рис. 3.
РЭМ-изображения поверхности образца после облучения ионами Xe с флуенсом 5 × 1014 см–2, полученные в режиме детектирования вторичной эмиссии (а) и обратно рассеянных электронов (б).
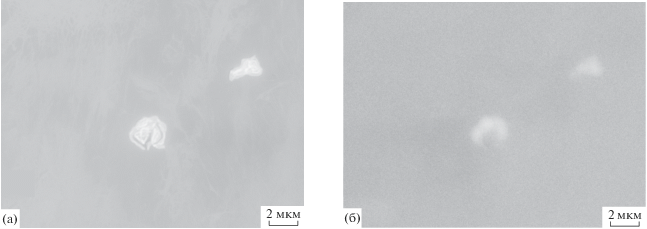
Анализ топологии поверхности в атомно-силовом микроскопе. На рис. 4а представлены 2D и 3D изображения поверхности кремния после имплантации Zn. Статистический анализ АСМ-изображений показал, что наибольшими параметрами шероховатости характеризуется исходный образец SiO2, имплантированный атомами Zn: Rms = 860, Ra = 680 пм. Для образца после отжига в атмосфере O2Rms = 155, Ra = 123 пм. И, наконец, наименьшие значения получены для образца, облученного ионами Xe: Rms = 127, Ra = 98 пм.
Рис. 4.
2D (слева) и 3D (справа) АСМ-изображения поверхности образца: а – после имплантации Zn; б – после отжига при 700°С в О2; в – после его облучения ионами Xe с флуенсом 5 × 1014 см–2.

Поверхность характеризуется следующими параметрами: среднее значение неоднородности составляет Ra = 680 пм; средняя шероховатость составляет Ra = 0.680 нм, а ее среднеквадратичное значение Rms = 860 пм. На рис. 4б представлены 2D и 3D изображения поверхности после отжига при 700°С. Поверхность характеризуется следующими параметрами: средняя шероховатость Ra = = 123 пм, ее среднеквадратичное значение Rms = = 155 пм. После облучения ионами Xe с флуенсом 5 × 1014 см–2 (рис. 4в) наблюдаются наименьшие значениями шероховатости: среднее значение Ra = 98 пм, а ее среднеквадратичное значение Rms = 127 пм. Следует отметить, что после имплантации поверхность представляется достаточно однородной. Однако после отжига при 700°С на ней формируются наночастицы с поперечным размером 20–50 нм и средней высотой около 1–5 нм. Такое структурирование поверхности можно связать с диффузией цинка к поверхности образца и образованием его скоплений в подповерхностном слое, в котором формируются преципитаты его оксидов или силицидов.
На рис. 5 представлено топографическое АСМ-изображение поверхности образца после отжига в атмосфере кислорода при 400°С и потенциал (Кельвин-мода). Как видно из сопоставления этих двух изображений, яркие пятна (бугорки) (рис. 5а) превращаются в области с меньшим отрицательным потенциалом (рис. 5б). Это свидетельствует о металлической природе этих бугорков. Как отмечено выше, цинк является быстро диффундирующей примесью, поэтому не исключена возможность его появления на поверхности пленки диоксида кремния за счет диффузии к поверхности, которая является для примесей неограниченным стоком. Положение еще более усугубляется, если рассматривать такой образец после отжига при 600°С. Обратная диффузия цинка из образца усиливается, и на поверхности уже видны крупные агломераты Zn-содержащих соединений (рис. 6а). На рис. 6б крупный Zn-содержащий агломерат в центре картины характеризуется меньшим значением потенциала. Следует отметить, что вокруг этого агломерата наблюдается увеличение потенциала.
Размер наночастиц. Известно, что при создании излучательных элементов на основе фазы ZnO наночастицы должны синтезироваться в узком по размеру диапазоне, тогда ширина линии излучения экситонной люминесценции сужается. В [16] был предложен новый метод избирательного изменения и контроля размеров сформированных металлических наночастиц путем облучения подложки пучками быстрых тяжелых ионов. Это облучение приводит к образованию во многих кристаллах деформационных латентных треков (неупорядоченных областей нанометрового размера вокруг траектории облучающего иона). Соответствующее облучение, создающее трек, может изменять форму наночастицы от сферической до эллипсоидальной. Этот эффект наиболее заметен при множественном (около 100 раз) воздействии быстрых тяжелых ионов [17].
После отжига в атмосфере О2 при температуре около 700°С образцы были облучены быстрыми ионами 132Xe26+ с энергией 167 МэВ в диапазоне флуенсов (1 × 1012)–(5 × 1014) см–2 для модификации синтезированных наночастиц оксида цинка. Параметры ионов, проходящих через аморфную пленку SiO2, рассчитаны по программе SRIM 2013 [18]: потери энергии в электронной системе dEel/dx = 14.7 кэВ/нм; потери в ядерной системе dEnucl/dx = 59.8 эВ/нм; проективный пробег Rp = 18.6 мкм; продольный страгглинг Str = 0.576 мкм; поперечный страгглинг Slat = 0.622 мкм.
Как было показано в [19] методом малоуглового рассеяния, радиус трека ионов Xe в аморфном SiO2 является функцией потерь энергии в электронной системе (dEel/dx). В случае ионов Xe с энергией 167 МэВ в матрице SiO2 потери электронной системы составляют 14.7 кэВ/нм, что соответствует радиусу трека r ≈ 4 нм. В упомянутой работе была также введена важная величина для оценки влияния ионных треков на облучаемую поверхность, а именно, коэффициент покрытия СR = πr2Φ, где Φ – флуенс быстрых ионов. Коэффициент покрытия показывает, сколько раз в среднем поверхность пересекается ионными треками. В настоящем исследовании в диапазоне флуенсов (1 × 1012)–(5 × 1014) см–2 эта величина составляет 0.5–250. Как уже упоминалось выше, для значительного изменения формы наночастиц величины СR должна быть больше 100.
При воздействии быстрых тяжелых ионов на наночастицы важную роль играет максимальный размер наночастиц, которые будут плавиться при облучении. В случае ионов Xe при энергии 167 МэВ максимальный размер наночастиц оксида цинка $R_{{{\text{NP}}}}^{{\max }}$ согласно [17] составляет:
Следует отметить, что приведенные вычисления носят оценочный характер. Как показано в [20], для реакции 2ZnO → 2Zn + O2 теплота Гиббса составляет ΔG(T) = +350 кДж/моль при 300 К. Иначе говоря, при комнатной температуре эта реакция не идет самопроизвольно. Однако при значительном повышении температуры, например до 2350°С, теплота Гиббса для этой реакции становится отрицательной, и поэтому реакция распада оксида цинка на Zn и O2 может идти самопроизвольно.
Исследование спектров фотолюминесценции. На рис. 7 представлены спектры ФЛ образцов после имплантации Zn, после отжига при 700°С и после облучения быстрыми ионами Xe с разными флуенсами. Из рисунка видно, что после имплантации Zn (кривая 1) на фоне уширенного пика с центром около 420–430 нм, обусловленного возникшими радиационными точечными дефектами и их кластерами, наблюдается узкий пик ФЛ на длине волны 370 нм, связанный с образованием фазы ZnO и экситонной рекомбинацией в ней. После отжига при 700°С (кривая 2) этот пик увеличивается, так как в процессе отжига в окислительной атмосфере молекулы кислорода, диффундируя в образец из окружающей атмосферы, доходят до имплантированного цинка (Rp = 40 нм), окисляют его и тем самым увеличивают общее содержание фазы оксида цинка в образце. После облучения образца быстрыми ионами Xe с флуенсом 5 × 1012 см–2 пик ФЛ при 370 нм практически исчезает, что может указывать на уменьшение содержания фазы ZnO в исследуемой пленке. В то же время уширенный пик ФЛ с центром при 425 нм значительно увеличивается с ростом флуенса Xe до 5 × 1014 см–2.
Рис. 7.
Спектры ФЛ пленки SiO2: имплантированной Zn (1), отоженной в атмосфере кислорода при 700°С (2); облученной быстрыми ионами Xe с флуенсами: 2 × 1013 (3) и 5 × 1014 см–2 (4). Спектры ФЛ сняты при температуре 10 К.

Исследование спектров отражения. Известно [21], что прозрачный слой в видимой области спектра, каким является диэлектрическая пленка SiO2, изменяет свою прозрачность и спектр отражения при имплантации больших концентраций примеси металла. В частности, поглощение увеличивается за счет явления поверхностного плазмонного резонанса, так же ведет себя и отражение. Для корректной интерпретации спектры отражения были представлены в виде отношения измеряемого спектра отражения к спектру исходной, не имплантированной цинком пленки SiO2 на Si подложке. Результаты представлены на рис. 8. По мере отжига металлическая фаза цинка переходит в фазу его оксида, и образец просветляется.
Рис. 8.
Нормированные кривые отражения: 1 – после имплантации; 2 – после отжига при 400; 3 – 600; 4 – 700; 5 – 800°С.

Как известно, максимум распределения имплантированного Zn при данных условиях внедрения находится на глубине 40 нм, что соответствует расчетной величине Rp по программе SRIM. Здесь же находятся и преципитаты цинка, поскольку его содержание значительно превосходит предел его равновесной растворимости в оксиде кремния. Разброс содержания имплантированного цинка и положение его максимума тоже соответствуют величинам, рассчитанным по программе SRIM. Поскольку полученные концентрации Zn значительно превышают его предельную равновесную растворимость в оксиде кремния, возможно выпадение Zn в преципитаты вблизи концентрационных максимумов в форме металлического Zn после имплантации и/или его оксидных соединений типа ZnO · ZnSiO3 после отжига при температуре менее 700°С, или ZnO · Zn2SiO4 при высоких температурах отжига (более 800°С).
При термообработке в атмосфере кислорода в диапазоне температур 600–900°C происходит постепенный отжиг радиационных дефектов. При температурах более 600°C значительно возрастает коэффициент диффузии цинка в оксиде кремнии [22]. Высокая диффузионная подвижность цинка способствует активному его перераспределению в области имплантированного слоя. После отжига при 900°С дефекты практически полностью отжигаются, а содержание цинка в образце заметно уменьшается: его меньшая часть продиффундировала в глубину подложки, а большая часть вылетела из образца из-за обратной диффузии в атмосферу.
ВЫВОДЫ
После имплантации Zn в пленку оксида кремния обнаружена фаза ZnO и характерный пик ФЛ на длине волны 370 нм. Низкотемпературный отжиг в диапазоне 400–600°С приводит к образованию в пленке SiO2 и на ее поверхности Zn-содержащиe преципитатов с поперечным размером порядка 100 нм. После отжига в диапазоне 700–800°С в пленке формируются Zn-содержащих преципитаты состава Zn · ZnO, а после отжига при температурах 900–1000°С образуется фаза состава ZnO · · Zn2SiO4.
По данным АСМ наибольшими параметрами шероховатости характеризуется исходный образец SiO2, имплантированный Zn: Rms = 860, Ra = = 680 пм. После отжига в атмосфере O2 при 700°С: Rms = 155, Ra = 123 пм. Наименьшую шероховатость имеет поверхность образца, облученного ионами Xe с флуенсом 5 × 1014 см–2: Rms = 127, Ra = 98 пм.
Облучение быстрыми ионами Xe приводит, с одной стороны, к разрушению фазы ZnO, что подтверждает исчезновение экситонного пика ФЛ на длине волны 370 нм, с другой стороны, к формированию большого количества радиационных дефектов и характерной люминесценции с максимумом при 430 нм, которая растет с увеличением интенсивности облучения. После облучения Xe на поверхности пленки SiO2 зафиксированы неглубокие углубления микрометровых размеров в плоскости изображения.
БЛАГОДАРНОСТИ
Работа частично выполнена в рамках Государственного задания ФАНО России (госпроект 14, тема 40.3, раздел № 0066-2014-0025 и тема 40.2, раздел № 0066-2014-0024), а также частично в рамках государственного задания ИФТТ РАН. Исследования методами сканирующей зондовой микроскопии выполнены при финансовой поддержке Министерства науки и высшего образования РФ на оборудовании ЦКП “Материаловедение и металлургия” НИТУ “МИСиС” (госзадание № 11.9706.2017/7.8).
Список литературы
Litton C.W., Collins T.C., Reynolds D.S. Zinc Oxide Material for Electronic and Optoelectronic Device Application. Chichester: Wiley, 2011. 379 p.
Amekura H., Sakuma Y., Kono K. et al. // Physica B. 2006. V. 376–377. P. 760.
Jiang C.Y., Sun X.W., Lo G.Q. et al. // Appl. Phys. Lett. 2007. V. 90. P. 263501.
Li C., Yang Y., Sun X.W. et al. // Nanotechnology. 2007. V. 18. P. 135604.
Chu S., Olmedo M., Yang Zh. et al. // Appl. Phys. Lett. 2008. V. 93. P. 181106.
Smestad G.P., Gratzel M. // J. Chem. Educ. 1998. V. 75. P. 752.
Bagnall D.M., Chen Y.F., Shen M.Y. et al. // J. Cryst. Growth. 1998. V. 184–185. P. 605.
Dodds J.S., Meyers F.N., Loh K.J. // Smart Structures and Systems. 2013. V. 12. P. 055.
Chang H., Park H.D., Sohn K.S., Lee J.D. // J. Korean Phys. Soc. 1999. V. 34 P. 545.
Straumal B.B., Mazilkin A.A., Protasova S.G. et al. // Phys. Rev. B. 2009. V. 79. P. 205206.
Son D.-I., Park D.-H., Choi W.K. et al. // Nanotechnology. 2009. V. 20. P. 195203.
Privezentsev V., Kulikauskas V., Steinman E., Bazhenov A. // Phys. Stat. Sol. C. 2013. V. 10. P. 48.
Amekura H., Takeda Y., Kishimoto N. // Mater. Lett. 2011. V. 222. P. 96.
Shen Y.Y., Zhang X.D., Zhang D.C. et al. // Mater. Lett. 2011. V. 65. P. 2966.
Privezentsev V.V., Tabachkova N.Yu., Eidelman K.B., Ksenich S.V. // Bull. Russ. Acad. Sci.: Phys. 2016. V. 80. P. 1421.
D’Orleans C., Stoquert J., Estourne’s C. et al. // Phys. Rev. B. 2003. V. 67. P. 220101R.
Komarov F.F., Milchanin O.A., Skuratov V.A. et al. // Bull. Russ. Acad. Sci.: Phys. 2016. V. 80. P. 160.
Ziegler J.F., Biersack. J.P. SRIM 2013. http://www.srim.org.
Kluth P., Schnohr C.S., Pakarinen O.H. et al. // Phys. Rev. Lett. 2008. V. 101. P. 175503.
Владимиров Л.П. Термодинамические расчеты равновесия металлургических реакций. М.: Металлургия, 1970. 528 с.
Zatsepin D., Zatsepin A., Boukhvalov D. et al. // J. Non-Crystall. Solids. 2016. V. 432. P. 183.
Diffusion in Condensed Matter: Methods, Materials, Models. / Ed. Heitjans P., Kärger J. Springer, 2005. V. 376–377. P. 760.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования




