Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 12, стр. 21-27
Захват дейтерия в наноструктурированном поверхностном слое вольфрама, образованном при высокотемпературном облучении гелиевой плазмой
З. Р. Арутюнян a, *, О. В. Огородникова a, А. С. Аксенова a, Ю. М. Гаспарян a, В. С. Ефимов a, М. М. Харьков a, А. В. Казиев a, Н. В. Волков a
a Национальный исследовательский ядерный университет “МИФИ”
115409 Москва, Россия
* E-mail: arutyunyan@plasma.mephi.ru
Поступила в редакцию 24.02.2020
После доработки 29.03.2020
Принята к публикации 02.04.2020
Аннотация
Предварительное облучение образца вольфрама низкоэнергетическими ионами гелия (80 эВ, поток 1021 м–2 · с–1) при температуре 1200–1250 К в установке c индукционным ВЧ-разрядом привело к формированию наноструктурированного поверхностного слоя вольфрама, называемого “пухом”. Затем осуществляли серию отжигов образца и облучение ионами ${\text{D}}_{3}^{ + }$ с энергией 2 кэВ (ион D с энергией 0.67 кэВ) при малых дозах 1019–1020 м–2. Анализ накопления дейтерия на каждом этапе проводили с помощью термодесорбционной спектроскопии in situ. С уменьшением концентрации гелия в образце характер захвата дейтерия существенно изменялся. При больших концентрациях гелия накопление дейтерия было мало. Отжиг в интервале температур 1000–1400 К приводил к десорбции гелия, модификации поверхностного слоя и дефектов и, как следствие, к увеличению амплитуды и смещению основного пика десорбции дейтерия в сторону больших температур. Отжиг при температуре 1600 К приводил к удалению наноструктурированного “пуха” на поверхности вольфрама и снижению накопления дейтерия вследствие увеличения коэффициента отражения от более гладкой поверхности.
ВВЕДЕНИЕ
Гелий является продуктом дейтерий-тритиевой реакции и будет естественной примесью в плазме термоядерных реакторов [1]. Вольфрам будет использован в качестве основного материала обращенных к плазме элементов в экспериментальной установке термоядерного синтеза ИТЭР в области дивертора [2]. Внедрение гелия в обращенные к плазме элементы приводит к существенной модификации поверхности, что может быть причиной повышенной эрозии, а также влиять на скорость накопления изотопов водорода в стенках термоядерных установок. Под действием гелия в поверхностном слое вольфрама образуются вакансионные комплексы гелия и более крупные пузыри, которые могут быть сильными ловушками для дейтерия [3]. С другой стороны, в целом ряде экспериментов наблюдается снижение накопления дейтерия в вольфраме при добавлении примеси гелия в дейтериевую плазму [4, 5].
В ИТЭР вольфрам будет использован в диверторной области, где будет подвержен мощным потокам тепла и частиц из плазмы, а температура поверхности в зоне максимальных нагрузок будет достигать 1573 К даже без учета импульсных нагрузок [6]. В [7] впервые показано, что в этих условиях на поверхности вольфрама может формироваться сильно развитая поверхность, так называемый “пух”. Это явление активно исследовали в последние годы [8–10]. В настоящей работе изучено влияние формирования “пуха” на поверхности вольфрама на эффективность захвата ионов дейтерия в поверхностном слое.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
В экспериментальной серии был использован образец размером 12 × 12 мм, отрезанный от фольги поликристаллического вольфрама толщиной 50 мкм и чистотой 99.95% (производство Plansee, Австрия). Плазменное облучение проводили на компактной плазменной установке “ВЧИ разряд” c индукционным ВЧ-разрядом (подробное описание в [11]). Остаточное давление в камере 5 × 10–5 Па. Продольное магнитное поле на оси составляло 15 × 10–4 Тл, а смещение на образцы подавали в импульсном режиме с частотой 100 кГц и коэффициентом заполнения 80%. Образцы перед установкой были предварительно очищены в ультразвуковой ванне в растворе спирта и помещены с помощью ввода движения в центр камеры перпендикулярно оси магнитного поля. Далее поверхность образца очищали в аргоновой плазме в течение 5 мин при подаче отрицательного потенциала на образец –100 В и мощности в разряд 1700 Вт.
Облучение в гелиевой плазме проходило при потенциале образца 80 В, мощности в разряде от 2000 Вт и потоке ионов на образец ~1.5 × 1021 м–2 · с–1. Температура поверхности в ходе облучения составляла ~1250 К. Время облучения было 1 ч, что достаточно для формирования на поверхности вольфрамового “пуха” [7, 8]. На рис. 1 приведены изображения поверхности (рис. 1а, 1б) и поперечного сечения (рис. 1в) после облучения, полученные с помощью растровой электронной микроскопии (микроскоп Hitachi S5500). Вся поверхность покрыта волокнами толщиной около 30 нм и длиной порядка 100 нм (более подробное описание структуры представлено в [11]).
Рис. 1.
Изображения поверхности вольфрама после облучения гелиевой плазмой при температуре 1200–1250 К и дозе 8 × 1024 м–2, полученные с помощью растровой электронной микроскопии: а, б – вид сверху, в – поперечное сечение
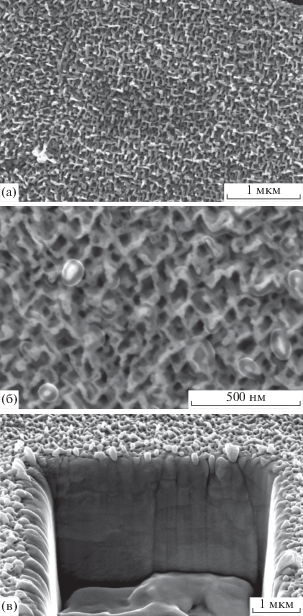
Последующие эксперименты проводили на ионно-пучковой установке “Медион” [3] после нахождения образца в атмосфере. Остаточное давление в камере облучения составляло менее 10–6 Па. Образец устанавливали с помощью ввода движения через шлюзовую камеру. На вводе движения за образцом помещали нагреватель, температуру контролировали с помощью вольфрам-рениевой термопары, приваренной непосредственно к образцу. Наличие многоступенчатой системы дифференциальной откачки позволяет минимизировать давление рабочего газа в камере облучения и проводить анализ захвата гелия и дейтерия методом термодесорбционной спектроскопии (ТДС) in situ, т.е. непосредственно в камере облучения ионами дейтерия без контакта с атмосферой.
Облучение проводили при комнатной температуре моноэнергетическим масс-сепарированным пучком ионов ${\text{D}}_{3}^{ + }$ с энергией 2 кэВ (ион D с энергией 0.67 кэВ), что ниже порога образования пар Френкеля в вольфраме. Использовали малые дозы облучения 1019 и 1020 м–2, для того чтобы характеризовать взаимодействие дейтерия с образованными гелием дефектами и не создавать дополнительные дефекты аналогично [3, 12, 13]. Последовательность облучения и параметры приведены в табл. 1.
Таблица 1.
Сводная информация о параметрах облучения ионами дейтерия и интегральном накоплении гелия и дейтерия во всех проведенных экспериментах
| № | Отжиг, мин | Температура, К | Доза, м–2 | Выход гелия, 1019 м–2 | Выход дейтерия, 1018 м–2 |
|---|---|---|---|---|---|
| 1 | 0 | 1000 | 1019 | 20 | 0.65 |
| 2 | 0 | 1000 | 1019 | 1.3 | На уровне фона в камере |
| 3 | 0 | 1000 | 1020 | 0.7 | 2.3 |
| 4 | 0 | 1000 | 1019 | 0.6 | На уровне фона в камере |
| 5 | 0 | 1000 | 1020 | 0.45 | 3.5 |
| 6 | 30 | 1000 | 1019 | 0.1 | На уровне фона в камере |
| 7 | 30 | 1200 | 1019 | 6.1 | 2.1 |
| 8 | 30 | 1400 | 1019 | 0.35 | 3.2 |
| 9 | 30 | 1600 | 1019 | 0.15 | 1.6 |
Продолжительность паузы между облучением и ТДС строго контролировали во всех экспериментах, она составляла 120 мин. Скорость линейного нагрева образца в ходе ТДС 2 К/с, максимальная температура нагрева 1000 К. В экспериментах № 1–5 образец вначале облучали ионами дейтерия, затем проводили ТДС-анализ до температуры 1000 К. Охлаждение образца начиналось сразу после достижения максимальной температуры без дополнительного выдерживания. В экспериментах № 6–9 образец предварительно выдерживали в течение 30 мин при температурах 1000, 1200, 1400 и 1600 К соответственно (температура в данном случае поднималась нелинейно не более чем за 30 с). После охлаждения процедура была аналогичной экспериментам № 1–5, т.е. проводили облучение ионами дейтерия и ТДС до 1000 К. Выход газов из образца регистрировали при помощи квадрупольного масс-спектрометра Hiden Hal 51, позволяющего проводить измерения с изменением энергии ионизирующих электронов для разрешения сигналов газов D2 и He. В данной экспериментальной серии измерения проводили с энергией 19 эВ (ниже порога ионизации гелия) для получения сигнала дейтерия, а также с энергией 31 эВ для получения суммарного сигнала дейтерия и гелия. Поток гелия пересчитывали из соотношения сигналов при 19 и 31 эВ с учетом калибровочных коэффициентов для гелия и дейтерия для обоих значений энергии (подробнее в [3, 14]).
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Десорбция гелия
В экспериментах [11, 15] было показано, что в ходе термодесорбционной спектроскопии гелий может продолжать выходить из вольфрама вплоть до 2500 К. В настоящих экспериментах максимальная температура в ходе ТДС была ограничена 1000 К, так как, с одной стороны, согласно данным просвечивающей микроскопии [16] при больших температурах начинается активное изменение структуры поверхности, а именно постепенная усадка и укрупнение вольфрамовых волокон, вызванное агломерацией гелиевых пузырьков и десорбцией гелия вплоть до исчезновения пуха при отжиге в течение 25 мин при температурах, превышающих 1273 К. С другой стороны, нагрева до этой температуры обычно достаточно для выделения всего дейтерия из образца. Максимальная температура ТДС также ниже температуры облучения гелием, тем не менее, на рис. 2а можно видеть, что при проведении первого этапа ТДС после облучения дейтерием выходит достаточно большое количество гелия. Интегральное количество вышедшего гелия (рис. 2б) составило 2 × 1020 м–2, т.е. 1/5 часть общего захваченного гелия, если сравнивать с аналогичными экспериментами [3, 11, 15], в которых общее количество гелия 1 × 1021 м–2 было измерено при нагреве до температуры 2500 К.
Рис. 2.
Серия последовательных ТДС-анализов образца после облучения ионами дейтерия при дозе 1019 (эксперименты 1, 2, 4, 6) и 1020 м–2 (эксперименты 3, 5) до проведения длительного отжига: а – спектры термодесорбции гелия из образца (эксперимент 6 – отжиг при 1000 К в течение 30 мин); б – интегральное количество вышедшего гелия при каждом анализе.

Положение пиков термодесорбции хорошо согласуется с предыдущими экспериментами [11, 15], проведенными в близких условиях на той же установке, в которых пики ТДС наблюдались при температурах 530 и 1120 К, а также свыше 1500 К. Появление низкотемпературных пиков десорбции гелия после высокотемпературного облучения, как было показано в недавних экспериментах по имплантации ионным пучком [15], может быть вызвано контактом с воздухом. Ненулевая десорбция гелия наблюдалась также и в ходе трех следующих измерений ТДС, однако количество вышедшего из образца гелия с каждым разом уменьшалось (рис. 2).
Выход гелия после отжига в течение 30 мин при температуре 1000 К, так же, как и при измерении ТДС после него, был на уровне фона. Однако после отжига при больших температурах (1200, 1400, 1600 К) выход гелия снова наблюдался (рис. 3). Каждый раз поток десорбции гелия увеличивался сразу после повышения температуры отжига образца и постепенно уменьшался со временем. Максимальное газовыделение наблюдалось в ходе отжига при температуре 1200 К, при дальнейшем увеличении температуры количество выделившегося гелия снижалось. В [16] количество вышедшего из образца гелия при отжиге 1273 К тоже уменьшалось по сравнению с отжигом при 1173 К, что согласуется с данными настоящей работы. В [16] при отжиге при 1073 К количество гелия, выделившегося из образца, было меньше, чем после отжига при 1173 К, однако отжигу при 1073 К предшествовал длительный отжиг при температурах 773, 873 и 973 К, что может влиять на результаты эксперимента.
Десорбция дейтерия
Первое облучение ионами дейтерия проводили при дозе 1 × 1019 м–2, аналогично предыдущим экспериментам в [3, 13, 17]. При этой дозе дейтерий заполняет ловушки вблизи зоны внедрения. При большой концентрации свободных центров захвата в поверхностном слое вольфрама накопление в предыдущих экспериментах было на уровне (2–3) × 1018 м–2, что близко к полному захвату дейтерия с учетом коэффициента отражения. В [3] в спектрах наблюдались пики, соответствующие наиболее сильным ловушкам. Следует отметить, что в [3] предварительное облучение ионами He+ проводили с энергией 3 кэВ при комнатной температуре, и после дозы 5 × 1021 м–2, когда была достигнута предельная концентрация гелия, накопление дейтерия (при дозе 1 × 1019 м–2) было на уровне фона. Концентрация гелия после плазменного облучения в поверхностном слое находится, согласно [15], приблизительно на том же уровне ~1021 м–2. Однако частичное освобождение ловушек вполне можно ожидать в силу большой температуры облучения.
Результаты настоящей работы показали, что после первого облучения десорбция дейтерия происходила в области температур 700–900 К с максимумом при температуре 790 К (рис. 4). Интегральное количество захваченного дейтерия оказалось 6.5 × 1017 м–2. Исходя из положения пика термодесорции дейтерия и сравнения с [13, 17] можно сказать, что дейтерий захватывается в энергетически достаточно глубокие ловушки с энергией связи свыше 2 эВ. Такая энергия может быть при абсорбции на поверхности гелиевых пузырьков или в вакансионных комплексах. Однако при втором и последующем аналогичном облучении дозой 1019 м–2 выход дейтерия при измерении ТДС больше не наблюдался. Детально изменение структуры при нагреве до 1000 К в работе не исследовали, однако можно предположить, что после нагрева до 1000 К выход гелия из сильно напряженной структуры гелиевого пуха вызвал резкое изменение структуры. Отсутствие накопления дейтерия говорит либо о его ускоренном выходе из вольфрама при имплантации, либо об отсутствии центров захвата. Ускоренный выход дейтерия из вольфрама при имплантации может быть связан с полем напряжений, вызванных гелиевыми пузырьками [4].
Рис. 4.
Спектры термодесорбции дейтерия из образца, облученного при температуре 300 К ионами дейтерия при дозе 1019 (эксперименты 1, 2, 4) и 1020 м–2 (эксперименты 3, 5).

При большей дозе облучения дейтерием (1020 м–2) некоторое количество дейтерия захватывается в образце, но выходит преимущественно при достаточно небольших температурах с максимумом потока десорбции при 500 К (рис. 4). Можно видеть также небольшой пик в области 800 К. Достаточно небольшое интегральное количество захваченного дейтерия говорит о том, что эффективность его захвата по-прежнему небольшая, но более длительное облучение, по всей видимости, позволяет заполнить большее количество ловушек и на большей глубине.
Во всех предыдущих измерениях после достижения температуры 1000 К нагрев выключали и образец охлаждали медленно (30 мин) до комнатной температуры. В следующей серии первый эксперимент был сделан после отжига при температуре 1000 К в течение 30 мин. Как видно из рис. 5а, десорбция дейтерия в этом случае снова не наблюдалась (на уровне фона), и не было дополнительного выхода гелия (рис. 2а), что свидетельствует о том, что дополнительное время отжига вплоть до 30 мин не приводит к существенной модификации приповерхностного слоя.
Рис. 5.
Захват дейтерия в образце, облученном дозой дейтерия 1019 м–2 при 300 К, после отжига при температурах 1000 (эксперимент 6), 1200 (эксперимент 7), 1300 (эксперимент 8) и 1400 К (эксперимент 9) в течение 30 мин: а – спектры термодесорбции дейтерия; б – интегральное количество вышедшего дейтерия.

Далее были проведены аналогичные эксперименты с отжигом при 1200, 1400 и 1600 К. Уже после отжига при температуре 1200 К в спектрах термодесорбции снова можно было видеть выход дейтерия с максимумом при ~500 К, что говорит об относительно слабой энергии связи дейтерия с дефектами. С увеличением температуры отжига основной пик десорбции дейтерия постепенно смещался в сторону больших температур, а именно ~550 и ~650 К после отжига 1400 и 1600 К соответственно. На рис. 3 видно, что увеличение температуры отжига приводило к дополнительному выходу гелия из образца, что может говорить о частичном освобождении дефектов или о дополнительной модификации поверхностного слоя. Заметим, что при температуре образца 1200 К наблюдается интенсивное формирование пуха при облучении гелием, тогда как наностуктурирование поверхности незначительно при температуре 1000 К [8, 11, 16]. В случае T = 1200 К становятся подвижны гелиевые кластеры. Таким образом, при отжиге 1200 К можно ожидать “заживление” поверхности вследствие диффузии и аннигиляции гелиевых пузырьков. В [8, 11, 16] методом просвечивающей электронной микроскопии показано, что сложная структура пуха стала более простой уже при отжиге 1173 К, и большинство пузырьков в пухе исчезли. Исходя из этого, изменение свойств центров захвата от относительно слабых к более сильным с увеличением температуры отжига связано с модификацией поверхностного слоя и отжигом слабых дефектов.
При извлечении образца после этой серии было обнаружено, что поверхность потеряла черный цвет, характерный при наличии “пуха” на поверхности. Соответственно, менялся захват дейтерия: сначала он увеличивался при отжиге от 1200 до 1400 К, а после 1600 К уменьшался. Последнее может быть связано с увеличением коэффициента отражения дейтерия при сглаживании сильно развитой поверхности (пуха) после отжига, что приводит к уменьшению проникающего потока дейтерия и, соответственно, к уменьшению захвата. Согласно [18] начальный коэффициент отражения атомов водорода от развитой поверхности с “пухом” был на 50% ниже по сравнению с более гладкой поверхностью вольфрама, что вполне соотносится с настоящими экспериментами.
ЗАКЛЮЧЕНИЕ
В работе методом ТДС исследован захват дейтерия в вольфрамовый пух, созданный при высокотемпературном плазменном облучении. Показано, что при первоначальной имплантации ионов дейтерия с энергией 670 эВ и дозе 1 × 1019 м–2 десорбция дейтерия происходит при высоких температурах с максимумом около 800 К, что говорит о наличии достаточно сильных центров захвата. Кратковременный отжиг до 1000 К приводит к частичному выходу гелия, а также к снижению эффективности захвата гелия. После отжига образцов при температурах 1200–1400 К основной ТДС-пик постепенно смещается в сторону больших температур, и увеличивается эффективность захвата дейтерия, что связано с интенсивной модификацией приповерхностного слоя и частичным освобождением ловушек. Отжиг при температуре 1600 К приводил к удалению наноструктурированного пуха на поверхности вольфрама и снижению накопления дейтерия, что объясняется увеличением коэффициента отражения от более гладкой поверхности.
Таким образом, главным фактором, определяющим захват дейтерия в образец, предварительно облученный гелием, является концентрация гелия под поверхностью. При частичном выходе гелия наблюдается модификация поверхности и структуры дефектов. Наличие развитого рельефа на поверхности вольфрама влияет на уменьшение коэффициента отражения, увеличивая поток внедрения дейтерия в вольфрам и, соответственно, увеличивая накопление.
Список литературы
Pitts R.A., Bonnin X., Escourbiac F. et al. // Nucl. Mater. En. 2019. V. 20. P. 100696. https://doi.org/10.1016/j.nme.2019.100696
Bachmann C., Arbeiter F., Boccaccini L.V. et al. // Fus. Eng. Des. 2016. V. 112. P. 527. https://doi.org/10.1016/j.fusengdes.2016.05.040
Арутюнян З.Р., Гаспарян Ю.Р., Ефимов В.С. и др. // Изв. РАН. Сер. физ. 2020. Т. 84. № 6. С. 882.
Ogorodnikova O.V., Schwarz-Selinger T., Sugiyama K., Alimov V.Kh. // J. Appl. Phys. 2011. V. 109. P. 013309. https://doi.org/10.1063/1.3505754
Alimov V.Kh., Shu W.M., Roth J. et al. // Phys. Scr. 2009. V. 138. P. 014 048. https://doi.org/10.1088/0031-8949/2009/T138/014048
De Temmerman G., Hirai T., Pitts R.A. // Plasma Phys. Control. Fusion. 2018. V. 60. P. 044018. https://doi.org/10.1088/1361-6587/aaaf62
Takamura S., Ohno N., Nishijima D., Kajita S. // Plasma Fus. Res. 2006. V. 1. P. 051. https://doi.org/10.1585/pfr.1.051
Kajita S., Sakaguchi W., Ohno N. et al. // Nucl. Fus. 2009. V. 49. P. 095005. https://doi.org/10.1088/0029-5515/49/9/095005
Wang K., Doerner R.P., Baldwin M.J. et al. // Sci. Rep. 2017. V. 7. P. 1. https://doi.org/10.1038/srep42315
Parish C.M., Wang K., Doerner R.P., Baldwin M.J. // Scr. Mater. 2017. V. 127. P. 132. https://doi.org/10.1016/j.scriptamat.2016.09.018
Ogorodnikova O.V., Klimov K.S., Poskakalov A.G. et al. // J. Nucl. Mater. 2019. V. 515. P. 150. https://doi.org/10.1016/j.jnucmat.2018.12.023
Rusinov A., Gasparyan Y., Trifonov N. et al. // J. Nucl. Mater. 2011. V. 41. P. 645. https://doi.org/10.1016/j.jnucmat.2010.10.069
Zibrov M., Ryabtsev S., Gasparyan Y., Pisarev A. // J. Nucl. Mater. 2016. V. 477. P. 292. https://doi.org/10.1016/j.jnucmat.2016.04.052
Davies S., Rees J.A., Seymour D.L. // Vacuum. 2014. V. 101. P. 416. https://doi.org/10.1016/j.vacuum.2013.06.004
Gasparyan Y., Ryabtsev S., Efimov V. et al. // Phys. Scr. 2020. V. 171. P. 014017. https://doi.org/10.1088/1402-4896/ab4068
Yajima M., Yoshida N., Kajita S. et al. // J. Nucl. Mater. 2014. V. 449. P. 9.https://doi.org/10.1016/j.jnucmat.2014.02.027
Ryabtsev S., Gasparyan Y., Zibrov M. et al. // Nucl. Instrum. Methods Phys. Res. B. 2016. V. 382. P. 101. https://doi.org/10.1016/j.nimb.2016.04.038
Doi K., Lee H.T., Tanaka N. et al. // Fus. Eng. Design. 2018. V. 136. P. 100. https://doi.org/10.1016/j.fusengdes.2018.01.001
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



