Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 12, стр. 89-94
Расчет миниатюрной формирующей линзы высоковольтного электронного литографа
В. В. Казьмирук a, *, И. Г. Курганов a, **, Т. Н. Савицкая a
a Институт проблем технологии микроэлектроники и особочистых материалов РАН
142432 Московская область, Черноголовка, Россия
* E-mail: kazmiruk@iptm.ru
** E-mail: kurganov@iptm.ru
Поступила в редакцию 18.02.2020
После доработки 12.03.2020
Принята к публикации 17.04.2020
Аннотация
Приведены результаты моделирования миниатюрной формирующей линзы для устройства высоковольтной электронно-лучевой литографии. Диаметр внешнего магнитопровода линзы составляет 64 мм, что позволяет осуществить компоновку четырех независимых электронно-оптических систем (ЭОС) над площадью шестидюймового фотошаблона. Электронно-оптические характеристики полученной миниатюрной фокусирующей линзы обеспечивают в режиме фокусировки пучка с энергией 50 кэВ при рабочем отрезке 15 мм исключение насыщения ее магнитопровода и разрешение, не превышающее 25 нм при сканировании на участке 100 × 100 мкм. Проведено исследование зависимости электронно-оптических свойств миниатюрной формирующей линзы от диаметра ее канала, величины зазора и длины магнитопровода. Полученные результаты дают возможность выбора оптимальной конфигурации формирующей линзы при разработке ЭОС электронно-лучевого литографа. Предложенная компоновка из четырех колонн позволит повысить производительность процесса литографии соответственно в четыре раза по сравнению с вариантом с одной колонной.
ВВЕДЕНИЕ
Основным недостатком электронно-лучевой литографии, препятствующим широкому использованию этого метода в промышленности, является ее низкая производительность. Нахождение путей повышения производительности электронно-лучевой литографии является одним из основных направлений исследований с момента ее зарождения. На данный момент эти исследования разделились на несколько направлений, из которых можно выделить два основных. Первое направление – это использование нескольких смежно-расположенных электронно-оптических систем (ЭОС) с независимыми источниками – так называемая “многоколонная литография” [1–4]. Второе направление – использование массива электронных пучков, полученных разделением пучка, исходящего из одного источника. Каждый пучок из массива может управляться либо соответствующим массивом фокусирующих линз, либо одной общей для всех линзой. Такой подход получил название “многолучевая литография” [5–8]. Если первый подход был подтвержден успешной практической реализацией и продемонстрировал повышенную производительность литографии [2], то второй подход был явственно реализован только для методов растровой электронной микроскопии [9].
Разработка ЭОС для многоколонных литографических систем, а также задача компоновки нескольких ЭОС на ограниченной площади, определяемой, например, геометрией фотошаблона, ставят вопрос об оптимальном проектировании электронных линз, при котором исключается насыщение магнитопровода, и (в то же самое время) обеспечиваются приемлемые аберрационные характеристики ЭОС.
Нами рассчитана миниатюрная фокусирующая линза для электронного литографа, удовлетворяющая указанным условиям при энергии электронного пучка 50 кэВ и позволяющая разместить до четырех ЭОС над рабочей областью фотошаблона для проекционной оптической литографии.
СОДЕРЖАНИЕ ИССЛЕДОВАНИЙ
Основное ограничение габаритных размеров ЭОС задается размером рабочей области фотошаблона – площадью, на которой происходит экспонирование резиста электронным пучком. В данной работе предполагается использование шестидюймовых фотошаблонов для установок серии PAS 5500 компании ASML (рис. 1), которые имеют размер 152 × 152 мм. При этом размер области, на которой происходит экспонирование непосредственно самого топологического рисунка, составляет 128 × 104 мм.
Рис. 1.
Схематическое изображение фотошаблона с четырехкратным увеличением для степпера ASML серии PAS5500. Размер E = 152 мм. Область экспонирования I обозначена крупной перекрестной штриховкой.

Для размещения четырех независимых ЭОС над площадью указанного фотошаблона внешний диаметр магнитопровода магнитных линз, находящихся в каждой из четырех систем, не должен превышать 64 мм. Малый радиальный размер ЭОС при энергии электронного пучка 50 кэВ приводит к проблемам, прежде всего для объективной линзы, имеющей наибольший ток возбуждения. При уменьшении внешнего диаметра магнитопровода объективной линзы высокое возбуждение катушки линзы, необходимое для фокусировки электронного пучка в плоскости фотошаблона, может привести к насыщению магнитопровода. Вследствие этого наблюдается некорректная и нестабильная работы линзы. Кроме того, соответствующая возбуждению высокая плотность тока в катушке линзы может привести к ее перегреву. Вместе с этим для обеспечения высокого разрешения системы коэффициенты аксиальных аберраций фокусирующей линзы должны иметь приемлемые значения. В рассматриваемой системе определяющее значение для диаметра, сфокусированного на образце электронного пучка имеют сферическая аберрация и конечная яркость источника электронов [10]. Зависимость размеров электронного пучка от основных факторов, влияющих на его уширение, показана на рис. 2.
Рис. 2.
Зависимости диаметра электронного пучка d∑ и компонент, составляющих общее уширение пучка от угла сходимости на образце, обусловленные: dG – конечной яркостью источника, ds – влиянием сферической аберрации, dD – влиянием дифракции, dC – влиянием хроматической аберрации.

Поэтому при моделировании миниатюрной линзы с малым внешним диаметром магнитопровода основными параметрами оптимизации были максимальное значение магнитной индукции в магнитопроводе линзы Bmax, коэффициент сферической аберрации Cs и плотность тока j в катушке линзы.
Моделирование осуществлялось при помощи программы EOD (Electron Optical Design) [11]. Программа EOD производит расчет вращательно-симметричных магнитных и электростатических полей методом конечных элементов, в котором потенциал поля определяется в узлах сетки, состоящей в данном случае из треугольных элементов, каждый из которых может содержать только один тип материала. Размер элементов и неоднородность сетки в программе EOD могут меняться в достаточно широком диапазоне. Подробно применяемый в программе метод расчета магнитных полей описан в работе [12].
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
В процессе моделирования миниатюрной фокусирующей линзы для электронного литографа с четырьмя колоннами были рассмотрены два типа объективных линз: с аксиальным и радиальным зазорами.
На первом этапе для определения оптимальных размеров полюсных наконечников фокусирующих линз с аксиальным и радиальным зазорами, внешний диаметр магнитопровода которых составлял 64 мм, были рассчитаны осевые аберрации для различных значений зазора магнитопровода S и диаметра канала d. Расчеты проводились для рабочего отрезка длиной 15 мм и энергии электронного пучка 50 кэВ.
Для коэффициента Cs сферической аберрации были построены зависимости от значений S и d.
Линза с аксиальным зазором
На рис. 3а, 3б приведены осевые сечения миниатюрной фокусирующей линзы с аксиальным зазором, для которой ширина зазора S и диаметр канала d составляют 4 и 8 мм соответственно.
Рис. 3.
Изображения сечений миниатюрной линзы с аксиальным зазором: а – половина осевого сечения с наложенной картой распределения магнитной индукции в магнитопроводе линзы; б – трехмерное сечение линзы.

На рис. 4 показана зависимость значений коэффициента Cs сферической аберрации фокусирующей линзы, изображенной на рис. 3, полученная в режиме фокусировки электронного пучка энергии 50 кэВ в плоскости рабочего отрезка от изменения величины зазора и канала магнитопровода линзы. Согласно расчетам, для всех рассмотренных пар значений ширины зазора и диаметра канала магнитная индукция в любой точке магнитопровода линзы не превышала 1.8 Тл, что на 20% меньше индукции насыщения технически чистого железа.
Рис. 4.
Зависимость коэффициента сферической аберрации Cs фокусирующей линзы с аксиальным зазором от ширины зазора S и диаметра канала d магнитопровода линзы.

Как видно из рис. 4, коэффициент сферической аберрации линзы с увеличением ширины зазора и диаметра канала магнитопровода уменьшается от значения 360 до 135 мм, продолжая оставаться достаточно большим в рассмотренном диапазоне значений S и d. Это обстоятельство затрудняет использование магнитных линз рассмотренного типа в качестве объектива ЭОС литографа с высоким разрешением.
Линза с радиальным зазором
На рис. 5 приведено осевое сечение формирующей линзы с радиальным зазором, полученное в программы EOD. Формирующие линзы с радиальным зазором неоднократно рассматривались авторами как элемент ЭОС растрового электронного микроскопа [13–15]. Отличительной чертой такой линзы является расположение ее главной плоскости вне области магнитопровода, в нашем случае ниже на 2.3 мм границы нижнего полюсного наконечника. Для уменьшения магнетизации магнитопровода его форма была выбрана конической, как показано на рис. 5. Магнитопровод линзы имеет длину 80 мм, диаметр канала d = 6 мм и ширину зазора S = 6 мм.
Рис. 5.
Осевое сечение миниатюрной фокусирующей линзы с радиальным зазором S = 6 мм, диаметром канала d = 6 мм и длиной магнитопровода L = 80 мм (а). Половина осевого сечения линзы с кривой распределения магнитной индукции вдоль оси линзы и картой распределения магнитной индукции в магнитопроводе (б).
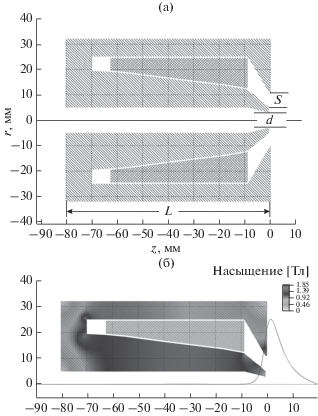
При фокусировке пучка электронов с энергией 50 кэВ в плоскости рабочего отрезка возбуждение катушки линзы составляет 1695 Ампер-витков при плотности тока в катушке 3.8 А/мм2. Максимальное значение магнитной индукции в магнитопроводе объективной линзы Bmax = 1.53 Тл. Коэффициент сферической аберрации Cs составляет 68.8 мм. Диаметр пятна, сфокусированного в плоскости рабочего отрезка, точечного при указанных условиях для полуугла сходимости пучка 5 и 10 мрад, равен 0.23 и 0.35 нм соответственно.
На рис. 6 показана зависимость значений коэффициента сферической аберрации Cs линзы с радиальным зазором, приведенной на рис. 5, от величины ее зазора и диаметра канала.
Рис. 6.
Зависимость коэффициента сферической аберрации Cs фокусирующей линзы с радиальным зазором от диаметра канала d и ширины зазора S.

Коэффициент сферической аберрации Cs в этом случае уменьшается при увеличении диаметра канала d и (в отличие от случая магнитной линзы с аксиальным зазором) при уменьшении величины зазора S, достигая значения Cs = 46.7 мм при ширине зазора S = 4.5 мм и диаметре канала d = 9 мм.
При изменении значений S и d максимальное значение магнитной индукции в магнитопроводе линзы достигает своего наибольшего значения Bmax = 1.75 Тл для линзы с минимальным значением коэффициента сферической аберрации, т. е., когда S = 4.5 мм и d = 9 мм. Таким образом, для всех рассмотренных пар S и d значение Bmax отличается от индукции насыщения технически чистого железа не менее чем на 22%.
Вследствие необходимости размещения в ЭОС литографа других функциональных и конструктивных элементов (отклоняющих систем, стигматора, диафрагм, обеспечивающих требуемые параметры экспонирования) длина магнитопровода входящих в ЭОС электромагнитных линз играет немаловажную роль. В этой связи для рассмотренной фокусирующей линзы с радиальным зазором было проведено исследование зависимости ее электромагнитных свойств, в том числе насыщения магнитопровода и плотности тока в катушке линзы, от длины магнитопровода.
Расчеты проводились в режиме фокусировки в плоскости Z = 15 мм, соответствующей рабочему отрезку, для кроссовера, находящегося на оптической оси в положении Z = –190 мм. При этом другие геометрические параметры линзы: форма полюсных наконечников, ширина зазора, радиус магнитопровода, а также рабочий отрезок оставались без изменения, в результате чего осевые аберрации линзы не менялись. Так коэффициент сферической аберрации на всех этапах изменения длины магнитопровода оставался равным Cs = 68.8 мм. Длина магнитопровода линзы менялась в диапазоне от 80 до 40 мм. Уменьшение длины магнитопровода линзы ведет к уменьшению площади сечения ее катушки, что (в свою очередь) приводит к изменению возбуждения линзы, необходимого для фокусировки электронного пучка в плоскости рабочего отрезка и, таким образом, к увеличению плотности тока в катушке линзы. На рис. 7 приведены зависимости максимального значения магнитной индукции в магнитопроводе объективной линзы Bmax и плотности тока j в катушке линзы от длины L ее магнитопровода.
Рис. 7.
Зависимости плотности тока j в катушке фокусирующей линзы с радиальным зазором (1) и максимального значения магнитной индукции Bmax в магнитопроводе линзы (2) от длины L магнитопровода линзы.
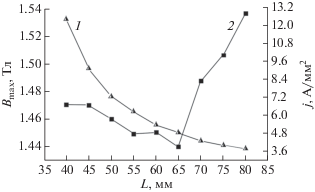
Как видно из рис. 7, для рассмотренной миниатюрной линзы оптимальным выбором по отношению к плотности тока катушки и насыщению магнитопровода является длина магнитопровода, равная 65 мм, в окрестности которой кривая магнетизации 2 имеет явно выраженный минимум Bmax = 1.44 Тл. При этом плотность тока в катушке линзы, обеспечивающая фокусировку пучка в плоскости рабочего отрезка, составляет 4.8 А/мм2.
Результатом соответствующей оптимизации по длине магнитопровода для линзы с минимальным коэффициентом сферической аберрации Cs = 46.7 мм является линза с длиной магнитопровода 74 мм, значением магнитной индукции Bmax = 1.737 (минимальное значение при изменении длины магнитопровода от 80 до 60 мм) и плотностью тока в катушке линзы 4.67 А/мм2.
ЗАКЛЮЧЕНИЕ
Характеристики полученной миниатюрной линзы обеспечивают при энергии электронов 50 кэВ и рабочем отрезке 15 мм отсутствие насыщения магнитопровода. Значение Bmax не превышает 1.8 Тл для магнитопровода из технически чистого железа при плотности тока в катушке менее 10 А/мм2, при этом разрешение не превышает 25 нм.
Проведенное моделирование магнитной линзы позволяет выбрать оптимальную конфигурацию ее геометрии для применения в многоколонных системах высоковольтной электронно-лучевой литографии. Полученные результаты могут быть использованы при проектировании электронно-оптических систем электронно-лучевых литографов.
Список литературы
Liu E.D., Tran C., Prescop T., Lam D.K. // Proc. of SPIE. 2012. V. 8323. P. 1Y-1. https://doi.org/10.1117/12.916118
Hayakawa H., Takizawa M., Kurokawa M., Tsuda A., Takigawa M., Hamaguchi S., Yamada A., Sakamoto K., Nakamura T. // Proc. of SPIE. 2013. V. 8701. P. 03-1. https://doi.org/10.1117/12.2029193
Kurokawa M., Sato T., Kojima S., Yamada A., Multicolumn charged particle beam exposure apparatus // US Patent. 2017/0323760A1.
Yamada A., Tanaka H., Abe T., Shimizu Y. // Proc. of SPIE. 2013. V. 8680. P. 25-1. https://doi.org/10.1117/12.2011376
Slot E., Wieland M., de Boer G., Kruit P., ten Berge G., Houkes A., Jager R., van de Peut T., Peijster J., Steenbrink S., Teepen T., van Veen A., Kampherbeek B. // Proc. of SPIE. 2008. V. 6921. P. 1P-1. https://doi.org/10.1117/12.771965
Platzgummer E., Klein C., Loeschner H. // J. Micro/Nanolith. MEMS MOEMS. 2013. V. 12(3). P. 031108-1. https://doi.org/10.1117/1.JMM.12.3.031108
Platzgummer E., Klein C., Loeschner H. // Proc. of SPIE. 2011. V. 8166. P. 22-1. https://doi.org/10.1117/12.895523
Servin I., Thiam N.A., Pimenta-Barros P., Pourteau M., Mebiene A., Jussot J., Pradelles J., Essomba P., Lattard L., Brandt P., Wieland M. // Proc. of SPIE. 2015. V. 9423. P. 1C-1. https://doi.org/10.1117/12.2085915
Kemen T., Garbowski T., Zeidler D. // Proc. of SPIE. 2015. V. 9658. P. 07-1. https://doi.org/10.1117/12.2195705
Силадьи М. Электронная и ионная оптика (Пер. с англ.). Москва: Мир, 1990. 639 с.
Lencova B., Zlamal J. // Nucl. Instrum. Methods in Phys. Res. A. 2011. V. 645. Iss. 1. P. 278. https://doi.org/10.1016/j.nima.2010.12.198
Lencova B. // Nucl. Instrum. Methods in Phys. Res. A. 1999. V. 427. P. 329. https://doi.org/10.1016/S0168-9002(98)01551-4
Казьмирук В.В., Савицкая Т.Н. // Изв. РАН. Сер. физ. 2011. Т. 75. № 9. С. 1263.
Казьмирук В.В., Курганов И.Г., Савицкая Т.Н. // Изв. РАН. Сер. физ. 2014. Т. 78. № 9. С. 1058.
Казьмирук В.В., Курганов И.Г., Савицкая Т.Н. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2019. № 7. С. 36. https://doi.org/10.1134/S1027451019040074
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


