Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 6, стр. 68-76
Влияние фокусировки зонда РЭМ на формирование изображений рельефных структур
Ю. А. Новиков *
Институт общей физики им. А.М. Прохорова РАН
119991 Москва, Россия
* E-mail: nya@kapella.gpi.ru
Поступила в редакцию 24.01.2019
После доработки 28.02.2019
Принята к публикации 05.03.2019
Аннотация
Проведено исследование влияния фокусировки зонда растрового электронного микроскопа на формирование изображений рельефных структур в режимах сбора вторичных медленных и обратно рассеянных электронов. В экспериментах использовались выступы и канавки в кремнии с трапециевидным профилем и большими углами наклона боковых стенок. В процессе дефокусировки диаметр зонда увеличивался до 8 раз. Показано, что изображение в режиме сбора вторичных медленных электронов значительно меняется, в то время как в режиме сбора обратно рассеянных электронов изображение в пределах шумов не изменилось. Указаны области сигналов, на которые влияет фокусировка растрового электронного микроскопа. Сделан вывод, что фокусировку необходимо осуществлять только в режиме сбора вторичных медленных электронов.
ВВЕДЕНИЕ
Растровый электронный микроскоп (РЭМ) является одним из самых распространенных приборов для исследования рельефа поверхности твердого тела и измерения размеров элементов микро- и наноструктур [1–7]. Это обусловлено тем, что для РЭМ разработаны тест-объекты [8–11] для его калибровки и сами методы калибровки РЭМ [8, 12–14], доведенные до российских национальных стандартов (ГОСТ Р) [15, 16], и методы измерения линейных размеров [8, 11, 17–23 ] в микрометровом (1–1000 мкм) и нанометровом (1–1000 нм) диапазонах. Это позволило создать систему передачи размера от первичного эталона длины (метра) в нанодиапазон [24, 25] с помощью РЭМ.
Растровые электронные микроскопы могут работать в нескольких режимах: низковольтном (энергия электронов зонда E ≤ 2 кэВ) и двух высоковольтных (E > 2 кэВ) при регистрации вторичных медленных электронов (ВМЭ) и обратно рассеянных электронов (ОРЭ). В настоящее время только низковольтный режим и высоковольтный режим при регистрации ВМЭ получили широкое распространение. Это связано с тем, что именно для этих режимов разработаны методы калибровки РЭМ и измерения на нем линейных размеров микро- и наноструктур. Режим регистрации обратно рассеянных электронов не получил широкого распространения из-за трудностей, связанных со слабой изученностью механизмов формирования изображения в режиме сбора ОРЭ [26–28].
В последнее время появились работы [29–33], в которых удалось решить проблему формирования изображения в РЭМ, работающем в режиме сбора обратно рассеянных электронов. В этой связи встала задача сравнения двух режимов работы РЭМ-регистрации вторичных медленных и обратно рассеянных электронов, их отличительных особенностей, достоинств и недостатков при проведении измерений на РЭМ.
Настоящая работа посвящена изучению влияния фокусировки зонда РЭМ на формирование изображений рельефных структур в режимах сбора вторичных медленных и обратно рассеянных электронов.
ЭКСПЕРИМЕНТАЛЬНАЯ АППАРАТУРА И ИССЛЕДУЕМЫЕ ОБЪЕКТЫ
Метод исследования
Метод исследования формирования РЭМ-изображений во вторичных медленных и обратно рассеянных электронах, использованный в данной работе, аналогичен методу, описанному в работах [26–29]. Фокусировку, выбор увеличения РЭМ и исследуемого элемента рельефа производят по изображению этого элемента в режиме регистрации ВМЭ. Далее, не меняя параметров РЭМ и не двигая образец, проводят повторное сканирование образца, но уже при регистрации сигнала ОРЭ.
Такой метод дает возможность контролировать параметры РЭМ по ВМЭ-изображениям, которые позволяют определять все основные характеристики РЭМ [8–11, 13, 14], в том числе и контролировать фокусировку зонда РЭМ – определять величину диаметра зонда. Неизменность увеличения и фокусировки в обоих режимах регистрации электронов гарантирует одинаковую форму пучка первичных электронов. А одна и та же область сканирования образца дает возможность проводить непосредственное сравнение сигналов, полученных в разных режимах, друг с другом. Это позволяет непосредственно сравнивать сигналы ВМЭ и ОРЭ и устранять ошибки, возникающие в процессе калибровки РЭМ и определении численных значений размеров элементов структур.
Исследуемые объекты
В качестве исследуемых объектов были выбраны выступы и канавки в кремнии с трапециевидным профилем и большими углами наклона боковых стенок. Такие структуры используются для калибровки РЭМ [8–11, 13, 14]. Кроме того, для таких структур, выполненных из монокремния с ориентацией поверхности (100) по технологии жидкостного анизотропного травления, разработаны методы проверки качества их изготовления [34–36], которые показали высокое качество структур, что позволяет устранить влияние недостатков технологии изготовления структур на результаты измерений.
Структурой с трапециевидным профилем и большими углами φ наклона боковых стенок (рис. 1а) является структура, удовлетворяющая условию [8, 9, 37, 38]:
где h – глубина (высота) элемента рельефа структуры (рис. 1а), d – эффективный диаметр электронного зонда РЭМ. Определение эффективного диаметра (далее диаметра) электронного зонда приведено в работах [39, 40].Рис. 1.
Схемы шаговой структуры (а), состоящей из двух выступов и канавки между ними с трапециевидным профилем и большими углами наклона боковых стенок, и ВМЭ-сигнала РЭМ (б), получаемого при сканировании такой структуры.
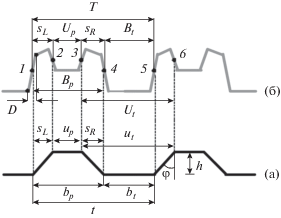
Выражение (1) правильно определяет большие углы наклона боковых стенок. Однако в широкой практике оно неудобно для использования. Гораздо удобнее пользоваться не выражением (1), а неравенством
Здесь sL,R – проекции боковых наклонных левой (L) и правой (R) стенок выступов, которые определены на рис. 1а.Неравенство (2) указывает, что диаметр зонда много меньше величины проекции боковой наклонной стенки выступа или канавки (рис. 1а) на плоскость основания структуры. Специальные исследования, проведенные в работе [21], показали, что особенности РЭМ-изображений во вторичных медленных электронах сохраняются в более широком диапазоне, чем дает выражение (2). Можно считать, что структуры с большими углами наклона боковых стенок удовлетворяют условию:
В качестве объекта с трапециевидным профилем и большими углами наклона боковых стенок в данной работе использовался тест-объект МШПС-2.0К [8, 9, 11, 35, 36]. Тест-объект выполнен из монокремния с ориентацией поверхности (100) по технологии жидкостного анизотропного травления вдоль кристаллографических плоскостей [41]. На рис. 2 приведено ВМЭ-изображение общего вида тест-объекта при разных увеличениях.
Рис. 2.
РЭМ-изображения общего вида (а), центрального модуля (б) и второй шаговой структуры (в) тест-объекта МШПС-2.0К.

Тест-объект состоит из пяти модулей (рис. 2а) по 3 шаговые структуры в каждом модуле (рис. 2б). Шаговые структуры длиной 100 мкм представляют собой 11 канавок (10 выступов) в кремнии (рис. 2в). Структуры могут быть выполнены с размерами верхнего основания выступов, лежащими в диапазоне 5–700 нм, и проекциями боковой наклонной стенки, лежащими в диапазоне 100–900 нм, при одном и том же номинальном значении шага 2000 нм. Аттестация шага тест-объекта была осуществлена на электронно-оптической метрологической системе [42] Физико-технического института (Physikalisch-Technische Bundesanstalt – PTB) Германии. Аттестованное значение шага структуры составило 2001 ± 1 нм. Тест-объект МШПС-2.0К прошел международные сличения [43] в России и Германии.
Плоскости верхних оснований выступов и нижних оснований канавок такой структуры совпадают с кристаллографическими плоскостями {100} кремния, а боковые стенки канавок – с кристаллографическими плоскостями {111} (рис. 3). Качество изготовления таких структур исследовалось в работах [35, 36], где было показано, что такие структуры обладают очень высоким качеством: гладкость стенок находится на атомарном уровне, а плоскости границ рельефных элементов совпадают с соответствующими кристаллографическими плоскостями кремния.
Рис. 3.
Схема расположения кристаллографических плоскостей кремния в структуре, полученной анизотропным травлением пластины кремния с ориентацией поверхности (100) через окна в маске.

На рис. 1 приведены схема двух трапециевидных выступов с большими углами наклона боковых стенок (рис. 1а) и схема ВМЭ-сигнала (рис. 1б). Вертикальными штриховыми линиями на рис. 1 показаны связи граничных точек профиля структуры с контрольными точками 1–6 на сигнале. При симметричном профиле зонда точки 1–6 делят соответствующие отрезки схемы сигнала пополам.
При выполнении условия (2) и условий
параметры сигнала ВМЭ (рис. 1б), структуры (рис. 1а) и микроскопа (m и d) связаны друг с другом соотношениями Здесь m – размер пикселя на ВМЭ-изображении. В силу метода исследования формирования ВМЭ и ОРЭ-изображений, изложенного выше, размер пикселя на ОРЭ-изображении будет такой же. Используя выражения (5)–(9), можно определить размер пикселя m и диаметр зонда d, если известен хотя бы один параметр рельефной структуры. Кроме того, с помощью выражений (5)–(8) можно определить все остальные параметры профиля структуры, если знать размер пикселя на изображении.На рис. 4 приведены ВМЭ-сигналы [40], полученные при сканировании выступа тест-объекта МШПС-2.0К в РЭМ при разных энергиях электронов зонда. Видно, что не при всех энергиях форма сигнала совпадает со схемой сигнала (рис. 1б). Только при энергиях меньше 2 кэВ или больше 10 кэВ форма ВМЭ-сигнала совпадает со схемой сигнала. Поэтому эксперименты следует проводить при значениях энергий первичных электронов больше 10 кэВ.
Рис. 4.
Формы ВМЭ-сигналов, полученных на РЭМ при сканировании выступа тест-объекта МШПС-2.0К зондами с энергиями первичных электронов 0.3, 0.6, 1.0, 2.5, 5, 10, 15, 20 кэВ (сигналы 1–8 соответственно).

Для экспериментов с дефокусировкой зонда РЭМ были выбраны 5 и 6 выступы и канавка между ними (нумерация слева направо) второй шаговой структуры (рис. 2в) центрального модуля (рис. 2б) тест-объекта МШПС-2.0К (рис. 2а) на уровне горизонтальных направляющих линий. Именно в этом месте была аттестована величина шага тест-объекта. На рис. 5 приведены изображения 5 и 6 выступов в режиме сбора ВМЭ (рис. 5а) и ОРЭ (рис. 5б) при сфокусированном зонде, а на рис. 6 в режиме сбора ВМЭ (рис. 6а) и ОРЭ (рис. 6б) при максимальной дефокусировке.
Экспериментальная аппаратура
Эксперименты проводились на РЭМ S-4800. Энергия электронов зонда составляла 20 кэВ. Рабочее расстояние в процессе эксперимента было 9.8 мм. Размер получаемого изображения 2560 × × 1920 pix. Более подробные сведения о микроскопе и режимах его работы приведены в статье [29].
Калибровка РЭМ (определение размера пикселя m и диаметра зонда d) осуществлялась с помощью того же самого тест-объекта МШПС-2.0К, на котором изучалось формирование ВМЭ и ОРЭ-изображений по ВМЭ-изображениям [8–10] как на сфокусированном изображении, так и при дефокусировках. Дефокусировка РЭМ осуществлялась поворотом ручки фокусировки. Были получены ВМЭ и ОРЭ-изображения при сфокусированном зонде и трем дефокусировкам.
Калибровка РЭМ (определение размера пикселя m и диаметра зонда d) осуществлялась с использованием размера шага T и параметра D на ВМЭ-сигналах (рис. 1б) и аттестованного значения шага t структуры (рис. 1а). При использовании выражения (5) и (9), были получены параметры РЭМ, соответствующие сфокусированному и трем дефокусированным изображениям. Эти параметры представлены в табл. 1. Среднее значение размера пикселя по всем четырем измерениям, определенное по методу наименьших квадратов, составляет
(10)
$m = 1.9648 \pm 0.0010{\text{ }}{{{\text{нм}}} \mathord{\left/ {\vphantom {{{\text{нм}}} {{\text{pix}}}}} \right. \kern-0em} {{\text{pix}}}}$Таблица 1.
Параметры РЭМ в эксперименте с дефокусировкой электронного зонда
| m, нм/pix | d, нм | |
|---|---|---|
| Фокусировка | 1.962 ± 0.002 | 8.9 ± 0.2 |
| Дефокусировка 1 | 1.967 ± 0.002 | 19.5 ± 0.5 |
| Дефокусировка 2 | 1.966 ± 0.002 | 32.7 ± 0.9 |
| Дефокусировка 3 | 1.964 ± 0.002 | 74 ± 2 |
Номинальное значение размера пикселя, заданное фирмой изготовителем РЭМ, составляло 1.984375 нм/pix. Отклонение среднего значения экспериментальных размеров пикселя от номинального значения составляет ~1%, что очень много для данного микроскопа. Однако максимальные расхождения экспериментальных значений не превышают 0.2%, что является хорошим результатом измерений.
При сфокусированном зонде его диаметр составил 8.9 нм, что является хорошей величиной для данного микроскопа. Максимальная дефокусировка увеличила диаметр зонда до 74 нм. Это очень большое увеличение размера зонда. Однако величина проекции боковой наклонной стенки используемого тест-объекта была 390 нм. Поэтому даже при максимальной дефокусировке выполняется не только выражение (3), но и (2). Следовательно, тест-объект можно считать имеющим большие углы наклона боковой стенки во всем используемом в эксперименте диапазоне фокусировок.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЯ
На тест-объекте был выбран участок с хорошо заметным дефектом поверхности (на рис. 5а и 6а этот дефект указан стрелками). На ВМЭ-изображениях этот дефект хорошо виден как при фокусировке (рис. 5а), так и при максимальной дефокусировке (рис. 6а). В то время как на ОРЭ-изображениях этот дефект не виден (рис. 5б и 6б) ни при какой фокусировке. Это связано с тем, что механизмы формирования ВМЭ-изображений определяются поверхностными свойствами исследуемого объекта, а ОРЭ-изображений определяются глубинными характеристиками рельефной поверхности. В процессе исследования область с дефектом из анализа исключалась.
Для уменьшения шумов, в анализе использовалось суммирование сигналов. Это возможно благодаря высокому качеству [35, 36] изготовления тест-объектов с трапециевидным профилем и большими углами наклона боковых стенок. Кроме того, расстояние между строками (~2 нм) много меньше диаметров зондов как для сфокусированного, так и для дефокусированных зондов. Поэтому одно и то же место тест-объекта сканируется многократно. Это также позволяет суммировать сигналы без потери информации.
На рис. 7 приведены суммированные по 10-ти сигналам ВМЭ (рис. 7а) и ОРЭ (рис. 7б) сигналы сфокусированного (сигналы 1) и максимально дефокусированного (сигналы 2) изображений, представленных на рис. 5 и 6 соответственно. Хорошо видно, что дефокусировка достаточно сильно искажает ВМЭ-сигнал. В то же время на ОРЭ-сигнал (рис. 7б) дефокусировка оказывает очень слабое (практически нулевое) влияние. Область искажения показана на рис. 7 стрелками. Для большей наглядности на рис. 8 приведены отдельные части ВМЭ (рис. 8а) и ОРЭ (рис. 8б) сигналов, соответствующие правой наклонной стенке левого выступа, при сфокусированном зонде (сигнал 1) и максимально дефокусированном зонде (сигнал 2). Сигналы наложены друг на друга. Хорошо видно, что влияние дефокусировки на ВМЭ-сигнал достаточно сильное, а на ОРЭ-сигнал на фоне шумов практически незаметное. И это при изменении диаметра зонда в 8 (!) раз. Такое поведение ОРЭ-сигнала указывает на значительные трудности, возникающие при фокусировании пучка электронов в процессе измерений на РЭМ в режиме регистрации обратно рассеянных электронов.
Рис. 7.
ВМЭ (а) и ОРЭ (б) сигналы изображений 5 и 6 выступов шаговой структуры тест-объекта. Сигналы 1 получены при сфокусированном зонде, сигналы 2 соответствуют максимально дефокусированному зонду. Стрелками на ВМЭ сигналах показаны области, которые изменяются или должны меняться при изменении фокусировки.

Рис. 8.
Части реальных ВМЭ (а) и ОРЭ (б) сигналов, полученных для сфокусированного 1 и максимально дефокусированного 2 зонда. Стрелками на сигналах показаны области, которые изменяются или должны меняться при изменении фокусировки зонда.

Для сравнения с экспериментом были рассчитаны формы сигналов с использованием моделей формирования ВМЭ и ОРЭ сигналов, описанных в работе [44]. Согласно этим моделям ВМЭ сигнал VSSE формируется двумя сигналами: сигналом VBSE, полученным в результате регистрации обратно рассеянных электронов, и сигналом VLE, полученным в низковольтном режиме работы РЭМ,
(11)
${{V}_{{SSE}}}\left( t \right) = {{A}_{{BSE}}}{{V}_{{BSE}}}\left( t \right) + {{A}_{{LE}}}{{V}_{{LE}}}\left( t \right),$На рис. 9 приведены части модельных ВМЭ (рис. 9а) и ОРЭ (рис. 9б) сигналов, аналогичные частям реальных сигналов, показанных на рис. 8. Видно, что реальные (рис. 8) и модельные (рис. 9) сигналы одинаковые (вклады ОРЭ и НВ-сигналов, лучше всего описывающих эксперимент, составляют 2 и 1 соответственно). Модельные и экспериментальные сигналы не стали накладывать друг на друга, так как совпадения столь хороши, что реальные и модельные сигналы закрывают друг друга. На рис. 9 убедительно показано, что дефокусировка значительно влияет на части ВМЭ-сигнала. В то же время дефокусировка практически не влияет на ОРЭ-сигнал. Области влияния фокусировки на сигналы показаны стрелками.
Рис. 9.
Части модельных ВМЭ (а) и ОРЭ (б) сигналов, полученных для сфокусированного 1 и максимально дефокусированного 2 зонда. Стрелками на сигналах показаны области, которые изменяются при изменении фокусировки зонда.
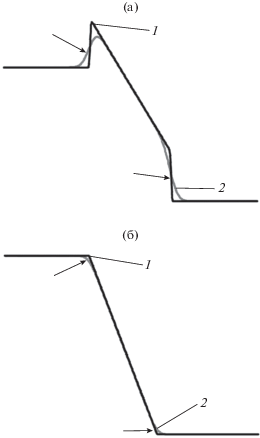
На рис. 10 приведены ВМЭ-сигналы 1 и ОРЭ-сигналы 2, из которых состоят сфокусированные (рис. 10а) и дефокусированные (рис. 10б) изображения, показанные на рис. 5 и 6. Сигналы отнормированы и наложены друг на друга. Хорошо видно, что ВМЭ-сигналы 1 состоят из ОРЭ-сигналов 2 и еще одного сигнала как для сфокусированного, так и для дефокусированного изображений.
Рис. 10.
ВМЭ-сигналы 1 и ОРЭ-сигналы 2, из которых состоят сфокусированные (а) и максимально дефокусированные (б) изображения, показанные на рис. 5 и 6 соответственно.

Для выяснения природы этого другого сигнала на рис. 11 приведены модельные ВМЭ-сигналы 1, ОРЭ-сигналы 2 и сигналы низковольтного (НВ) РЭМ-сигналы 3 для сфокусированного (рис. 11а) и дефокусированного (рис. 11б) зондов, рассчитанные по моделям, представленным в работе [44]. Как видно ВМЭ-сигналы состоят из ОРЭ и НВ-сигналов. Причем влияние фокусировки на ВМЭ-сигнал осуществляется через низковольтный сигнал.
ЗАКЛЮЧЕНИЕ
Дефокусировка РЭМ значительно влияет на изображение, полученное в режиме сбора вторичных медленных электронов, и почти не влияет на изображение, полученное в режиме сбора обратно рассеянных электронов. Поэтому в процессе работы на РЭМ фокусировку изображения необходимо осуществлять только в режиме сбора вторичных медленных электронов. Даже в том случае, если планируется осуществлять работу на РЭМ только в режиме сбора обратно рассеянных электронов.
Список литературы
Reimer L. Scanning Electron Microscopy: Physics of Image Formation and Microanalysis. / Ed. Springer-Verlag. Berlin, Heidelberg, N.Y. 1998.
Marchman H.M., Griffith J.E., Guo J.Z.Y., Frackoviak J., Celler G.K. // J. Vac. Sci. Technol. 1994. V. B12. № 6. P. 3585.
Новиков Ю.А., Раков А.В. // Микроэлектроника. 1996. Т. 25. № 6. С. 417.
Новиков Ю.А., Раков А.В. // Измерительная техника. 1999. № 1. С. 14.
Postek M.T., Vladar A.E. Handbook of Silicon Semiconductor Metrology / Ed. Diebold A.C. New York--Basel: Marcel Dekker Inc., N.Y.-Basel. 2001. P. 295.
Криштал М.М., Ясников И.С., Полунин В.И., Филатов А.М., Ульяненков А.Г. Сканирующая электронная микроскопия и рентгеноспектральный микроанализ в примерах практического применения. / М.: Техносфера, 2009. 208 с.
Растровая электронная микроскопия для нанотехнологий. Методы и применение. / Под ред. Жу У., Уанга Ж.Л. Пер. с англ. М.: БИНОМ. Лаборатория знаний, 2013. 582 с.
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Прохоров А.М., Раков А.В. // Микроэлектроника. 2002. Т. 31. № 4. С. 243.
Novikov Yu.A., Gavrilenko V.P., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7042. P. 704208. https://doi.org/10.1117/12.794834
Gavrilenko V.P., Mityukhlyaev V.B., Novikov Yu.A., Ozerin Yu.V., Rakov A.V., Todua P.A. // Measurement Science and Technology. 2009. V. 20. P. 084022. https://doi.org/10.1088/0957-0233/20/8/084022
Frase C.G., Hassler-Grohne W., Dai G., Bosse H., Novikov Yu.A., Rakov A.V. // Measurement Science and technology. 2007. V. 18. P. 439. https://doi.org/10.1088/0957-0233/18/2/S16
Новиков Ю.А., Стеколин И.Ю. // Труды ИОФАН. 1995. Т. 49. С. 41.
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Раков А.В. // Микроэлектроника. 2004. Т. 33. № 6. С. 419.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A., Volk Ch.P. // Proc. SPIE. 2009. V. 7272. P. 72720Z. https://doi.org/10.1117/12.813514
Гавриленко В.П., Лесновский Е.Н., Новиков Ю.А., Раков А.В., Тодуа П.А., Филиппов М.Н. // Известия РАН. Серия физическая. 2009. Т. 73. № 4. С. 454.
Gavrilenko V.P., Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7378. P. 737 812. https://doi.org/10.1117/12.821760
Gavrilenko V.P., Kalnov V.A., Novikov Yu.A., Orlikovsky A.A., Rakov A.V., Todua P.A., Valiev K.A., Zhikharev E.N. // Proc. SPIE. 2009. V. 7272. P. 727 227. https://doi.org/10.1117/12.814062
Новиков Ю.А. // Микроэлектроника. 2017. Т. 46. № 1. С. 61. https://doi.org/10.7868/S0544126917010070
Данилова М.А., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. // Измерительная техника. 2008. № 8. С. 20.
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Известия РАН. Серия физическая. 1998. Т. 62. № 3. С. 543.
Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2010. V. 7521. P. 752116. https://doi.org/10.1117/12.854696
Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2006. V. 6260. P. 626015. https://doi.org/10.1117/12.683401
Новиков Ю.А. // Микроэлектроника. 2017. Т. 46. № 1. С. 61. https://doi.org/10.7868/S0544126917010070
Гавриленко В., Новиков Ю., Раков А., Тодуа П. // Наноиндустрия. 2009. № 4. С. 36.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7405. P. 740504. https://doi.org/10.1117/12.826164
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Труды ИОФАН. 1998. Т. 55. С. 100.
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Известия вузов. Электроника. 1998. № 1. С. 91.
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2011. № 10. С. 5.
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2014. № 8. С. 46. https://doi.org/10.7868/S0207352814080101
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 5. С. 78. https://doi.org/10.7868/S0207352815050091
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 10. С. 59. https://doi.org/10.7868/S0207352815100170
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2016. № 2. С. 66. https://doi.org/10.7868/S0207352816020086
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2016. № 9. С. 12. https://doi.org/10.7868/S0207352816090110
Todua P.A., Gavrilenko V.P., Novikov Yu.A., Rakov A.V. // Proc. SPIE. 2008. V. 7042. P. 704209. https://doi.org/10.1117/12.794926
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. Т. 46. № 11. С. 77. https://doi.org/10.7868/S0207352817110105
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2018. № 12. С. 86. https://doi.org/10.1134/S0207352818120144
Новиков Ю.А., Раков А.В., Тодуа П.А. // Измерительная техника. 2009. № 2. С. 22.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2010. V. 7718. P. 77180Y. https://doi.org/10.1117/12.853892
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Плотников Ю.И., Раков А.В., Тодуа П.А. // Труды ИОФАН. 2006. Т. 62. С. 77.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7042. P. 70420C. https://doi.org/10.1117/12.794891
Броудай И., Мерей Дж. Физические основы микротехнологии. / Пер. с англ. М.: Мир. 1985. 496 с.
Haessler-Grohne W., Bosse H. // Measurement Science and Technology. 1998. V. 9. P. 1120.
Волк Ч.П., Горнев Е.С., Календин В.В., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Bosse H., Frase C.G. // 12 Российский симпозиум по растровой электронной микроскопии и аналитическим методам исследования твердых тел. Черноголовка. 2001. Тезисы докладов. С. 128.
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 4. С. 263. https://doi.org/10.7868/S0544126914050068
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования