Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 8, стр. 70-77
Теоретическое объяснение эффекта уменьшения энергии плазмонов Si(111) при имплантации ионов с большой дозой
А. С. Рысбаев a, *, Ж. Б. Хужаниёзов a, М. Т. Нормурадов b, А. К. Ташатов b, Б. Д. Игамов a, С. Т. Абраева a
a Ташкентский государственный технический университет им. И.А. Каримова
100095 Ташкент, Узбекистан
b Каршинский государственный университет
180103 Карши, Узбекистан
* E-mail: rysbaev@mail.ru
Поступила в редакцию 07.12.2019
После доработки 28.01.2020
Принята к публикации 30.01.2020
Аннотация
В работе приводится теоретическое объяснение экспериментально обнаруженного эффекта уменьшения энергии возбуждения поверхностных и объемных плазменных колебаний валентных электронов кремния Si(111) при имплантации ионов Ва и щелочных элементов с большой дозой D > > 1016 см–2. Наблюдаемый эффект уменьшения энергии плазмонов Si(111) объясняется на основе двухжидкостной модели электронного газа сильным затуханием колебаний валентных электронов вследствие разупорядочения кристаллической структуры Si(111) вплоть до полной аморфизации.
ВВЕДЕНИЕ
В последнее десятилетие наноматериалам уделяется особое внимание со стороны исследователей практически всех специальностей, причем с каждым годом растет число публикаций по этой тематике в геометрической прогрессии. В первую очередь это связано с тем, что результаты исследований в этой области привели к открытию многих уникальных свойств вещества в нанокристаллическом состоянии. Это позволило создать не только совершенно новые материалы и устройства, но и изменить многие представления ученых об окружающем нас мире [1, 2].
Наибольший интерес наносистемы представляют в связи с проявлением в них эффектов размерного квантования. К таким эффектам относят: образование квантовых точек, когда размеры частиц полупроводника соизмеримы с де-бройлевской длиной волны электрона; изменение ширины запрещенной зоны за счет локализации экситонов; окраску металлических частиц ввиду плазмонного резонанса. Размерные эффекты наиболее ярко выражены для нанокластеров, т.е. частиц с размерами менее 5 нм.
Проведенные ранее нами [3–5] экспериментальные исследования спектров характеристических потерь энергии электронов с Ер = 30–300 эВ, отраженных от кремния, имплантированного ионами Ва+ и щелочных элементов с дозой D, превышающей дозу аморфизации Da показали, что важнейшей особенностью этих спектров является уменьшение энергии поверхностных и объемных плазмонов с ростом дозы облучения матрицы примесными ионами. В данной работе мы попытались теоретически объяснить наблюдаемый в эксперименте эффект уменьшения энергии плазмонов Si(111) при имплантации ионов с большой дозой.
Существующие представления о процессе однократных характеристических потерь энергии налетающих электронов средних энергий с их последующим отражением от мишени основываются на таком теоретическом описании процесса испускания электроном плазмона в акте неупругого столкновения с электронами среды и столкновения с некогерентно и упруго рассеивающими центрами, в котором законы сохранения энергии и импульса выполняются в каждом акте рассеяния. Такие представления справедливы только тогда, когда можно пренебречь всеми диссипативными процессами, сопровождающими электронный транспорт. Однако в реальности имеет место электронное поглощение, которое связано с процессами диссипации энергии и импульса быстрого электрона в процессе его движения в среде. Для описания таких диссипативных процессов в [6] рассмотрен мнимый потенциал электронного волнового поля быстрого электрона. Этот мнимый потенциал для электронов средних энергий определяется в основном тремя процессами диссипации энергии и импульса: выходом электрона из когерентного состояния за счет испускания плазмонов, за счет потери энергии при возбуждении электронно-дырочных пар, за счет малоуглового некогерентного упругого рассеяния на атомах. В соответствии с “оптической” теоремой [6] величина мнимого потенциала Г пропорциональна концентрации атомов п и мнимой части Im ƒ(0) амплитуды электронного рассеяния на нулевой угол. Для средних энергий электронов Е ≈ 100–300 эВ отношение Г/$\hbar $ωр ≈ ≈ 0.7–1.0. Следовательно, в каждом акте неупругого рассеяния электрона имеет место отклонение от условий выполнения законов сохранения на величину Г, сравнимую с плазменной энергией $\hbar $ωр.
Однотипное в генетическом плане явление перенормировки энергии объемного плазмона в переходном металле хорошо известно и достаточно подробно проанализировано в монографии Пайнса [7], а также в работах [8–10]. Суть этого явления кратко заключается в том, что уменьшение энергии плазмона по отношению к плазменной частоте колебаний s-электронов обусловлено влиянием поляризации d-электронов, зона которых расположена ниже уровня Ферми на расстоянии, превышающем энергию плазменного колебания s-электронов.
Аналогичную ситуацию в плане перенормировки энергии объемного плазмона, вероятно, следует ожидать и в ионно-имплантированном полупроводнике, где за счет экранировки, связанной с поляризацией остовных электронов примесного иона, плазменная частота слоя постепенно с ростом дозы облучения должна уменьшается по отношению к своему значению в матрице.
МЕТОДИКА
Экспериментальные измерения проводили в приборе с анализатором типа сферического зеркала с тормозящим полем, позволяющим исследовать поверхность методами электронной оже-спектроскопии (ЭОС), спектроскопии упруго рассеянных электронов (СУРЭ), фотоэлектронной спектроскопии (ФЭС), спектроскопии характеристических потерь энергии электронов (СХПЭЭ) и дифракции медленных электронов (ДМЭ) при давлении остаточных газов не более 10–7 Па [11]. В качестве объектов исследования были выбраны монокристаллы Si (111) n- и р-типа с удельным сопротивлением 6000 Ом · см. Очистку образцов проводили термическим прогревом в два этапа: длительно при температуре 1200 К в течение 60 мин и кратковременно при 1500 К в течение 1 мин, а также разработанным авторами [12] новым способом вакуумной очистки поверхности Si, который заключается в создании в приповерхностной области внутреннего геттерирующего слоя имплантацией ионов Ва или щелочных элементов с низкой энергией (до 5 кэВ) и последующим удалением геттерного слоя кратковременным высокотемпературным прогревом.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Целью работы является теоретическая интерпретация обнаруженного в эксперименте эффекта уменьшения энергии возбуждения объемных и поверхностных плазменных колебаний в Si(111) и Si(100) при имплантации ионов Ва и щелочных элементов с низкой энергией.
На рис. 1 и 2 приведены спектры ХПЭ для Si(111), имплантируемых ионами Na+ и Ba+ с энергией Е0 = 1 кэВ с различной дозой облучения D, см–2: 5 × 1013 (кривая 2), 5 × 1014 (3), 7 × 1015 (4), 1 × 1016 (5), 8 × 1016 (6) и 2 × 1017 (7), снятые при энергии первичных электронов Ер = 100 эВ. На спектре ХПЭ чистого кремния (кривая 1) наблюдаются пики с потерями энергии: 7, 11, 17 и 22 эВ, обусловленные возбуждением межзонного перехода (7 эВ), поверхностных ($\hbar {{\varpi }_{s}}$ = 11 эВ), объемных ($\hbar {{\varpi }_{{\text{p}}}}$ = 17 эВ) и кратных им (2$\hbar {{\varpi }_{s}}$ = 22 эВ) плазменных колебаний валентных электронов. Экспериментально наблюдаемые нами значения энергии возбуждения поверхностных и объемных плазменных колебаний валентных электронов для чистого Si (111) хорошо согласуются со значениями, полученными расчетным путем по формуле Бома и Пайнса [7].
Рис. 1.
Спектры ХПЭ для чистого Si (111) (кривая 1) и Si, имплантированного ионами Na+ с Е0 = 1 кэВ с различной дозой D, см–2: 5 × 1013 (2), 5 × 1014 (3), 7 × × 1015 (4), 1 × 1016 (5), 8 × 1016 (6), 2 × 1017 (7).

Рис. 2.
Спектры ХПЭ для чистого Si (111) (кривая 1) и Si, имплантированного ионами Ba+ с Е0 = 1 кэВ с различной дозой D, см–2: 5 × 1013 (2), 5 × 1014 (3), 5 × 1015 (4), 1 × 1016 (5), 8 × 1016 (6), 2 × 1017 (7).
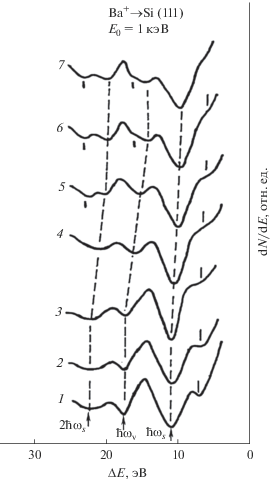
В спектре 7, для Si, имплантированного ионами Na+ с дозой D = 2 × 1017 см–2, наблюдаются пики ХПЭ при 6; 9.2; 13.2; 18.5 и 25 эВ. Пик при 6 эВ, вероятно, связан с возбуждением межзонного перехода электронов из валентной зоны NaSi в зону проводимости. А характер изменения интенсивностей пиков при 9.2 и 13 эВ с увеличением энергии Ер от 30 до 300 эВ позволил нам считать первый пик обусловленным возбуждением поверхностного плазмона, а второй – возбуждением объемного плазмона в ионно-имплантированном Si. Характерной особенностью спектров ХПЭ, приведенных на рис. 1 и 2 является смещение пиков плазменных потерь энергии электронов в область меньших значений с увеличением дозы имплантируемых ионов натрия и бария соответственно.
При исследовании изменения кристаллической структуры поверхности Si(111) и Si(100) методом ДМЭ в процессе имплантации ионов Ва+ и щелочных элементов с энергией 0.5–5 кэВ было установлено, что начиная с некоторой дозы ионов Da, поверхность кремния полностью аморфизируется. Обнаружено, что для данного типа ионов величина Da уменьшается с ростом энергии имплантируемых ионов. В табл. 1 приведены значения Da поверхности Si(111) при имплантации ионов Li+, Na+, K+, Rb+, Cs+ и Ba+ с разной энергией.
Таблица 1.
Минимальные значения дозы аморфизации поверхности Si(111)/Si(100)
| Энергия ионов Е0, эВ | Значения дозы аморфизации поверхности Si(111)/Si(100) Dа, × 1015 см–2 | |||||
|---|---|---|---|---|---|---|
| Li+ | Na+ | K+ | Rb+ | Cs+ | Ba+ | |
| 500 | 10/12 | 7/9 | 6/8 | 6/8 | 4/6 | 4/5 |
| 1000 | 7/8 | 5/7 | 5/7 | 5/7 | 2/4 | 1/3 |
| 2000 | 5/7 | 3/5 | 3/4 | 4/3 | 1/2 | 0.7/1 |
| 3000 | 3/5 | 1/3 | 0.8/2 | 0.7/1 | 0.6/1 | 0.6/0.9 |
| 4000 | 1/1.5 | 0.8/1.2 | 0.9/1.2 | 0.5/0.8 | 0.4/0.5 | 0.3/0.6 |
| 5000 | 0.5/1 | 0.3/0.6 | 0.2/0.4 | 0.1/0.2 | 0.09/0.1 | 0.08/0.1 |
Из табл. 1 видно, что минимальное значение дозы аморфизации Dа, для легких ионов больше, чем для тяжелых, а также доза аморфизации Si(100) во всех случаях превышает Dа Si(111). Это связано с тем, что при бомбардировке поверхности кремния тяжелыми ионами эффективность дефектообразования повышается из-за большей предельно переданной энергии ионами атомам мишени при их столкновении, а также с тем, что грань (100) является наименее плотной, а (111) является наиболее плотной гранью кремния.
Для определения спектра энергетических потерь первичного пучка в ионно-имплантированном Si мы будем исходить из следующей простейшей структуры приповерхностной области. Имеется нарушенный слой толщиной а, который граничит с ненарушенным чистым Si, занимающим остальное полупространство (рис. 3). На рисунке область а > z > 0 – область нарушенного слоя, z > а – область чистого материала:
(1)
${{\varepsilon }_{0}}\left( \omega \right) = 1 - \frac{{\omega _{{{\text{р0}}}}^{2}}}{{{{{\left( {\omega - i\nu } \right)}}^{2}}}}.$В длинноволновом пределе, диэлектрическая проницаемость ионно-легированного полупроводника может быть записана в виде суммы:
где ε0(ω) – диэлектрическая проницаемость исходного чистого полупроводника, а(3)
${{\varepsilon }_{s}}\left( z \right) = \frac{{4\pi {{e}^{2}}}}{m}{{N}_{{{\text{imp}}}}}\left( z \right)\sum\limits_{l = {\nu }} {\frac{{{{Z}_{{{\text{эф}},1}}}}}{{\left( {\omega _{{{\text{1c}}}}^{2} - \omega _{{{\text{pe}}}}^{2}} \right)}}} $Рассмотрим спектральную интенсивность испускания объемного плазмона налетающим электроном в среде с ДП ε(ω, z) при условии нормального падения на поверхность. В работе [13] изложен метод расчета сечения возбуждения объемного плазмона быстрой заряженной частицей в пространственно неоднородной среде, которой является полубесконечный кристалл. Для рассматриваемой здесь ситуации спектральная интенсивность возбуждения плазмонов имеет вид:
(4)
$\begin{gathered} {{I}_{\omega }} = - \frac{2}{{{{{\left( {2\pi } \right)}}^{3}}{{\hbar }^{2}}{{\upsilon }^{2}}}}\int {dq} \int\limits_{ - \infty }^{ + \infty } {dz} \int\limits_{ - \infty }^{ + \infty } {dz{\kern 1pt} '} \times \\ \times \,\,\exp \left[ { - i\frac{\omega }{\upsilon }\left( {z - z{\kern 1pt} '} \right)} \right]\operatorname{Im} D\left( {z,z{\kern 1pt} ',q,\omega } \right), \\ \end{gathered} $Для среды с локальной ДП ε(ω, z) уравнение для функции D(z, z') будет иметь вид:
(5)
$\begin{gathered} \frac{d}{{dz}}\left[ {\varepsilon \left( {\omega ,z} \right)\frac{{dD}}{{dz}}} \right] - {{q}^{2}}\varepsilon \left( {\omega ,z} \right)D = 0,\,\,\,\,z > 0, \\ \frac{{{{d}^{2}}D}}{{d{{z}^{2}}}} - {{q}^{2}}D = 4\pi {{e}^{2}}\hbar \delta \left( {z - z{\kern 1pt} '} \right),\,\,\,\,z < 0, \\ \end{gathered} $(6)
$\begin{gathered} {{D}_{1}}\left( {z,z{\kern 1pt} ',q,\omega } \right) = \\ = - \frac{{4\pi {{e}^{2}}\hbar {{\varepsilon }_{0}}\left( \omega \right)\exp \left[ {q\left( {z + z'} \right)} \right]}}{{q\left\{ {1 + {{\varepsilon }_{0}}\left( \omega \right) + q\int\limits_0^\infty {dx\left[ {\frac{{{{\varepsilon }_{0}}\left( \omega \right)}}{{\varepsilon \left( {x,\omega } \right)}} - 1} \right]} } \right\}}}, \\ z\,\,\,\,{\text{и}}\,\,\,\,z{\kern 1pt} ' < 0. \\ \end{gathered} $(7)
$\begin{gathered} {{I}_{{{{\omega }_{{\text{1}}}}}}} = - \frac{{2{{e}^{2}}}}{{\pi \hbar {{\nu }^{2}}}} \times \\ \times \,\,\operatorname{Im} \left\{ {{{\varepsilon }_{0}}\frac{{\left[ {\frac{{\pi \nu }}{{2\omega }}\left( {1 + {{\varepsilon }_{0}}} \right) + {{Z}_{{\operatorname{int} }}}\left( \omega \right)\ln \left[ {\frac{{\nu \left( {1 + {{\varepsilon }_{0}}} \right)}}{{\omega {{Z}_{{\operatorname{int} }}}\left( \omega \right)}}} \right]} \right]}}{{\left[ {{{{\left( {1 + {{\varepsilon }_{0}}} \right)}}^{2}} + \frac{\omega }{{{{\nu }^{2}}}}Z_{{\operatorname{int} }}^{2}\left( \omega \right)} \right]}}} \right\}. \\ \end{gathered} $Прежде всего, следует учесть, что входящий в формулу (7) интеграл можно представить следующим образом:
(8)
$\begin{gathered} {{Z}_{{\operatorname{int} }}}\left( \omega \right) = \int\limits_0^\infty {dz\left[ {\frac{{{{\varepsilon }_{0}}\left( \omega \right)}}{{\varepsilon \left( {\omega ,z} \right)}} - 1} \right]} = \\ = - \int\limits_0^\infty {\frac{{dz{{\varepsilon }_{s}}\left( z \right)}}{{[{{\varepsilon }_{0}}\left( \omega \right) + {{\varepsilon }_{s}}\left( z \right)]}}} + i\pi {{\varepsilon }_{0}}(\omega )[ - {{\varepsilon }_{0}}(\omega )] \times \\ \times \,\,\left[ {{{\varepsilon }_{0}}(\omega ) + {{\varepsilon }_{s}}({{z}_{{\max }}})} \right]{{\frac{1}{{\left| {d{{\varepsilon }_{s}}\left( {{z \mathord{\left/ {\vphantom {z {dz}}} \right. \kern-0em} {dz}}} \right){\text{ }}} \right|}}}_{{z = {{z}_{0}}\left( \omega \right)}}}, \\ \end{gathered} $(9)
$\begin{gathered} \left| {{{d{{\varepsilon }_{s}}(z)} \mathord{\left/ {\vphantom {{d{{\varepsilon }_{s}}(z)} {dz}}} \right. \kern-0em} {dz}}} \right| = \left| {{{z}_{0}}(\omega )--{{z}_{{{\text{max}}}}}} \right|F({{z}_{0}}(\omega )), \\ z = {{z}_{0}}(\omega ). \\ \end{gathered} $(10)
${{\left[ {{{z}_{0}}\left( \omega \right) - {{z}_{{\max }}}} \right]}^{2}} \cong \frac{{{{\pi }^{2}}{{\omega }^{2}}\varepsilon _{s}^{2}\left( {{{z}_{{\max }}}} \right)}}{{{{{v}}^{2}}\left\{ {{{{[1 - {{\varepsilon }_{s}}\left( {{{z}_{{\max }}}} \right)]}}^{2}} + \frac{{{{\omega }^{2}}}}{{{{\nu }^{2}}}}{{{\left[ {\int\limits_0^\infty {\frac{{dz{{\varepsilon }_{s}}\left( z \right)}}{{{{\varepsilon }_{s}}\left( z \right) - {{\varepsilon }_{s}}\left( {{{z}_{{\max }}}} \right)}}} } \right]}}^{2}}} \right\}{{F}^{2}}\left( {{{z}_{0}}} \right)}}.$(11)
$\begin{gathered} \operatorname{Im} \int\limits_0^\infty {dz\exp \left( { - 2\chi z} \right)} \frac{1}{{\varepsilon \left( {\omega ,z} \right)}} = \\ = \frac{{\pi [ - {{\varepsilon }_{0}}\left( \omega \right) + {{\varepsilon }_{s}}\left( {{{z}_{{\max }}}} \right)]}}{{\left| {{{d{{\varepsilon }_{s}}} \mathord{\left/ {\vphantom {{d{{\varepsilon }_{s}}} {dz}}} \right. \kern-0em} {dz}}} \right|z = {{z}_{0}}}}\exp [ - 2\chi {{z}_{0}}\left( \omega \right)]. \\ \end{gathered} $Как условие (10), так и выражение (11) показывают, что оба процесса генерации объемного плазмона содержат пик при условии zmax = z0(ω) или ε0(ω) + εs(zmax) = 0. Cледовательно, положение пика объемного плазменного резонанса в ионно-имплантированном полупроводнике приходится на низкочастотный край диапазона возбуждаемых частот, определяемых неравенством –εs(zmax) ≤ ε0(ω) ≤ 0. Поскольку с ростом дозы облучения величина εs(zmax) увеличивается, сдвиг пика в сторону меньших энергий также возрастает по отношению к положению $\hbar $ωрез в чистом полупроводнике.
Известно, что спектр объемных плазмонов определяется функцией ${{J}_{{\text{m}}}}\frac{1}{{\varepsilon (\omega )}},$ энергетическое положение максимума которой соответствуют пику объемных плазмонов. В нарушенном слое диэлектрическая проницаемость ε(ω) отличается от ε0(ω) двумя факторами. Во-первых, внедренные ионы Nа (или Ва), образующие соединение с Si, дают вклад в плазменные колебания с частотой ωp < ωp0 и затуханием γ $ \ll $ ωp. Во-вторых, в системе валентных электронов в области нарушенного слоя увеличивается затухание, так что
(12)
${{\varepsilon }_{s}}\left( \omega \right) = 1 - \frac{{\omega _{{{\text{p}}0}}^{2}}}{{{{{\left( {\omega - i\gamma } \right)}}^{2}}}} - \frac{{\omega _{{\text{p}}}^{2}}}{{{{{\left( {\omega - i\gamma } \right)}}^{2}}}},$Если в чистом Si спектр потерь определяется функцией ${{J}_{{\text{m}}}}\frac{1}{{{{\varepsilon }_{0}}(\omega )}},$ то в ионно-имплантированном Si этот спектр определяется функцией ${{J}_{{\text{m}}}}\frac{1}{{\varepsilon (\omega )}}.$ Максимум функции ${{J}_{{\text{m}}}}\frac{1}{{{{\varepsilon }_{0}}(\omega )}}$ достигается при ω = ωp, когда ν/ωp$ \ll $ 1. Максимум функции ${{J}_{{\text{m}}}}\frac{1}{{\varepsilon (\omega )}}$ может быть сдвинут относительно ω = ωp как в область больших частот, так и в область меньших частот в зависимости от величины отношения $\frac{\gamma }{{{{\omega }_{{\text{p}}}}}}.$ Чем больше значение $\frac{\gamma }{{{{\omega }_{{\text{p}}}}}},$ тем сильнее сдвигается максимум в область частот, меньших ωp. На рис. 4 показаны спектры ${{J}_{{\text{m}}}}\frac{1}{{\varepsilon (\omega )}}$ для A = $\frac{{\omega _{{{\text{p0}}}}^{2}}}{{\omega _{{\text{p}}}^{2}}}$ = = 0.6 и величины $\frac{\gamma }{{{{\omega }_{{\text{p}}}}}}$ = 0.05; 1.0; 1.5; 2 соответственно. Величина $\frac{\gamma }{{{{\omega }_{{\text{p}}}}}}$ = 0.05. Сдвиг максимума спектра в область ω < ωp происходит при $\frac{\gamma }{{{{\omega }_{{\text{p}}}}}}$ ≥ 1, т.е. при достаточно сильном разрушении структуры в области нарушенного слоя. Таким образом, характерной чертой, присущей спектру ХПЭ для объемного плазмона в нарушенном слое, является сильное затухание в системе валентных электронов, которое одного порядка с отношением плазменных частот в металлическом Ва, Na и в чистом Si. Относительный вес, с которым входят спектры ${{J}_{{\text{m}}}}\frac{1}{{{{\varepsilon }_{0}}(\omega )}}$ и ${{J}_{{\text{m}}}}\frac{1}{{\varepsilon (\omega )}}$ в сечение возбуждения объемных плазмонов падающим электроном, может быть определен из теории возбуждения плазмонов в пространственно неоднородной среде. Ясно только то, что вес спектра объемных потерь в нарушенном слое должен сильно зависеть от соотношения толщины этого слоя а и длины λc, на которой падающий электрон выходит из когерентности.
Рис. 4.
Зависимости ${{I}_{m}}\frac{1}{{\varepsilon (\omega )}}$ от $\frac{\omega }{{{{\omega }_{{\text{p}}}}}}$ для Si, имплантированного ионами Ва+, с Е0 = 1 кэВ. Кривым 4–1 соответствуют значения A = $\frac{{\omega _{{{\text{p0}}}}^{2}}}{{\omega _{{\text{p}}}^{2}}}$ = 0.6 и $\frac{{{{\gamma }_{0}}}}{{{{\omega }_{{\text{p}}}}}}$ = 0.5; 1.0; 1.5; 2. Кривые 4'–1' соответствуют Si, имплантированному ионами Na+, а кривые 4–1 ионами Ва+ с дозой 1014, 1015, 1016 и 1017 см–2 соответственно.

Для оценки влияния ионной имплантации на свойства поверхностного плазменного резонанса достаточно исследовать характер испускания таких плазмонов при движении налетающего электрона в вакууме еще до пересечения им границы среды. Дело в том, что при движении электрона в вакууме отсутствует канал черенковского возбуждения объемного плазмона, поэтому вероятность возбуждения поверхностного плазмона в вакууме больше, чем при его движении в полупроводнике.
Спектральное распределение интенсивности возбуждения поверхностного плазмона определяется уже известным выражением (6). Анализ этого выражения показал, что пик спектра поверхностного резонанса имеет место при
(13)
${{\varepsilon }_{0}}\left( \omega \right) + 1 \approx - \frac{3}{8}\frac{{\omega _{{{\text{p0}}}}^{2}}}{{{{\nu }^{2}}}}{{\left[ {\int\limits_0^\infty {dz{{\varepsilon }_{s}}\left( z \right)} } \right]}^{2}},$Из дисперсионного уравнения (13) следует, что положение пика поверхностного резонанса оказывается чувствительным к профилю распределения внедренной примеси. Аналогичное утверждение справедливо, и для положения пика объемного плазмона, что было показано ранее. Закономерности сдвига пика поверхностного плазмона с ростом дозы облучения, т.е. с увеличением величины εs(zmax), в сторону меньших энергий близки к таковым для объемного плазмона.
В качестве демонстрации оценим сдвиг энергетического положения пика объемного плазменного резонанса с ростом дозы облучения кремния ионами натрия [15].
При имплантации ионов натрия в кремний вклад в статическую поляризацию дают четыре электрона оболочки L2.3(ZL2.3= 4) с энергией перехода $\hbar $ωL1,c ≅ 31 эВ и два электрона оболочки L1(ZL1= 2) с энергией перехода $\hbar $ωL1,c ≅ 62 эВ. Функцию εs(z) можно записать в виде εs(z) ≅ ≅ 0.45С(z), где С(z) = Nimp(z)/NSi, a NSi есть концентрация атомов Si в элементарной ячейке, равная NSi = 5 × 1022 cм–3. Выражение для диэлектрической проницаемости ε0(ω) для Si было взято в виде ε0(ω) = 1 – $\omega _{{{\text{pl}}}}^{2}$/(ω2 – $\omega _{{\text{g}}}^{2}$), где $\hbar $ωрv = 16.6 эВ, а величина $\hbar $ωg ≅ 4 эВ. Для расчета зависимости энергии пика объемного плазмона от дозы облучения ионами натрия нами были использованы экспериментальные данные о величине С(zmax) для Na+ → Si при энергии ионов Е0 = 0.5 кэВ, полученные из анализа распределений Nimp(z). Эти значения С(zmax) приведены в табл. 2.
Таблица 2.
Зависимость энергии пика, соответствующего возбуждению объемного плазмона в Si, от дозы облучения ионами Na+ с энергией 1 кэВ
| D, см2 | C (zmax) | zmax, Å | ${{\varepsilon }_{s}}$ (zmax) | $\hbar $ωрез, эВ | ||
|---|---|---|---|---|---|---|
| эксперимент | расчет | |||||
| Na+ | 0 | – | – | 0 | 17.0 | 17.1 |
| 1014 | 0.12 | 33 | 0.092 | 16.75 | 16.72 | |
| 1015 | 0.18 | 27 | 0.079 | 16.0 | 16.4 | |
| 1016 | 0.32 | 21 | 0.141 | 15.0 | 16.0 | |
| 1017 | 0.42 | 20 | 0.234 | 14.0 | 14.1 | |
| Ba+ | 0 | – | – | 0 | 17.0 | 17.1 |
| 1014 | 0.10 | 29 | 0.042 | 16.8 | 16.9 | |
| 1015 | 0.16 | 25 | 0.84 | 16.6 | 16.7 | |
| 1016 | 0.28 | 21 | 0.154 | 15.7 | 15.4 | |
| 1017 | 0.45 | 21 | 0.273 | 13.8 | 13.4 | |
В табл. 2 приведены экспериментальные и расчетные данные о значениях энергии пиков спектра потерь энергии электронов, обусловленных возбуждением ими объемных плазмонов в структуре Na+ → Si и Вa+ → Si. Из сравнения сдвигов пика с ростом дозы облучения видно, что расчетные значения составляют 99% при дозе 1015 см–2 и 76% при дозе 1016 см–2 от значений экспериментально наблюдаемых величин сдвигов энергий пиков объемных плазмонов. Можно предположить, что причиной расхождения между расчетными и экспериментальными значениями сдвигов пиков спектра является увеличение постоянной решетки при имплантации ионов примеси, что приводит в свою очередь к уменьшению энергии плазменных колебаний валентных электронов. Однако теоретическая оценка такого эффекта представляет собой сложную задачу.
ЗАКЛЮЧЕНИЕ
Таким образом представленная теоретическая модель достаточно хорошо объясняет наблюдаемый в эксперименте эффект уменьшения энергии $\hbar $ων и $\hbar $ωs плазмонов Si при имплантации больших доз ионов Ва и щелочных элементов сильным затуханием колебаний валентных электронов в следствии с разупорядочением кристаллической структур Si(111) вплоть до полной аморфизации. В то же время результаты настоящей работы показывают, что эффект статической поляризации остовных электронов примесных ионов существенно влияет на сдвиг энергий пиков потерь на возбуждение плазмонов в ионно-легированном полупроводнике.
Список литературы
Елисеев А.А., Лукашин А.В. Функциональные наноматериалы / Ред. Третьякова Ю.Д. М.: Физматлит, 2010. 452 с.
Суздалев И.П. Нанотехнология: физикохимия нанокластеров, наноструктур и наноматериалов. М.: Ком Книга, 2006. 592 с.
Rysbaev A.S., Nasriddinov S.S., Normuradov M.T. // Uzbek. Phys. Jornal. 2000. № 1. V. 2. P. 33.
Рысбаев А.С. Тонкие наноразмерные силицидные пленки: получение и свойства. Монография. Тверь: Изд-во ТГТУ, 2013. 150 с.
Хужаниёзов Ж.Б., Рысбаев А.С., Бекпулатов И.Р. Особенности возбуждения плазменных колебаний электронов в неупорядоченных полупроводниках. Монография. Ташкент: Infinity Group, 2014. 168 с.
Ландау Л.Д., Лифшиц Е.М. Квантовая механика. Нерелятивистская теория. М.: Физматлит, 1963. 544 с.
Пайнс Д. Элементарные возбуждения в твердых телах. М.: Мир, 1965. 382 с.
Горбаченко В.Д., Жарников М.В., Максимов Е.Г., Рашкеев С.Н. // Журн. эксп. и теор. физики. 1985. Т. 88. Вып. 2. С. 677.
Горбаченко В.Д., Жарников М.В., Максимов Е.Г., Молдосанов К.А. // Журн. эксп. и теор. физики.1984. Т. 86. Вып. 2. С. 597.
Strum M. //Adv. Phys. 1982. V. 31. № 1. P. 64.
Нормурадов М.Т., Руми Д.С., Рысбаев А.С. // Изв. Ан УзССР. Сер. Физ-мат. 1986. № 4. С. 70.
Рысбаев А.С., Хужаниёзов Ж.Б., Рахимов А.М., Бекпулатов И.Р. Способ дополнительной очистки поверхности монокристаллов кремния. Патент № IAP 05720. от 30.11.2018 г.
Либенсон Б.Н., Румянцев В.В. // ЖЭТФ. 1984. Т. 86. С. 1715.
Румянцев В.В., Либенсон Б.Н. // ЖЭТФ. 1982. Т. 83. С. 247.
Рысбаев А.С., Нормурадов М.Т., Хужаниязов Ж.Б., Бекпулатов И.Р., Рахимов А.М. Исследование влияния имплантации ионов бария и щелочных элементов и последующего отжига на кристаллическую структуру поверхности монокристаллов Si(111) и Si(100) // Труды XXIV Международной конференции “Радиационная физика твердого тела”, М.: НИИ ПМТ, 2014. С. 172.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



