Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 8, стр. 61-69
Молекулярно-динамическое моделирование воздействия на кремний ионов инертных газов низкой энергии
А. А. Сычева a, *, Е. Н. Воронина a, b
a Московский государственный университет им. М.В. Ломоносова,
Научно-исследовательский институт ядерной физики
им. Д.В. Скобельцына
119234 Москва, Россия
b Московский государственный университет им. М.В. Ломоносова, Физический факультет
119991 Москва, Россия
* E-mail: sycheva.phys@gmail.com
Поступила в редакцию 11.01.2020
После доработки 25.02.2020
Принята к публикации 28.02.2020
Аннотация
Моделирование воздействия ионов инертных газов (He, Ne, Ar, Kr, Xe) с энергией 50–500 эВ на кристаллический кремний проводилось методом молекулярной динамики с накоплением повреждений. На основании выполненного анализа структурных изменений приповерхностных слоев материала продемонстрированы существенные различия в механизмах повреждения кремния легкими и тяжелыми частицами. Показано, что при воздействии на материал ионов Xe и в особенности ионов He внедренные в материал атомы образуют наиболее крупные кластеры.
ВВЕДЕНИЕ
Физическое распыление, при котором под действием потока налетающих частиц происходит эмиссия атомов из приповерхностных слоев мишени, находит применение в современных технологических процессах, в том числе при плазменной обработке материалов. Одной из ключевых задач микро- и наноэлектроники является реализация технологии атомно-слоевого травления, позволяющей удалять отдельные приповерхностные слои обрабатываемых материалов при обеспечении селективности воздействия на них частиц плазмы. Отличительной особенностью используемых процессов является низкая энергия налетающих ионов, которая обычно составляет от нескольких десятков до сотен электронвольт.
Кремний является одним из наиболее широко применяемых в современной микроэлектронике материалов. К настоящему времени накоплен большой объем экспериментальных данных о физическом распылении кремния при энергиях ионов свыше 1 кэВ [1–3], которые хорошо согласуются с теорией распыления Зигмунда на основе модели линейного каскада [4]. Однако для энергий вблизи порогового значения существующие экспериментальные данные весьма разрознены и в некоторых случаях противоречивы [5–7]. Теоретическое описание воздействия низкоэнергетических ионов на кремний также затруднено, поскольку приближения, используемые в модели линейного каскада, не выполняются [8, 9]. Так, в рамках теории Зигмунда предполагается, что число распыленных атомов мишени в результате воздействия иона пропорционально энергии Edep, выделяющейся в небольшой приповерхностной области материала вблизи точки удара. В работах [8, 9] было показано, что для низких энергий ионов зависимость коэффициента распыления от Edep не является линейной, а форма пространственной области, в которой преимущественно выделяется энергия иона, зависит от типа, энергии и угла падения налетающей частицы, а также плотности материала мишени. Например, при нормальном падении на поверхность кристаллического кремния ионов Xe с энергией 250 эВ указанная область является эллипсоидом, большая ось которого направлена вглубь материала, а для ионов Ar той же энергии близка к правильной сфере [8]. Таким образом, для исследования механизмов воздействия на материал ионов низких энергий (менее 500 эВ) необходимо использование иных подходов.
Компьютерное моделирование бомбардировки ионами инертных газов поверхностей различных материалов рассматривается в настоящее время как достаточно надежный инструмент для изучения механизмов такого воздействия. Для моделирования физического распыления материалов используется два основных подхода: метод молекулярной динамики (МД) и метод Монте-Карло на основе приближения независимых парных соударений [10–12]. Принципиальным отличием МД-подхода является возможность учета в МД многочастичного взаимодействия, что может иметь существенное значение при низких энергиях ионов и в особенности вблизи пороговой энергии распыления.
Во многих работах [3] МД-моделирование воздействия ионов на материал проводилось без накопления повреждений, т.е. налетающие ионы взаимодействовали с неповрежденной поверхностью. Однако длительное воздействие ионов на кристаллический кремний приводит к накоплению налетающих частиц в приповерхностных слоях материала и образованию аморфного слоя, толщина которого зависит от энергии налетающих ионов. Этот слой содержит большое количество дефектов, его наличие облегчает проникновение ионов в верхние слои материала и может способствовать усилению распыления [13]. Воздействие ионов инертных газов с энергиями выше нескольких килоэлектронвольт также часто вызывает образование внутри материала полостей, заполненных имплантированными ионами. Указанные процессы могут оказывать существенное влияние на свойства облучаемого материала, поэтому детальное изучение их механизмов при низких энергиях налетающих ионов является ключевым для разработки технологии создания наноразмерных элементов электроники. Таким образом, для исследования таких важных эффектов, как формирование аморфного слоя, накопление налетающих частиц в приповерхностных слоях и формирование кластеров, необходимо учитывать изменения структуры материала-мишени, вызванных последовательными ударами ионов [13–16].
В данной работе было проведено МД-моделирование воздействия ионов инертных газов (He, Ne, Ar, Kr, Xe) с энергиями 50–500 эВ на поверхность (001) кристаллического кремния под углом 0°.
МЕТОДИКА МОДЕЛИРОВАНИЯ
При низких энергиях ионов их потери энергии в веществе dE/dx определяются в основном упругими процессами, в то время как потери на ионизацию атомов мишени существенно меньше (например, для Xe с E = 200 эВ упругие и ионизационные потери, рассчитанные с помощью SRIM, составляют 18.7 и 1.3 эВ/Å). Для ионов He доля неупругих потерь энергии заметно выше (~34% при 200 эВ), однако величина этих потерь весьма мала (на основании оценки SRIM – 2.2 эВ/Å). Таким образом, потерями энергии ионов на ионизацию мишени можно пренебречь, и использование метода МД без учета неупругих взаимодействий является вполне оправданным для ионов с энергией менее 500 эВ.
Для МД-моделирования взаимодействия ионов Ne, Ar, Kr, Xe с материалом были созданы мишени кристаллического кремния размером 5.4 × × 5.4 × 5.4 нм, что соответствует 10 × 10 × 10 элементарных ячеек кристаллической решетки Si. В случае воздействия на материал ионов He глубина мишени была увеличена в 2 раза, и ее размеры составили 5.4 × 5.4 × 10.8 нм. Исходная ячейка моделирования была построена таким образом, чтобы поверхность кремния (001) располагалась перпендикулярно оси Z под вакуумным промежутком высотой в 10 элементарных ячеек. Вдоль осей X и Y были наложены периодические граничные условия с целью имитации бесконечно большой поверхности материала. Нижний слой атомов толщиной 0.5 нм был зафиксирован в течение всего процесса моделирования. Перед началом моделирования воздействия ионов температура мишени составила 300 К. Взаимодействие между атомами Si в кристаллическом кремнии определялось силовым полем Стиллинжера-Вебера [17]. Потенциал Мольера описывал взаимодействие между ионами и ионов с исследуемым материалом (постоянную экранирования рассчитывали по модели Фирсова) [10].
В настоящей работе МД-моделирование производилось с накоплением повреждений, как, например, в [14–16]. Использование такого подхода обусловлено необходимостью исследования изменений в морфологии материала под действием ионов. Каждую 21 пс в верхней части ячейки создавался ион со случайными координатами и с заданной скоростью, направленной перпендикулярно поверхности. При этом полагалось, что заряд налетающего иона нейтрализуется перед ударом, и далее происходит взаимодействие нейтрального атома с материалом. Если воздействие приводило к вылету атома Si или He/Ne/Ar/Kr/Xe с поверхности, то такой атом считался распыленным (для Si) или отразившимся (для He/Ne/Ar/ Kr/Xe) и удалялся из системы в тот момент, когда расстояние между ним и поверхностью превышало 1.5 нм. Подавление перегрева материала осуществлялось благодаря периодическому воздействию на систему внешнего термостата в соответствии со следующим алгоритмом, использованным в [15]: первые 3.5 пс с момента генерации иона термостат не использовался, а во второй половине цикла к системе применялся термостат Берендсена при температуре 300 К для того, чтобы охладить материал до указанной температуры. Временнóй шаг интегрирования был определен как промежуток, за который изменение координат атома не превышает постоянную решетки, и был выбран равным 0.1 фс. Полученная в конце цикла структура рассматривалась как исходная поверхность для следующего удара, и процесс повторялся до достижения необходимого значения дозы.
Вычисления выполнялись с помощью свободного программного пакета LAMMPS (Large-scale Atomic/Molecular Massively Parallel Simulator) [18] с использованием ресурсов суперкомпьютерного комплекса МГУ имени М.В. Ломоносова [19]. Моделирование воздействия ионов на кремниевые подложки было выполнено для 1000 последовательных ударов, что соответствует дозе (интегральному по времени потоку ионов на единицу площади поверхности) 3.4 × 1015 см–2. Визуализация кремниевых мишеней и анализ результатов расчетов выполнялся с помощью программы OVITO [20]. Усредненная локальная температура области материала определялась в соответствии с алгоритмом, предложенным в [21]: c помощью OVITO была определена средняя кинетическая энергия атомов, заключенных в сферу, радиус которой был равен периоду кристаллической решетки кремния, и атом, расположенный в центре указанной сферы, считался “расплавленным”, если его локальная температура превышала температуру плавления кремния (1688 К).
Для определения величины аморфного слоя, образовавшегося на поверхности кремния в результате воздействия ионов, был использован алгоритм извлечения дислокаций (Dislocation Extraction Algorithm) [22], реализованный в программе OVITO. Длина свободного пробега налетающих частиц в кремнии определялась как среднее арифметическое взвешенное из глубин проникновения внедренных в материал ионов.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Как известно, воздействие пучком ионов на материал может сопровождаться физическим распылением атомов мишени, если энергия налетающих частиц выше порогового значения, что для кристаллического кремния составляет ~50 эВ [23]. В табл. 1 указаны полученные в результате моделирования коэффициенты физического распыления Y, рассчитанные как число распыленных атомов материала, приходящихся на один ион. Приведенные значения Y соответствуют динамическому равновесию, которое устанавливается в системе после завершения формирования аморфного слоя на поверхности мишени. Дальнейшее возрастание числа падающих ионов не приводит к заметным изменениям в интенсивности распыления.
Таблица 1.
Параметры физического распыления кремния различными ионами, рассчитанные для дозы 3.4 × 1015 см–2
| Ион | E, эВ | Y | YSRIM | Yexp | Yion | Edep/E, % | Epike, эВ |
|---|---|---|---|---|---|---|---|
| He | 50 | ~0 | 0.04 | – | 0.75 | 79.2 | 1.4 |
| 100 | 0.06 | 0.01 | ~0–0.018 | 0.51 | 82.2 | 1.2 | |
| 200 | 0.07 | 0.14 | 0.026–0.007 | 0.35 | 66.3 | 0.6 | |
| Ne | 50 | ~0 | 0.16 | – | 0.99 | 90.4 | 1.9 |
| 100 | 0.11 | 0.28 | 0.043 | 0.97 | 95.5 | 1.4 | |
| 200 | 0.26 | 0.45 | 0.17 | 0.93 | 98.2 | 0.9 | |
| Ar | 50 | ~0 | 0.02 | – | 0.99 | 96.2 | 1.6 |
| 100 | 0.05 | 0.06 | 0.048–0.083 | 0.99 | 98.3 | 1.2 | |
| 200 | 0.21 | 0.15 | 0.16–0.31 | 0.96 | 99.3 | 0.8 | |
| Kr | 50 | ~0 | – | – | 0.98 | 97.2 | 1.2 |
| 100 | 0.09 | 0.02 | – | 0.93 | 99.0 | 0.6 | |
| 200 | 0.11 | 0.07 | – | 0.91 | 99.7 | 0.4 | |
| Xe | 50 | ~0 | – | – | 0.91 | 98.0 | 0.6 |
| 200 | 0.06 | 0.04 | 0.08 | 0.81 | 99.9 | 0.3 |
Хорошо видно, что в рассматриваемом диапазоне энергий налетающих ионов рассчитанные значения коэффициента распыления соответствуют экспериментальным данным Yexp, представленным в работах [24, 25]. При этом величина Y в существенной степени определяется отношением масс иона Mi и атомов мишени MSi и принимает максимальное значение для ионов Ne и Ar, для которых Мi/MSi ~ 1. Немонотонная зависимость коэффициента распыления от массы иона обусловлена тем, что при низких энергиях налетающих ионов длина их пробега R в материале (табл. 2) определяется, в первую очередь, упругими потерями энергии, которые зависят от массы иона немонотонно. Глубина проникновения ионов He является максимальной за счет низких потерь энергии и малого размера, что позволяет имплантированным атомам легко перемещаться между кристаллическими ячейками кремния. Масса ионов Ne и Ar близка к массе атома Si, поэтому их пробег в материале примерно одинаков, в то время как для более тяжелых ионов (Kr, Xe) глубина проникновения увеличивается с ростом массы иона. Для сравнения в табл. 1, 2 приведены результаты расчета коэффициента распыления и глубины пробега с помощью программы SRIM [12] на основе метода Монте-Карло. Хорошо видно, что результаты, полученные в данной работе, лучше соответствуют экспериментальным данным.
Таблица 2.
Параметры модифицированного слоя кристаллического кремния для энергии налетающих ионов 200 эВ, рассчитанные с помощью SRIM и МД (доза 3.4 × 1015 см–2)
| Ион | RSRIM ± ΔR, нм | R ± ΔR, нм | h, нм | K, % |
|---|---|---|---|---|
| He | 4.4 ± 2.6 | 3.45 ± 1.9 | 4.2 | 33 |
| Ne | 1.6 ± 0.9 | 1.4 ± 0.8 | 1.5 | 30 |
| Ar | 1.6 ± 0.6 | 1.0 ± 0.4 | 1.1 | 49 |
| Kr | 2.1 ± 0.4 | 1.1 ± 0.4 | 1.5 | 14 |
| Xe | 2.7 ± 0.4 | 1.5 ± 0.4 | 2.0 | 10 |
В общем случае ион, налетающий на поверхность мишени, может испытать отражение, проникнуть в приповерхностные слои и вылететь обратно, либо остаться в материале. Энергетические спектры ионов с исходной энергией 200 эВ, вылетевших с поверхности кремния, представлены на рис. 1. Из рис. 1а и табл. 1, в которой указаны величины коэффициента отражения ионов от поверхности кремния Yion, видно, что значительный вклад в спектр легких ионов He вносят отраженные от мишени частицы с энергией в диапазоне ~20–160 эВ, поэтому энергия Edep, передаваемая ионом He атомам мишени, оказывается относительно низкой (табл. 1). Для ионов, масса которых превышает массу атома Si, отражение практически отсутствует, величина Edep возрастает, а количество ионов Ne, Ar, Kr, Xe, покидающих поверхность с энергией более 4 эВ, мало (рис. 1б). С ростом энергии ионы глубже проникают в материал, что приводит к увеличению Edep и смещению положения максимума энергетического спектра вылетающих ионов Epike в область меньших энергий (табл. 1).
Рис. 1.
Энергетические спектры атомов He (а) и Ne, Ar, Kr, Xe (б), выбиваемых с поверхности материала под воздействием ионов с энергией 200 эВ в различных диапазонах: а – 0−160 эВ; б – 0−4 эВ (Xe – кривая 1, Kr – кривая 2, Ar – кривая 3, Ne – кривая 4).

Особенности перемещения ионов и выделения энергии в материале иллюстрирует рис. 2, на котором приведены снимки ячейки моделирования через 100, 500 и 1000 фс после удара налетающего иона с E = 200 эВ. Более темным цветом выделены так называемые “расплавленные” атомы, для которых усредненная кинетическая энергия соответствует температуре, превышающей температуру плавления материала мишени (1688 К). Такие области локального “перегрева” материала практически совпадают с пространственным распределением области выделенной энергии, а их размер наглядно характеризует интенсивность передачи энергии атомам мишени [21, 26, 27]. Как видно из рис. 2, через 100 фс ион He успевает преодолеть достаточно большое расстояние в кремнии и передать свою энергию большому числу атомов, однако уже через 500 фс ион практически полностью теряет свою энергию, а области “локального перегрева” исчезают. В то же время воздействие иона Xe такой же первоначальной энергии приводит к образованию значительно более обширной области “перегрева”, которая сохраняется в течение длительного промежутка времени.
Рис. 2.
Снимки кремниевых мишеней (вид сбоку) через 100 (слева), 500 (посередине) и 1000 фс (справа) после удара иона He (a), Ar (б) и Xe (в). Средняя локальная температура “расплавленных атомов” показана оттенками серого: светло-серый цвет соответствует температуре 1700 K, черный – 5000 К.
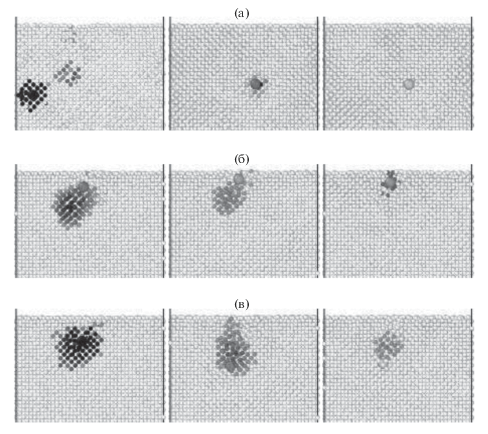
Различия в механизмах взаимодействия ионов инертных газов с кремнием проявляются в структуре приповерхностных слоев материала. Как видно из рис. 3, слой кремния, содержащий имплантированные ионы, включает в себя аморфную область, граница которой обозначена черной сплошной линией, а также нижележащий слой, содержащий точечные дефекты кристаллической решетки. Толщина аморфного слоя h, определяется средней глубиной проникновения ионов (табл. 2). Доля ионов K, имплантированных в материал ниже границы аморфного слоя, в существенной степени зависит от типа иона, как видно из рис. 3 и табл. 2. Тяжелые ионы Kr и Xe, проникая в кремний, создают много дефектов, поэтому вне аморфного слоя находится только 10 и 14% атомов Xe и Kr соответственно. Для легких ионов Ne и He аналогичная величина составляет около 30%, а соотношение толщин аморфной и кристаллической областей модифицированного слоя примерно равно ~1 : 1.
Рис. 3.
Снимки сечений кремниевых мишеней (вид сбоку) после моделирования 1000 последовательных ударов ионов He (а), Ne, (б), Ar (в), Kr (г), Xe (д) с исходной энергией 200 эВ (доза 3.4 × 1015 см–2). Черная линия показывает распределение имплантированных атомов по глубине; горизонтальная черная сплошная линия соответствует нижней границе аморфного слоя; исходное положение уровня поверхности обозначено горизонтальной черной пунктирной линией.
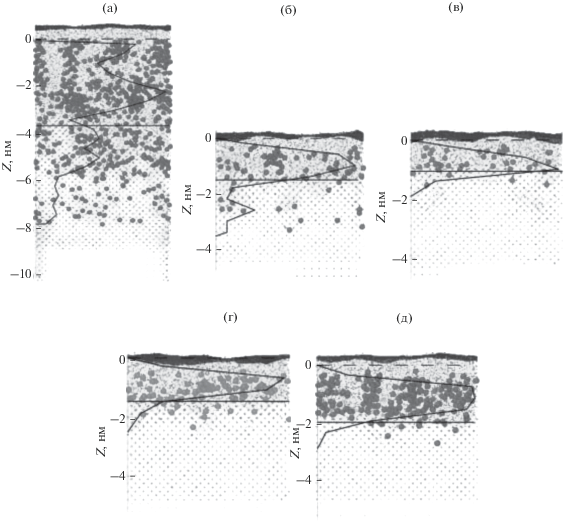
Представленные на рис. 3 снимки кремниевых мишеней демонстрируют, что интенсивность накопления ионов в приповерхностных слоях материала различна для разных ионов. Рассчитанные зависимости числа имплантированных ионов от дозы, приведенные на рис. 4, подтверждают этот вывод. Небольшая глубина проникновения облегчает вылет имплантированного иона с поверхности, поэтому число внедренных атомов N минимально для Ar и максимально для He. В случае He процесс накопления является наиболее интенсивным и не достигает насыщения в рассматриваемом диапазоне значений дозы. Более того, по мере облучения большое число имплантированных атомов He приводит к повышению уровня поверхности относительно первоначального положения. В случае остальных ионов процесс накопления практически не влияет на положение уровня поверхности. Из рис. 4а также видно, что процесс накопления ионов в кристаллическом кремнии имеет нелинейный характер. При малых значениях дозы происходит активный рост числа налетающих частиц в материале, далее достигается состояние динамического равновесия, при котором число ионов, имплантированных в материал, колеблется вокруг некоторого среднего значения Nav. На основании этих значений для каждого иона была рассчитана равновесная поверхностная плотность a, численно равная числу имплантированных атомов, приходящемуся на единицу площади поверхности мишени. Значения поверхностной плотности для случая E = 200 эВ даны в табл. 3.
Рис. 4.
Зависимости числа имплантированных атомов N от дозы для энергии налетающих ионов 200 эВ: а – Xe – кривая 1, Kr – кривая 2, Ne – кривая 3, Ar – кривая 4; б – He – кривая 1, Xe – кривая 2.

Таблица 3.
Параметры кластеров имплантированных атомов инертных газов, образовавшихся в приповерхностных слоях кремния, для энергии налетающих ионов 200 эВ
| Ион | N ± ΔN | Nclusters | nmax | nav | RRDF, Å | R0, Å | a, 1014 атом/см2 |
|---|---|---|---|---|---|---|---|
| He | 1144 | 45 | 196 | 17 | 3.6 | 2.98 | 38.8 |
| Ne | 72 ± 8 | 9 | 5 | 4 | 3.2 | 3.15 | 2.4 |
| Ar | 40 ± 5 | 3 | 4 | 3 | 3.1 | 3.76 | 1.4 |
| Kr | 85 ± 11 | 9 | 7 | 5 | 3.2 | 4.04 | 2.9 |
| Xe | 187 ± 15 | 15 | 31 | 9 | 2.9 | 4.36 | 6.3 |
Приведенные на рис. 3 и 4 результаты МД-моделирования позволяют сделать вывод, что в процессе облучения имплантированные ионы способны перемещаться в приповерхностных слоях материала, сближаясь друг с другом и образовывая кластеры. Подобное явление также наблюдалось экспериментально при воздействии ионов Ar, Kr и Xe с энергиями более 1 кэВ, причем размер кластеров увеличивается с ростом концентрации внедренных атомов и зависит от энергии налетающих частиц [2, 28–30]. Например, для атомов Ar, имплантированных в кремний, было показано, что при энергии 3 кэВ средний диаметр образующихся кластеров, определенный с помощью просвечивающего электронного микроскопа, составил ~1 нм [2]. При более низких энергиях кластеры Ar не были обнаружены, однако накопление Ar в кремнии наблюдалось даже при 100 эВ [31], а образование кластеров может происходить при поверхностной плотности имплантированных атомов ~1014 см–2 [32]. Активное накопление налетающих частиц и образование так называемых “пузырей”, состоящих из внедренных атомов, под воздействием ионов He наблюдалось экспериментально в различных кремнийсодержащих материалах (Si, Si3N4) в более широком диапазоне энергий налетающих ионов 0.45–10 кэВ [33, 34]
Анализ результатов выполненного МД‑моделирования позволил выявить особенности процессов кластеризации различных ионов. В табл. 3 приведено общее число кластеров, обнаруженных в материале Nclusters, максимальное количество атомов в кластере nmax, а также среднее число атомов в одном кластере nav. Указанные параметры были рассчитаны для структур, полученных под воздействием ионов с энергией 200 эВ и соответствующих состоянию динамического равновесия, т.е. выполнено условие: N = Nav (для He параметры были определены при максимальной дозе 5.1 × 1015 см–2). Представленные данные демонстрируют, что интенсивность образования кластеров и их размер определяется значением поверхностной плотности a, которая для всех рассматриваемых случаев превышает величину 1014 см–2. Наиболее активно процессы кластеризации протекают для He и Xe, причем средний размер кластеров He примерно в 2 раза превышает размер кластеров Xe, а слабее всего – для Ar. Следует отметить, что среднее число атомов Ar, Ne и Kr в кластерах в состоянии динамического равновесия равно 3–5, поэтому средний размер таких структур довольно мал (до 0.5–0.6 нм). Этот факт может объяснить отсутствие экспериментальных подтверждений образования кластеров Ar при энергиях ниже 1 кэВ. На основании данных табл. 3 также можно объяснить наблюдаемые на рис. 4 флуктуации числа имплантированных атомов N: они определяются размерами образующихся кластеров, поскольку попадание налетающего иона в область вблизи крупного кластера способно инициировать вылет сразу нескольких имплантированных атомов, в результате чего величина N резко уменьшается. Подобное явление было подробно изучено в работе [35] для случая воздействия на кремний ионов Ar.
Важной характеристикой процессов кластеризации является среднее расстояние между соседними атомами в кластерах. Как было показано в [28], кластеры атомов Ar, сформированные в кремнии при воздействии ионов с энергией 40 и 130 кэВ находятся под давлением. В настоящей работе для рассматриваемых кластерных структур были построены радиальные функции распределения (РФР), характеризующие вероятность частиц быть обнаруженными на различных расстояниях друг от друга. Рассчитанные равновесные расстояния RRDF между соседними атомами в кластерах, соответствующие положению первого пика РФР, сравнивались с расстоянием между атомами инертных газов в димерах R0 (табл. 3). Хорошо видно, что для структур, образованных имплантированными ионами с массой, превышающими массу атомов Si, (Ar, Kr, Xe), выполняются соотношение RRDF < R0. Таким образом, кластеры, сформированные под воздействием ионов Ar, Kr и Xe, находятся под давлением со стороны окружающих атомов материала, что хорошо согласуется с результатами экспериментальных исследований, упомянутых выше. Наиболее сильное сжатие наблюдается у имплантированных атомов Xe, в то время как взаимодействие более легких ионов He и Ne с материалом не приводит к аналогичным эффектам, так как они обладают меньшими размерами и более высокой подвижностью в объеме материала.
ЗАКЛЮЧЕНИЕ
В настоящей работе методом молекулярной динамики с накоплением повреждений было проведено моделирование воздействия на кристаллический кремний ионов He, Ne, Ar, Kr, Xe с энергиями 50–500 эВ при нормальном падении. Сравнение рассчитанных коэффициентов распыления с существующими экспериментальными данными показало, что применяемая методика моделирования позволяет корректно описать процесс физического распыления кристаллического кремния ионами инертных газов низких энергий. Различия в механизмах взаимодействия налетающих частиц с поверхностью проявляются в структуре модифицированного ионами верхнего слоя кремния, состоящего из аморфной области и нижележащего материала с точечными дефектами в кристаллической решетке. Поскольку тяжелые ионы Xe и Kr создают большое количество дефектов, толщина образующегося аморфного слоя совпадает со средней длиной пробега этих ионов в материале, и практически все внедренные атомы находятся в этом слое. Легкие ионы (Ne и в особенности He) за счет малых размеров обладают более высокой проникающей способностью, поэтому значительная часть имплантированных ионов (30% и более) находится ниже границы аморфного слоя.
Как показывают результаты моделирования, интенсивность накопления налетающих частиц в кремнии различна для разных ионов. В случае ионов He данный процесс протекает наиболее интенсивно по сравнению с остальными ионами и приводит к повышению уровня поверхности относительно первоначального положения. Для ионов Ne, Ar, Kr и Xe при относительно небольших дозах достигается состояние динамического равновесия, при котором число внедренных в материал атомов колеблется вблизи среднего значения. Величина флуктуаций этой величины определяется размером и числом кластеров, формирующихся в приповерхностных слоях. Наиболее активно процессы кластеризации протекают для He и Xe, причем средний размер кластеров He примерно в 2 раза превышает размер кластеров Xe, а слабее всего – для Ar. Кластеры, сформированные при воздействии ионов с массой, превышающей массу атомов Si, (Ar, Kr, Xe) находятся под дополнительным давлением со стороны окружающих атомов материала.
Список литературы
Blank P., Wittmaack K. // J. Appl. Phys. 2008. V. 50. № 3. P. 1519. https://doi.org/10.1063/1.326140
Bangert U., Goodhew P.J., Jeynes C., Wilson I.H. // J. Phys. D. 1986. V. 19. № 4. P. 589. https://doi.org/10.1088/0022-3727/19/4/013
Behrisch R. Sputtering by particle bombardment: Experiments and computer calculations from threshold to MeV energies. Topics in Applied Physics. Berlin: Springer, 2007. 509 p.
Sigmund P. // Phys. Rev. 1969. V. 184. № 2. P. 383. https://doi.org/10.1103/PhysRev.184.383
Wittmaack K. // Phys. Rev. B. 2003. V. 68. № 23. P. 235 211. https://doi.org/10.1103/PhysRevB.68.235211
Zalm P.C. // J. Appl. Phys. 1983. V. 54. № 5. P. 2660. https://doi.org/10.1063/1.332340
Lopaev D.V., Rakhimova T.V., Rakhimov A.T. et al. // J. Phys. D. Appl. Phys. 2017. V. 51. № 2. P. 02LT02. https://doi.org/10.1088/1361-6463/aa9c18
Hossain M.Z., Freund J.B., Johnson H.T. // J. Appl. Phys. 2012. V. 111. № 10. P. 103513. https://doi.org/10.1063/1.4718024
Hobler G., Bradley R.M., Urbassek H.M. // Phys. Rev. B. 2016. V. 93. № 20. P. 205443. https://doi.org/10.1103/PhysRevB.93.205443
Smith R. Atomic and Ion Collisions in Solids and at Surfaces: Theory, Simulation and Applications. New York: Cambridge University Press, 2005. 310 p.
Palov A.P., Balint-Kurti G.G., Voronina E.N., Rakhimova T.V. // J. Vac. Sci. Technol. A. V. 36. № 4. P. 04130. https://doi.org/10.1116/1.5027387
Ziegler J.F., Ziegler M.D., Biersack J.P. // Nucl. Instrum. Methods Phys. Res. B. 2010. V. 268. № 11. P. 1818. https://doi.org/10.1016/j.nimb.2010.02.091
Humbird D., Graves D.B. // Pure Appl. Chem. 2002. V. 74. № 3. P. 419. https://doi.org/10.1351/pac200274030419
Moore M.C., Kalyanasundaram N., Freund J.B., Johnson H.T. // Nucl. Instrum. Methods Phys. Res. B. 2004. V. 225. № 3. P. 241. https://doi.org/10.1016/j.nimb.2004.04.175
Timonova M., Lee B.-J., Thijsse B.J. // Nucl. Instrum. Methods Phys. Res. B. 2007. V. 225. № 1. P. 195. https://doi.org/10.1016/j.nimb.2006.11.023
Sycheva A.A., Voronina E.N., Rakhimova T.V. // J. Surf. Invest.: X-Ray, Synchrotron Neutron Tech. 2018. V. 12. № 6. P. 1270. https://doi.org/10.1134/S1027451019010191
Stillinger F.H., Weber T.A. // Phys. Rev. B. 1985. V. 31. № 8. P. 5262. https://doi.org/10.1103/PhysRevB.31.5262
Plimpton S. // J. Comp. Phys. 1995. V. 117. P. 1. https://doi.org/10.1006/jcph.1995.1039
Sadovnichy V., Tikhonravov A., Voevodin Vl., Opanasenko Vl. // Contemporary High Performance Computing: From Petascale to Exacsale / Ed. Vetter J.S. Chapman and Hall/CRC, 2013. P. 283.
Stukovski A. // Modelling Simul. Mater. Sci. Engin. 2010. V. 18. № 1. P. 015012. https://doi.org/10.1088/0965-0393/18/1/015012
Colla T.J., Urbassek H.M. // Radiat. Eff. Defects Solids 1997. V. 142. № 1. P. 439. https://doi.org/10.1080/10420159708211625
Stukowski A., K. Albe // Modelling Simul. Mater. Sci. Eng. 2010. V. 18. P. 085001. https://doi.org/10.1088/0965-0393/18/8/085001
Kanarik K.J., Tan S., Gottscho R.A. // J. Phys. Chem. Lett. 2018. V. 9. № 16. P. 4814. https://doi.org/10.1021/acs.jpclett.8b00997
Oostra D.J., Haring A., van Ingen R.P., de Vries A.E. // J. Appl. Phys. 1988. V. 64. № 1. P. 315. https://doi.org/10.1063/1.341429
Balooch M., Moalem M., Wang W.-E., Hamza A.V. // J. Vac. Sci. Technol. A. 1996. V. 14. № 1. P. 229. https://doi.org/10.1116/1.579924
Anders C., Bringa E.M., Urbassek H.M. // Nucl. Instrum. Methods Phys. Res. B. 2015. V. 342. P. 234. https://doi.org/10.1016/j.nimb.2014.10.005
Sycheva A.A., Voronina E.N., Rakhimova T.V., Rakhimov A.T. // Appl. Surf. Sci., 2019. V. 475. P. 1021. https://doi.org/10.1016/j.apsusc.2019.01.078
Faraci G., La Rosa S., Pennisi A.R. et al. // Phys. Rev. B. 1991. V. 43. № 12. P. 9962. https://doi.org/10.1103/PhysRevB.43.9962
Greuter M.J.W., Niesen L., Hakvoort R.A.et al. // Hyperfine Interact. 1993. V. 79. P. 669. https://doi.org/10.1007/bf00567594
Faraci G., Pennisi A.R., Terrasi A.,Mobilio S. // Phys. Rev. B. 1988. V. 38. № 18. P. 13468. https://doi.org/10.1103/PhysRevB.38.13468
Lau W.M., Bello I., Huang L.J., Feng X. // J. Appl. Phys. 1993. V. 74. № 12. P. 7101. https://doi.org/10.1063/1.355024
van Veen G.N.A., Sanders F.H.M., Dieleman J. et al. // Phys. Rev. Lett. 1986. V. 57. № 6. P. 739. https://doi.org/10.1103/physrevlett.57.739
Martirosyan V., Despiau-Pujo E., Dubois J. et al. // J. Vac. Sci. Technol. A. 2018. V. 36. № 4. P. 041301. https://doi.org/10.1116/1.5025152
Wittmaack K. // Appl. Phys. Lett. 2008. V. 92. № 5. P. 051907. https://doi.org/10.1063/1.2839601
Sycheva A.A., Voronina E.N., Rakhimova T.V., Rakhimov A.T. // J. Vac. Sci. Technol. A. 2018. V. 36. № 6. P. 061303. https://doi.org/10.1116/1.5050325
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


