Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 9, стр. 39-46
Температурная зависимость накопления дейтерия и гелия в W и Ta-покрытиях в процессе облучения ионами D+ или He+
В. В. Бобков a, *, Л. П. Тищенко a, **, Ю. И. Ковтуненко a, А. Б. Цапенко a, А. А. Скрипник a, Л. А. Гамаюнова a
a Харьковский национальный университет им. В.Н. Каразина
61022 Харьков, Украина
* E-mail: bobkov@karazin.ua
** E-mail: plip@karazin.ua
Поступила в редакцию 16.12.2019
После доработки 04.01.2020
Принята к публикации 17.01.2020
Аннотация
Методом термодесорбционной спектрометрии исследованы процессы накопления и термического выделения дейтерия и гелия для вольфрамового и танталового покрытий трехслойных композитов, включающих в себя подложку из нержавеющей стали и промежуточный слой титана, в зависимости от температуры образцов в процессе облучения 20 кэВ-ионами ${\text{D}}_{{\text{2}}}^{ + }$ или He+. Температура образцов (в интервале значений 290–870 K) влияет на характер спектров термической десорбции этих газов. С увеличением температуры значения концентрации и коэффициента захвата дейтерия и гелия в покрытиях обоих типов уменьшаются. Предположены механизмы накопления и термической десорбции дейтерия и гелия, а также образования дефектов кристаллической решетки. Дейтерий и гелий захватывается радиационными дефектами вакансионного типа, образуя газ-вакансионные комплексы. С увеличением температуры образцов в процессе облучения ионами ${\text{D}}_{{\text{2}}}^{ + }$ или He+ термодесорбция имплантированных газов, связанная с диссоциацией газ-вакансионных комплексов, миграцией частиц газов по междоузлиям к поверхности, рекомбинацией в молекулу D2 для дейтерия и выходом в вакуум, усиливается.
ВВЕДЕНИЕ
Вольфрам и тантал рассматриваются в работах [1–5] как материалы, которые могут быть использованы в защитных покрытиях компонентов, обращенных к плазме, в установках термоядерного синтеза с магнитным [1, 3–5] и инерционным удержанием плазмы [2]. Их предлагают использовать как в качестве отдельных материалов: W [1, 3, 5] и Ta [2, 3], так и в составе вольфрам-танталовых композитов [4] (с 10 и 20 ат. % Ta-волокон в W-матрице) и сплавов WTa5 [5] (с 5 мас. %. Ta). В работах [1, 2] отмечено, что одним из способов создания защитных покрытий для элементов конструкций, обращенных к плазме, может быть плазменное напыление на них вольфрама или тантала. Одним из преимуществ использования Ta и W является незначительное накопление в них изотопов водорода, а, следовательно, незначительное накопление радиоактивного трития при воздействии плазменных потоков. Эта проблема интенсивно изучается [1–9] с целью повышения радиационной стойкости предлагаемых материалов и получения новых материалов с улучшенными параметрами. Ранее нами было проведено комплексное исследование процессов образования радиационных дефектов кристаллической решетки, захвата, удержания и термической десорбции дейтерия и гелия, ионно-имплантированных в вольфрамовые [6–9] и танталовые [10] покрытия при комнатной температуре.
В настоящей работе исследованы процессы, сопровождающие имплантацию ионов дейтерия и гелия в танталовое и вольфрамовое покрытия при различных температурах образцов. Показано влияние температуры образцов при облучении ионами D+ и He+ на захват, удержание и термодесорбцию имплантированных газов из покрытий. Проведено сравнение накопления и удержания дейтерия и гелия при ионном облучении и термической десорбции этих газов для Ta и W-покрытий при последующем нагреве. Определены типы радиационных нарушений кристаллической решетки, показано их влияние на структурные особенности покрытий.
МЕТОДИКА ЭКСПЕРИМЕНТОВ
Проведены исследования вольфрамовых и танталовых покрытий, полученных методом магнетронного распыления W и Ta-мишеней в атмосфере Ar при давлении 1.0 Па. Осаждение исследуемых покрытий осуществляли со скоростью 0.6 нм/с при температуре T = 600 K на подложку из нержавеющей стали толщиной 0.8 мм с напыленным на нее промежуточным слоем Ti толщиной менее 10 нм. Толщина покрытий составляла ∼1.0 мкм (W) и ∼1.5 мкм (Ta). Они имели поликристаллическую структуру со средним размером зерна около 60 нм. Образцы обозначали (н. ст. + + W) или (н. ст. + Ta). Их облучали пучками ионов 20 кэВ He+ или 20 кэВ ${\text{D}}_{{\text{2}}}^{ + }$ (10 кэВ D+) при плотности тока ∼5 мкА/см2 до доз Φ, равных (1.0 и 2.0) × 1017 см–2. Такие дозы облучения ионами D+ или He+ выбраны в связи с наиболее простым характером спектров термодесорбции дейтерия и гелия для вольфрамовых и танталовых покрытий при комнатной температуре. Влияние дозы облучения указанными ионами показано нами в работах [6, 7, 9, 10]. Ионы дейтерия имплантировали в покрытия при температурах образца To: 290, 370, 440, 470, 500, 570 и 670 K, а ионы гелия при температурах To: 290, 370, 670, 770 и 870 K. В табл. 1 приведены значения величины To для исследованных вольфрамовых и танталовых покрытий. Приведены также значения величины Φ для ионов D+ и He+. Согласно работе [11], средний проективный и полный пробеги ионов D+ (10 кэВ) и He+ (20 кэВ) в вольфрамовом и танталовом покрытиях имели значения около 60 и 160 нм соответственно, были сопоставимы для сравниваемых ионов и значительно меньше толщины покрытий. Профили распределения радиационных повреждений, создаваемых ионами D+ и He+ в кристаллической решетке W и Ta покрытий, были идентичны.
Таблица 1.
Параметры захвата и термодесорбции дейтерия и гелия из Ta и W-покрытий
| Композитная структура | Ион | Условия облучения | C, 1017 см–2 | ΔT, K | Tmax, K | |
|---|---|---|---|---|---|---|
| То, K | Ф, 1017 см–2 | |||||
| н. ст. + Ta | D+ | 290 | 2.0 | 0.041 | 500–1100 | 770 |
| D+ | 370 | 2.0 | 0.037 | 450–1100 | 770 | |
| D+ | 470 | 2.0 | 0.026 | 480–1100 | 770 | |
| D+ | 570 | 2.0 | 0.015 | 600–1100 | 770 | |
| D+ | 670 | 2.0 | 0.01 | 690–1100 | 770 | |
| He+ | 290 | 1.0 | 0.81 | 900–1750 | 1660 | |
| He+ | 290 | 2.0 | 1.62 | 900–1750 | 1680 | |
| He+ | 370 | 2.0 | 1.62 | 1000–1750 | 1660 | |
| He+ | 670 | 2.0 | 1.40 | 1100–1750 | 1680 | |
| He+ | 770 | 2.0 | 1.34 | 1100–1750 | 1680 | |
| He+ | 870 | 2.0 | 1.20 | 1100–1750 | 1680 | |
| н. ст. + W | D+ | 290 | 2.0 | 0.12 | 450–1000 | 650 |
| D+ | 370 | 2.0 | 0.056 | 450–1000 | 645 | |
| D+ | 440 | 2.0 | 0.079 | 460–1000 | 650 | |
| D+ | 470 | 2.0 | 0.052 | 500–1000 | 645 | |
| D+ | 500 | 2.0 | 0.039 | 520–1000 | 650 | |
| He+ | 290 | 1.0 | 0.82 | 750–1750 | 1540 | |
| He+ | 290 | 2.0 | 1.64 | 750–1750 | 1560 | |
| He+ | 370 | 2.0 | 1.40 | 750–1750 | 1550 | |
| He+ | 470 | 2.0 | 1.22 | 800–1750 | 1560 | |
| He+ | 670 | 2.0 | 1.00 | 800–1750 | 1550 | |
| He+ | 670 | 1.0 | 0.50 | 800–1750 | 1540 | |
| He+ | 870 | 2.0 | 0.80 | 950–1750 | 1540 | |
| He+ | 870 | 1.0 | 0.40 | 950–1750 | 1540 | |
Для изучения накопления имплантированных гелия и дейтерия в вольфрамовом и танталовом покрытиях и их термодесорбции в вакуум, образования и отжига собственных радиационных дефектов кристаллической решетки и их взаимодействия друг с другом был использован метод термодесорбционной спектрометрии (ТДС). Методом ТДС при помощи малогабаритного статического газового масс-спектрометра, калиброванного гелиевым натекателем ГЕЛИТ-1, были получены спектры термодесорбции гелия и дейтерия (m = 4 а. е. м). На основании данных [12] по сечению ионизации частиц гелия и дейтерия в источнике данного масс-спектрометра определяли значения концентрации C [см–2] и коэффициента захвата η = C/Ф имплантированных газов. Более подробное описание методики экспериментов содержится в работе [13].
Спектры термодесорбции атомов гелия и молекул дейтерия изучали при нагреве облученных образцов с постоянной скоростью α = 0.8 K/с в температурном интервале 290–1800 K. Нагрев образцов проводили на Ta-ленте с приваренной к ней термопарами: либо хромель–алюмель, либо платина–сплав платины и 13% родия. Термопару платина–сплав платины и 13% родия использовали при измерении температуры в диапазоне 1650–1800 К. Пересчет температуры нагреватель–образец проводили по заранее отработанным градуировочным зависимостям значений температуры образца (Т, К) от значений тока нагревателя (I, A), полученным, когда к образцу была приварена термопара одного или другого вида. Ошибка измерения температуры составляла ±25 K. Спектры термодесорбции представляли собой зависимости количества S [см–2] частиц имплантированного газа, выделившегося при данной температуре нагрева T, от значения этой температуры. Давление в камере во время ТДС-анализа составляло 1.3 × 10–4 Па. Чувствительность использованной методики к определению количества частиц гелия и дейтерия была не хуже 2.0 × × 1012 см–2. При нагреве необлученных образцов в температурном интервале 290–1800 K максимальный фон интенсивности для ионов с m = = 4 а. е. м. не превышал S = 3.0 × 1013 см–2.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
При нагреве исследованных образцов с имплантированным дейтерием или гелием наблюдается их термодесорбция из вольфрамовых и танталовых покрытий в вакуум. На рис. 1 приведены спектры термодесорбции дейтерия в вакуум из вольфрамового (рис. 1а) и танталового (рис. 1б) покрытий, облученных ионами D+ до одной и той же дозы, но при различных температурах To образцов. На рис. 2 приведены спектры термодесорбции гелия в вакуум из вольфрамового (рис. 2а) и танталового (рис. 2б) покрытий, облученных ионами He+ до одной и той же дозы, но при различных температурах образцов.
Рис. 1.
Спектры термодесорбции дейтерия из покрытий, находящихся при различных температурах To при облучении ионами D+: а – W-покрытие при To, K = 290 (1), 370 (2), 440 (3), 470 (4), 500 (5); б – Та-покрытие при To, K = 290 (1), 370 (2), 470 (3), 570 (4), 670 (5); α = 0.8 К/с, ${\text{Ф}}_{{\text{D}}}^{ + }$ = 2.0 × 1017 см–2, энергия ионов D+ 10 кэВ.

Рис. 2.
Спектры термодесорбции гелия из покрытий, находящихся при различных температурах To при облучении ионами He+: а – W-покрытие при To, K = 290 (1), 370 (2), 670 (3), 870 (4); б – Та-покрытие при To, K = 290 (1) или 370 (1), 670 (2), 770 (3), 870 (4); α = 0.8 K/с, ФHe+ = 2.0 × 1017 см–2, энергия ионов He+ 20 кэВ.

Из полученных результатов следует, что характер спектров термодесорбции как дейтерия (рис. 1а, 1б), так и гелия (рис. 2а, 2б) из W и Ta-покрытий сохраняется с повышением температуры образцов при имплантации этих газов. Спектры термодесорбции имеют вид зависимостей с одним пиком. Наибольшая термодесорбция дейтерия из всех облученных образцов наблюдается при значениях температуры Tmax, близких к 645 K для вольфрамового покрытия и к 770 K для танталового покрытия. Наибольшая термодесорбция гелия зарегистрирована при значениях температуры Tmax ≈ 1550 K (W) и Tmax ≈ 1670 K (Ta).
С увеличением температуры To при имплантации дейтерия и гелия уменьшается интенсивность пиков термодесорбции этих газов из покрытий обоих типов (рис. 1а, 1б и рис. 2а, 2б).
Значения температурных интервалов ΔT термодесорбции дейтерия и гелия, а также температуры Tmax в максимуме пиков в спектрах их термодесорбции из Ta и W-покрытий для различных условий облучения приведены в табл. 1 , из которой следует, что термодесорбция дейтерия из вольфрамового покрытия начинается при температурах T ≥ 450 K и заканчивается при T ≈ 1000 K, а из танталового покрытия начинается при температурах T ≥ 500 K и заканчивается при T ≈ 1100 K. Термодесорбция гелия из вольфрамового покрытия, начинается при температурах T ≥ 750 K и заканчивается при T ≈ 1750 K, а из танталового покрытия начинается при температурах T ≥ 900 K и заканчивается при T ≈ 1750 K. Начало заметной термодесорбции как дейтерия, так и гелия из покрытий обоих типов смещается в область более высоких температур постимплантационного нагрева с увеличением температуры To облучаемых образцов. Для всех значений температуры To термодесорбция дейтерия по сравнению с гелием как из Ta, так и W-покрытий происходит при более низких температурах последующего после облучения нагрева образцов (табл. 1 ).
Значения концентраций C дейтерия и гелия для вольфрамовых и танталовых покрытий при различных значениях температуры To образцов и дозы Ф облучения их ионами D+ или He+ представлены в табл. 1. На рис. 3 показаны зависимости коэффициента захвата ηD дейтерия от температуры облучаемых ионами D+ образцов для танталового покрытия (кривая 1) и вольфрамового покрытия (кривая 2). Зависимости коэффициента захвата ηHe гелия от температуры To образца при облучении ионами He+ показаны на рис. 4 для танталового покрытия (кривая 1) и для вольфрамового покрытия (кривая 2). Как видно из рис. 3, 4, наблюдается уменьшение величин ηD и ηHe с увеличением To образца как для Ta, так и W-покрытий.
Рис. 3.
Зависимости коэффициента захвата ηD дейтерия от температуры To образцов при облучении ионами D+: 1 – Та-покрытие, 2 – W-покрытие; ${\text{Ф}}_{{\text{D}}}^{ + }$ = 2.0 × × 1017 см–2, энергия ионов D+ 10 кэВ.
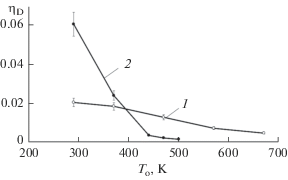
Рис. 4.
Зависимости коэффициента захвата ηHe гелия от температуры To образцов при облучении ионами He+: 1 – Та-покрытие, 2 – W-покрытие; ${\text{Ф}}_{{{\text{He}}}}^{ + }$ = 2.0 × × 1017 см–2, энергия ионов He+ 20 кэВ.

В интервале изменения значений To, равном 290–500 K, для вольфрамового покрытия по сравнению с танталовым покрытием проявляется более значительное уменьшение величины ηD (примерно в 15 и 2 раза соответственно).
В интервале изменения значений To, равном 290–870 K, для вольфрамового покрытия по сравнению с танталовым покрытием уменьшения величин ηHe более сопоставимы (примерно в 2 раза для W и 1.3 раза для Ta).
Как видно из рис. 3, 4 и табл. 1 , при всех исследованных температурах To образцов при облучении ионами He+ и D+ как для танталового покрытия, так и для вольфрамового покрытия значения концентрации C и коэффициента захвата ηHe гелия намного больше аналогичных значений величин C и ηD для дейтерия. Дейтерий по сравнению с гелием накапливается в покрытиях из обоих металлов в меньшей концентрации и с коэффициентом захвата приблизительно на порядок ниже.
В работе предполагается, что для W и Ta-покрытий при комнатной температуре измеренное (рис. 4) максимальное значение коэффициента захвата гелия, равное 0.81–0.82 (±10%), свидетельствует о том, что оставшийся в образцах гелий с концентрацией C ≤ 0.2 × ${\text{Ф}}_{{{\text{He}}}}^{ + }$ десорбируется при температурах выше 1800 К.
В работе [14] при помощи просвечивающей электронной микроскопии (ПЭМ) было проведено исследование микроструктуры W-покрытий, содержащих имплантированные при комнатной температуре дейтерий или гелий. Было показано, что в покрытиях, облученных ионами D+ (${\text{Ф}}_{{\text{D}}}^{ + }$ ≤ ≤ 6 × 1018 см–2) или He+ (${\text{Ф}}_{{{\text{He}}}}^{ + }$ < 7.0 × 1017 см–2), происходит образование междоузельных дислокационных петель и дислокационных сеток. Средний диаметр дислокационных петель составлял 5.0 нм, а плотность 3.2 × 1012 см–2 при ${\text{Ф}}_{{\text{D}}}^{ + }$ = 6.0 × 1018 см–2. При этом образования дейтериевых и гелиевых пузырьков не замечено. Гелиевые пузырьки были видны при ${\text{Ф}}_{{{\text{He}}}}^{ + }$ ≥ 7 × 1017 см–2. Они имели средний диаметр 2.5 нм и плотность 5 × 1012 см–2 при ${\text{Ф}}_{{{\text{He}}}}^{ + }$ = 7 × 1017 см–2.
ПЭМ-исследования в работах [15–18] также выявляют образование междоузельных дислокационных петель и дислокационных сеток при Тo = = 300−350 K в монокристаллическом W, облученном ионами ${\text{D}}_{{\text{2}}}^{ + }$ (10 кэВ, 1 × 1018 см–2) [18] и ионами Н+ (10 кэВ, 3 × 1018 см–2) [15], в металлургическом W(99.95%) и сверхчистом W(99.995%), облученном ионами He+ (8 кэВ, 1 × 1014 ≤ ${\text{Ф}}_{{{\text{He}}}}^{ + }$ ≤ ≤ 6 × 1015 см–2) при Тo = 293 K [16, 17]. С увеличением ${\text{Ф}}_{{{\text{He}}}}^{ + }$ наблюдался рост среднего размера петель до 5.0 нм, а их плотность достигала значения 3.5 × 1012 см–2. Затем они накапливаются как запутанные дислокации. В работе [16] показано, что с увеличением температуры облучения 8 кэВ-ионами He+ плотность петель резко падала, а их размер увеличивался. При температуре 873 и 1073 K для доз 5.6 × 1014 ≤ ${\text{Ф}}_{{{\text{He}}}}^{ + }$ ≤ 2.6 × 1015 см–2 дислокационные петли быстро росли и переплетались друг с другом. Согласно работам [16, 17], в указанных выше образцах W, облученных 8 кэВ-ионами He+ до ${\text{Ф}}_{{{\text{He}}}}^{ + }$ ≥ 2 × 1017 см–2 при комнатной температуре, были заметны пузырьки гелия. В работе [16] была показана температурная зависимость значений дозы облучения ионами He+, при которых замечено образование гелиевых пузырьков в металлургическом W: для Тo = 293 K – ${\text{Ф}}_{{{\text{He}}}}^{ + }$ ≥ 2 × 1017 см–2, для Тo = 873 K – ${\text{Ф}}_{{{\text{He}}}}^{ + }$ ≥ 1.5 × 1017 см–2, для Тo = = 1073 K – ${\text{Ф}}_{{{\text{He}}}}^{ + }$ ≥ 5.0 × 1015 см–2. Гелиевые пузырьки, образованные при комнатной температуре, имели средний диаметр около 2.5 нм и плотность большую, чем плотность дислокационных петель (3.5 × 1012 см–2). В случае облучения при Тo = 873 K пузырьки тех же размеров были выравнены вдоль плоскостей матрицы [110], а при Тo = 1073 K большие пузырьки диаметром более 20 нм образуются вместе с пузырьками значительно меньших размеров (около 5 нм).
Авторы данной работы в предыдущих исследованиях W [6, 8, 13] и Ta [10] покрытий, облученных ионами D+ или He+, приводят наиболее вероятные виды радиационных нарушений, механизмы их накопления и отжига, включая образование газовых пузырьков и термодесорбцию дейтерия и гелия из образцов в вакуум. Показано, что для облученных W и Ta-покрытий при комнатной температуре указанными ионами до доз Ф ≤ 2.0 × 1017 см–2 термодесорбция дейтерия наблюдается в основном пике при значениях температуры максимума Tmax ≈ 645 K для вольфрамового покрытия и Tmax ≈ 770 K для танталового покрытия. На основании значения величины энергии активации термодесорбции Ea дейтерия, которая составляет Ea = 1.4 эВ [6, 8, 19, 20] для вольфрамового покрытия, предположено, что образованные радиационные дефекты вакансионного типа захватывают дейтерий, образуя дейтерий-вакансионные комплексы. Термодесорбция дейтерия из W-покрытий может быть связана с диссоциацией таких комплексов, миграцией атомов дейтерия по междоузлиям к поверхности и последующей десорбцией D2 в вакуум. Согласно [19, 20], энергия связи вакансий с дейтерием в вольфраме равна 1.1 эВ, а энергия миграции атомов дейтерия по междоузлиям составляет $E_{{{\text{D}},i}}^{{\text{m}}}$ ≈ ≈ 0.39 эВ. Работы [19, 20] также показали, что термодесорбция дейтерия имеет место преимущественно в пике с Tmax ≈ 630 K, когда в W при комнатной температуре был имплантирован дейтерий до дозы 1.0 × 1017 см–2. Авторы этих работ связывают природу пика с освобождением дейтерия в результате диссоциации дейтерий-вакансионных комплексов DVn, где n = 4–10, миграцией атомов дейтерия по междоузлиям к поверхности и последующей десорбцией D2 в вакуум.
Термодесорбция гелия наблюдается в пике при значениях температуры максимума Tmax ≈ ≈ 1550 K для вольфрамового покрытия и Tmax ≈ ≈ 1670 K для танталового покрытия. Для вольфрамового покрытия, согласно проведенным расчетам [7], значение энергии активации термодесорбции гелия составляет Еа ≈ 4.2 эВ в указанном пике. Согласно [21, 22], значение величины Еа близко к значению энергии диссоциации гелий-вакансионного комплекса типа HeV ($E_{{{\text{HeV}}}}^{{{\text{diss}}}}$ ≈ 4.42 эВ). Диссоциация комплекса HeV включает освобождение He из вакансии с энергией связи $E_{{{\text{HeV}}}}^{{\text{b}}}$ ≈ 3.9 эВ, миграцию атома гелия по междоузлиям к поверхности с энергией миграции $E_{{{\text{He}},i}}^{{\text{m}}}$ ≈ 0.28 эВ и десорбцию He в вакуум. По-видимому, можно предположить, что пик термодесорбции гелия для вольфрамового покрытия связан с диссоциацией гелий-вакансионных комплексов типа HeV, междоузельной диффузией гелия в кристаллической решетке W и десорбцией в вакуум. В работе [22] показано, что в вольфраме, облученном 60 кэВ He+ до дозы 2.0 × 1013 см–2, наблюдали термодесорбцию гелия при Tmax ≈ 1500 K и Tmax > 1873 K, которую авторы объясняли освобождением из моновакансий HeV и комплексов HenVm, где n > m.
Результаты проведенных в данной работе имплантаций ионов D+ и He+ в вольфрамовое и танталовое покрытия при повышенных температурах показывают влияние температуры To облучаемых образцов на захват, удержание и термодесорбцию имплантированных газов из покрытий. Обнаружено, что вид спектров термодесорбции дейтерия или гелия в вакуум для исследованных покрытий изменяется следующим образом. Спектры термодесорбции этих газов описываются по-прежнему зависимостями с одним пиком. Значения концентраций и коэффициентов захвата дейтерия или гелия в покрытиях уменьшаются с увеличением температуры образцов при имплантации в них ионов D+ или Не+.
Для вольфрамового покрытия по сравнению с танталовым покрытием проявляется более значительное уменьшение величин ηD и ηHe. Исходя из результатов сохранения характера (один пик) спектров термодесорбции дейтерия или гелия в вакуум для исследованных интервалов изменения температуры To образцов, можно предположить, что природа образованных радиационных нарушений и механизмы их отжига могут быть одинаковыми. При высоких температурах, по аналогии с комнатной, в покрытиях из вольфрама и тантала в результате облучениях ионами D+ или Не+ образуются следующие радиационные нарушения: дефекты вакансионного типа, дислокационные петли внедрения и газ-вакансионные комплексы, являющиеся ловушками имплантированных газов. При увеличении температуры образцов в процессе облучения ионами, а также при последующем постимплантационном нагреве термодесорбция дейтерия и гелия, связанная с диссоциацией газ–вакансионных комплексов, миграцией частиц газов по междоузлиям к поверхности и выходом в вакуум, усиливается.
ЗАКЛЮЧЕНИЕ
Исследованы процессы накопления дейтерия и гелия, образования радиационных дефектов кристаллической решетки в вольфрамовом и танталовом покрытиях при различных температурах при облучении их ионами D+ и He+. Изучены спектры термической десорбции дейтерия и гелия в вакуум, определены концентрации и коэффициенты захвата этих газов в покрытиях. Спектры термодесорбции дейтерия и гелия описываются зависимостями с одним пиком. Максимумы десорбции дейтерия при этом наблюдаются при Tmax ≈ 645 K для вольфрамового покрытия и Tmax ≈ ≈ 770 K для танталового покрытия. Максимальная десорбция гелия происходит при Tmax ≈ 1550 K для вольфрамового покрытия и Tmax ≈ 1670 K для танталового покрытия.
Значения концентрации и коэффициентов захвата ηD дейтерия и ηHe гелия уменьшаются с увеличением температуры To покрытий в процессе облучения ионами D+ и He+. В одинаковых сравниваемых интервалах изменения To для вольфрамового покрытия по сравнению с танталовым покрытием наблюдается более значительное уменьшение величины ηD (примерно в 15 и 2 раза соответственно), в то время как уменьшение величины ηHe для вольфрамового покрытия по сравнению с таковым для танталового покрытия более близко по своему значению (примерно в 2 и 1.3 раза соответственно).
Предложены возможные механизмы накопления и термической десорбции дейтерия и гелия, а также образования радиационных дефектов кристаллической решетки. Дейтерий и гелий, по-видимому, захватывается радиационными дефектами вакансионного типа, образуя газ–вакансионные комплексы. При увеличении температуры образцов в процессе облучения ионами, а также при последующем постимплантационном нагреве термодесорбция дейтерия и гелия, связанная с диссоциацией газ-вакансионных комплексов, миграцией частиц газов по междоузлиям к поверхности и выходом в вакуум, усиливается.
Список литературы
Голубева А.В. // ВАНТ. Сер. термояд. синтез. 2009. Вып. 4. С. 54.
Taylor L.H., Green L. // Fusion Eng. Des. 1996. V. 32–33. P. 105.
Hirai T., Philipps V., Tanabe T., Wada M., Huber A., Brezinsek S., von Seggern J., Linke J., Ohgo T., Ohya K., et al. // J. Nucl. Mater. 2002. V. 307–311. Part 1. P. 79.
Dias M, Mateus R., Catarino N., Franco N, Nunes D, Correia J.B., Carvalho P.A., Hanada K., Sârbu C., Alves E. // J. Nucl. Mater. 2013. V. 442. Issues 1–3. P. 69.
Makhlai V.A., Garkusha I.E., Linke J., Malykhin S.V., Aksenova N.N., Byrka O.V., Herashchenko S.S., Surovitskiy S.V., Wirtz M., // Nucl. Mater. Energy. 2016. V. 9. P. 116.
Bobkov V.V., Onishchenko A.V., Sobol O.V., Starovoitov R.I., Kovtunenko Yu.I., Logachev Yu.E., and Tishchenko L.P. // J. Surf. Invest.: X-ray, Synchrotron and Neutron Tech. 2010. V. 4. № 5. P. 852.
Bobkov V.V., Tishchenko L.P. Onishchenko A.V., Zubarev E.N., Starovoitov R.I., Kovtunenko Yu.I., Logachev Yu.E., and Gamayunova L.A. // J. Surf. Invest.: X-ray, Synchrotron and Neutron Tech. 2011. V. 5. № 4. P. 806.
Bobkov V.V., Starovoitov R.I., Tishchenko L.P., Kovtunenko Yu.I., and Gamayunova L.A. // J. Surf. Invest.: X-ray, Synchrotron and Neutron Tech. 2014. V. 8. № 5. P. 853.
Azarenkov N.A., Bobkov V.V., Tishchenko L.P., Starovoitov R.I., Kovtunenko Yu.I., Logachev Yu.E., Gamayunova L.A. // Probl. Atom. Sci. and Technology. Ser.: Plasma Physics (22). 2016. № 6. P. 73.
Bobkov V.V., Tishchenko L.P., Kovtunenko Yu.I., Tsapenko O.B., Skrynik A.O., Logachev Yu.E., Gamayunova L.A. // Probl. Atom. Sci. and Technology. Ser.: Plasma Physics (118). 2018. № 6. P. 63.
Ziegler J.F., Biersack J.P., and Ziegler M.D. // Ion Implantation Techniques: Lectures Given at the Ion Implantation School in Connection with Fourth International Conference on Ion Implantation: Equipment and Techniques Berchtesgaden, Fed. Rep. of Germany, September 13–15, 1982. (Springer-Verlag Berlin Heidelberg, 1982). S. 122.
Смирнов Б.М. Атомные столкновения и элементарные процессы в плазме. М.: Атомиздат, 1968. 305 с.
Тищенко Л.П., Перегон Т.И., Ковтуненко Ю.И., Бобков В.В., Онищенко А.В., Старовойтов Р.И. // Изв. РАН. Сер. физ. 2006. Т. 70. № 8. С. 1197.
Бобков В.В., Старовойтов Р.И., Тищенко Л.П., Зубарев Е.Н., Ковтуненко Ю.И., Логачев Ю.Е. // Труды XX Межд. конф. ВИП-2011. Звенигород, Россия, 25–29 августа, 2011 (Москва, 2011). Т. 2. С. 61.
Arkhipov I.I., Kanashenko S.L., Sharapov V.M., Zalavutdinov R.Kh., Gorodetsky A.E. // J. Nucl. Mater. 2007. V. 363–365. P. 1168.
Iwakiri H., Yasunaga K., Morishita K., Yoshida N. // J. Nucl. Mater. 2000. V. 283–287. P. 1134.
Watanabe Y., Iwakiri H., Yoshida N., Morishita K., Kohyama A. // Nucl. Instrum. Methods. B. 2007. V. 255. P. 32.
Nagata S., Takahiro K., Horiike S., Yamaguchi S. // J. Nucl. Mater. 1999. V. 266–269. P. 1151.
Efimov V.S., Gasparyan Yu.M., and Pisarev A.A. // Proceedings of the 20th International Conference on Ion-Surface Interactions, Zvenigorod, Russia, August 25–29, 2011 (Moscow, 2011). V. 1. P. 306.
Eleveld H., van Veen A. // J. Nucl. Mater. 1994. V. 212. P. 1421.
Кирсанов В.В. Дефекты в кристаллах и их моделирование на ЭВМ. Ленинград: Наука, 1980. 214 с.
Debelle A., Lhuillier P.-E., Barthe M.-F., Sauvage T., Desgardin P. // Nucl. Instrum. Methods. B 2010. V. 268. P. 223.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


