Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 12, стр. 74-78
Численное моделирование радиационного нагрева различных полупроводниковых гетероструктур
Г. Ф. Сивых a, *, Н. Ю. Петров a, **
a Новосибирский государственный технический университет
630073 Новосибирск, Россия
* E-mail: genfes@ngs.ru
** E-mail: n.petrov@corp.nstu.ru
Поступила в редакцию 20.03.2021
После доработки 25.05.2021
Принята к публикации 30.05.2021
Аннотация
Исследовано влияние толщины эпитаксиального слоя на температуру различных образцов гетероструктур с существенно отличающимися коэффициентами поглощения в результате их лучистого нагрева. Показано, что началу роста эпитаксиального слоя сопутствует скачкообразное увеличение температуры, которое обусловлено увеличением коэффициента отражения на границе образца вследствие появления слоя с оптическими свойствами, отличными от свойств подложки.
ВВЕДЕНИЕ
Последние годы отмечены интенсивным развитием технологий изготовления полупроводниковых структур. Одним из наиболее перспективных является метод молекулярно-лучевой эпитаксии (МЛЭ), позволяющий выращивать гетероструктуры с точностью до атомного монослоя [1]. Наиболее распространенным способом нагрева подложек в установках МЛЭ является использование теплового излучения от резистивного нагревателя.
Температура полупроводникового образца существенно зависит от наличия на его поверхности других покрытий или полупроводниковых слоев. Например, при выращивании полупроводниковых эпитаксиальных слоев, ширина запрещенной зоны которых меньше, чем у подложки, в них будет дополнительно поглощаться тепловое излучение в длинноволновой области спектра. К подобным гетероструктурам относятся Ge/Si, InAs/GaAs, PbTe/Si и другие.
Рост в режиме неконтролируемого повышения температуры приводит к ухудшению качества структуры [2–7]. Поэтому необходим контроль температуры образца в процессе его роста и, при необходимости, ее корректировка путем изменения температуры нагревателя [8]. Однако прямой контроль температуры растущего эпитаксиального слоя сопряжен с существенными техническими трудностями при его реализации. Например, при использовании термопары невозможен непосредственный тепловой контакт с подложкой вследствие ее вращения.
В настоящей работе предлагается численный метод прогнозирования нагрева образца для существенно различных по физическим свойствам гетероструктур Ge/Si (образец 1) и PbTe/InSb (образец 2) в процессе МЛЭ.
ПОСТАНОВКА ЗАДАЧИ И АЛГОРИТМ РАСЧЕТА
Схема установки МЛЭ, использованная в работе для анализа нагрева образцов, представлена на рис. 1. Нагреватель располагается вплотную к подложке, причем спектр его излучения совпадает со спектром абсолютно черного тела.
Уравнение теплового баланса образца в рамках модели серого тела имеет вид:
(1)
${{a}_{1}}S{{I}_{{\text{H}}}} = ({{a}_{1}} + {{a}_{3}}){\kern 1pt} \sigma S{{T}^{4}} + S({{I}_{f}} + {{I}_{b}}).$Коэффициенты отражения $\rho $ и пропускания $a = 1 - \rho $ для границ раздела рассчитывали по формулам Френеля:
(2)
$\rho = {{\left( {\frac{{{{n}_{{21}}} - 1}}{{{{n}_{{21}}} + 1}}} \right)}^{2}},\,\,\,\,a = {{n}_{{21}}}{{\left( {\frac{2}{{{{n}_{{21}}} + 1}}} \right)}^{2}},$Поскольку материалы образцов обладают высокой степенью селективности, расчет энергии, поглощенной образцом, проводился путем разбиения излучения нагревателя на узкие спектральные полосы:
Здесь ${{I}_{{{\text{H}},~i}}} = \int_{{{\lambda }_{i}}}^{{{\lambda }_{{i{\kern 1pt} + {\kern 1pt} 1}}}} {r{\kern 1pt} {\text{*}}d\lambda } $ – плотность потока лучистой энергии нагревателя, приходящейся на диапазон длин волн $\left[ {{{\lambda }_{i}},~{{\lambda }_{{i{\kern 1pt} \, + \,{\kern 1pt} 1}}}} \right],$ $r* = \frac{{2\pi h{{c}^{2}}}}{{{{\lambda }^{5}}}}$ × × $\frac{1}{{{\text{exp}}\left( {{{hc} \mathord{\left/ {\vphantom {{hc} {k{{T}_{{\text{H}}}}\lambda }}} \right. \kern-0em} {k{{T}_{{\text{H}}}}\lambda }}} \right) - 1}}$ – спектральная светимость абсолютно черного тела; $k$ – постоянная Больцмана, $h$ – постоянная Планка.Для расчета температуры различных гетероструктур в [9] были использованы две схемы прохождения излучения нагревателя через образец. В случае схемы 1 (рис. 1) ${{I}_{f}} = {{I}_{0}},$ ${{I}_{b}} = {{I}_{1}};$ для схемы 2 (рис. 2) – ${{I}_{f}} = {{I}_{0}} + {{I}_{2}},$ ${{I}_{b}} = {{I}_{1}} + I_{{\text{3}}}^{'}.$ Поглощение излучения нагревателя внутри образца рассчитывали с использованием экспоненциального закона Бугера. В качестве примера приведем уравнение для расчета плотности потока ${{I}_{1}},$ покидающего образец, для схемы 1 (рис. 1): ${{I}_{1}} = \sum {{I}_{{1,~i}}},$ где
(4)
${{I}_{{1,i}}} = {{a}_{1}}{{a}_{2}}{{a}_{3}}{\text{exp}}\left( { - {{\alpha }_{{1,i}}}b} \right){\text{exp}}\left( { - {{\alpha }_{{2,i}}}d} \right){{I}_{{{\text{H}},i}}}.$Рис. 3.
Зависимость коэффициентов поглощения Ge (1), Si (2) и спектральной светимости r * (3) от длины волны.
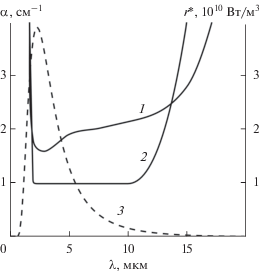
Рис. 4.
Зависимость коэффициентов поглощения PbTe (1), InSb (2) и спектральной светимости r * (3) от длины волны.
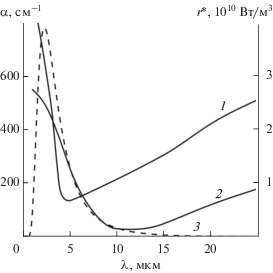
Следует сразу отметить, что использование схем 1 и 2 оправдано в тех случаях, когда оба слоя гетероструктурного образца обладают сильным поглощением. Однако для материалов с достаточно высокой прозрачностью в диапазоне частот, на который приходится основная доля энергии, излученной нагревателем (этот диапазон будем называть энергонесущим), необходимо учитывать дополнительный унос энергии вследствие многократного отражения лучей от внутренних границ образца. Типичным примером такого материала может служить кремний, коэффициент поглощения которого в энергонесущем диапазоне длин волн λ = 1–10 мкм составляет $\alpha \approx 100~\,{{{\text{м}}}^{{ - 1}}}$ (рис. 3). Поэтому для учета этой особенности была использована схема 3 , представленная на рис. 5.
С целью упрощения расчетов в схеме не учитываются лучи, возникающие при отражении от нижней поверхности границы 2. Примером такого луча является луч $I_{{\text{3}}}^{'}$ на схеме 2 . Возникающая погрешность пренебрежимо мала. Действительно, поскольку коэффициенты преломления кремния и германия в энергонесущем диапазоне частот близки по величине, коэффициент отражения на границе между ними составляет $\rho \approx 0.005,$ т.е. пренебрежимо мал. Например, расчет, проведенный для схемы 2 , с учетом луча $I_{{\text{3}}}^{'}$ приводит к уменьшению температуры образца лишь на $\Delta T \approx 1~$ К по сравнению с расчетом, когда этот луч не учитывается. При таком упрощении для плотности потоков, не поглощенных образцом, будем иметь:
Аналогичные расчеты были проведены для образца 2 (гетероструктуры PbTe/InSb). Структуры такого типа представляют определенный интерес из-за возможности их использования при создании инфракрасных детекторов [12]. В настоящей работе эта гетероструктура выбрана в качестве “предельной”, а именно для демонстрации особенностей при расчете нагрева структур с экстремально высокими значениями коэффициентов поглощения.
РЕЗУЛЬТАТЫ РАСЧЕТА
Расчеты были проведены для образцов с толщиной подложки $b = 500{\text{\;}}$ мкм при температуре нагревателя ${{T}_{{\text{H}}}} = 1250~$ К. На рис. 6 представлена зависимость температуры образцов 1 (кривая 1) и 2 (кривая 2) со слоем толщиной $d = 5~$ мкм от числа N учтенных при расчете лучей, покинувших образец. Асимптотический характер зависимости, полученной для образца 1, свидетельствует о том, что точность, достигаемая при расчете, вполне удовлетворительна при N = 6. Различие в температурах ${{T}_{6}} \approx 628~$ К и ${{T}_{7}} \approx 627$ К составляет $\Delta T \approx 1~$ К, что согласуется с величиной погрешности схемы 3 , использованной в расчетах. Здесь и ниже индекс при значениях температуры совпадает с номером соответствующих лучей на рис. 5.
Рис. 6.
Зависимость температуры образца со слоем Ge (1) и PbTe (2) толщиной 5 мкм от числа учтенных при расчете лучей.

Для полноты картины приведем также интенсивность луча $~{{I}_{0}} = 4.22 \times {{10}^{4}}$ Вт/м2, отраженного от лицевой стороны образца 1, и последних лучей, учтенных при расчете ${{I}_{6}} = 201$ Вт/м2 и ${{I}_{7}} = 52$ Вт/м2. Величина невязки, возникающей вследствие пренебрежения последующими лучами, не превышает 0.05% от суммарной интенсивности лучей, не поглощенных образцом. Для образца 2 удовлетворительная точность достигается уже при N = 1. Различие в температурах ${{T}_{1}} = 1072.67$ К и ${{T}_{2}} = 1072.47$ К составляет лишь $\Delta T \approx 0.2$ К.
На рис. 7 представлены результаты расчета температуры образца 1 в зависимости от толщины $d$ эпитаксиальной пленки Ge для трех схем. Видно, что результаты расчета с использованием схемы 3 , учитывающей многократное отражение лучей, существенно отличаются от расчета по схемам 1 и 2 . Например, при толщине пленки $d = 5$ мкм разница температур, полученная при расчете по схеме 3 , составляет $\Delta {{T}_{1}} \approx 230$ К для схемы 1 и $\Delta {{T}_{2}} \approx 90$ К для схемы 2 . Влияние толщины эпитаксиального слоя Ge менее существенное, чем учет многократного отражения. Оно составляет $\Delta {{T}_{d}} \approx 20$ К при $d = 5$ мкм.
Рис. 7.
Зависимость температуры образца 1 от толщины d эпитаксиальной пленки Ge для трех расчетных схем: 1 – схема 1 , $N = 1;$ 2 – схема 2 , $N = 2;$ 3 – схема 3 , $~N = 7.$
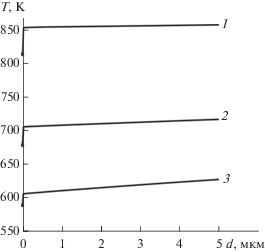
На рис. 8 представлены результаты расчета температуры образца 2 в зависимости от толщины $d$ эпитаксиальной пленки PbTe для трех схем. Видно, что результаты расчета с использованием схемы 3 , учитывающей многократное отражение лучей, практически не отличаются от расчета по схемам 1 и 2 . Например, при толщине пленки $d = 5~$ мкм разница температур, полученная при расчете по схеме 3 , составляет $\Delta {{T}_{1}} \approx 0.2$ К для схемы 1 и $\Delta {{T}_{2}} \approx 0.01$ К для схемы 2 .
Рис. 8.
Зависимость температуры образца 2 от толщины d эпитаксиальной пленки PbTe для трех расчетных схем: сплошная линия – схема 1 , $~N = 1;$ пунктир – схема 2 ; $N = 2;$ точки – схема 3 , $N = 3.$

Скачкообразное увеличение температуры образца 1 на начальном этапе роста эпитаксиального слоя на $\Delta {{T}_{0}} \approx 18$ К связано не с увеличением толщины слоя, а с резким увеличением коэффициента отражения образца на его границе с вакуумом вследствие образования микрослоя германия на поверхности кремниевой подложки: от ${{\rho }_{{{\text{Si}}}}} = 0.305$ до ${{\rho }_{{{\text{Ge}}}}} = 0.365.$ Достоверность этого вывода подтверждена расчетами. Температура образца уменьшается монотонно при уменьшении толщины пленки вплоть до значения $d = 0.01$ мкм, при котором пленку еще можно характеризовать макроскопическими величинами – толщиной d и показателем преломления n.
Аналогичная ситуация наблюдается для образца 2. Резкое увеличение температуры образца на начальном этапе роста эпитаксиального слоя $\Delta {{T}_{0}} \approx 24~$ К соответствует увеличению коэффициента отражения образца от ${{\rho }_{{{\text{InSb}}}}} = 0.365$ до ${{\rho }_{{{\text{PbTe}}}}} = 0.473.$
ЗАКЛЮЧЕНИЕ
Проанализировано влияние расчетной схемы на температуру гетероструктурных образцов Ge/Si и PbTe/InSb в результате их лучистого нагрева. Показано, что для материалов типа Ge/Si с высокой прозрачностью в энергонесущем диапазоне частот, в отличие от материалов с низкой прозрачностью типа PbTe/InSb, следует учитывать дополнительный унос энергии вследствие многократного отражения лучей от внутренних границ образца.
Влияние толщины эпитаксиального слоя Ge на температуру образца 1 менее существенно, чем учет многократного отражения.
Скачкообразное увеличение температуры образцов, которое сопутствует началу роста эпитаксиального слоя, обусловлено увеличением коэффициента отражения образцов вследствие появления на их границе слоя с оптическими свойствами, отличными от свойств подложки.
Список литературы
Алферов Ж.И., Асеев А.Л., Гапонов С.В., Копьев П.С., Панов В.И., Полторацкий Э.А., Сибельдин Н.Н., Сурис Р.А. // Микросистемная техника. 2003. № 8. С. 3.
Grange J.D., Parker E.H.C., King R.M. // J. Phys. D. Appl. Phys. 1979. V. 12. P. 1601.
Kubiak R.A.A., Parker E.H.C., Neustead S., Harries J.J. // Appl. Phys. A. 1984. V. 35. P. 61.
Yano M., Nogami M., Matsushima Y., Kimata M. // Jpn. J. Appl. Phys. 1977. V. 16. № 12. P. 2131.
Meditt B.T., Parker E.H.C., King R.M., Grange J.D. // J. Cryst. Growth. 1980. V. 50. P. 538.
Foxon C.T., Joyce B. // J. Cryst. Growth. 1978. V. 44. P. 75.
Кантер Ю.О., Торопов А.И., Ржанов А.В., Стенин С.И., Говрилова Т.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1986. № 9. С. 83.
Рогозин И.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2007. № 8. С. 78.
Кацюба А.В., Величко А.А., Илюшин В.А., Сивых Г.Ф. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2014. № 7. С. 70. https://doi.org/10.7868/S0207352814070075
Воронкова Е.М., Гречушников Б.Н., Дистлер Г.И., Петров И.П. Оптические материалы для инфракрасной техники. М.: Наука, 1965. 336 с.
Котликов Е.Н., Кузнецов Ю.А., Лавровская Н.П., Тропин А.Н. // Научное приборостроение. 2008. Т. 18. № 3. С. 32.
Lee K.-K., Priyantha W., Myers T.H. // Appl. Phys. Lett. 2012. V. 100. Iss. 5. P. 052108. https://doi.org/10.1063/1.3681161
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования