Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 2, стр. 60-66
Особенности морфологии и структуры тонких пленок кремния
А. В. Новак a, b, *, В. Р. Новак c, Д. И. Смирнов a, d, А. В. Румянцев a
a Национальный исследовательский университет “МИЭТ”
124498 Зеленоград, Россия
b АО “Ангстрем”
124460 Зеленоград, Россия
c ООО “НТ-МДТ Спектрум Инструментс”
124460 Зеленоград, Россия
d OОО “ИМАШ ресурс”
105082 Москва, Россия
* E-mail: novak-andrei@mail.ru
Поступила в редакцию 12.01.2020
После доработки 18.03.2020
Принята к публикации 22.03.2020
Аннотация
Изучена морфология поверхности и структура тонких LPCVD-пленок кремния толщиной менее 40 нм, получаемых при температуре осаждения T = 550°С, при которой обычно получают аморфные пленки (a-Si), и при температуре осаждения 584°С, при которой получают пленки поликристаллического кремния с полусферическими зернами (HSG-Si) с большой шероховатостью поверхности. Найдено, что при температуре осаждения 550°С при толщинах 35 нм и более происходит образование аморфных пленок, имеющих сравнительно гладкую поверхность, а при толщинах менее 35 нм происходит образование зернообразных поликристаллических HSG-Si-пленок с большой шероховатостью поверхности. Показано, что зернообразные пленки кремния, осажденные при T = 550°С (d = 28 нм), имеют морфологию, аналогичную HSG-Si-пленкам, осажденным при T = 584°С (d = 29 нм). Найдено, что с уменьшением толщины осаждаемой пленки кремния до 28 нм нижняя граница температурного интервала, при которой происходит образование HSG-Si пленок, сдвигается в сторону меньших температур до T = 550°C.
ВВЕДЕНИЕ
Тонкие пленки аморфного кремния (a-Si), поликристаллического (poly-Si) и поликристаллического кремния с полусферическими зернами (HSG-Si), получаемые на основе метода химического осаждения из газовой фазы (CVD), широко используются в микроэлектронике, в том числе в различных трехмерных полупроводниковых структурах, например, для вертикальных транзисторов (V‑NAND flash-память) [1, 2], щелевых конденсаторов для DRAM-памяти [3, 4]. В частности, особый интерес представляют тонкие слои аморфного кремния, на основе которых в последнее время разрабатываются различные тонкопленочные транзисторы (TFT) [2, 5–8] с тонкопленочным каналом из поликристаллического кремния (poly-Si), получаемым при кристаллизации аморфного кремния (a-Si). В данных работах при изготовлении тонкопленочных транзисторов и трехмерных устройств канал poly-Si формировали посредством кристаллизации тонких LPCVD-пленок a-Si с толщинами 50–100 нм. Использование тонких слоев a-Si обусловлено тем, что слои poly-Si, полученные кристаллизацией a-Si, имеют существенно меньшую шероховатость поверхности [9, 10].
Шероховатость поверхности, неоднородность толщины и структура осажденных слоев кремния оказывает существенное влияние на электрофизические характеристики приборов (особенно с уменьшением толщины слоев), что обусловлено необходимостью миниатюризации тонкопленочных устройств. Ранее изучению морфологии и структуры пленок кремния было посвящено значительное количество работ, однако в основном изучались довольно “толстые” пленки, имеющие толщины более 50–500 нм.
В данной работе изучается морфология и структура тонких пленок кремния, имеющих среднюю толщину d менее 50 нм, полученных методом химического парофазного осаждения при низком давлении (LPCVD) и при температурах осаждения Td ≈ 550 и ≈584°С.
ЭКСПЕРИМЕНТ И АНАЛИЗ АСМ-ИЗОБРАЖЕНИЙ
Методика изготовления и измерения пленок
Пленки кремния получали методом химического парофазного осаждения при низком давлении (LPCVD) при разложении моносилана SiH4, давление составляло 0.2 Торр. В качестве подложек для осаждения использовались пластины монокристаллического кремния p-типа (c-Si) со слоем термического окисла (SiO2) толщиной 35 нм. Изготовлялись и исследовались два типа образцов: пленки, осаждаемые при температуре 550°C, и пленки, осаждаемые при 584°C. Согласно литературным данным [7–12], температура осаждения около 550°C – это температура, при которой обычно производят получение пленок аморфного кремния (a-Si). Температура осаждения, равная 580–584°C, соответствует температуре, при которой получаются пленки поликристаллического кремния с полусферическими зернами (HSG-Si – Hemispherical Grain Si), имеющие большую площадь поверхности [13–15]. Толщина получаемых слоев кремния варьировалась от 10 до 60 нм.
Изучение морфологии производили методами атомно-силовой (АСМ) и растровой электронной микроскопии (РЭМ). Для АСМ-измерений использовался атомно-силовой микроскоп Солвер P47 (NT-MDT, г. Зеленоград) в полуконтактном режиме сканирования, амплитуда колебаний зонда составляла 5–10 нм. В качестве зондов использовали кантилеверы марки NSG_01 (NT-MDT), имеющие, согласно паспортным данным, радиус кривизны острия менее 5–10 нм. В результате АСМ-измерений получали сканы АСМ-изображений размерами 500 × 500 нм, 1 × 1 мкм, имеющие 1024 × 1024 точек. Для полученных АСМ-изображений, представляющих двумерные функции высоты поверхности Z(xi, yj), отсчитанной от базовой плоскости XY, вычисляли основные параметры поверхности, определяемые стандартами ISO 25 178-2:2012 [16] и ASME B46.1-2009 [17] и характеризующие шероховатость, пространственные и корреляционные свойства поверхности. Расчет параметров морфологии и математическую обработку АСМ-изображений проводили при помощи программных пакетов Image Analysis P9 (NT-MDT). РЭМ-изображения получали на электронно-ионном микроскопе Helios Nanolab 650. Структуру пленок кремния изучали при помощи многофункционального рентгеновского дифрактометра Smartlab 3 kW (Rigaku, Япония) и просвечивающего электронного микроскопа (ПЭМ) Titan Themis 200 при ускоряющем напряжении 200 кВ. Рентгеноструктурные измерения были проведены в скользящей несимметричной геометрии сканирования для исследования нанометрового приповерхностного слоя за счет эффекта полного внешнего рентгеновского отражения. Использована фокусировка Брэгга–Брентано, селекция характеристической линии излучения (CuKα) λ = 0.1542 нм выполнена при помощи монохроматора-анализатора на базе мозаичного кристалла пиролитического графита. Дифракционный сигнал от исследуемых нанометровых пленок оказался слабым и зашумленным, поэтому выполнена математическая аппроксимация формы пиков стандартной функцией псевдо-Фойгта.
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
Морфология пленок кремния
На рис. 1 показаны АСМ-изображения пленок кремния, осажденных при T = 550°C (рис. 1а–1в) и T = 584°C (рис. 1г–1е) и имеющих средние толщины d, нм: 12 (рис. 1а), 28 (рис. 1б), 35 (рис. 1в), 9 (рис. 1г), 29 (рис. 1д), 40 нм (рис. 1е). В табл. 1 приведены основные статистические параметры, рассчитанные для АСМ-изображений с одинаковой выборочной площадью и усредненные по четырем изображениям.
Рис. 1.
АСМ-изображения размером 0.5 × 0.5 мкм пленок кремния, имеющие средние толщины d и температуры осаждения T, соответственно: 12 нм, T=550°C (а); 28 нм, T = 550°C (б); 35 нм, T = 550°C (в); 9 нм, T = 584°C (г); 29 нм, T = 584°C (д); 40 нм, T = 584°C (е).

Таблица 1.
Основные статистические параметры, рассчитанные для АСМ-изображений пленок кремния, осажденных при температурах 550 и 584°C
| Температура осаждения Т, °C | 550°C | 584°C | ||||
| Средняя толщина пленки d, нм | 12 | 28 | 35 | 9 | 29 | 40 |
| Размер зерен Dg, нм | 27.4 ± 1.1 | 51.7 ± 1.1 | – | 22.2 ± 1.1 | 64.1 ± 1.2 | 70.3 ± 3.7 |
| Высота зерен Zg, нм | 17.1 ± 1.0 | 39.0 ± 1.0 | – | 11.6 ± 1.2 | 41.1 ± 0.83 | 51.8 ± 1.3 |
| Отношение Zg/Dg | 0.62 | 0.75 | – | 0.52 | 0.64 | 0.74 |
| Плотность зерен Ng, 1/(мкм · мкм ) | 864 | 262 | – | 1500 | 200 | 160 |
| Амплитудные параметры | ||||||
| Максимальная высота рельефа поверхности Sz, нм | 33.8 ± 2.5 | 55.3 ± 3.4 | 9.36 ± 0.9 | 20.6 ± 1.9 | 52.4 ± 0.7 | 63.1 ± 1.7 |
| Среднеквадратичная шероховатость Sq, нм | 6.05 ± 0.3 | 13.0 ± 0.8 | 1.19 ± 0.1 | 3.7 ± 0.1 | 10.7 ± 0.1 | 11.8 ± 0.4 |
| Глубина самой глубокой впадины Sv, нм | 12.4 ± 1.2 | 28.2 ± 2.1 | 5.4 ± 0.4 | 8.5 ± 1.2 | 29.6 ± 0.8 | 40.6 ± 0.8 |
| Высота самого высокого пика Sp, нм | 21.3 ± 1.1 | 27.1 ± 1.2 | 3.93 ± 0.2 | 12.0 ± 1.2 | 22.8 ± 0.5 | 22.9 ± 1.0 |
| Асимметрия Ssk | 0.35 ± 0.05 | –0.45 ± 0.05 | –0.28 ± 0.12 | 0.19 ± 0.13 | –0.89 ± 0.01 | –1.29 ± 0.06 |
| Эксцесс Sku | 2.47 ± 0.10 | 2.16 ± 0.10 | 3.16 ± 0.13 | 2.49 ± 0.16 | 3.12 ± 0.03 | 4.43 ± 0.15 |
| Пространственные параметры | ||||||
| Автокорреляционная длина Sal, нм | 16.1 ± 1.1 | 22.0 ± 1.6 | 13.5 ± 0.9 | 10.0 ± 0.4 | 20.1 ± 0.4 | 22.3 ± 1.0 |
| Аспектное отношение текстуры Str | 0.9 ± 0.1 | 0.9 ± 0.1 | 0.9 ± 0.1 | 0.9 ± 0.1 | 0.9 ± 0.1 | 0.9 ± 0.1 |
Как видно из данных (табл. 1 и рис. 1) в исследованном интервале толщин пленок (10–40 нм) при температуре осаждения Т = 584°С происходит образование пленок поликристаллического кремния с полусферическими зернами (HSG-Si) аналогично более толстым пленкам, имеющим толщины 40–150 нм [13–15]. Пленки HSG-Si состоят из сравнительно плотно упакованных зерен (размерами в несколько десятков нанометров) и имеют значительную шероховатость поверхности [16–18]. Площадь поверхности таких пленок примерно в два раза превышает площадь гладкой поверхности.
Традиционным параметром, используемым для характеристики шероховатости поверхности, является среднеквадратичная шероховатость Sq, которая относится к группе амплитудных или высотных параметров [19–21]. Этот параметр также называют шириной интерфейса w [15, 22] и корреляционной длиной в вертикальном направлении [23]. Параметр Sq является характеристикой неоднородности поверхности в вертикальном направлении. Другими высотными параметрами являются Sz, Sv. Параметр Sz (максимальная высота рельефа поверхности) определяется как разность высот между самой высокой и самой низкой точками поверхности на выборочной площади. Этот параметр соответствует толщине поверхностного “возмущенного” слоя, не полностью заполненного материалом, в котором происходит изменение рельефа. Параметр Sv определяется как глубина самой глубокой впадины, отсчитанная от средней плоскости, определяемой из условия 〈Z(xi, yj)〉 = 0. Фактически Sv соответствует средней толщине поверхностного “возмущенного” слоя.
В случае исследованных нами пленок HSG-Si, осажденных при температуре 584°С, среднеквадратичная шероховатость Sq возрастает с 3.7 до 11.8 нм при увеличении средней толщины d от 10 до 40 нм. При этом соответственно максимальная высота рельефа поверхности Sz возрастает от 20.6 до 63.1 нм, средний размер зерен Dg увеличивается от 22 до 70 нм, средняя высота зерен Zg увеличивается с 12 до 52 нм. Автокорреляционная длина Sal, характеризующая неоднородность поверхности в латеральном направлении, возрастает с 10 до 22 нм.
В случае пленок кремния, осажденных при температуре T = 550°C, при средней толщине пленки d менее 35 нм происходит образование зернообразных пленок, имеющих большую шероховатость поверхности, которые по своей морфологии аналогичны HSG-Si-пленкам, получаемым при температуре осаждения Т = 584°С. А затем с ростом средней толщины, происходит резкое изменение морфологии пленки. И при толщине d = 35 нм и более происходит образование аморфных пленок кремния. Соответственно, для пленок, осажденных при T = 550°C, при средних толщинах 12 и 28 нм среднеквадратичная шероховатость Sq составляет 6.1 и 13.0 нм; максимальная высота рельефа Sz – 34 и 55 нм; средний размер зерен Dg – 27 и 52 нм; средняя высота зерен Zg – 17 и 39 нм; автокорреляционная длина в латеральном направлении Sal – 16 и 22 нм.
Некоторое отличие морфологии HSG-Si-пленок, осажденных при T = 550°C от пленок, осажденных при T = 584°C, состоит в том, что в пленках (T = 550°C) зерна являются более каплеобразными и более изолированными друг от друга, что хорошо видно на РЭМ-изображениях (рис. 2), где показан фрагмент пленки толщиной d = 28 нм (T = 550°C) и пленки d = 29 нм (T = = 584°C).
Рентгенофазовый анализ пленок кремния
На рис. 3 представлены рентгеновские дифрактограммы для двух пленок кремния: зернообразной (толщина d = 28 нм, T = 550°C) и HSG-Si-пленки (d = 29 нм, T = 584°C). На дифрактограмме пленки с полусферическими зернами (HSG-Si) отчетливо видны дифракционные отражения от различных кристаллографических плоскостей кремния, что указывает на поликристаллический характер исследуемого образца. В то же время дифракционный сигнал от пленки кремния толщиной d = 28 нм (T = 550°C), имеющей зернообразную морфологию, определятся слабо, что характерно для образцов, в которых процесс кристаллизации не завершен полностью.
Рис. 3.
Рентгеновские дифрактограммы исследуемых пленок: а – дифракционные отражения от кристаллографической плоскости Si(111), б – Si(311). Кривая 1 – сигнал от HSG-Si-пленки толщиной d = 29 нм, T = 584°C; кривая 2 – от зернообразной кремниевой пленки толщиной d = 28 нм, T = 550°C.

Наблюдение наибольшей интенсивности пика Si(311) по сравнению с Si(111) в образцах согласуется с данными, опубликованными в работах [17, 18], где сообщалось, что зерна, из которых образованы HSG-Si-пленки, ориентированы преимущественно в плоскости (001) и образуют текстуру. В указанных работах и в настоящем исследовании рентгеноструктурные измерения проведены в скользящей несимметричной геометрии, в связи с чем, для текстуры (001) преобладающим будет отражение от плоскости (311).
Для HSG-Si-пленки по уширению дифракционного пика Si(111) по формуле Селякова-Шеррера (с поправкой на геометрическое расхождение пучка в скользящей геометрии сканирования) рассчитана величина области когерентного рассеяния (ОКР), связанная со средними размерами блоков в кристаллитах пленки. Величина ОКР находится в пределах 10–15 нм, что удовлетворительно согласуется с общей толщиной HSG-Siпленки d = 29 нм.
Ранее в работах [13–15] проводилось изучение условий формирования HSG-Si- пленок кремния для интервала толщин 60–170 нм. Было найдено, что температурный интервал, в котором возможно образование HSG-Si-пленок, с уменьшением толщины осажденной пленки расширяется, и при этом нижняя граница температурного интервала смещается в сторону меньших температур. Так, эта граница температурного интервала соответствует: 580°C при толщине 150 нм; 578°C при толщине 100 нм и 570°C при толщине 60 нм [13]. Из полученных нами данных следует, что с уменьшением толщины осаждаемой пленки до 28 нм нижняя граница температурного интервала, при которой происходит образование HSG-Si-пленки, сдвигается до T = 550°C.
Морфология и структура пленок кремния, осажденных при T = 550°C и имеющих толщину более 30–35 нм, существенно отличается от более тонких HSG-Si-пленок, полученных при этой же температуре. Такие пленки являются аморфными и имеют сравнительно гладкую поверхность по сравнению с пленками поликристаллического кремния и пленками HSG-Si [10]. Так, в случае пленки толщиной d = 35 нм (T = 550°C) (рис. 1в): среднеквадратичная шероховатость Sq составляет 1.2 нм, максимальная высота рельефа Sz – 9.4 нм. В частности, такой параметр, как относительное увеличение площади поверхности Sdr [16–18], в случае пленки d = 35 нм (T = 550°C) составляет около 1.2%, в то время как в случае пленок HSG-Si значение параметра Sdr составляет ~80–100%.
На рис. 4 показаны ПЭМ-изображения образцов поперечного сечения пленки кремния d = = 35 нм, T = 550°C, осажденной на слой оксида кремния, толщиной 35 нм, который сформирован на кремниевой пластине. В верхней части рисунка виден защитный слой платины и аморфного углерода (Pt + a-C), необходимый для минимизации повреждений изучаемого материала в процессе приготовления тонкой фольги методом фокусированного ионного пучка.
Рис. 4.
ПЭМ-изображение пленки кремния толщиной 35 нм, осажденной при T = 550°C на слой оксида кремния толщиной 35 нм (а). Увеличенное изображение области, выделенной на рис. 4а штриховой линией (б).
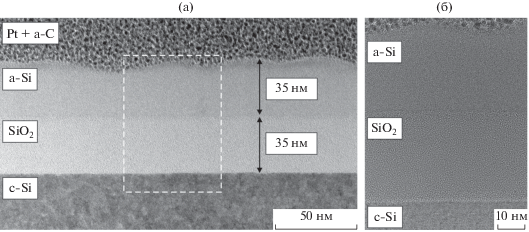
Из ПЭМ-данных, показанных на рис. 4, видно, что пленка толщиной d = 35 нм (T = 550°C) является сплошной, внутри ее отсутствуют какие-либо зерна, а поверхность ее достаточно гладкая. Согласно данным, полученным нами ранее [10], пленки кремния, осажденные при T = = 550°C и имеющие толщины в интервале 40–500 нм, являются аморфными, причем с ростом толщины шероховатость поверхности таких пленок уменьшается.
Тот факт, что LPCVD-пленка, осажденная при T = 550°С и имеющая толщину 35 нм, не содержит внутри себя каких-либо зерен, указывает на то, что нижний слой пленки, образованный в начале осаждения, не содержит зерен. Из этого следует, что ранее сделанное предположение [10, 24] об эволюции морфологии поверхности тонких LPCVD-пленок аморфного кремния в процессе роста не вполне соответствуют действительности. Согласно этим представлениям [10, 24], при LPCVD-осаждении пленки аморфного кремния сначала происходит образование зернообразного слоя, имеющего значительную шероховатость, а затем с ростом толщины этот слой зарастает аморфным кремнием, при этом шероховатость уменьшается. Обнаруженное нами отсутствие зерен в нижнем слое аморфной LPCVD-пленки, осажденной при T = 550°С и имеющей толщину 35 нм показывает, что это не так. Т.е. на начальной стадии осаждения пленки не происходит образования кристаллических полусферических зерен и последующее их зарастание кремнием, имеющим аморфную фазу. Это, в частности, согласуется с представлениями по образованию и росту HSG-Si-пленок [16–18]. Согласно этим представлениям, центры зарождения полусферических зерен возникают на поверхности аморфного кремния, и во время осаждения верхняя поверхность осаждающейся пленки еще имеет аморфную структуру. Затем образуется структура HSG-Si путем зарождения и роста зерен через миграцию атомов Si на чистой поверхности осажденного аморфного Si как во время продолжающегося осаждения, так и последующего отжига в вакууме (или нахождения пленки в течение некоторого времени при температуре осаждения в бескислородной атмосфере).
ЗАКЛЮЧЕНИЕ
Таким образом, проведено исследование морфологии поверхности и структуры тонких LPCVD-пленок кремния (в интервале толщин 10–40 нм), получаемых при температуре осаждения T = 550°С, которая обычно используется для получения слоев аморфного кремния (при толщинах 50–500 нм), и при температуре 584°С, при которой получают HSG-Si-пленки с большой шероховатостью поверхности.
Для тонких LPCVD-пленок кремния (в интервале толщин 10–40 нм), получаемых при температурах осаждения 550 и 584°С, из анализа АСМ-данных получены такие характеристики поверхности как средний размер Dg, средняя высота Zg и плотность зерен Ng, среднеквадратичная шероховатость поверхности Sq, максимальная высота рельефа Sz, латеральная корреляционная длина Sal и другие статистические параметры.
Показано, что при получении пленок кремния при температуре осаждения Т = 550°С, наблюдается зависимость от средней толщины осажденного слоя: при толщинах 35 нм и более происходит образование аморфных пленок, имеющих сравнительно гладкую поверхность, а при толщинах менее 35 нм происходит образование поликристаллических пленок кремния с полусферическими зернами HSG-Si с большой шероховатостью поверхности.
Найдено, по данным рентгенофазового анализа, что в зернообразных пленках кремния, осажденных при T = 550°С и имеющих толщину d = = 28 нм, не завершен полностью процесс кристаллизации. Пленки HSG-Si толщиной d = 29 нм, осажденные при T = 584°С, состоят из наноразмерных кристаллитов кремния, которые образуют текстуру с преимущественной ориентацией в плоскости (001).
Получено, что с уменьшением толщины осаждаемой LPCVD-пленки кремния до 28 нм нижняя граница температурного интервала, при которой происходит образование HSG-Si-пленки, сдвигается в сторону меньших температур до T = = 550°C.
Список литературы
Wang B., Gao B., Wu H., Qian H. // Microelectronic Engineering. 2018. V. 192. P. 66.
Nguyen M.C., Jeon Y.S., Tong D.T., You S.W., Jeong J.K., Kim B., Ahn J.Y., Hwang K., Choi R. // Solid-State Electronics. 2015. V. 104. P. 86.
Yang H.J., Hee S.K., Seong J.K. // Materials Science in Semiconductor Processing. 2002. V. 5. P. 497.
Chao T.S., Ku W.M., Lin H.C., Landheer D., Wang Y.Y., Mori Y. // IEEE Transactions on electron devices. 2004. V. 51. № 12. P. 2200.
Wang L., Sun L., Han D., Wang Y., Chan M., Zhang S. // J. Display Technol. 2014. V. 10. №. 4. P. 317.
Kuo P.Y., Chao T.S., Lai J.T., Lei T.F. // IEEE Electron Device Lett. 2009. V. 30. № 3. P. 237.
Wu C.Y., Liu Y.T., Liao T.C., Yu M. H., Cheng H.C. // IEEE Electron Device Lett. 2011. V. 32. № 8. P. 1095.
Lee I.C., Tsai C.C., Kuo H.H., Yang P.Y., Wang C.L., Cheng H.C. // IEEE Electron Device Lett. 2012. V. 33. № 4. P. 558.
Harbeke G., Krausbauer L. et al. // J. Electrochem. Soc. 1984. V. 131. P. 675.
Новак А.В., Новак В.Р., Смирнов Д.И. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. № 10. С. 18.
Edrei R., Shauly E.N., Roizin Y., Hoffman A. // Appl. Surf. Science. 2002. V. 188. P. 539.
Lai M.Z., Lee P.S., Agarwal A. // Thin Solid Films. 2006. V. 504. P. 145.
Новак А.В. // Известия вузов. Электроника. 2013. № 6(104). С. 10.
Новак А.В., Новак В.Р. // Письма в ЖТФ. 2013. Т. 39. Вып. 19. С. 32.
Новак А.В., Новак В.Р. // Письма в ЖТФ. 2014. Т. 40. Вып. 13. С. 18.
Watanabe H., Aoto N., Adachi S., Kikkawa T. // J. Appl. Phys. 1992. V. 71. № 7. P. 3538.
Ino M., Miyano J., Kurogi H., Tamura H., Nagatomo Y., Yoshimaru M. // J. Vac. Sci. Technol. B. 1996. V. 14. № 2. P. 751.
Lee E.G., Im H.B. // J. Materials Science. 1993. V. 28. P. 6279.
ISO 25 178-2:2012 Geometrical Product Specifications (GPS) – Surface Texture: Areal – Part 2: Terms, Definitions and Surface Texture Parameters.
ASME B46.1-2009 Surface Texture (Surface Roughness, Waviness, and Lay), American national standard.
Blunt L., Jiang X. // Advanced Techniques for Assessment Surface Topography: Development of a Basis for 3D Surface Texture Standards “Surfstand”. London: Kogan Page Science, 2003.
Pelliccione M., Lu T.-M. // Evolution of Thin Film Morphology. Modeling and Simulation. N.Y.: Springer, 2008.
Meakin P. // Fractals Scaling and Growth Far from Equilibrium. Camb. Univ. Press, 1998.
Nasrullah J., Tyler G.L., Nishi Y. // IEEE Trans. on Nanotech. 2005. V. 4. № 3. P. 303.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования