Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 4, стр. 104-107
Электронная структура и свойства наноразмерных структур, созданных на поверхности свободной пленочной системы Si/Cu
З. А. Исаханов a, *, Р. М. Ёркулов a, Б. Е. Умирзаков b, **, М. Ш. Исаев b, А. А. Абдувайитов b
a Институт ионно-плазменных и лазерных технологий АН РУз
100125 Ташкент, Узбекистан
b Ташкентский государственный технический университет
100095 Ташкент, Узбекистан
* E-mail: za.isakhanov@gmail.com
** E-mail: ftmet@rambler.ru
Поступила в редакцию 06.07.2020
После доработки 18.09.2020
Принята к публикации 22.09.2020
Аннотация
Методом низкоэнергетической (Е0= 1–5 кэВ) имплантации ионов ${\text{О}}_{2}^{ + }$, Ва+, Cu+ и Со+ с последующим отжигом на поверхности свободно висящей нанопленочной системы Si/Cu(100) получены нанофазы и пленки SiO2 и силицидов металлов. Определены морфология их поверхности, состав, параметры энергетических зон, максимальное значение коэффициента вторичной электронной эмиссии, квантовый выход фотоэлектронов. Показано, что ширина запрещенной зоны силицидов металлов составляет 0.3–0.4 эВ, а их удельное сопротивление 100–500 мкОм · см.
ВВЕДЕНИЕ
В последнее время широко исследуют наноразмерные пленки и кластерные фазы, созданные на поверхности и приповерхностной области полупроводников и диэлектрических пленок, что обусловлено перспективностью этих материалов для разработки новых приборов микро-, опто- и наноэлектроники. Наноразмерные системы можно получить с помощью методов молекулярно-лучевой, твердофазной и газофазной эпитаксии [1–9] и низкоэнергетической ионной имплантации [10–14]. Особый интерес представляет получение и изучение свойств наноструктур на основе свободно висящих пленок. Ранее [15, 16] были изучены процессы формирования наноразмерных пленок SiO2 и MeSi2 (Ме – металл) на поверхности тонкой пленочной системы Si/Cu. В частности установлено, что в пленке SiO2, полученной имплантацией ионов ${\text{О}}_{{\text{2}}}^{ + }$ в сочетании с отжигом в Si/Cu, содержится большое количество нестехиометрических оксидов SiOх и несвязанных атомов Si (5–6 ат. %), а в пленках ВаSi2 и СоSi2 содержатся избыточные атомы металла – до 10 ат. %. Это приводит к уменьшению ширины запрещенной зоны Eg в SiO2 и ВаSi2 в два раза и более.
В настоящей работе впервые изучены электронная структура, эмиссионные, электрофизические и оптические свойства тонких (d ≤ 30–40 Å) пленок оксидов и силицидов металлов, сформированных на поверхности свободно висящей пленки Si/Cu при ионной имплантации в сочетании с отжигом.
МЕТОДЫ ЭКСПЕРИМЕНТА
Свободно висящая пленочная система Si/Cu получена методом [8]. В основном использована пленка Si толщиной 400 Å, нанесенная на поверхность монокристаллической пленки Cu(100) толщиной 450 Å. Неоднородность пленки Si по толщине составляла 15–20 Å. Имплантацию ионов, отжиг и основные исследования проводили на одной и той же экспериментальной установке в вакууме не хуже 10–6 Па. Энергия ионов ${\text{O}}_{2}^{ + }$ варьировалась в пределах от 1 до 5 кэВ, а их доза D ≈ ≈ 1014–1017 см–2. Для исследования состава, электронной структуры и эмиссионных свойств использован комплекс методов: электронная оже-спектроскопия (ЭОС), фотоэлектронная спектроскопия (ФЭС), спектроскопия характеристических потерь энергии электронами (СХПЭЭ), измерения коэффициентов вторичной электронной эмиссии и квантового выхода фотоэлектронов. Исследования морфологии поверхности и кристаллической структуры пленок проводили с использованием растровой электронной микроскопии (РЭМ) и дифракции быстрых электронов (ДБЭ).
Профили распределения атомов по глубине определяли методом ЭОС в сочетании с послойным травлением ионами аргона с Е0 = 2 кэВ под углом 5°–10° относительно поверхности образца.
РЕЗУЛЬТАТЫ ЭКСПЕРИМЕНТА И ИХ ОБСУЖДЕНИЕ
На рис. 1 приведены РЭМ-изображения и картины ДБЭ для поверхности Si/Cu(100) до и после имплантации ионами ${\text{О}}_{{\text{2}}}^{{\text{ + }}}$ с Е0 = 1 кэВ при дозе D = = 6 × 1015 см–2. Видно, что поверхность чистого кремния обладает относительно гладким микрорельефом (рис. 1а) и имеет структуру, близкую к поликристаллической (вставка на рис. 1а). После имплантации ионов ${\text{О}}_{{\text{2}}}^{{\text{ + }}}$ на поверхности Si появляются отдельные локальные участки (кластеры) с измененной структурой и составом. Поверхностные размеры кластерных фаз лежат в пределах от 10 до 20 нм. Эти фазы занимают половину всей облученной площади. Однако на электронограмме полностью исчезают концентрические кольца, характерные для поликристаллических пленок, и наблюдаются новые широкие и размытые кольца, присущие сильно разупорядоченной поверхности (вставка на рис. 1б). По-видимому, возникновение микронапряжений вблизи локализации кластеров приводит к разупорядочению и других участков облученной поверхности. Начиная с дозы D ≈ 2 × 1016 см–2 наблюдается перекрывание границ отдельных участков (кластеров), и при D ≈ 8 × 1016 см–2 происходит полное легирование поверхностных слоев и формируется аморфный слой нестехиометрической двуокиси кремния – на электронограмме вместо серии колец наблюдается одно диффузное кольцо – аморфное гало. После отжига при Т = 750 К стехиометрический состав пленки SiO2 существенно улучшается (концентрация SiO2 увеличивается до 85–90 ат. %), но высокая степень аморфности сохраняется.
Рис. 1.
РЭМ-изображения и картины ДБЭ (вставки) для поверхности Si/Cu(100) до (а) и после (б) имплантации ионами ${\text{О}}_{{\text{2}}}^{{\text{ + }}}$ с Е0 = 1.0 кэВ при дозе D = 6 × 1015 см–2.
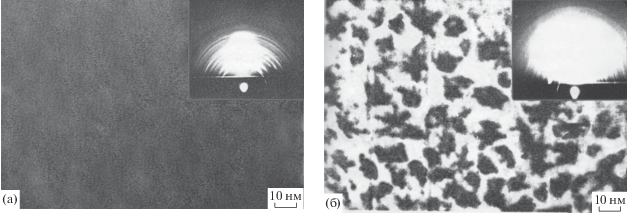
На рис. 2 приведены спектры ХПЭЭ для пленки Si/Cu(100) до и после формирования наноразмерной оксидной пленки. Видно, что в спектре Si/Cu(100) обнаруживается ряд интенсивных пиков. Наличие пиков при значениях энергии ΔЕ1 = = 3.4, ΔЕ2 = 6.7 и ΔЕ4 = 14 эВ можно объяснить возникновением межзонных переходов, а другие пики – возбуждением поверхностных (ΔЕ3 = ħωs = = 10.4, ΔЕ6 = ħωs = 21 эВ) и объемных (ΔЕ5 = ħωv = = 17 эВ) плазменных колебаний [9]. В спектре нанопленки SiO2 обнаруживаются два максимума, обусловленные межзонными переходами ΔЕ1 = 9.1, ΔЕ3 = 19 эВ и два максимума – плазменными колебаниями: ΔЕ2 = ħωs = 15 и ΔЕ4 = ħωv = = 23 эВ. Отметим, что энергия плазменных колебаний и межзонных переходов в свободной нанопленке SiO2/Si отличается от энергии в случае толстой пленки SiO2. Природа смещения максимумов, обусловленных межзонными электронными переходами, вероятно, связана с деформацией функций электронных состояний при уменьшении толщины пленки SiO2 и увеличении влияния подложки.
В случае имплантации ионов металлов после отжига на поверхности Si в зависимости от дозы облучения образовались нанофазные слои силицидов металлов. Получены нанокластерные фазы и пленки (d = 20–50 Å) силицидов типа BaSi2 и CoSi2. Таким образом, после отжига свободно висящих пленок Si/Cu, имплантированных ионами ${\text{О}}_{{\text{2}}}^{{\text{ + }}}$ и Ва+, формируются трехслойные системы SiO2/Si/Cu и BaSi2/Si/Cu. В табл. 1 приведены параметры энергетических зон, максимальные значения коэффициентов вторичной электронной эмиссии σm, квантовый выход фотоэлектронов Y, удельное сопротивление ρ нанопленок SiO2 и силицидов металлов. Видно, что при образовании силицидов металла значение Eg кремния уменьшается в три раза, удельное сопротивление – в 104 раза, значения σm и Y – в полтора–два раза, а в случае формирования SiO2Eg увеличивается примерно в четыре раза, ρ – в 300 раз, а σm и Y – в два–три раза. Однако эти данные заметно отличаются от данных для аналогичных пленок, полученных на поверхности массивных пленок Si. Например, значение Eg для SiO2 и BaSi2, созданных на поверхности массивных пленок Si, составляет 7.9 и 0.7 эВ соответственно. Эти отличия объясняются тем, что в пленках SiO2 (и силицидов металлов), созданных на поверхности свободных пленок, из-за ограничения температуры отжига содержится некоторое количество несвязанных атомов кремния и оксида типа SiOх (1 ≤ х < 2) [10].
Таблица 1.
Параметры энергетических зон, максимальные коэффициенты вторичной электронной эмиссии (σm), квантовый выход фотоэлектронов (Y) и удельное сопротивление (ρ) полученных пленок
| Параметры | Si, d = 400 Å | SiO2/Si, d = 20 Å | BaSi2/Si, d = 50–60 Å | CoSi2/Si, d = 50–60 Å |
|---|---|---|---|---|
| eφ, эВ | 5.1 | 3.9 | 3.1 | – |
| Eg, эВ | 1.1 | 4.1 | 0.3 | 0.4 |
| ρ, мкОм · см | 6 × 105 | 2 × 108 | 100–150 | 80–100 |
| Ф, эВ | 5.2 | 4.9 | 3.9 | 4.1 |
| χ | 4.1 | 0.8 | 3.6 | 3.7 |
| σm | 1.2 | 2.2 | 2 | 1.7 |
| Y | 8 × 10–5 | 6 × 10–4 | 4 × 10–4 | – |
ЗАКЛЮЧЕНИЕ
Таким образом, в работе впервые изучены морфология поверхности, параметры энергетических зон, эмиссионные и оптические свойства наноразмерных фаз и пленок SiO2, BaSi2 и CoSi2, созданных на поверхности свободной нанопленочной системы Si/Cu. Показано, что физические свойства этих пленок существенно отличаются от свойств пленок, полученных на поверхности массивных пленок. В частности, это отличие в случае пленок SiO2 составляет примерно два раза.
Список литературы
Stepanov A.L., Nuzhdin V.I., Valeev V.F., Vorobev V.V., Rogov A.M., Osin Y.N. // Vacuum. 2019. V. 159. P. 353.
Leong D.N., Harry M.A., Reeson K.J., Homewood K.P. // Appl. Phys. Lett. 1996. V. 68. P. 1649.
Гриценко В.А. // УФН. 2008. Т. 178. С. 727.
Карабешкин К.В., Карасев П.А., Титов А.И. // ФТП. 2013. Т. 47. С. 206.
Алексеев А.А., Олянич Д.А., Утас Т.В., Котляр В.С., Зотов А.В., Саранин А.А. // ЖТФ. 2015. Т. 85. Вып. 10. С. 94.
Ницук Ю.А., Киосе М.И., Вакстон Ю.Ф., Смынтына В.А., Яцунский И.Р. // ФТП. 2019. Т. 53. Вып. 3. С. 381.
Donaev S.B., Djurabekova F., Tashmukhamedova D.A., Umirzakov B.E. // Phys. Stat. Sol. C. 2015. V. 12. Iss. 1–2. P. 89.
Wang D., Zou Z-Q. // Nanotechnology. 2009. V. 20. P. 275 607.
Komarov F., Vlasukova L., Greben M., Milchanin O., Zuk J., Wesch W., Wendler E., Togambaeva A. // Nucl. Instrum. Methods Phys. Res. B. 2013. V. 307. P. 102.
Umirzakov B.E., Tashmukhamedova D.A., Boltaev E.U., Dzhurakhalov A.A. // Materials Science and Engineering B: Solid-State Materials for Advanced Technology. 2003. V. 101. Iss. 1-3. P. 124. https://doi.org/0.1016/S0921-5107(02)00677-3.
Umirzakov B.E., Pugacheva T.S., Tashatov A.T., Tashmukhamedova D.A. // Nucl. Instrum. Methods Phys. Res. B. 2000. V. 166–167. P. 572. https://doi.org/10.1016/S0168-583X(99)01151-9
Isakhanov Z.A., Mukhtarov Z.E., Umirzakov B.E., Ruzibaeva M.K. // Tech. Phys. 2011. V. 56. P. 546. https://doi.org/10.1134/S1063784211040177
Alov N.V. // Nucl. Instrum. Methods Phys. Res. B. 2007. V. 256. Iss. 1. P. 337.
Ivna K., Piltaverlavana J., Badovinac R // Appl. Surf. Sci. 2017. V. 425. P. 416.
Umirzakov B.E., Ruzibaeva M.K., Isakhanov Z.A., Yorkulov R.M. // Tech. Phys. 2019. V. 64. Iss. 6. P. 887.
Isakhanov Z.A., Kosimov I.O., Umirzakov B.E., Erkulov R.M. // Tech. Phys. 2020. V. 65. Iss. 1. P. 114.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



