Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 5, стр. 102-112
Калибровка растрового электронного микроскопа. 1. Выбор параметров РЭМ
Ю. А. Новиков *
Институт общей физики им. А.М. Прохорова РАН
119991 Москва, Россия
* E-mail: nya@kapella.gpi.ru
Поступила в редакцию 17.07.2020
После доработки 25.10.2020
Принята к публикации 28.10.2020
Аннотация
Рассмотрено влияние параметров растрового электронного микроскопа на его калибровку с помощью тест-объектов с трапециевидным профилем выступов и канавок с большими углами наклона боковых стенок. Показано влияние фокусировки зонда РЭМ и энергии его электронов на калибровку РЭМ в режимах сбора вторичных медленных электронов и обратно рассеянных электронов. Показано, что калибровку микроскопа можно проводить только в низковольтном режиме работы при энергии первичных электронов меньше 2 кэВ и в режиме сбора вторичных медленных электронов при энергии первичных электронов больше 10 кэВ. Приведена модель формирования сигналов микроскопа в этих диапазонах энергий. Рассмотрено влияние контаминации на время жизни тест-объекта и точность калибровки растрового электронного микроскопа.
В нанотехнологии свойства наноструктур зависят от формы и размеров их элементов. Поэтому нанотехнология требует наличия методов визуализации рельефа поверхности твердого тела и измерения линейных размеров элементов, из которых состоит этот рельеф.
Среди методов визуализации рельефа наибольшего развития достигла растровая электронная микроскопия [1–6]. Это обусловлено тем, что промышленность выпускает растровые электронные микроскопы (РЭМ) высокого разрешения [7, 8]. Кроме того, для калибровки РЭМ были созданы тест-объекты [9–13] и сами методы калибровки [9, 10, 13–15], доведенные до российских национальных стандартов (ГОСТ Р) [16, 17]. Разработанные методы измерений на РЭМ линейных размеров [5, 6, 18, 19] элементов микро- и наноструктур, лежащих в диапазоне от 10 нм до 100 мкм, обеспечивают прослеживаемость измерений от первичного эталона длины (метра) до измеряемого размера [5, 6]. Достоинством РЭМ является также малое время его калибровки и измерения на нем размеров элементов наноструктур, несмотря на то, что измерения ведутся в вакууме.
Для проведения измерений на РЭМ требуется его калибровка. В настоящее время рекомендуется [5, 6, 9, 10, 14–17] делать калибровку с помощью рельефных кремниевых структур [9–13], имеющих трапециевидный профиль с большими углами наклона боковых стенок. Качество изготовления таких структур очень высокое. Однако идеальных технологий не бывает. Поэтому в работах [12, 13, 20] были рассмотрены методы контроля качества изготовления тест-объектов и их отдельных элементов.
В работе [12] были рассмотрены несколько методов контроля качества изготовления тест-объекта с трапециевидным профилем и большими углами наклона боковых стенок, которые показали, что качество тест-объектов высокое. Однако ни один из рассмотренных методов не может использоваться в повседневной работе. В статьях [13, 20] был предложен метод контроля качества изготовления тест-объекта, который дает гарантии того, что в выбранном для калибровки месте тест-объекта качество его изготовления высокое и достаточное для проведения калибровки РЭМ. В этом методе определение качества изготовления осуществляется на том же РЭМ, на котором проводится калибровка РЭМ и измерения размеров элементов микро- и наноструктур. Причем в том же самом месте тест-объекта, которое используется для калибровки РЭМ. И даже в процессе самой калибровки.
Казалось бы, рассмотрены все необходимые методы и условия для того, чтобы осуществлять калибровку РЭМ с помощью тест-объектов с трапециевидным профилем и большими углами наклона боковых стенок выступов и канавок. Однако длительный опыт калибровки РЭМ разных моделей с помощью таких тест-объектов, анализ опубликованных работ, в которых такая калибровка осуществлялась, и применение виртуального растрового электронного микроскопа (ВРЭМ) [21–25] для уменьшения ошибок при проведении калибровки [25] выявил некоторые особенности калибровки РЭМ. Незнание этих особенностей может привести к большим ошибкам в калибровке РЭМ и, следовательно, к ошибкам измерения линейных размеров элементов наноструктур.
В связи с этим потребовалось рассмотреть особенности калибровки РЭМ с помощью структур [9–13] с трапециевидным профилем и большими углами наклона боковых стенок выступов и канавок, указать типичные ошибки, которые делаются или могут делаться в процессе калибровки РЭМ, и описать методы устранения таких ошибок.
Настоящая статья является первой в серии статей, посвященных описанию особенностей калибровки РЭМ с помощью тест-объектов с трапециевидным профилем и большими углами наклона боковых стенок. Она посвящена выбору параметров РЭМ, при которых должна проводиться калибровка, и учету особенностей тест-объекта, влияющих на точность калибровки.
ТЕСТ-ОБЪЕКТ ДЛЯ КАЛИБРОВКИ РЭМ
В настоящее время существует несколько видов тест-объектов с трапециевидным профилем и большими углами наклона боковых стенок [9–13]. Один из них – МШПС-2.0К (мера ширины и периода, специальная, номинальный размер шага 2.0 мкм, кремниевая) [9, 10] – получил широкое распространение и признание в качестве измерительного прибора. Именно на этом тест-объекте отрабатывался метод контроля качества его изготовления [12, 13]. Поэтому этот тест-объект будем рассматривать в качестве тест-объекта для калибровки РЭМ.
Тест-объект МШПС-2.0К [9, 10] представляет собой кремниевый чип размером 1 × 1 см2 (рис. 1а). В центре чипа расположены 5 групп по 3 шаговые структуры (рис. 1а, 1б), которые помечены римскими цифрами I, II и III в каждой группе (рис. 1в). Это позволяет проследить историю каждой шаговой структуры (важность этой процедуры будет показана ниже). Шаговые структуры (рис. 1г) состоят из 11 канавок (10 выступов), профиль которых имеет вид трапеции с большими углами наклона боковых стенок [9, 10]. Верх выступов и дно канавок совпадает с кристаллографическими плоскостями {100} кремния, а боковые стенки – с плоскостями {111} (рис. 2). Все группы структур соединены направляющими канавками шириной 10 мкм (рис. 1б), с помощью которых легко находить каждую группу. Около шаговой структуры ширина канавки уменьшается до 2 мкм (рис. 1в, 1г). Это позволяет выделить на каждой шаговой структуре область тест-объекта, к которой можно обращаться неограниченное количество раз. Длина шаговых структур составляет 100 мкм.
Рис. 1.
Изображения элементов тест-объекта МШПС-2.0К при разных увеличениях: кремниевый чип (а), общий вид тест объекта (б), группа из трехшаговых структур центрального модуля (в) и вторая шаговая структура центрального модуля в районе направляющих линий (г).
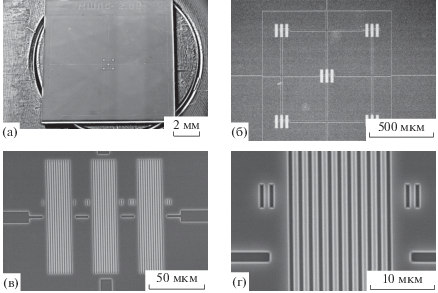
Рис. 2.
Схема кристаллографических плоскостей кремния в структуре тест-объекта МШПС-2.0К. На вставке изображение в просвечивающем электронном микроскопе боковой наклонной стенки канавки тест-объекта.

В процессе изготовления тест-объекты МШПС-2.0К могут быть сделаны с разными размерами выступов и канавок [10, 18] (рис. 3), но при одном значении номинальной величины шага 2 мкм. Качество изготовления тест-объекта исследовалось в работах [12, 13]. Было показано, что боковые наклонные стенки выступов и канавок совпадают с кристаллографическими плоскостями кремния {111} с точностью до одного атомарного слоя [12] (вставка на рис. 2).
Аттестация тест-объекта МШПС-2.0К осуществлялась на электронно-оптической метрологической системе [26] в Физико-техническом институте Германии (Physikalisch-Technische Bundesanstalt – PTB). Аттестованное значение шага составило 2001 ± 1 нм. Тест-объект прошел международные сличения [27] в России и Германии.
ФОРМА СИГНАЛА РЭМ
В основе калибровки РЭМ лежит правильный выбор параметров РЭМ, которые сильно влияют на форму сигнала, регистрируемого растровым электронным микроскопом, и, следовательно, на его калибровку. Среди таких параметров главными являются режим регистрации вторичных электронов, энергия E электронов зонда и величина рабочего отрезка (РО) микроскопа.
Режим регистрации вторичных электронов
Растровый электронный микроскоп может работать в трех режимах сбора вторичных электронов: низковольтном (НВ) при энергии электронов зонда E ≤ 2 кэВ и двух высоковольтных (E > > 2 кэВ) при регистрации вторичных медленных электронов (ВМЭ) и обратно рассеянных электронов (ОРЭ).
Формы сигналов, полученных при сканировании на РЭМ S-4800 одного и того же выступа тест-объекта МШПС-2.0К, приведены на рис. 4. Энергия электронов зонда была 20 кэВ для ВМЭ и ОРЭ сигналов и 1 кэВ для НВ сигнала. Видно, что формы сигналов разные и имеют мало общего с формой рельефа (кроме ОРЭ сигнала). Однако формы всех сигналов можно аппроксимировать прямыми линиями, точки пересечения которых будут использоваться в процессе калибровки РЭМ.
Рис. 4.
ВМЭ, ОРЭ и НВ-сигналы (1, 2 и 3 соответственно), полученные при сканировании выступа тест-объекта МШПС-2.0К.

В работе [28] исследовалось влияние фокусировки зонда РЭМ на формирование изображений в разных режимах сбора вторичных электронов. Было показано, что при изменении фокусировки (увеличение диаметра зонда РЭМ в 8 (!) раз с 9 до 74 нм) форма ОРЭ сигнала практически (в пределах шумов) не изменилась, в то время как форма ВМЭ сигнала изменилась значительно. На рис. 5 [28] показаны части ВМЭ (рис. 5а) и ОРЭ (рис. 5б) сигналов, полученных при энергии электронов зонда E = 20 кэВ и диаметрах зондов 9 нм (сигналы 1) и 74 нм (сигналы 2), которые иллюстрируют высказанное выше утверждение. Необходимо отметить, что размер пикселя при дефокусировке не менялся [28].
Рис. 5.
Части ВМЭ (а) и ОРЭ (б) сигналов, полученных при сканировании сфокусированным 1 и дефокусированным 2 зондами. Стрелками на сигналах показаны области, которые изменяются или должны меняться при изменении фокусировки зонда.

Таким образом, не рекомендуется проводить калибровку РЭМ с помощью тест-объектов с трапециевидным профилем выступов и канавок и большими углами наклона боковых стенок в режиме сбора обратно рассеянных электронов, так как в режиме сбора ОРЭ невозможно хорошо сфокусироваться и невозможно измерить диаметр зонда. Калибровку РЭМ надо осуществлять в режимах сбора ВМЭ или в низковольтном режиме работы РЭМ даже, если в дальнейшем планируется проводить измерения в режиме ОРЭ. Более подробно с этими результатами можно ознакомиться в работе [28].
ВЛИЯНИЕ ЭНЕРГИИ ЭЛЕКТРОНОВ ЗОНДА НА ФОРМУ СИГНАЛА
На рис. 6 приведены сигналы РЭМ [29], полученные при сканировании выступа тест-объекта МШПС-2.0К на РЭМ, работающем в низковольтном режиме и в режиме регистрации вторичных медленных электронов, при разных энергиях электронов зонда, лежащих в диапазоне 0.3–20 кэВ. Видно, что диапазон энергий первичных электронов E можно разделить на 3 области: E ≤ ≤ 2 кэВ, 2 кэВ < E < 10 кэВ, E ≥ 10 кэВ.
Рис. 6.
Формы реальных ВМЭ и НВ-сигналов, полученных на РЭМ при сканировании выступа тест-объекта МШПС-2.0К зондами с разными энергиями первичных электронов 0.3, 0.6, 1.0, 2.5, 5, 10, 15, 20 кэВ (сигналы 1–8 соответственно).

В первой области (E ≤ 2 кэВ) и в третьей области (E ≥ 10 кэВ) сигналы хорошо описываются прямыми ломаными линиями. Наличие четко выраженных изломов позволяет на сигнале выделять контрольные точки и с достаточной точностью определять их координаты. Такие точки можно использовать для калибровки РЭМ.
Во второй области (2 кэВ < E < 10 кэВ) форму сигнала нельзя описать ломаной линией. Сигнал имеет сложную сглаженную форму, где невозможно выбрать точки, которые можно было бы использовать в процессе калибровки. Поэтому эту область энергий первичных электронов не рекомендуется использовать для калибровки РЭМ. Более подробно с этими результатами можно ознакомиться в работе [29].
ВЫБОР РАБОЧЕГО ОТРЕЗКА ПРИ КАЛИБРОВКЕ РЭМ
Рабочий отрезок современных РЭМ может меняться в широком диапазоне. Его величина оказывает большое влияние на изображение исследуемого объекта. Это обусловлено тем, что электронный зонд растрового электронного микроскопа имеет сложную форму в вертикальной плоскости – вид сходящегося-расходящегося пучка [30] (рис. 7). При этом РО влияет на оба параметра пучка: угол сходимости–расходимости φd и глубину фокусировки hf. При уменьшении рабочего отрезка микроскопа глубина фокусировки уменьшается и может стать меньше высоты рельефа. В этом случае на верхнее и нижнее основания рельефа будет воздействовать зонд с разными диаметрами [31], что приведет к искажению изображения тест-объекта и, следовательно, к ошибкам калибровки РЭМ.
Рис. 7.
Схема вертикального профиля электронного зонда РЭМ в области фокусировки с углом сходимости–расходимости φd, глубиной фокусировки hf, диаметром зонда в фокусе df (минимальный диаметр зонда) и действующим диаметром зонда d (диаметр зонда на уровне плоскости исследуемого образца).
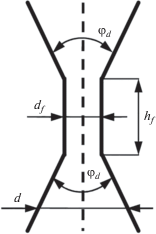
В большинстве микроскопов есть режим автоматического выбора рабочего отрезка при вертикальном перемещении исследуемого образца и изменении увеличения микроскопа. Поэтому в процессе калибровки РЭМ (да и вообще при любых измерениях на РЭМ) автоматический выбор рабочего отрезка должен быть отключен.
Величина рабочего отрезка выбирается исходя из требования, чтобы глубина фокусировки была больше высоты рельефа тест-объекта и исследуемого объекта. С методом измерения вертикальной формы электронного зонда РЭМ (в том числе и определение глубины фокусировки) можно ознакомиться в работе [30]. Эксперименты на разных РЭМ показали, что для большинства современных РЭМ величина рабочего отрезка должна быть больше 8 мм для исследования структур с высотой (глубиной) рельефа менее 2 мкм.
МОДЕЛЬ ФОРМЫ СИГНАЛА РЭМ
Рассмотрим модель формирования сигналов РЭМ, работающем в НВ и ВМЭ-режимах, в которой определим связи контрольных точек сигнала (точки пересечения прямых линий, аппроксимирующих сигнал) с граничными точками структуры. Формирование сигнала будем рассматривать на примере сканирования ступеньки [32] с большим углом наклона боковой стенки. При этом диаметр зонда много меньше проекции боковой наклонной стенки ступеньки.
Поперечная форма зонда РЭМ
При моделировании формы сигнала очень важна поперечная форма зонда РЭМ. В работах [33, 34] рассматривались возможные модельные формы зонда, а в работе [35] – реальные поперечные формы зонда в сфокусированном режиме и при разных дефокусировках. В экспериментах [35] на РЭМ, работающем в низковольтном режиме, измерялись плотности распределения электронов в сфокусированном и дефокусированных зондах. Эти плотности аппроксимировались несколькими гауссовскими функциями:
Оказалось, что у хорошо настроенного микроскопа плотность распределения электронов в сфокусированном зонде имеет форму одного гауссиана [35] (рис. 8а). При дефокусировке форму зонда можно представить в виде нескольких гауссианов, сдвинутых латерально друг относительно друга [35] (кривые 1–4 на рис. 8б). Параметры этих гауссианов приведены в таблице 1. Кривая 5 на рис. 8б является суммой четырех компонент.
Рис. 8.
Плотности распределения электронов (точки) в сфокусированном (а) и дефокусированном (б) зондах низковольтного РЭМ и разложения этих плотностей на гауссовские функции (линии).

Таблица 1.
Параметры аппроксимирующих зонд гауссианов
| Рисунок | j | Aj, нм | σj, нм | Ij, % | d, нм |
|---|---|---|---|---|---|
| 8а | 1 | 0 | 12.151 ± 0.002 | 100 | 28 |
| 8б | 1 | –144.94 ± 0.17 | 31.3 ± 0.4 | 9.5 ± 0.4 | 320 |
| 2 | –55.3 ± 0.6 | 63.8 ± 1.1 | 45.3 ± 1.1 | ||
| 3 | 78.5 ± 0.8 | 59.1 ± 0.5 | 39.7 ± 0.7 | ||
| 4 | 150.78 ± 0.10 | 19.30 ± 0.14 | 5.49 ± 0.10 |
Так как зонд имеет сложную форму (рис. 8), то наиболее эффективной (близкой к эксперименту) при разных фокусировках зонда модельной формой сечения зонда надо признать форму с равномерной плотностью распределения электронов в нем. Кроме того, поперечную форму сечения зонда надо представлять в виде эквивалентной квадратной формы. Сторона такого квадрата в работах [33, 34] названа “эффективным диаметром”. Далее именно этот параметр будем называть диаметром зонда. Более подробно с этими результатами можно ознакомиться в работах [33–35].
В случае сфокусированного зонда (один гауссиан) связь диаметра d зонда с параметром σ гауссиана определяется выражением
При аппроксимации несколькими гауссианами экспериментальное определение диаметра зонда описано в работе [35] и будет представлено во второй статье данной серии.
Форма сигнала
Рассмотрим модель [32] формирования сигналов ВМЭ и НВ при сканировании ступеньки с большим углом наклона боковой стенки модельным зондом, имеющим квадратное сечение и равномерную плотность распределения электронов в нем.
На рис. 9а–9в показаны шесть основных положений зонда, которые определяют форму модельных сигналов, а на рис. 9г – модельный ВМЭ-сигнал при энергии электронов зонда более 10 кэВ, и на рис. 9д – модельный НВ-сигнал. На рис. 9г, 9д показаны точки на сигналах, которые соответствуют шести положениям зонда на рис. 9а–9в. Реальные формы сигналов высоковольтного и низковольтного РЭМ при сканировании ступеньки приведены на рис. 10 [10]. Видно, что отдельные части реальных сигналов действительно можно аппроксимировать прямыми линиями.
Рис. 9.
Схемы сканирования зондом ступеньки (а), (б) и (в) с большим углом наклона боковой стенки и формирования ВМЭ (г) и НВ (д) сигналов РЭМ.
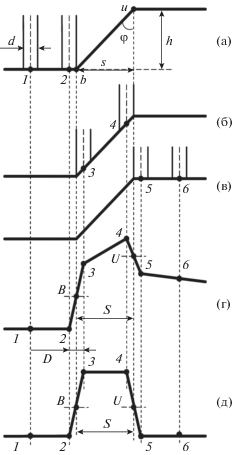
В положении 1 на рис. 9а зонд находится на нижнем основании ступеньки далеко от нее. При этом величины обоих сигналов находятся на уровне фона (точки 1 на рис. 9г, 9д). Такая величина сигнала будет сохраняться до тех пор, пока зонд не достигнет положения 2 на рис. 9а. При переходе зонда из положения 2 на нижнем основании ступеньки в положение 3 на рис. 9б на наклонной стенке ступеньки величины сигналов сильно и быстро возрастают (рис. 9г, 9д). Этот эффект объясняется увеличением поверхности, засвеченной зондом при переходе зонда с основания ступеньки на наклонную стенку. Длина такого перехода соответствует поперечному размеру зонда.
В положении 3 на рис. 9б зонд полностью находится на боковой стенке ступеньки и при дальнейшем движении по этой стенке до положения 4 на рис. 9б уровень ВМЭ-сигнала будет меняться (увеличиваться) достаточно слабо (рис. 9г). Это изменение ВМЭ-сигнала объясняется вкладом в сигнал вторичных медленных электронов, образованных обратно рассеянными электронами, достигшими нижнего основания и боковой стенки ступеньки (подсветка сигнала). Для низковольтного сигнала (рис. 9д) изменения величины сигнала между точками 3 и 4 практически нет, так как нет боковой подсветки сигнала. Впрочем, небольшие изменения возможны. Они связаны с ориентацией канавок шаговой структуры относительно положения детектора электронов. При правильной ориентации изменений НВ-сигнала в этой области не должно быть.
При переходе зонда со стенки ступеньки (положение 4 на рис. 9б) на верхнее основание ступеньки (положение 5 на рис. 9в) уровень сигналов (рис. 9г, 9д) опять будет сильно меняться, но теперь он будет уменьшаться из-за уменьшения облучаемой зондом площади. Длина такого перехода соответствует поперечному размеру зонда.
В положении 5 на рис. 9в зонд будет полностью находиться на верхнем основании ступеньки. При дальнейшем движении к положению 6 на рис. 9в уровень ВМЭ-сигнала будет слабо уменьшаться (рис. 9г), достигнув уровня сигнала в положении 1 зонда на рис. 9а, удалившись на достаточно большое расстояние от боковой стенки. Этот эффект объясняется уменьшением выхода дополнительных электронов (подсветка) через боковую стенку ступеньки. Уровень НВ-сигнала при таком движении зонда практически не меняется (рис. 9д).
Из рис. 9 видно, что точки b и u, характеризующие ступеньку, имеют на обоих сигналах своих аналогов точки B и U, которые делят отрезки 2–3 и 4–5 пополам.
Различия в формах сигналов высоковольтного (рис. 9г) и низковольтного (рис. 9д) РЭМ присутствуют только в областях между точками 3–4 и точками 5–6 (рис. 9г, 9д). Эти области сигнала формируются при движении зонда по наклонной стенке и по верхнему основанию ступеньки. Отличия объясняется различной формой области рассеяния первичных электронов зонда в веществе: “грушевидная” форма для первичных высоковольтных электронов и полусферическая для первичных низковольтных электронов.
Необходимо отметить, что учет отличия формы самого зонда от прямоугольного сечения и плотности распределения электронов от равномерного распределения приведет только к размытию изломов в точках 2, 3, 4 и 5 обоих сигналов. Однако, несмотря на это, отдельные элементы сигналов РЭМ все равно легко линеаризуются – аппроксимируются прямыми линиями (рис. 10 [10]). Это позволяет заменять реальные сигналы РЭМ, полученные при сканировании электронами зонда с энергиями, лежащими в первой и третьей областях первичных энергий электронов (рис. 6), их модельными приближениями и работать с модельными сигналами. Более подробно с этими результатами можно ознакомиться в работах [10, 32].
ХАРАКТЕРИСТИКИ ТЕСТ-ОБЪЕКТА, ОГРАНИЧИВАЮЩИЕ ЕГО ПРИМЕНЕНИЕ
При проведении калибровки РЭМ необходимо учитывать особенности технологии изготовления тест-объекта и работы РЭМ, которые ограничивают применение тест-объекта при калибровке РЭМ.
Несовершенство технологии изготовления
Идеальных технологий не бывает. Поэтому в процессе изготовления тест-объекта возможно появление дефектов поверхности. На рис. 11 приведены изображения шага тест-объекта МШПС-2.0К в РЭМ, работающем в режиме сбора ВМЭ (рис. 11а) и ОРЭ (рис. 11б). На ВМЭ-изображении виден дефект поверхности (указан стрелкой). В то же время на ОРЭ-изображении дефект не виден. При калибровке РЭМ по ВМЭ-изображению дефект внесет большие искажения в форму сигнала и, следовательно, приведет к ошибкам калибровки РЭМ. Выше было показано, что калибровку по ОРЭ-изображению проводить не рекомендуется. Поэтому необходимо проводить калибровку РЭМ по ВМЭ-изображению. При этом область дефекта на ВМЭ-изображении необходимо убрать из области тест-объекта, которая используется для калибровки. Это легко сделать. На рис. 11а горизонтальными линиями выделена область, в которой видимых дефектов нет. Ее и надо использовать для калибровки РЭМ. Более подробно с этими результатами можно ознакомиться в работе [12].
Рис. 11.
ВМЭ (а) и ОРЭ (б) изображения шага тест-объекта МШПС-2.0К, по которому осуществляется калибровка РЭМ. Стрелкой показан дефект структуры тест-объекта, который хорошо виден на ВМЭ-изображении и не виден на ОРЭ-изображении.
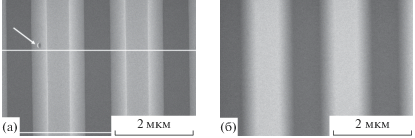
Однако отсутствие видимых дефектов не означает, что дефектов нет вообще. Необходимо осуществлять контроль сигналов в выделенной области на их соответствие моделям сигналов, изображенных на рис. 9г, 9д. Сигналы, не соответствующие моделям сигналов, из получения контрольных точек для калибровки РЭМ необходимо исключать. Такая процедура обычно осуществляется с помощью компьютерных программ обработки сигналов в автоматическом или ручном режимах. Метод, используемый в такой процедуре, в разных программах обработки сигналов разный и обычно не разглашается. Поэтому для осуществления такого контроля необходимо пользоваться описанием работы соответствующих программ.
Время жизни тест-объекта
Время жизни тест-объекта играет большую роль для калибровки РЭМ. Дело в том, что при облучении зондом поверхности твердого тела эта поверхность заряжается и как насосом вытягивает на себя всякую грязь из вакуума. Обычно это углерод. Такой эффект называется “контаминация”. Загрязненная поверхность меняет свои эмиссионные свойства, а рельеф меняет свою форму и размеры, что приводит к искажению сигналов ВМЭ и НВ и ошибкам калибровки. Необходимо отметить, что при наличии контаминации искажения ОРЭ-сигналов не происходит [36], но искажение рельефа может происходить.
Влияние контаминации на измерение размеров элементов наноструктур обычно незначительно в связи с тем, что само измерение производится однократно и достаточно быстро. Но для калибровки РЭМ контаминация играет значительную роль, так как тест-объект в процессе многочисленных калибровок используется многократно.
Исследования влияния контаминации на искажение изображения рельефа тест-объекта МШПС-2.0К проводились в работе [37]. На рис. 12 приведено ВМЭ-изображение в РЭМ S-4800 при энергии первичных электронов 15 кэВ шаговой структуры тест-объекта МШПС-2.0К. На изображении показана область, которая длительно сканировалась электронным зондом, и прилегающие к ней области шаговой структуры. На рис. 12 можно выделить три области поверхности структуры: область сканирования 1, область сильного потемнения изображения 2, которая расположена непосредственно за областью сканирования, и область слабого потемнения изображения 3. Область 2 имеет ширину, лежащую в диапазоне 2–3 мкм (внешний размер области составляет порядка 6 мкм). Область 3 сильно вытянута вдоль направления канавок. Ширина области находится в диапазоне 2–8 мкм (внешние поперечный и продольный размеры области достигает 8 и 20 мкм соответственно).
Рис. 12.
Изображение области 1 сканирования и прилегающих к ней областей 2 и 3 шаговой структуры тест-объекта МШПС-2.0К после многократного сканирования электронным зондом.

Самые большие искажения изображения структуры осуществляются не в области сканирования электронным зондом (как это следовало бы ожидать), а в прилегающих областях, размеры которых при энергии первичных электронов 15 кэВ достигают 20 мкм вдоль и 8 мкм поперек канавок.
На рис. 13 приведены сигналы [37], пересекающие три области загрязнения. При этом сигналы 1–3 взяты в тех местах, которые пересекают области 1–3 на рис. 12. Обращает на себя внимание, что в области сканирования (центральная часть сигнала 1) осуществляются минимальные искажения сигнала. Однако на границе сигнала 1, где сигнал выходит из области сканирования 1 и попадает в область 2 и даже в область 3 на рис. 12, искажения сигнала столь значительны, что форма сигнала уже не соответствует модели сигнала на рис. 9г.
Сигнал 2 пересекает области 2 и 3 на рис. 12. При этом центральная часть сигнала соответствует области 2, а края сигнала соответствуют области 3 на рис. 12. В центре сигнала его форма соответствует модельной форме сигнала на рис. 9г, но, согласно результатам работы [37], размеры элементов сигнала заметно увеличены.
Сигнал 3 на рис. 13 соответствует области 3 на рис. 12. Его форма сильно искажена, но искажение в центре сигнала и на его краях разные и обе формы сигнала не соответствует модели сигнала на рис. 9г и поэтому не могут быть использованы для калибровки РЭМ.
Таким образом, в процессе сканирования некоторой области электронным зондом РЭМ загрязняется гораздо большая область, чем область сканирования. Причем минимальные искажения формы сигнала осуществляются именно в области сканирования – в центре этой области, а максимальные – вне области сканирования. Поэтому область сканирования тест-объекта можно использовать для калибровки РЭМ несколько раз. Области тест-объекта, прилегающие к области сканирования, имеют очень большие искажения сигнала, не позволяющие использовать их для калибровки РЭМ.
Для определения количества сканирований в одной области тест-объекта в работе [37] были исследованы изменения размера проекции боковых наклонных стенок канавок в зависимости от количества сканирований. Измерения проводились на РЭМ S-4800 при энергии первичных электронов 20 кэВ и токе зонда 0.2 нА. Оказалось [37], что при данных параметрах зонда размер проекции боковой наклонной стенки не меняется в пределах семи сканирований. Учитывая конструкцию тест-объекта МШПС-2.0К (рис. 1), наличие большого количества в нем шаговых структур, возможность работать с одним местом на структуре контролируемое количество раз и размеры областей загрязнения, в работе [37] был сделан вывод о возможности использовать тест-объект МШПС-2.0К до 1000 раз для калибровки РЭМ, при этом до семи раз в одном месте. Более подробно с этими результатами можно ознакомиться в работе [37].
Таким образом, калибровка РЭМ с помощью тест-объекта МШПС-2.0К может осуществляться до семи раз в одном месте структуры при выбранных в работе [37] параметрах РЭМ. При других параметрах (и на других РЭМ) возможно увеличение или уменьшение числа сканирований.
ЗАКЛЮЧЕНИЕ
Правильную калибровку РЭМ с помощью тест-объектов с трапециевидным профилем рельефа и большими углами наклона боковых стенок рельефа можно осуществить при выполнении следующих условий.
1. Калибровка РЭМ осуществляется в низковольтном режиме работы или в высоковольтном режиме при регистрации вторичных медленных электронов. Калибровка РЭМ в режиме сбора обратно рассеянных электронов не проводится.
2. Энергия первичных электронов в низковольтном режиме должна быть не более 2 кэВ.
3. Энергия первичных электронов в режиме сбора вторичных медленных электронов должна быть более 10 кэВ.
4. Автоматический режим выбора рабочего отрезка РЭМ должен быть выключен, а величина рабочего отрезка должна быть такой, чтобы глубина фокусировки РЭМ была больше высоты (глубины) рельефа тест-объекта.
5. Одна и та же область тест-объекта может использоваться ограниченное число раз (зависит от тока зонда). Ближайшая область сканирования структуры, используемая для калибровки РЭМ, должна располагаться на расстоянии от другой области сканирования не менее 10 мкм поперек канавок тест-объекта и не менее 20 мкм вдоль канавок.
6. Дефектные области, видимые на изображении, исключаются из калибровки РЭМ.
В следующей статье данной серии будут рассмотрены методы обработки сигналов РЭМ, полученных в процессе его калибровки, и указаны типичные ошибки при такой обработке.
Список литературы
Reimer L. Scanning electron microscopy: physics of image formation and microanalysis. / Ed. Springer-Verlag: Berlin, Heidelberg, N.Y., 1998.
Postek M.T., Vladar A.E. Critical Dimension Metrology and the Scanning Electron Microscope. / Handbook of Silicon Semiconductor Metrology. Ed. A.C. Diebold. Marcel Dekker Inc. N.Y.–Basel, 2001. P. 295.
Новиков Ю.А., Раков А.В. // Измерительная техника. 1999. № 1. С. 14.
Hatsuzawa T., Toyoda K., Tanimura Y. // Rev. Sci. Instrum. 1990. V. 61. №. 3. P. 975.
Гавриленко В., Новиков Ю., Раков А., Тодуа П. // Наноиндустрия. 2009. № 4. С. 36.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7405. P. 740504. https://doi.org/10.1117/12.826164
Новиков Ю.А. // Поверхность. Рентген., синхротр, и нейтрон. исслед. 2013. № 5. С. 105. https://doi.org/10.7868/S0207352813050107
Новиков Ю.А. // Поверхность. Рентген., синхротр, и нейтрон. исслед. 2013. № 8. С. 105. https://doi.org/10.7868/S0207352813080131
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Прохоров А.М., Раков А.В. // Микроэлектроника. 2002. Т. 31. № 4. С. 243.
Novikov Yu.A., Gavrilenko V.P., Ozerin Yu.V., Rakov A.V., Todua P.A. // Proc. SPIE. 2007. V. 6648. P. 66480R. https://doi.org/10.1117/12.733134
Данилова М.А., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. // Измерительная техника. 2008. № 9. С. 49.
Новиков Ю.А. // Поверхность. Рентген., синхротр, и нейтрон. исслед. 2017. № 11. С. 77. https://doi.org/10.7868/S0207352817110105
Новиков Ю.А. // Поверхность. Рентген., синхротр, и нейтрон. исслед. 2018. № 12. С. 86. https://doi.org/10.1134/S0207352818120144
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Раков А.В. // Микроэлектроника. 2004. Т. 33. № 6. С. 419.
Кальнов В.А., Новиков Ю.А., Орликовский А.А. // Микроэлектроника. 2012. Т. 41. № 6. С. 426.
Gavrilenko V.P., Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7378. P. 737 812. https://doi.org/10.1117/12.821760
Гавриленко В.П., Лесновский Е.Н., Новиков Ю.А., Раков А.В., Тодуа П.А., Филиппов М.Н. // Известия РАН. Серия Физическая. 2009. Т. 73. № 4. С. 454.
Данилова М.А., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. // Измерительная техника. 2008. № 8. С. 20.
Gavrilenko V.P., Kalnov V.A., Novikov Yu.A., Orlikovsky A.A., Rakov A.V., Todua P.A., Valiev K.A., Zhikharev E.N. // Proc. SPIE. 2009. V. 7272. P. 727 227. https://doi.org/10.1117/12.814062
Todua P.A., Gavrilenko V.P., Novikov Yu.A., Rakov A.V. // Proc. SPIE. 2008. V. 7042. P. 704209. https://doi.org/10.1117/12.794926
Новиков Ю.А. // Микроэлектроника. 2013. Т. 42. № 1. С. 34. https://doi.org/10.7868/S0544126912060105
Новиков Ю.А. // Микроэлектроника. 2013. Т. 42. № 4. С. 262. https://doi.org/10.7868/S0544126913040042
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 4. С. 263. https://doi.org/10.7868/S0544126914040073
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 6. С. 456. https://doi.org/10.7868/S0544126914060076
Новиков Ю.А. // Микроэлектроника. 2015. Т. 44. № 4. С. 306. https://doi.org/10.7868/S0544126915030072
Haessler-Grohne W., Bosse H. // Measurement Science and Technology. 1998. V. 9. P. 1120.
Волк Ч.П., Горнев Е.С., Календин В.В., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Bosse H., Frase C.G. // 12 Российский симпозиум по растровой электронной микроскопии и аналитическим методам исследования твердых тел. Черноголовка. 2001. Тезисы докладов. С. 128.
Новиков Ю.А. // Поверхность. Рентген., синхротр, и нейтрон. исслед. 2020. № 6. С. 68. https://doi.org/10.31857/S1028096020050106
Novikov Yu.A., Darznek S.A., Filippov M.N., Mityukhlyaev V.B., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7025. P. 702 511. https://doi.org/10.1117/12.802428
Новиков Ю.А., Раков А.В., Стеколин И.Ю. // Измерительная техника. 1996. № 12. С. 26.
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 5. С. 373. https://doi.org/10.7868/S0544126914050068
Novikov Yu.A., Ozerin Yu.V., Rakov A.V., Todua P.A. // Measurement Science and Technology. 2007. V. 18. P. 367. https://doi.org/10.1088/0957-0233/18/2/S07
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Плотников Ю.И., Раков А.В., Тодуа П.А. // Труды ИОФАН. 2006. Т. 62. С. 77.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7042. P. 70420C. https://doi.org/10.1117/12.794891
Novikov Yu.A. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2014. V. 8. № 6. P. 1252. https://doi.org/10.1134/S1027451014060135
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 10. С. 59. https://doi.org/10.7868/S0207352815100170
Novikov Yu.A. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2020. V.14. № 6. P. 1387. https://doi.org/10.1134/S1027451020060397
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования