Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 5, стр. 33-41
Морфология и структурные свойства эпитаксиальных пленок AlGaInSbAs, выращенных на подложках InAs
Л. С. Лунин a, *, М. Л. Лунина a, Д. Л. Алфимова a, А. С. Пащенко a, О. С. Пащенко a
a Южный научный центр Российской академии наук
344006 Ростов-на-Дону, Россия
* E-mail: lunin_ls@mail.ru
Поступила в редакцию 14.04.2020
После доработки 03.06.2020
Принята к публикации 05.06.2020
Аннотация
Обсуждается влияние условий выращивания на морфологию поверхности и структурные свойства твердых растворов AlGaInSbAs, полученных на подложках арсенида индия. Определены оптимальные параметры процесса выращивания (T < 873 K, G ≤ 60 K/см, l > 80 мкм) изопериодных пленок AlGaInSbAs на подложках InAs с высоким структурным совершенством BH/2 < 30″ и шероховатостью поверхности менее 12 нм. Исследовано влияние состава эпитаксиальных пленок AlGaInSbAs на рассогласование периодов решетки пленки и подложки InAs. Показано, что рассогласование периодов решеток пленки и подложки увеличивается с ростом галлия в твердом растворе AlxGayIn1 –x–ySbzAs1 –z и достигает величины Δa = 1.8 × 10–2 Å. В случае изменения концентрации сурьмы рассогласование решеток достигает Δa = 7.2 × 10–3 Å при z = 0.5 моль доли.
ВВЕДЕНИЕ
Создание новых конструкционных материалов с заданными свойствами и характеристиками в твердотельной микроэлектронике зачастую основано на использовании полупроводниковых твердых растворов [1–6], что обуславливает актуальность их изучения. Выбор пятикомпонентных твердых растворов обусловлен возможностью повысить совершенство гетерограницы “эпитаксиальный слой–подложка” за счет одновременного согласования параметров решетки и коэффициентов термического расширения (КТР) сопрягаемых материалов [1, 7]. Это позволяет создавать изопараметрические гетероструктуры для высокоэффективных приборов, работающих в широком спектральном диапазоне. Для создания термофотоэлектрических преобразователей (TФЭП) и фотоприемников (ФП), работающих в диапазоне длин волн более 2.2 мкм, необходимо получение и исследование твердых растворов AlGaInSbAs, изопериодных арсениду галлия [8–14]. Использование гетероструктур AlGaInSbAs/InAs для ТФЭП и ФП предъявляет повышенные требования к морфологии поверхности эпитаксиальных слоев и их структурному совершенству [15–17].
Целью настоящей работы является исследование морфологии поверхности и структурного совершенства эпитаксиальных слоев твердых растворов AlGaInSbAs, выращенных на подложках InAs.
ТЕОРЕТИЧЕСКИЙ АНАЛИЗ
Для выращивания твердых растворов AlGaInSbAs на подложках InAs необходим теоретический анализ их устойчивости к спинодальному распаду. По методике [7] был проведен расчет областей спинодального распада. На рис. 1 приведены линии спинодали при 773 K для твердого раствора AlGaInSbAs без учета возможного влияния упругих напряжений на границе слой–подложка. Видно, что с ростом концентрации Al в твердом растворе область спинодального распада расширяется и все большая часть изопериодических составов попадает в зону распада. Тем не менее, даже при небольшом отклонении от изопериодных составов появляются напряжения из-за рассогласования периодов решеток подложки и слоя, которые сужают область спинодального распада [1, 7, 18].
Рис. 1.
Концентрационные зависимости AlxGayIn1 –x–y-SbzAs1 –z/InAs-областей спинодального распада (пунктиром обозначены области составов, подверженных распаду при относительном рассогласовании периодов решетки пленки и подложки Δa/a = 2.8 × 10–3 (Δa = 1.8 × × 10–2 Å); цифры при кривых указывают значения содержания Al в твердой фазе (x)).

На рис. 1 пунктирная кривая соответствует твердому раствору AlxGayIn1 –x–ySbzAs1 –z, рассогласованному по параметру решетки на Δa/a = = 2.8 × 10–3 (Δa = 1.8 × 10–2 Å) для x = 0.1 мол. доли.
Следует отметить, что точность расчетов зависит от выбора модели распределения компонентов твердого раствора в подрешетках III и V групп:
1) распределение атомов случайное, т.е. пятикомпонентная твердая фаза представляет регулярный раствор;
2) упорядоченное распределение атомов в твердом растворе, которое учитывает парное взаимодействие.
Влияние упорядочения в твердых растворах на параметр кристаллической решетки и его отклонения для случайного распределения атомов представлены на рис. 2 и рис. 3 соответственно.
Рис. 2.
Влияние эффекта упорядочения на параметр кристаллической решетки регулярного твердого раствора AlxGayIn1 –x–ySbzAs1 –z.
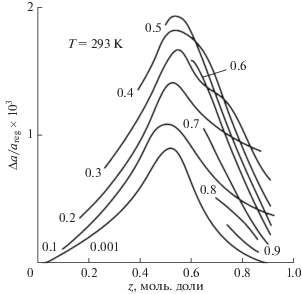
Рис. 3.
Отклонения упорядоченного распределения компонентов в твердом растворе AlxGayIn1 –x–ySbzAs1 –z от случайного при температуре T = 773 K (а, б) и T = 293 K (в, г).

Видно, что параметр решетки твердого раствора, рассчитанного в рамках модели регулярного раствора areg, больше того же параметра, найденного с учетом упорядочения aord, при всех значениях x. Зависимость (areg – aord)/areg = Δa/areg от z имеет при z = 0.5 моль. доли максимумы, высота которых растет с увеличением x. Отношение мольных долей xAlSb, xGaAs с упорядочением к соответствующим полям случайного распределения в твердом растворе (рис. 3) подтверждает необходимость учета упорядочения в твердом растворе AlxGayIn1 –x–ySbzAs1 –z.
Зависимости коэффициентов распределения компонентов в гетеросистеме AlxGayIn1 –x–ySbzAs1 –z/ InAs от состава представлены на рис. 4. На графиках отсутствует коэффициент распределения индия. В нашем случае он находился в диапазоне 0.1 ≤ KIn ≤ 0.6. Величина KAl меняется с изменением z в пределах от 104 до 10, причем KAl ≤ 500, когда z ≥ 0.75 моль. доли практически при любом значении x. В этом случае для x ≤ 0.2 моль. доли имеются два состава в пределах 0 ≤ z ≤ 0.6 моль. доли, для которых KAl одинаков. Аналогичная ситуация наблюдается и для KGa. Величина KGa также заметно зависит от состава твердого раствора и лежит в пределах 0.2 ≤ KGa ≤ 40, т.е. имеет значения, при которых осуществление жидкофазного роста без подпитки не вызывает особых трудностей.
Рис. 4.
Зависимости коэффициентов распределения химических элементов в твердом растворе AlxGayIn1 –x–ySbzAs1 –z от их концентрации:(а) Sb; (б) As; (в) Al; (г) Ga.

KSb растет с увеличением z, а KGa, наоборот, снижается. Величина KAs зависит от состава существенно, однако KAs, в отличие от KAl, увеличивается с ростом z, и уже при x > 0.3 моль. доли величина KAs превышает 500. Это делает проблематичной возможность выращивания слоев твердого раствора AlxGayIn1 –x–ySbzAs1 –z при x > 0.3 моль. доли и z > 0.6 моль. доли без подпитки жидкой фазы соответствующими элементами.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Выращивание эпитаксиальных слоев твердого раствора AlGaInSbAs толщиной 1–5 мкм на подложках InAs осуществляли методом ЗПГТ [18, 19]. К исходным материалам для проведения эпитаксии из жидкой фазы в поле температурного градиента относится также материал подложки. Мы использовали монокристаллические подложки InAs. Экспериментальные данные показывают, что основные характеристики эпитаксиальных слоев твердых растворов AIIIBV, полученных методом ЗПГТ, существенно зависят от кристаллографической ориентации и качества подготовки поверхности [19]. Подготовка пластин предполагает обеспечение планарной зеркальной поверхности с шероховатостью менее 10 нм. При этом поверхность подложки должна быть ориентирована и точно соответствовать заданной кристаллографической плоскости. Причем пределы разориентации должны составлять не более 10″. Перед эпитаксией проводились традиционные операции обезжиривания, химической и плазмохимической обработки. Для уменьшения шероховатости поверхности подложки InAs до 1 нм применяли ионно-лучевую полировку [20].
Для получения эпитаксиальных слоев твердого раствора AlGaInSbAs постоянного состава использовалась подпитывающая твердая фаза, содержащая компоненты с большим коэффициентом распределения Al и As (рис. 3). В качестве подпитывающей твердой фазы применяли предварительно синтезированные поликристаллы AlGaSbAs необходимого состава. Методика синтеза поликристалла описана в работе [19].
Определение несоответствия параметров решеток подложки и слоя, а также оценка кристаллического совершенства гетероструктур осуществлялись методом регистрации рентгеновской дифракции. Получение кривых дифракционного отражения (КДО) рентгеновского излучения проводилось на высокоразрешающем рентгеновском дифрактометре ТРС-1 в двухкристальной геометрии с использованием CuKα-излучения. Погрешность измерений составляла 10–4 Å. Кристаллические совершенство структуры также оценивалось на электронографе ЭМР-102 по электронограммам, снятым на отражение (путем анализа наличия Кикучи-линий) при ускоряющем напряжении 100 кВ и токе луча 1 мА.
Составы полученных твердых растворов определяли методом масс-спектроскопии вторичных нейтральных частиц [21]. Масс-спектры измерялись при травлении поверхности гетероструктур со стороны эпитаксиального слоя ионами аргона с энергией 4 кэВ и плотностью тока 50 мкA/cм2. Вторичные частицы регистрировали квадрупольным масс-спектрометром Micromass PC100 в режиме многоканального ионного мониторинга. Относительное среднеквадратическое отклонение измерений массовой доли составляет не более 0.1%. Давление аргона в камере составляло 6.5 × 10–4 Па.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
При гетероэпитаксии наиболее важную роль в дефектообразовании играет различие периодов кристаллических решеток, сопрягающихся на границе материалов. Согласно закону Вегарда, период решетки твердого раствора AlxGayIn1 –x–ySbzAs1 –z определяется интерполяционной зависимостью от его состава. На рис. 5 приведена зависимость рассогласования периодов решетки от концентрации атомов галлия (кривая 1) и сурьмы (кривая 2).
Рис. 5.
Зависимость рассогласования периодов решеток подложки InAs и эпитаксиальной пленки твердого раствора AlxGayIn1 –x–ySbzAs1 –z от концентрации галлия (кривая 1) и сурьмы (кривая 2) при T = 753 K, G ≤ 30 K/см, l > 120 мкм.

Видно, что с ростом концентрации Ga разница периодов решетки возрастает, достигая максимального значения Δa/a = 3 × 10–3(Δa = 1.8 × 10–2 Å). Для сурьмы Δa/a вначале возрастает, достигая максимума 1.2 × 10–3 при z = 0.5 мол. доли, а затем спадает. Это связано, по-видимому, с усилением эффекта упорядочения при концентрациях Sb > > 0.5 моль. доли, что подтверждает характер расчетов, проведенных с учетом эффекта упорядочения (рис. 3). Пунктирная кривая 2 ' (рис. 5) показывает зависимость Δa/a при случайном распределении атомов в твердом растворе AlGaInSbAs. Величина Δδ является параметром упорядочения. Как видно, для твердого раствора AlGaInSbAs при расчетах периода решетки следует учитывать эффект упорядочения распределения атомов в подрешетке. Следует заметить, что эпитаксиальные пленки имеют постоянный состав по толщине (рис. 6).
Рис. 6.
Профиль распределения компонентов по глубине эпитаксиального слоя твердого раствора AlGaInSbAs/InAs, полученный методом оже-спектроскопии.
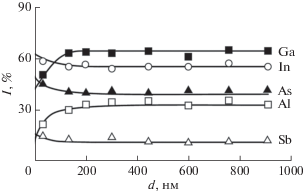
Для исследования структурного совершенства выращивались изопериодные (Δa/a < 1 × 10–3, Δa < 6 × 10–3 Å) и неизопериодные (Δa/a > 5 × 10–3, Δa > 3 × 10–2 Å) гетероструктуры, составы которых были получены из расчетных данных, представленных на рис. 1, в области существования твердого раствора. Результаты исследований структурного совершенства (рис. 7) показали, что во всех изопериодных гетероструктурах Al0.1Ga0.2In0.7Sb0.3As0.7/InAs (изолиния 0.1 на рис. 1) интенсивность пиков и полуширина КДО на половине высоты BH/2 для слоя и подложки сравнимы (рис. 7, кривые 2 и 1 соответственно).
Рис. 7.
Кривые дифракционного отражения: 1 – подложки InAs, 2 – изопериодного слоя Al0.1Ga0.2In0.7Sb0.3As0.7, 3 – не изопериодного твердого раствора Al0.2Ga0.4In0.4Sb0.3As0.7.

Для неизопериодной гетероструктуры Al0.2Ga0.4In0.4Sb0.4As0.6/InAs наблюдается значительное увеличение BH/2 и уменьшение интенсивности пика (рис. 7, кривая 3). Следует отметить, что увеличение полуширины КДО эпитаксиального слоя влечет к росту аналогичной величины у подложки. Это связано с тем, что ухудшение структуры слоя приводит к появлению в нем дополнительных напряжений, воздействующих на подложку.
При малой толщине эпитаксиальных слоев AlGaInSbAs (<1 мкм) возрастание BH/2 их КДО не приводит к увеличению BH/2 КДО подложки. Уменьшение полуширины переходного слоя (неоднородного по составу рис. 6) на границе раздела слой–подложка или его отсутствие приводит к улучшению кристаллического совершенства слоя в целом. Из-за низкой плотности ростовых дефектов сохраняется однородность эпитаксиальных слоев AlGaInSbAs, о чем свидетельствует присутствие четко наблюдаемых толщинных осцилляций на КДО, обусловленных интерференцией излучения в эпитаксиальном слое с планарным верхним и нижним ограничениями (между прямой волной и двукратным отражением). Отметим, что картина дифракции рентгеновского излучения в условиях четких фазовых соотношений оказывается наиболее чувствительной к минимальным нарушениям кристаллического совершенства, возникающим на начальной стадии релаксации упругих напряжений. Увеличение значения рассогласования параметров слоя AlGaInSbAs и подложки InAs ведет к уменьшению амплитуды, увеличению BH/2 и количества толщинных осцилляций, что, в свою очередь, указывает на ухудшение планарности эпитаксиальных слоев и гладкости гетерограницы (рис. 7).
Кристаллическое совершенство эпитаксиальных слоев AlGaInSbAs/InAs также оценивалось по электронограммам, полученным на отражение, путем анализа Кикучи-линий (рис. 8).
Рис. 8.
Электронограммы дифракции быстрых электронов эпитаксиальных слоев AlxGayIn1 –x–ySbzAs1 –z на подложках InAs: а – x = 0.1, y = 0.2, z = 0.3 моль. доли; б – x = 0.2, y = 0.4, z = 0.4 моль. доли; в – x = 0.8, y = 0.1, z = 0.6 моль. доли.

Видно, что для изопериодных гетероструктур Al0.1Ga0.2In0.7Sb0.3As0.7/InAs кристаллическая структура поверхностного слоя высокосовершенна, о чем свидетельствует наличие на электронограммах сетки штрихов и Кикучи-полос (рис. 8а). При увеличении несоответствия (Δa/a) до 1 × 10–3 структура верхнего слоя мозаична, а более глубоких слоев (свыше 10 нм) совершенна (рис. 8б). При еще большем увеличении несоответствия Δa/a > 5 × 10–3 (Δa > 3 × 10–2 Å) структура остается мозаичной на всю глубину эпитаксиального слоя, что свидетельствует о наличии негомогенности состава твердого раствора (рис. 8в).
В работе было исследовано влияние толщины жидкой зоны l, температуры T и ее градиента G на структурное совершенство изопараметрических эпитаксиальных слоев Al0.1Ga0.2In0.7Sb0.3As0.7 (рис. 9).
Рис. 9.
Зависимости ширины кривых качания на половине максимума BH/2 от: а – толщины зоны l, б – градиента температуры G, в – температуры T.

Зависимость BH/2 кривых КДО от толщины жидкой зоны l (рис. 9а) показала, что для тонких зон (l < 40 мкм) наблюдается значительное ухудшение качества эпитаксиальных слоев Al0.1Ga0.2In0.7Sb0.3As0.7, особенно это проявляется для нанослоев (<25 нм). Это связано с тем, что в тонких зонах не происходит полного растворения микрочастиц при кристаллизации источника, в результате в эпитаксиальных слоях наблюдаются нановключения, нарушаются планарность гетерограницы и однородность состава. По мере увеличения толщины зоны (l > 40 мкм) улучшается качество слоев Al0.1Ga0.2In0.7Sb0.3As0.7, выражаемое в уменьшении BH/2. Однако дальнейшее увеличение толщины зоны l > 200 мкм приводит к увеличению градиента температуры и возникновению различия скоростей растворения и кристаллизации. Как следствие происходит отклонение состава твердого раствора Al0.1Ga0.2In0.7Sb0.3As0.7 от стехиометрического. Этим объясняется ухудшение структурного совершенства эпитаксиального слоя Al0.1Ga0.2In0.7Sb0.3As0.7 и выбор оптимальных толщин зон (100 ≤ l ≤ 200 мкм) для получения совершенных гетероструктур с BH/2 < 30″ (рис. 9а).
Результаты измерений полуширины BH/2 КДО для слоев Al0.1Ga0.2In0.7Sb0.3As0.7 от температуры подложки T и дополнительного вертикального градиента температуры G приведены на рис. 9б, в соответственно. Показано, что структурное совершенство слоев значительно ухудшается при температурах >873 K и градиентах температур >60 K/см и достигают значительных величин BH/2 ≥ 40″. Это обусловливается нарушением теплового и диффузионного равновесия, вследствие чего нарушается стабильность фронта кристаллизации и появляются микро- и нановключения на гетерогранице AlGaInSbAs/InAs.
Результаты исследования морфологии поверхности изо-параметрических эпитаксиальных слоев Al0.1Ga0.2In0.7Sb0.3As0.7 показали, что поверхность слоев имеет некоторый рельеф. Измерения шероховатости продемонстрировали ее зависимость от параметров процесса выращивания. При температурах T > 873 K, градиентах G > 60 K/см и толщинах зон l < 80 мкм шероховатость неравномерна и достигает 60 нм (рис. 10а). Это обусловлено нарушением стабильности и планарности движения зоны и, как следствие, стабильности фронта кристаллизации слоев AlGaInSbAs на подложках InAs. Для эпитаксиальных слоев Al0.1Ga0.2In0.7Sb0.3As0.7, выращенных при условиях T < 873 K, G < 60 K/см и l > 80 мкм, достигнута наименьшая шероховатость: не более 12 нм (рис. 10б), что связано со стабильностью фронтов кристаллизации и растворения, так как не наблюдается отклонений от стехиометрического состава из-за несоответствия скоростей кристаллизации и растворения на границах жидкой зоны.
ЗАКЛЮЧЕНИЕ
Твердый раствор AlxGayIn1 –x–ySbzAs1 –z склонен к спинодальному распаду. Однако в пределах 0.01 ≤ x ≤ 0.04, 0.0 ≤ y ≤ 0.9, 0.0 ≤ z ≤ 0.2 и 0.8 ≤ z ≤ ≤ 0.9 моль. доли можно выращивать эпитаксиальные пленки твердого раствора AlxGayIn1 –x–ySbzAs1 –z, изопериодные подложкам арсенида индия.
Проведенные рентгеноструктурные исследования подтверждают, что эпитаксиальные слои AlGaInSbAs, изопериодные с InAs, полученные методом ЗПГТ, обладают достаточно высоким структурным совершенством. Показано, что рассогласование периодов решеток пленки и подложки увеличивается с ростом галлия в твердом растворе AlxGayIn1 –x–ySbzAs1 –z и достигает максимального значения Δa/a = 3 × 10–3 (Δa = 1.8 × × 10–2 Å). Для сурьмы Δa/a сначала возрастает, достигая максимума 1.2 × 10–3 (Δa = 7.2 × 10–3 Å) при z = 0.5 моль. доли, а затем уменьшается до 0.8 × 10–3 (Δa = 4.8 × 10–3 Å). Получены и объяснены зависимости структурного совершенства эпитаксиальных слоев твердого раствора AlGaInSbAs (InAs) от ростовых параметров ЗПГТ: толщины и состава жидкой зоны, температуры и дополнительного вертикального градиента температуры. Выявлены оптимальные параметры процесса выращивания (T < 873 K, G ≤ 60 K/см, l > 80 мкм) изопериодных пленок AlGaInSbAs на подложках InAs с высоким структурным совершенством BH/2 < 30″ и качественной морфологией поверхности с шероховатостью менее 12 нм.
Список литературы
Adachi S. Properties of semiconductor Alloys: Group-IV, III–V and II–VI Semiconductors. Chippenham: John Wiley & Sons, 2009. 422 p.
Sugiyama H., Uchida K., Han X., Periyanayagam G.K., Aikawa M., Hayasaka N., Shimomura K. // J. Cryst. Growth. 2019. V. 507. P. 93.https://doi.org/10.1016/j.jcrysgro.2018.10.024
Ng J.S., Tan C.H. // IPC. 2018. Reston. VA. USA. P. 1. https://doi.org/10.1109/IPCon.2018.8527084
An N., Ma L., Wen G., Liang Zh., Zhang H., Gao T., Fan C. // Appl. Sci. 2019. V. 9. № 1. P. 162.https://doi.org/10.3390/app9010162
Kressel H., Butler J.K. Semiconductor lasers and heterojunction LEDs. New York City: Academic Press, 2012. 622 p.https://doi.org/10.1016/b978-0-12-426250-8.x5001-5
Cheng H.-W., Lin Sh.-Ch., Li Z.-L., Sun K.-W., Lee Ch.-P. // Mater. 2019. V. 12. № 2. P. 317.https://doi.org/10.3390/ma12020317
Лозовский В.Н., Лунин Л.С. Пятикомпонентные твердые растворы соединений A3B5. Ростов-на-Дону: СКНЦВШ, 1992. 193 с.
Polupan G., Torchynska T., Vega Macotela L.G., Cisneros Tamayo R., Escobosa Echavarría A. // J. Mater. Sci.: Mater Electron. 2020. V. 31. № 3. P. 2643.https://doi.org/10.1007/s10854-019-02803-x
Zhang Y., Wang Q., Zhang X., Chen B., Wu B., Ma D., Zhang L., Wang Z. // Jpn. J. Appl. Phys. 2017. V. 56. № 2. P. 025501. https://doi.org/10.7567/JJAP.56.025501
Sun Y., Dong J., Yu S., Zhao Y., He Y. // J. Mater. Sci.: Mater Electron. 2017. V. 28. №. 1. P. 745.https://doi.org/10.1007/s10854-016-5585-z
Piskorski Ł., Frasunkiewicz L., Sarzała R.P. // Bull. Pol. Ac.: Tech. 2015. V. 63. № 3. P. 597.https://doi.org/10.1515/bpasts-2015-0070
Seredin P.V., Lenshin A.S., Arsentyev I.N., Vinokurov D.A., Prutskij T., Leiste H., Rinke M Glotov A.V., Lenshin A.S., Arsentyev I.N., Vinokurov D.A., Prutskij T., Leiste H., Rinke M // Semicond. 2014. V. 48. № 1. P. 21.https://doi.org/10.1134/S1063782614010217
Torchynska T., Cisneros-Tamayo R., Vega-Macotela L., Polupan G., Escobosa-Echavarria A. // Superlattices Microstruct. 2018. V. 124. P. 153.https://doi.org/10.1016/j.spmi.2018.10.005
Seredin P.V., Glotov A.V., Domashevskaya E.P., Arsentyev I.N., Vinokurov D.A., Tarasov I.S. // Appl. Surf. Sci. 2013. V. 267. P. 181.https://doi.org/10.1016/j.apsusc.2012.09.053
Arif O., Zannier V., Li A., Rossi F., Ercolani D., Beltram F., Sorba L. // Cryst. Growth Des. 2020. V. 20. № 2. P. 1088.https://doi.org/10.1021/acs.cgd.9b01421
Solov’ev V.A., Chernov M.Y., Morozov S.V., Kudryavtsev K.E., Sitnikova A.A., Ivanov S.V. // JETP Lett. 2019. V. 110. № 5. P. 313.https://doi.org/10.1134/S0021364019170120
Hasan S., Han H., Korytov M., Pantouvaki M., Van Campenhout J., Merckling C., Vandervorst W. // J. Cryst. Growth. 2020. V.531. P. 125342.https://doi.org/10.1016/j.jcrysgro.2019.125342
Alfimova D.L., Lunin L.S., Lunina M.L., Kazakova A.E., Pashchenko A.S., Chebotarev S.N. // Inorg. Mater. 2017. V. 53. № 12. P. 1217.https://doi.org/10.1134/S0020168517120019
Лозовский В.Н., Лунин Л.С., Попов В.П. Зонная перекристаллизация градиентом температуры полупроводниковых материалов. М.: Металлургия, 1987. 232 с.
Chebotarev S.N., Pashchenko A.S., Williamson A., Lunin L.S., Irkha V.A., Gamidov V.A. // Techn.Phys. Lett. 2015. V. 41. P. 661.https://doi.org/10.1134/S1063785015070056
Blagin A.V., Valyukhov D.P., Lunin L.S., Pigulev R.V., Khabibulin I.M. // Inorg. Mater. 2008. V. 44. № 8. P. 793.https://doi.org/10.1134/S0020168508080013
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



