Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 5, стр. 56-62
Модернизированный Bosch-процесс травления для формирования конических структур на поверхности кремния
А. С. Рудый a, *, О. В. Морозов b, **, С. В. Курбатов a, ***
a Ярославский государственный университет им. П.Г. Демидова
150003 Ярославль, Россия
b Ярославский филиал Физико-технологического института им. К.А. Валиева РАН
150007 Ярославль, Россия
* E-mail: rudy@uniyar.ac.ru
** E-mail: moleg1967@yandex.ru
*** E-mail: kurbatov-93@bk.ru
Поступила в редакцию 10.08.2020
После доработки 25.11.2020
Принята к публикации 28.11.2020
Аннотация
Представлен метод формирования конических структур в циклическом плазмохимическом процессе травления кремния с использованием фоторезистивной маски сферической формы. Метод использует возможности управления профилем структуры за счет управления селективностью процесса травления кремния и фоторезиста. В данной работе для контроля величины селективности каждый цикл известного двухстадийного Bosch-процесса травления кремния дополняется третьей стадией травления фоторезиста в кислородсодержащей плазме. На основании экспериментальных результатов разработана модель трансформации контура фоторезистивной маски в процессе травления. В соответствии с модельными представлениями рассчитаны параметры дополнительной стадии для каждого цикла травления кремния. В результате получены конические структуры с близким к заданной величине наклоном боковых стенок.
ВВЕДЕНИЕ
Кремниевые структуры с коническим профилем находят применение в различных микро-технологиях, например, формирование антибликового покрытия для повышения эффективности солнечных элементов [1], увеличение площади поверхности твердотельных литий-ионных аккумуляторов для повышения удельной емкости и плотности мощности [2], в интегральных микросхемах применяются отверстия конической формы для трехмерной интеграции и в качестве контактных окон для возможности конформного напыления слоев металлизации [3]. Такие конические структуры получают методами плазмохимического травления канавок в кремнии с положительным углом наклона боковых стенок (ширина канавки уменьшается с увеличением глубины). Существуют различные подходы для формирования профиля канавок.
Один подход основан на управлении анизотропией травления кремния, другой подход на управлении селективностью травления кремния по отношению к маске. Управление анизотропией травления может осуществляться изменением соотношения газовой смеси в плазме SF6/C4F8 [4], SF6/O2 [5, 6]. В цитируемых работах получают канавки с положительным углом наклона боковых стенок за счет усиленной пассивирующей способности смеси. Однако, такие процессы характеризуются низкой скоростью травления, при этом и глубина канавок ограничена единицами мкм. Увеличение пассивирующей способности стадии пассивации использовали также в быстром циклическом Bosch-процессе травления [7]. Метод позволяет получать канавки глубиной до 20 мкм при угле наклона стенок не менее 85°. Глубокие канавки (до 100 мкм) получены в работе [8], где управление анизотропией травления достигается включением дополнительной стадии изотропного травления в анизотропный Bosch-процесс. В результате последовательного подтрава под маску формируется положительный угол наклона стенок, величина которого контролируется, в том числе длительностью дополнительной стадии. В качестве недостатка данного метода авторы отмечают отклонения профиля стенок от конусности. Другой подход (управление селективностью травления) подразумевает использование маски со сглаженным профилем. Сглаженный профиль маски, полученный термическим оплавлением фоторезиста, применяли в работе [9] для получения конических структур в кремнии травлением в плазме SF6/O2. В работе [10] в качестве маски применяется фоторезистивная структура переменной толщины, изготовленная методом “grey-scale” фотолитографии. Управление переносом 3D-рисунка маски в кремний проводился настройкой селективности процесса глубокого Bosch травления.
Общим признаком в реализациях этих подходов является то, что управление селективностью или анизотропией не может проводиться независимо от других параметров процесса травления. В патенте [11] предложена концепция процесса травления через маску со скругленными краями, где травление маски и кремния разделено на два этапа, которые повторяются заданное количество раз. Такой способ управления селективностью обеспечивает большую гибкость при выборе режимов травления для получения требуемой геометрии конических структур.
Целью данной работы является разработка метода управления профилем кремниевых структур в плазмохимическом процессе травления. Концепция, предложенная в [11] реализована нами в модернизированном Bosch-процессе травления кремния через термически оплавленную маску фоторезиста. Каждый цикл разработанного анизотропного Bosch-процесса дополняется третьей стадией травления фоторезиста в кислородсодержащей плазме. Управление селективностью проводили настройкой параметров третьей стадии. Стадии формирования конической кремниевой структуры модернизированного Bosch-процесса представлены на рис. 1. Угол наклона θ контролируется независимыми величинами смещения края маски Δa и глубиной траления ΔH в одном цикле травления.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
В качестве маскирующего материала использовали фоторезист S1318 SP15, который наносили методом центрифугирования на кремниевую пластину КЭФ 4.5 (100) диаметром 100 мм при частоте вращения 2000 об./мин. При проведении фотолитографических процессов использовался фотошаблон с рисунком в виде чередующихся “прозрачных” и “непрозрачных” полос номинальной ширины 10 мкм. Полученная маска с прямоугольным профилем подвергалась термической обработке в сушильном шкафу для оплавления при температуре 145°С в течение 20 мин. Параметры оплавления были подобраны экспериментально так, чтобы за счет сил поверхностного натяжения формировалась цилиндрическая форма маски [12, 13]. На рис. 2 показаны результаты оплавление маски фоторезиста. Параметры поперечного сечения маски (до и после оплавления) приведены в табл. 1. Геометрические размеры маски и кремниевых структур контролировались с помощью растрового электронного микроскопа Supra 40 (Carl Zeiss, Германия).
Рис. 2.
РЭМ-изображения маски фоторезиста: а – изображение исходной маски, б – маска после оплавления.
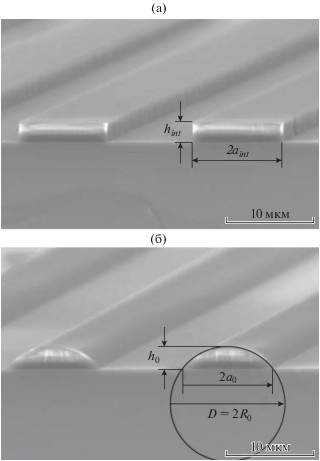
Таблица 1.
Параметры маски
| Исходная | После оплавления | ||
|---|---|---|---|
| hint, мкм | 2.3 ± 0.1 | h0, мкм | 2.83 ± 0.06 |
| 2aint, мкм | 10.3 ± 0.2 | 2a0, мкм | 10.5 ± 0.3 |
| R0, мкм | 6.3 ± 0.3 | ||
Пластина с подготовленной маской была разделена на отдельные прямоугольные пластинки площадью ~2 см2 (далее образцы). Образцы приклеивались на поверхность цельной пластины со слоем окисла ~1 мкм для того, чтобы избежать загрузочного эффекта в процессе травления.
Плазмохимическое травление кремния выполнялось на установке Plasmalab Systems 100 (Oxford Instruments, Великобритания) с источником индуктивно-связанной плазмы (ICP 360). Параметры модернизированного Bosch-процесса травления представлены в табл. 2.
Таблица 2.
Параметры циклического процесса на разных стадиях
| Параметры | Стадия | ||
|---|---|---|---|
| травление кремния | пассивация | травление фоторезиста | |
| Длительность, с | 8 | 5 | ti = 0–77 |
| Мощность (ICP), Вт | 2000 | 1200 | 2000 |
| Мощность смещения, Вт | 15 | 5 | 0 |
| Давление, Па | 3.9 | 2.7 | 1.3 |
| Поток SF6, нcм3/мин | 60 | 0 | 0 |
| Поток C4F8, нcм3/мин | 0 | 100 | 0 |
| Поток O2, нcм3/мин | 0 | 0 | 25 |
| Поток Ar, нcм3/мин | 0 | 0 | 75 |
На рис. 3 представлен результат базового Bosch-процесса травления, количество циклов n = 10. Базовый процесс характеризуется высокой селективностью S(Si/mask) = ΔH/Δhi ~ 100, при этом наличие скругленного профиля не влияет на характерный для Bosch травления прямоугольный профиль структур. Форма поверхности стенок в виде периодически повторяющихся гребешков (scallops) определяется изотропным характером травления кремния в SF6 плазме.
Трансформацию контура маски в модернизированном процессе изучали посредством измерений параметров: h, R, a при разной суммарной длительности дополнительных стадий tΣ. Процессы травления проводили как при фиксированной, так и при переменной от цикла к циклу длительности дополнительной стадии ti (табл. 2).
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Для надежного управления профилем кремниевых структур необходимо знать, как изменяется параметр а в процессе травления. Учитывая, что травление фоторезиста происходит преимущественно в кислородсодержащей плазме, взаимосвязь между параметрами маски (рис. 2б) в процессе травления можно описать выражением:
(1)
$a({{t}_{{{\Sigma }}}}) = {{[2h({{t}_{{{\Sigma }}}})R({{t}_{{{\Sigma }}}}) - {{h}^{2}}({{t}_{{{\Sigma }}}})]}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}{\text{\;}}.$Геометрическое соотношение (1) между параметрами a, h, R справедливо при сохранении формы поперечного сечения маски в виде сегмента круга [12]. Сдвиг края маски Δa будет различным при одном и том же Δh в зависимости от механизма травления, который определяется параметрами дополнительной стадии травления. Рассмотрим два граничных случая, когда механизм имеет изотропный или анизотропный характер. Графические построения, иллюстрирующие разный характер трансформации параметров маски в форме окружности приведены на рис. 4. При чисто изотропном механизме вектор скорости травления в каждой точке контура маски направлен по радиусу окружности, поэтому ΔR = Δh (рис. 4а). При чисто анизотропном механизме вектор скорости травления направлен вертикально вниз, так что радиус кривизны маски не изменяется ΔR = 0 (рис. 4б). В качестве степени изотропии процесса травления фоторезиста примем коэффициент k = ΔR/Δh. С учетом этого, для чисто изотропного травления k = 1, для чисто анизотропного k = 0.
Рис. 4.
Схематическое изображение контуров маски при разных параметрах h, Δa = const: а – изотропный механизм, б – анизотропный механизм.

Механизм травления фоторезиста был установлен путем сравнения экспериментальных данных с модельными представлениями (рис. 5).
В выбранных нами условиях дополнительной стадии механизм травления носит смешанный характер. Коэффициент k = 0.72 ± 0.07 был вычислен на основе экспериментальной зависимости (рис. 5). Здесь мы полагаем k = const, поскольку экспериментальные зависимости R(tΣ) и h(tΣ) с хорошей точностью интерполируются линейной функцией (рис. 6). Скорости изменения параметров vR и vh определяются по углу наклона соответствующих зависимостей.
Рис. 6.
Зависимость толщины (а) и радиуса (б) маски от суммарной длительности дополнительной стадии.

На основании полученных аппроксимаций выражение (1) можно записать в виде:
(2)
$a({{t}_{{{\Sigma }}}}) = {{[2({{h}_{0}} - {{{v}}_{h}}{{t}_{{{\Sigma }}}})({{R}_{0}} - k{{{v}}_{h}}{{t}_{{{\Sigma }}}}) - {{({{h}_{0}} - {{{v}}_{h}}{{t}_{{{\Sigma }}}})}^{2}}]}^{{\frac{1}{2}}}}$Экспериментальная зависимость a(tΣ) удовлетворительно описывается формулой (2) с k = 0.72 (рис. 7).
Рис. 7.
Экспериментальные данные a(tΣ) и функции a(tΣ), рассчитанной по формуле (2), при разных величинах k.

В режиме травления с постоянной длительностью дополнительных стадий ti получаются кремниевые структуры со скругленным профилем стенок. На рис. 8 представлено РЭМ-изображение кремниевых структур полученных при ti = 60 с.
Рис. 8.
РЭМ-изображение поперечного сечения структур, количество циклов травления – 6, селективность S(Si/mask) ~ 1.5.

Кремниевые структуры имеют гребенчатую форму поверхности, количество гребешков соответствует количеству циклов травления. Высота структуры со скругленным профилем стенок определяется селективностью процесса травления. Скругленная форма стенок является следствием нелинейного характера зависимости a(tΣ).
Полученную функциональную зависимость a(tΣ) (2) использовали для определения длительности дополнительной стадии процесса травления кремния с целью формирования конических структур с постоянным углом наклона стенок θ. Условие θ = const будет выполняться при одинаковом сдвиге маски Δa в каждом цикле модернизированного Bosch-процесса травления. Для обеспечения одинакового сдвига маски Δa необходимо определить длительность дополнительной стадии травления ti для каждого цикла. Величину ti рассчитывали с использованием численного интегрирования мгновенной скорости изменения a:
(3)
$\Delta {{a}_{i}} = \mathop \smallint \limits_{{{\tau }_{i}}}^{{{\tau }_{{i + 1}}}} \frac{{\partial a({{t}_{{{\Sigma }}}})}}{{\partial {{t}_{{{\Sigma }}}}}}d{{t}_{{{{\Sigma \;}}}}}.$Таблица 3.
Рассчитанные параметры процесса и маски
| № цикла | ti, с | hi, мкм | S(Si/mask) | Ri, мкм | ai, мкм |
|---|---|---|---|---|---|
| 0 | 0 | 2.78 | − | 6.33 | 5.24 |
| 1 | 74 | 2.25 | 1.2 | 5.92 | 4.64 |
| 2 | 69 | 1.75 | 1.3 | 5.53 | 4.04 |
| 3 | 62 | 1.30 | 1.5 | 5.18 | 3.44 |
| 4 | 55 | 0.91 | 1.7 | 4.87 | 2.84 |
| 5 | 46 | 0.58 | 2.0 | 4.62 | 2.24 |
| 6 | 37 | 0.31 | 2.4 | 4.41 | 1.64 |
Величина Δai = const определяет целевой угол наклона стенок структуры в соответствии с выражением:
Угол наклона θ определяется в том числе скоростью травления кремния. В модернизированном процессе травления скорость травления кремния выше, чем в базовом Bosch-процессе. Глубина травления за один цикл ΔH = 0.69 мкм, против ΔH = 0.64 мкм (рис. 3). Это связано с тем, что в базовом процессе некоторая доля стадии травления затрачивается на удаление пассивирующей пленки. В модернизированном процессе поверхность кремния очищена в кислородсодержащей плазме, и травление кремния происходит полное время стадии травления. Результат травления в модернизированном Bosch-процессе, при условиях согласно табл. 3, представлен на рис. 9.Полученные кремниевые структуры имеют угол наклона стенок θexp = 52° ± 1°. Величина угла θexp несколько отличается от целевого значения θtag = 49°, соответствующего выбранному параметру Δai = 0.60 мкм. При вычислении значения θtag ширина основания кремниевой структуры полагалась равной 2a0. Однако ширина основания структуры последовательно уменьшается за счет изотропной составляющей травления кремния в каждом цикле Bosch-процесса (рис. 3). За счет этого величина θexp немного больше значения θtag.
ЗАКЛЮЧЕНИЕ
Представленный метод управления селективностью травления посредством изменения длительности дополнительной стадии модернизированного Bosch-процесса позволяет контролировать процесс переноса формы маски в кремний. Добавление стадии травления в кислородсодержащей плазме к базовому Bosch-процессу незначительно сказывается как на степени анизотропии, так и на скорости травления кремния. Расчеты, проведенные на основе исследования механизма травления фоторезиста, позволяют достаточно точно предсказывать профиль стенок формируемых кремниевых структур. Целевая кремниевая структура с правильной конической формой профиля получена в результате управления селективностью в пределах от 1.2 до 2.4. Достаточно грубая гребенчатая форма поверхности стенок структур связана с параметрами базового Bosch-процесса, которые были выбраны для наглядной демонстрации метода.
Список литературы
Cheon S.-E., Lee H.-S., Choi J., Jeong A.R., Lee T.S., Jeong D.S., Lee K.-S., Lee W.-S., Kim W.M., Lee H., Kim I. // Scientific Reports. 2017. V. 7. № 7336. P. 1.https://doi.org/10.1038/s41598-017-07463-7
Talin A.A., Ruzmetov D., Kolmakov A., McKelvey K., Ware N., Gabaly F.E., Dunn B., White H.S. // ACS Appl. Mater. Interfaces. 2016. V. 8. № 47. P. 32 385.https://doi.org/10.1021/acsami.6b12244
Li R., Lamy Y., Besling W.F., Roozeboom F., Sarro P.M. // J. Micromech. Microeng. 2008. V. 18. № 12. P. 1.https://doi.org/10.1088/0960-1317/18/12/125023
Saffih F., Con C., Alshammari A., Yavuz M., Cui B. // J. Vac. Sci. Technol. 2014. V. 32. № 6. P. 1.https://doi.org/10.1116/1.4901420
Figueroa R.F., Spiesshoefer S., Burkett S.L., Schaper L. // J. Vac. Sci. Technol. 2005. V. 23. № 5. P. 2226.https://doi.org/10.1116/1.2041654
Dixit P., Vähänen S., Salonen J., Monnoyer P. // ECS J. Solid State Sci. Technol. 2012. V. 1. № 3. P. 107.https://doi.org/10.1149/2.022203jss
Patent 6849554B2 (US). Method of etching a deep trench having a tapered profile in silicone. / Inventors. Rattner M., Chinn S.D. // 2005. P. 1–6.
Roxhed N., Griss P., Stemme G. // J. Micromech. Microeng. 2007. V. 17. № 5. P. 1087.https://doi.org/10.1088/0960-1317/17/5/031
De Boer M.G., Gardeniers J.G.E., Jansen H.V., Smulders E., Gilde M., Roelofs G., Sasserath J.N., Elwenspoek M. // J. Microelectromechanical S. 2002. V. 11. № 4. P. 385.https://doi.org/10.1109/JMEMS.2002.800928
Waits C.M., Morgan B., Kastantin M., Ghodssi R. // Sensors and Actuators. 2005. V. 119. № 1. P. 245.https://doi.org/10.1016/j.sna.2004.03.024
Patent 20020166838A1 (US). Sloped trench etching process. / Inventor. Nagarajan R. // 2002. P. 1–6.
O’Neill F.T., Sheridan J.T. // Optik. 2002. V. 113. № 9. P. 391.https://doi.org/10.1078/0030-4026-00186
Nussbaumyx P., Völkely R., Herzigy H.P., Eisnerz M., Haselbeckz S. // Pure Appl. Opt. 1997. V. 6. P. 617.https://doi.org/10.1088/0963-9659/6/6/004
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования