Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 5, стр. 47-55
Формирование наночастиц в Si, имплантированном ионами цинка и кислорода с последующим отжигом в вакууме
В. В. Привезенцев a, b, *, А. Н. Палагушкин a, В. С. Куликаускас c, В. И. Зиненко d, О. С. Зилова e, А. А. Бурмистров e, Т. С. Ильина f, Д. А. Киселев f, А. Ю. Трифонов g, h, А. Н. Терещенко i
a Научно исследовательский институт системных исследований Российской академии наук
117218 Moсква, Россия
b Физико-технологический институт им. К.А. Валиева Российской академии наук
117218 Moсква, Россия
c Научно-исследовательский институт ядерной физики
Московского государственного университета им. Ломоносова
11999 Moсква, Россия
d Институт проблем технологии микроэлектроники и особо чистых материалов Российской академии наук
142432 Московская область, Черноголовка, Россия
e Национальный исследовательский университет “МЭИ”
111250 Москва, Россия
f Национальный исследовательский технологический университет “МИСиС”
119049 Москва, Россия
g Национальный исследовательский университет “МИЭТ”
124489 Зеленоград, Москва, Россия
h Федеральное государственное унитарное предприятие “НИИФП”
124460 Зеленоград, Москва, Россия
i Институт физики твердого тела Российской академии наук
142432 Московская область, Черноголовка, Россия
* E-mail: v.privezentsev@mail.ru
Поступила в редакцию 20.02.2019
После доработки 28.05.2020
Принята к публикации 30.05.2020
Аннотация
В работе представлено формирование наночастиц в кремнии, последовательно легированном ионами Zn и О и отожженном в вакууме. Пластины n-типа Si с ориентацией (100) толщиной 380 нм и диаметром 76 мм, выращенного методом Чохральского, были имплантированы ионами 64Zn+ с дозой 5 × 1016 cм–2 и энергией 50 кэВ, и ионами 16О+ с дозой 2 × 1017 cм–2 и энергией 20 кэВ. При имплантации ионный ток не превышал 0.5 мкА/см2, чтобы перегрев пластин по сравнению с комнатной температурой не превышал 50°С. Далее пластины резались на образцы размером 10 × 10 мм и отжигались при температурах от 400 до 900°С с шагом в 100°С в вакууме в течение 30 мин. Обнаружено, что после имплантации в Si образуется аморфизованный слой толщиной около 150 нм, в котором формируются аморфные наночастицы Zn и О с размером около 5 нм. По мере термообработок радиационные дефекты отжигаются, а толщина аморфизованного слоя уменьшается. После отжига при 700°С на спектре фотолюминесценции образуется пик на длине волны 370 нм, обусловленный образованием наночастиц фазы ZnO. После отжига при 900°С этот пик пропадает, а на спектре фотолюминесценции появляется пик на длине волны 425 нм, обусловленный появлением фазы Zn2SiO4.
ВВЕДЕНИЕ
Наночастицы (НЧ) оксида цинка ZnО, сформированные в различных матрицах, cмогут найти применение в современной оптоэлектронике, поскольку оксид цинка является прямозонным материалом с шириной запрещенной зоны 3.37 эВ и имеет большую энергию связи электрона и дырки в экситоне 60 мэВ, которая позволяет получать УФ-излучение с длиной волны λ = 390 нм при температуре до 350°С [1]. Поэтому матрицы с НЧ из ZnO смогут найти широкое применение в таких современных оптоэлектронных устройствах, как УФ-лазеры и светодиоды [2], электролюминесцентные дисплеи [3]. Перспективно применение ZnO также в солнечных элементах [4], в cенсорных газовых устройствах [5], приборах памяти (мемристорах) [6], в приборах спинтроники, так как обнаружено, что ZnO в форме наночастиц обладает ферромагнетизмом уже при комнатной температуре [7], для медико-биологических целей [8–11] и т.п.
Формирование НЧ цинка в Si можно осуществить с помощью ионного легирования подложки Zn, после которого в подложке образуются НЧ металлического Zn. Далее для получения фазы ZnO необходимо применять окисление при повышенных температурах [12–15]. Этот метод позволяет получать концентрации цинка в кремнии в максимуме нормального распределения до значения NZn = 1 × 1022/cм3 (25 ат. %), что гораздо больше значения их предельной равновесной растворимости, которая составляет $N_{{{\text{Zn}}}}^{{{\text{lim}}}}$ = 6 × × 1016 см–3 [16] при температуре диффузии 1250°С. С другой стороны, можно проводить cовместную имплантацию ионов Zn и O и последующей отжиг в нейтральной или инертной средах [17].
В данной работе представлены результаты исследования формирования наночастиц ZnO в кремнии, последовательно легированном ионами Zn и О и отожженном в вакууме.
ОБРАЗЦЫ И МЕТОДИКИ ЭКСПЕРИМЕНТА
Подложки n-типа Si с ориентацией (100), выращенные по методу Чохральского, были последовательно имплантированы ионами 64Zn+ с дозой 5 × 1016 cм–2 и энергией 50 кэВ и ионами 16О+ с дозой 2 × 1017 cм–2 и энергией 20 кэВ при комнатной температуре так, чтобы их проекционные пробеги Rp = 40 нм [18] cовпадали. При имплантации ионный ток не превышал 0.5 мкА/см2, чтобы перегрев пластин по сравнению с комнатной температурой был не более 50°С. Далее пластины резались на образцы размером 10 × 10 мм и отжигались при температурах от 400 до 900°С с шагом в 100°С в вакууме в течение 30 мин.
Образцы были исследованы методом растровой электронной микроскопии (РЭМ), использовался растровый электронный микроскоп MIRA3 (TESCAN), в режимах вторичной эмиссии (ВЭ) электронов и обратно рассеянных электронов (ОРЭ) в сочетании с энерго-дисперсионной спектроскопией (ЭДС). Визуализация поверхности образцов проводилась также с помощью сканирующего зондового микроскопа MFP-3D (Asylum Research) в полуконтактной (AC Air Topography) и в Кельвин модах с применением кантилевера марки HA-NC/Pt (Tipsnano, Россия) жесткостью 3.5 Н/м и резонансной частотой свободных колебаний 140 кГц. Обработка полученных изображений осуществлялась в программе Gwyddion [19]. Структура поперечных сечений имплантированных слоев была исследована с помощью просвечивающего электронного микроскопа высокого разрешения (ПЭМ ВР) Tecnai G2 20 S-TWIN (FEI) в режиме высокого разрешения (S-TWIN) при ускоряющим напряжением 200 кэВ. Оптические свойства образцов исследовались методом фотолюминесценции (ФЛ) при температуре 10 К в диапазоне длин волн 350–800 нм с использованием He–Cd-лазера с длиной волны 325 нм и мощностью накачки 0.5 Вт/см2. Для регистрации спектров ФЛ использовался фотоэлектронный умножитель ФЭУ-79.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Исследования поверхности методами РЭМ и ЭДС
На рис. 1 представлены два РЭМ-изображения поверхности Si после имплантации Zn и O, одно в режиме РЭМ-ВЭ (рис. 1а), а другое в режиме РЭМ-ОРЭ (рис. 1б) при одном и том же увеличении. На рис. 1а в режиме РЭМ-ВЭ (топологический контраст) на поверхности Si видны многочисленные яркие пятна размером 10–100 нм, т.е. частицы на поверхности кремниевой подложки (бугорки). На рис. 1б в режиме РЭМ-ОРЭ (Z-контраст) частицы также хорошо выделяются на общем фоне. Это свидетельствует о том, что в состав этих частиц входят элементы тяжелее, чем Si. Иначе говоря, исходя из состава примесей, это Zn-cодержащие частицы (преимущественно Zn, так как температура имплантации была невелика по сравнению с комнатной). Из ЭДС-спектра получены численные значения содержания элементов в подложке после имплантации. Данные приведены в табл. 1, из которой следует, что в образце, кроме элемента матрицы Si, имплантированных элементов Zn и О также зафиксировано загрязнение углеводородами. Последнее связано с недостаточной очисткой атмосферы вакуумной камеры от паров масла, так как использовалась масляная откачка. После всего изложенного становится ясно, что яркие частицы на рис. 1 являются Zn-содержащими частицами. Это могут быть как частицы самого Zn, так и его оксида ZnO, что менее вероятно при низкой температура внедрения. Возможно также, что наблюдаемая частица представляет их смесь (Zn·ZnO).
Таблица 1.
Содержание элементов в подложке после Zn/O имплантации
| Элемент | Массовые % | Атомные % |
|---|---|---|
| SiKα1 | 72.94 | 62.83 |
| ZnLα1, 2 | 9.65 | 3.57 |
| OKα1 | 2.91 | 4.39 |
| СKа α1, 2 | 14.50 | 29.21 |
| Итого | 100.00 | 100.00 |
Дополнительным подтверждением к вышеизложенному являются ЭДС-карты элементов, представленные на рис. 2. Темные пятна на картах для линии спектра SiKα1 показывают отсутствие этого элемента в рассматриваемой частице. Светлое пятно на карте для линии спектра ZnLα1, 2 (рис. 2в) показывает наличие этого элемента в рассматриваемой частице. Зафиксировать светлые пятна на ЭДС-карте на рис. 2г для линии ОKα1 практически не удалось, поскольку, несмотря на высокий уровень легирования кислородом, мы использовали подложку кремния, выращенного по Чохральскому, в котором уровень кислорода составляет 1017–1018/см3, поэтому на таком фоне фиксация наночастиц О затруднена. Иначе говоря, нами визуализированы Zn-cодержащие НЧ, которые состоят преимущественно из Zn или смеси фаз Zn·ZnO.
Рис. 2.
РЭМ-ВЭ-изображение (а) и ЭДС-карты по кадру (а) для подложки Si после Zn/O-имплантации: карты для элеменов по линиям спектра SiKα1 (б), ZnLα1, 2 (в), ОKα1 (г) и СKα1, 2 (д).

На рис. 3 приведены РЭМ-ВЭ и РЭМ-ОРЭ-изображения поверхности Si-подложки, имплантированной Zn/О, после отжига в вакууме при температуре 700°С. Из рис. 3а следует, что в режиме топологического контраста на изображении наблюдаются в основном темные пятна (кратеры) и небольшое количество ярких пятен (бугорков) на поверхности подложки. На рис. 3б представлено изображение той же площади, но уже в режиме Z-контраста. Из этого рисунка следует, что как темные пятна впадины (кратеры), так и светлые пятна (бугорки) на поверхности пластины кремния сохранили соответственно свой темный и светлый фон, который был на рис. 3а. Иначе говоря, кратеры заполняются элементами легче, чем элемент Si-матрицы. Вероятно, они заполнены углеводородными загрязнениями, а светлые пятна на поверхности кремниевой пластины – это Zn-содержащие частицы. Из рис. 3б следует, что размеры как тех, так и других составляют менее 100 нм.
Рис. 3.
РЭМ-ВЭ (а) и РЭМ-ОРЭ (б) изображения поверхности имплантированного образца Si после отжига в вакууме при температуре 700°C в течение одного часа.
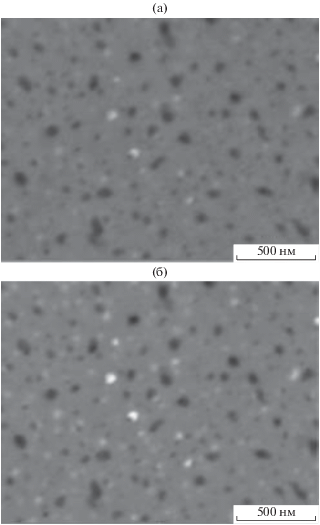
В табл. 2 представлены данные из ЭДС-спектра, полученного по кадру рис. 3. Из таблицы видно, что ЭДС-спектр ожидаемо состоит из нескольких элементов: Si – элемента матрицы, имплантированных элементов Zn и О, а также контаминации углеводородами C. Дополнительным подтверждением к вышеизложенному являются ЭДС-карты элементов, представленные на рис. 4. На РЭМ-ВЭ-изображении наблюдаются как темные, так и светлые пятна. На ЭДС-картах можно различить только светлые пятна (рис. 4в), относящийся к ZnLα1, 2-линии. Поскольку уровень сигнала достаточно малый, выделить остальные элементы не представилось возможным.
Таблица 2.
Содержание элементов в подложке после отжига при Т = 700°С
| Элемент | Массовые % | Атомные % |
|---|---|---|
| Si-Kα1 | 83.55 | 73.62 |
| Zn-Lα1, 2 | 3.52 | 1.33 |
| O-Kα1 | 3.10 | 4.80 |
| С-Kа α1, 2 | 9.83 | 20.25 |
| Итого | 100.00 | 100.00 |
Рис. 4.
РЭМ-ВЭ-изображение (а) подложки Si после отжига при 700°С (а); карты для элеменов по линиям спектра SiKα1 (б), Zn-Lα1, 2 (в), ОKα1 (г) и СKα1, 2 (д).
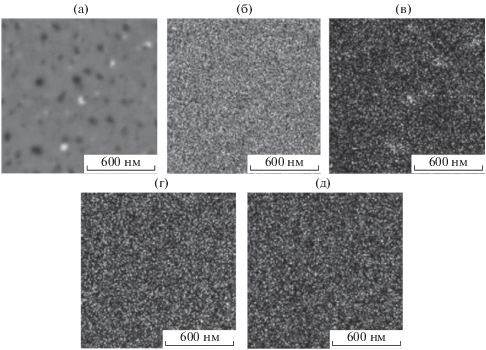
Из анализа данных табл. 2 становится ясно, что визуализированные на рис. 3. темные НЧ на поверхности кремния являются кратерами или порами, содержащими углеводородные загрязнения, а светлые пятна Zn-содержащими частицами, преимущественно состоящими из оксида цинка ZnO (см. ниже).
Анализ топологии поверхности методом атомно-силовой микроскопии
На рис. 5 представлены 2D- (рис. 5а) и 3D- (рис. 5б) АСМ-изображения поверхности кремниевой пластины после Zn/O-имплантации. В этом случае поверхность характеризуется следующими параметрами: Ra = 0.141 нм а Rms = 0.189 нм. Она сглаживается по сравнению с исходной поверхностью обычной коммерческой кремниевой подложки вследствие явления распыления верхнего слоя при имплантации, что хорошо известного из литературы.
На рис. 6 представлены 2D- (рис. 6а) и 3D- (рис. 6б) АСМ-изображения поверхности имплантированной кремниевой пластины после после отжига при 700°С в течение 1 ч в вакууме. Поверхность характеризуется следующими параметрами: среднее значение неоднородности поверхности составляет Ra = 0.148 нм, а Rms = 0.190 нм. Из сравнения данных на рис. 5 и 6 следует, что шероховатость поверхности подложки кремния несколько увеличилась после отжига от ее состояния после Zn/O-имплантации. Относительно размеров неоднородностей поверхности в плоскости можно отметить, что они тоже увеличились, т.е. поверхность структурируется. Такое структурирование поверхности в плоскости мы связываем с образованием латентных областей внутри матрицы Si после отжига, который сопровождаются формированием НЧ оксида цинка. При этом возможна диффузия Zn к поверхности образца, образованием его скоплений вблизи поверхности, создающих неровности на самой поверхности. Также возможен вылет цинка в окружающую атмосферу с образованием поверхностных пор (кратеров) небольших размеров (около 10 нм).
Анализ поперечных сечений методом просвечивающей электронной микроскопии
На рис. 7 представлены ПЭМ-изображения поперечного сечения верхнего слоя Si после Zn/O имплантации: на рис. 7а – обзорное, а на рис. 7б – при высоком разрешении. Из анализа ПЭМ-изображений рис. 7а следует, что после имплантации Zn/О под поверхностью пластины образуется аморфизованный слой толщиной около 200 нм. Об аморфизации свидетельствует электронограмма, представленная на вставке на рис. 7а (вставка вверху), которая представляет из себя гало. Ниже располагается кристаллический слой кремния, о чем свидетельствует электронограмма на вставке рис. 7а (вставка внизу), на которой видны рефлексы, относящиеся к кристаллическому Si. На рис. 7б представлено ПЭМ-изображение подповерхностного слоя при высоком разрешении (ВР). На нем видны НЧ цинка и/или кислорода со средним размером около 5 нм. Они являются аморфными, так как атомные плоскости не просматриваются (рис. 7б) и Фурье-образ представляет собой гало без каких-либо рефлексов (вставка на рис. 7б).
Рис. 7.
ПЭМ-изображения поперечного сечения приповерхностного слоя Si после Zn/O-имплантации: а – панорамное изображение, б – приповерхностный слой. Вставка (рис. 7а сверху) – электронограмма подповерхностного аморфизованного слоя. Вставка (рис. 7а снизу) – электронограмма кремниевой кристаллической подложки. Вставка (рис. 7б внизу слева) – фурье-образ приповерхностной области по кадру (б).
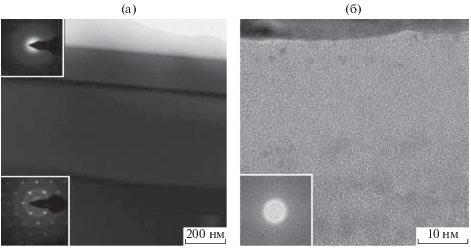
На рис. 8 представлены ПЭМ-изображения поперечного сечения приповерхностного слоя подложки Si после отжига при 700°С: на рис. 8а – панорамное темнопольное (ТП), а на рис. 8б – светлопольное (СП) при высоком разрешении (ВР). Из анализа ПЭМ-изображений следует, что после отжига, на глубине около 40 нм, что соответствует величине проекционных пробегов для ионов Zn и О, которые (как уже было отмечено) были выбраны одинаковыми и составляют около 40 нм, располагаются кристаллические частицы Si c ориентацией (111), (220) и (113), а также кристаллические НЧ оксида цинка с ориентацией (102) со средним размером 5–10 нм. Эти НЧ являются кристаллическими, на что указывают рефлексы на Фурье-образе (вставка на рис. 8a). Гало на этом Фурье-образе свидетельствует о частичной аморфизации приповерхностного слоя образца. На рис. 8б изображен подповерхностный слой кремния после отжига при 700°С. На нем видна частица с размерами около 5 нм. Кристаллографические плоскости разнонаправлены. Фурье-образ по этому кадру свидетельствует, что это наночастицы кремния.
Исследование спектров ФЛ
На рис. 9 представлены спектры ФЛ образцов Si, полученные при температуре 10 К. ФЛ исследована для образцов после Zn/O имплантации (кривая 1) и после отжигов в диапазоне температур от 400 до 900°С (кривые 2–6). Из кривой 1 (рис. 9) следует, что ФЛ подложки Si после Zn/O имплантации представляет собой малоинтенсивную широкую полосу с максимумом около 420–430 нм, обусловленную радиационными дефектами в Si после имплантации. После отжига при 400°С, как это следует из кривой 2, спектр ФЛ практически не изменяется. Дальнейший отжиг при 600°С приводит к уменьшению интенсивности ФЛ, которое мы связываем с отжигом радиационных дефектов в имплантированном Si. Кроме того, на спектре появляется узкий интенсивный пик на длине волны 370 нм, обусловленный экситонной люминесценцией в образовавшейся фазе ZnO. Последнее стало возможным, поскольку в матрице кремния, очевидно, имеется достаточное количество атомов кислорода, а при имплантации Zn и О происходит локальный нагрев, при котором атомы кислорода становятся свободными и могут окислить имплантированный цинк. После отжига при 700°С этот пик ФЛ значительно возрастает, что свидетельствует об увеличении содержания фазы ZnO в подложке. Одновременно с этим происходит образование интенсивной широкой полосы ФЛ с максимумом в области 390 нм, природа которой на данный момент неясна, но, предположительно, связана с образованием в подложке высокотемпературной фазы силицида цинка – виллемита Zn2SiO4. Отжиг при 800°С приводит к уменьшению интенсивности линии экситонной люминесценции в ZnO и сдвигу широкой полосы люминесценции в длинноволновую область. Заключительный отжиг при 900°С приводит к значительному гашению экситонной ФЛ на длине волны 370 нм в результате разрушения фазы ZnO, а также уменьшению интенсивности широкой полосы ФЛ.
ЗАКЛЮЧЕНИЕ
После Zn/O-имплантации в подложке Si образуются аморфизованный слой, о чем свидетельствует РЭМ-исследования.
Из анализа ПЭМ-изображений следует, что в этом слое формируются аморфные Zn-содержащие наночастицы размером около 10 нм. Наличие фазы Zn цинка подтверждается ЭДС-спектром для ZnLα1, 2-линии.
После Zn/O имплантации, согласно данным АСМ, параметры шероховатости составляют: Ra = 0.141 нм, а Rms = 0.189 нм.
После отжига при 700°С шероховатость поверхности несколько увеличивается, и она характеризуется следующими параметрами: среднее значение шероховатости составляет Ra = 0.148 нм, а Rms = 0.190 нм.
После отжига при 600°С в Si-подложке формируется фаза ZnO, о чем свидетельствует спектр ФЛ с характерным экситонным пиком для этой фазы на длине волны 370 нм. Это пик растет с ростом температуры до 700°С, а затем снижается с ростом температуры до 900°С в результате разрушения фазы ZnO.
Список литературы
Litton C.W., Collins T.C., Reynolds D.S. Zinc Oxide Materials for Electronic and Optoelectronic Device Application. Chichester: Wiley, 2011. 386 p.
Jiang C.Y., Sun X.W, Lo G.Q., Kwong D.L., Wang J.X. // Appl. Phys. Lett. 2007. V. 90. P. 263501.
Li C., Yang Y., Sun X.W, Lei W., Zhang X.B., Wang B.P., Wang J.X., Tay B.K. Ye J.D., Lo G.Q., Kwong D.L. // Nanotechnology. 2007. V. 18. P. 135604.
Smestad G.P., Gratzel M. // J. Chem. Educ. 1998. V. 75. P. 752.
Chu S., Olmedo M., Yang Zh., Kong J., Liu J. et al. // Appl. Phys. Lett. 2008. V. 93. P. 181106.
Straumal B.B., Mazilkin A.A., Protasova S.G., Myatiev A.A., Straumal P.B., Schütz G., van Aken P.A., Goering E., Baretzky B. // Phys. Rev. B. 2009. V. 79. P. 205206.
Dodds1 J.S., Meyers F.N., Loh K.J. // Smart Structures and Systems. 2013 V. 12 P. 055.
Bagnall D.M., Chen Y.F., Shen M.Y., Zhu Z., Goto T., Yao T. // J. Cryst. Growth 1998. V. 184/185. P. 605.
Chang H., Park H.D., Sohn K.S., Lee J.D. // J. Korean Phys. Soc. 1999. V. 34. P. 545.
Yusof M.M., Ani M.H., Suryanto. //Advanced Mater. Res. 2013 V. 701. P. 172.
Son Dong-Ick, Park Dong-Hee, Choi Won Kook, Cho Sung-Hwan, Kim Won-Tae, Kim Tae Whan // Nanotechnology. 2009. V. 20. P. 195203.
Amekura H., Takeda Y., Kishimoto N. // Mater. Lett. 2011. V. 222. P. 960.
Umeda N., Amekura H., Kishimoto N. // Vacuum. 2009. V. 83. P. 645.
Shen Y.Y., Zhang X.D., Zhang D.C., Xue Y.H., Zhang L.H., Liu C.L. // Mater. Lett. 2011. V. 65. P. 2966.
Privezentsev V., Kulikauskas V., Steinman E., Bazhenov A. // Phys. Stat. Sol. C. 2013. V. 10. P. 48.
Milnes A.G. Deer impurities in semiconductors. N.Y.: Wiley, 1973. 563 p.
Privezentsev V.V., Makunin A.V., Batrakov A.A., Ksenich S.V., Goryachev A.V. // Semiconds. 2018. V. 52. P. 645.
Ziegler J.F., Biersack J.P. // SRIM 2008 (http:// www.srim.org).
http://gwyddion.net/
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования