Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2022, № 10, стр. 48-51
Изучение состава неконтролируемых примесей и профилей их распределения на границе раздела Ni–CdS
А. А. Абдувайитов a, Х. Х. Болтаев a, *, Г. А. Розиков b
a Ташкентский государственный технический университет им. Ислама Каримова
100095 Ташкент, Узбекистан
b Ташкентский институт текстильной и легкой промышленности
100100 Ташкент, Узбекистан
* E-mail: khurshid.boltaev@gmail.com
Поступила в редакцию 19.10.2021
После доработки 19.01.2022
Принята к публикации 22.01.2022
- EDN: OEHYAA
- DOI: 10.31857/S1028096022100028
Аннотация
Методами электронной оже-спектроскопии и вторично-ионной масс-спектрометрии исследованы концентрация атомов неконтролируемых примесей, их химический состав на поверхности пленок Ni, а также профили распределения атомов некоторых примесей в пленках Ni и на границе системы Ni–CdS. Пленки Ni толщиной 0.5–1 мкм получены методом термического испарения в вакууме (~10–6 Пa). В хорошо обезгаженной пленке Ni, кроме кислорода и углерода, обнаружены примесные атомы более 10 элементов, однако их общая концентрация составляет ~1–1.5 ат. %. Эти примесные атомы проникают в слой Ni из подложки CdS, глубина их проникновения составляет 0.3–0.4 мкм. На границе системы Ni–CdS концентрация кислорода достигала 8–10 ат. %, в результате чего формировались соединения типа NiO и NiO2.
ВВЕДЕНИЕ
Благодаря своим уникальным свойствам пленки CdS и их трехкомпонентные твердые растворы (например, CdxHg1 –xTe) широко используются при создании различных видов фотодетекторов, фотоприемников, солнечных элементов и других чувствительных приборов, нано- и оптоэлектроники [1–8]. Особое значение имеет нанесение на их поверхность тонких надежных омических контактов. Ухудшение контакта вследствие его загрязнения (в особенности окисления) и уменьшения адгезии пленки, взаимной диффузии основных и примесных элементов на границе металлической пленки и полупроводника, и других причин во многих случаях приводит к негодности полупроводниковых приборов [9–12].
Основные дефекты вблизи контакта образуются из-за несоответствия типа и параметров кристаллических решеток металла и полупроводника. В частности, исследования структуры границ раздела Me–Si нанометровой толщины, подвергнутой термообработке в интервале температур Т = 330–870 К, показали, что вблизи границы вследствие низкотемпературной диффузии образуется аморфный слой кремния [13]. В работе [14] для уменьшения взаимной диффузии на границе раздела Ni–CdS использован метод низкоэнергетической бомбардировки CdS ионами Ar+. В результате облучения на поверхности CdS образовались барьерные слои Cd толщиной 10–12 Å, что в 3–4 раза уменьшило глубину взаимной диффузии атомов Ni и CdS. Необходимо отметить, что наличие атомов химически активных примесных элементов (O, K, Ca и других) в составе контактирующего металла и полупроводника существенно влияет на качество контакта.
Такие исследования для систем Me–CdS пока не проведены. В настоящей работе изучены состав неконтролируемых примесей, содержащихся в Ni и CdS, и их профили распределения по глубине на границе раздела Ni–CdS.
МЕТОДИКА ПРОВЕДЕНИЯ ЭКСПЕРИМЕНТА
Напыление пленок Ni на поверхности CdS/SnO2, изучение состава неконтролируемых примесей на поверхности и их профилей распределения по глубине системы Ni/CdS осуществлено в универсальной сверхвысоковакуумной установке типа “УСУ-2”. Для сравнения некоторые эксперименты были проведены на вторично-ионном масс-спектроскопе типа “МИ-1201Б” [15].
В качестве подложек были использованы поликристаллические пленки CdS n-типа толщиной 1 мкм, выращенные на поверхности стекла SnO2. Пленки Ni толщиной 0.5–1 мкм осаждены на поверхность нагретого до ~400 K CdS методом термического испарения в вакууме (~10–6 Пa). Перед напылением поверхность CdS была очищена нагреванием до ~900 K в сочетании с ионным травлением. После очистки на поверхности CdS в основном содержались примеси кислорода с концентрацией 1–1.5 aт. %.
Все исследования проведены при давлении ~10–7 Пa. Профили распределения атомов Ni по глубине определены методом электронной оже-спектроскопии в сочетании с травлением поверхности ионами Ar+ с энергией E0 = 1 кэВ, падающих на поверхность под углом 10°–15°. Оценка толщины пленок Ni также проведена методом электронной оже-спектроскопии в сочетании с травлением поверхности ионами Ar+. Предварительно с помощью прибора LASS-2200, оснащенного профилометром Alpha-Step, определяли скорость травления поверхности при различных плотностях тока ионов аргона j. При j ≈ 20 мкм/см2 скорость травления для Ni составляла ~10 нм/мин. Ошибка измерений не превышала 3–5%.
Концентрация Ñx атомов, входящих в состав пленки и подложки, была определена по относительному изменению интенсивности оже-пиков. В расчетах использован метод коэффициентов (факторов) элементной оже-чувствительности с матричными поправками [16]:
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Перед измерением система Ni–CdS была очищена прогреванием до Т = 850–870 K в течение 3–4 ч. Из оже-электронного спектра, приведенного на рис. 1, видно, что на поверхности пленки Ni содержится небольшое количество (2–3 aт. %) атомов примесных элементов (Rb, С, О, Cl, K, Ca, Mn и других). Исследования, проведенные с использованием метода вторично-ионной масс-спектрометрии, показали, что в Ni наряду с указанными примесями содержатся в малом количестве (менее 0.2–0.3 aт. %) атомы неконтролируемых примесей: P, S, Cr, Ti, Zn, Cu. На рис. 2 приведены профили распределения примесных атомов С, О и Na по глубине. Видно, что на поверхности пленки Ni общая концентрация О и С составляет ~1.5–2.0 ат. %. С ростом глубины их концентрация уменьшается и достигает минимума на глубине 0.6–0.7 мкм, то есть вблизи границы раздела Ni–CdS. На этой же глубине и далее были обнаружены примесные атомы Na. Концентрация всех примесных атомов в интервале x ≈ ≈ 0.7–1 мкм резко увеличивается и при х ~ 1 мкм концентрация О составляет ~8–10 ат. %; С – 3–4 ат. %; Na – 1.5 ат. %. На глубине х ~ 1.2–1.3 мкм их концентрация уменьшается в 2–3 раза, затем – практически не меняется. Исходя из этого, можно предполагать, что эти примеси содержались в слое CdS.
Рис. 2.
Кривые профилей распределения концентрации примесей C, O, Na по глубине х в системе Ni–CdS; ◻ – кислород; ⚪ – углерод; ⚫ – натрий.

Наличие в объеме и на поверхности пленки CdS примесных элементов O, K, Na, и других приводит к изменению удельного сопротивления металлического контакта и переходного слоя, образующегося на границе Ni–CdS. Действительно, примесные элементы щелочных металлов и кислорода, находясь на поверхности полупроводниковых пленок, мигрируют и могут собираться на границе между металлическим контактом и пленкой и, соответственно, приводят к окислению и образованию щелочно-металлических соединений [15, 17, 18].
На рис. 3 приведены низкоэнергетические области оже-спектров Ni, снятые после послойного травления пленки Ni в пределах 0.4, 0.8 и 1.0 мкм. Видно, что вблизи М2М4М5 – пика Ni (Е = 61 эВ), при х ~ 0.8 мкм, явно выделяется сателлитный пик, соответствующий энергии 54 эВ. Анализ показал, что положение этого оже-пика приблизительно соответствует соединению NiO. Максимальная концентрация кислорода на границе контакта Ni–CdS (при х ≈ 1 мкм) составляет 8–10 ат. %. В этой области положение сателлитного оже-пика смещается в область Е ≈ 51 эВ. Совместный анализ спектров оже-электронов и вторичных ионов показали, что на границе двух слоев образуется соединение типа NiO2. Такое количество кислорода приводит к окислению значительной части Ni вблизи границы, что приводит к увеличению сопротивления контакта [13].
Рис. 3.
Низкоэнергетический оже-пик никеля, соответствующий энергии 61 эВ (переход М2М4М5), полученный после снятия ионным травлением поверхности толщиной 0.4 (1); 0.8 (2); 1.0 мкм (3).
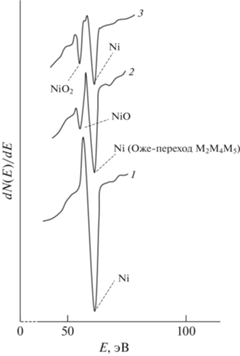
На рис. 4 приведен масс-спектр отрицательно заряженных частиц, распыленных с глубоких слоев никелевой пленки после травления на глубину х ~ 0.8 мкм. В спектре наряду с интенсивными пиками, характерными для Ni, присутствуют пики, соответствующие примесным элементам, имеющимся в составе CdS.
Рис. 4.
Масс-спектрограмма отрицательно заряженных частиц, распыленных при бомбардировке контактных областей никелевой пленки пучком атомов Cs с энергией Е0 = 8 кэВ.

По-видимому, из-за несоответствия типов кристаллических решеток Ni (кубическая) и Cd (гексагональная, типа вюрцита) на их границе возникают различные виды дефектов. Следовательно, образуются сильно разупорядоченный переходной слой и точечные дефекты вне его. Накопление точечных включений атомов, в частности кислорода, уменьшает концентрацию основных носителей заряда в полупроводнике и окисляет поверхность металлических контактов. Поэтому подбор материалов для металлических контактов с кристаллической структурой близкой к структуре подложки-полупроводника, очевидно, увеличивает срок эксплуатации полупроводниковых приборов, созданных на основе таких структур.
В настоящей работе изучены профили распределения основных и примесных атомов на границе системы Ni–CdS. Показано, что примесные атомы, содержащиеся на поверхности CdS, диффундируют в пленку контактирующего металла. Установлено, что глубина проникновения неконтролируемых примесей из CdS в Ni составляет ~0.3–0.4 мкм. В частности, концентрация кислорода в контактной области увеличивается до 8–10 ат. %, что приводит к образованию соединений типа NiO и NiO2 на границе.
Список литературы
Стецюра С.В., Глуховский Е.Г., Козловский А.В., Маляр И.В. // ЖТФ. 2015. Т. 85. № 5. С. 116.
Chan W.C.W., Nie S. // Science. 1998. V. 281. P. 2016
Петросян П.Т., Гриорян Л.П. // ЖТФ. 2017. Т. 87. № 3. С. 443.
Мирсагатов Ш.А., Сапаев И.Б. // ФТТ. 2015. Т. 57. № 4. С. 646.
Свит К.А., Журавлев К.С. // ФТП. 2019. Т. 53. № 11. С. 1573.
Бондарь Н.В., Бродин М.С., Матвеевская Н.А., Бейник Т.Г. // ФТП. 2019. Т. 53. № 2. С.199.
Новиков Г.Ф., Tsai W.-T., Бочаров К.В., Рабенок Е.В., Jeng M.-J., Chang L.-B., Feng W.-Sh., Ao J.-P., Sun Y. // ФТП. 2016. Т. 50. № 10. С. 1363.
Редько Р.А., Будзуляк С.И., Корбутяк Д.В., Лоцько А.П., Вахняк Н.Д., Демчина Л.А., Калитчук С.М., Конакова Р.В., Миленин В.В., Быков Ю.В., Егоров С.В., Еремеев А.Г. // ФТП. 2015. Т. 49. № 7. С. 916.
Алиев А.А., Абдувайитов А.А. // Узбекский физический журн. 2007. № 6. С. 263.
Umirzakov B.E., Tashmukhamedova D.A., Boltaev E.U., Dzhurakhalov A.A. // Mater. Sci. Engineer. B. 2003. V. 101. № 1–3. P. 124.
Алиев А.А., Хазратов Ф.Х. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2003. № 9. С. 79.
Ташмухамедова Д.А., Юсупжанова М.Б., Ташатов А.К., Умирзаков Б.Е. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2018. № 9. С. 78. http://doi.org./10.1134/S0207352818090111
Крылов П.Н., Кривелевич С.А. Ускова Е.А. // Химическая физика и мезоскопия. 2011. Т. 13. № 2. С. 238.
Умирзаков Б.Е., Ташмухамедова Д.А., Раббимов Э.А., Содикжанов Ж.Ш., Уроков А.Н. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2019. № 12. С. 76. http://doi.org./10.1134/S10280 96019120343
Abduvaiitov A.A., Boltaev Kh.Kh. // Technical Phys. 2015. V. 60. № 4. P. 621. http://doi.org./10.1134/S1063784215040027
Palmberg P.W. // J. Vac. Sci. Technol. 1976. V. 13. № 1. P. 314.
Эргашов Ё.С., Ташмухамедова Д.А., Раббимов Э. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 4. С. 38. http://doi.org./10.7868/S0207352815040083
Эргашов Ё.С., Ташмухамедова Д.А., Умирзаков Б.Е. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. № 4. С. 104. http://doi.org./10.7868/S0207352817040084
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



