Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2022, № 2, стр. 58-63
Равновесная концентрация изломов на SB ступенях поверхности Si(100)
М. Ю. Есин a, *, С. А. Тийс a, **, А. И. Никифоров a, b
a Институт физики полупроводников им. А.В. Ржанова Сибирского отделения Российской академии наук
630090 Новосибирск, Россия
b Национальный исследовательский Томский государственный университет
634050 Томск, Россия
* E-mail: yesinm@isp.nsc.ru
** E-mail: teys@isp.nsc.ru
Поступила в редакцию 25.05.2021
После доработки 26.06.2021
Принята к публикации 30.06.2021
- EDN: BLQJPK
- DOI: 10.31857/S1028096022020030
Аннотация
Представлены результаты исследований температурных и временных зависимостей концентрации изломов на ступенях SA, SB, перпендикулярных к димерным рядам верхней террасы поверхности Si(100) с отклонением 0.5°. Изображения ступенчатой поверхности Si(100) с атомным разрешением были получены методом сканирующей туннельной микроскопии. По изображениям определялось количество изломов на ступенях. Зависимость количества изломов от температуры имеет минимум при 650°С. Вероятно, что при низких температурах активнее происходит процесс “выглаживания” ступеней (исчезновение изломов ступеней), а при высоких температурах – “разрушение” ступеней (формирование большого количества изломов ступеней). Процесс “выглаживания” и “разрушения” ступеней, в свою очередь, состоит из последовательности элементарных актов атомов и димеров. Концентрация изломов уменьшается и выходит на стационарный уровень с увеличением длительности отжига. Равновесная концентрация изломов ступеней определяется температурой и длительностью отжига поверхности.
ВВЕДЕНИЕ
Известно, что на вицинальной поверхности Si(100) с углом отклонения более 2° в процессе отжига происходит формирование сдвоенных ступеней [1]. Аналогичный эффект сдваивания ступеней можно наблюдать при эпитаксиальном росте на поверхности с меньшим отклонением от плоскости {100} [2, 3]. Для понимания физики процесса сближения и расхождения ступеней необходимо рассмотрение кинетики элементарных актов атомов на ступенях и террасах поверхности [4, 5]. Условия, влияющие на сближение однослойных ступеней, определяются поверхностной диффузией и анизотропией кинетики роста [3]. Когда происходит сближение ступеней в процессе роста молекулярно-лучевой эпитаксии (МЛЭ) [2, 3, 6–8], на ступени одновременно действуют силы отталкивания, которые объясняются термодинамикой ступенчатой поверхности. Отталкивание между ступенями может возникать из упругого и эффективного энтропийного взаимодействия [1]. Если ступени отталкиваются вследствие действия упругого или эффективного энтропийного взаимодействия, то ступени будут равноудалены друг от друга [9]. Морфология ступеней играет важную роль при движении ступеней в процессе МЛЭ [10–13]. Одним из важных вопросов остается определение равновесной концентрации SB ступеней поверхности Si(100). В связи с этим поверхность Si(100) вызывает интерес к изучению равновесной структуры SB ступеней.
Вследствие поверхностной перестройки атомов поверхность с моноатомными ступенями имеет двухдоменную структуру (2 × 1 и 1 × 2) с димерными рядами, расположенными перпендикулярно друг к другу [14, 15]. При отклонении поверхности Si(100) строго в направлении [110] край одной из ступеней будет расположен перпендикулярно к димерным рядам верхней террасы (SB ступень), а край другой ступени – параллельно димерным рядам верхней террасы (SA ступень). По причине этих структурных особенностей края SA ступеней являются гладкими, а края SB ступеней шероховатыми [16]. Таким образом, система, состоящая из чередующихся моноатомных SA и SB ступеней на поверхности Si(100), является интересной для изучения кинетики элементарных процессов. Цель данной работы – поиск оптимальных условий формирования равновесной концентрации изломов SB ступеней на поверхности Si(100).
Концентрация изломов SB ступеней в процессе отжига уменьшается со временем и выходит на постоянный уровень. Концентрацию изломов, которая не изменяется со временем отжига, мы называем равновесной концентрацией изломов. Из выражения для концентрации изломов, предложенного Swartzentruber и др. в работе [16], следует, что концентрация изломов ступеней увеличивается при повышении температуры отжига. Наиболее вероятно, время, за которое происходит формирование равновесной концентрации изломов ступеней, должно уменьшатся при повышении температуры.
МЕТОДИЧЕСКАЯ ЧАСТЬ
Отжиг и получение чистой поверхности кремния проводили в сверхвысоковакуумной установке к сканирующему туннельному микроскопу (СТМ) фирмы Omicron. Образцы кремния размером 12 × 3 × 0.4 мм вырезали из подложки Si(100) n-типа с сопротивлением 5–10 Ом · см, которая имела отклонение от плоскости {100} к плоскости {111} строго вокруг оси ❬110❭ на угол 0.5°. Перед установкой в камеру СТМ образцы обрабатывали в водном растворе смеси азотной кислоты и перекиси водорода для формирования тонкого защитного слоя оксида кремния. Последующее удаление защитного слоя оксида кремния прогревом в вакууме позволяло воспроизводимо получать атомарно-чистую поверхность. В вакуумной камере образцы предварительно обезгаживались (не менее 4 ч при температуре около 600°С), затем поверхность кремния очищалась прогревом при 1250°С несколько секунд при давлении не выше (1–2) × 10–10 Торр. Образец прогревался прямым пропусканием тока и охлаждался с помощью управляемого компьютером блока питания Agilent N5770A. Формирование исходной атомарно-чистой поверхности Si(100) происходило после охлаждения образца от 1250 до 350°С ступенчатым понижением тока накала по логарифмической зависимости под управлением компьютера. Суммарное время охлаждения составляло около 32 мин.
Отжиги исходной поверхности образца проводили в интервале температур 450–850°С (с шагом 100°), время отжига варьировали от 5 до 160 мин. После отжигов и отключения тока накала образец остывал не менее одного часа с целью исключения термодрейфа во время записи изображений СТМ. Калибровка температуры образца проводилась с помощью оптического пирометра.
В качестве СТМ-зонда использовались вольфрамовые иглы, полученные электролитическим травлением в растворе щелочи. СТМ-изображения поверхности записывались при комнатной температуре. Для всех изображений СТМ светлые участки на рисунках соответствуют выступающим частям рельефа поверхности, а темная расцветка соответствует углублениям. Для каждого отжига производился подсчет изломов по 8 изображениям СТМ размером 80 × 80 нм с суммарной длинной SB ступени примерно 1500 нм.
РЕЗУЛЬТАТЫ
СТМ-изображение исходной поверхности после медленного охлаждения от 1250 до температуры 350°С показано на рис. 1а. Для сравнения на рис. 1б показано изображение поверхности после отжига 750°С в течение 40 мин. Как видно из полученных изображений, исходная поверхность после медленного охлаждения была более дефектная, чем после дополнительно отжига при 750°С. Аналогичный результат и для количества изломов на SB ступенях. После медленного охлаждения изломов SB ступеней больше, чем после дополнительного отжига при 750°С. Количество изломов на ступенях SB при остывании от температуры 350°С мы приняли за исходную точку на зависимостях от температуры отжига (рис. 2), а также за начальную точку на зависимости количества изломов ступеней от длительности отжига (рис. 3).
Рис. 1.
Изображения СТМ поверхности Si(100) (80 × 80 нм): а – после медленного охлаждения до температуры 350°С, б – после отжига при температуре 750°С.
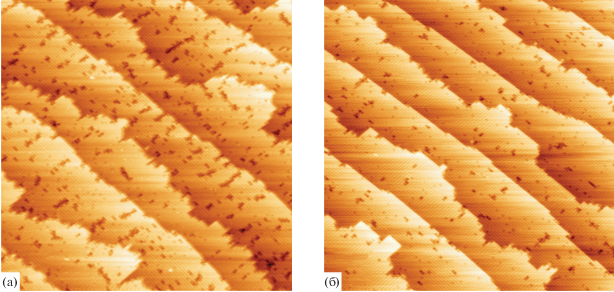
Рис. 3.
Зависимость количества изломов SB ступеней поверхности Si(100) от длительности отжига при температуре 650°С.
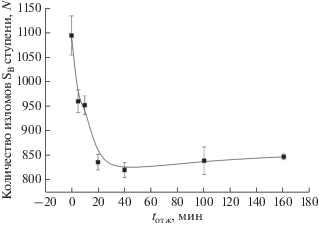
На рис. 2 представлена зависимость количества изломов SB ступеней поверхности Si(100) от температуры отжига. Количество изломов выбрано как сумма всех изломов с разной длиной на ступенях. Отжиг проводился в течение 40 мин при всех температурах. Как видно из рис. 2, кривая зависимости концентрации изломов SB ступеней от температуры отжига имеет вид параболы с ветвями, направленными вверх, и минимумом при температуре 650°С. С увеличением температуры отжига концентрация изломов ступеней сначала уменьшается и затем (после температуры 650°С) начинает расти. Количество изломов SB ступеней при 650°С по сравнению с 350°С меньше примерно на 25%.
На рис. 3 представлена зависимость количества изломов SB ступеней поверхности Si(100) от длительности отжига при оптимальной температуре 650°С. Кривая зависимости количества изломов SB ступеней от длительности отжига сначала падает и выходит на постоянный уровень. Концентрацию изломов ступеней, которая изменяется незначительно со временем отжига, будем считать равновесной концентрацией изломов ступеней. Время формирования равновесной концентрации изломов для температуры отжига 650°С составляет примерно 20 мин.
На рис. 4 представлено изменение размеров изломов SB ступеней после отжига при температуре 650°С в течение 40 мин. На врезке изображен фрагмент SB ступени и измеряемая величина длины излома n. По оси Y отложено количество изломов ступеней в логарифмическом масштабе, по оси X отложена длина изломов в n атомах. Для двух температур распределения изломов SB ступеней имеют логарифмическую зависимость. Можно видеть, что при температуре 650°С коротких изломов (примерно n ≤ 8) меньше, чем при 350°С, а длинных изломов (примерно n > 20), наоборот, больше.
ОБСУЖДЕНИЕ РУЗУЛЬТАТОВ
Как известно из работ Chadi и др. [17], атомная структура SB ступеней включает в себя перестроенные (rebonded) и неперестроенные (nonbonded) ступени. Атомы перестроенной ступени связаны с атомами нижележащей террасы, а атомы неперестроенной ступени не связаны. Неперестроенная структура атомов менее энергетически выгодна, чем перестроенная структура атомов ступеней, несмотря на то что для последней деформация длины связи достигает 5% [17]. В реальных изображениях СТМ большинство ступеней имеют структуру перестроенных ступеней. Эти структурные особенности играют важную роль в определении энергетики ступеней поверхности [18].
Из работы [17] следует, что ступени ограничиваются в большинстве случаев перестроенной структурой атомов на ступени с атомами нижней террасы, при этом изломы чаще имеют длину, кратную 2а (а – постоянная решетки поверхностной ячейки). Формирование излома происходит путем отсоединения четырех атомов, составляющих два димера. Один из краев излома представляет собой часть сегмента SA и другой край – часть сегмента SB, причем независимо от того, излом это SA или SB ступени. Следует, что работа, затраченная на испарение комплекса двух димеров из одного излома, не зависит от типа ступени. А также эта работа (на атом), взятая с отрицательным знаком, равна химическому потенциалу кристалла Si в абсолютном нуле. Расстояние между изломами должно быть кратным 2а по той же причине [19].
Как ранее было показано Swartzentruber и др. в работе [16], что в предположении независимых изломов, т.е. N(n) ∼ exp(–(E(n)/kT)), где N(n) –концентрация изломов длиной n атомов, E(n) – энергия излома длиной n атомов, k –постоянная Больцмана и T – температура, энергия может быть выражена в форме E(n) = nεSB + C. Величина εSB может быть интерпретирована как энергия на атом ступени, а С – константа, связанная с изломом. Энергия излома – сумма постоянной энергии угла и энергии формирования излома, которая пропорциональна длине излома. Такое рассмотрение справедливо для термически активированных изломов. При строгой ориентации в азимутальном направлении [110] подложки Si(100) термически активированных изломов больше чем тех, которые появились в результате азимутальной разориентации. Согласно формуле концентрации изломов N(n) ∼ ∼ exp(–(E(n)/kT)), с увеличением температуры поверхности концентрация изломов SB ступени увеличивается. Однако, полученный результат (рис. 2) имеет немонотонную зависимость концентрации изломов от температуры.
В данной работе показано, что концентрация изломов SB ступеней при температуре отжига 650°С уменьшается со временем и выходит на постоянный уровень (рис. 3). Процесс “выглаживания”, по-видимому, будет состоять из последовательности элементарных актов: отсоединение димеров из излома или ступени, диффузия димера вдоль ступени или по террасе и присоединение димера к излому. В то время как формирование излома ступени будет состоять преимущественно только из процесса отсоединения димеров. Равновесная концентрация изломов достигается, когда количество термически активированных изломов скомпенсировано количеством исчезнувших изломов в процессе “выглаживания” ступени (согласно приведенному нами определению). Такое определение равновесной концентрации изломов несет скорее условный характер. Поскольку при достаточно высоких температурах отжига может возникнуть ситуация, когда максимально возможное количество изломов будет приблизительно равно количеству димерных рядов, и концентрация изломов перестанет изменяться.
Однако, как ранее уже упоминалось, существует процесс “выглаживания” и “разрушения” ступеней. Как следствие из полученной немонотонной зависимости количества изломов от температуры с минимумом при 650°С (рис. 2), вероятно, что при низких температурах активнее происходит процесс “выглаживания” ступеней (исчезновение изломов ступеней), а при высоких температурах – “разрушение” ступеней (формирование большого количества изломов ступеней). Вследствие этого получилось, что сначала (до температуры 650°С) концентрация изломов уменьшается с увеличением температуры отжига, а свыше 650°С – увеличивается.
Кроме того, было замечено, что с увеличением температуры отжига увеличивается количество длинных изломов ступеней (рис. 4). С увеличением длины изломов появляется несимметричный выступ ступени (в плоскости террасы): с одной стороны будет длинный излом, с другой – множество коротких изломов так, как это показано на рис. 5. В результате это приводит к увеличению концентрации изломов разной длины.
Для чисто однослойных ступеней поверхности Si(100), которые возникают при малых углах разориентации, конечные температуры приводят к термическому огрублению ступени [20]. Энтропийное отталкивание ступеней возникает из-за того, что ступени не пересекаются друг с другом. Сближение ступеней друг к другу уменьшает извилистость ступени и, таким образом, снижает энтропию ступени. Столкновения ступеней приводят к эффективному энтропийному отталкиванию между ступенями [1]. Это ограничение имеет тенденцию подавлять количество длинных изломов вблизи соседней ступени. В большинстве случаев также присутствуют и другие взаимодействия между ступенями, такие как упругие взаимодействия [21, 22]. Упругое взаимодействие между ступенями оказывается намного сильнее, чем энтропийное отталкивание между ступенями [23].
ЗАКЛЮЧЕНИЕ
Построены зависимости концентрации изломов SB ступеней поверхности Si(100) от температуры и длительности отжига. Показано, что концентрация изломов SB ступеней при температуре отжига 650°С уменьшается со временем и выходит на постоянный уровень. Зависимость концентрации изломов SB ступеней от температуры отжига имеет немонотонный характер с минимумом при 650°С. В результате показано, что равновесная концентрация изломов SB ступеней определяется температурой и длительностью отжига поверхности Si(100).
Список литературы
Swartzentruber B.S., Kitamura N., Lagally M.G., Webb M.B. // Phys. Rev. B. 1993. V. 47. № 20. P. 13 432. https://doi.org/10.1103/PhysRevB.47.13432
Aizaki N., Tatsumi T. // Surf. Sci. 1986. V. 174. P. 658. https://doi.org/10.1016/0039-6028(86)90488-7
Stoyanov S. // Europhys. Lett. 1990. V. 11. № 4. P. 361. https://doi.org/10.1209/0295-5075/11/4/012
Zhao R., Ackerman D.M., Evans J.W. // Phys. Rev. B. 2015. V. 91. № 23. P. 235441. https://doi.org/10.1103/PhysRevB.91.235441
Zhao R., Evans J.W., Oliveira T.J. // Phys. Rev. B. 2016. V. 93. № 16. P. 165411. https://doi.org/10.1103/PhysRevB.93.165411
Wierenga P.E., Kubby J.A., Griffith J.E. // Phys. Rev. Lett. 1987. V. 59. № 19. P. 2169. https://doi.org/10.1103/PhysRevLett.59.2169
Hoeven A.J., Lenssinck J.M., Dijkkamp D., Van Loenen E.J., Dieleman J. // Phys. Rev. Lett. 1989. V. 63. № 17. P. 1830. https://doi.org/10.1103/PhysRevLett.63.1830
Itoh H., Narui S., Zhang Z., Ichonokawa T. // Surf. Sci. Lett. 1992. V. 277. P. L70. https://doi.org/10.1016/0167-2584(92)90136-S
Swartzentruber B.S., Schacht M. // Surf. Sci. 1995. V. 322. № 1–3. P. 83. https://doi.org/10.1016/0039-6028(95)90019-5
Алейнер И.Л., Сурис Р.А. // ФТТ. 1992. Т. 34. Вып. 5. С. 1522.
Hervieu Yu.Yu., Markov I. // Surf. Sci. 2014. V. 628. P. 76. https://doi.org/10.1016/j.susc.2014.05.016
Hervieu Yu. Yu. // Russ. Phys. J. 2020. V. 63. № 6. https://doi.org/10.1007/s11182-020-02116-1
Rodyakina E.E. Sitnikov S.V. Rogilo D.I. Latysheva A.V. // J. Cryst. Growth. 2019. V. 520. P. 85. https://doi.org/10.1016/j.jcrysgro.2019.05.026
Tromp R.M., Hamers R.J., Demuth J.E. // Phys. Rev. Lett. 1985. V. 55. № 12. P. 1303. https://doi.org/10.1103/PhysRevLett.55.1303
Hamers R.J., Tromp R.M., Demuth J.E. // Phys. Rev. B. 1986. V. 34. № 8. P. 5343. https://doi.org/10.1103/PhysRevB.34.5343
Swartzentruber B.S., Mo Y.-W., Kariotis R., Lagally M.G., Webb M.B. // Phys. Rev. Lett. 1990. V. 65. № 15. P. 1913.https://doi.org/10.1103/PhysRevLett.65.1913
Chadi D.J. // Phys. Rev. Lett. 1987. V. 59. № 15. P. 1691. https://doi.org/10.1103/PhysRevLett.59.1691
Poon T.W., Yip S., Ho P.S., Abraham F.F. // Phys. Rev. Lett. 1990. V. 65. № 17. P. 2161. https://doi.org/10.1103/PhysRevLett.65.2161
Markov l.V., Crystal Growth for Beginners: Fundamentals of Nucleation, Crystal Growth, and Epitaxy. New Jersey, London, Singapore, Hong Kong: World Scientific, 2003. P. 546.
Pehlke E., Tersoff J. // Phys. Rev. Lett. 1991. V. 67. № 4. P. 465. https://doi.org/10.1103/PhysRevLett.67.465
Марченко В.И., Паршин А.Я. // ЖЭТФ. 1980. Т. 79. Вып. 1(7). С. 257.
Alerhand O.L., Vanderbilt D., Meade R.D., Joannopoulos J.D. // Phys. Rev. Lett. 1988. V. 61. № 17. P. 1973.https://doi.org/10.1103/PhysRevLett.61.1973
Van Dijken S., Zandvliet H.J.W., Poelsema B. // Phys. Rev. Lett. 1997. V. 55. № 12. P. 7864. https://doi.org/10.1103/PhysRevB.55.7864
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования





