Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2022, № 4, стр. 44-51
Особенности формирования волнообразного рельефа поверхности кремния при облучении фокусированным пучком ионов галлия
М. А. Смирнова a, В. И. Бачурин a, *, Л. А. Мазалецкий a, Д. Э. Пухов a, А. Б. Чурилов a, А. С. Рудый a
a Ярославский филиал Физико-технологического института им. К.А. Валиева РАН
150007 Ярославль, Россия
* E-mail: vibachurin@mail.ru
Поступила в редакцию 14.08.2021
После доработки 15.10.2021
Принята к публикации 20.10.2021
- EDN: SPVMRE
- DOI: 10.31857/S1028096022040161
Аннотация
Исследованы процессы формирования микрорельефа поверхности Si(100) при облучении пучком ионов Ga+ с энергией 30 кэВ дозами D = 6 × 1016–4 × 1018 cм–2 при углах падения θ = 0°–50°. Установлено, что волнообразный рельеф образуется в угловом диапазоне θ = 25°–35° при D = 2 × 1017– 2 × 1018 см–2. Однако хорошо воспроизводимый рельеф наблюдается при углах падения θ = 30° ± 2° начиная с доз облучения 2 × 1017 см–2. С увеличением D от 2 × 1017 до 2 × 1018 см–2 происходит рост длины волны и амплитуды от ~150 до ~400 нм и от ~30 до ~70 нм соответственно. При D > 2 × 1018 см–2 волнообразный рельеф разрушается. Особенностями формирования такого рельефа поверхности Si с помощью ионного пучка Ga+ являются достаточно узкий угловой диапазон, в котором образуется рельеф, и величина дозы облучения, с которой начинается его зарождение. Причинами этих особенностей могут быть преципитаты имплантированного Ga в приповерхностном слое Si и угловые зависимости коэффициента распыления и состава приповерхностного слоя Si, облученного пучком ионов Ga+.
ВВЕДЕНИЕ
Облучение поверхности твердого тела методом ионной бомбардировки приводит к образованию на поверхности различного рода микро- и наноструктур. В зависимости от типа подложки, энергии и сорта ионов существует возможность формирования определенной морфологии поверхности. В последние десятилетия достаточно большой интерес вызывает формирование на поверхности материалов (полупроводников, металлов, диэлектриков) периодических структур нанометрового масштаба, в том числе синусоидального волнообразного рельефа. Этой теме посвящено большое количество работ. В обзорах [1–3] представлены основные результаты, посвященные экспериментальному и теоретическому исследованию формирования волнообразного рельефа поверхности различных материалов, облучаемых ионами инертных и химически активных газов. Экспериментально установлены основные параметры формирующихся структур в зависимости от энергии и типа ионов, угла падения, температуры образцов. В частности, для ионов средних энергий (10–40 кэВ) определен диапазон углов падения ионного пучка, в котором наблюдается образование волнообразного рельефа. Для ионов инертных газов этот диапазон составляет 45°–60°. При использовании химически активных пучков ионов кислорода и азота такой рельеф поверхности кремния формируется при углах падения 30°–60°. В указанном угловом диапазоне наблюдаются значительный рост угловой зависимости коэффициента распыления и резкое уменьшение концентрации имплантированных ионов кислорода и азота в приповерхностном слое [4, 5]. Следует отметить, что пороговые дозы облучения (или глубины кратеров распыления), при которых начинается процесс зарождения волнообразного рельефа, существенно отличаются в случае использования ионных пучков инертных и химически активных газов. Волнообразный рельеф поверхности Si появляется при бомбардировке ионами Ar+ с энергией 20 кэВ на глубине кратера распыления ~44 мкм (D = 6 × 1019 см–2) [6], ионами ${\text{O}}_{2}^{ + }$ с энергией 12.5 кэВ – ~1 мкм [7, 8], ионами ${\text{N}}_{2}^{ + }$ с энергией 9 кэВ – 0.2 мкм [8]. Такие различия объясняются существованием преципитатов оксидов и нитридов кремния [4, 9] в приповерхностном слое при наклонном падении ионных пучков. Гетерогенность приповерхностного слоя приводит к формированию произвольного начального рельефа поверхности вследствие различия скоростей распыления кремния и его соединений, который инициирует возникновение волнообразного рельефа. Низкая растворимость азота в кремнии (~1016 см–3) по сравнению с кислородом приводит к формированию ячеек нитрида кремния практически с самого начала ионной бомбардировки [9]. Это объясняет меньшую на порядок глубину кратеров распыления, соответствующую зарождению волнообразного рельефа под действием ионов азота по сравнению с облучением ионами кислорода. При бомбардировке ионами инертных газов накопленные крупные дефекты могут инициировать появление волнообразного рельефа, что обуславливает необходимость больших доз облучения [6].
В настоящей работе представлены результаты экспериментального изучения процессов формирования микрорельефа поверхности Si при облучении пучком ионов Ga+ с энергией 30 кэВ. Ионы этого типа являются нейтральным по отношению к Si, поскольку они не образуют химических соединений с атомами кремния. Имплантированные ионы Ga присутствуют в приповерхностном слое в виде преципитатов на глубине, сравнимой с проективным пробегом [10, 11]. Такое поведение внедренных ионов отличается от классически нейтральных атомов инертных газов. К настоящему времени имеется незначительное количество работ, посвященных формированию рельефа под действием ионного пучка Ga+ на поверхности Si [12, 13], стекла [14], монокристаллов алмаза [15, 16]. Следует отметить, что фокусированные пучки ионов Ga+ широко применяют для формирования различных наноструктур на поверхности материалов. Используют различные условия облучения (угол падения, доза облучения и другие). А формирование волнообразного рельефа может приводить к изменению скорости распыления при различных отношениях амплитуда/длина волны из-за эффектов затенения [17] и воспроизводимости результатов, особенно при создании структур с высоким соотношением размеров [18].
МЕТОДИКА ПРОВЕДЕНИЯ ЭКСПЕРИМЕНТОВ
Эксперименты по облучению Si(100) пучком ионов Ga+ с энергией 30 кэВ проводили на установке Quanta 3D 200i. Использовали пучки диаметром 4 мкм, 300 и 85 нм со следующими параметрами облучения: процент перекрытия ионного пучка 95% (диаметр пучка 4 мкм) и 50% (300 и 85 нм), время задержки в точке 0.1 мкс, частота сканирования 1000, 70 и 50 Гц, соответственно, тип сканирования для всех диаметров пучка – серпантин. Ток ионного пучка во всех экспериментах составлял I = 5 нА, площадь растров 20 × × 20 мкм2, плотность тока j = 1.25 мА · см–2 (7.8 × × 1015 см–2 · с) по площади растра и до ~90 А · см–2 в точке при использовании пучка диаметром 85 нм. Влияние облучения фокусированным ионным пучком на температуру поверхности Si в области падения ионов было оценено по формулам, предложенным в [19]. Максимальное увеличение температуры в точке падения ионного пучка не превышает 8°С, что практически не влияет на процесс формирования рельефа поверхности [1, 3].
Для исследования топографии при облучении поверхности Si пучком ионов Ga+ было выполнено несколько серий экспериментов. В первой серии углы падения ионного пучка составляли θ = 0°, 25°, 30°, 35°, 40°, 50° при дозах облучения D = 2 × 1017–4 × 1018 см–2. Во второй серии при дозе D = 1018 см–2 образцы бомбардировали при углах падения θ = 0°, 20°, 30°, 40° и 50°. В результате проведенных экспериментов было установлено, что формирование волнообразного рельефа с высокой степенью воспроизводимости наблюдается при углах падения θ = 30° ± 2°. Поэтому в третьей серии были изготовлены растры при фиксированном угле падения ионного пучка θ = 30° и дозах облучения D = 6 × 1016–4 × 1018 см–2.
Топографию поверхности исследовали на установке Quanta 3D 200i (in situ). Более детальное исследование всех образцов проводили ex situ в растровом электронном микроскопе (РЭМ) Supra 40. Энергия электронного пучка составляла 20 кэВ, углы падения 0° и 60°. Изображения формировали в результате детектирования обратно отраженных электронов. Для нескольких растров с волнообразным рельефом на установке Quanta 3D 200i были приготовлены поперечные срезы, которые исследовали затем в РЭМ Supra 40.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
В результате проведенных исследований было установлено, что формирование волнообразного рельефа поверхности Si, бомбардируемой пучком ионов Ga+ с энергией 30 кэВ, можно наблюдать в достаточно узком диапазоне углов падения вблизи θ = 30°. Рельеф поверхности, сформированный в результате облучения, перпендикулярен плоскости падения первичного пучка. Этот результат совпадает с данными [12, 13]. В [12] исследования выполнены только при θ = 30°, а в [13] шаг изменения угла падения составлял 5°. Изучение топографии поверхности в диапазоне углов от 25° до 35° с шагом 1° выявило, что волнообразный рельеф действительно с высокой степенью воспроизводимости наблюдается при θ = 30° ± 2°. Хотя следует отметить, что при использовании пучка диаметром 4 мкм он образовывался в большем угловом диапазоне. На рис. 1 представлены кратеры распыления при углах падения 30°, 35° и 40°. Видно, что при θ = 30° на дне кратера сформирован волнообразный рельеф перпендикулярно плоскости падения ионного пучка. При θ = 35° выделяются две области, в одной из которых волновой вектор рельефа совпадает с направлением пучка, а в другой повернут на некоторый угол. В [13] сообщается о повороте волнового вектора при увеличении дозы облучения, причины которого требуют более детального изучения. При θ = 40° волнообразный рельеф, перпендикулярный направлению ионного пучка, наблюдается только на краях кратера распыления. Расширение углового диапазона, в котором происходит формирование рельефа при использовании ионного пучка диаметром 4 мкм, может быть связано с достаточно широким гало ионного пучка, плотность тока которого подчиняется распределению Гаусса. Угол падения ионов на поверхность, соответствующих хвостовой части распределения, может отличаться от установленного угла падения θ. В [12] приведен волнообразный рельеф вне зоны падения пучка, сформированный под действием ионов, отвечающих хвосту распределения. Длина волны такого рельефа уменьшается от 800 до 50 нм по мере удаления от растра распыления, что авторы [12] связывают с уменьшением плотности тока и, соответственно, дозы облучения области за пределами кратера распыления.
Рис. 1.
РЭМ-изображения кратеров распыления Si при углах падения пучка ионов Ga+: а – 30°; б – 35°; в – 40°. Доза облучения 1018 см–2.
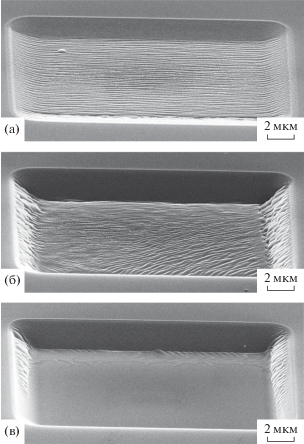
Дальнейшее исследование развития рельефа поверхности Si было выполнено с использованием пучка ионов Ga+ с энергией 30 кэВ диаметром d = 4 мкм при θ = 30°. Выбор размера пучка обусловлен следующими причинами. На рис. 2 приведены изображения волнообразного рельефа, полученные при облучении Si дозой ионов 1018 см–2, диаметр пучка d = 4 мкм, 300 и 85 нм. Видно, что во всех случаях возникают рельефы поверхности с близкими значениями длины волны. Однако повторяемость результатов наилучшая при использовании пучка d = 4 мкм с перекрытием 95%. Практически реализован случай распыления расфокусированным пучком, разворачиваемым в растр аналоговым способом. При облучении пучками с d = 85 и 300 нм степень перекрытия составляла 50%, и воспроизводимость результатов была не совсем удовлетворительная. Как отмечается в [20], использование фокусированных ионных пучков требует дополнительных исследований влияния параметров облучения (степени перекрытия, времени задержки пучка в точке, типа сканирования, частоты сканирования) на процесс формирования структур на поверхности кремния.
Рис. 2.
РЭМ-изображения кратеров распыления Si пучком ионов Ga+ диаметром: а – 4 мкм; б – 300; в – 85 нм. Угол падения ионов 30°, доза облучения 1018 см–2.

На рис. 3 представлены РЭМ-изображения поверхности Si, полученные при различных дозах облучения. Как показано в [10], распыление Si пучком ионов Ga+ с энергией 30 кэВ становится заметным начиная с доз D ~3 × 1016 см–2, и при дозе 6 × 1016 см–2 глубина кратера распыления составляет ~10 нм. При этой дозе облучения поверхность практически гладкая, на которой выделяются капли галлия размером несколько десятков нанометров. Ранее в [10, 11] было показано, что имплантированный Ga в приповерхностном слое существует в виде преципитатов размером ~10 нм, расположенные на глубине 10–20 нм. По-видимому, при D ~6 × 1016 см–2 преципитаты Ga появляются на поверхности и сливаются в более крупные капли (рис. 3а). Известно, что энергия сублимации, которую принимают в качестве энергии связи атомов на поверхности, составляет для Ga и Si 2.82 и 4.70 эВ соответственно. Это может приводить к тому, что из-за разницы коэффициентов распыления Ga и Si на поверхности могут появляться топографические неоднородности. Действительно, при дозах D = = (0.9–1.5) × 1017 см–2 наблюдается неконтрастный непериодический рельеф поверхности в виде холмов и впадин (рис. 3б). Периодический волнообразный рельеф начинает формироваться с дозы D = 2 × 1017 см–2 (рис. 3в). С ростом дозы длина волны рельефа увеличивается. На рис. 4 представлена зависимость длины волны от дозы облучения. При дозах D > 2 × 1018 см–2 происходит разрушение волнообразного рельефа, хотя структура остается периодической со значительно большей длиной волны (рис. 3е, 4).
Рис. 3.
РЭМ-изображения поверхности Si, облученной ионами Ga+ под углом 30° дозами: а – 6 × 1016; б – 1017; в – 2 × 1017; г – 8 × 1017; д – 2 × 1018; е – 4 × 1018 см–2.
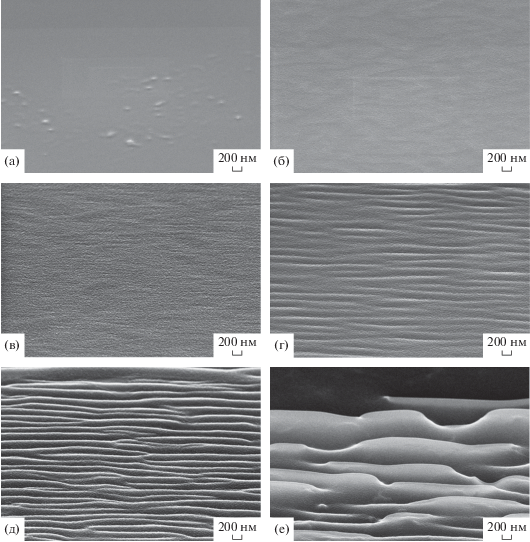
На рис. 5 представлены изображения поперечных срезов растров распыления при дозах облучения D = 4 × 1017 и 2 × 1018 см–2. Видно, что с ростом дозы облучения наблюдается также увеличение амплитуды волнообразного рельефа от ~30 до ~70 нм.
Рис. 5.
РЭМ-изображения поперечного сечения волнообразного рельефа на поверхности Si, облученного пучком ионов Ga+ под углом 30° дозами облучения: а – 4 × 1017; б – 2 × 1018 см–2.
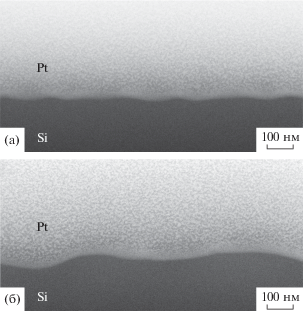
Таким образом, в результате проведенных исследований установлено, что формирование волнообразного рельефа поверхности Si при облучении пучком ионов Ga+ с энергией 30 кэВ происходит в узком диапазоне углов падения θ = 30° ± ± 2° начиная с дозы облучения D = 2 × 1017 см–2. Появлению такого рельефа с увеличением дозы предшествует возникновение на поверхности капель Ga и непериодического рельефа в виде холмов и впадин. Особенностями формирования волнообразного рельефа являются как низкий порог дозы облучения, так и узкий диапазон углов падения ионного пучка.
Как отмечалось выше, волнообразный рельеф поверхности Si при бомбардировке ионами инертных газов с энергией десятки кэВ наблюдается при дозах облучения, близких к 1019 см–2. Имплантированные ионы Ga не образуют химический соединений с атомами Si, т.е. являются “нейтральными”. В отличие от внедренных атомов инертных газов, растворенных в Si, имплантированные ионы Ga в приповерхностном слое Si существуют в виде преципитатов нанометрового масштаба [10, 11]. Это обстоятельство ускоряет процесс формирования волнообразного рельефа. Гетерогенный состав приповерхностного слоя из кремния и его химических соединений при бомбардировке ионами химически активных газов ${\text{O}}_{2}^{ + }$ и ${\text{N}}_{2}^{ + }$ позволяет на порядки снизить пороговую дозу облучения по сравнению с ионами инертных газов [4, 5] из-за различия коэффициентов распыления Si и оксидов или нитридов Si. Следует отметить, что в последнее время появилось достаточно большое количество работ, в которых рассматриваются процессы формирования рельефа поверхности различных материалов, в том числе Si, при одновременном распылении ионами инертных газов и осаждении атомов металлов [21–24] и бомбардировке ионами металлов [25]. Интересными представляются результаты и выводы [23], где рассмотрены процессы формирования рельефа на поверхности Si при облучении ионами Kr+ с энергией 2 кэВ с одновременным осаждением распыленных атомов ряда металлов, как образующих, так и не образующих силициды. Было установлено, что волнообразный рельеф поверхности Si появляется лишь в случае осаждения металлов, образующих силициды. По мнению авторов, [22, 23], существование силицидов металлов в приповерхностном слое является одним из необходимых условий формирования волнообразного рельефа. Большая скорость распыления Si по сравнению с силицидами металлов приводит к появлению топографических неоднородностей на поверхности, инициирующих появление такого рельефа. К такому же выводу приходят авторы [25].
Влияние топографических неоднородностей на процесс формирования волнообразного рельефа изучали в нескольких работах, как экспериментальных, так и теоретических. В [26] показано, что наличие островков Au на поверхности Si приводит практически к мгновенному формированию волнообразного рельефа на поверхности Si при бомбардировке ионами ${\text{N}}_{2}^{ + }$ с такой же длиной волны, как и при облучении гладкой поверхности Si после достижения критической дозы. В [27] продемонстрировано, что создание на поверхности Si топографических неоднородностей путем химической обработки приводит к уменьшению на два порядка критической дозы облучения ионами ${\text{O}}_{2}^{ + }$ с энергией 16.7 кэВ. Как известно, одна из первых моделей, объясняющих формирование волнообразного рельефа [28], предполагает зависимость коэффициентов уравнения от локального угла падения. Однако причины появления исходной топографии поверхности, приводящей к изменению локального угла падения, не рассматриваются. Позднее в [29] была предложена нелинейная модель формирования волнообразного рельефа, в уравнение которой был введен член η(x, y, t), учитывающий стохастический характер плотности тока падающих ионов. С практической точки зрения учет этого слагаемого представляется довольно затруднительным. Поэтому в [30] было предложено заменить его при моделировании формирования волнообразного рельефа произвольным начальным рельефом. Этот подход привел авторов к результатам моделирования структур при нормальном падении пучка, достаточно хорошо совпадающих с экспериментальными результатами. В [31] в рамках пространственно-нелокальной модели эрозии поверхности при ионной бомбардировке, основанной на зависимости локального коэффициента распыления и поверхностной диффузии, показано, что присутствие на поверхности неоднородности в виде ступеньки нанометрового масштаба приводит к формированию волнообразного рельефа.
Рассмотренные выше детали формирования волнообразного рельефа позволяют объяснить причину низкого значения критической дозы облучения. При дозе облучения D = 6 × 1016 см–2 преципитаты Ga оказываются на поверхности в виде капель. Различие скоростей распыления Si и Ga приводит к формированию топографических неоднородностей в виде холмов и впадин, которая впоследствии инициирует формирование волнообразного рельефа.
Достаточно узкий диапазон углов падения пучка ионов Ga+, бомбардировка в котором приводит к появлению волнообразного рельефа, связана с угловыми зависимостями коэффициента распыления пучком ионов Ga+ и состава приповерхностного слоя Si (рис. 6) [32]. Видно, что при θ > 20° наблюдается резкое снижение концентрации Ga как на поверхности Si, так и ее интегральное значение в приповерхностном слое. Поэтому при θ > 40° содержания Ga на поверхности недостаточно для создания исходных для инициирования волнообразного рельефа топографических неоднородностей. Возможно, что формирование рельефа может наблюдаться и при больших углах падения ионного пучка, но при значительно больших дозах. При θ < 30° наблюдается слабое изменение угловой зависимости коэффициента распыления, которое не позволяет в значительной степени обеспечить изменение локального угла падения на склоны формируемого рельефа.
Рис. 6.
Угловые зависимости нормированного коэффициента распыления и концентрации Ga на поверхности Si по данным [32]. Концентрация Ga на поверхности Si определена методом растровой электронной оже-спектроскопии.
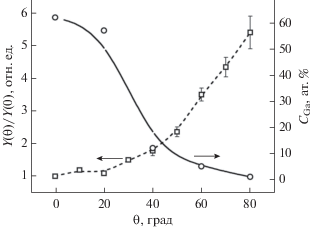
ЗАКЛЮЧЕНИЕ
В работе исследованы процессы формирования микрорельефа поверхности Si (100) при облучении пучком ионов Ga+ с энергией 30 кэВ дозами D = 6 × 1016–4 × 1018 cм–2 при углах падения θ = = 0°–50°.
Установлено, что хорошо воспроизводимый волнообразный рельеф поверхности Si формируется в узком диапазоне углов падения θ = 30° ± 2° начиная с дозы облучения D = 2 × 1017 см–2. С увеличением D до 2 × 1018 см–2 происходит рост длины волны и амплитуды от ~150 до ~400 нм и от ~30 до ~70 нм соответственно. При D > 2 × × 1018 см–2 волнообразный рельеф разрушается. Возникновению такого рельефа предшествует появление капель Ga на поверхности при D = 6 × × 1016 см–2 и непериодического рельефа в виде холмов и впадин вплоть до формирования волнообразного рельефа при D = 2 × 1017 см–2.
Особенностями формирования волнообразного рельефа поверхности Si под действием пучка ионов Ga+ являются достаточно узкий угловой диапазон и пороговая доза облучения. Причинами этих особенностей могут быть преципитаты имплантированного Ga в приповерхностном слое Si и угловые зависимости коэффициента распыления и состава приповерхностного слоя Si, облученного ионным пучком.
Список литературы
Makeev M.A., Cuerno R., Barbasi A. // Nucl. Instrum. Methods Phys. Res. B. 2002. V. 197. P. 185. https://doi.org/10.1016/S0168-583X(02)01436-2
Valbusa U., Borgano C., Mongeot F. // J. Phys.: Condens. Matter. 2002. V. 14. P. 8153. https://doi.org/10.1088/0953-8984/14/35/301
Munoz-Garcia J., Vazquez L., Castro M. et al. // Mater. Sci. Eng. R. 2014. V. 86. P. 1. https://doi.org/10.1016/j.mser.2014.09.001
Wittmaack K. // Surf. Interf. Anal. 2000. V. 29. P. 721. https://doi.org/10.1002/1096-9918(200010)29:10%3C721: :AID-SIA916%3E3.0.CO;2-Q
Bachurin V.I., Lepshin P.A., Smirnov V.K. // Vacuum. 2000. V. 56. P. 241. https://doi.org/10.1016/S0042-207X(99)00194-3
Carter G., Vishnyakov V. // Surf. Interf. Anal. 1995. V. 23. P. 514. https://doi.org/10.1002/sia.740230711
Elst K., Vandervorst W. // J. Vac. Sci. Technol. A. 1994. V. 12. P. 3205. https://doi.org/10.1116/1.579239
Smirnov V.K., Kibalov D.S., Krivelevich S.A. et al. // Nucl. Instrum. Methods Phys. Res. B. 1999. V. 147. P. 310. https://doi.org/10.1016/S0168-583X(98)00610-7
Бачурин В.И., Лепшин П.А., Смирнов В.К., Чурилов А.Б. // Изв. РАН. Сер. физ. 1998. Т. 62. С. 703.
Frey L., Lehrer C., Ryssel H. // Appl. Phys. A. 2003. V. 76. P. 1017. https://doi.org/10.1007/s00339-002-1943-1
Rommel M., Spoldi G., YanevV. et al. // J. Vac. Sci. Technol. B. 2010. V. 28. P. 595. https://doi.org/10.1116/1.3431085
Habenicht S., Lieb K.P., Koch J., Wieck A.D. // Phys. Rev. B. 2002. V. 65. P. 115327. https://doi.org/10.1103/PhysRevB.65.115327
Qian H.X., Znou W. // Mater. Lett. 2012. V. 77. P. 113. https://doi.org/10.1016/j.matlet.2012.03.003
Gnaser H., Reuscher B., Zeuner A. // Nucl. Instrum. Methods Phys. Res. B. 2012. V. 285. P. 142. https://doi.org/10.1016/j.nimb.2012.05.028
Datta F., Yuh-Renn Wu., Wang Y.L. // Phys. Rev. D. 2001. V. 63. P. 125407. https://doi.org/10.1103/PhysRevB.63.125407
Adams D.P., Vasile M.J., Mayer T.M., Hodges V.C. // J. Vac. Sci. Technol. B. 2003. V. 21. P. 2334. https://doi.org/10.1116/1.1619421
Carter G. // J. Appl. Phys. 1999. V. 83. P. 455. https://doi.org/10.1063/1.369408
MoberlyChan W. // MRS Proceed. 2006. V. 960. P. 0960-N10-02-LL06-02. https://doi.org/10.1557/PROC-0960-N10-02-LL06-02
Meingails J. // J. Vac. Sci. Technol. B. 1987. V. 5. P. 469. https://doi.org/10.1116/1.583937
Kots I.N., Kolomiitsev A.S., Lisitsyn S.A. et al. // Russ. Microelectron. 2019. V. 48. № 2. P. 72. https://doi.org/10.1134/S1063739719020057
Masko S., Frost F., Ziberi B. et al. // Nanotechnol. 2010. V. 21. P. 085301. https://doi.org/10.1088/0957-4484/21/8/085301
Zhang K., Bobes O., Hofsass H. // Nanotechnol. 2014. V. 25. P. 085301. https://doi.org/10.1088/0957-4484/25/8/085301
Engler M., Frost F., Muller S. et al. // Nanotechnnol. 2014. V. 25. P. 115303. https://doi.org/10.1088/0957-4484/25/11/115303
Liu Y., Hirsch D., Fechner R. et al. // Appl. Phys. A. 2018. V. 124. P. 73. https://doi.org/10.1007/s00339-017-1393-4
Redondo-Cubero A., Lorenz K., Palomares F.J. et al. // J. Phys.: Condens. Matter. 2018. V. 30. P. 274001. https://doi.org/10.1088/1361-648X/aac79a
Смирнов В.К., Кибалов Д.С., Лепшин П.А., Бачурин В.И. // Изв. РАН. Сер. физ. 2000. Т. 64. С. 626.
Karmakar P., Mollick S.A., Ghose D., Chakrabarti A. // Appl. Phys. Lett. 2008. V. 93. P. 103102. https://doi.org/10.1063/1.2974086
Bradley R.M., Harper M.E. // J. Vac. Sci. Technol. A. 1988. V. 6. P. 2390. https://doi.org/10.1116/1.575561
Cuerno R., Barbasi A.I. // Phys. Rev. Lett. 1995. V. 74. P. 4746. https://doi.org/10.1103/PhysRevLett.74.4746
Kahng B., Jeong H., Barbasi A.I. // Appl. Phys. Lett. 2001. V. 78. P. 805. https://doi.org/10.1063/1.1343468
Рудый А.С., Бачурин В.И. // Изв. РАН. Сер. физ. 2008. Т. 72. № 5. С. 622.
Bachurin V.I., Zhuravlev I.V., Pukhov D.E. et al. // J. Surf. Invest.: X-Ray, Synchrotron Neutron Tech. 2020. V. 14. № 4. P. 784. https://doi.org/10.1134/S1027451020040229
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



