Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2022, № 6, стр. 96-102
Исследование мемристоров на основе пленок оксида кремния, имплантированных цинком
В. В. Привезенцев a, *, **, В. С. Куликаускас b, В. В. Затекин b, Д. А. Киселев c, М. И. Воронова c
a Федеральный научный центр “Научно-исследовательский институт системных исследований РАН”
117218 Moсква, Россия
b Московский государственный университет им. М.В. Ломоносова, НИИЯФ им. Д.В. Скобельцына
119991 Москва, Россия
c Национальный исследовательский технологический университет “МИСиС”
119049 Москва, Россия
* E-mail: privezentsev@niisi.ras.ru
** E-mail: privezentsev@mail.ru
Поступила в редакцию 28.08.2021
После доработки 25.10.2021
Принята к публикации 30.10.2021
- EDN: ECYRAP
- DOI: 10.31857/S1028096022060140
Аннотация
Нанокластеры металлов и металлооксидных соединений в различных твердотельных матрицах могут найти применение в перспективных устройствах микроэлектроники. Представлены результаты исследования мемристоров на основе пленок оксида кремния, имплантированных ионами цинка 64Zn+ (доза 3× 1016 cм–2, энергия 40 кэВ) при комнатной температуре и отожженных при температурах 400–800°С в окислительной среде. Профили концентрации имплантированного цинка, а также элементов матрицы – кремния и кислорода – получены с использованием спектроскопии резерфордовского обратного рассеяния ионов He+ с энергией 2 MэВ. Топологию поверхности исследовали с помощью сканирующего зондового микроскопа в режиме атомно-силовой микроскопии и кельвин-моде. После имплантации происходит сглаживание поверхности образца из-за распыления. Далее в процессе термических отжигов шероховатость поверхности увеличивается, и наблюдается уширение распределения шероховатости по сравнению с имплантированным образцом. Полученные в кельвин-моде изображения поверхностного потенциала различаются знаком сигнала – положительным для исходного образца и отрицательным для отожженного при 800°С. Фазовый состав пленок изучали с помощью рентгенодифракционного анализа в скользящей геометрии. Установлено, что после имплантации в пленке SiО2 образуются кристаллические фазы Zn. После отжига при 800°С фаза Zn частично превращается в фазу ZnO и в основном в фазу силицида цинка (виллемита) Zn2SiO4. Анализ мелких пиков на дифрактограммах, выполненный в программе EVA, указывает, что в образцах образуются фазы β-Zn2SiO4 и Zn1.95SiO4.
ВВЕДЕНИЕ
Свойства нанокластеров металлов и их оксидов широко исследуют в настоящее время ввиду их возможного применения в будущих микроэлектронных устройствах [1]. В частности, нанокластеры оксида цинка имеют важное значение, поскольку ZnO является прямозонным материалом с шириной запрещенной зоны 3.37 эВ, имеет большую энергию связи электрона и дырки в экситоне 60 МэВ [2]. Это позволяет использовать их в источниках УФ-света [3], электролюминесцентных дисплеях [4] и солнечных батареях [5]. Поскольку оксид цинка без дополнительных примесей в форме нанокластеров обладает ферромагнетизмом уже при комнатной температуре [6], его можно использовать в приборах спинтроники [7]. Сорбционный эффект, свойственный этому материалу, позволяет строить на его основе различные химические сорбционные датчики [8], а также применять его в медицине [9] и биологии [10]. В последнее время в научной литературе появились сообщения, что тонкие пленки из аморфного SiOx, легированного Zn, являются перспективными материалами для устройств энергонезависимой памяти ReRAM (ReRAM-Resistive Random-Access Memory, резистивная память с произвольным доступом), поскольку они могут проявлять свойственные мемристорам вольт-амперные характеристики в зависимости от концентрации нанокластеров Zn или ZnOx. Причиной такого поведения может быть наличие в легированном оксиде кремния нанокластеров Zn или ZnOx, т.е., вообще говоря, скоплений нанокластеров дефектов или фаз, содержащих Zn [11]. Такие пленки могут быть перспективны в микроэлектронике, поскольку их технология совместима с КМОП-технологией (КМОП – комплементарная структура металл–оксид–полупроводник) [12].
Нанокластеры ZnO в кварце или в пленке SiO2 могут быть получены путем термической обработки в окислительной атмосфере образцов, предварительно легированных цинком и содержащих нанокластеры Zn. Эти нанокластеры могут быть созданы, в частности, методом имплантации ионов Zn, так его считают одним из самых чистых и гибких технологических методов. Известны попытки сформировать такие нанокластеры с контролируемыми размерами и формой в кварцевом стекле [13–16] и пленке SiO2 [17–19] путем имплантации Zn и термического отжига в окислительной атмосфере. Поэтому становится очень важным процесс формирования нанокластеров Zn и ZnO высокого качества, внедренных в микроэлектронные пленки типа SiO2 для дальнейшего промышленного применения.
В работе представлены результаты исследования пленок оксида кремния, имплантированных цинком, с последующим отжигом на воздухе при повышенных температурах, которые могут в дальнейшем применяться в мемристорах.
МАТЕРИАЛЫ И МЕТОДЫ
Сначала на кварцевой подложке толщиной 1 мм был сформирован слой нижнего электрода из Au толщиной 64 нм путем электронно-лучевого напыления в вакууме. Затем тем же самым методом была напылена рабочая (активная) область мемристора из оксида кремния толщиной 120 нм. После этого с помощью имплантера Varian-Extrion 200–1000 в эту пленку были внедрены ионы цинка 64Zn+. Параметры имплантации выбирали следующим образом: для ионов Zn+ энергия была 40 кэВ и доза имплантации 3.0 × 1016 cм–2. Следует отметить, что плотность ионного тока не превышала 0.55 мкА/см2, чтобы перегрев пластин по сравнению с комнатной температурой не превышал 70°С. Согласно расчету по программе SRIM [20] для выбранной энергии имплантации ионов Zn их проекционный пробег в пленке SiO2 составлял 30 нм при размытии 10 нм. После имплантации образцы размером 10 × 10 мм были последовательно подвержены изохронному отжигу в течение 1 ч на воздухе в диапазоне температур от 400 до 800°С с шагом 100°С. Эволюция профилей концентрации имплантированного Zn, а также профилей концентрации элементов матрицы оксида кремния в процессе отжига была исследована методом спектроскопии резерфордовского обратного рассеяния (РОР), были использованы ионы He+ с энергией 2 МэВ.
Морфологию поверхности и карты распределения поверхностного потенциала исследовали при комнатной температуре в сканирующем зондовом микроскопе Ntegra Prima в режиме атомно-силовой микроскопии (АСМ) (NT-MDT SI, Россия) с применением кантилевера марки NSG30/Pt (TipsNano, Эстония) с жесткостью 35 Н/м и резонансной частотой свободных колебаний 320 кГц. Обработку полученных АСМ-изображений осуществляли с помощью программы Gwyddion [21]. Фазовый состав образцов исследовали с использованием рентгеновского дифрактометра DISCOVERY D8 (Bruker) (СuKα-излучение, λ = 1.54 Å) в скользящей геометрии – угол падения рентгеновских лучей на поверхность образца составлял 0.3°.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
РОР-исследования
На рис. 1 представлен экспериментальный спектр РОР после имплантации цинка. На нем хорошо видны пики, относящиеся к имплантированному Zn и к ныпыленному слою Au. Также в спектре РОР хорошо различимы “ступеньки”, относящиеся к элементам матрицы кварца, и пики кремния и кислорода из пленки оксида кремния. На рис. 2 показан модельный спектр РОР для исследованной конструкции мемристора. Он соответствует экспериментальному спектру на рис. 1.
На рис. 3 изображен экспериментальный спектр РОР кварца (технологический спутник), имплантированного Zn c той же энергией и дозой, что и при изготовлении мемристора. Этот спектр отличается от спектра исследованной структуры мемристора (рис. 1). Слой золота (64 нм, нижний электрод), находящийся под имплантированной цинком пленкой SiO2 (толщиной 120 нм) в мемристоре, вносит свои коррективы в обычный для таких случаев спектр РОР монолитного однородного кварца, имплантированного цинком (рис. 3). А именно, в “ступеньках”, соответствующих кремнию и кислороду, появляются провалы (рис. 1).
На рис. 4 представлены модельные профили концентрации имплантированного цинка, а, также кремния и кислорода в пленке оксида кремния, рассчитанные по программе SIMNRA [22]. Анализ кривых показывает, что в имплантированном состоянии профиль концентрации примеси Zn симметричный и имеет форму распределения Гаусса.
На рис. 5 показаны экспериментальные спектры РОР зоны цинка при изменении температуры отжига от 400 до 800°С с шагом 200°С. После отжига при низких температурах (400–600°С) профиль концентрации цинка слабо изменяется. Как хорошо известно, имплантированные атомы Zn очень подвижны в SiO2 при высоких температурах (700°C и выше). При этих температурах они движутся к поверхности образца, которая является для них неограниченным стоком. Отсюда становится ясным поведение профилей концентрации цинка в спектрах РОР на рис. 5. Поэтому теперь при 800°С профиль концентрации имплантированного Zn не симметричный. Он частично смещается в область малых номеров каналов (вглубь пленки SiO2) и в основном перемещается в область больших номером каналов (к поверхности пленки SiO2).
Сканирующая зондовая микроскопия
На рис. 6 представлены изображения поверхности исходного образца после имплантации Zn (рис. 6а) и после отжига при температуре 800°С (рис. 6б). Как видно из рис. 6а, поверхность пленки оксида кремния после имплантации достаточно однородная и характеризуется следующими статистическими параметрами шероховатости: Rms = 0.63 нм, Ra = 0.38 нм. Однако на поверхности различаются отдельные частицы высотой до 4 нм и диаметром до 500 нм. Установлено, что отжиг при 800°С приводит к увеличению параметров шероховатости поверхности в три раза по сравнению с исходным образцом после имплантации Zn: Rms = 1.94 нм, Ra = 0.95 нм. Этот эффект может быть следствием формирования после имплантации в приповерхностном слое оксида кремния и последующим ростом при окислении при повышенных температурах нанокластеров фазы металлического Zn, оксида цинка ZnO и, наконец, фаз силицида цинка Zn2SiO4 с разной степенью его окисления (в частности, β-Zn2SiO4 и Zn1.95SiO4).
Рис. 6.
Изображения поверхности образца: а – после имплантации в АСМ-моде, Rms = 0.63 нм, Ra = 0.38 нм; б – после отжига при 700°С, Rms = 1.94 нм, Ra = 0.95 нм.
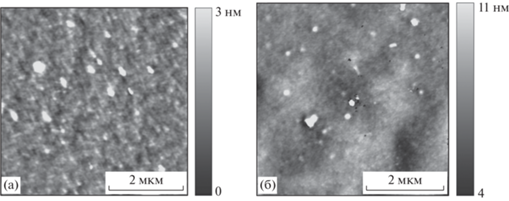
Гистограммы распределения высот неровностей для исходного образца (рис. 7, кривая 1) и после отжига при 800°С (рис. 7, кривая 2) также подтверждают вышесказанное утверждение об увеличении степени шероховатости поверхности в процессе термического отжига: для отожженного образца характерно смещение гистограммы в область более высоких значений и значительное уширение распределения по сравнению с исходным образцом. Очевидна разница и в значениях стандартного отклонения (σ) распределений высот неровностей: в исходном образце σ = 0.36, а в отожженном образце σ = 0.95.
Рис. 7.
График распределения высот неровностей для исследуемого образца: 1 – после имплантации; 2 – после отжига при 800°C.

В кельвин-моде получены изображения поверхностного потенциала (рис. 8). Обращает на себя внимание разный знак сигнала в случае исходного образца и отожженного при 800°С (шкала Z на рис. 8а, 8б). Положительные значения поверхностного потенциала в случае образца после имплантации положительными ионами 64Zn+, по всей видимости, обусловлены преобладанием положительного диполя в этом состоянии. Поскольку эксперименты проводились на воздухе, то поверхностный потенциал частично обусловлен также экранирующим зарядом, возникающим из-за внутреннего заряда диэлектрического образца, и зарядами, абсорбируемыми из окружающей среды [23]. В случае образца, отожженного при 800°С, сигнал поверхностного потенциала принимает отрицательные значения.
Рис. 8.
Изображение поверхностного потенциала образца, полученное в кельвин-моде, после имплантации (а) и после отжига при 800°С (б).
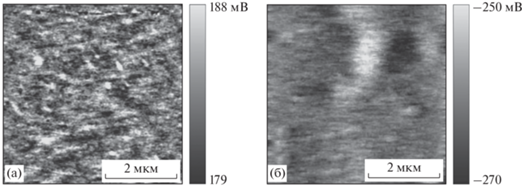
Гистограммы распределения сигнала поверхностного потенциала для двух образцов, построенные по полученным изображениям (рис. 9), представляют собой довольно “узкие” распределения Гаусса – полная ширина на половине высоты равна 5.0 мВ в случае исходного образца и 5.8 мВ в случае отожженного образца.
Рентгенофазовый анализ
На рис. 10 показаны рентгеновские дифрактограммы в скользящей геометрии образца после имплантации (кривая 1) и после отжига при 800°С (кривая 2). Для наглядности кривые смещены по оси ординат. На дифрактограммах наблюдается гало при малых углах 2θ (20°–30°), которое является результатом рассеяния на аморфном слое SiO2. На кривой 1 (после имплантации Zn) присутствуют пики, относящиеся к кристаллическим фазам Au (нижнего электрода) при 38°, 44.4° и 64.5° и виллемита Zn2SiO4$33\bar {3}$ при 48.9°. На дифрактограмме 2 (после отжига при 800°С) к упомянутым выше пикам Au добавляются еще пики виллемита Zn2SiO4 223 при 38.8°, 333 при 48.9°, 713 при 65.6° и близкий к нему пик 226 при 66.8°. На дифрактограммах образца после отжига при 800°С зафиксированы пики кристаллического оксида меди CuO при углах 35.5°, 38.8°, 48.7°, 58.2° и 61.5°. Медь является примесью к золоту, увеличивающая его твердость, поэтому при отжиге она может диффундировать из золотого электрода с образованием кристаллитов. Фазовый анализ, выполненный по программе EVA [24], указывает, что остальные отдельные мелкие пики на дифрактограммах, вероятнее всего, принадлежат фазам виллемита с разной степенью окисления цинка – β-Zn2SiO4 и Zn1.95SiO4. Также, возможно, что появление слабых пиков на дифрактограмме образца после отжига при 800°С в окислительной среде связано с частичной перекристаллизацией аморфного оксида кремния.
ВЫВОДЫ
Ионы 64Zn+ с энергией 40 кэВ (доза 3.0 × × 1016 cм–2) были имплантированы в пленку SiO2 (верхний слой мемристора), их проекционные пробеги в SiO2 составляли 30 нм c размытием 10 нм. После имплантации образцы подвергали изохронному отжигу в течение 1 ч на воздухе в диапазоне температур 400–800°C. Из анализа спектров РОР следует, что после отжига при низкой температуре (ниже 600°С) пик концентрации Zn незначительно уменьшился и слегка переместился в глубину подложки. При высоких температурах отжига (700°С и выше) имплантированные атомы Zn движутся к поверхности образца. Профиль концентрации имплантированного Zn становится несимметричным, поскольку образуется небольшой второй максимум концентрации атомов Zn вблизи поверхности. Из АСМ-исследований следует, что в процессе отжига увеличивается шероховатость поверхности и значительное уширяется ее распределение по сравнению с имплантированным образцом. В кельвин-моде получены изображения поверхностного потенциала. Обнаружена разница в знаке поверхностного потенциала в случае исходного образца и образца, отожженного при 800°С. Рентгеновские исследования в скользящей геометрии выявили фазу металлического Au как после имплантации Zn, так и после отжига. Zn после имплантации находится в металлическом нейтральном состоянии. После отжига на воздухе при температуре 800°С обнаружены фазы ZnO, виллемита Zn2SiO4, а также мелкие пики, относящиеся к фазам силицида цинка, а именно β-Zn2SiO4 и Zn1.95SiO4.
Список литературы
Baraton M.I. Synthesis, Functionalization, and Surface Treatment of Nanoparticles. Am. Sci., Los-Angeles, 2002.
Litton C.W., Collins T.C., Reynolds D.S. Zinc Oxide Material for Electronic and Optoelectronic Device Application. Chichester: Wiley, 2011.
Flytzanis C., Haqche F., Klein M.C., Ricard D., Roussignol Ph. // Prog. Optics. 1991. V. 291. P. 321.
Jiang C.Y., Sun X.W., Lo G.Q., Kwong D.L., Wang J.X. // Appl. Phys. Lett. 2007. V. 90. P. 263501.
Smestad G.P., Gratzel M. // J. Chem. Educ. 1998. V. 75. P. 752.
Li C., Yang Y., Sun X.W., Lei W., Zhang X.B., Wang B.P., Wang J.X., Tay B.K., Ye J.D., Lo G.Q., Kwong D.L. // Nanotechnology. 2007. V. 18. P. 135604.
Straumal B.B., Mazilkin A.A., Protasova S.G. et al. // Phys. Rev. B. 2009. V. 79. P. 205206.
Chu S., Olmedo M., Yang Zh. et al. // Appl. Phys. Lett. 2008. V. 93. P. 181106.
Dodds J.S., Meyers F.N., Loh K.J. // Smart Structures and Systems. 2013. V. 12. P. 055.
Sirelkhatim A., Mahmud S., Seeni A. et al. // Nano-Micro Lett. 2015. V. 7. P. 219.
Inbasekaran S., Senthil R., Ramamurthy G., Sastry T.P. // Int. J. Innov. Res. Sci. Engin. Technol. 2014. V. 3. P. 8601.
Chang K.-C., Tsai T.-M., Zhang R. et al. // Appl. Phys. Lett. 2013. V. 103. P. 083509.
Huang J.-S., Yen W.-C., Lin S.-M. et al. // J. Mater. Chem. C. 2014. V. 2. P. 4401.
Amekura H., Takeda Y., Kishimoto N. // Mater. Lett. 2011. V. 222. P. 96.
Shen Y.Y., Zhang X.D., Zhang D.C., Xue Y.H., Zhang L.H., Liu C.L. // Mater. Lett. 2011. V. 65. P. 2966.
Privezentsev V., Kulikauskas V., Steinman E., Bazhenov A. // Phys. Stat. Sol. C. 2013. V. 10. P. 48.
Privezentsev V.V., Palagushkin A.N., Skuratov V.A., Kulikauskas V.S., Zatekin V.V., Makunin A.V., Kiselev D.A., Steinman E.A., Tereshchenko A.N. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2019. V. 13. № 2. P. 326.
Khramov E.V., Privezentsev V.V., Palagushkin A.N., Shchebachev K.D., Tabachkova N.Yu. // J. Electron. Mater. 2020. V. 49. P. 7343. https://doi.org/10.1007/s11664-020-08454-7
Privezentsev V.V., Sergeev A.P., Kirilenko E.P., Goryachev A.V., Zilova O.S., Burmistrov A.A., Batrakov A.A. // J. Mater. Sci.: Mater. Electron. 2021. V. 32. P. 4581.
Ziegler J.F., Biersack J.P. SRIM 2008 (http:// www.srim.org).
http://gwyddion.net
http://www.simnra.com
Kalinin S.V., Bonnell D.A. // Nano Lett. 2004. V. 4. P. 555.
DIFFRAC.EVA Bruker (https://www.bruker.com)
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования









