Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2023, № 1, стр. 55-60
Изменение зарядового состояния МОП-структур с радиационно-индуцированным зарядом при сильнополевой инжекции электронов
Д. В. Андреев a, Г. Г. Бондаренко b, В. В. Андреев a, *
a Московский государственный технический университет им. Н.Э. Баумана, Калужский филиал
248000 Калуга, Россия
b Национальный исследовательский университет “Высшая школа экономики”
101000 Москва, Россия
* E-mail: vladimir_andreev@bmstu.ru
Поступила в редакцию 29.06.2022
После доработки 15.07.2022
Принята к публикации 15.07.2022
- EDN: BKNMNM
- DOI: 10.31857/S1028096023010053
Аннотация
Изучено влияние режимов сильнополевой инжекции электронов на зарядовое состояние и дефектность МОП-структуры (металл–оксид–полупроводник) после радиационного облучения. Показано, что для стирания радиационно-индуцированного положительного заряда, накапливаемого в пленке SiO2 МОП-структур, необходимо использовать сильнополевую туннельную инжекцию электронов по Фаулеру–Нордгейму при электрических полях, не вызывающих генерацию дырок. Установлено, что стирание радиационно-индуцированного положительного заряда в пленке SiO2 МОП-структур и генерация новых поверхностных состояний в основном определяются величиной заряда, инжектированного в диэлектрик. Установлено, что при аннигиляции захваченных в SiO2 дырок в результате взаимодействия с инжектированными электронами наблюдается существенное увеличение количества поверхностных состояний, значительно превышающих количество поверхностных состояний, возникающих при отжиге радиационно-индуцированного заряда при комнатной температуре. Предложена модель, описывающая процесс аннигиляции радиационно-индуцированного положительного заряда при взаимодействии с инжектированными электронами.
ВВЕДЕНИЕ
Одним из основных последствий радиационного облучения МОП-приборов (МОП – металл–оксид–полупроводник), влияющих на их работоспособность и определяющих их надежность, является изменение зарядового состояния диэлектрика и границы раздела, сопровождающееся структурными изменениями материалов [1–7]. На изменении зарядового состояния подзатворного диэлектрика при радиационных воздействиях основана работа сенсоров RadFET (Radiation sensing Field Effect Transistor), пороговое напряжение которых обычно пропорционально поглощенной дозе [8–14]. Явления, протекающие после облучения в этих МОП-приборах, привлекают к себе большое внимание в течение последних нескольких десятилетий, поскольку изменение зарядового состояния оксида затвора и эволюция дефектов как в диэлектрической пленке, так и на границе раздела Si–SiO2 после облучения очень важны для эксплуатации МОП-приборов и сенсоров [8–10]. Совместное воздействие радиационного излучения и сильных электрических полей, а также послерадиационная сильнополевая инжекция носителей заряда в подзатворный диэлектрик может оказывать существенное влияние на протекающие в МОП-структурах зарядовые процессы. Использование режимов сильнополевой инжекции носителей заряда в подзатворный диэлектрик может существенно расширить возможности МОП-сенсоров радиационных излучений, повысив их дозовую чувствительность и позволяя контролировать интенсивность излучения по измерению ионизационного тока в подзатворном диэлектрике [15–18]. В [11, 19, 20] было показано, что использование сильнополевой туннельной инжекции электронов по Фаулеру–Нордгейму после радиационного облучения позволяет стирать большую часть радиационно-индуцированного положительного заряда, и в результате появляется возможность повторного использования сенсоров RADFET. Однако радиационное облучение и сильнополевая инжекция носителей заряда в подзатворный диэлектрик, особенно при совместном воздействии, могут существенно ускорять возникновение дефектов и деградацию МОП-приборов и сенсоров. Следовательно, крайне важно определить ограничения на радиационные и сильнополевые воздействия, позволяющие корректно эксплуатировать МОП-приборы, в том числе при совместном или поочередном радиационном и сильнополевом воздействии.
В настоящей работе изучено влияние режимов сильнополевой инжекции электронов по Фаулеру–Нордгейму на стирание радиационно-индуцированного положительного заряда и эволюцию зарядового состояния и дефектов в тонких термических пленках диоксида кремния МОП-приборов.
ОБРАЗЦЫ И МЕТОДЫ
В качестве исследуемых образцов использовали МОП-структуры, изготовленные на кремнии n-типа с термическими пленками SiO2 толщиной 100 нм и алюминиевым затвором [15, 16]. Диоксид кремния толщиной 100 нм получали термическим окислением кремния в атмосфере кислорода при температуре 1000°C с добавлением 3% HCl. Верхние электроды формировали с использованием фотолитографии по алюминиевой пленке, напыленной магнетронным методом. После формирования Al-электродов проводили отжиг в среде азота при температуре 475°С. Такие МОП-структуры были изготовлены промышленным способом и совместимы с технологией изготовления интегральных микросхем серии CD4000. Данная технология также используется для изготовления сенсоров RADFET [12].
Сильнополевую туннельную инжекцию электронов проводили в режиме протекания постоянного тока при положительной полярности металлического электрода с использованием экспериментальной установки, реализованной с использованием прецизионного генератора/измерителя тока/напряжения PXIe-4135, являющегося модулем серии PXI от National Instruments. Основным параметром, характеризующим изменение зарядового состояния диэлектрической пленки МОП-структуры, был сдвиг напряжения на образце во время инжекции (VI), определяемый при постоянной величине инжекционного тока, протекающего через подзатворный диэлектрик [21, 22]. Для получения дополнительной информации об изменении зарядового состояния МОП-структур применяли метод C–V-характеристик. Основными информативными параметрами, получаемыми из измерения C–V, были: напряжение плоских зон (VFB), напряжение середины зоны (VMG) и пороговое напряжение, соответствующее образованию инверсного слоя (VT).
Облучение протонами проводили на экспериментальной установке, созданной на базе ускорителя, что позволяло использовать потоки протонов с энергией 150–500 кэВ. Один импульс на ускорителе обеспечивал флуенс протонов 1010 см–2. Плотность тока протонов составляла (1–4) × × 10–8 А/см2, что исключало возможность разогрева исследованных образцов. Для облучения МОП-структур гамма-квантами использовали источник Co60.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Проведенные ранее исследования воздействия протонного излучения и облучения гамма-квантами [15–18] на аналогичные МОП-структуры показали, что оба вида облучения приводят к накоплению в пленке подзатворного диэлектрика положительного заряда и увеличению плотности ловушек на границе раздела с полупроводником. Сдвиг порогового напряжения, полученного из измерений C–V до дозы 100 крад, был пропорционален дозе облучения [15–17], что позволяет применять эти структуры в качестве сенсоров радиационного излучения. Данные результаты хорошо согласуются с результатами других исследователей аналогичных МОП-приборов [8–12]. Проведение радиационного облучения МОП-структур, находящихся в режиме сильнополевой инжекции электронов, подробно описано в [15–18] и позволяет значительно увеличить дозовую чувствительность сенсоров и расширить их характеристики.
Одна из основных характеристик МОП-сенсора – это стабильность его показаний во времени после снятия облучения. Эта стабильность в основном определяется релаксацией радиационно-индуцированного положительного заряда при отжиге структуры, который обычно проводится при комнатной температуре [8–12]. На рис. 1 приведены изменения порогового напряжения МОП-структуры и поверхностных состояний при хранении структуры при комнатной температуре после облучения флуенсом протонов 5 × 1011 см–2 с энергией 500 кэВ. Близкие к приведенным на рисунке изменения параметров наблюдались при аналогичном хранении МОП-структур, облученных гамма-квантами с дозой около 10 крад. Как видно из рис. 1, при хранении МОП-структур наблюдается постепенное уменьшение сдвига порогового напряжения, что соответствует уменьшению положительного заряда, накопленного в подзатворном диэлектрике в процессе облучения. Основным механизмом отжига положительного заряда является туннельный либо туннельно-термоактивационный обмен зарядами с подложкой [9–12]. Результаты, приведенные на рис. 1, хорошо коррелируют с экспериментальными данными, полученными другими авторами [8–14]. Как видно из рисунка, образование поверхностных состояний продолжается и после прекращения действия излучения в течение всего времени выдерживания структуры, что также согласуется с литературными данными [9–11]. Кривые, характеризующие релаксацию положительного заряда, накопленного в подзатворном диэлектрике при совместном воздействии радиационного излучения и сильных электрических полей, были схожи.
Рис. 1.
Зависимость порогового напряжения ΔVТ на МОП-структуре (1), содержащей радиационно-индуцированный положительный заряд, и количества поверхностных состояний Nit (2) от времени выдерживания (отжига) образцов при комнатной температуре.
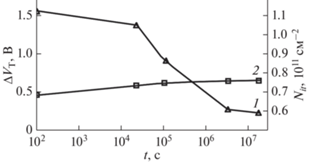
В последнее время для расширения функциональных возможностей МОП-сенсоров и улучшения их метрологических характеристик широко исследуют возможность стирания положительного заряда сильнополевой инжекцией электронов (инжекционный отжиг) и радиационным облучением при отрицательном смещении на затворе (радиационный отжиг) [11, 19, 20]. Для изучения возможности стирания положительного заряда была использована сильнополевая инжекция электронов из кремния в режиме поддержания постоянного тока в диапазоне 0.1–1 мкА/см2. Предварительные исследования необлученных МОП-структур показали, что при данных плотностях инжекционного тока практически не наблюдаются процессы межзонной ударной ионизации в пленке SiO2 и процесс инжекции дырок из анода. В результате при данных режимах инжекции зарядовое состояние необлученных МОП-структур изменялось незначительно, и этими изменениями можно было пренебречь. Использование режима протекания постоянного сильнополевого инжекционного тока для стирания радиационно-индуцированного положительного заряда в пленке SiO2 МОП-структур позволяет поддерживать постоянную плотность инжектированного заряда и обеспечивать более быстрый и стабильный режим стирания по сравнению с инжекцией в режиме поддержания постоянного напряжения.
На рис. 2 приведено изменение напряжения ΔVI на МОП-структуре, содержащей положительный заряд (созданный облучением флуенсом протонов 1011 см–2) при сильнополевой туннельной инжекции электронов из кремния в режиме протекания постоянного тока Jinj = 10–6 А/см2 и изменение напряжения плоских зон VFB, измеренные путем прерывания инжекции. Как видно из рисунка, в процессе стирания положительного заряда значительно увеличивается количество поверхностных состояний Nit, что хорошо согласуется с теорией генерации новых поверхностных состояний при аннигиляции захваченных дырок в результате взаимодействия с инжектированными электронами, предложенной в [23, 24]. Уменьшение сдвига порогового напряжения в процессе инжекции было небольшим, поскольку аннигиляция положительного заряда компенсировалась ростом количества поверхностных состояний. Кривые, характеризующие изменение зарядового состояния МОП-структуры, содержащей аналогичный радиационно-индуцированный положительный заряд при сильнополевой инжекции электронов в режиме протекания постоянного тока Jinj = 10–7 А/см2, были схожи с кривыми, приведенными на рис. 2. Следовательно, при таких сильнополевых воздействиях стирание положительного заряда и генерация новых поверхностных состояний в основном определяются величиной заряда, инжектированного в диэлектрик. Однако при уменьшении плотности инжекционного тока пропорционально увеличивается время инжекции, что нежелательно с практической точки зрения для МОП-сенсоров радиационного излучения.
Рис. 2.
Зависимость от величины инжектированного заряда: 1 – напряжения ΔVI на МОП-структуре, содержащей радиационно-индуцированный положительный заряд при последующей сильнополевой туннельной инжекции электронов из кремния в режиме протекания постоянного тока Jinj = 1 мкA/см2 (1' – теоретически рассчитанная кривая); 2 –напряжения плоских зон в процессе инжекции; 3 – количества поверхностных состояний.
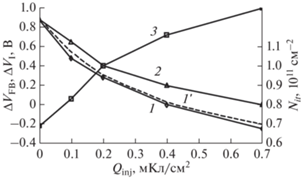
Проведение дополнительных исследований позволило сделать вывод, что протонное облучение особенно при больших флуенсах и последующая сильнополевая инжекция электронов создают в объеме пленки SiO2 электронные ловушки. Следовательно, экспериментальные данные, представленные на рис. 2, характеризуют не только релаксацию положительного заряда, но и частичную компенсацию его отрицательным зарядом электронов, захватываемых в ловушки в процессе инжекции. Именно захватом небольшого количества электронов можно объяснить разницу в смещениях напряжения плоских зон и напряжения во время инжекции постоянным током.
Зонная диаграмма, характеризующая основные физические процессы, которые протекают в МОП-структуре, содержащей положительный заряд, индуцированный радиационным воздействием при его последующем стирании сильнополевой инжекцией электронов, представлена на рис. 3. Как видно из рисунка, в результате радиационной ионизации часть дырок, избежавших рекомбинации и приблизившихся к границе раздела Si–SiO2, может захватываться в ловушки в объеме SiO2 у границы с кремнием, создавая положительный заряд Qp. Дырки захватываются в ловушки, основную часть которых составляют напряженные связи кислородных вакансий O≡Si–Si≡O [1–3]. Захват дырок приводит к разрыву напряженной связи и образованию фиксированного положительного заряда, ответственным за который считают (преимущественно) E '-центры O≡Si–+Si≡O [1–3, 7]. При сильнополевой инжекции электронов из кремния (рис. 3, процесс 1) часть инжектированных электронов взаимодействует с захваченными дырками (процесс 3), приводя к их аннигиляции [23–30]. При аннигиляции части дырок в результате взаимодействия с инжектированными электронами могут генерироваться новые поверхностные состояния (рис. 3, процесс 4). В настоящее время существуют два основных объяснения природы таких поверхностных состояний и механизмов их генерации [24–28]. Первый предполагает участие водорода и его соединений в этих процессах, а второй объясняет происхождение части поверхностных состояний отжигом положительного заряда и структурным преобразованием его в поверхностное состояние (“конверсионные” модели). Водородная модель предполагает активную химическую роль соединений водорода (протонов и атомарного водорода) в генерации поверхностных состояний. В этом случае поверхностные состояния связывают с Pb-центрами и их модификациями. Под действием радиационного облучения часть связанного водорода, находящегося в объеме SiO2 в виде групп SiH и SiOH, может высвобождаться (рис. 3, процесс 5), что приводит к образованию в диэлектрике электронных ловушек [24, 25, 29, 30]. Освобождение водорода может происходить в результате взаимодействия водородных групп с высокоэнергичными инжектированными электронами [24, 25]. Затем соединения водорода перемещаются к границе раздела Si–SiO2 (рис. 3, процесс 6), где они могут инициировать образование Рb-центров (процесс 7). Часть инжектированных электронов может захватываться в созданные в SiO2 электронные ловушки (рис. 3, процесс 8), образуя отрицательный заряд Qn.
Рис. 3.
Зонная диаграмма МОП-структуры с радиационно-индуцированным положительным зарядом, иллюстрирующая основные процессы изменения зарядового состояния: 1 – сильнополевая туннельная инжекция электронов по Фаулеру–Нордгейму; 2 – транспорт и разогрев инжектированных электронов в зоне проводимости SiO2; 3 – аннигиляция части захваченных дырок в результате взаимодействия с инжектированными электронами; 4 – генерация поверхностных состояний в результате аннигиляции захваченных дырок; 5 – высвобождение водорода; 6 – транспорт водорода; 7 – взаимодействие водорода с дефектами, связанными с поверхностными состояниями; 8 – захват электронов ловушками, созданными излучением и сильнополевой инжекцией электронов.

В случае, представленном на рис. 3, генерация дырок в результате радиационной и сильнополевой инжекции отсутствует и, следовательно, для определения изменения плотности радиационно-индуцированных дырок в процессе сильнополевой инжекции электронов можно использовать уравнение:
где для определения плотности тока Фаулера–Нордгейма использовано выражение [25]: Для определения количества поверхностных состояний, генерируемых при аннигиляции захваченных дырок инжектированными электронами, применяли выражение [15, 24]:(3)
$\frac{{dn_{{it}}^{{e - h}}}}{{dt}} = {{\gamma }_{{e - h}}}\frac{{{{J}_{{{\text{inj}}}}}}}{q}{{\sigma }_{{ep}}}p\left( {E,t} \right),$Для определения плотности электронов, накапливаемых в объеме подзатворного диэлектрика (рис. 3, процесс 8), использовано следующее уравнение [15–18]:
(4)
${{n}_{t}} = {{N}_{t}}\left[ {1 - \exp \left( { - \frac{{{{\sigma }_{t}}{{Q}_{{{\text{inj}}}}}}}{q}} \right)} \right].$(5)
$\Delta {{V}_{T}} = \frac{q}{{\varepsilon {{\varepsilon }_{0}}}}\left[ {p\left( {{{d}_{{{\text{ox}}}}} - {{x}_{p}}} \right) + n_{{it}}^{{e - h}}{{d}_{{{\text{ox}}}}} - {{n}_{t}}\left( {{{d}_{{{\text{ox}}}}} - {{x}_{n}}} \right)} \right],$Систему уравнений (1)–(5) решали при следующих начальных условиях: p(0) = prad, $n_{{it}}^{{e - h}}(0) = n_{{it\,{\kern 1pt} {\text{rad}}}}^{{e - h}},$ где prad и $n_{{it\,\,{\text{rad}}}}^{{e - h}}$ – плотность захваченных дырок и количество поверхностных состояний, индуцированных радиационным излучением. Параметры модели, входящие в выражения (1)–(5): b0 = 3 × 10–13 МВ3/см; Nt = (0.2–1.2) × 1013 см–2; γe–h = 0.3; σt = 1.4 × 10–15 см2; xp = 6 нм; xn = 60 нм.
Сдвиг напряжения на МОП-структуре при постоянной плотности тока ΔVI в режиме сильнополевой инжекции электронов из кремния можно определить, если использовать уравнение (5) без второго слагаемого (учитывающего генерацию поверхностных состояний). На рис. 2 временная зависимость ΔVI, полученная на основе решения уравнений (1)–(5), показана пунктирной линией. Как видно из рисунка, теоретически рассчитанная кривая во всем диапазоне сильнополевой инжекции практически совпадает с экспериментальными данными, что подтверждает корректность предложенной модели. Параметры, входящие в модель, были практически идентичны параметрам, используемым в [15–18], что говорит об универсальности модели, предложенной в [15, 16], и возможности ее применения как для описания генерации положительного заряда, так и для его релаксации при радиационных и/или сильнополевых инжекционных воздействиях.
ВЫВОДЫ
Показано, что для стирания радиационно-индуцированного положительного заряда, накапливаемого в пленке SiO2 МОП-структур, желательно использовать сильнополевую туннельную инжекцию электронов при электрических полях, не вызывающих генерацию дырок. Установлено, что при аннигиляции захваченных в SiO2 дырок в результате взаимодействия с инжектированными электронами наблюдается существенное увеличение количества поверхностных состояний, значительно превышающих количество поверхностных состояний, возникающих при отжиге радиационно-индуцированного заряда при комнатной температуре.
Показано, что стирание радиационно-индуцированного положительного заряда в пленке SiO2 МОП-структур и генерация новых поверхностных состояний в основном определяются величиной заряда, инжектированного в диэлектрик, и, следовательно, использование режима протекания постоянного инжекционного тока позволяет обеспечить более быстрый и стабильный режим стирания.
Предложена модель, описывающая процесс аннигиляции радиационно-индуцированного положительного заряда при взаимодействии с инжектированными электронами. Показано, что параметры предложенной модели близки к параметрам модели, описывающей накопление положительного заряда в пленке SiO2 МОП-структур при сильнополевой инжекции электронов по Фаулеру–Нордгейму.
Установлено, что при сильнополевой инжекции в подзатворный диэлектрик МОП-структуры, содержащий радиационно-индуцированный накопленный положительный заряд, только часть этого заряда аннигилирует при взаимодействии с инжектированными электронами. Показано, что при продолжительной инжекции электронов МОП-структур может наблюдаться накопление отрицательного заряда в объеме пленки SiO2 в результате захвата части инжектированных электронов в ловушки, возникающие в оксиде после радиационного облучения и в процессе сильнополевой инжекции.
Список литературы
Oldham T.R., McLean F.B. // IEEE Trans. Nucl. Sci. 2003. V. 50. P. 483. https://doi.org/10.1109/TNS.2003.812927
Schwank J.R., Shaneyfelt M.R., Fleetwood D.M., Felix J.A., Dodd P.E., Paillet P., Ferlet-Cavrois V. // IEEE Trans. Nucl. Sci. 2008. V. 55. P. 1833. https://doi.org/10.1109/TNS.2008.2001040
Fleetwood D.M. // IEEE Trans. Nucl. Sci. 2018. V. 65. P. 1465. https://doi.org/10.1109/TNS.2017.2786140
Hughes H.L., Benedetto J.M. // IEEE Trans. Nucl. Sci. 2003. V. 50. P. 500. https://doi.org/10.1109/TNS.2003.812928
Esqueda I.S., Barnaby H.J., King M.P. // IEEE Trans. Nucl. Sci. 2015. V. 62. P. 1501. https://doi.org/10.1109/TNS.2015.2414426
Murata K., Mitomo S., Matsuda T., Yokoseki T., Makino T., Onoda S., Takeyama A., Ohshima T., Okubo S., Tanaka Y., Kandori M., Yoshie T., Hijikata Y. // Phys. Stat. Sol. A. 2017. V. 214. P. 1600446. https://doi.org/10.1002/pssa.201600446
Fleetwood D.M. // IEEE Trans. Nucl. Sci. 2020. V. 67. P. 1216. https://doi.org/10.1109/TNS.2020.2971861
Holmes-Siedle A., Adams L. // Radiat. Phys. Chem. 1986. V. 28. P. 235. https://doi.org/10.1016/1359-0197(86)90134-7
Pejović M.M. // Radiat. Phys. Chem. 2017. V. 130. P. 221. https://doi.org/10.1016/j.radphyschem.2016.08.027
Ristic G.S., Vasovic N.D., Kovacevic M., Jaksic A.B. // Nucl. Instrum. Methods Phys. Res. B. 2011. V. 269. P. 2703. https://doi.org/10.1016/j.nimb.2011.08.015
Lipovetzky J., Holmes–Siedle A., Inza M.G., Carbonetto S., Redin E., Faigon A. // IEEE Trans. Nucl. Sci. 2012. V. 59. P. 3133. https://doi.org/10.1109/TNS.2012.2222667
Siebel O.F., Pereira J.G., Souza R.S., Ramirez-Fernandez F.J., Schneider M.C., Galup-Montoro C. // Radiat. Measurements. 2015. V. 75. P. 53. https://doi.org/10.1016/j.radmeas.2015.03.004
Kulhar M., Dhoot K., Pandya A. // IEEE Trans. Nucl. Sci. 2019. V. 66. P. 2220. https://doi.org/10.1109/TNS.2019.2942955
Camanzi B., Holmes-Siedle A.G. // Nature Mater. 2008. V. 7. P. 343. https://doi.org/10.1038/nmat2159
Andreev D.V., Bondarenko G.G., Andreev V.V., Stolyarov A.A. // Sensors. 2020. V. 20. P. 2382. https://doi.org/10.3390/s20082382
Andreev V.V., Maslovsky V.M., Andreev D.V., Stolyarov A.A. // Proc. SPIE. 2019. V. 11022. P. 1102207. https://doi.org/10.1117/12.2521985
Andreev V.V., Bondarenko G.G., Andreev D.V., Stolyarov A.A. // J. Contemp. Phys. (Armenian Acad. Sci.). 2020. V. 55. P. 144. https://doi.org/10.3103/S106833722002005X
Andreev D.V., Bondarenko G.G., Andreev V.V., Maslovsky V.M., Stolyarov A.A. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2020. V. 14. P. 260. https://doi.org/10.1134/S1027451020020196
Lipovetzky J., Redin E.G., Faigon A. // IEEE Trans. Nucl. Sci. 2007. V. 54. P. 1244. https://doi.org/10.1109/TNS.2007.895122
Peng L., Hu D., Jia Y., Wu Y., An P., Jia G. // IEEE Trans. Nucl. Sci. 2017. V. 64. P. 2633. https://doi.org/10.1109/TNS.2017.2744679
Andreev V.V., Bondarenko G.G., Maslovsky V.M., Stolyarov A.A., Andreev D.V. // Phys. Stat. Sol. C. 2015. V. 12. P. 299. https://doi.org/10.1002/pssc.201400119
Andreev D.V., Maslovsky V.M., Andreev V.V., Stolyarov A.A. // Phys. Stat. Sol. A. 2022. V. 219. P. 2100400. https://doi.org/10.1002/pssa.202100400
Lai S.K. // J. Appl. Phys. 1983. V. 54. P. 2540. https://doi.org/10.1063/1.332323
Arnold D., Cartier E., DiMaria D.J. // Phys. Rev. B. 1994. V. 49. P. 10278. https://doi.org/10.1103/PhysRevB.49.10278
Strong A.W., Wu E.Y., Vollertsen R., Sune J., Rosa G.L., Rauch S.E., Sullivan T.D. Reliability Wearout Mechanisms in Advanced CMOS Technologies. Wiley-IEEE Press, 2009. 624 p.
Palumbo F., Wen C., Lombardo S., Pazos S., Aguirre F., Eizenberg M., Hui F., Lanza M. // Adv. Funct. Mater. 2019. V. 29. P. 1900657. https://doi.org/10.1002/adfm.201900657
Wu E.Y. // IEEE Trans. Electron Devices. 2019. V. 66. P. 4523. https://doi.org/10.1109/TED.2019.2933612
Zebrev G.I., Orlov V.V., Gorbunov M.S., Drosdetsky M.G. // Microelectron. Reliab. 2018. V. 84. P. 181. https://doi.org/10.1016/j.microrel.2018.03.014
Andreev D.V., Bondarenko G.G., Andreev V.V., Maslovsky V.M., Stolyarov A.A. // Acta Phys. Pol. A. 2019. V. 136. P. 263. https://doi.org/10.12693/APhysPolA.136.263
Cerbu F., Madia O., Andreev D.V., Fadida S., Eizenberg M., Breuil L., Lisoni J.G., Kittl J.A., Strand J., Shluger A.L., Afanas’ev V.V., Houssa M., Stesmans A. // Appl. Phys. Lett. 2016. V. 108. P. 222901. https://doi.org/10.1063/1.495271
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


