Приборы и техника эксперимента, 2019, № 5, стр. 114-118
МЕТОД ОПЕРАТИВНОГО КОНТРОЛЯ ОДНОРОДНОСТИ РАСПРЕДЕЛЕНИЯ ЭЛЕКТРОФИЗИЧЕСКИХ СВОЙСТВ ПОЛУПРОВОДНИКОВЫХ МАТЕРИАЛОВ
В. Н. Власов a, *, В. И. Стрелов a, Е. Н. Коробейникова a
a Институт кристаллографии РАН Федерального научно-исследовательского центра
“Кристаллография и фотоника” РАН
119333 Москва, Ленинский просп., 59, Россия
* E-mail: kmikran@spark-mail.ru
Поступила в редакцию 16.12.2018
После доработки 04.02.2019
Принята к публикации 08.02.2019
Аннотация
Разработан эффективный метод оперативного контроля однородности распределения электрофизических свойств в полупроводниковых материалах по результатам измерения термо-э.д.с. Данный метод применим для образцов, имеющих преимущественно один тип проводимости. В этом случае можно получить качественные и количественные результаты распределения концентрации носителей заряда. Показано, что в случае смешанного типа проводимости возможен только качественный анализ концентрации носителей заряда, который, однако, так же может быть полезным и информативным при изучении процессов легирования полупроводниковых кристаллов.
Развитие полупроводниковой микроэлектроники предъявляет высокие требования к структурному совершенству и однородности свойств полупроводниковых материалов [1]. Главный акцент современного этапа развития сделан на решающей роли изменения свойств твердых тел как путем управления структурой, так и в результате новых возможностей легирования элементами независимо от их химической природы и атомных размеров.
В этой связи не менее важной задачей является совершенствование локальных методов контроля электрофизических параметров полупроводниковых материалов, знания о которых необходимы для создания приборов. Одним из таких важных параметров является контроль распределения концентрации носителей заряда в объеме материала.
В настоящее время в микроэлектронике для определения однородности полупроводников наиболее широко используют контактные (зондовые) и бесконтактные (неразрушающие) методы измерения удельного сопротивления.
Наибольшее применение среди контактных методов нашли двух- и четырехзондовые методы, основанные на явлении растекания тока в точке контакта металлического острия зонда с полупроводником [2–4], метод Холла (для определения концентрации и подвижности носителей заряда измеряют проводимость образца и постоянную Холла) [5]. При этом метод Холла для определения концентрации носителей заряда недостаточно локален, так как для проведения измерений необходимы образцы в виде пластин толщиной ~1 мм и площадью ~1 см2 [6].
Наряду с перечисленными разработаны методы измерения электрических параметров, не требующие механического контакта. Например, разработаны методы измерения, в которых используется электронный луч [7, 8]. Растровые сканирующие методы электронно-лучевого зондирования позволяют получать высокое разрешение по площади исследуемого образца, детально исследовать его поверхность. Однако использование электронного луча требует вакуумирования измеряемого образца при проведении испытаний, что приводит к значительному увеличению времени измерений и стоимости исследований.
Применяются также оптические методы контроля. По глубине возникающей модуляции зондирующего луча можно судить об электрофизических свойствах полупроводника [9–11]. К сожалению, метод, основанный на измерении модуляции поглощения, является недостаточно чувствительным. Для его применения в исследуемых образцах необходимо достичь концентрации дополнительных носителей заряда более чем 1016–1017 см–3.
В данной работе дополнительно к существующим методам предлагается простой в реализации для широкого круга изделий метод измерения сопротивления растекания (${{R}_{S}}$), обладающий высокой локальностью измерений. Используемый метод является контактным, т.е. требует создания электрического контакта с исследуемым полупроводником. При этом он может найти широкое применение при проведении научно-исследовательских и опытно-конструкторских работ в области полупроводникового приборостроения (контроль полупроводниковых пластин, объемных монокристаллов, полупроводниковых слоистых структур и т.п.).
Устройство для измерения величины ${{R}_{S}}$ содержит измерительный зонд, выполненный в виде стержня из твердого металла, один конец которого заострен. Зонд приводят в соприкосновение с плоской поверхностью измеряемого образца. Диаметр контакта зонд–образец обычно составляет 5–20 мкм, что и определяет локальность данного метода [6]. Далее измеряют сопротивление ${{R}_{S}}$ контакта зонд–образец и определяют величину удельного сопротивления ρ по формуле: ρ = $a{{R}_{S}}$, где величина $a$ определяется измерением ${{R}_{S}}$ у эталонных образцов с известным значением величины ρ.
При этом величина ρ связана не только с концентрацией носителей заряда n, определяемой концентрацией легирующего элемента, но также и с подвижностью µ носителей заряда известной формулой ${\rho } = {{(en{\mu })}^{{ - 1}}}$, где $e$ – заряд электрона. При этом при постоянном значении n величина µ может иметь разные значения в разных точках измеряемого образца. В связи с этим использовать данные распределения концентрации легирующей примеси в образце по результатам распределения величины ρ не совсем корректно.
В этой связи основной целью работы является разработка метода оперативного контроля однородности распределения электрофизических свойств полупроводниковых материалов (концентрации носителей заряда), позволяющего избежать, в том числе, и проблемы влияния подвижности носителей заряда.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Усовершенствованный метод определения концентрации носителей заряда основан на методике, предложенной в работе [12]. Практическое применение устройства, описанного в [12], связано с дискретным отсчетом измеряемой величины, что вызывает большие неудобства, так как отнимает слишком много времени. Для устранения этого недостатка было использовано устройство с непрерывным процессом измерения и записью измеряемой величины на двухкоординатный самописец [13].
Кроме того, усовершенствование метода заключалось в размещении на измерительном зонде нагревателя с регулируемой мощностью до 0.2 Вт. Нагреватель представляет тонкий медный изолированный провод ПЭЛ-01, намотанный на измерительный зонд и питаемый от регулируемого источника тока.
Измерительный зонд соприкасается с плоской поверхностью измеряемого образца. Диаметр контакта зонда с образцом такой же, как и в случае измерения величины ${{R}_{S}}$. Таким образом, локальность измерения величины ${{R}_{S}}$ и термо-э.д.с. совпадают. Для получения термо-э.д.с. нагреватель на зонде нагревают до температуры на 5–10°С выше комнатной. При нагреве в точке контакта образца с зондом из-за разности температур в точке контакта зонда и комнатной возникает термо-э.д.с. UT.
Схема усовершенствованного устройства представлена на рис. 1. Устройство содержит подвижный столик 1 с закрепленным на нем образцом 2. С помощью системы электромотор–редуктор столик может перемещаться по оси Х. Сам столик связан с датчиком перемещения 3. Электрический сигнал, пропорциональный величине перемещения столика, с датчика 3 подается на Х-вход двухкоординатного самописца. Во время измерения на образец сверху опускается измерительный зонд 4 с размещенным на нем нагревателем 5.
Рис. 1.
Схема устройства для определения концентрации носителей заряда в полупроводниках. 1 – подвижный столик; 2 – образец; 3 – датчик перемещения; 4 – измерительный зонд; 5 – нагреватель; 6 – груз; ИТ – источник тока.
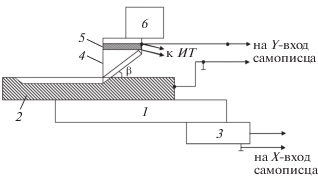
Измерительный зонд изготовлен из пластины твердого материала, проводящего электрический ток. Рабочая сторона зонда заточена подобно лезвию ножа. Перемещаясь по поверхности образца, зонд оставляет на нем канавку шириной 15–30 мкм. Канавка не должна содержать сколов, что достигается подбором угла β между лезвием зонда и поверхностью образца. Ширина канавки определяет локальность метода и регулируется весом груза 6, размещенного на зонде.
Температура контакта зонд–образец регулируется величиной тока, пропускаемого через нагреватель. Величина тока через нагреватель, необходимая для проведения измерений, определяется с помощью эталонного образца, у которого коэффициент термо-э.д.с. известен из литературных данных. При проведении измерений величина температуры контакта значения не имеет, так как ее значение не входит в расчетные формулы. Главное, чтобы она была на 5–10°С выше комнатной и не менялась в процессе измерений. За 20–30 мин до начала измерений нагреватель включают, чтобы дать зонду возможность равномерно прогреться. Затем зонд опускают на образец, включают электромотор и производят запись ${{U}_{T}} = f(x)$. Напряжение UT подается на Y-вход самописца через контакты, размещенные на зонде и образце (рис. 1).
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Установление зависимости между величинами ${{U}_{T}}(x)$ и распределением концентрации носителей заряда n(x) в полупроводнике проводилось по следующей схеме. Пусть разность температур в точке х контакта зонд–образец и комнатной температурой равна ΔT. Тогда
где ${{{\alpha }}_{{\text{п}}}}(x)$ – удельная термо-э.д.с. полупроводника, ${{{\alpha }}_{{{\text{зонд}}}}}$ – удельная термо-э.д.с. зонда. Записав выражение (1) для х = х1 (х1 – любое значение х), найдем разность между ними. После соответствующих преобразований получим(2)
$({{U}_{T}}({{x}_{1}}) - {{U}_{T}}(x)){\text{/}}\Delta T = {{{\alpha }}_{{\text{п}}}}({{x}_{1}}) - {{{\alpha }}_{{\text{п}}}}(x).$Для полупроводников с примесным типом проводимости ${{{\alpha }}_{n}}(x)$ [14] имеет вид:
где А, В, С – константы, не связанные с легированием примесью. В литературе выражение (3) называется формулой Писаренко и применимо только к примесным полупроводникам, у которых концентрация носителей одного типа много выше концентрации носителей противоположного типа [15]. Подставив уравнение (3) в (2), после соответствующих преобразований получим где т.е. зависимость между величинами ${{U}_{T}}(x)$ и $n(x)$ носит логарифмический характер. Для проведения масштабирования по оси y необходимо иметь два образца с известными значениями n1 и n2 (так как для этого необходимо иметь два значения y(х): y1 и y2. В качестве n1 в (4) удобно брать концентрацию носителей заряда в затравке nз, которая заранее определяется из холловских измерений. Концентрация носителей заряда в начале образца (пластины, вырезанной из монокристалла) в (4) определяется как ${{n}_{2}} = n(x = 0) = {{k}_{0}}{{n}_{{\text{з}}}}$, где ${{k}_{0}}$ – равновесный коэффициент распределения легирующей примеси.В качестве примера на рис. 2 показано распределение величины ${{U}_{T}} = f(x)$ (конвертированное в зависимость $y(x) = \ln (n(x){\text{/}}{{n}_{{\text{з}}}})$) на пластине германия, легированного галлием. Пластина вырезана вдоль оси роста $\langle 111\rangle $ из монокристалла Ge(Ga) (концентрация галлия в затравке 2 ⋅ 1018 см–3), выращенного вертикальным методом Бриджмена [16].
Рис. 2.
Распределение логарифма относительной концентрации носителей заряда вдоль оси роста монокристалла Ge(Ga).

Так как равновесный коэффициент распределения галлия в германии ${{k}_{0}} = 0.087$, то, подставив это значение в уравнение (4), получим
(6)
$y(x = 0) = \ln ({{n}_{2}}{\text{/}}{{n}_{{\text{з}}}}) = \ln \left( {\frac{{{{k}_{0}}{{n}_{{\text{з}}}}}}{{{{n}_{{\text{з}}}}}}} \right) = \ln {{k}_{0}} = - 2.3,$Однако необходимо уточнить, что если в исследуемом образце наблюдается проводимость смешанного типа, то возможен только качественный анализ распределения концентрации носителей заряда. Это можно продемонстрировать на следующем примере. На монокристаллическую затравку GaSb с концентрацией дырок p = 2 ⋅ 1017 см3 был выращен вертикальным методом Бриджмена кристалл GaSb, легированный Те [17]. Из выращенного кристалла вдоль оси роста $\langle 111\rangle $ вырезана пластина, на которой после химико-механической полировки проведены соответствующие измерения.
На рис. 3 показана кривая изменения сопротивления растекания вдоль оси роста кристалла, конвертированного в удельное сопротивление ρ. Эта кривая получена на обычном (не усовершенствованном) устройстве для измерения величины ${{R}_{S}}$. С помощью усовершенствованной методики получена кривая распределения термо-э.д.с. ${{U}_{T}}(x)$ вдоль оси роста кристалла, результаты измерений которой представлены на рис. 4.
Из кривой на рис. 3 ${\rho } = {\rho }(x)$ следует, что при легировании величина ${\rho }(x)$ сначала резко уменьшается по сравнению с ${{{\rho }}_{{\text{з}}}}$ (затравочная часть). С увеличением x наблюдается сначала медленный, а затем быстрый рост ${\rho }(x)$ до значений ${\rho } = 1.8 \cdot {{10}^{{ - 2}}}$ Ом · см. Затем ${\rho }(x)$ быстро падает до значений, несколько превышающих значение ${{{\rho }}_{{\text{з}}}}$.
Анализ кривой ${{U}_{T}}(x)$ на рис. 4 позволяет сделать вывод о том, что теллур является для GaSb донором, т.е. дает n-тип проводимости. На начальном участке роста концентрация Tе и, следовательно, носителей n-типа велика, т.е. n > p. Происходит перекомпенсация носителей p-типа носителями n-типа, и кристалл меняет проводимость с p-типа на n-тип. Этому соответствует смена знака кривой ${{U}_{T}}(x)$ на рис. 4. Так как n > p, то начальный участок кристалла имеет ${{{\rho }}_{n}} < {{{\rho }}_{{\text{з}}}}$ (рис. 3). Далее концентрация Tе начинает уменьшаться (рис. 4), и ${\rho }(x)$ растет.
При x = 12 мм происходит компенсация носителей заряда, т.е. ${{{\mu }}_{p}}p = {{{\mu }}_{n}}n$, где ${{{\mu }}_{p}}$ – подвижность дырок и p – их концентрация; ${{{\mu }}_{n}}$ и n – подвижность и концентрация электронов соответственно. Это соответствует максимальному значению ${\rho }(x)$ на кривой рис. 3. Далее концентрация Tе уменьшается настолько, что p > n, и проводимость кристалла приобретает p-тип. Теперь n-носители только частично компенсируют носители p-типа, что приводит к небольшому увеличению ${\rho }(x)$ на рис. 3).
Таким образом, применение метода с измерением термо-э.д.с. позволяет определить тип носителей заряда в исследованном кристалле, а также их распределение вдоль оси роста. Как показали проведенные исследования, большая часть кристалла имеет смешанный или близкий к нему тип проводимости. К сожалению, для таких кристаллов определить количественно концентрацию носителей заряда не удается, так как в этом случае формула (3) не работает. Для таких случаев возможен только качественный анализ, который является весьма полезным и информационным. Однако при этом полученная зависимость (рис. 4) дает линейные размеры пролегированных и непролегированных областей, что является важным при анализе полученных результатов для отработки технологии роста кристаллов.
ЗАКЛЮЧЕНИЕ
Проведено усовершенствование локального метода контроля электрофизических параметров полупроводниковых материалов, знание которых необходимо для создания приборов микроэлектроники. При этом он может найти широкое применение при проведении научно-исследовательских и опытно-конструкторских работ в области полупроводникового приборостроения (контроль полупроводниковых пластин, объемных монокристаллов, полупроводниковых слоистых структур и т.п.). Регистрация распределения термо-э.д.с. (${{U}_{T}}(x)$) вдоль оси роста кристалла совместно с распределением сопротивления растекания (${{R}_{S}}$) позволяет более информативно, как качественно, так и количественно, исследовать процесс легирования монокристаллов полупроводников. Исследованы профили распределения концентрации носителей заряда в монокристаллах с одним типом проводимости на примере Ge(Ga) и смешанном типе проводимости на примере GaSb(Te).
Список литературы
Освенский В.Б. // Фундаментальные проблемы Российской металлургии на пороге XXI века. Т. 4. Актуальные проблемы технологии полупроводниковых материалов. М.: МИСИС, 1998. С. 152.
Фистуль В.И., Мейер А.А. Зондовые методы измерения удельного сопротивления полупроводников. М.: Гиредмет, 1968.
Блад П., Ортон Дж.В. // Зарубежная радиоэлектроника. 1981. Ч. 1. № 1. С. 3.
Павлов Л.П. Методы измерения параметров полупроводниковых материалов. М.: Высшая школа, 1987.
Кучис Е.В. Методы исследования эффекта Холла. М.: Сов. радио, 1974.
Батавин В.В., Концевой Ю.А., Федоровия Ю.В. Измерение параметров полупроводниковых материалов и структур. М.: Радио и связь, 1985.
Chan D.S.H. // IEEE Trans. on Electron Devices. 1982. V. 42. № 5. P. 185.
Schroder D.K. Semiconductor material and device characterization. NY: Willey-Inter-science IEEE, 2006.
Linnros J., Norlin P., Hallen A. // IEEE Trans. on Electron Devices. 1993. V. 40. № 11. P. 2065. https://doi.org/10.1109/ 16.239750
Polla D.L. // IEEE Trans. on Electron Devices Letters. 1983. V. EDL-4. P. 185.
Schuze H.J., Frohnmeyer A., Niedernostheide F.J. // J Electrochem. Soc. 2001. V. 148. № 11. P. G655. https://doi.org/10.1149/1.1409974
Власов В.Н., Серебряков Ю.А., Стрелов В.И. Патент № 103933 РФ // Опубл. 27.04.2011. Бюл. № 12.
Власов В.Н., Серебряков Ю.А., Стрелов В.И. Патент № 145584 РФ // Опубл. 20.09.2014. Бюл. № 26.
Неменов Л.Л., Соминский М.С. Основы физики и техники полупроводников. М.: Наука, 1975.
Фистуль В.И. Введение в физику полупроводников. М.: Высшая школа, 1984.
Стрелов В.И., Захаров Б.Г., Артемьев В.К. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2009. № 2. С. 25.
Серебряков Ю.А., Стрелов В.И., Фоломеев В.И., Артемьев В.К. // Тезисы докладов ХIII Национальной конференции по росту кристаллов НКРК-2008. М., 17–21 ноября 2008. С. 206.
Дополнительные материалы отсутствуют.
Инструменты
Приборы и техника эксперимента




