Химия высоких энергий, 2020, T. 54, № 2, стр. 126-134
ЭПР спектроскопия имплантированных ионами Р+ и В+ пленок диазохинон-новолачного резиста
Д. И. Бринкевич a, *, С. Д. Бринкевич a, А. Н. Олешкевич a, В. С. Просолович a, В. Б. Оджаев a
a Белорусский государственный университет
220050 Минск, пр. Независимости, 4, Беларусь
* E-mail: BrinkevichSD@bsu.by
Поступила в редакцию 28.08.2019
После доработки 28.08.2019
Принята к публикации 21.10.2019
Аннотация
C использованием метода ЭПР установлена природа стабильных радикалов в имплантированных ионами бора и фосфора пленках позитивного фоторезиста ФП9120, нанесенных на поверхность пластин монокристаллического кремния. При дозе имплантации 6 × 1015 см–2 в спектре ЭПР наблюдается узкая синглетная изотропная линия c g-фактором 2.0064. При увеличении дозы до 1.2 × 1016 см–2 величина ее g-фактора снижалась до значений, близких к g-фактору свободного электрона. Концентрация парамагнитных центров была выше при имплантации ионов фосфора, чем в образцах имплантированных ионами бора. Указанное обстоятельство связано с тем, что при имплантации В+ вклад ядерного торможения мал и не превышает 10–15% от электронного торможения. Образование долгоживущих парамагнитных центров, регистрируемых методом ЭПР спустя недели после имплантации позитивного фенолформальдегидного фоторезиста, обусловлено наличием в структуре радикалов мощной системы сопряженных >C=O и –С=С– кратных связей.
ВВЕДЕНИЕ
Одним из наиболее перспективных методов управления электрофизическими, прочностными и биологическими свойствами приповерхностных слоев полимеров является ионная имплантация [1, 2]. Так, при облучении ионами наблюдается монотонный рост электропроводности имплантированного слоя, значение которой может меняться на 10–18 порядков величины [3]. Преимуществом магниторезонансных методов (в частности, ЭПР) является высокая чувствительность, которая особенно важна при исследовании тонких пленок. Метод ЭПР-спектроскопии широко применяется в физике, химии, биологии и медицине с середины прошлого столетия. Он является основным, а часто и единственно возможным, методом исследования свободнорадикальных процессов [4].
Целью работы являлось исследование радиационно-индуцированных процессов в пленках диазохинон-новолачного фоторезиста ФП9120 при имплантации ионов бора и фосфора, а также облучении γ-квантами.
МЕТОДИКА ЭКСПЕРИМЕНТА
Пленки позитивного фоторезиста ФП9120, представляющего собой композит из светочувствительного О-нафтохинондиазида и фенол-формальдегидной смолы, толщиной 1.0, 1.8 и 2.5 мкм наносились на поверхность Si методом центрифугирования [5]. Толщина h пленки фоторезиста определялась скоростью вращения и составляла: 1.0 мкм при скорости вращения v = = 8300 об./мин; 1.8 мкм – при v = 2900 об./мин; 2.5 мкм – при v = 1200 об./мин. В качестве подложек использовались пластины (диаметром 100 мм) монокристаллического кремния марки КДБ-10 с ориентацией (111). Перед формированием пленки фоторезиста пластины кремния подвергали стандартному циклу очистки поверхности в органических и неорганических растворителях. После нанесения фоторезиста на рабочую сторону пластины проводилась сушка в течение 50–55 мин при температуре 88°С. Толщина пленок фоторезиста контролировалась с помощью микроинтерферометра МИИ-4.
Спектры ЭПР пленок фоторезиста регистрировались на спектрометре “RadioPan SE/X-2543” с резонатором H102 в X-диапазоне при комнатной температуре. Максимальная мощность СВЧ излучения в резонаторе – 200 мВт. Частота модуляции магнитного поля – 100 кГц, амплитуда – 0.1 мТл. Для контроля добротности измерительного резонатора, настройки фазы модуляции магнитного поля и калибровки магнитной компоненты СВЧ- излучения использовался кристалл рубина, закрепленный на стенке резонатора. Чувствительность спектрометра составляла 3 × 1012 спин/мТл.
Имплантация ионами фосфора Р+ (энергия 100 кэВ) и бора В+ (энергия 60 кэВ) в интервале доз 6 × 1014 см–2–1.2 × 1016 см–2 при плотности ионного тока j = 4 мкA/cм2 проводилась в остаточном вакууме не хуже 10–5 мм. рт. ст. на ионно-лучевом ускорителе “Везувий-6”. Облучение полимерных пленок γ-квантами дозой до 270 кГр. проводилось на установке MPX-γ-25M с источником 60Co. Мощность поглощенной дозы составляла 0.25 ± 0.007 Гр/с.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На спектрах ЭПР необлученной пленки фоторезиста линий поглощения не наблюдалось. Облучение γ-квантами 60Co дозой до 270 кГр и ионная имплантация дозами до 5 × 1015 см–2 также не приводили к образованию стабильных парамагнитных центров. Измеренный через 4 ч после прекращения облучения спектр (рис. 1) был идентичен спектру необлученного фоторезиста.
При дозе 6.1015 см–2 в спектре ЭПР имплантированных Р+ пленок появляется узкая синглетная линия шириной ~4 Гс. В имплантированных бором образцах она не наблюдалась, вероятнее всего, из-за низкой интенсивности. Форма линии характерна для образцов, содержащих парамагнитные центры с анизотропным g-фактором [6]. Ее анизотропные компоненты g| = 2.0064 и g⊥ ~ 2.0015. Линии ЭПР с близкими анизотропными компонентами наблюдались авторами [7] в облученном лигнине и связывались с образованием ион-радикала семихинона. Отмечалось, что частичная локализация несвязанного электрона на атоме кислорода вследствие сильной спин-орбитальной связи приводит к анизотропии g-фактора.
После увеличения дозы ионной имплантации до 1.2 × 1016 см–2 линия ЭПР смещалась в высокополевую часть спектра и наблюдалась во всех исследовавшихся образцах (рис. 2). Величина ее g‑фактора снижалась до значений 2.00127–2.00254 (табл. 1), что очень близко к g-фактору свободного электрона (gs = 2.0023). Линия становится ассиметричной (рис. 3), причем параметр ассиметрии колеблется в широких пределах: а/в = (1.2–1.75), где а и в – амплитуды соответственно низкополевой и высокополевой частей первой производной линии ЭПР поглощения. Это свидетельствует о сильном спин-орбитальном взаимодействии, которое приводит к уменьшению величины g-фактора в соответствии с выражением [6]:
(1)
$g = {{g}_{{\text{s}}}}(1--{{a\lambda } \mathord{\left/ {\vphantom {{a\lambda } {\Delta E}}} \right. \kern-0em} {\Delta E}}),$Рис. 2.
Спектр ЭПР пленки фоторезиста толщиной 2.5 мкм, облученной ионами фосфора (а) и бора (б) при дозе имплантации 1.2 × 1016 см–2.
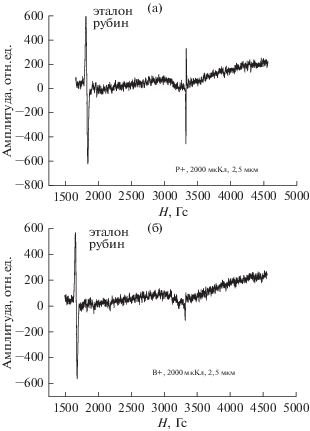
Таблица 1.
Параметры линии ЭПР в имплантированных дозой 1.2 × 1016 см–2 пленках фоторезиста
| Ион | Толщина пленки, мкм | g | ΔH, Гс | Амплитуда, отн. ед. | Концентрация радикалов, отн. ед. |
|---|---|---|---|---|---|
| Р+ | 1.0 | 2.0018 | 5.30 | 1029.7 | 28 924 |
| 2.5 | 2.0020 | 5.47 | 782.3 | 23 407 | |
| В+ | 1.0 | 2.0021 | 8.86 | 296.6 | 23 283 |
| 2.5 | 2.0014 | 9.05 | 192.9 | 15 799 |
Рис. 3.
Форма линии ЭПР пленки фоторезиста толщиной 1.0 мкм, облученной ионами фосфора дозой 1.2 × 1016 см–2.
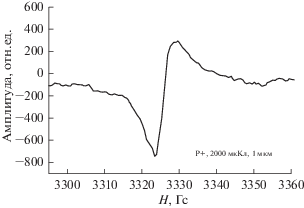
Таким образом, при увеличении дозы имплантации наблюдается усиление спин-орбитального взаимодействия, обусловленное, вероятнее всего, увеличением степени делокализации неспаренного электрона.
Концентрация парамагнитных центров была выше при имплантации ионов фосфора, чем в образцах имплантированных ионами В+ (табл. 1). При этом ширина линии ЭПР в имплантированных Р+ пленках была почти в 2 раза меньше. Сужение линии ЭПР свидетельствует о росте обменного взаимодействия, которое обусловлено перекрытием областей делокализации парамагнитных центров [8]. Отметим, что концентрация парамагнитных центров была выше в более тонких пленках (1.0 мкм) как при имплантации бора, так и фосфора (табл. 1). Это обусловлено тем, что поглощенная доза в расчете на единицу объема полимера будет меньше для толстых пленок (2.5 мкм), а, следовательно, и степень их радиационной конверсии.
Наличие в спектре ЭПР одиночной линии с g‑фактором, близким к g-фактору свободного электрона, характерно для различных углеродсодержащих материалов: углей, графита, пиролизованных, облученных и исходно-проводящих полимеров [8]. Конкретная структура этого парамагнитного центра окончательно не установлена. Мало отличаясь по ширине и величине g-фактора синглеты могут принадлежать различным радикалам – например, имеющим сопряженные углерод-углеродные связи или с частичной локализацией спиновой плотности на кислородном атоме (феноксильные радикалы, семихиноны и др.) [7]. Так, линия ЭПР с g-фактором 2.0025 ± 0.0005, наблюдавшаяся ранее в различных полимерах (полиэтилен, ПЭТФ, полиимид) при имплантации ионов азота и аргона по мнению авторов [8] обусловлена неспаренными электронами, делокализованными по π-полисопряженной системе. Линия с g-фактором 2.0020 наблюдалась также в композитах полиметилметакрилат-фуллерен С60 и связывалась с комплексами фуллерен–кислород [9].
Отметим, что для радикалов монозамещенных фенолов характерны значения g-фактора 2.0048–2.0037 в зависимости от наличия и состава боковых групп [4]. Таким образом, наблюдавшиеся в настоящей работе парамагнитные центры, вероятнее всего, не являются фенольными радикалами, но, по всей видимости, включают в свой состав атомы кислорода.
Изменение потерь в резонаторе (добротности резонатора) при внесении в него исследуемых образцов контролировалось по изменению амплитуды эталонного образца рубина, наклеенного на стенку резонатора. Добротность контура (амплитуда сигнала эталона) снижалась при увеличении толщины пленки как в исходных, так и в имплантированных образцах на 7–14% (табл. 2). После имплантации амплитуда сигнала эталона возрастала, причем более интенсивно в случае внедрения ионов фосфора (табл. 2). Указанный факт является неожиданным, поскольку при имплантации растет электрическая (омическая) проводимость полимерных пленок [8], что должно приводить к снижению добротности контура и, соответственно, к уменьшению амплитуды сигнала эталона.
Таблица 2.
Амплитуда сигнала ЭПР (в отн. ед.) эталона (рубина) при внесении в резонатор пленок фоторезиста на кремнии
| Толщина пленки, мкм | Необлученные | Р+ 1.2 × 1016 см–2 |
В+ 1.2 × 1016 см–2 |
|---|---|---|---|
| 1.0 | 1032 | 1304 | 1286 |
| 2.5 | 918 | 1213 | 1130 |
Увеличение добротности резонатора с имплантированными образцами по сравнению с исходными пленками может быть связано с присутствием в пленке фоторезиста небольшого количества воды (до 1% от веса фоторезиста). Вода может также поступать в необлученный полимер из атмосферы. Известно [8], что вода хорошо поглощает СВЧ излучение. Поэтому при помещении пленки фоторезиста с остатками воды в резонатор, его добротность ухудшается и, соответственно, падает амплитуда сигнала ЭПР эталона. Причем чем толще пленка фоторезиста, тем больше количество воды в ней и хуже добротность резонатора. В условиях имплантации (вакуум не менее 10-5 мм. рт. ст.) происходит удаление (испарение + реакции дегидратации) воды из фоторезиста, что должно приводить к увеличению добротности резонатора и, соответственно, к усилению сигнала ЭПР эталона, что и наблюдалось в эксперименте.
Для объяснения полученных экспериментальных данных необходимо принимать во внимание, что фенолформальдегидные смолы – основной компонент фоторезиста – являются сетчатыми полимерами с достаточно вариативным составом. Их средняя молекулярная масса, степень сшивки и другие физико-химические свойства сильно зависят от соотношения фенола и формальдегида при конденсации, а также условий отверждения смолы (температура, время, механическое воздействие) и последующих технологических обработок [10].
Ионное облучение фоторезиста индуцирует сложный комплекс физических и химических процессов, оказывающих заметное влияние на структуру и состав полимеров. Для легких ионов, в частности В+, основным механизмом торможения в полимере является взаимодействие электронами материала мишени – электронное торможение [8]. Помимо ионов в ходе этого процесса также образуются возбужденные макромолекулы полимера, как в результате непосредственного воздействия ионизирующей частицы, так и вследствие вторичных процессов нейтрализации разноименно заряженных частиц в треке.
Ядерное торможение вносит существенный вклад при низких энергиях – в конце пробега ионов – и приводит к деструкции макромолекул, образованию нарушенных областей и, в дальнейшем (при больших дозах), к формированию аморфизированного углеродного слоя. С увеличением массы высокоэнергетической частицы доля потерь на ядерное торможение будет возрастать. Для иона P+ с энергией 60 кэВ она составляет 40% [8].
Вклад первичной ионизации молекул при ионной имплантации полимеров доминирует – на него приходится свыше половины энергии, потерянной при электронном торможении (по некоторым данным до 80%) [11]. Выбитые электроны достаточно подвижны, они могут перемещаться на расстояния порядка 100 нм в полимере, вызывая радиационно-индуцированные процессы и образуя латентные треки [8, 11].
В отличие от корпускулярного излучения γ-кванты изотопных источников передают энергию только электронам и не взаимодействуют с ядрами атомов. В упрощенном виде воздействие высокоэнергетических ионов и γ-излучения на фенолформальдегидную смолу можно свести к возбуждению (реакция 2) и ионизации макромолекул (реакция 3) полимера.
Образующийся в реакции 3 электрон после термализации преимущественно будет вступать в реакции нейтрализации с положительно заряженными ионами. Этому способствует низкая диэлектрическая проницаемость среды, а в случае ионной имплантации – еще и высокая концентрация ионов вдоль трека частицы. Избежавшие нейтрализации электроны могут присоединяться к фенольным или к карбонилсодержащим фрагментам полимера [12, 13], количество последних будет значительно увеличиваться с ростом поглощенной дозы.
Высокие выходы возбужденных частиц и их относительная стабильность вследствие распределения избыточной энергии по сопряженным π‑связям ароматического кольца являются причинами высокой радиационной устойчивости фенол-формальдегидных смол по сравнению с карбоцепными полимерами [1] или алифатическими спиртами [14]. Свободные радикалы при облучении фенол-формальдегидных смол будут образовываться вследствие ион-молекулярных реакций, например (4), при распаде возбужденных молекул по реакции (5), а также различных радикал-молекулярных реакций (преимущественно, присоединения радикалов), например (6).
Наибольшую термодинамическую стабильность будут проявлять радикалы феноксильного (I) и метиленового (II) типа. Основным механизмом их гибели будет рекомбинация с формированием ковалентных сшивок между полимерными цепями, например, вследствие реакции (7). Что проявляется в упрочнении пленки фоторезиста по мере облучения, которое мы наблюдали в работе [15]. Со значительно меньшей вероятностью происходит диспропорционирование радикалов феноксильного (I) и метиленового (II) типа, например, по реакции (8) в результате чего образуются хинонметиновые фрагменты в составе полимера.
В спектрах ЭПР фоторезиста, облученного низкоинтенсивным γ-излучением изотопа 60Со дозой 270 кГр нами не было обнаружено долгоживущих парамагнитных центров. Следовательно, образующиеся в этих условиях радикалы феноксильного (I), метиленового (II) и пентадиенильного (III) типов, а также аддукты электронов с О-нафтохинондиазидом и другими карбонилсодержащими примесями в фоторезисте гибнут в бирадикальных реакциях во время облучения. Частицы, идентифицированные методом ЭПР, в имплантированном ионами Р+ и В+ фоторезисте имеют другую природу.
По мере увеличения поглощенной дозы, как при γ-облучении, так и при ионной имплантации, в фенолформальдегидной смоле будет увеличиваться доля хиноидных структур, которые будут образовываться в результате реакций дегидрирования (9) и дегидратации (10) возбужденных макромолекул полимера. Выделение водорода, воды и других низкомолекулярных соединений происходит в условиях глубокого вакуума при имплантации [8]. В случае переноса энергии возбуждения с макромолекул фенол-формальдегидной смолы на О-нафтхинондиазид будет происходить увеличение адгезии пленки к подожке [16] и упрочнение полимера [15]. Карбонилсодержащие фрагменты в облученном фоторезисте также образуются в результате диспропорционирования радикалов по реакциям, аналогичным (8).
Величина поглощенной дозы при ионной имплантации 6 × 1015 см–2 Р+ в фоторезист составляет ~1 × 1012 Гр в пересчете на весь объем пленки полимера и ~2 × 1013 Гр в области термализации ионов. Это на 7–8 порядков больше, чем при γ‑облучении, что будет непосредственно сказываться на степени радиационной конверсии полимера. Доля хиноиндых фрагментов, образующихся в реакциях (8)–(10), а также количество сопряженных хинонметиновых групп в них будет значительно больше при ионной имплантации, чем при γ-облучении.
Идентифицированные нами долгоживущие парамагнитные центры в образцах фоторезиста, имплантированных ионами Р+ и В+ в дозах 6 × 1015–1.2 × 1016 см–2, могут образовываться в результате двух принципиально разных процессов. Но при этом и в одном, и во втором случае важным фактором является возможность стабилизации образующегося радикала за счет сопряжения с “протяженными” хиноидными фрагментами. Как и большинство других веществ, имеющих сопряженные >C=O и –С=С– связи [13, 17, 18], хинонметиновые группы в облученном фоторезисте будут акцептировать электроны, например, по реакции (11) с образованием стабильного анион-радикала. Несколько менее очевидной выглядит возможность образования долгоживущих радикалов за счет окисления фенольной группы, например, по реакции (12). Феноксильный радикал (I) может вступать в качестве окислителя R•. В этом случае радикал-молекулярная реакция (12) является термодинамически выгодной за счет значительно большей делокализации образующегося в ней радикала по сравнению с исходным.
Образующиеся в реакциях (11) и (12) радикалы имеют мощную систему сопряженных двойных связей и, соответственно, высокую делокализацию спиновой плотности. Поэтому удается зарегистрировать их и спустя несколько недель после облучения фоторезиста. Наблюдаемое нами снижение величины g-фактора и увеличение интенсивности сигнала в спектрах ЭПР по мере роста дозы имплантации ионами связано с увеличением количества сопряженных >C=O и –С=С– связей, которые входят в состав стабильного радикала, повышая его делокализацию и термодинамическую стабильность. При высокой степени радиационной конверсии фенол-формальдегидной смолы количество сопряженных кратных связей может быть настолько велико, что в стабильных радикалах неспаренный электрон будет иметь свойства, близкие к свободному. Из-за этого в фоторезисте, облученном ионами P+ и B+ в дозе 1.2 × 1016 см–2, величина g-фактора парамагнитных частиц снижалась до значений 2.00127–2.00254, близких к соответствующей величине для свободного электрона (gs = 2.0023).
Таким образом, образование долгоживущих радикалов, регистрируемых методом ЭПР спустя недели после имплантации позитивного фенолформальдегидного фоторезиста, обусловлено образованием мощной системы сопряженных кратных связей >C=O и –С=С– в макромолекуле, стабилизирующей парамагнитные центры.
Более низкая концентрация парамагнитных центров в имплантированных бором образцах фоторезиста связана с тем, что при имплантации В+ вклад ядерного торможения мал – не превышает 10–15% от электронного торможения. Это существенно ниже, чем при имплантации фосфора, для которой потери на ядерное (около 40%) и электронное (~60%) торможение сопоставимы. Кроме того, линейная передача энергии – потери энергии излучения на единицу длины пути в образце – при имплантации ионами бора будет значительно меньше. Следовательно, при имплантации В+ энергия ионизирующего излучения будет распределяться по большему объему полимера, в результате чего степень радиолитических превращений фенолформальдегидной смолы будет значительно ниже.
Отметим, что описанные выше радиационно-индуцированные процессы могут происходить за пределами области пробега ионов. Наличие длинных молекулярных цепочек в структуре фенол-формальдегидной смолы способствует передаче энергии из области пробега ионов на сравнительно большие расстояния (более 1 мкм) [1], особенно если избыточная энергия недостаточна для распада молекул на радикалы. Ранее радиационно-индуцированные процессы за пределами области внедрения ионов (так называемые “эффекты дальнодействия”) наблюдались не только для фенолформальдегидной смолы, но и для других полимеров (полиэтилен, ПЭТФ, полиимид, полиэфирэфиркетон) при имплантации различных ионов (Sb+, B+, Ni+, Ag+, Fe+) [1, 15, 19–21].
ЗАКЛЮЧЕНИЕ
В имплантированных ионами бора и фосфора пленках позитивного фоторезиста ФП9120, нанесенных на поверхность пластин монокристаллического кремния марки КДБ-10 с ориентацией (111) методом центрифугирования, при дозе имплантации 6 × 1015 см–2 в спектре ЭПР наблюдается узкая синглетная изотропная линия c g-фактором 2.0064. При увеличении дозы до 1.2 × 1016 см–2 величина ее g-фактора снижалась до значений, близких к g-фактору свободного электрона (gs = 2.0023). Концентрация парамагнитных центров была выше при имплантации ионов фосфора, чем в образцах имплантированных ионами В+. Имплантация фоторезистивных пленок приводила также к возрастанию добротности резонатора (увеличению сигнала эталона) по сравнению с необлученными пленками, что связано с удалением остатков растворителя (воды) из пленок фоторезиста в процессе облучения в вакууме. Наблюдавшееся в работе образование долгоживущих парамагнитных центров, регистрируемых методом ЭПР спустя недели после имплантации позитивного фенолформальдегидного фоторезиста, обусловлено наличием в структуре радикалов мощной системы сопряженных >C=O и –С=С– кратных связей.
Список литературы
Kondyurin A., Bilek M. Ion beam treatment of polymers: application aspects from medicine to space. Elsevier. 2015. 256 p.
Wallace W.E., Chiou T.T., Rothman J.B., Composto R.J. // Nuclear Instruments and Methods in Physics Research B. 1995. V. 103. P. 435.
Vabishchevich N., Brinkevich D., Volobuev V., Lukashevich M., Prosolovich V., Sidorenko Yu., Odzhaev V., Partyka J. // Acta physica polonica A. 2011. V. 120. № 1. P. 46.
Steenken S., Neta P. // The chemistry of phenols. Edited by Z. Rappoport. John Wiley & Sons. 2003. P. 1107.
Бринкевич Д.И., Харченко А.А., Просолович В.С., Оджаев В.Б., Бринкевич С.Д., Янковский Ю.Н. // Микроэлектроника. 2019. Т. 48. № 3. С. 235.
Экспериментальные методы химической кинетики. / Под ред. Н.М. Эмануэля, М.Г. Кузьмина М.: МГУ, 1985. С. 10.
Кузина С.И., Брезгунов А.Ю., Дубинский А.А., Михайлов А.И. // Химия высоких энергий. 2004. Т. 38. № 5. С. 337.
Оджаев В.Б., Козлов И.П., Попок В.Н., Свиридов Д.В. Ионная имплантация полимеров. Минск: Белгосуниверситет. 1998. 197 с.
Поздняков А.О., Хандге У.А., Кончиц А.А., Альтштадт Ф. // Письма в Журнал технической физики. 2010. Т. 36. № 20. С. 67.
Gardziella A., Pilato L.A., Knop A. Phenolic Resins. Chemistry, Applications, Standardization, Safety and Ecology. (2nd. ed.) Berlin Heidelberg: Springer-Verlag. 2000. 566 p.
Экспериментальные методы химии высоких энергий / Под ред. Мельникова М.Я. М.: МГУ, 2009. С.169.
Пикаев А.К. Современная радиационная химия. Твердое тело и полимеры. Прикладные аспекты М: Наука. 1987. 448 с.
Бринкевич С.Д., Резцов И.А., Шадыро О.И. // Химия высоких энергий. 2014. Т. 48. № 5. С. 350.
Бринкевич С.Д. // Химия высоких энергий. 2015. Т. 49. № 2. С. 83.
Бринкевич Д.И., Бринкевич С.Д., Вабищевич Н.В., Оджаев В.Б., Просолович В.С. // Микроэлектроника. 2014. Т. 43. № 3. С. 193.
Вабищевич С.А., Бринкевич С.Д., Бринкевич Д.И., Просолович В.С. // Химия высоких энергий. 2020. Т.54. № 1. С. 54.
Samovich S.N., Brinkevich S.D., Edimecheva I.P., Shadyro O.I. // Radiation Physics and Chemistry. 2014. V. 100. P. 13.
Бринкевич С.Д., Шадыро О.И. // Химия высоких энергий. 2018. Т. 52. № 4. С. 347.
Харченко А.А., Бринкевич Д.И., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2015. № 1. С. 94.
Бринкевич Д.И., Харченко А.А., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б., Валеев В.Ф., Нуждин В.И., Хайбуллин Р.И. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2017. № 8. С.25.
Харченко А.А., Бринкевич Д.И., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2015. № 4. С. 60.
Дополнительные материалы отсутствуют.
Инструменты
Химия высоких энергий








