Химия высоких энергий, 2021, T. 55, № 6, стр. 461-468
Адгезия облученных пленок диазохинонноволачного фоторезиста к монокристаллическому кремнию
С. А. Вабищевич a, С. Д. Бринкевич b, *, Н. В. Вабищевич a, Д. И. Бринкевич b, В. С. Просолович b
a Полоцкий государственный университет
214400 Новополоцк,
ул. Блохина, 29, Беларусь
b Белорусский государственный университет
220050 Минск, пр. Независимости, 4, Беларусь
* E-mail: brinkevichsd@bsu.by
Поступила в редакцию 02.06.2021
После доработки 02.07.2021
Принята к публикации 06.07.2021
Аннотация
В работе методом индентирования исследовано влияние γ-облучения на адгезионные свойства пленок диазохинонноволачного фоторезиста ФП9120, нанесенных на пластины монокристаллического кремния методом центрифугирования. Установлено, что γ-облучение приводит к снижению значений удельной энергии отслаивания G фоторезистивных пленок на кремнии. При этом в ИК-спектрах фоторезиста в ходе γ-облучения было отмечено уменьшение интенсивности полос колебаний, связанных с Si–O–C фрагментом, ответственным за адгезию к кремнию. Наблюдаемые экспериментальные результаты объяснены с учетом радиационно-химических и релаксационных процессов, протекающих как на границе раздела фоторезист/кремний, так и в объеме полимерной пленки.
ВВЕДЕНИЕ
Современный технологический процесс получения изделий электроники основан на применении фотолитографии (ФЛ) – метода формирования заданного рисунка на кремниевой подложке для получения необходимой топологии микросхем [1]. В процессе изготовления микросхемы на одной пластине операции ФЛ повторяются многократно. Так, при формировании элементной базы по n-МОП технологии применяется до 10 операций фотолитографии, в то время как в БИКМОП технологии применяется порядка 22 операций ФЛ [2].
Материалами, позволяющими осуществлять литографические процессы, являются резисты – химические вещества или их смеси, изменяющие под действием высокоэнергетического излучения (ультрафиолетового, рентгеновского, потока электронов или других ионов) свои физико-химические свойства. Наиболее широкое применение в технологических процессах микроэлектроники получили позитивные двухкомпонентные фоторезисты (ФЛ) на базе светочувствительного о-нафтохинондиазида и новолачной смолы, используемой в качестве основы. Под воздействием излучения с длиной волны λ ~ 300–350 нм о-нафто-хинондиазид в фоторезистивной пленке подвергается деазотированию и далее превращается в 1-Н-инден-3-карбоновую кислоту (реакция (1)) вследствие наличия в пленке 1–2% воды. В результате этого фотохимического процесса облученные области фоторезиста становятся растворимыми в 0.1–0.3 М щелочном проявителе [1, 2].
Позитивный фоторезист марки ФП9120, который представляет собой композит из о-нафтохинондиазида и смеси фенол- и крезолоформальдегидных смол, широко используется в современной полупроводниковой электронике в качестве защитного светочувствительного материала в прецизионных фотолитографических процессах при изготовлении полупроводниковых приборов и интегральных микросхем [2]. Одной из наиболее важных технологических характеристик фоторезистивных пленок является их адгезия к подложке монокристаллического кремния.
Необходимость увеличения разрешения литографического процесса диктует в соответствие с критерием Релея переход от УФ-излучения к более коротковолновому излучению – рентгеновскому или γ-излучению. Ранее в [3, 4] показано, что γ-облучение может существенным образом изменять спектральные характеристики и микротвердость фоторезистивных пленок на кремнии. Однако влияние γ-облучения на адгезию пленок диазохинонноволачных ФР к монокристаллическому кремнию до настоящего времени не исследовалось. Отметим также, что использование изотопных источников γ-излучения является наиболее доступным и отработанным способом исследования процессов, индуцируемых под действием ионизирующего фотонного излучения в различных материалах.
Целью настоящей работы было исследование влияния γ-облучения на адгезию пленок диазохинон-новолачного фоторезиста ФП9120 к монокристаллическому кремнию, а также выявление радиационно-химических процессов, лежащих в основе наблюдаемых закономерностей.
МЕТОДИКА ИЗМЕРЕНИЙ
Пленки диазохинонноволачного резиста марки ФП9120 толщиной от 1.0 до 2.5 мкм наносились на поверхность монокристаллических пластин (диаметр 100 мм) кремния КДБ10 с ориентацией (111) методом центрифугирования. Толщина пленки резиста hпл задавалась скоростью вращения и составляла: 1.0 мкм при скорости вращения v = = 8300 об/мин; 1.8 мкм – при v = 2900 об/мин; 2.5 мкм – при v = 1200 об/мин. Толщина пленок контролировалась с помощью микроинтерферометра МИИ-4, при этом отклонения от среднего значения для всех исследуемых образцов не превышали 2%, что близко к погрешности измерений.
Микроиндентирование проводилось на приборе ПМТ-3 по стандартной методике при комнатной температуре [3]. В качестве индентора использовался алмазный наконечник в форме четырехгранной пирамиды с квадратным основанием и углом при вершине α = 136°. Нагрузка (P) на индентор варьировалась в пределах от 1 до 100 г. Длительность нагружения составляла 2 с; выдержка под нагрузкой 5 с. Для надлежащей визуализации отпечатка измерения выполнялись на микроскопе Axiovert-10 в поляризованном свете.
Удельная энергия отслаивания пленок (G) рассчитывалась по формуле (2), используемой для исследования различных полимерных пленок на стеклянных подложках [5]:
(2)
$G = \frac{{0.627{{H}^{2}}h\left( {1 - {{\nu }^{2}}} \right)}}{{E{{{\left( {1 + \nu + 2\left( {1 - \nu } \right){{H{{l}^{2}}} \mathord{\left/ {\vphantom {{H{{l}^{2}}} P}} \right. \kern-0em} P}} \right)}}^{2}}}},$Длина трещины расслоения принималась равной расстоянию от центра отпечатка до границы разрушения сферической области. Рассчитывалось среднее значение длины трещины расслоения для всей серии отпечатков данной нагрузки. Значение микротвердости Н полимера для расчетов G выбиралось равным 0.35 ГПа, что соответствовало значениям Н для тех нагрузок, при которых глубина проникновения индентора не превышает 50% толщины пленки. Этот выбор обусловлен тем, что подложка оказывает существенное влияние на величину микротвердости композиций пленка–подложка [6]. В случае “мягкой” пленки на “твердой” подложке пластическая деформация локализуется в пленке, и микротвердость композиции пленка–подложка существенно возрастает лишь при глубине проникновения индентора, равной толщине пленки.
При каждом измерении на поверхность образца наносилось не менее 50 отпечатков. Для обработки экспериментальных данных использовались стандартные методы математической статистики [3]. Погрешность измерения удельной энергия отслаивания резистивных пленок на пластинах монокристаллического кремния составляла 11% (с доверительной вероятностью 0.95).
Облучение γ-квантами 60Со осуществлялось при комнатной температуре и атмосферном давлении на установке MPX-γ-25M. Мощность поглощенной дозы составляла 0.110 ± 0.008 Гр/с. Интервал поглощенных доз – от 1 до 300 кГр. Имплантация ионами Р+ (энергия 100 кэВ) и В+ (энергия 60 кэВ) в интервале доз Ф = 5 × 1014–1 × × 1016 cм–2 в режиме постоянного ионного тока (плотность ионного тока j = 4 мкА/см2) проводилась при комнатной температуре в остаточном вакууме не хуже 10–5 Па на ионно-лучевом ускорителе “Везувий-6”.
Спектры нарушенного полного внутреннего отражения (НПВО) структур фоторезист/кремний регистрировались в диапазоне волновых чисел ν = 400–4000 см–1 при комнатной температуре ИК-Фурье спектрофотометром ALPHA (Bruker Optik GmbH) [7]. Разрешение было не хуже 2 см–1, количество сканов – 24. Коррекция фона проводилась перед каждым измерением.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Приведенные на рис. 1 и 2 экспериментальные данные указывают на то, что γ-облучение приводит к снижению значений удельной энергия отслаивания G фоторезистивных пленок на кремнии. Этот эффект наиболее выражен при нагрузках свыше 10 г, когда индентор глубоко проникает в Si и преобладает латеральная составляющая отрывного усилия. Относительное изменение энергии отслаивания ΔG/G при γ-облучении не проявляло существенной зависимости от толщины фоторезистивной пленки. Так после облучения γ-квантами дозой 270 кГр пленки фоторезиста толщиной 1 мкм ΔG/G при нагрузке 50 г составляло ~30%, а в пленках толщиной 2.5 мкм при той же нагрузке ΔG/G = 40%.
Рис. 1.
Зависимости удельной энергии отслаивания G от величины нагрузки для исходных 1 и облученных γ-квантами дозой 270 кГр 2 пленок фоторезиста ФП9120 толщиной 2.5 мкм.
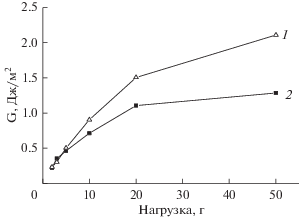
Рис. 2.
Зависимости удельной энергии отслаивания G от величины нагрузки для исходных (а) и имплантированных Р+ (б) пленок фоторезиста ФП9120 толщиной 1.0 мкм. Поглощенная доза γ-излучения: 1 – 0; 2 – 270.
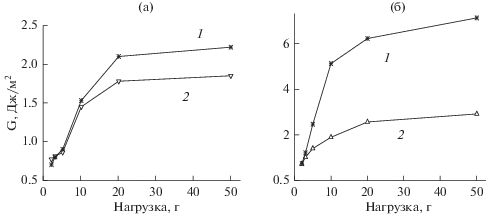
Поскольку ранее [8] было показано, что имплантация ионов B+ и P+ приводит к увеличению удельной энергии отслаивания G диазохинонноволачных фоторезистивных пленок в 2–3 раза, в работе также было исследовано влияние γ-облучения на адгезию пленок, предварительно имплантированных фосфором и бором. В этих образцах эффект снижения удельной энергия отслаивания G после γ-облучения был существенно выше, чем в неимплантированных пленках (сравни рис. 2а и 2б). Так в имплантированных фосфором пленках фоторезиста величина G снижалась в 3.5 раза (рис. 2б), бора также в ~3 раза; в то время как в неимплантированных образцах ΔG/G = 30% (рис. 2а). Кроме того, оказалось, что облучение γ-квантами практически полностью нивелирует имплантационное увеличение адгезии фоторезистивной пленки к кремнию. Значения удельной энергии отслаивания G после γ-облучения обоих типов составляли ~1.8–2.6 Дж/м2 (кривые 2 на рис. 2а, 2б).
Полученные методом индентирования экспериментальные данные коррелируют с результатами измерений спектров нарушенного полного внутреннего отражения. Ранее в работе [9] было показано, что адгезия фоторезистивных пленок ФП9120 к кремнию обусловлена образованием на границе раздела фоторезист/кремний Si–O–C связи, наиболее интенсивные колебания которой наблюдаются при ~1070, 970 и ~780 см–1. Облучение γ-квантами приводило к снижению интенсивности указанных колебаний (рис. 3), что свидетельствует о разрыве адгезионных Si–O–C связей при γ-облучении фоторезистивной пленки. При этом заметные изменения спектров НПВО фоторезистивных пленок толщиной 2.5 мкм наблюдались при дозах γ-квантов свыше 200 кГр.
Рис. 3.
Полосы колебаний адгезионных Si–O–C связей при ~780 см–1 в спектрах НПВО имплантированных В+ (1) и затем облученных γ-квантами дозой 270 кГр (2) пленок фоторезиста ФП9120 толщиной 2.5 мкм.

Полученные экспериментальные результаты являются следствием реализации комплекса радиационно-химических процессов в пленке ФР, нанесенной на монокристаллический кремний. Под воздействием γ-излучения реакции возбуждения (3) и ионизации (4) макромолекул происходят в объеме полимера.
Свободнорадикальные частицы, образующиеся в результате ион-молекулярных реакций (5), распада возбужденных частиц (6), а также радикал-молекулярных взаимодействий, например, (7) будут достаточно равномерно распределены по объему полимерной пленки при облучении ФР фотонным излучением. Наиболее термодинамически стабильными в силу делокализации спиновой плотности по ароматической системе и, следовательно, более распространенными парамагнитными частицами при облучении будут радикалы феноксильного (II) и метиленового (III) типа.
Одной из наиболее очевидных причин снижения адгезии фоторезиста к кремнию в результате γ-облучения является формирование сшивок в объеме пленки [10, 11]. Как известно [12], в фенолформальдегидных смолах, являющихся основой фоторезиста, при электронном и γ-облучении наблюдаются преимущественно реакции рекомбинации радикалов (в основном феноксильного (II) и метиленового типов (III)), а не процессы деструкции. В результате сшивания полимер становится более жестким и теряет свои пластические свойства [3]. При надавливании на γ-облученный ФР нагрузка в основном передается на межфазную границу полимер–кремний, в то время как при индентировании необлученной фоторезистивной пленки происходит изменение конформации макромолекул под пирамидкой, из-за чего нагрузка распределяется на больший объем/площадь полимера. Более того, при сшивании ФР увеличивается плотность резистивной пленки. Это приводит к формированию упругих напряжений на границе раздела фоторезист/кремний, приводящих к ухудшению адгезии полимера к кремниевой подложке.
Изменения адгезионных свойств фоторезиста к монокристаллическому кремнию в условиях облучения может быть обусловлено и релаксационными процессами. Образующаяся в процессах прямого возбуждения под действием ионизирующего излучения (3) или в результате косвенных процессов (рекомбинации радикалов, а также нейтрализации разноименно заряженных ионов) энергия возбуждения может передаваться на большие расстояния по макромолекулам полимера, особенно если величина энергии недостаточна для распада молекул на радикалы (~4 эВ) по реакции (6). При γ-облучении значительная часть энергии ионизирующего излучения конвертируется в низкоэнергетическое возбуждение макромолекул и “накапливается” на межфазных границах, на дефектах и включениях в пленке [13]. При этом энергии низкоэнергетического возбуждения достаточно для различных конформационных изменений в структуре фенолформальдегидной смолы (т.е. связанных с расположением полимерной цепи в объеме пленки). В результате чего под действием γ-излучения может происходить релаксация напряжений в пленке, возникших в процессе ее нанесения центрифугированием и при сушке, что в конечном итоге будет проявляться снижением адгезии фоторезиста к кремнию.
Важно также учитывать явление накопления электрического заряда в полимере при воздействии ионизирующего излучения, которое наиболее актуально для эксплуатации космической техники [14] и при электронной литографии [15]. При достижении критической величины заряда происходит электрический пробой, который может приводить к сбою в работе электронных схем и нарушению технологических процессов [14]. Эмиссия электронов сквозь тонкие диэлектрические пленки (эффект Малтера) хорошо изучена [16]. Для ее инициирования обычно необходимо внешнее воздействие (облучение фотонами, ионная имплантация) [16]. Эффект накопления электрического заряда связан с тем, что электроны, выбиваемые при ионизации в полимерной пленке, стекают на границы раздела фаз. В нашем случае при γ-облучении они, в основном, накапливаются в приповерхностном слое кремния. При этом в полимере остаются катион-радикалы, а потом и катионы, что приводит к возникновению объемного заряда (разности потенциалов) на границе раздела фоторезист/кремний. При этом основное падение напряжения приходится на слой полимера толщиной ~10 нм, непосредственно контактирующий с полупроводником. У границы фоторезист/кремний создается так называемое “греющее” поле с напряженностью до 5 × 107 В/см [16]. Это поле может модифицировать структуру полимера вблизи границы раздела фаз и снижать адгезию фоторезиста к кремнию.
Процессы с участием электронов на границе раздела фоторезист/кремний при γ-облучении могут быть причиной сильного снижения адгезии к монокристаллическому кремнию предварительно имплантированного ионами Р+ фоторезиста (рис. 2б). Ранее мы показали [9], что высокое значение удельной энергии отслаивания пленки G от подложки для имплантированного ионами ФР обусловлено формированием Si–O–C фрагментов на границе раздела фаз. В условиях глубокого вакуума, необходимого для проведения ионной имплантации, из пленки удаляются остаточные растворители, включая воду. Поэтому перенос энергии возбуждения по макромолекулам полимера на фрагменты о-нафтохинондиазида и последующее деазотирование не приводят к образованию инденкарбоновой кислоты по реакции (1). Вместо этого реакционноспособный кетен (I) присоединяет по кратной связи доступные для взаимодействия гидроксильные группы. В результате взаимодействия с НО-группой фенолформальдегидной смолы в объеме происходит образование сложноэфирных связей, проявляющееся как увеличение микротвердости ФР [3]. На поверхности раздела фоторезист/кремний реализуется этерификация по реакции (8) с образованием Si–O–C фрагментов, увеличивающих адгезионное взаимодействие пленки к подложке [9].
Характерной особенностью всех карбонилсодержащих соединений является их способность присоединять электрон [17, 18]. Реализация такой реакции (9) для кремний-органического эфира (IV) должна приводить к образованию анион-радикала (V), способного подвергаться гетеролитической и гомолитической фрагментации по реакциям (10) и (11) соответственно.
Таким образом, причиной снижения адгезии пленки фоторезиста к монокристаллическому кремнию при γ-облучении является в том числе и перенос электронов на межфазную границу и последующая деструкция связей Si–O–C по реакциям (10) и (11).
Необходимо также отметить, что образованию новых адгезионных связей на границе фоторезист/кремний при облучении γ-квантами препятствует активное разложение о-нафтхинондиазида и кетена (I), вероятно, под действием электронов и Н-атомов. Так в процессе γ-облучения мы наблюдали полное удаление полос колебаний, обусловленных С=С=О-группой, уже при дозе 50 кГр [4]. Разложение о-нафтхинондиазида под действием электронного излучения отмечали также авторы [10].
ЗАКЛЮЧЕНИЕ
Таким образом, установлено, что γ-облучение приводит к снижению значений удельной энергии отслаивания G фоторезистивных диазохинонноволачных пленок на кремнии. Эффект наиболее выражен для пленок фоторезистов, предварительно имплантированных ионами P+ или B+. Наблюдаемый эффект связан с совокупностью радиационно-химических и релаксационных процессов, протекающих как на границе раздела фоторезист/кремний, так и в объеме полимерной пленки. В частности, к снижению адгезии могут приводить сшивание макромолекул новолака в объеме полимера с изменением плотности фоторезиста, релаксация напряжений в пленке вследствие конформационных перестроек макромолекул в процессе γ-облучения, а также накопление заряда на межфазной границе. Данные ИК-спектрометрии НПВО свидетельствуют, что снижение адгезии ФР к монокристаллическому кремнию при γ‑облучении происходит в том числе и вследствие разрушения сложноэфирных сшивок, образованных гидроксильными группами на поверхности оксидного слоя кремниевой пластины и карбоксильными группами 1-Н-инден-3-карбоновой кислоты, привитой к новолачной смоле.
Список литературы
Моро У. Микролитография. Принципы, методы, материалы. В 2-х ч. Ч.2. М.: Мир, 1990. 632 с. (Moreau W.М. Semiconductor Lithography. Principles, Practices, and Materials. Plenum Press. N.Y., London. 1988.)
Бринкевич Д.И., Бринкевич С.Д., Вабищевич Н.В., Оджаев В.Б., Просолович В.С. // Микроэлектроника. 2014. Т. 43. № 3. С.193. https://doi.org/10.7868/ S0544126914010037
Вабищевич С.А., Вабищевич Н.В., Бринкевич Д.И., Просолович В.С., Янковский Ю.Н., Бринкевич С.Д. // Вестник Полоцкого государственного университета. Серия С. Фундаментальные науки. Физика 2016. № 12. С. 30.
Бринкевич С.Д., Бринкевич Д.И., Просолович В.С., Свердлов Р.Л. // Химия высоких энергий. 2021. Т. 55. № 1. С. 66–75.
Malzbender J., den Toonder J.M.J., Balkenende A.R., de With G. // Materials Science and Engineering R. 2002. V. 36. P. 47.
Шугуров А.Р., Панин А.В., Осколков К.В. // Физика твердого тела. 2008. Т. 50. № 6. С. 1007.
Бринкевич С.Д., Гринюк Е.В., Бринкевич Д.И., Просолович В.С. // Химия высоких энергий. 2020. Т. 54. № 5. С. 377.
Вабищевич С.А., Бринкевич С.Д., Бринкевич Д.И., Просолович В.С. // Химия высоких энергий. 2020. Т. 54. № 1. С. 54.
Бринкевич С.Д., Гринюк Е.В., Свердлов Р.Л., Бринкевич Д.И., Просолович В.С., Петлицкий А.Н. // Журн. прикладной спектроскопии. 2020. Т. 87. № 4. С. 589.
Тригуб В.И., Маравина С.Е., Федоров А.Е., Яничкин В.А., Смирнов С.В. // Физика и химия обработки материалов. 2004. № 2. С. 30.
Livesay W.R., Rubiales A.L., Ross M.F., Woods S.C., Campbell S. // Proc. SPII 1925. Advances in Resist Technology and Processing X (15.09.1993) https://doi.org/10.1117/12.154778
Олешкевич А.Н., Лапчук Н.М., Оджаев В.Б., Карпович И.А., Просолович В.С., Бринкевич Д.И., Бринкевич С.Д. // Микроэлектроника. 2020 Т. 49. № 1. С. 58.
Экспериментальные методы химии высоких энергий / Под ред. Мельникова М.Я. М.: МГУ, 2009. С. 169.
Абрамешин А.Е. // Технологии электронной совместимости. 2012. № 3. С. 29.
Рау Э.И., Евстафьева Е.Н., Зайцев С.И., Князев М.А., Свинцов А.А., Татаринцев А.А. // Микроэлектроника. 2013. Т. 42. № 2. С. 116.
Корнилов В.М., Лачинов А.Н., Логинов Б.А., Беспалов В.А. // Журн. технической физики. 2009. Т. 79. № 5. С. 116.
Бринкевич С.Д., Резцов И.А., Шадыро О.И. // Химия высоких энергий. 2014. Т. 48. № 5. С. 350.
Пикаев А.К. Современная радиационная химия. Радиолиз газов и жидкостей / Под ред. В.И. Спицына. М.: Наука, 1986. 439 с.
Дополнительные материалы отсутствуют.
Инструменты
Химия высоких энергий