Химия высоких энергий, 2022, T. 56, № 4, стр. 284-292
Ионная имплантация диазохинонноволачного фоторезиста
Д. И. Бринкевич a, *, С. Д. Бринкевич a, b, **, В. С. Просолович a
a Белорусский государственный университет
220030 Минск, Беларусь
b ООО МИГ Сколково Ядерная медицина
127299 Москва, ул. Большая Академическая, д. 4, Россия
* E-mail: brinkevich@bsu.by
** E-mail: s.brinkevich@medinvest-group.ru
Поступила в редакцию 31.01.2022
После доработки 03.03.2022
Принята к публикации 04.03.2022
- EDN: LECGAE
- DOI: 10.31857/S0023119322040052
Аннотация
Методами ИК-Фурье спектроскопии нарушенного полного внутреннего отражения, индентирования и измерения спектров отражения исследованы процессы модификации структурных и оптических свойств пленок диазохинонноволачных фоторезистов марок ФП9120 и S1813 на пластинах монокристаллического кремния за областью пробега ионов при имплантации легкими В+, Р+ и тяжелыми ионами Sb+. Показано, что при имплантации легких ионов В+ и Р+ доминирующими являются процессы с участием фоточувствительной компоненты ФР – нафтохинондиазида, которые приводят к образованию кетена и последующим реакциям с его участием. При имплантации тяжелых ионов Sb+ радиационно-индуцированные реакции за слоем внедрения протекают преимущественно с участием макромолекул основного компонента ФР – фенолформальдегидной смолы. Установленные различия обусловлены преобладающим влиянием электронного механизма торможения для легких ионов и ядерного механизма торможения для тяжелых ионов.
ВВЕДЕНИЕ
Литография – один из основных технологических процессов микро- и наноэлектроники [1], многократно повторяющийся на различных стадиях производства приборов микро- и оптоэлектроники. Так, при формировании элементной базы по БИКМОП технологии применяется до 22 операций фотолитографии [2]. Именно технические параметры литографии в значительной степени определяют эффективность производства и качество производства изделий электроники. В качестве защитного светочувствительного материала (фоторезиста (ФР)) в литографических процессах при изготовлении полупроводниковых приборов, интегральных схем, металлизированных шаблонов, шкал, сеток, печатных плат широко применяются композиты из фенолформальдегидных смол и нафтохинондиазида [1].
В настоящее время наблюдается возрастание роли ионной имплантации (ИИ) в производственных процессах современной электроники [3]. Повышение степени интеграции предъявляет высокие требования к блоку операций, обеспечивающих маскирование ионного пучка, что обуславливает повышенный интерес к процессам модификации свойств фоторезистивной пленки на пластинах монокристаллического кремния при ИИ. При облучении полимерных материалов ускоренными ионами происходит перестройка их структуры. Колебания большинства молекулярных групп полимеров лежат в средней ИК-области, поэтому исследование спектров поглощения в этом диапазоне дает ценную информацию о модификации структуры фоторезистов при ИИ.
Модификация структуры диазохинонноволачного (ДХН) резиста марки AZ-1350 J в области пробега RP ионов с различной массой и, следовательно, с разным типом торможения, рассмотрена в публикации [4]. Однако в указанной работе пробег заряженных частиц сопоставим или превышает толщину пленки. В то время как при используемых в микроэлектронике энергиях пробег ионов существенно меньше толщины фоторезистивной пленки, обычно составляющей 1.0–2.5 мкм. Так при имплантации ионов В+ с энергией 100 кэВ проецируемый пробег ионов RP составляет ~ 0.4 мкм, а для ионов Sb+ с энергией 60 кэВ – RP = 0.06 мкм [2, 5]. С другой стороны, известно [5–7], что при ИИ трансформация структуры полимерных материалов может наблюдаться далеко за областью пробега ионов – на расстоянии 1–5 мкм и более. При толщине фоторезистивных пленок, использующихся в современных литографических процессах (менее 3 мкм), это может приводить к модификации физико-механических свойств по всей толщине пленки и, что более важно, изменять адгезию ФР к кремниевой пластине [8]. Однако механизм трансформации под действием ионной имплантации структуры ДХН-резистов за областью пробега ионов и, соответственно, изменения физико-механических и адгезионных свойств фоторезистивных пленок на Si, к настоящему времени окончательно не установлен. Отметим, что эффект дальнодействия – изменение структуры и свойств пленок на глубинах, значительно превышающих область пробега имплантированных ионов, – наблюдался ранее различными авторами в твердых телах и полимерах [2, 5–9].
Ранее в работе [10] установлено, что основной вклад в ИК-спектры нарушенного полного внутреннего отражения (НПВО) пленок ФР на кремнии в области волновых чисел 400–4000 см–1 вносит слой фоторезиста за областью пробега ионов, что позволяет методом НПВО получать объективную информацию о модификации структуры ФР в данной области.
Целью настоящей работы являлось исследование особенностей модификации структурных и оптических свойств пленок ДХН-резистов марок ФП9120 и S1813 на пластинах монокристаллического кремния за областью пробега ионов при имплантации легкими и тяжелыми ионами.
МЕТОДИКА ЭКСПЕРИМЕНТА
Пленки позитивного фоторезиста марок ФП9120 и S1813 толщиной 1.0–5.0 мкм наносились методом центрифугирования на поверхность пластин монокристаллического кремния с ориентацией (100) и (111) [11]. Перед формированием пленки ФР кремниевые пластины подвергали стандартному циклу обработки поверхности в органических и неорганических растворителях с целью очистки от различного вида поверхностных загрязнений. После нанесения фоторезиста на рабочую сторону пластины проводилась сушка в течение 50–55 мин при температуре 88°С.
Имплантация ионами B+, Р+ и Sb+ (энергия 30–100 кэВ) в интервале доз 5 × 1014 –6 × 1017 cм–2 в режиме постоянного ионного тока (плотность ионного тока j = 4 мкА/см2) проводилась при комнатной температуре в остаточном вакууме не хуже 10–5 Па на имплантаторе “Везувий-6”. Использовавшиеся режимы ионной имплантации широко применяются при производстве интегральных микросхем.
Спектры нарушенного полного внутреннего отражения (НПВО) структур фоторезист–кремний в диапазоне ν = 400–4000 см–1 регистрировались при комнатной температуре ИК-Фурье спектрофотометром ALPHA (Bruker Optik GmbH). Разрешение составляло 2 см–1, количество сканов – 24. Коррекция фона проводилась перед каждым измерением.
Исследование прочностных свойств проводилось при комнатной температуре на приборе ПМТ-3 методом микроиндентирования. Нагрузка на индентор в виде четырехгранной алмазной пирамиды с квадратным основанием в оправе типа НПМ и углом при вершине α = 136° варьировалась в пределах 1–100 г. Длительность нагружения составляла 2 с; выдержка под нагрузкой 5 с. При каждом измерении на поверхность образца наносилось не менее 50 отпечатков и проводилась обработка результатов измерений с использованием методов математической статистики. Для количественной оценки адгезионных свойств определяли удельную энергию отслаивания пленок (G), широко используемую для исследования различных полимерных пленок на стеклянных подложках [8] и рассчитываемую по формуле (1):
где h – толщина пленки; ν – коэффициент Пуассона (использовалось значение 0.3), Е – модуль Юнга (для исследовавшейся пленки 8 ГПа); Р – нагрузка на индентор, l – длина трещины расслоения.ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Установлено, что при помещении в 3М водный раствор KOH необлученная пленка фоторезиста набухает и без внешних воздействий отслаивается, причем полное отслаивание пленки происходит в течение 30–50 с. Имплантированная дозами 5 × 1014 – 6 × 1017 cм−2 для всех видов ионов фоторезистивная пленка значительно более устойчива к воздействию щелочного раствора, причем растворяется она неоднородно. На поверхности структуры через несколько минут пребывания в растворе 3M KOH появляются светлые линии, обусловленные локальным растворением пленки фоторезиста до кремниевой подложки. Их количество и размеры (длина и ширина) увеличиваются со временем. По краям этих линий наблюдается небольшое отслаивание пленки от кремния. Процесс травления длится до 90 мин и заканчивается образованием на поверхности кремниевой подложки сетки, которая отслаивается от Si и распадается на отдельные углеродные “нити”, едва видимые невооруженным глазом и не растворимые в 3М КОН [2].
Такое поведение пленок обусловлено тем, что при указанных выше дозах пленка ФР карбонизируется в области пробега ионов и этот слой становится нерастворимым в водном растворе 3М KOH. ФР за областью пробега ионов сохраняет свойства фенолформальдегидной смолы и растворяется в 3М KOH, хотя скорость его травления значительно ниже, чем исходных пленок ФР. Снижение скорости травления свидетельствует о структурных и конформационных изменениях ФР за слоем внедрения ионов. Проникновение травителя к слою ФР за областью пробега ионов и, соответственно, его растворение идет по микротрещинам в имплантированном слое, формирующемся в процессе облучения. С увеличением длительности травления трещины увеличиваются как по ширине, так и в длину, формируя кружевные сетки, которые распространяются по поверхности и превращают остатки ФР в островки, уменьшающиеся со временем в размерах. Остатки имплантированного слоя формируют нерастворимые в 3М КОН углеродные волокна (“нити”). Такое поведение наблюдалось при имплантации различными видами ионов обоих марок диазохинон-новолачных фоторезистов ФП9120 и S1813.
При исследовании спектров нарушенного полного внутреннего отражения пленок ФР на кремнии было показано [10, 12], что в процессе имплантации как легкими (В+ и Р+), так и тяжелыми (Sb+) ионами происходит интенсивная трансформация спектра НПВО, выражающаяся в перераспределении интенсивности полос плоскостных деформационных колебаний О–Н связей и пульсационных колебаний углеродного скелета ароматических колец. Заметного разрушения или повреждения ароматических колец при ИИ за областью пробега ионов не наблюдается, однако изменяется состав их заместителей, что приводит к перераспределению интенсивности валентных колебаний. Наблюдалось также увеличение интенсивности и смещение в низкоэнергетичную полос колебаний С=О связей, обусловленное удалением водорода в процессе имплантации, которое приводит к возникновению систем сопряженных связей >С=О и >C=C<, например, хиноидных структур в пленке ФР и, соответственно, к изменению спектроскопических характеристик указанных связей. В процессе ИИ наблюдается слабое смещение в низкоэнергетичную область максимумов валентных колебаний С–Н-связей и перераспределение интенсивностей между максимумами, обусловленными концевой метильной и метиленовой группами в пользу последней. Это свидетельствует о радиационном сшивании молекул новолачной смолы с участием радикалов, локализованных на концевых метильных группах. Такие реакции подробно рассмотрены в работе [10, 13]. У полосы 1430–1455 см–1, обусловленной валентными колебаниями ароматического кольца, связанными с СН2-мостиком, в процессе имплантации наблюдается перераспределение интенсивности между максимумами 1451 и 1433 см–1, обусловленное образованием водородных связей по СН2-мостику. Образование сшивок приводит к росту микротвердости пленки, наблюдавшемуся в работах [2, 14]. Интенсивность рассмотренных выше радиационно-индуцированных процессов зависит от условий имплантации – массы и энергии иона, плотности ионного тока и т.д.
В спектрах НПВО после имплантации легкими ионами В+ и Р+ появляется интенсивная полоса с двумя максимумами при 2151 и 2115 см–1, обусловленная валентными колебаниями двойных кумулятивных связей С=С=О [10]. Появление этих полос обусловлено образованием кетена(II) в результате радиационно-индуцированной перегруппировки Вольфа по реакции (2). Идентичный процесс происходит и при УФ-облучении фоторезиста, однако он заканчивается образованием инденкарбоновой кислоты вследствие быстрого присоединения воды. В условиях высокого вакуума при ионной имплантации и, как следствие, удаления воды из пленки [2] у кетена(II) значительно менее реакционноспособное окружение. Это в купе со стабилизацией в полимерной матрице позволяет регистрировать соединение(II) в имплантированном ФР по характерным максимумам колебаний двойных кумулятивных связей С=С=О.
Кроме того, после имплантации легких ионов наблюдалось усиление адгезии ФР к кремнию, обусловленное взаимодействием кетена с гидроксильными группами поверхностного слоя кремниевой пластины по реакции (3) [15].
Имплантация тяжелыми ионами Sb+ приводила к более сильной, чем в случае легких ионов, радиационно-индуцированной модификации ФР за слоем внедрения. Наблюдалось интенсивное образование сшивок макромолекул обоих компонентов ФР, приводящее к сильному росту (почти на порядок) микротвердости фоторезистивной пленки [2]. Одновременно снижалась адгезия полимера к кремнию. Так, при флюенсах > 5 × 1016 см–2 удельная энергия отслаивания полимерной пленки G снижалась на порядок до значений 0.1–0.2 Дж/м2 и индентор практически не испытывал сопротивления при прохождении границы раздела фоторезист/Si. При этом нарушение адгезии приводило к появлению в спектре НПВО полосы 610 см–1, связанной с решеточным поглощением Si [12].
Существенные различия спектров НПВО при имплантации легкими и тяжелыми ионами наблюдаются в области 2000–2400 см–1, характерной для колебаний двойных куммулятивных связей [16]. Так, после имплантации Sb+ в спектре НПВО пленок ФР появляется полоса при 2331 см–1, обусловленная валентными колебаниями О=С=О (рис. 1), которая отсутствует при имплантации легкими ионами. Интенсивность указанной полосы растет пропорционально увеличению дозы имплантации [12]. Обратная ситуация с полосой в диапазоне 2151–2115 см–1, обусловленной валентными колебаниями двойных кумулятивных связей С=С=О в кетене. Она наблюдается при внедрении легких ионов бора и фосфора [10] и отсутствует в образцах, имплантированных тяжелыми ионами Sb+ [12].
Рис. 1.
Спектры НПВО исходной (1) и имплантированных Sb+ дозами 1 × 1016 см–2 (2) и 5 × 1016 см–2 (3) пленок ФП9120 в области двойных кумулятивных связей.

Имплантация приводила также к уменьшению оптической длины 2nd (n – показатель преломления; d – толщина пленки) имплантированных пленок фоторезиста (рис. 2). Здесь n – показатель преломления; d – толщина пленки. Поскольку в работе [11] было показано, что толщина пленки в процессе имплантации дозой Ф до 1 × 1017 см–2 не изменяется, это свидетельствует об уменьшении показателя преломления n фоторезиста, обусловленном радиационным сшиванием молекул новолачной смолы и выделением газа (преимущественно водорода и его соединений). Снижение n становилось существеннее при увеличении флюенса. Для Ф = 5 × 1016 см–2 при имплантации фосфора оно составляло от ~ 4.5% (при λ = 1050 нм) до 3.3% (при λ = 500 нм) [11]. Отметим, что при имплантации ионами Sb+ снижение показателя преломления n фоторезиста составляло 16.2% (при λ = = 1050 нм) для Ф = 5 × 1016 см–2 и было ~ 4 раза сильнее, чем в случае внедрения B+ и P+.
Рис. 2.
Спектральные зависимости оптической длины исходного фоторезиста (1) и имплантированного В+ (2) и Sb+ (3) дозой 5 × 1016 см–2.
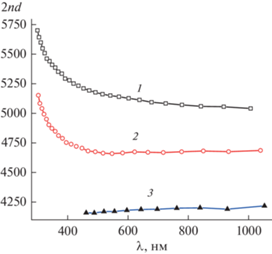
Показатель преломления n полимера связан с молярной массой М, плотностью вещества ρ и молекулярной рефракцией RM следующим выражением [11, 17]:
Молекулярная рефракция RM является аддитивной величиной и складывается из рефракций Ri отдельных атомов и инкрементов для типов химических связей (двойная, тройная).
Из формулы (4) следует, что обусловленное радиационно-индуцированным сшиванием увеличение молярной массы полимера М приводит к уменьшению показателя преломления. Образующиеся при ионной имплантации фенолформальдегидных смол радикалы имеют различное строение и реакционную способность, но вследствие реакций с макромолекулами достаточно быстро в объеме полимера остаются наиболее термодинамически стабильные радикалы фенольного и метиленового типа [17, 18]. Разнообразные реакции рекомбинации радикалов фенольного и метиленового типа приводят к образованию новых С−С и С−О химических связей и, как следствие, увеличению средней молекулярной массы макромолекул фенолформальдегидной смолы. Сшивание макромолекул фенолформальдегиных смол под действием излучения приводит, как сказано выше, к увеличению их средней молекулярной массы М, что вероятно и является причиной наблюдаемого снижения показателя преломления. Кроме того, при имплантации имеет место газовыделение (преимущественно водорода и его соединений), что обуславливает снижение плотности вещества ρ. Газовыделение приводит также к снижению молекулярной рефракции RM вследствие уменьшения вклада рефракций Ri атомов водорода. В соответствии с выражением (2) снижение величин ρ и RM должно приводить к уменьшению значения n. Указанные обстоятельства и обуславливают уменьшение показателя преломления n фоторезиста, которое наиболее выражено при имплантации тяжелых ионов сурьмы.
Таким образом, из приведенных экспериментальных данных видно, что в фоторезистивных пленках радиационно-индуцированные процессы за слоем внедрения существенно отличаются при имплантации легких и тяжелых ионов. Как отмечалось выше, при имплантации легких ионов В+ и Р+ доминирующими являются процессы с участием нестабильной фоточувствительной компоненты ФР – нафтохинондиазида, которые приводят к образованию кетена и последующим реакциям с его участием. С другой стороны, при имплантации тяжелых ионов Sb+ радиационно-индуцированные реакции за слоем внедрения происходят преимущественно с участием макромолекул основного компонента ФР – фенолформальдегидной смолы.
Наблюдавшиеся экспериментально различия в модификации запробежной области резистивных пленок при имплантации легкими и тяжелыми ионами могут быть объяснены со следующих позиций. Существуют два основных механизма торможения ионов – электронное, которое преобладает в случае легких ионов, и ядерное торможение (в случае тяжелых ионов) [19].
При имплантации легких ионов В+ и Р+ преобладает электронный механизм торможения ионов (для В+ на него приходится более 85% потерь энергии, для Р+ ‒ около 60% потерь энергии). При электронном торможении основная доля потерь энергии ионов (около 80–90%) приходится на процессы возбуждения (5) и ионизации (6) макромолекул фенолформальдегидной смолы [10]. Последующие ион-молекулярные реакции катион-радикалов, а также распад возбужденных частиц являются источником образованию различных радикалов фенолформальдегидной смолы [10, 17].
Энергия возбуждения может передаваться по цепочкам макромолекул и в результате бимолекулярных соударений. Если энергия возбуждения не превышает величину энтальпии гомолитической диссоциации самой слабой связи в фенолформальдегидной смоле, то эта избыточная энергия будет мигрировать на большие расстояния в полимерном компаунде. В этих условиях такое низкоэнергетичное возбуждение может достаточно специфично передаваться на орто-нафтохинондиазид, привитый к фенолформальдегидной смоле ковалентной связью, поскольку это вещество способно поглощать УФ-излучение с энергией 2.8–4.0 эВ с последующим деазотированием (перестройка Вульфа) и образованием кетена [10]. Важно заметить, что вне зависимости от источника происхождения избыточной энергии (УФ-облучение, или ионная имплантация) фоточувствительный компонент резиста должен подвергаться разложению с образованием кетена, что и наблюдалось нами экспериментально при имплантации легких ионов бора и фосфора.
При ядерном механизме торможения (для тяжелых ионов Sb+ доля ядерного торможения составляет около 80% [19]) происходят неупругие столкновения с ядрами мишени с образованием ядер отдачи (С, Н, О), которые способны вызвать деструкцию полимера за областью пробега имплантированных ионов на расстояниях до 2–3RP [20]. Основным компонентом фоторезистивной пленки (до 70% ее массы) является фенолформальдегидная смола. Поэтому радиационной деструкции будет подвергаться именно полимерный компонент пленки преимущественно в приповерхностной области (в области торможения ионов). На больших глубинах (>5RP) радиационно-индуцированные процессы могут протекать вследствие эмиссии вторичных электронов из приповерхностного слоя при ионной имплантации, а также из-за переноса энергии возбуждения по макромолекулам полимера.
Наблюдаемые при ионной имплантации сурьмы изменения механических и адгезионных свойств фоторезиста на кремниевой подложке обусловлены следующей комбинацией радиационно-химических процессов. Очень высокая плотность ионизации вдоль трека Sb+ из-за преобладающего ядерного механизма торможения ионов будет приводить к разогреву, выраженной деструкции полимерного компаунда с образованием низкомолекулярных соединений и эмиссией газообразных веществ, о чем, в частности, свидетельствует обнаруженная нами полоса СO2 при 2331 см–1. Причем выходу СO2 из объема пленки может препятствовать карбонизированный ионной имплантацией сильно сшитый приповерхностный слой фоторезиста.
Ранее с использованием методов АСМ мы наблюдали сильное изменение морфологии поверхности фоторезиста в условиях ионной имплантации, проявляющееся в образовании “вулканического” рельефа поверхности, и, следовательно, формировании напряжений в приповерхностном слое. Причем наиболее эффективно эти процессы протекали при имплантации Sb+ [21]. Так, при дозе Sb+ свыше 5 × 1016 см–2 наблюдались сильная деструкция полимера, вынос вещества из приповерхностного слоя фоторезиста и выход на поверхность углеродно-металлических нанокластеров. Важно, что при имплантации легких ионов в идентичной дозе таких процессов не наблюдалось.
В областях между треками, где в процессе ионной имплантации будет образовываться высокая концентрация радикалов, активно будут протекать бирадикальные реакции, и, в первую очередь, более характерные для фенолформальдегидной смолы процессы рекомбинации радикалов с образованием сшивок между макромолекулярными цепочками. Значительно большая плотность ионизации фоторезиста в приповерхностном слое при имплантации Sb+ по сравнению с легкими ионами B+ и P+ будет приводить к тому, что для тяжелых ионов меньшая доля энергии ионизирующего излучения будет передаваться в объем полимерной пленки. Такая комбинация радиационных повреждений фоторезиста преимущественно в приповерхностном слое при имплантации сурьмы будет приводить с одной стороны к наблюдаемому увеличению микротвердости, а с другой – к снижению адгезии к кремниевой пластине вследствие накопления напряжений в объеме пленке и на границе раздела фаз.
Следует также учитывать наличие в пленке упругих напряжений, возникающих вследствие испарения растворителя при сушке. В процессе ИИ в зависимости от массы (размеров) иона эти напряжения могут как компенсироваться, так и увеличиваться, приводя к накоплению деформации. В работе [4] показано, что в случае преобладания электронного механизма торможения (ионы He+) в области пробега в пленке диазохинонноволачного фоторезиста преобладают процессы сшивки и сохраняются химические характеристики исходного материала даже при дозе Ф = 1 × 1016 см–2. Таким образом, ожидать формирования каких-то упругих напряжений на границе внедренный слой/фоторезист не приходится. Когда доминирует ядерный механизм торможения (облучение Xe+ и I+), в области пробега ионов наблюдается карбонизация, и при Ф > 1 × × 1014 см–2 фоторезист превращается в слой аморфного углерода. Вероятно, под карбонизированным слоем в полимерном компаунде могут накапливаться низкомолекулярные соединения, в том числе и существующие в газообразном состоянии при нормальных условиях. В результате этих процессов на границе раздела внедренный слой/фоторезист будут возникать упругие напряжения, которые могут модифицировать структуру фоторезистивной пленки за слоем внедрения, что и наблюдалось в работе [2].
Необходимо также учитывать, что атом Sb (ковалентный радиус 1.41 Å) существенно больше атомов углерода (0.77 Å) и бора (0.89 Å). В имплантированном слое толщиной ~100 нм при дозе 1 × 1016 см–2 содержание атомов импланта достигает (3–8) × 1021 см–3. Причем чем тяжелее атом, тем ýже будет профиль распределения и выше концентрация атомов импланта при одной и той же дозе. Например, при имплантации бора профиль распределения импланта шире в 5 раз по сравнению с сурьмой и аналогичным образом будет отличаться и концентрация ионов в имплантированном слое. Поскольку в области термализации ионов концентрация имплантируемых частиц может быть сравнима с концентрацией атомов мишени имеет место формирование слоя металло-полимерного композита. Имплантация «тяжелого» иона Sb+ будет вызывать более сильные напряжения на границе раздела внедренный слой/фоторезист, что в итоге может сказываться и на адгезионных взаимодействиях пленки в кремниевой подложке.
К снижению адгезии может приводить также накопление электрического заряда вблизи границы раздела фоторезист/кремний при воздействии ионизирующего излучения. Это приводит к возникновению электрического поля с напряженностью до 5 × 107 В/см, которое может модифицировать структуру полимера вблизи границы раздела фаз [22, 23]. При достижении критической величины заряда может происходить электрический пробой полимерной пленки, сопровождающийся ее сильным разогревом и модификацией структуры.
ЗАКЛЮЧЕНИЕ
Установлено, что в фоторезистивных диазохинонноволачных пленках на пластинах монокристаллического кремния радиационно-индуцированные процессы за слоем внедрения существенно отличаются при имплантации легких и тяжелых ионов. Это обусловлено действием двух различных механизмов торможения быстрых ионов. Показано, что при имплантации легких ионов В+ и Р+, когда преобладает электронный механизм торможения, производящий возбуждение и ионизацию электронной подсистемы молекул, доминирующими являются процессы с участием нестабильной фоточувствительной компоненты ФР – нафтохинондиазида, которые приводят к образованию кетена и последующим реакциям с его участием. При имплантации тяжелых ионов Sb+, когда преобладает ядерных механизм торможения быстрых ионов, при котором налетающий ион, сталкиваясь с атомами мишени, постепенно передает им свою кинетическую энергию, радиационно-индуцированные реакции за слоем внедрения протекают преимущественно с участием макромолекул основного компонента ФР – фенолформальдегидной смолы. На глубинах больше величины проецированного пробега ионов радиационно-индуцированные процессы могут протекать также вследствие эмиссии вторичных электронов из нарушенного при ионной имплантации приповерхностного слоя и вследствие переноса энергии возбуждения по макромолекулам полимера.
Список литературы
Моро У. Микролитография. Принципы, методы, материалы. В 2-х ч. Ч.2. М.: Мир, 1990. 632 с. (Moreau W.M. Semiconductor lithography. Principles, practices and materials. N.Y., London: Plenum Press).
Бринкевич Д.И., Бринкевич С.Д., Вабищевич Н.В., Оджаев В.Б., Просолович В.С. // Микроэлектроника. 2014. Т. 43. № 3. С. 193. (Brinkevich D.I., Brinkevich S.D., Vabishchevich N.V., Odzhaev V.B., Prosolovich V.S. // Russian Microelectronics. 2014. V. 43. № 3. P. 194–200.)
Larson L.A., Williams J.M., Current M.I. // Reviews of Accelerator Science and Technology. 2011. V. 4. № 1. P. 11.
Garcia I.T.S., Zawislak F.C., Samios D. // Applied Surface Science. 2004. V. 228. P. 63.
Бринкевич Д.И., Харченко А.А., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б., Валеев В.Ф., Нуждин В.И., Хайбуллин Р.И. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. № 8. С. 25. (Brinkevich D.I., Kharchenko A.A., Brinkevich S.D., Lukashevich M.G., Odzhaev V.B., Valeev V.F., Nuzhdin V.I., Khaibullin R.I. // J. of Surface Investigation. X-ray, synchrotron and neutron techniques 2017. V. 11. №. 4. P. 801–806.)
Kondyurin A., Bilek M. Ion beam treatment of polymers: application aspects from medicine to space. Elsevier. 2015. 256 p.
Харченко А.А., Бринкевич Д.И., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 1. С. 94. (Kharchenko A.A., Brinkevich D.I., Brinkevich S.D., Lukashevich M.G., Odzhaev V.B. // J. of Surface Investigation. X-ray, synchrotron and neutron techniques 2015. V. 9. № 1. P. 87–91.)
Вабищевич С.А., Бринкевич С.Д., Бринкевич Д.И., Просолович В.С. // Химия высоких энергий. 2020. Т. 54. № 1. С. 54. (Vabishchevich S.A., Brinkevich S.D., Brinkevich D.I., Prosolovich V.S. // High energy chemistry. 2020. V. 54. № 1. P. 46–50.)
Brinkevich D.I., Odzhaev V.B., Prosolovich V.S., Yankovski Yu.N. // VACUUM. Surface engineering & vacuum technology. 2005. V. 78. № 2 (357). P. 251.
Бринкевич С.Д., Гринюк Е.В., Бринкевич Д.И., Просолович В.С. // Химия высоких энергий. 2020. Т. 54. № 5. С. 377. (Brinkevich S.D., Grinyuk E.V., Brinkevich D.I., Sverdlov R.L., Prosolovich V.S., Pyatlitski A.N. // Journal of Applied Spectroscopy. 2020. V. 87. № 4. Р. 647–651.)
Бринкевич Д.И., Харченко А.А., Просолович В.С., Оджаев В.Б., Бринкевич С.Д., Янковский Ю.Н. // Микроэлектроника. 2019. Т. 48. № 3. С. 235. (Brinkevich D.I., Kharchenko A.A., Prosolovich V.S., Odzhaev V.B., Brinkevich S.D., Yankovski Yu.N. // Russian Microelectronics. 2019. V. 48. № 3. P. 197–201.)
Бринкевич С.Д., Бринкевич Д.И., Просолович В.С. // Микроэлектроника. 2021 Т. 50. № 1. С. 36. (Brinkevich S.D., Brinkevich D.I., Prosolovich V.S. // Russian Microelectronics. 2021. V. 50. № 1 P. 33–38.)
Бринкевич С.Д., Бринкевич Д.И., Просолович В.С., Ластовский С.Б., Петлицкий А.Н. // Журнал прикладной спектроскопии. 2020. Т. 87. № 6. С. 941. (Brinkevich S.D., Brinkevich D.I., Prosolovich V.S., Lastovskii S.B., Pyatlitski A.N. // Journal of Applied Spectroscopy. 2021. V. 87. № 6 P. 1072–1078.)
Вабищевич С.А., Вабищевич Н.В., Бринкевич Д.И., Просолович В.С., Янковский Ю.Н., Бринкевич С.Д. // Вестник Полоцкого государственного университета. Серия С. Фундаментальные науки. Физика. 2016. № 12. С. 30.
Brinkevich S.D., Grinyuk E.V., Brinkevich D.I., Sver-dlov R.L., Prosolovich V.S., Pyatlitski A.N. // Journal of Applied Spectroscopy. 2020. V. 87. № 4. P. 647.
Тарасевич Б.Н. ИК спектры основных классов органических соединений. Справочные материалы. М: МГУ. 2012.
Харченко А.А., Бринкевич Д.И., Просолович В.С., Бринкевич С.Д., Оджаев В.Б., Янковский Ю.Н. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2020. № 6. С. 14. (Kharchenko A.A., Brinkevich D.I., Prosolovich V.S., Brinkevich S.D., Odzaev V.B., Yankovski Yu.N. // Journal of Surface Investigation: X-ray, Synchrotron and Neutron Techniques. – 2020. V. 14. № 3. Р.558–561.)
Бринкевич Д.И., Бринкевич С.Д., Олешкевич А.Н., Просолович В.С., Оджаев В.Б. // Химия высоких энергий. 2020. Т. 54. № 2. С. 126. (Brinkevich D.I., Brinkevich S.D., Oleshkevich A.N., Prosolovich V.S., Odzhaev V.B. // High energy chemistry. 2020. V. 54. № 2. P. 115–122.)
Оджаев В.Б., Козлов И.П., Попок В.Н., Свиридов Д.В. Ионная имплантация полимеров // Мн.: Белгосуниверситет. 1998. 197 с.
Комаров Ф.Ф., Леонтьев А.В., Коньшин И.В. // Вакуумная техника и технология. 1994. Т. 4. № 3. С. 45.
Бринкевич Д.И., Бринкевич С.Д., Лукашевич М.Г., Просолович В.С., Оджаев В.Б., Янковский Ю.Н. // Микроэлектроника. 2015. Т. 44. № 6. С. 448. (Brinkevich D.I., Brinkevich S.D., Lukashevich M.G., Prosolovich V.S., Odzhaev V.B., Yankovski Yu.N. // Russian Microelectronics. 2015. V. 44, № 6. P. 399–403.)
Вабищевич С.А., Бринкевич С.Д., Вабищевич Н.В., Бринкевич Д.И., Просолович В.С. // Химия высоких энергий. 2021. Т. 55. № 6. С. 461. (Vabishchevich S.A., Brinkevich S.D., Vabishchevich N.V., Brinkevich D.I., Prosolovich V.S. // High Energy Chemistry. 2021. V. 55. № 6. P. 495–501.)
Корнилов В.М., Лачинов А.Н., Логинов Б.А., Беспалов В.А. // Журнал технической физики. 2009. Т. 79. № 5. С. 116. (Kornilov V.M., Lachinov A.N., Loginov B.A., Bespalov V.A. Tech. Phys., 2009, V. 79. № 5. P. 719.)
Дополнительные материалы отсутствуют.
Инструменты
Химия высоких энергий




