Кристаллография, 2021, T. 66, № 4, стр. 650-657
Электронно-микроскопические исследования поверхностных образований в эпитаксиальном слое Ge3Sb2Te6, выращенном на кремниевой подложке
Ю. С. Зайцева 1, *, Н. И. Боргардт 1, А. С. Приходько 1, Е. Залло 2, 3, Р. Каларко 2
1 Национальный исследовательский университет “Московский институт электронной техники”
Москва, Зеленоград, Россия
2 Институт твердотельной электроники им. Пауля Друде
Берлин, Германия
3 Институт Вальтера Шоттки, Физический факультет, Технический университет Мюнхена
Гархинг, Германия
* E-mail: julia3ybina@gmail.com
Поступила в редакцию 09.06.2020
После доработки 09.06.2020
Принята к публикации 22.06.2020
Аннотация
Дефекты в форме усеченных треугольных пирамид на поверхности эпитаксиального слоя Ge3Sb2Te6, выращенного на подложке Si(111), идентифицированы методом растровой электронной микроскопии. Установлено, что стороны их оснований ориентированы вдоль Si〈110〉, а размеры варьируются от десятков до нескольких сотен нанометров. С использованием образцов поперечного сечения методом высокоразрешающей электронной микроскопии показано, что плоскости (111) кубической или (0001) гексагональной фаз Ge3Sb2Te6 в эпитаксиальном слое параллельны Si(111), а в поверхностных образованиях они могут располагаться под углом 70.5° к границе раздела между слоем и подложкой. Анализом атомарной структуры и с помощью энергодисперсионного рентгеновского микроанализа установлено, что в дефектах состав меняется от Ge3Sb2Te6 к GeSb2Te4 вдоль направления роста.
ВВЕДЕНИЕ
Халькогенидные полупроводники системы Ge–Sb–Te (GST) находят применение в микроэлектронике для создания запоминающих устройств, функционирование которых основано на изменении фазового состояния вещества. Достоинствами таких устройств являются их высокое быстродействие и энергонезависимость [1, 2].
Перспектива использования фазовых переходов в материалах системы GST для создания элементов памяти, обладающих высоким быстродействием, малым энергопотреблением и интегрированных в кремниевую технологию, инициирует развитие методов молекулярно-пучковой эпитаксии, позволяющей выращивать на кремниевой подложке слои и многослойные структуры GST с высоким кристаллическим совершенством [3, 4]. Благодаря ван-дер-ваальсовым связям между атомами кремния и материала GST трансляционная симметрия кристаллической подложки не оказывает существенного влияния на атомный порядок в эпитаксиальном слое [4, 5]. С помощью электронно-микроскопических исследований таких слоев выявлены особенности их атомарной структуры и фазообразования [6–9]. В частности, установлено, что переход из кубической фазы с ГЦК-решеткой типа NaCl в гексагональную фазу сопровождается двумерным упорядочением характерных для материалов GST вакансий между плоскостями (111), заполненными атомами теллура. Образующуюся промежуточную фазу с вакансионными слоями принято называть упорядоченной кубической фазой [6, 8]. При ее трансформации в гексагональную фазу эти слои формируют так называемые щели Ван-дер-Ваальса, параллельные плоскостям (0001) [10, 11]. Атомарная структура материала при таком переходе лишь незначительно изменяется, что существенно усложняет однозначную идентификацию фазового состояния GST, в том числе, методами высокоразрешающей электронной микроскопии (ВРЭМ).
Для эпитаксиальных слоев GST характерна блочная структура, в которой блоки упорядоченной ГЦК или гексагональной фазы разделяются слоями вакансий или ван-дер-ваальсовыми щелями, расположенными параллельно границе с подложкой. Несмотря на совершенство кристаллического строения таких слоев, на их поверхности могут формироваться образования (дефекты) в форме усеченных пирамид с латеральными размерами, достигающими нескольких сотен нанометров. Подобные дефекты были выявлены методами атомно-силовой и растровой электронной микроскопии (РЭМ) для материалов GST [12–14], Sb2Te3 [15] и GeTe [16], выращенных на подложке Si(111), а также в Bi2Se3 [17] на подложке SiC(0001). На основе полученных данных высказаны предположения о том, что поверхностные образования могут возникать благодаря двойникам вращения [14], являться следствием спирального роста вокруг дислокаций, находящихся в центре дефекта или в окрестности атомной ступени на подложке [15, 17]. Они могут формироваться благодаря скольжению дислокаций при охлаждении выращенного эпитаксиального слоя до комнатной температуры [18], которое сопровождается релаксацией напряжений, вызванных различием коэффициентов теплового расширения кремния и материала GST. Однако эти предположения не объясняют в полной мере природы дефектов, и для выявления причин их формирования требуются дальнейшие исследования, в том числе для получения данных об атомарной структуре.
В настоящей работе форма, размеры и ориентация дефектов на поверхности слоя Ge3Sb2Te6 (GST326), выращенного методом молекулярно-пучковой эпитаксии на подложке Si(111), изучены с применением РЭМ, их атомарная структура исследована методами просвечивающей электронной микроскопии (ПЭМ), а неоднородности состава выявлены с помощью энергодисперсионного рентгеновского микроанализа.
ФОРМИРОВАНИЕ ТОНКИХ ПЛЕНОК И ЭКСПЕРИМЕНТАЛЬНОЕ ОБОРУДОВАНИЕ
Слой GST326 толщиной ~50 нм выращивали методом молекулярно-пучковой эпитаксии на кремниевой подложке Si(111). Первоначально подложку очищали от органических загрязнений [19], затем переносили в ростовую камеру и нагревали до 720°C со скоростью 0.1°C/с, что обеспечивало формирование реконструированной поверхности 7 × 7-Si(111), которое контролировали методом дифракции быстрых электронов на отражение. На следующем этапе осуществляли пассивацию поверхности сурьмой [20], приводящую к ее реконструкции: Si(111)–(√3 × √3)R30°–Sb. Осаждение материала из отдельных эффузионных ячеек Ge, Sb, Te проводили при температуре подложки 250°C и давлении около 3 × 10–10 мбар со скоростью 0.3875 нм/мин [7, 21].
Исследование морфологии поверхности эпитаксиального слоя проводили методом РЭМ с применением электронной колонны электронно-ионного микроскопа Helios NanoLab 650 при ускоряющем напряжении 1 кВ. Для лучшей визуализации поверхностных дефектов на предметный столик прибора подавали отрицательный потенциал –500 В.
Образцы поперечного сечения с ориентацией поверхности Si($1\bar {1}0$) для электронно-микроскопических исследований готовили методом In-Situ Lift-Out [22, 23] с помощью фокусированного ионного пучка прибора Helios NanoLab 650. Такой подход позволял прецизионно выбирать на поверхности эпитаксиального слоя область формирования тонкой фольги для получения на ней поперечного сечения двух–трех поверхностных дефектов. Для обеспечения стабильности положения тонкой фольги при исследованиях в просвечивающем электронном микроскопе в медном держателе образца с помощью ионного пучка создавалась прямоугольная выемка, в которую помещалась фольга и закреплялась в ней осаждением слоя платины.
Исследования структуры и состава эпитаксиальной пленки проводили при ускоряющем напряжении 200 кВ в просвечивающем электронном микроскопе Titan Themis 200, оснащенном корректором сферической аберрации объективной линзы и энергодисперсионным спектрометром Super-X.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Растровая электронная микроскопия поверхности слоя GST326. Исследования методом РЭМ показали, что на поверхности слоя GST присутствуют строго ориентированные относительно подложки образования в форме усеченных пирамид с правильным треугольником в основании (рис. 1а). Треугольники могли быть развернуты друг относительно друга на 60°, однако, как будет показано далее, их стороны лежали вдоль направлений 〈110〉 кремниевой подложки. Некоторые из образований, на одно из которых указывает стрелка на рис. 1а, имели более сложную форму: на поверхности более крупного дефекта формировался дефект с меньшими латеральными размерами.
Рис. 1.
РЭМ-изображение поверхности слоя с ориентированными вдоль Si〈110〉 поверхностными образованиями (а); гистограммы распределений размеров сторон оснований поверхностных дефектов (б) и углов их отклонения от направлений Si〈$1\bar {1}0$〉 (в). На рис. а стрелка указывает на дефект, визуализируемый в виде лежащих друг на друге треугольников; штрихпунктирной линией отмечено сечение, в котором приготавливалась тонкая фольга для ПЭМ.

Для статистического анализа геометрических параметров поверхностных дефектов путем покадровой съемки было сформировано изображение от прямоугольной области площадью около 850 мкм2. Для этого было получено 15 × 15 последовательных микрофотографий (кадров) с увеличением ×100 000. Размер каждой из них составлял 1024 × 884 пикселя, что соответствовало области размером ~2.5 × 2.2 мкм2. Образец на столике ориентировали так, чтобы меньшая сторона микрофотографии была параллельна одной из сторон треугольных дефектов (рис. 1а). Получение изображений осуществлялось в автоматическом режиме с помощью специальной управляющей программы (скрипта) с перекрытием соседних кадров ~15%, что позволило с хорошей точностью соединить их между собой для получения единого изображения всей исследованной области.
Определение геометрических характеристик поверхностных образований и статистическую обработку полученных данных осуществляли в программном пакете Matlab. На изображениях отмечали точки, соответствующие вершинам треугольников, лежащих в основаниях более 900 дефектов. Затем по полученным координатам вершин рассчитывали длины сторон и площади треугольников.
На рис. 1б показана гистограмма распределения длин сторон оснований дефектов, из которой следует, что их латеральные размеры варьируются в пределах от 30 до 500 нм. Из гистограммы также видно, что у около 40% поверхностных образований эти длины составляют от 100 до 160 нм, а доля дефектов размером более 300 нм не превышает 4%. Средняя площадь треугольных оснований дефектов равна ~0.01 мкм2, а доля занимаемой ими поверхности образца ~1.5%. Поверхностные образования сложной формы, визуализирующиеся в виде лежащих друг на друге треугольников различного размера, составляют ~5% от общего числа дефектов.
На рис. 1в приведена гистограмма распределения отклонений сторон оснований дефектов от направления Si [$1\bar {1}0$], полученная на основе данных о координатах вершин треугольников. Из нее следует, что около трети поверхностных образований ориентированы вдоль направления [$1\bar {1}0$] с отклонением менее 1°. Для 80% дефектов разориентация не превышает 3.5°, лишь у 5% дефектов стороны оснований отклоняются от этого направления на угол больше 6.5°, а максимальный угол отклонения не превышает 13.5°.
Структура и химический состав эпитаксиального слоя GST326. На рис. 2 приведены высокоразрешающие изображения, иллюстрирующие структуру эпитаксиального слоя GST. На рис. 2а показана область вблизи границы раздела Si/GST, отмеченной пунктирной линией. Из рисунка видно, что поверхность подложки является атомарно гладкой и параллельные границе плоскости Si(111) и материала GST примыкают друг к другу без видимых искажений вследствие ван-дер-ваальсовых связей между атомами подложки и эпитаксиального слоя. Благодаря таким связям появляется возможность формировать слои GST с совершенной кристаллической структурой при существенном рассогласовании параметров решетки подложки и выращенного материала [4].
Рис. 2.
ВРЭМ-изображения границы раздела Si/GST (пунктирная линия) (а) и участков слоя GST (б, в); фрагмент ячейки GST326 в гексагональной фазе (г). Штриховые линии на рис. а, б, в – вакансионные слои, 1, 2, 3, 4 – блоки Ge2Sb2Te5, GeSb2Te4, Ge3Sb2Te6, Ge5Sb2Te8, 5 – область материала в разупорядоченной кубической фазе; на рис. г v – щели Ван-дер-Ваальса; схема ячейки соответствует участку образца на рис. б, обведенному пунктирным контуром.
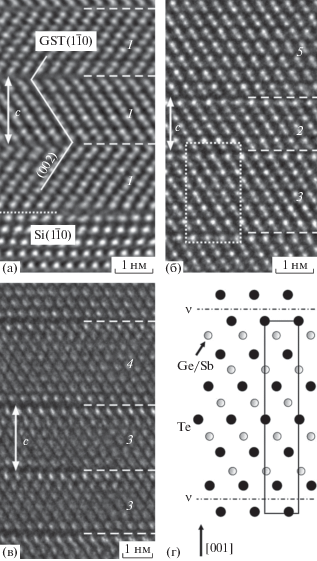
Методом энергодисперсионного рентгеновского микроанализа установлено, что средние концентрации Ge, Sb и Te в эпитаксиальном слое соответствуют стехиометрическим значениям для соединения GST326. Однако путем измерения параметра решетки c, соответствующего расстоянию между соседними щелями Ван-дер-Ваальса, выявлены различные соединения системы GST и, как следствие, локальные вариации химического состава эпитаксиального слоя. Преимущественно он состоит из блоков GST, свидетельствующих о наличии упорядоченной кубической [8] или гексагональной [10] фазы GST. Слои вакансий (щели Ван-дер-Ваальса) параллельны границе раздела Si/GST и отмечены штриховыми линиями на рис. 2а–2в. Как видно из рис. 2а, смежные блоки GST могут быть двойниками с плоскостью двойникования (111) и разворотом между плоскостями (002) соседних блоков, приблизительно равным 110°, что является характерным значением для системы GST [24]. Помимо фаз с упорядоченным расположением вакансий в слое были выявлены области, одна из которых отмечена цифрой 5 на рис. 2б, с описанной в [2, 25] кубической фазой со случайным расположением вакансий в структуре типа NaCl и параметром решетки 0.6 нм.
Размер блоков GST, определяемый расстоянием между соседними слоями вакансий (щелями Ван-дер-Ваальса), варьировался на экспериментальных изображениях от 1.3 до 2.8 нм, что свидетельствовало о наличии различных соединений системы GST в локальных участках эпитаксиального слоя. Отмеченные цифрой 1 блоки на рис. 2а относятся к соединению Ge2Sb2Te5 с параметром решетки $c = 1.7$ нм, совпадающим с размером блока. На рис. 2б блоки GeSb2Te4 и Ge3Sb2Te6 с $c = 1.3$ и $c = 2.0$ нм отмечены цифрами 2 и 3, а на рис. 2в цифре 4 соответствует блок Ge5Sb2Te8 с $c = 2.8$ нм. Однозначная идентификация фазового состояния материала GST с блочной структурой на ВРЭМ-изображениях возможна при условии высокосимметричной ориентации Si[$1\bar {1}0$] тонкой фольги относительно падающего электронного пучка по чередованию атомных плоскостей в области вакансионных слоев (щелей Ван-дер-Ваальса) [7]. Например, на рис. 2б ограниченная пунктирным контуром область гексагональной фазы GST326 соответствует кристаллической решетке, представленной на рис. 2г.
Структура и химический состав поверхностных дефектов. Использование метода In-Situ Lift-Out при приготовлении электронно-микроскопических образцов позволяет сопоставлять РЭМ- и ПЭМ-изображения выбранных дефектов (рис. 3а). Поскольку образец поперечного сечения формировался перпендикулярно одной из сторон треугольного основания поверхностных образований, то из ВРЭМ-изображения на рис. 2а следует, что эта сторона ориентирована вдоль Si[$1\bar {1}0$], а две другие его стороны параллельны направлениям Si[$10\bar {1}$] и Si[$01\bar {1}$] (рис. 3а). Как видно из рис. 3б, поперечные сечения дефектов имеют трапециевидную форму. Анализ электронно-микроскопических изображений показал, что высота поверхностных образований, составляющая от 10 до 35 нм, обычно в 6–9 раз меньше его характерного латерального размера – длины стороны треугольного основания.
Рис. 3.
Совмещенные РЭМ-микрофотографии поверхности эпитаксиального слоя GST и изображение поперечного сечения дефекта (а), его увеличенное ПЭМ-изображение (б) и ВРЭМ-изображения границы раздела Si/GST с моноатомными ступенями на кремнии (в, г). А и Б на рис. б – области, показанные на рис. в, г. На рис. в, г граница раздела Si/GST выделена штриховой линией, стрелки указывают на ступени.

На изображении на рис. 3б выявляется сложная доменная структура как в области дефекта, так и в слое GST непосредственно под ним. Домен, отмеченный цифрой I, является участком слоя, развернутым на небольшой угол вокруг направления Si[111] относительно смежных областей. Цифре II соответствует домен, в котором вакансии упорядочены в плоскостях под углом к границе раздела Si/GST, и его появление приводит к формированию возвышения на поверхности дефекта. За исключением доменов типа II, ориентация вакансионных слоев (щелей Ван-дер-Ваальса) в области дефектов остается параллельной границе раздела Si/GST, как и в эпитаксиальном слое. Для примера на ВРЭМ-изображении (рис. 4а) показан увеличенный фрагмент сечения дефекта, представленного на рис. 3б, вблизи его боковой грани и поверхности слоя GST.
Рис. 4.
ВРЭМ-изображение области поверхностного образования вблизи его боковой грани (а), в верхней части (б) и на участке с “паркетным” контрастом (в); 1, 2 и 3 – соединения Ge2Sb2Te5, GeSb2Te4 и Ge3Sb2Te6; I и II на рис. а – области эпитаксиального слоя и дефекта, имеющие одинаковую ориентацию ($1\bar {1}0$). Вставка на рис. в – фурье-изображение, где окружностями отмечены рефлексы кубической фазы GST.

На рис. 3в, 3г показаны ВРЭМ-изображения границы раздела Si/GST в областях, которые отмечены штрихпунктирными контурами на рис. 3б и на которых на поверхности подложки в области дефекта выявлены моноатомные ступени, отмеченные стрелками на рис. 3в, 3г. Их локализацию проводили с помощью фурье-изображений от области микрофотографии размером ~5 × 5 нм2 вблизи участка поверхности подложки, содержащего ступень. При перемещении этой области перпендикулярно направлению роста расположение моноатомной ступени выявлялось с точностью около 1 нм по появлению рефлексов материала GST, которые сравнительно просто выявляются на фурье-изображении благодаря существенному различию параметров кристаллических решеток кремния и GST.
Атомарное строение материала GST в области поверхностных дефектов в целом соответствует блочной структуре эпитаксиального слоя, включая локальные участки, соответствующие разупорядоченной кубической фазе. Однако в отличие от эпитаксиального слоя в верхней части крупных дефектов с латеральными размерами свыше 150 нм и высотой более 25 нм преимущественно выявляются блоки с параметром решетки $c = 1.3$ нм, соответствующим соединению GeSb2Te4. Пример такой структуры показан на рис. 4б, на котором цифрами 2 и 3, как и на рис. 2, отмечены блоки GeSb2Te4 и GST326. Выявленное обеднение материала GST германием в крупных дефектах в дальнейшем было подтверждено методом энергодисперсионного микроанализа.
Еще одно различие между блочными структурами эпитаксиального слоя и поверхностных образований состоит в том, что в дефектах имеются блоки, в которых упорядочение вакансий происходит в плоскостях типа ($11\bar {1}$), развернутых относительно границы раздела Si/GST на 70.5° (домен II на рис. 3б). В большей степени этот эффект наблюдался в крупных дефектах, а в небольших поверхностных образованиях блоки GST располагались параллельно границе раздела Si/GST, как и в эпитаксиальном слое.
Так называемый “паркетный” контраст [26, 27] на ВРЭМ-изображении (рис. 4в), возникающий вследствие проекционного наложения двух областей GST с разными ориентациями вакансионных слоев (щелей Ван-дер-Ваальса), подтверждает разворот одного из блоков GST относительно границы раздела Si/GST. Цифрами 1 и 2 на рис. 4в показаны блоки Ge2Sb2Te5 и GeSb2Te4, а на вставке представлено соответствующее фурье-изображение, на котором окружностями показаны рефлексы кубической фазы GST в оси зоны [$1\bar {1}0$]. Расстояние между рефлексами сверхструктуры, формируемой вакансионными слоями в плоскостях (111) и ($11\bar {1}$), соответствует параметру решетки c соединения GST.
Проведенный для нескольких дефектов химический микроанализ подтвердил наличие вариаций их состава, выявленных методом ВРЭМ. Средний состав каждого дефекта оценивали в области над поверхностью эпитаксиального слоя, как показано штрихпунктирным контуром на рис. 5а. Как видно из графика зависимости средних концентраций C германия и сурьмы от высоты дефекта h, приведенного на рис. 5б, в небольших поверхностных образованиях высотой не более 15 нм химический состав мало отличался от состава слоя GST326. В наиболее крупных дефектах, высота которых над поверхностью слоя превышала 30 нм, концентрация германия составляла 12 ат.%, концентрация сурьмы – 29 ат.%, в результате чего их химический состав соответствовал стехиометрии соединения GeSb2Te4.
Рис. 5.
Поперечное сечение дефекта (а), графики зависимости средних концентраций германия (квадраты) и сурьмы (крестики) C в поверхностных дефектах от высоты h (б) и изменения этих концентраций вдоль направления роста H в крупных дефектах (в). На рис. а штрихпунктирным контуром выделена область, в которой определялся средний химический состав дефектов, штриховым контуром и стрелкой показаны прямоугольная область и направление ее смещения при локальной оценке концентрации Ge и Sb в крупных дефектах.

Изменение концентраций Ge, Sb и Te в направлении роста для отдельного крупного дефекта оценивали путем анализа состава в локальных прямоугольных областях, как показано на рис. 5а штриховым контуром и стрелкой, обозначающей направление перемещения этого контура. Таким образом, усредненные вдоль латерального направления концентрации элементов определяли последовательно на разных расстояниях H от поверхности эпитаксиального слоя. Из графика зависимости концентраций (рис. 5в) следует, что в крупных дефектах концентрация германия может варьироваться от 18 ат.% вблизи слоя до 10 ат.% в верхней части дефекта, атомарная доля сурьмы при этом возрастает, а содержание теллура практически не меняется.
Возможные механизмы формирования поверхностных образований. Полученные результаты о форме и ориентации дефектов на поверхности слоя GST, выращенного на подложке Si(111), находятся в соответствии с данными [12, 15, 17]. 60-градусная симметрия поверхности подложки обусловливает треугольную форму оснований дефектов с ориентацией сторон треугольников вдоль направлений 〈110〉, а двойникование в эпитаксиальном слое GST с разворотом плоскостей (002) (рис. 2а) приводит к двум различным ориентациям поверхностных образований.
Наличие атомарных ступеней, расположенных на поверхности подложки под дефектами (рис. 3б–3г), позволяет предположить, что их формирование происходит в соответствии с моделью, предложенной в [17]. Она распространяет на эпитаксию 2D-материалов хорошо известный механизм спирального роста в области выхода на поверхность винтовых дислокаций, который приводит к формированию пирамид на поверхности выращенного слоя [28]. Как показано в [17], в случае эпитаксиального выращивания 2D-материалов ступени на поверхности подложки могут оказывать на их кристаллизацию такое же влияние, как винтовые дислокации, вызывая спиральный рост и обусловливая образование поверхностных дефектов. Косвенным подтверждением такого механизма роста является формирование поверхностных дефектов сложной формы, аналогичных отмеченному стрелкой на рис. 1а. Кроме того, выявленное в [21] подавление роста подобных образований на вицинальных поверхностях Si(111) также находится в соответствии с предложенной в [17] моделью, согласно которой возможность реализации механизма спирального роста уменьшается для достаточно высоких ступеней.
Другим фактором, влияющим на кристаллизацию материала GST в области крупных дефектов, является формирование доменов с упорядоченной ГЦК или гексагональной структурой, в которых вакансиионные слои или щели Ван-дер-Ваальса расположены наклонно к границе раздела Si/GST. Поскольку материалы системы GST формируют зерна, вытянутые вдоль плоскостей {111} для кубической или (0001) для гексагональной фазы [10, 24], то появление в процессе роста домена с наклонным упорядоченным расположением вакансий (домен II на рис. 2б) приводит к ускоренному росту как самого домена, обусловливающему его возвышение над поверхностью дефекта, так и всего поверхностного образования.
Изменение состава материала GST в процессе роста поверхностных дефектов может быть еще одним фактором, влияющим на скорость их формирования, и его изучение требует дальнейших исследований.
Отметим, что поверхностные образования присущи не только эпитаксиальным слоям GST, но и тонким пленкам, выращенным методом вакуумно-термического испарения. Однако подобные дефекты могут иметь совершенно иную природу, например, образования, изученные в [29], представляли собой кристаллы кубической фазы Sb2O3.
ЗАКЛЮЧЕНИЕ
Методами растровой и высокоразрешающей просвечивающей электронной микроскопии, энергодисперсионного рентгеновского микроанализа исследованы морфология поверхности эпитаксиального слоя GST326, выращенного на атомарно гладкой подложке Si(111), а также структура и состав выявленных поверхностных дефектов. Установлено, что дефекты в форме усеченных треугольных пирамид ориентированы относительно подложки так, что стороны их оснований располагаются вдоль направлений Si〈110〉. Статистический анализ более 900 образований на поверхности слоя GST площадью около 850 мкм2 показал, что в 80% случаев разориентация их сторон относительно направлений Si〈$1\bar {1}0$〉 не превышает 3.5° и только для 5% дефектов она более 6.5°. Латеральные размеры более 40% дефектов находятся в пределах 80–160 нм, их средняя площадь равна ~0.01 мкм2, а доля занимаемой площади на поверхности слоя составляет ~1.5%.
Эпитаксиальный слой GST обладает блочной структурой, характерной для упорядоченной кубической или гексагональной фаз, и лишь в некоторых локальных областях была выявлена разупорядоченная кубическая фаза. Вакансионные слои в плоскостях (111) для кубической фазы или щели Ван-дер-Ваальса в плоскостях (0001) для гексагональной фазы располагались параллельно границе раздела Si/GST, блоки GST могли являться двойниками с плоскостью двойникования (111) и разворотом плоскостей (002) на угол ~110°.
Атомарное строение GST в области поверхностных дефектов в целом аналогично структуре эпитаксиального слоя. Основное отличие, характерное для крупных, высотой более 25 нм, дефектов, состояло в том, что часть блоков GST имела ориентацию вакансионных слоев (щелей Ван-дер-Ваальса) под углом 70.5° к границе с подложкой. При проекционном наложении изображений двух областей GST с различными ориентациями вакансионных щелей на ВРЭМ-микрофотографиях формировался “паркетный” контраст.
Методом энергодисперсионного микроанализа установлено, что химический состав небольших поверхностных образований близок к стехиометрии эпитаксиального слоя GST326. Для крупных дефектов характерно уменьшение концентрации Ge и ее увеличение для Sb в направлении роста, вследствие чего средний состав GST в таких образованиях соответствует соединению GeSb2Te4.
Одной из вероятных причин формирования поверхностных образований являются ступени на подложке Si(111), наличие которых может способствовать спиральному росту материала, приводящему к формированию дефектов пирамидальной формы на поверхности эпитаксиального слоя GST. Другими факторами, влияющими на размеры таких дефектов, являются образование и ускоренный рост доменов GST с вакансионными слоями (щелями Ван-дер-Ваальса), ориентированных под углом к границе раздела Si/GST.
Работа выполнена при финансовой поддержке Минобрнауки РФ (тема АААА-А20-120071490069-9, соглашение № 075-03-2020-216, код 0719-2020-0018) с использованием оборудования ЦКП “Диагностика и модификация микроструктур и нанообъектов”.
Список литературы
Redaelli A. Phase Change Memory. Springer International Publishing AG, 2018. 330 p.
Wuttig M., Yamada N. // Nature Mater. 2007. V. 6. P. 824.
Chong T.C., Shi L.P., Zhao R. et al. // Appl. Phys. Lett. 2006. V. 88. P. 122114.
Momand J., Wang R., Boschker J.E. et al. // Nanoscale. 2017. V. 9. P. 8774.
Koma A. // Thin Solid Films. 1992. V. 216. P. 72.
Mio A.M., Privitera S.M.S., Bragaglia V. et al. // Nanotechnology. 2017. V. 28. P. 065706.
Bragaglia V., Arciprete F., Zhang W. et al. // Sci. Rep. 2016. V. 6. P. 23843.
Zheng Y., Cheng Y., Huang R. et al. // Sci. Rep. 2017. V. 7. P. 5915.
Lotnyk A., Dankwort T., Hilmi I. et al. // Nanoscale. 2019. V. 11. P. 10838.
Kooi B.J., Groot W.M.G., De Hosson J.Th.M. // J. Appl. Phys. 2004. V. 95. № 3. P. 924.
Park Y.J., Lee J.Y., Kim Y.T. // Appl. Surf. Sci. 2006. V. 253. P. 714.
Boschker J.E., Calarco R. // Adv. Phys. X. 2017. V. 2. № 3. P. 675.
Schuck M., Ries S., Schreiber M. et al. // J. Cryst. Growth. 2015. V. 420. P. 37.
Hilmi I., Thelander E., Schumacher P. et al. // Thin Solid Films. 2016. V. 619. P. 81.
Boschker J.E., Galves L.A., Flissikowski T. et al. // Sci. Rep. 2015. V. 5. P. 18079.
Wang R., Boschker J.E., Bruyer E. et al. // J. Phys. Chem. C. 2014. V. 118. P. 29724.
Liu Y., Weinert M., Li L. // Phys. Rev. Lett. 2012. V. 108. P. 115501.
Zogg H., Blunier S., Fach A. et al. // Phys. Rev. B. 1994. V. 50. P. 10801.
Takagaki Y., Giussani A., Perumal K. et al. // Phys. Rev. B. 2012. V. 86. P. 125137.
Andrieu S. // J. Appl. Phys. 1991. V. 69. P. 1366.
Zallo E., Cecchi S., Boschker J.E. et al. // Sci. Rep. 2017. V. 7. P. 1466.
Mayer J., Giannuzzi L.A. Kamino T. // MRS Bulletin. 2007. V. 32. P. 400.
Волков Р.Л., Боргардт Н.И., Кукин В.Н. и др. // Поверхность. Рентген., синхротр. и нейтр. исследования. 2011. Т. 9. С. 94.
Park Y.J., Lee J.Y., Kim Y.T. // Appl. Surf. Sci. 2006. V. 252. P. 8102.
Wang J., Xu Y., Mazzarello R. et al. // Materials. 2017. V. 10. № 8. P. 862.
Rosenthal T., Welzmiller S., Neudert L. et al. // J. Solid State Chem. 2014. V. 219. P. 108.
Zhang B., Zhang W., Shen Z. et al. // Appl. Phys. Lett. 2016. V. 108. P. 191902.
Burton W.K., Cabrera N., Frank F.C. // Philos. Trans. 1951. V. 243. P. 299.
Зыбина Ю.С., Боргардт Н.И., Лазаренко П.И. и др. // Поверхность. Рентген., синхротр. и нейтр. исследования. 2019. Т. 10. С. 82.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография


