Микроэлектроника, 2020, T. 49, № 2, стр. 101-110
Особенности кинетики реактивно-ионного травления SiO2 в фтор-, хлор- и бром-содержащей плазме
А. М. Ефремов a, b, *, Д. Б. Мурин a, В. Б. Бетелин b, K.-H. Kwon c
a Федеральное государственное бюджетное образовательное учреждение высшего образования “Ивановский государственный химико-технологический университет”, кафедра технологии приборов и материалов электронной техники Иваново
Иваново, Шереметевский проспект 7, Россия
b Федеральное государственное учреждение “Федеральный научный центр Научно-исследовательский институт системных исследований Российской АН
Москва, Нахимовский просп., 36, к. 1, Россия
c Korea University, Department of Control and Instrumentation Engineering
339-700 Sejong, South Korea
* E-mail: efremov@isuct.ru
Поступила в редакцию 19.06.2019
После доработки 30.07.2019
Принята к публикации 30.07.2019
Аннотация
Проведено исследование влияния вида активного газа и соотношения концентраций компонентов в смесях CF4 + Ar, Cl2 + Ar и HBr + Ar на параметры плазмы, стационарные концентрации активных частиц и кинетику реактивно-ионного травления SiO2. Показано, что скорость травления SiO2 снижается в ряду CF4–Cl2–HBr и характеризуется немонотонным (с максимумом при 20–25% Ar) поведением при варьировании начального состава смесей. Установлено, что причинами не монотонности для каждой из смесей являются увеличение эффективной вероятности взаимодействия и снижение выхода травления за счет изменения электрофизических параметров плазмы и плотностей потоков активных частиц.
1. ВВЕДЕНИЕ
Неравновесная низкотемпературная плазма галогенсодержащих газов традиционно используется в технологии интегральной микро- и наноэлектроники в процессах очистки и структурирования (размерного травления) поверхности полупроводниковых пластин и функциональных слоев различной природы [1, 2]. В частности, в качестве активного компонента плазмообразующих сред для процессов реактивно-ионного травления кремния и его соединений (SiC, SiO2, Si3N4) нашли применение F-, Cl- и Br-содержащие газы, типичными представителями которых являются CF4, Cl2 и HBr [2–4]. Выбор активного газа для целей конкретного процесса определяется, как правило, набором оптимизируемых выходных параметров – скорости травления, анизотропии, селективности по отношению к материалу маски и/или нижележащего слоя, шероховатости и чистоты поверхности, глубины нарушенного слоя и др. Так, фторная химия обеспечивает высокие скорости травления кремния(из-за высокой летучести продуктов травления) при невысокой анизотропии процесса (из-за спонтанного взаимодействия атомов фтора с кремнием, приводящего к эрозии боковых стенок формируемого рельефа) [5]. Напротив, хлорная и бромная химии способствуют достижению анизотропного профиля травления, но отличаются низкими абсолютными значениями скоростей удаления материала с обрабатываемой поверхности [3, 4]. Последнее является следствием низкой летучести хлоридов и бромидов кремния, требующих ионно-стимулированной десорбции.
Очевидно, что выбор оптимального плазмообразующего газа для целей данного процесса требует знания особенностей и понимания взаимосвязей объемной и гетерогенной подсистем для каждой комбинации “плазма-обрабатываемый материал”. На настоящий момент времени имеется достаточное количество работ, посвященных исследованию кинетики и механизмов травления кремния в F-, Cl- и Br-содержащей плазме [2, 5–13]. Результаты сравнения этих систем могут быть кратко обобщены в виде следующих положений:
− Вероятность спонтанной химической реакции в системе Si + F значительно выше по сравнению с Si + Cl/Br [9]. Данный эффект обычно относят к меньшему размеру атомов фтора, что обеспечивает проникновение этих частиц в поверхностные слои обрабатываемого материала и образование насыщенных летучих фторидов кремния [5, 9]. Напротив, атомы Cl и Br взаимодействую с кремнием лишь по ограниченному числу связей, в результате чего 1) процесс травления требует ионной бомбардировки поверхности для десорбции ненасыщенных труднолетучих соединений вида SiClx(x < 4) и SiBrx(x < 4) [2, 8–10]; и 2) абсолютные значения скоростей травления значительно ниже по сравнению с фторной химией в аналогичном диапазоне условий [2, 9].
− Более низкие скорости травления кремния в плазме HBr по сравнению с плазмой Cl2 согласуются с различиями концентраций и плотностей потоков атомов в данных системах [10, 14]. В то же время, плазма HBr обеспечивает лучшую анизотропию травления кремния по причине 1) более низких значений ${{{{{\Gamma }}_{{{\text{Br}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{Br}}}}}} {{{{\Gamma }}_{ + }}}}} \right. \kern-0em} {{{{\Gamma }}_{ + }}}}$ [14](${{{\Gamma }}_{{{\text{Br}}}}}$ – плотность потока атомов брома, ${{{\Gamma }}_{ + }}$ – плотность потока ионов); 2) меньшего углового рассеяния ионов большей массы [12]. Было найдено также, что добавление кислорода к Cl2 и HBr вызывает снижение скорости травления, но способствует увеличению анизотропии процесса. Механизм данного эффекта связан с образованием менее летучих продуктов реакции вида SiClxOy и SiBrxOy, пассивирующих боковые стенки формируемого рельефа [12, 13].
К сожалению, провести аналогичное сравнение для SiO2 не представляется возможным из-за недостатка данных. Имеющиеся в литературе сведения по кинетике травления SiO2 в Cl- и Br-содержащей плазме разрознены, часто противоречивы и не согласуются по исследованным диапазонам условий. В то же время, актуальность такого сравнения обусловлена тем, что критерием оптимизации процессов реактивно-ионного травления часто выступает селективность в системе SiO2/Si. Таким образом, знание особенностей кинетики травления SiO2 в F-, Cl- и Br-содержащей плазме является необходимым условием выбора плазмообразующего газа, обеспечивающего достижение требуемых технологических и конструкционных параметров конечного изделия. С учетом вышесказанного, целью данной работы являлось исследование кинетики и анализ механизмов травления SiO2 в системах
переменного начального состава. Основное внимание было направлено на:
1) выявление взаимосвязей между характеристиками газовой фазы и гетерогенными процессами, определяющими кинетику травления SiO2;
2) анализ механизмов влияния начального состава смесей на скорость травления через изменение электрофизических параметров и состава плазмы.
2. МЕТОДИЧЕСКАЯ ЧАСТЬ
2.1. Экспериментальные методики и оборудование
Эксперименты проводились при возбуждении индукционного ВЧ (13.56 МГц) разряда в смесях CF4 + Ar, Cl2 + Ar и HBr + Ar в реакторе планарного типа с цилиндрической ($r$ = 13 см, $l$ = 16 см) рабочей камерой из анодированного алюминия [15]. В качестве постоянных условий процесса выступали вкладываемая мощность $W$ = 700 Вт, общее давление газа $p$ = 6мторр (~0.8 Па) и его расход $q$ = 44 станд. см3/мин. В качестве варьируемого параметра использовалась доля аргона в плазмообразующей смеси ${{y}_{{{\text{Ar}}}}},$ которая устанавливалось изменением индивидуальных расходов советующих газов в диапазоне 0–75%.
В качестве объектов травления использовались фрагменты окисленных пластин Si(100) размером ~4 см2, которые располагались на подложкодержателе из анодированного алюминия в нижней части рабочей камеры реактора. Температура образца ${{T}_{S}}$ стабилизировалась на уровне 17 ± 3°С с помощью системы проточного водяного охлаждения. Отрицательное смещение на подложкодержателе $ - {{U}_{{dc}}}$ задавалось независимым ВЧ (12.56 МГц) генератором с постоянной мощностью смещения ${{W}_{{dc}}}$ = 300 Вт. Измерение параметра $ - {{U}_{{dc}}}$ проводилось с помощью высоковольтного зонда AMN-CTR (Youngsin Eng, Korea). Подвергаемые травлению образцы были частично маскированы фоторезистом AZ1512, при этом высота ступеньки $\Delta h$ на границе маскированной и немаскированной областей измерялась профилометром Alpha-step D-500 (KLA-Tencor, USA). Скорость травления определяли как $R = {{\Delta h} \mathord{\left/ {\vphantom {{\Delta h} \tau }} \right. \kern-0em} \tau },$ где $~\tau ~$ – время травления.
Диагностика плазмы осуществлялась двойным зондом Лангмюра DLP2000 (Plasmart Inc., Korea). Обработка зондовых ВАХ базировалась на известных положениях теории двойного зонда [16, 17] с использованием максвелловской функции распределения электронов по энергиям (ФРЭЭ). Результатом обработки выступали данные по температуре электронов ${{T}_{e}}$ и плотности ионного тока ${{J}_{ + }}$. Суммарная концентрация положительных ионов ${{n}_{ + }}$ определялась из соотношения
где ${{v}_{B}} \approx \sqrt {{{e{{T}_{e}}} \mathord{\left/ {\vphantom {{e{{T}_{e}}} {{{m}_{i}}}}} \right. \kern-0em} {{{m}_{i}}}}} $ – скорость ионов на внешней границе двойного электрического слоя у поверхности зонда [5, 14]. Эффективная масса ионов ${{m}_{i}}$ оценивалась в предположении, что мольная доля каждого типа положительного иона пропорциональна2.2. Моделирование плазмы
Для получения данных по составу плазмы CF4 + + Ar, Cl2 + Ar и HBr + Ar использовалась 0-мерная кинетическая модель с использованием экспериментальных данных по ${{T}_{e}}$ и ${{n}_{ + }}$ в качестве входных параметров. Кинетические схемы (наборы реакций и соответствующих констант скоростей) для каждой из систем были заимствованы из наших предшествующих работ [12–14, 18–20]. Алгоритм моделирования базировался на совместном решении уравнений химической кинетики нейтральных и заряженных частиц cиспользованием типовых допущений для разрядов низкого ($p$ < 20 мторр) давления [18–20]:
1) максвелловская ФРЭЭ обеспечивает адекватное описание кинетики процессов под действием электронного удара;
2) температура газа ${{T}_{{{\text{gas}}}}}$ ≈ const в условиях $p,~W$ = const;
3) гетерогенная рекомбинация атомов и радикалов подчиняется механизму Или-Ридила.
Концентрация электронов оценивалась по измеренному значению ${{n}_{ + }}$ с использованием соотношения
полученного при совместном решении кинетического уравнения для отрицательных ионов и уравнения квазинейтральности плазмы [19, 20]. Константы скоростей ион-ионной рекомбинации ${{k}_{{ii}}}$ принимались равными для всех типов положительных ионов [14]. При расчете суммарных частот диссоциативного прилипания ${{\nu }_{{da}}}$ принимались во внимание CFx (x = 2–4), Cl2, HBr и Br2. Выходными параметрами модели служили средние по объему плазмы концентрации частиц и плотности их потоков на обрабатываемую поверхность.
2.3. Анализ кинетики гетерогенных процессов
Для анализа взаимосвязей параметров газовой фазы и кинетики гетерогенного взаимодействия активных частиц плазмы с поверхностью SiO2 использовались известные положения по механизмам реактивно-ионных процессов [5, 7, 8, 12–14]:
1) Любой канал физического взаимодействия (в нашем случае – ионное распыление основного материала и/или ионно-стимулированная десорбция частиц) характеризуется скоростью ${{Y}_{S}}{{{\Gamma }}_{ + }},$ где ${{Y}_{S}}$ – выход процесса (атом/ион) и ${{{\Gamma }}_{ + }} \approx {{{{J}_{ + }}} \mathord{\left/ {\vphantom {{{{J}_{ + }}} e}} \right. \kern-0em} e}$ – плотность потока ионов. Полагая ${{Y}_{S}}$ ~ $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} ,$ где ${{\varepsilon }_{i}} = e\left| { - {{U}_{f}} - {{U}_{{dc}}}} \right|$ – энергия бомбардирующих ионов, $ - {{U}_{f}} \approx 0.5{{T}_{e}}{\text{ln}}\left( {{{{{m}_{e}}} \mathord{\left/ {\vphantom {{{{m}_{e}}} {2.3{{m}_{i}}}}} \right. \kern-0em} {2.3{{m}_{i}}}}} \right)$ – плавающий потенциал, ${{M}_{i}}$ эффективная молярная масса ионов, изменение скорости любого ионного процесса при варьировании условий обработки отслеживается параметром $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}.$
2) Любой канал химического взаимодействия (в нашем случае – реакции атомов галогенов с образованием соединений вида SiXn, где Х = F, Cl или Br) характеризуется скоростью ${{\gamma }_{R}}{{{\Gamma }}_{X}},$ где ${{\gamma }_{R}}$ – эффективная вероятность взаимодействия и ${{{\Gamma }}_{X}} \approx \left( {{1 \mathord{\left/ {\vphantom {1 4}} \right. \kern-0em} 4}} \right){{n}_{X}}{{v}_{T}}$ – плотность потока атомов с концентрацией ${{n}_{X}}$(X = F, ClorBr). Величина ${{\gamma }_{R}}$ в условиях ${{T}_{S}}$ = const зависит от кинетики адсорбционно-десорбционнных процессов с участием активных частиц и продуктов взаимодействия [5, 8]. В частности, корреляция параметров ${{\gamma }_{R}}$ и $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ является свидетельством ионной активации химической реакции через очистку и/или образование активных центров, способных адсорбировать атомы галогенов [5, 7].
3. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 1 представлены данные по скоростям травления SiO2 и селективности травления по отношению к фоторезисту в плазме смесей CF4 + Ar, Cl2 + Ar и HBr + Ar. Из рис. 1а можно видеть, что скорость травления SiO2 в чистых галогенсодержащих газах снижается в ряду CF4–Cl2–HBr (~309 нм/мин для CF4, ~152 нм/мин для Cl2 и ~92 нм/мин для HBr), что согласуется со снижением летучести соответствующих галогенидов кремния. Последний вывод может быть проиллюстрирован сравнением температур кипения для SiF4 (–86°C), SiCl4 (57.7°C) и SiBr4 (154°C) [21]. Увеличение доли аргона во всех трех смесях сопровождается качественно аналогичными изменениями скорости травления SiO2, которая имеет явную тенденцию к снижению (вплоть до ~6 нм/мин при 100% Ar) с максимумом в области ${{y}_{{{\text{Ar}}}}}$ ~ 25%. Низкие скорости распыления ионного травления (распыления) SiO2 свидетельствуют о том, что основным механизмом процесса в исследованном диапазоне условий является ионно-стимулированная химическая реакция. Скорость травления фоторезиста монотонно снижается с ростом доли аргона в плазмообразующей смеси (342–277 нм/мин для CF4 + Ar, 192–114 нм/мин для Cl2 + Ar и 142–74 нм/мин для HBr + Ar при 0–75% Ar), что обуславливает немонотонное изменение селективности травления в системе SiO2/фоторезист. Наилучшая селективность ~1 достигается в системах 75% CF4 + 25% Ar и 50% Cl2 + 50% Ar.
Рис. 1.
Скорость травления SiO2 (а) и селективность травления по отношению к фоторезисту (б) в плазме смесей CF4 + Ar (1), Cl2 + Ar (2) и HBr + Ar (3).
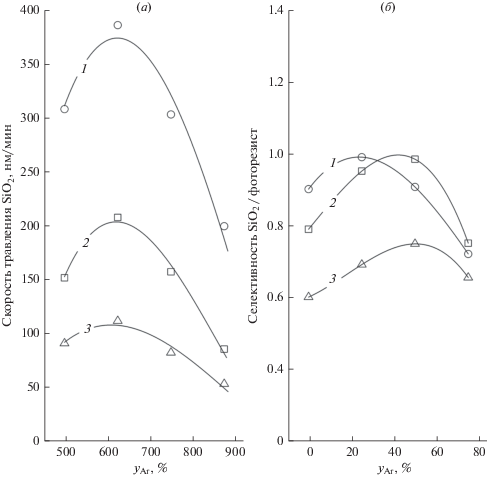
Качественно подобные зависимости ${{R}_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}}$ = = $f\left( {{{y}_{{{\text{Ar}}}}}} \right)$ позволяют предположить близкие механизмы и режимы травленияво всех трех смесях. Последнее означает, фактически, что соответствующие процессы травления обеспечиваются одинаковыми типами активных частиц и имеют однотипные (газофазные или гетерогенные) лимитирующие стадии. Из анализа предшествующих работ [7, 8, 22] следует, что немонотонные зависимости скорости травленияот начального составабинарной смеси химически активного и инертного газов могут быть обусловлены действием нескольких факторов, а именно:
1) немонотонными изменениями концентраций и плотностей потоков активных частиц (атомов галогенов, положительных ионов) по причине изменений электрофизических параметров плазмы и кинетики плазмохимических процессов в газовой фазе;
2) влиянием начального состава смеси на кинетические характеристики (вероятности, константы скоростей) гетерогенного взаимодействия. Механизмы процессов, формирующих стационарные электрофизические параметры и состав плазмы в смесях CF4 + Ar, Cl2 + Ar и HBr + Ar подробно изучались в наших работах [14, 19, 20]. Поэтому ограничимся лишь актуализацией соответствующих данных применительно к условиям настоящей работы. В частности, результаты диагностики плазмы и моделирования кинетики заряженных частиц, представленные на рис. 2 и 3, могут быть обобщены в виде следующих положений:
Рис. 2.
Электрофизические параметры плазмы смесей CF4 + Ar (1), Cl2 + Ar (2) и HBr + Ar (3): а – температура электронов (сплошные линии) и плотность ионного тока (пунктир); б – суммарная концентрация положительных ионов (сплошные линии) и концентрация электронов (пунктир).

Рис. 3.
Параметры, характеризующие интенсивность воздействия активных частиц на обрабатываемую поверхность в плазме смесей CF4 + Ar (1), Cl2 + Ar (2) и HBr + Ar (3): а – отрицательное смещение на подложкодержателе (сплошные линии) и плотность потока энергии ионов (пунктир); б – плотность потока атомов галогенов.

1) Температура (средняя энергия) электронов уменьшается в ряду CF4–HBr–Cl2 (~3.1 эВ для CF4, ~2.7эВ для HBr и ~2.5 эВ для Cl2, см. рис. 2а). Причина этого заключается в том, что плазма Cl2 обеспечивает наибольшие потери энергии электронов в процессах низкопорогового электронного возбуждения и ионизации. Увеличение ${{T}_{e}}$ с ростом параметра ${{y}_{{{\text{Ar}}}}}$ (3.1–3.5 эВ для CF4 + Ar, 2.5–3.3 эВ для Cl2 + Ar и 2.7–3.3 эВ для HBr + Ar при 0–75% Ar) обусловлено тем, что атомы Ar характеризуются более высоким пороговыми энергиями и низкими сечениями электронного возбуждения и ионизации. Поэтому добавка аргона приводит к снижению потерь энергии электронов в неупругих столкновениях с частицами газа и, как следствие, к увеличению доли “быстрых” электронов в ФРЭЭ.
2) Концентрация положительных ионов увеличивается в ряду CF4–Cl2–HBr (~4.5 × 1010 см–3 для CF4, ~ 6.6 × 1010 см–3 для Cl2 и ~1.1 × 1011 см–3 для HBr, см. рис. 2б), что согласуется с различиями скоростей ионизации доминирующих нейтральных частиц(исходных молекул и атомов галогенов)в каждой из систем. Причина этих различий заключается в том, что константы скоростей R1: HBr + e → HBr+ + 2e (~4.7 × 10–10 см3/с) и R2: Br + e → Br+ + 2e (~4.6 × 10–10 см3/с) существенно выше по сравнению с R3: Cl2 + e → ${\text{Cl}}_{2}^{ + }$ + + 2e (~4.2 × 10–10 см3/с), R4: Cl + e → Cl+ + 2e (~1.8 × 10–10 см3/с), R5: CF4 + e → ${\text{CF}}_{3}^{ + }$ + F + 2e (~1.9 × 10–10 см3/с) и R6: F + e → F+ + 2e (~8.2 × × 10–11 см3/с). Рост параметра ${{y}_{{{\text{Ar}}}}}$ приводит к росту констант скоростей ионизации всех нейтральных частиц, при этом в области ${{y}_{{{\text{Ar}}}}}$> 50% выполняется условие ${{k}_{7}}$ > ${{k}_{1}} - ~{{k}_{6}}$, где R7: Ar + e → Ar+ + 2e. Одновременно имеет место снижение частоты ион-ионной рекомбинации в объеме плазмы из-за снижения концентрации отрицательных ионов. Оба этих механизма обуславливают рост эффективных скоростей ионизации и величины ${{n}_{ + }}$ (4.5 × × 1010–9.3 × 1010 см–3 для CF4 + Ar, 6.6 × 1010–1.1 × × 1011 см–3 для Cl2 + Ar и 1.1 × 1011–2.7 × 1011 см–3 для HBr + Ar при 0–75% Ar, см. рис. 1б). Аналогичным образом изменяются и плотности ионных токов в каждой из систем (рис. 1а).
3) Концентрация электронов увеличивается в ряду Cl2–CF4–HBr (~2.7 × 1010 см–3 для CF4, ~2.4 × × 1010 см–3 для Cl2 и ~5.3 × 1010 см–3 для HBr, см. рис. 2б), что частично противоречит отмеченным выше соотношениям ${{n}_{ + }}$. Так, выполнение условия ${{n}_{e}}$(CF4) >${{n}_{e}}$(Cl2) обеспечивается значительно более высокими скоростями гибели электронов по реакции R8: Cl2 + e → Cl + Cl– (${{k}_{8}}$ ~ 3.4 × 10–10 см3/с) по сравнению с R9: CF4 + e → CF3 + F– (${{k}_{9}}$ ~ 0.6 × × 10–11 см3/с) из-за беспорогового прилипания электронов к молекулам Cl2. Рост параметра ${{y}_{{{\text{Ar}}}}}$ приводит к одновременному росту эффективной скорости ионизации и снижению частоты диссоциативного прилипания в соответствии с изменением величины $1 - {{y}_{{{\text{Ar}}}}}.$ Это обуславливает монотонный рост ${{n}_{е}}$ при увеличении содержания аргона во всех исследованных смесях (2.7 × 1010–8.6 × 1010 см–3 для CF4 + Ar, 2.4 × 1010–9.0 × 1010 см–3 для Cl2 + Ar и 5.3 × 1010–1.2 × 1011 см–3 для HBr + + Ar при 0–75% Ar, см. рис. 2б).
4) Отрицательное смещение на подложкодержателе при ${{W}_{{dc}}}$ = const имеет близкое значение в чистых галогенсодержащих газах и снижается с ростом доли Ar в плазмообразующей смеси (рис. 3а). Это соответствует снижению энергии ионов, бомбардирующих поверхность обрабатываемого материала (${{\varepsilon }_{i}}$ = 475–371 эВ для CF4 + Ar, 429–365 эВ для Cl2 + Ar и 433–355 эВ для HBr + + Ar при 0–75% Ar). Соответствующее снижение величины $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} $ с ростом ${{y}_{{{\text{Ar}}}}}$ с избытком компенсируется увеличением плотности потока ионов (5.7 × 1015–1.6 × 1016 см–2 с–1 для CF4 + Ar, 8.8 × 1015–1.9 × 1016 см–2 с–1 для Cl2 + Ar и 1.3 × × 1016–2.4 × 1016 см–2 с–1 для HBr + Ar при 0–75% Ar), что в итоге приводит к монотонному росту параметра $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ (рис. 3а). Абсолютная величина последнего при ${{y}_{{{\text{Ar}}}}}$ = const увеличивается в ряду CF4–Cl2–HBr из-за отмеченных выше различий ${{n}_{ + }}$ и ${{{\Gamma }}_{ + }}.$
Среди нейтральных частиц в плазме смесей CF4 + Ar, Cl2 + Ar и HBr + Ar наибольший интерес для анализа кинетики реактивно-ионного травления SiO2 представляют атомы галогенов. Образование этих частиц обеспечивается диссоциацией исходных молекул по механизмам R10:
Таким образом, снижение концентрации и плотности потока атомов галогенов в ряду Cl2–HBr–CF4 (рис. 3б) в условиях $p,~W$ = const напрямую связано с различиями в скоростях генерации этих частиц (из-за различий констант скоростей R10–R14, обусловленных абсолютными величинами пороговых энергий и сечений диссоциации). Рост параметра ${{y}_{{{\text{Ar}}}}}$ приводит к увеличению эффективности R10–R14 из-за одновременного увеличения температуры и концентрации электронов. Результирующий рост частот диссоциации молекул
обуславливает более медленное, по сравнению с параметром $1 - {{y}_{{{\text{Ar}}}}},$ снижение скорости образования, концентрации и плотности потоков атомов F, Cl и Br (в ~1.2раза для ${{n}_{{\text{F}}}}$ и ${{n}_{{{\text{Cl}}}}},$ и в ~1.4 раза для ${{n}_{{{\text{Br}}}}}$ при 0–50% Ar). Фактически, это соответствует увеличению степеней диссоциации галогенсодержащих частиц из-за роста эффективности диссоциации электронным ударом при изменении электрофизических параметров плазмы. Подобные эффекты неоднократно отмечались ранее в работах [19, 20, 22] для смесей Cl2 + Ar и HBr + Ar.
Сравнение данных рис. 1 и рис. 3 показывает, что немонотонные зависимости ${{R}_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}} = f\left( {{{y}_{{{\text{Ar}}}}}} \right)$ в каждой из смесей не коррелируют с монотонным поведением $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ и ${{{\Gamma }}_{X}}$. Это позволяет предположить, что основной причиной не монотонности является влияние начального состава смесей на кинетические характеристики гетерогенных стадий процесса травления. Так, увеличение доли аргона в плазмообразующей смеси приводит к увеличению эффективных вероятностей взаимодействия ${{\gamma }_{R}}$, определенных как отношение скорости травления (в пересчете на плотность потока продуктов с обрабатываемой поверхности в газовую фазу) к плотности потока атомов F, Cl или Br (рис. 4а). Данный факт находит простое объяснение на основе “классического” механизма травления SiO2, включающего стадии разрыва оксидных связей ионной бомбардировкой (R15), хемосорбцию атомов галогенов на кремнии (R16), химическую реакцию (R17) и ионно-стимулированную десорбцию продуктов реакции (R18):
(R15)
${\text{Si}}{{{\text{O}}}_{n}}\left( {s.} \right)\xrightarrow{{{\text{ионы}}}}\,~{\text{Si}}\left( {s.} \right) + nO,$Рис. 4.
Кинетические характеристики взаимодействия плазмы смесей CF4 + Ar (1), Cl2 + Ar (2) и HBr + Ar (3) с поверхностью SiO2: а – эффективная вероятность взаимодействия атомов галогенов; б – выход травления.

Действительно, так как реакции вида SiO2 + F, Cl, Br термодинамически невозможны, процесс R15 выступает в качестве инициирующей стадии травления и формирует последовательную схему с R16–R18. В такой ситуации интенсификация ионной бомбардировки увеличивает ${{\gamma }_{{\text{R}}}}$ за счет роста скоростей образования центров адсорбции по R15 и их очистки от продуктов взаимодействия по R18. Более медленное изменение ${{\gamma }_{{\text{R}}}}$ по сравнению с$\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ во всех трех смесяхможет быть связано с ионно-стимулированной десорбцией активных частиц:
(R19)
${\text{Si}}:nX\left( {s.} \right)\xrightarrow{{{\text{ионы}}}}{\text{Si}}\left( {s.} \right) + \,~nX,$снижающей эффективность R17. Из рис. 4а можно видеть также, что абсолютная величина ${{\gamma }_{R}}$ при ${{y}_{{{\text{Ar}}}}}$ = const снижается в ряду CF4–HBr–Cl2. Максимальное значение ${{\gamma }_{R}}$ в системе CF4 + Ar обусловлено высокой летучестью фторидов кремния, что обеспечивает эффективную очистку активных центров по R18. Выполнение условия ${{\gamma }_{R}}$(HBr) > ${{\gamma }_{R}}$(Cl2), которое формально противоречит соотношению летучестей хлоридов и бромидов кремния, является результатом существенных различий параметров $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ в этих системах (рис. 3а). Таким образом, универсальной (то есть справедливой для всех трех смесей) причиной максимума на зависимости ${{R}_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}} = f\left( {{{y}_{{{\text{Ar}}}}}} \right)$ является увеличение эффективной вероятности взаимодействия атомов галогенов из-за увеличения интенсивности ионной бомбардировки на фоне медленного снижения плотности потока атомов на поверхность.
В заключении отметим, что существуют подходы, в которых реактивно-ионное травление SiO2 рассматривается не как ионно-стимулированная химическая реакция, а как физическое распыление, стимулированное химической реакцией [5, 9]. Кинетической характеристикой такого процесса является выход травления ${{\gamma }_{R}}$, определяемый как отношение скорости травления (в пересчете на плотность потока продуктов с обрабатываемой поверхности в газовую фазу) к плотности потока ионов. По сути, данный параметр представляет эффективный коэффициент распыления, который зависит не только от энергии ионов, но и от химического состояния (наличия и/или состава продуктов химических реакций) обрабатываемой поверхности. Из рис. 4б можно видеть, что увеличение доли аргона в смесях
приводит к монотонному снижению величины ${{Y}_{{\text{R}}}}$. Очевидно, что причиной этого эффекта является снижение эффективного коэффициента распыления из-за 1) уменьшения энергии ионов, бомбардирующих поверхность; и 2) увеличения пороговой энергии распыления, вызванного переходом от распыления продуктов химических реакций (то есть частично галогенированных атомов кремния) к распылению SiO2.Таким образом, в рамках данного подхода наличие максимума на зависимости ${{R}_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}} = f\left( {{{y}_{{{\text{Ar}}}}}} \right)$ также объясняется противоположным характером изменения плотности потока активных частиц и кинетического коэффициента, характеризующего их взаимодействие с поверхностью. Снижение выхода распыления в ряду CF4–Cl2–HBr при ${{y}_{{{\text{Ar}}}}}$ = const однозначно коррелирует с изменением летучести галогенидов кремния, которая определяет пороговую энергию распыления.
ЗАКЛЮЧЕНИЕ
Проведено исследование взаимосвязей параметров газовой фазы (электрофизических параметров, концентраций и плотностей потоков активных частиц) и кинетики реактивно-ионного травления SiO2 в бинарных смесях CF4 + Ar, Cl2 + + Ar и HBr + Ar. Найдено, что при постоянных внешних условиях процесса (давление газа, вкладываемая мощность и мощность смещения) скорость травления SiO2 снижается в ряду CF4–Cl2–HBr и характеризуется немонотонным (с максимумом при 20–25% Ar) поведением при варьировании начального состава смесей. При совместном использовании методов диагностики и моделирования плазмы установлено, что: 1) вид активного газа оказывает существенное влияние на концентрации активных частиц (атомов галогенов, положительных ионов) через особенности кинетики процессов под действием электронного удара; и 2) варьирование начального состава смесей характеризуется качественно однотипными изменениями состава плазмы и плотностей потоков активных частиц на обрабатываемую поверхность. При анализе кинетики травления SiO2 с использованием расчетных данных по плотностям потоков активных частиц показано, что универсальной (то есть справедливой для всех трех смесей) причиной не монотонности скорости травления является противоположный характер изменения плотностей потоков активных частиц и кинетических характеристик гетерогенного взаимодействия – эффективной вероятности и выхода травления.
Публикация выполнена в рамках государственного задания ФГУ ФНЦ НИИСИ РАН (проведение фундаментальных научных исследований) по теме № 0065-2019-0006 “Фундаментальные и прикладные исследования в области субволновой голографической литографии, физико-химических процессов травления 3D нанометровых диэлектрических структур для развития критических технологий производства ЭКБ”.
Список литературы
Advanced plasma processing technology. John Wiley & Sons Inc.New York. 2008, 479 p.
Wolf S., Tauber R.N. Silicon Processing for the VLSI Era. V. 1. Process Technology. Lattice Press. New York. 2000. 416 p.
Nojiri K. Dry etching technology for semiconductors. Springer International Publishing. Tokyo. 2015, 116 p.
Rooth J.R. Industrial Plasma Engineering. IOP Publishing LTD. Philadelphia. 2001. 658 p.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. John Wiley & Sons Inc. New York. 2005, 730 p.
Standaert T.E.F.M., Hedlund C., Joseph E.A., Oehrlein G.S. Role of fluorocarbon film formation in the etching of silicon, silicon dioxide, silicon nitride, and amorphous hydrogenated silicon carbide // J. Vac. Sci. Technol. A. 2004. V. 22. P. 53–60.
Gray D.C., Tepermeister I., Sawin H.H. Phenomenological modeling of ion enhanced surface kinetics in fluorine-based plasma etching // J. Vac. Sci. Technol. B. 1993. V. 11. P. 1243–1257.
Jin W., Vitale S.A., Sawin H.H. Plasma-surface kinetics and simulation of feature profile evolution in Cl2 + HBr etching of polysilicon // J. Vac. Sci. Technol. 2002. V. 20. P. 2106–2114.
Vitale S.A., Chae H., Sawin H.H. Silicon etching yields in F2, Cl2, Br2, and HBr high density plasmas // J. Vac. Sci. Technol. 2001. V. 19. P. 2197–2206.
Cheng C.C., Guinn K.V., Herman I.P., Donnelly V.M. Competitive halogenation of silicon surfaces in HBr/Cl2 plasmas studied with xray photoelectron spectroscopy and in situ, realtime, pulsed laserinduced thermal desorption // J. Vac. Sci. Technol. A. 1995. V. 13. P. 1970–1976.
Ito T., Karahashi K., Kang S.-Y., Hamaguchi S. Evaluation of Si etching yields by Cl+ Br+ and HBr+ ion irradiation // J. Phys.: Conference series. 2010. V. 232. P. 012021.
Lee B.J., Efremov A., Kim J., Kim C., Kwon K.-H. Peculiarities of Si and SiO2 Etching Kinetics in HBr + Cl2 + O2 Inductively Coupled Plasma // Plasma Chem. Plasma Proc. 2019. V. 39. P. 339–358.
Lee B.J., Efremov A., Kwon K.-H. Plasma parameters, gas-phase chemistry and Si/SiO2 etching mechanisms in HBr + Cl2 + O2 gas mixture: Effect of HBr/O2 mixing ratio // Vacuum. 2019. V. 163. P. 110–118.
Efremov A., Lee J., Kwon K.-H. A comparative study of CF4, Cl2 and HBr + Ar inductively coupled plasma sfordryetching applications // Thin Solid Films. 2017. V. 629. P. 39–48.
Son J., Efremov A., Yun S.J., Yeom G.Y., Kwon K.-H. Etching Characteristics and Mechanism of SiNx Films for Nano-Devices in CH2F2/O2/Ar Inductively Coupled Plasma: Effect of O2 Mixing Ratio // J. Nanosci. Nanotechnol. 2014. V. 14. P. 9534–9540.
Johnson E.O., Malter L. A floating double probe method for measurements in gas discharges // Phys. Rev. 1950. V. 80. № 1. P. 58–68.
Shun’ko E.V. Langmuir probein theory and practice. Universal Publishers. Boca Raton, 2008. 245 p.
Efremov A., Lee J., Kim J. On the control of plasma parameters and active species kinetics in CF4 + O2 + Ar gas mixture by CF4/O2 and O2/Ar mixing ratios // Plasma Chem. Plasma Process. 2017. V. 37. P. 1445–1462.
Efremov A., Min N.K., Choi B.G., Baek K.H., Kwon K.H. Model-based analysis of plasma parameters and active species kinetics in Cl2/X (X = Ar, He, N2) inductively coupled plasmas // J. Electrochem. Soc. 2008. V. 155. № 12. P. D777–D782.
Kwon K.H., Efremov A., Kim M., Min N.K., Jeong J., Kim K. A model-based analysis of plasma parameters and composition in HBr/X (X = Ar, He, N2) inductively coupled plasmas // J. Electrochem. Soc. 2010. V. 157. № 5. P. H574–H579.
Lide D.R. Hand book of chemistry and physics. CRC Press. New York. 1998–1999. 2661 p.
Efremov A.M., Kim D.P., Kim C.I. Simple model for ion-assisted etching using Cl2-Ar inductively coupled plasma: effect of gas mixing ratio // IEEE Trans. Plasma Sci. 2004. V. 32. P. 1344–1351.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


