Микроэлектроника, 2020, T. 49, № 2, стр. 111-115
Исследование дефектообразования при облучении кремния γ-квантами
М. А. Сауров a, С. В. Булярский b, *, А. В. Лакалин b
a Национальный исследовательский университет “Московский институт электронной техники”
124498 Зеленоград, Москва, площадь Шокина, 1, Россия
b Институт нанотехнологий микроэлектроники Российской академии наук
119991 , Москва, Ленинский проспект, 32А, Россия
* E-mail: bulyar2954@mail.ru
Поступила в редакцию 04.07.2019
После доработки 23.07.2019
Принята к публикации 16.08.2019
Аннотация
Исследовались параметры рекомбинационных центров кремниевых фотодиодов до и после облучения γ-квантами. Исследования проводились методом рекомбинационной спектроскопии глубоких уровней. Показано, что после облучения увеличиваются токи через p-n-переход, как при прямом, так и при обратном смещении, что объясняется ростом концентрации рекомбинационных центров, связанных с образованием вакансий при облучении.
ВВЕДЕНИЕ
Взаимодействие радиационного излучения с полупроводниками сопровождается возникновением дефектов кристаллической решетки: вакансий, атомов основного вещества, переходящих в междоузлия, а также более сложных дефектов вторичного дефектообразования [1]. Такие дефекты существенно изменяют основные физические свойства полупроводников, в первую очередь, время жизни и обратные токи приборов. Вследствие их высокой чувствительности к введению дефектов изменения происходят уже при небольших дозах облучения. Именно это является причиной низкой устойчивости полупроводниковых приборов к воздействию высокоэнергетической радиации. К настоящему времени накоплена достаточно обширная информационная база об образовании радиационных дефектов в кремнии и кремниевых структурах, а также проводились исследования параметров глубоких центров различными методами [2–6]. Цель данной работы – применение метода рекомбинационной спектроскопии для расчета параметров глубоких центров и исследование влияния γ-облучения на характеристики кремниевых диодов.
Как известно, в кремниевых диодах при низком уровне инжекции преобладают токи рекомбинации через глубокие центры. Это позволяет применить метод рекомбинационной спектроскопии [7–9] для определения параметров рекомбинационных центров. К таким параметрам прежде всего следует отнести время жизни неосновных носителей заряда τ, которое весьма чувствительно к радиации и с ростом дозы облучения уменьшается, а также энергию активации.
МЕТОДИКА ЭКСПЕРИМЕНТА
Экспериментально исследованы кремниевые фотодиоды, изготовленные на основе слаболегированного кремния n-типа, с удельным сопротивлением порядка 500 Ом см. Проводились измерения электрических характеристик диодов, затем они облучались и измерения повторялась заново. Исследовались образцы, подвергнутые облучению дозой 0.5 Мрад (энергия γ-квантов E ≈ 1.25 МэВ). Были проведены измерения вольт-амперных характеристик (ВАХ) кремниевых фотодиодов в интервале температур –30…+60°С как до облучения, так и после облучения. Для измерений ВАХ на постоянных токах использовался анализатор полупроводниковых приборов B1500A фирмы Keysight. Прибор оптимизирован для измерений слаботочных сигналов вплоть до токов 10–15 А и оснащен специальными экранированными триаксиальными выводами с функцией компенсации сверх малых токов. Входное сопротивление прибора (более 100 ТОм) обеспечивает при измерениях самый минимальный уровень вносимых искажений и ошибок в тестируемые схемы в этом классе приборов.
Прямые и обратные вольт-амперные характеристики до и после облучения приведены на рис. 1.
Рис. 1.
Прямые (слева) и обратные (справа) вольт-амперные характеристики кремниевого диода при температуре 0°С: 1 – до облучения; 2 – после облучения.
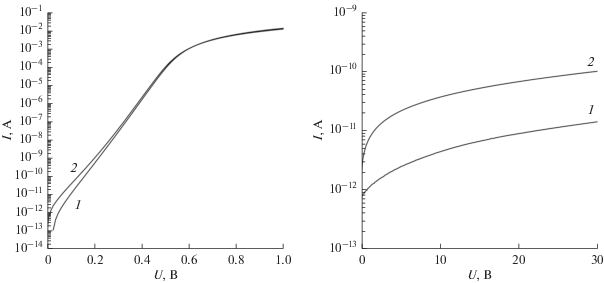
На начальном участке прямой вольт-амперной характеристики наблюдалось увеличение тока после облучения. Так как на этом участке ток обусловлен рекомбинацией в ОПЗ, можно сделать вывод, что увеличивается концентрация рекомбинационных центров.
Ток через диод при обратном смещении обусловлен генерацией в ОПЗ. Выражение для тока генерации имеет вид:
где $q$ – заряд электрона, $w$ – ширина области пространственного заряда (ОПЗ), ${{N}_{t}}$ – концентрация рекомбинационных центров, $e_{n}^{t}$ – скорость термической эмиссии электронов.Формула (1) показывает, что величина тока генерации при обратном смещении прямо пропорциональна концентрации рекомбинационных центров. Ток генерации после облучения вырос в 10 раз. Можно предположить, что в 10 раз увеличилась концентрация рекомбинационных центров.
ОБРАБОТКА РЕЗУЛЬТАТОВ ИЗМЕРЕНИЙ
Результаты измерений обрабатывались по методикам работ [7–9].
Экспериментальные вольтамперные характеристики подвергались преобразованию, которое позволяло лучше выявить их особенности. Была рассчитана зависимость приведенной скорости рекомбинации от напряжения ${{R}_{{np}}}\left( U \right).$ Эта величина является обратной времени жизни и обладает особенностями, которые связаны с параметрами рекомбинационных центров. Приведенная скорость рекомбинации определяется как [8]:
(2)
${{R}_{{np}}}(U) = \frac{{{{i}_{r}}(U)\exp \left( {\frac{{qU}}{{2kT}}} \right)}}{{Sw(U){{n}_{i}}\left( {\exp \left( {\frac{{qU}}{{kT}}} \right) - 1} \right)}}\frac{{{{U}_{{{\text{dif}}}}}(U) - U}}{{2kT}},$На рис. 2 представлены рассчитанные приведенные скорости рекомбинации образца № 5 при температуре 0°С до и после облучения. Ее связь с параметрами центров рекомбинации имеет вид [8, 9]:
(3)
${{R}_{{np}}}(U) = \sum\limits_{m = 1}^s {\frac{{{{c}_{{nm}}}{{c}_{{pm}}}{{N}_{{tm}}}{{n}_{i}}\exp \left( {\frac{{qU}}{{2kT}}} \right)}}{{2{{n}_{i}}\sqrt {{{c}_{{nm}}}{{c}_{{pm}}}} \exp \left( {\frac{{qU}}{{2kT}}} \right) + {{c}_{{nm}}}{{n}_{{1m}}} + {{c}_{{pm}}}{{p}_{{1m}}}}}} ,$Рис. 2.
Приведенные скорости рекомбинациипри температуре 0°С: 1 – до облучения; 2 – после облучения.

Для того, чтобы разделить приведенную скорость рекомбинации на составляющие, соответствующие потокам рекомбинации через отдельные рекомбинационные центры, были введены обозначения ${{\alpha }_{m}} = ({{{{n}_{{1m}}}} \mathord{\left/ {\vphantom {{{{n}_{{1m}}}} {{{n}_{i}}}}} \right. \kern-0em} {{{n}_{i}}}}){{c}_{{nm}}}{{N}_{{tm}}},$ ${{\zeta }_{m}} = ({{{{n}_{{1m}}}} \mathord{\left/ {\vphantom {{{{n}_{{1m}}}} {{{n}_{i}}}}} \right. \kern-0em} {{{n}_{i}}}}){{({{{{c}_{{nm}}}} \mathord{\left/ {\vphantom {{{{c}_{{nm}}}} {{{c}_{{pm}}}}}} \right. \kern-0em} {{{c}_{{pm}}}}})}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}$ (здесь воспользовались равенством n1mp1m = $n_{i}^{2}$), тогда:
(4)
${{R}_{{np}}}(U) = \sum\limits_{m = 1}^s {\frac{{{{\alpha }_{m}}\exp \left( {\frac{{qU}}{{2kT}}} \right)}}{{2{{\zeta }_{m}}\exp \left( {\frac{{qU}}{{2kT}}} \right) + {{\zeta }_{m}}^{2} + 1}}} .$Каждое слагаемое в (4) соответствует рекомбинационному центру с номером m и описываются двумя параметрами αm и ζm. В случае единственного рекомбинационного центра (m = 1) в области очень малых напряжений, когда
приведенная скорость рекомбинации равна:
(6)
${{R}_{{np}}}(U) = \frac{\alpha }{{{{\zeta }^{2}} + 1}}\exp \left( {\frac{{qU}}{{2kT}}} \right).$С ростом напряжения, когда
приведенная скорость рекомбинации
По начальному участку ${{R}_{{np}}}(U)$ легко определить предэкспоненциальный множитель α/(ζ2 + 1) в (5), а по конечному участку –α/(2ζ) в (8), после чего можно найти α и ζ, которые, в свою очередь, связаны с параметрами глубокого уровня [7–9]:
(9)
${{E}_{{tn}}} = \frac{{{{E}_{g}}}}{2} - kT\ln \zeta + \frac{3}{4}kT\ln \frac{{m_{n}^{*}}}{{m_{p}^{*}}} + \frac{1}{2}kT\ln \frac{{{{c}_{n}}}}{{{{c}_{p}}}},$Оценку времени жизни можно сделать по $m_{n}^{*},~m_{p}^{*}$ формуле:
(10)
$\sqrt {{{\tau }_{{n0}}}{{\tau }_{{p0}}}} = {{\left( {\frac{1}{{{{c}_{n}}{{N}_{t}}}}} \right)}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}{{\left( {\frac{1}{{{{c}_{p}}{{N}_{t}}}}} \right)}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}} = \frac{\zeta }{\alpha },$Для разделения ${{R}_{{np}}}(U)$ на составляющие и нахождения значений αm и ζm удобно использовать регрессионный анализ, когда экспериментальная ${{R}_{{np}}}(U)$ аппроксимируется теоретической модельной зависимостью (4). В результате аппроксимации получается набор значений параметров αm и ζm (m = 1, …, s).
Для расчета ${{R}_{{np}}}(U)$ по формуле (2) предварительно измерялась вольт-фарадная характеристика, из которой определялись ${{U}_{{{\text{dif}}}}}$ и зависимость $w(U).$ Для рассматриваемого образца экспериментальную зависимость ${{R}_{{np}}}(U)$ удалось разложить на три уровня (рис. 3), и для каждого из них определить α и ζ. Затем, зная α и ζ, согласно (9), (10) рассчитывались энергия активации ${{E}_{{tn}}}$ и $\sqrt {{{\tau }_{{n0}}}{{\tau }_{{p0}}}} .$ На рис. 4 представлены зависимости ${{E}_{{tn}}}(T)$ в рассматриваемом интервале температур –30…+60°С, полученные путем разделения ${{R}_{{np}}}(U)$ на составляющие, для всех трех уровней. При этом энергии активации каждого уровня как до облучения, так и после облучения не изменились (в пределах погрешности).
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
Анализ полученных характеристик показывает, что в рекомбинации принимают участие рекомбинационные центры, которые создают в запрещенной зоне полупроводника глубокие уровни с энергиями (при температуре 20°С)
Концентрация этих рекомбинационных центров растет при облучении образцов γ-квантами. Это приводит к увеличению тока рекомбинации из-за уменьшения времени жизни. При этом природа рекомбинационных центров до и после облучения не изменяется, т.к. энергии активации уровней в пределах погрешности остались теми же. Так как при облучении γ-квантами образуются собственные точечные дефекты, в том числе вакансии, то можно сделать вывод, что наблюдаемые рекомбинационные центры связаны с этими дефектами и являются комплексами, которые возникли в результате взаимодействия точечных собственных дефектов кремния с примесными атомами. Судя по величинам энергий, центр с энергией 0.27 эВ может принадлежать дивакансии кремния, а центры 0.44 и 0.54 эВ принадлежат вакансионно-примесным комплексам [1, 2].
ЗАКЛЮЧЕНИЕ
В результате выполненных экспериментальных исследований показано, что при облучении кремниевых фотодиодов γ-квантами увеличение токов при прямом и обратном смещении обусловлено ростом концентрации рекомбинационных центров, связанных с образованием собственных точечных дефектов и комплексов, образованными точечными дефектами с примесными атомами.
Список литературы
Вавилов В.С., Ухин Н.А. Радиационные дефекты в полупроводниках и полупроводниковых приборах. М.: Атомиздат. 1969, 312 с.
Borchi E., Bruzzi M. Radiation damage in silicon detectors // LaRivista del Nuovo Cimento. 1994. V. 17. № 11. P. 1–63.
Lefèvre H. Annealing behavior on trap-centers in silicon containing A-swirl defects // Appl. Phys. A. 1982. V. 29. № 2. P. 105–111.
Sobolev N.A., Shek E.I., Kurbakov A.I., Rubinova E.E., Sokolov A.E. Characterization of vacancy-related defects introduced into silicon during heat treatment by deep-level transient spectroscopy and gamma-ray diffraction techniques // Appl. Phys. A. 1996. V. 62. № 3. P. 259–262.
Chroneos A., Londos C., Sgourou E.N., Pochet P. Point defect engineering strategies to suppress A-center formation in silicon // Appl. Phys. Lett. 2011. V. 99. № 24. P. 99241901.
Ohyama H., Shitogiden H., Takakura K. et al. // J. Mater. Sci.: Mater Electron. 2008. V. 19. № 2. P. 171–173.
Bulyarskiy S.V., Grushko N.S., Somov A.I., Lakalin A.V. Recombination in the space charge region and its effect on the transmittance of bipolar transistors // Semiconductors. 1997. V. 31. № 9. P. 983–987.
Bulyarskiy S.V., Grushko N.S., Lakalin A.V. Differential methods for determination of deep-level parameters from recombination currents of p-n-junctions // Semiconductors. 1998. V. 32. № 10. P. 1065–1068.
Vorob’ev M.O., Grushko N.S., Lakalin A.V. Deep-level Bulyarskiy recombination spectroscopy in GaP light-emitting diodes // Semiconductors.1999. V. 33. № 6. P. 668–671.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника




