Микроэлектроника, 2023, T. 52, № 1, стр. 58-67
Разработка методики построения нелинейной модели метаморфного 0.15 мкм МHEMT InAlAs/InGaAs транзистора
В. В. Локотко 1, *, И. С. Васильевский 1, Н. И. Каргин 1
1 Национальный исследовательский ядерный университет “МИФИ”
Москва, Россия
* E-mail: vasilii.lokotko@gmail.com
Поступила в редакцию 17.06.2022
После доработки 11.07.2022
Принята к публикации 11.07.2022
- EDN: CXYGKP
- DOI: 10.31857/S0544126922700053
Аннотация
В статье рассматривается высокоточная методика моделирования InAlAs/InGaAs MHEMT транзисторов СВЧ диапазона частот с длиной затвора 0.15 мкм. Описанная методика учитывает нелинейные зависимости внутренних параметров от приложенных напряжений. Установлено, что максимальная ошибка моделирования не превышает 1.5% в диапазоне частот от 1 до 50 ГГц.
1. ВВЕДЕНИЕ
Технологический прогресс в области систем радиосвязи требует наличия электронной схемы с возможностью работы на сверхвысоких частотах. Одним из ключевых элементов в тракте приемника является малошумящий усилитель. При этом к нему предъявляется ряд требований по коэффициенту шума и усиления в широком частотном диапазоне. Для нахождения компромиссов необходимо на этапе проектирования разработать модель, которую можно использовать для разработки усилителя. В настоящее время существует множество способов проектирования эмпирической модели транзистора. Все они могут быть классифицированы как аналитические, [1–3] на основе оптимизации [4–6] и гибридные методы (на основе частичной оптимизации) [7–9]. Аналитические методы основаны на приближенных выражениях и измерениях в интересующей рабочей точке. Чаще всего они страдают от погрешностей измерений из-за крайне низких значений параметров, приводящих к ошибочному извлечению элементов схемы. Как правило, эти методы требуют большого объема измерений. Для преодоления таких ограничений были разработаны методы моделирования на основе алгоритмов оптимизации. Они не требуют тщательных начальных оценок параметров модели и обеспечивают хорошее соответствие между измеренными и смоделированными характеристиками устройства. Однако, существует проблема локального минимума, кроме того, эти методы часто дают нефизические значения элементов схемы, что приводит к ошибочной модели наряду с увеличением затраченного. Гибридные методы лишены указанных недостатков, в них определенный набор элементов схемы вычисляется с использованием аналитически аппроксимированных выражений, а остальные определяются с помощью подходящих алгоритмов оптимизации.
Существующие САПР, предназначенные для проектирования СВЧ-устройств (такие, как ADS, Microwave Office, Serenade и др.), обычно решают широкий спектр задач, при этом в некоторых узкоспециализированных случаях могут выдавать ошибочные результаты. Так при проектировании малосигнальных моделей транзистора, данные САПР используют только оптимизационные методы, что приводит к физически не обоснованным результатам, при отсутствии начальных условий. Использование узкоспециализированных программ позволит повысить эффективность проектирования СВЧ-устройств (в том числе МШУ), а именно: упростить и ускорить определенный этап проектирования устройства, улучшить качественные показатели, а также снизить требования к квалификации разработчиков. Использование нелинейных моделей позволяет характеризовать транзистор при отсутствии измеренных S-параметров при определeнных напряжениях смещения и питания. Как правило точность модели уменьшается по мере увеличения числа параметров. Большее количество параметров так же приводит к увеличению времени определения параметров транзистора. В данной статье описывается методика формирования 16-элементной нелинейной модели для метаморфного 0.15 мкм МHEMT InAlAs/InGaAs транзистора, состоящая из 46 параметров. Процент ошибок в диапазоне от 1 до 50 ГГц не превышает 3.5% для линейной и 1.5% для нелинейной модели.
2. МЕТОДИКА
Эквивалентная схема полевого транзистора может быть разделена на внутреннюю часть, значения которой являются функцией напряжения смещения и питания f(Ugs, Uds), и внешнюю часть, которая не зависит от прикладываемых напряжений f(Ugs, Uds) = const. Каждый элемент рассчитывается путем решения аналитических уравнений или оптимизации S-параметров. Точное измерение S-параметра является обязательным условием для определения значений параметров эквивалентной схемы транзистора.
На рис. 1 представлена эквивалентная схема полевого транзистора, состоящая из двух основных частей: внутренней и внешней. Внутренняя часть представляет собой непосредственно структуру транзистора, а внешняя описывает паразитные параметры.
Внешняя часть состоит из 8 элементов: Rg, Lg, Cpg – паразитные сопротивление, индуктивность и емкость затвора; Rd, Ld, Cpd паразитные сопротивление, индуктивность и eмкость стока; Rs, Ls паразитные сопротивление и индуктивность истока. Внутренняя часть стоит из 7 элементов Rds, Cds – внутренние сопротивление и eмкость перехода сток-исток, Rgd, Cgd – внутренние сопротивление и ёмкость перехода сток-затвор; Rgs, Cgs – внутренние сопротивление и емкость перехода исток-затвор; gmUgs – эквивалентный источник тока, где g = gme–jωτ, τ – время задержки, gm – крутизна транзистора, Ugs напряжение истоком и затвором.
На рис. 2 представлена блок схема методики моделирования транзистора. Методика построения модели HEMT транзистора состоит из нескольких этапов. На первом этапе проводятся измерения S-параметров исследуемого транзистора в широком диапазоне частот для различных напряжений смещения и питания. На втором этапе определяются внешние и внутренние параметры эквивалентной схемы транзистора. На третьем этапе определяются параметры нелинейной модели методом минимизации среднеквадратичной ошибки.
Экстракция паразитных емкостей
Часто выделяют два набора паразитных емкостей. Первые обусловлены контактными площадками или контактами зондов, Cpg, Cpd и Cdsp; и те, которые учитывают межэлектродные емкости Cgsi, Cdgi и Cdsi. Расчет таких емкостей, описанный в [6], требует начальных условий, полученных из эмпирических предположений, основанных на топологии транзистора. Для упрощения расчетов, межэлектродными емкостями часто пренебрегают многие авторы [7, 8], поскольку эти значения всегда относительно малы. В данной статье Cdgp также игнорируется для упрощения расчета.
Емкости контактных площадок Cpg и Cpd могут быть извлечены в режиме “холодного” полевого транзистора (Uds = 0 В, Ugs ≤ 0 В) на низких частотах (порядка 1 ГГц). Согласно [1], эквивалентная схема в данных условиях может быть представлена, как показано на рис. 3. В этом случае из мнимой части Y-параметров можно извлечь контактные емкости следующими отношениями:
где Cb – емкость внутренней части цепи, при (Uds = = 0, Ugs ≤ 0).Емкости контактных площадок определялись путем вычисления наклона мнимых частей Y-параметров. В статье [9] говорится, что напряжение смещения Ugs ≤ 0 В подавляет проводимость затвора. Это позволяет точнее определять значения емкости контактных площадок, при использовании меньших значений напряжения смещения.
Экстракция паразитных индуктивностей и сопротивлений
Согласно [1], эквивалентная схема в условиях Uds = 0 В, Ugs ≤ 0 В, может быть представлена как показано на рис. 4. Паразитные индуктивности и сопротивления определены из измерения импеданса в “холодном” режиме работы транзистора путем анализа Z-параметров:
(4)
${{Z}_{{11}}} = {{R}_{g}} + {\text{ }}{{R}_{s}}~ + j{{\omega }}\left( {{{L}_{s}} + {{L}_{g}}} \right),$(5)
${{Z}_{{12}}} = {{R}_{{{\text{ch}}}}}{\text{/}}2 + {\text{ }}{{R}_{s}}~ + j{{\omega }}{{L}_{s}},$(6)
${{Z}_{{22}}} = {{R}_{d}} + {{R}_{s}}~ + {{R}_{{{\text{ch}}}}} + j{{\omega }}\left( {{{L}_{s}} + {{L}_{d}}} \right),$В данной работе мы пренебрегали сопротивлением канала Rch, как это было предложено в [6], что облегчает определение паразитных сопротивлений.
Значения индуктивностей определялись из линейных зависимостей мнимых частей импеданса, а сопротивления – из действительных частей импеданса в частотном диапазоне выше 30 ГГц, чтобы минимизировать погрешность от остаточных емкостных элементов. Действительные и мнимые части приводились к частотным формам путем умножения на круговую частоту ω и построения соответствующих зависимостей ωIm(Z) и ω2Re(Z) от ω2.
Расчет внутренних параметров
Для определения значений внутренних параметров транзистора необходимо извлечь внешние параметры из измеренных Y-параметров путем матричных преобразований:
(7)
${{Y}^{i}} = {{\left[ {{{{\left[ {{{{\left[ {{{Y}^{m}} - {{Z}^{R}}} \right]}}^{{ - 1}}} - \omega Y} \right]}}^{{ - 1}}} - \omega {{Z}^{L}}} \right]}^{{ - 1}}};$(8)
${{Z}^{R}} = \left[ {\begin{array}{*{20}{c}} {{{R}_{g}} + {{R}_{s}}}&{{{R}_{s}}} \\ {{{R}_{s}}}&{{{R}_{d}} + {{R}_{s}}} \end{array}} \right];$(9)
${{Y}^{C}} = \left[ {\begin{array}{*{20}{c}} {{{C}_{{pg}}}}&0 \\ 0&{{{C}_{{pd}}}} \end{array}} \right];$(10)
${{Z}^{L}} = \left[ {\begin{array}{*{20}{c}} {{{L}_{g}} + {{L}_{s}}}&{{{L}_{s}}} \\ {{{L}_{s}}}&{{{L}_{d}} + {{L}_{s}}} \end{array}} \right],$Внутренние параметры транзистора определяются путем решения системы линейных комплексных уравнений (11)–(16):
(11)
$\begin{gathered} {{Y}_{{11}}} = ({{R}_{g}}_{s}{{\omega }^{2}}C_{{gs}}^{2} + j\omega {{C}_{g}}_{s}){\text{/}}{{D}_{1}} + \\ + \,\,({{R}_{g}}_{d}{{\omega }^{2}}C_{{gd}}^{2} + j\omega {{C}_{g}}_{d}){\text{/}}{{D}_{2}}; \\ \end{gathered} $(12)
${{Y}_{{12}}} = - ({{R}_{g}}_{d}{{\omega }^{2}}C_{{gd}}^{2} + j\omega {{C}_{g}}_{d}){\text{/}}{{D}_{2}};$(13)
$\begin{gathered} {{Y}_{2}}_{1} = {{g}_{m}}{{e}^{{( - j\omega \tau )}}}{\text{/}}(1 + j\omega {{C}_{g}}_{s}{{R}_{g}}_{s}) - \\ - \,\,_{{}}^{{}}({{R}_{g}}_{d}{{\omega }^{2}}C_{{gd}}^{2} + j\omega {{C}_{g}}_{d}){\text{/}}{{D}_{2}}; \\ \end{gathered} $(14)
${{Y}_{2}}_{2} = 1{\text{/}}{{R}_{d}}_{s} + j\omega {{C}_{d}}_{s} + ({{R}_{g}}_{d}{{\omega }^{2}}C_{{gd}}^{2} + j\omega {{C}_{g}}_{d}){\text{/}}{{D}_{2}};$В некоторых работах [1–3] на этом этапе для определения параметров Rgs, Rgd, Cgs, Cgd используется предположение что D1 и D2 примерно равны единице на низких частотах. Однако такое допущение может повлиять на точность расчета на высоких частотах. Для повышения точности используется выражения, в которых ωCR выражены через соответствующие мнимые и действительные части Y-параметров.
Нелинейная модель
Используемая в данной работе нелинейная модель разработана на основе модели Angelov [10]. Подход состоит в том, чтобы учесть нелинейность всех внутренних параметров транзистора, в то время как в работе [10] нелинейно описываются такие параметры на gm, Cgs и Cgd. Каждый элемент внутренней цепи транзистора является функцией f(Ugs, Uds), двух переменных Uds и Ugs. Учет нелинейности всех внутренних параметров обеспечивает высокую точность. Также нелинейная модель позволяет формировать матрицы S-параметров при отсутствии проведенных измерений. Предложенная эмпирическая гибридная модель задается набором нелинейных уравнений (19)–(26):
(19)
${{C}_{{ds~}}}({{U}_{{gs}}},{{U}_{{ds}}}) = {{C}_{{ds0}}}\left( {1 + {\text{th}}\left( {{{a}_{1}} + {{a}_{2}}{{U}_{{gs}}} + {{a}_{3}}{{U}_{{ds}}}} \right)} \right);$(20)
$\begin{gathered} {{C}_{{gd~}}}({{U}_{{gs}}},{{U}_{{ds}}}) = {{C}_{{gd0}}}\left( {1 + {\text{th}}\left( {{{b}_{1}} + {{b}_{2}}{{U}_{{gs}}} + {{b}_{3}}{{U}_{{ds}}}} \right)} \right) + \\ + \,\,\left( {{{U}_{{gs}}} + {{b}_{4}}{{U}_{{ds}}}} \right); \\ \end{gathered} $(21)
$\begin{gathered} {{C}_{{gs}}}({{U}_{{gs}}},{{U}_{{ds}}}) = {{C}_{{gs0}}}\left( {1 + {\text{th}}\left( {{{c}_{1}} + {{c}_{2}}{{U}_{{gs}}} + {{c}_{3}}{{U}_{{ds}}}} \right)} \right) \times \\ \times \,\,\left( {1 + {\text{th}}\left( {{{c}_{4}} + {{c}_{5}}{{U}_{{gs}}}} \right)} \right); \\ \end{gathered} $(22)
$\begin{gathered} {{R}_{{ds}}}({{U}_{{gs}}},{{U}_{{ds}}}) = {{R}_{d}}_{{s0}}(1 - {\text{th}}({{d}_{1}}{{U}_{g}}_{s} + {{d}_{2}}{{U}_{d}}_{s} + {{d}_{3}})) + \\ + \,\,({{U}_{g}}_{s} - {{d}_{4}}{{U}_{d}}_{s}); \\ \end{gathered} $(23)
$\begin{gathered} {{R}_{{gs}}}({{U}_{{gs}}},{{U}_{{ds}}}) = {{R}_{{gs0}}}\left( {1 + {\text{th}}\left( {{{e}_{1}}{{U}_{{ds}}}~ + \,\,{{e}_{2}}} \right)} \right) \times \\ \times \,\,\left( {1 + {\text{th}}\left( {{{e}_{3}}{{U}_{{gs}}}~ + \,\,{{e}_{4}}} \right)} \right); \\ \end{gathered} $(24)
$\begin{gathered} {{R}_{{gd}}}({{U}_{{gs}}},{{U}_{{ds}}}) = {{R}_{{gd0}}}\left( {1 + {\text{th}}\left( {{{f}_{1}} + {{f}_{2}}{{U}_{{gs}}}~ + {{f}_{3}}{{U}_{{ds}}}} \right)} \right) \times \\ \times \,\left( {1 + {\text{th}}\left( {{{f}_{4}}{{U}_{{gs}}} + {{f}_{5}}} \right)} \right); \\ \end{gathered} $(25)
${{\tau }}({{U}_{{gs}}},{{U}_{{ds}}}) = {{{{\tau }}}_{0}}\left( {1 + {\text{th}}\left( {{{g}_{1}} + {{g}_{2}}{{U}_{{gs}}}~ + {\text{ }}{{g}_{3}}{{U}_{{ds}}}} \right)} \right);$(26)
$\begin{gathered} {{g}_{m}}({{U}_{{gs}}},{{U}_{{ds}}}) = {{g}_{{m0}}}\left( {1 + {\text{th}}\left( {{{h}_{1}} + {{h}_{2}}{{U}_{{gs}}} + {{h}_{3}}{{U}_{{ds}}}~} \right)} \right) \times \\ \times \,\,\left( {1 + {\text{th}}\left( {{{h}_{4}} + {{h}_{5}}{{U}_{{gs}}} + {{h}_{6}}{{U}_{{ds}}}} \right)} \right). \\ \end{gathered} $Параметры модели определяются методом наименьших квадратов для каждого уравнения. Точность модели определяется расчетом значения среднеквадратической ошибки отклонения измеренных и смоделированных S-параметров по формуле (27):
(27)
$\begin{gathered} E({{U}_{{gs}}},{{U}_{{ds}}})\,\,~ = \\ = \,\,100\frac{{\sqrt {{{{\sum {\left( {{{x}_{i}}({{U}_{{gs}}},{{U}_{{ds}}}) - \mu ({{U}_{{gs}}},{{U}_{{ds}}})} \right)} }}^{2}}} }}{N}\% , \\ \end{gathered} $Для аппроксимации зависимости тока стока Id от прикладываемых напряжений питания Uds и смещения Ugs использовалась модифицированная модель Angelov по формуле (28):
где Ugs – напряжение затвор-исток, Uds – напряжение сток-исток, Id – ток стока, Ipk, P1, P2, α, n – коэффициенты аппроксимации.3. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Рассмотрим экстракцию значений элементов малосигнальной схемы СВЧ транзистора изготовленного по отечественной 0.15 мкм GaAs HEMT-технологии. Измерения S-параметров проводились в диапазоне от 0.1 до 50 ГГц при напряжении питания Uds от 0 до 2.5 В и напряжении смещения Ugs от –0.6 до –0.05 В. Измерительный стенд включал источник питания AMCAD pivsystem, векторный анализатор цепей компании Keysight N5245A и ручную зондовую станцию, объединённых системой GPIB.
В результате процедуры экстракции были получены параметры транзистора, представленные в табл. 1–4.
Таблица 1.
Значения внешних параметров эквивалентной схемы транзистора
| Rg, Ом | 0.17 | Lg, пГ | 41.1 |
| Rs, Ом | 2.03 | Ls, пГ | 6.3 |
| Rd, Ом | 2.97 | Ld, пГ | 59.4 |
| Cpg, фФ | 18.0 | Cpd, фФ | 28.6 |
Таблица 2.
Значения внутренних параметров при разных напряжениях питания Uds
| Ugs = –0.1 В Uds = 1 В |
Ugs = –0.1 В Uds = 1.5 В |
Ugs = –0.1 В Uds = 2 В |
|
|---|---|---|---|
| Cgs, фФ | 218.1 | 223.0 | 226.4 |
| Cgd, фФ | 34.1 | 30.2 | 28.5 |
| Cds, фФ | 89.6 | 93.8 | 93.7 |
| Rgs, Ом | 4.0 | 4.1 | 4.2 |
| Rgd, Ом | 16.8 | 22.7 | 25.3 |
| Rds, Ом | 67.0 | 93.6 | 113.7 |
| gm, мС | 223.3 | 246.8 | 256.3 |
| τ, пс | 0.75 | 1.04 | 1.28 |
Таблица 3.
Значения оптимизационных параметров нелинейной модели
| Cds0 | a1 | a2 | a3 | Cgd0 | b1 |
|---|---|---|---|---|---|
| 63.02 × 10–15 | 0.22 | 0.75 | 0.03 | 40.02 × 10–15 | –0.68 |
| b2 | b3 | b4 | Cgs0 | c1 | c2 |
| –0.54 | 0.16 | –7.93 | 175.87 × 10–15 | 0.16 | 2.56 |
| c3 | c4 | c5 | Rds | d1 | d2 |
| 0.28 | –0.27 | 2.72 | 661.57 | –16.39 | –0.83 |
| d3 | d4 | Rgs | e1 | e2 | e3 |
| –7.33 | –72.79 | 3.38 | 0.08 | –0.06 | 10.11 |
| e4 | Rgd | f1 | f2 | f3 | f4 |
| 6.06 | 20.07 | –1.25 | –1.02 | 0.51 | 2.37 |
| f5 | gm0 | h1 | h2 | h3 | h4 |
| 5.63 | 0.16 | 2.05 | 8.63 | 0.62 | –0.43 |
| h5 | h6 | τ0 | g1 | g2 | g3 |
| –0.12 | 0.08 | 1.13 × 10–12 | 1.03 | –0.18 | 0.31 |
4. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 5 представлены зависимости ωIm(Z) и ω2Re(Z) от ω2 в диапазоне частот от 0.5 до 10 ГГц для значений паразитных параметров, указанных в табл 1.
Рис. 5.
Зависимости значения внешних параметров малосигнальной модели в диапазоне от 1 до 10 ГГц. Сплошные линии – аппроксимация, наборы точек – измеренные данные.

Как видно из рис. 5, полученные зависимости точно аппроксимируются полученными в ходе экстракции паразитных параметров в полосе от 0.1 до 50 ГГц, что является достаточным для использования полученных данных в расчете внутренних параметров.
На рис. 6 представлены зависимости S-параметры, полученные по формулам (11)–(18) для значений внутренних параметров из табл. 2.
Рис. 6.
Сравнение измеренных и смоделированных S-параметров при напряжении питания и смещения согласно табл. 2: (а) Ugs = –0.1 В, Uds = 1 В; (б) Ugs = –0.1 В, Uds = 1.5 В; (в) Ugs = –0.1 В, Uds = 2 В.
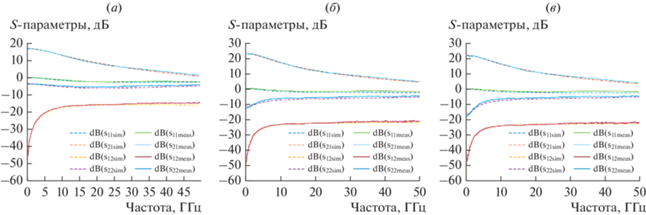
Из рис. 6 следует, что смоделированные S-параметры согласуются с измеренными. При этом разница между смоделированными и измеренными данными не превышает 1 дБ в полосе частот от 0.1 до 50 ГГц.
На рис. 7 представлены поверхности описывающие зависимости параметров нелинейной модели от приложенных напряжений питания и смещения, рассчитанные по формулам (19)–(26).
Рис. 7.
Зависимости внутренних параметров транзистора от приложенных напряжения питания и смещения согласно формулам (19)–(26): (а) Cds(Ugs, Uds); (б) Cgd(Ugs, Uds); (в) Cgs(Ugs, Uds); (г) gm(Ugs, Uds); (д) Rds(Ugs, Uds); (е) Rgd(Ugs, Uds); (ж) Rgs(Ugs, Uds); (з) τ(Ugs, Uds).

На рис. 8 предоставлено двумерное представление ошибки E(Ugs, Uds) измеренных и смоделированных S-параметров от приложенных напряжений питания Uds и смещения Ugs в диапазоне частот от 0.1 до 50 ГГц для линейной и нелинейной модели. Из рисунка следует, что нелинейная модель точно описывает поведение транзистора во всех измеренных режимах работы. Максимальное значение ошибки не превышает 1.5% в частотном диапазоне от 0.1 до 50 ГГц, при этом в модели используется всего 46 оптимизационных параметров, за счет этого достигается меньшее время расчета. Максимальное значение ошибки линейной модели не превышает 3.5%.
Рис. 8.
Зависимости ошибки E(Ugs, Uds) в диапазоне частот от 0.1 до 50 ГГц: (а) линейная модель; (б) нелинейная модель.

На рис. 9 представлены зависимости тока стока Id от прикладываемого напряжения сток-истока Uds при различных напряжениях на затвор-истоке Ugs. Из рисунка следует, что теоретически рассчитанные ВАХ совпадают с экспериментальными зависимостями.
Рис. 9.
Зависимости тока стока Id от прикладываемого напряжения питания Uds при различных напряжениях смещения Ugs: (а) смоделированные значения; (б) измеренные значения.

С целью определения факторов, оказывающих доминирующее влияние на точность моделирования S-параметров транзистора, было проведено вариационное исследование точности в диапазоне ±20% от номинальных значений внутренних параметров нелинейной модели транзистора. На основе этих данных были получены двумерные поверхности, описывающие E (%) в зависимости от значений внутренних параметров транзистора в частотном диапазоне от 0.1 до 50 ГГц (рис. 10). Цветным градиентом обозначено значение E (%), синий цвет соответствует минимальному значению, а оранжевый – максимальному. Под поверхностью построены контуры проекции минимальной ошибки моделирования.
Из результатов проведенных исследований следует, что подход построения нелинейной модели транзистора дает точное соответствие измеренных и смоделированных S-параметров и ВАХ. Полученные значения внутренних параметров советуют минимальной ошибке моделирования. Изменение значений сопротивлений Rgs и Rgd не оказывают влияния на точность моделирования. Из рис. 9 также следует, что повышение точности возможно достичь путем решения задачи оптимизации в более узком диапазоне значений.
ЗАКЛЮЧЕНИЕ
В работе проведено исследование транзистора на основе метаморфной гетероструктуры I-nAlAs/InGaAs. Была предложена гибридная методика экстракции параметров эквивалентной схемы транзистора с учетом нелинейных зависимостей внутренних параметров. Установлено, что расхождение экспериментальных и теоретически рассчитанных S-параметров не превышает 1.5% в диапазоне частот от 0.1 до 50 ГГц. Разработанная методика характеризуется высокой скоростью и точностью расчета значений параметров HEMT транзистора. Описанный подход применим для других типов полевых транзисторов, которых можно описать эквивалентной схемой, представленной на рис. 1. Полученные результаты могут быть использованы для построения многокаскадных усилителей диапазона частот до 50 ГГц.
Работа выполнена в рамках стратегического проекта СП4 НИЯУ МИФИ “Радиофотоника и квантовая сенсорика”.
Список литературы
Dambrine G. et al. A new method for determining the FET small-signal equivalent circuit // IEEE Transactions on microwave theory and techniques. 1988. V. 36. № 7. P. 1151–1159.
Yanagawa S., Ishihara H., Ohtomo M. Analytical method for determining equivalent circuit parameters of GaAs FETs // IEEE Transactions on microwave theory and techniques. 1996. V. 44. № 10. P. 1637–1641.
Anholt R., Swirhun S. Equivalent-circuit parameter extraction for cold GaAs MESFET’s // IEEE transactions on microwave theory and techniques. 1991. V. 39. № 7. P. 1243–1247.
Manohar S., Pham A., Evers N. Direct determination of the bias-dependent series parasitic elements in SiC MESFETs // IEEE transactions on microwave theory and techniques. 2003. V. 51. № 2. P. 597–600.
Ooi B.L., Zhong Z., Leong M.S. Analytical extraction of extrinsic and intrinsic FET parameters // IEEE transactions on microwave theory and techniques. 2009. V. 57. № 2. P. 254–261.
Jarndal A., Kompa G. A new small-signal modeling approach applied to GaN devices // IEEE Transactions on Microwave Theory and Techniques. 2005. V. 53. № 11. P. 3440–3448.
Brady R.G., Oxley C.H., Brazil T.J. An improved small-signal parameter-extraction algorithm for GaN HEMT devices // IEEE Transactions on Microwave Theory and Techniques. 2008. V. 56. № 7. P. 1535–1544.
Berroth M., Bosch R. High-frequency equivalent circuit of GaAs FETs for large-signal applications // IEEE transactions on Microwave Theory and Techniques. 1991. V. 39. № 2. P. 224–229.
Chigaeva E. et al. Determination of small-signal parameters of GaN-based HEMTs // Proceedings 2000 IEEE/Cornell Conference on High Performance Devices (Cat. No. 00CH37122). IEEE, 2000. P. 115–122.
Angelov I., Zirath H., Rosman N. A new empirical nonlinear model for HEMT and MESFET devices // IEEE Transactions on Microwave Theory and Techniques. 1992. V. 40. № 12. P. 2258–2266.
Fukui H. Design of microwave GaAs MESFET’s for broad-band low-noise amplifiers // IEEE Transactions on Microwave Theory and Techniques. 1979. V. 27. № 7. P. 643–650.
Gorelov A.A. et al. Parametrization of a Microwave and the Noise Model of a Metamorphic 0.15 µm MHET InAlAs/InGaAs Transistor //Russian Microelectronics. 2021. V. 50. № 3. P. 170–177.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника