Микроэлектроника, 2023, T. 52, № 1, стр. 46-57
Моделирование дефектной структуры суперъячейки и явления переноса в TlInTe2
М. М. Асадов 1, 2, *, С. Н. Мустафаева 3, С. С. Гусейнова 3, В. Ф. Лукичев 4, **
1 Институт катализа и неорганической химии им. М.Ф. Hагиева, Министерство
науки и образования Азербайджана
AZ-1143 Баку, пр. Г. Джавида, 113, Азербайджан
2 Научно-исследовательский институт “Геотехнологические
проблемы нефти, газа и химии” АГУНП
AZ-1010 Баку, пр. Азадлыг, 20, Азербайджан
3 Институт физики, Министерство науки и образования Азербайджана
AZ-1143 Баку, пр. Г. Джавида, 13, Азербайджан
4 Физико-технологический институт им. К.А. Валиева РАН
117218 Москва, Нахимовский просп., 36, корп. 1, Россия
* E-mail: mirasadov@gmail.com
** E-mail: lukichev@ftian.ru
Поступила в редакцию 19.09.2022
После доработки 21.09.2022
Принята к публикации 22.09.2022
- EDN: CXXQYI
- DOI: 10.31857/S0544126922700181
Аннотация
Локальное окружение атомов в полупроводниковом соединении TlInTe2 с тетрагональной сингонией исследовано методом теории функционала плотности (DFT). Введение точечного дефекта (вакансий индия) в решетку TlInTe2 моделировалось с использованием суперъячеек. DFT-моделирование электронных свойств (полные и локальные парциальные плотности состояний электронов (РDOS)) проводилoсь как для примитивной ячейки TlInTe2 (16 атомов на элементарную ячейку), так и для дефектной суперячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ (где ${{{\text{V}}}_{{{\text{In}}}}} - $ вакансия In) состоящей из 32 атомов. DFT-GGA расчеты зонной структуры TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ показали, что ширина запрещенной зоны (${{E}_{{\text{g}}}}$) составляет ${{E}_{{\text{g}}}}$ = 1.21 эВ. Это значение значительно отличается от экспериментального значения. Для корректировки взаимодействия частиц в решетке использовали модель Хаббарда. Рассчитанная DFT-GGA + U (U – потенциал Хаббарда) способом запрещенная зона TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ составляет ${{E}_{{\text{g}}}} = ~$ 0.97 эВ. Для суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ вычислены энергии образования вакансии, химический потенциал индия, а также стандартная энтальпия образования TlInTe2. При объяснении влияния различных факторов на явления переноса в TlInTe2, их теплопроводность и электропроводность использованы как DFT-расчетные, так и экспериментальные данные. С учетом экспериментальных данных для кристаллов р-TlInTe2 установлен механизм проводимости в направлении структурных цепочек (с-оси кристалла). В интервале температур $T$ = 148–430 K оценили величину запрещенной зоны ${{E}_{{\text{g}}}}$ = 0.94 эВ и энергию активации примесной проводимости ${{E}_{t}}$ = 0.1 эВ (при 210–300 К). При температурах $T$ ≤ 210 К в кристаллах р-TlInTe2 имеет место прыжковая проводимость на постоянном токе. С учетом этого для р-TlInTe2 вычислены следующие физические параметры: плотность состояний, локализованных вблизи уровня Ферми, их энергетический разброс и среднее расстояние прыжков.
1. ВВЕДЕНИЕ
Разработка новых принципов работы и полупроводниковых материалов, повышающих функциональность, быстродействие и компактность электронных устройств, является актуальной задачей. В этом плане, повышение эффективности термоэлектрических материалов является важной задачей. Расчет электронной зонной структуры материала позволяет корректировать его состав и свойства. Другими словами, теоретическими и экспериментальными исследованиями зависимости состав-свойства-кристаллическая структура-электронная структура можно улучшить термоэлектрические характеристики материалов. Технология изготовления, в частности, полупроводниковых термоэлектрических устройств развивается таким образом.
Связь между тепловыми и электрическими процессами в полупроводниках вызывает термоэлектрические явления. В этом случае важным является выбор современных термоэлектрических материалов. Одним из таких материалов является полупроводник TlInTe2 [1–4]. В TlInTe2 ширина запрещенной зоны меняется в зависимости от стехиометрического состава. Наш интерес к материалам на основе TlInTe2 стимулируется изучением электронных свойств. Изменение свойств в кристаллах TlInTe2 может произойти, в частности, при дефектообразовании, замещении как катионов, так и анионов.
Структурные и электронные свойства кристаллов TlInTe2 исследованы экспериментально [1, 2] и теоретически [3, 4]. Однако влияние состава на дефектную зонную структуру TlInTe2 не изучено, а это необходимо для изучения характеристик материала с заданными свойствами. Появление дефектов в решетке кристаллов приводит к изменениям также электронной структуры. Кроме того, концентрация адсорбированных атомов на поверхности и скорость их миграции оказывают влияние на концентрацию вакансий в кристалле.
TlInTe2 имеет многодолинную зонную структуру [3, 4]. Такая структура способствует высоким коэффициентам Зеебека и термоэлектрической добротности TlInTe2. Кроме того из-за слабой связи катионов Tl+ с другими ионами и сильного фононного ангармонизма структуры TlInTe2 имеет низкую решеточную теплопроводность $({{k}_{{\text{l}}}} = ~$ 0.37 В/(м K)) при комнатной температуре. Это значение теплопроводности в несколько раз меньше по сравнению со значением ${{k}_{{\text{l}}}}$ для термоэлектрических материалов Bi2Te3 (1.4 В/(м K)) и PbTe (1.95 В/(м K)). Из-за низкого значения ${{k}_{{\text{l}}}}$ термоэлектрическая добротность материала TlInTe2 при комнатной температуре сильно повышается и может достигать 1.78 и 1.84 для p- и n-типа TlInTe2 соответственно.
В этой работе мы исследуем два объекта: суперъячейку TlInTe2 с точечными дефектами (вакансии индия ${{{\text{V}}}_{{{\text{In}}}}}$) и кристаллы TlInTe2. Аналогично бинарному соединению TlSe (тетрагональная сингония, пространственная группа (пр. гр.) $D_{{4h}}^{{18}} - I4{\text{/}}mcm$; a = 8.02 Å и c = 7.00 Å, $Z$ = 4. T = = 300 K) тройное соединение TlInTe2 также имеет объемно-центрированную тетрагональную структуру [5].
2. МОДЕЛЬ И МЕТОДИКА РАСЧЕТОВ
В рамках теории функционала плотности (DFT) проведены расчеты зонной электронной структуры с дефектом типа вакансия суперъячеек TlInTe2. Расчеты проводили с помощью программного пакета АТК [6–8]. Для расчетов использовали функционалы, учитывающие как локальный, так и нелокальные обмены частиц в кристалле TlInTe2. Использовали электронные конфигурации нейтральных атомов в их основных состояниях: Tl – [Xe] 4f14 5d10 6s2 6p1, In – [Kr] 4d10 5s2 5p1, Te – [Kr] 4d10 5s2 5p4. DFT-расчеты проводили как для элементарной ячейки TlInTe2 (16 атомов на элементарную ячейку), так и для суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ (суперъячейка из 32 атомов).
Метод DFT реализовывали в рамках приближения обобщенного градиента (Generalized Gradient Approximation-GGA) [6–8]. Электронно-ионные взаимодействия учитывались через псевдопотенциалы с использованием обменно-корреляционного функционала PBE [9]. Функционал GGA по сравнению с приближением локальной плотности (LDA), согласно предварительным расчетам, позволяет адекватно описывать свойства TlInTe2 при образовании вакансий индия ${{{\text{V}}}_{{{\text{In}}}}}$.
DFT-расчеты TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ проводились в следующей последовательности. Элементрную кристаллическую ячейку TlInTe2 релаксировали и оптимизировали с допусками к силе и напряжению 0.01 и 0.01 эВ/Å3 соответственно. Принимали, что при релаксации ячейки в стационарной точке на поверхности потенциальной энергии силы, действующие на атомы, равны нулю. Оптимизация геометрии и расчеты полной энергии по зоне Бриллюэна TlInTe2 с тетрагональной сингонией (рис. 1) проводились в суперъячейке TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ (32 атома на элементарную ячейку). Интегрирование в обратном пространстве и вычисления электронной плотности проведены по схеме Монкхорста−Пака [10] с сеткой 2 × 2 × 2 k-точек зоны Бриллюэна. Рассчитаны зонная структура (BS), общая и локальные парциальные плотности состояний (РDOS) для всех атомов в элементарной ячейке TlInTe2. Кинетическая энергия отсечки составляла 500 эВ.
Оптимизацию считали завершенной, когда вычисленные энергетические градиенты были ниже порогового значения потенциальной энергии. Таким образом, расчеты структурных и энергетических характеристик выполняли для оптимизированной структуры TlInTe2, соответствующей минимуму энергии.
Величину ширины запрещенной зоны $({{E}_{{\text{g}}}})$ суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ корректировали с использованием функционала GGA + U (U – параметр кулоновского взаимодействия) [11–13]. В этом случае учитывали вклад d-состояний атомов Tl, In и Te, который повышает силу ковалентной связи в энергетическом зазоре ${{E}_{{\text{g}}}}$.
3. РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
3.1. Модели парного взаимодействия
В модели ионного кристалла, последний состоит из положительных и отрицательных ионов. За счет кулоновского притяжения электрических зарядов происходит их объединение. Также существуют другие силы притяжения атомов, которые имеют дисперсионную природу. В квантовой механике электроны в атоме находятся в непрерывном движении, и в заданный момент система “электрон-остов” представляет собой мгновенный диполь.
В ионном кристалле дисперсионные силы притяжения (Ван-дер-Ваальсово взаимодействие) возникают за счет взаимодействия диполей между атомами. Эти силы спадают с увеличением расстояния между частицами. В модели Борна–Майера [14] ионное парное взаимодействие представляется в виде: ${{V}_{{ij}}}\left( {{{R}_{{ij}}}} \right) = ~{{Z}_{i}}{{Z}_{j}}{\text{/}}{{R}_{{ij}}}$ $ + \,\,{{\lambda }_{{ij}}}{\text{exp}}\left( { - {{R}_{{ij}}}{\text{/}}{{\rho }_{{ij}}}} \right) - {{c}_{{ij}}}{\text{/}}R_{{ij}}^{6}$, где $Z = ze$ – заряд иона, $\lambda $ − предэкспоненциальный множитель перед потенциалом отталкивания, ${{\lambda }_{{ij}}}$ – силовой параметр Ван-дер-Ваальсова взаимодействия, ${{\rho }_{{ij}}}$ – эмпирический параметр жесткости, cij – параметр диполь-дипольного взаимодействия. В молекуле заряды взаимодействуют с силой ${{z}^{2}}~\left( {{{e}^{2}}{\text{/}}{{R}^{2}}} \right)$, где $z$ – заряд иона, $e$ – заряд электрона, $R$ – расстояние между центрами двух (и/или трех) сферических ионов. Суммарное кулоновское отталкивание иона оказывается меньше суммарного кулоновского притяжения в ионном кристалле. Модель ионного кристалла позволяет оценить энергию решетки, упругие и термические свойства соединений.
Из-за частично ковалентного характера химических связей в полупроводниках (например, TlInTe2: ${\text{T}}{{{\text{l}}}^{ + }}{\text{I}}{{{\text{n}}}^{{3 + }}}{\text{Te}}_{2}^{{2 - }}$) использование потенциала в форме Борна–Майера не корректно. Вклад ковалентной связи в электростатических взаимодействиях учитывается различными способами. Например, вместо формальных зарядов ${{z}_{i}}$ используют эмпирические эффективные атомные заряды $f{{z}_{i}}$. Здесь степень ионного вклада связи $f$ меняется от 0 (чисто ковалентная связь) до 1 (чисто ионная связь): ${{V}_{{ij}}}\left( {{{R}_{{ij}}},~f} \right) = ~{{f}^{2}}{{Z}_{i}}{{Z}_{j}}{\text{/}}{{R}_{{ij}}} + $${{\lambda }_{{ij}}}{\text{exp}}\left( { - {{R}_{{ij}}}{\text{/}}{{\rho }_{{ij}}}} \right) - {{c}_{{ij}}}{\text{/}}R_{{ij}}^{6}$. Такой подход понижает величину электростатических взаимодействий. С целью увеличения жесткости связи на коротких расстояниях в металлических системах часто используется потенциал Морзе (${{V}_{{\text{M}}}})$: ${{V}_{{\text{M}}}} = ~{{D}_{{ij}}}{{\left\{ {1 - {\text{exp}}[ - {{\sigma }_{{ij}}}\left( {R_{{ij}}^{0} - {{R}_{{ij}}}} \right)} \right\}}^{2}} - $ – Dij, где $R_{{ij}}^{0}$ – сумма ковалентных радиусов $i$ и $j$ при минимуме потенциала, ${{D}_{{ij}}}$ – энергия диссоциации ковалентной связи $i - j$, ${{\sigma }_{{ij}}}$ – параметр мягкости потенциала Морзе (${{\sigma }_{{ij}}} \cong 1{\text{/}}2~{{\rho }_{{ij}}}$).
С учетом вышеуказанных моделей полный парный потенциал в ионно-ковалентном приближении можно записать в вид:
Химические связи в полупроводниковых соединениях не могут быть описаны только в ионном или только в ковалентном приближении. В халькогенидах химические связи представляют сумму между ионным и ковалентным типами связи.
Кристаллические структуры соединений TlМХ2 (M = In, Ga; X = S, Se, Te) [11, 15–19] можно описать как чередующиеся атомные цепочки и/или слои с разной электронной плотностью. Вследствие цепочечно-слоистой структуры такие материалы обладают уникальными механическими, магнитными, оптическими и термоэлектрическими свойствами. Объяснение физических свойств таких анизотропных кристаллических структур требует понимания природы химической связи и заполнения орбит в электронной структуре. Расстояния и силы связи между частицами в различных направлениях в кристаллах TlМХ2 неодинаковы, что приводит к анизотропии.
Нарушение стехиометрического соотношения между компонентами, например, в TlInTe2 может приводить к формированию точечных дефектов и изменению свойств. TlInTe2 с нейтральными вакансиями является примером материала с дефектной структурой.
Исходя из ионной формулы TlInTe2 (${\text{T}}{{{\text{l}}}^{ + }}{\text{I}}{{{\text{n}}}^{{3 + }}}{\text{Te}}_{2}^{{2 - }}$) примем, что каждый катион ${\text{I}}{{{\text{n}}}^{{3 + }}}$ образует четыре ковалентные связи с четырьмя ближайшими анионами ${\text{Te}}_{2}^{{2 - }}$. За счет этого в структуре TlInTe2 вдоль с-оси кристалла формируются “цепочки” типа In-Te. Эти цепочки распространяются вдоль тетрагональной c-оси кристалла TlInTe2, и они связываются между собой катионами Tl+. В элементарной ячейке TlInTe2 каждый катион Tl+ окружен восемью анионами ${\text{Te}}_{2}^{{2 - }}$ и при этом кристаллическая решетка искажается.
3.1.1. Суперъячейка
Для изучения особенностей электронных свойств и зонной структуры, в частности, полупроводниковых соединений типа TlМХ2 применяются неэмпирические квантовые расчеты [19]. В этом случае из экспериментальных данных используются только заряды ядер атомов. Условные вклады (ионная, ковалентная, донорно-акцепторная, металлическая связь) в химическую связь не используются. Рассчитывают распределение электронной плотности в поле нескольких ядер.
Экспериментальные исследования электронной структуры нестехиометрического соединения TlInTe2 отсутствуют.
Рассмотрим результаты моделирования структуры TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ в 32-атомной суперъячейке. Кристаллическую решетку (рис. 2 [4]) предварительно релаксировали и в такой решетке создавали вакансию индия (${{{\text{V}}}_{{{\text{In}}}}}$).
На рис. 3 приведена структура суперъячейки TlInTe2 с вакансией индия. В дефектной структуре TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ вакансия ${{{\text{V}}}_{{{\text{In}}}}}$ окружена неспаренными электронами атомов теллура. В этом случае вакансия ${{{\text{V}}}_{{{\text{In}}}}}$ может принимать электроны и связываться с другими атомами TlInTe2. Тогда в структуре TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ вакансия ${{{\text{V}}}_{{{\text{In}}}}}$ заряжается отрицательно и выполняет функцию акцептора (полупроводниик р-типа). Наоборот, если в TlInTe2 имеется вакансия теллура ${{{\text{V}}}_{{{\text{Te}}}}},$ которая окружена неспаренными электронами атомов In, то вакансия ${{{\text{V}}}_{{{\text{Te}}}}}$ должна быть донором (полупроводниик n-типа).
3.1.2. Зонная структура
На рис. 4 приведена DFT-GGA + U рассчитанная зонная структуры суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ с вакансией индия. Валентная зона состоит из двух областей, разделенных непрямой щелью (~0.1 эВ). Дно валентной полосы наблюдается в точке Г зоны Бриллюэна ниже энергии –4 эВ. Энергетические зоны вблизи уровня Ферми (${{E}_{{\text{F}}}}$) не имеют заметной дисперсии в направлении ГM и ГZ, что указывает на слабое взаимодействие между атомными слоями в кристаллической структуре TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$.
Рис. 4.
DFT-GGA + U рассчитанная зонная структура суперъячейки TlInTe2, состоящей из 32 атомов и вакансии индия.

Сравнение DFT расчетных данных для TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ (рис. 4а) и TlInTe2 (рис. 4б, [3]) показывает, что энергетические зоны, распределения плотностей электронных состояний и топология поверхности Ферми этих структур аналогичны.
Рассмотрим значение ${{E}_{{\text{g}}}}$ в TlInTe2, которое характеризует минимальную энергию перехода электрона из валентной зоны в зону проводимости. DFT-GGA расчетное значение запрещенной зоны ${{E}_{{\text{g}}}}$ суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ было (${{E}_{{\text{g}}}}$ = 1.21 эВ) выше, чем экспериментальное значение ${{E}_{{\text{g}}}}$ для TlInTe2 [5]. Рассчитанная нами DFT-GGA + U способом запрещенная зона TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ составляет ${{E}_{{\text{g}}}} = ~$ 0.97 эВ (рис. 4а), что близко к экспериментальным значениям для TlInTe2.
3.1.3. Плотность состояний
На рис. 5а, б показаны распределения парциальных электронных плотностей состояний (РDOS) атомов Tl, In и Te в суперъячейке TlInTe2 с In-вакансией. Анализ РDOS вкладов отдельных атомов TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ показывает, что нижняя часть валентной зоны (в интервале от –5.5 до 5.5 эВ) образована, сначала 5p-состояниями теллура. По мере увеличения энергии вклад в DOS начинают давать гибридизованные In 4d- и Tl 6p-состояния. Поэтому в зонной структуре TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ верхняя часть валентной зоны (от –1.9 эВ до ${{E}_{{\text{F}}}}$) и дно зоны проводимости определяются 4d-состояниями атомов индия. Состояния таллия не вносят значительного вклада в DOS в рассматриваемой энергетической области (рис. 5а, б).
Рис. 5.
DFT-GGA + U рассчитанная парциальная плотность состояний электронов (РDOS) в суперъячейке TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$, содержащей 32 атома. а) s-, p-состояния, б) d-состояния атомов Tl, In и Te вблизи уровня Ферми. 0 эВ соответствует уровню Ферми. Спин-вверх ($ \uparrow $) и спин-вниз ($ \downarrow $) состояния атомов.

РDOS спин-вверх ($ \uparrow $) и спин-вниз ($ \downarrow $) состояний атомов в TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ аналогичны. РDOS s-, p-, d-состояний атомов Tl, In и Te указывает на то, что в TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ общий локальный магнитный момент составляет 0.00$~{{{{\mu }}}_{{\text{B}}}}$.
Из DOS следует, что присутствие в структуре монослоя тетрагонального TlInTe2 In-вакансий приводит к изменению электронной структуры в области запрещенной зоны. В халькогенидных материалах анионные вакансии могут формировать на поверхности кристаллитов поверхностные состояния акцепторного типа. Они могут привести к изгибу электронных зон у поверхности материала [19]. А микропримеси и точечные дефекты в этих кристаллитах могут формировать поверхностные состояния донорного типа. В зависимости от энергии этих донорных состояний, а также от величины поверхностной плотности халькогенидных вакансий, акцепторные состояния могут заполняться электронами с поверхностных донорных состояний. В этом случае за счет искривления зон у поверхности халькогенида величина и знак поверхностного заряда могут измениться. Таким образом, формирование In-вакансий в TlInTe2 может повысить поверхностную плотность состояний в кристаллитах.
3.1.4. Энергию образования вакансии
Энергию образования $E_{f}^{{{\text{V}}_{{{\text{In}}}}^{{\text{x}}}}}$ нейтральной вакансии индия в In-подрешетке суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ вычисляли по уравнению [8]
(1)
$E_{f}^{{{\text{V}}_{{{\text{In}}}}^{{\text{x}}}}} = E_{{{\text{tot}}}}^{{{\text{V}}_{{{\text{In}}}}^{{\text{x}}} + {\text{bulk}}}}\left[ {{\text{Tl}}{{{({\text{In}})}}_{{n - 1}}}{{{\left( {{\text{T}}{{{\text{e}}}_{2}}} \right)}}_{n}}} \right] - E_{{{\text{tot}}}}^{{{\text{bulk}}}}\left[ {{\text{Tl}}{{{({\text{In}})}}_{n}}{{{\left( {{\text{T}}{{{\text{e}}}_{2}}} \right)}}_{n}}} \right] + {{\mu }_{{{\text{In}}}}},$Рассчитанное нами значение ${{\mu }_{{{\text{In}}}}}$ = 2.11 эВ соответствует значению ${{\mu }_{{{\text{In}}}}}$= 2.14 эВ [20]. DFT-расчет энергии образования In-вакансии в суперъячейке TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ составлял: $E_{f}^{{{\text{V}}_{{{\text{In}}}}^{{\text{x}}}}}$ = 1.17 эВ.
3.1.5. Энтальпия образования
Стандартная энтальпия образования ($({{\Delta }_{f}}H_{T}^{^\circ })$ TlInTe2 при температуре T вычисляется уравнением
(2а)
${{\Delta }_{f}}H_{T}^{^\circ }\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right) = {{\Delta }_{f}}H_{0}^{^\circ }\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right) + \mathop \smallint \limits_0^T [\Delta {{C}_{p}}\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right)dT \approx ~{{\Delta }_{f}}H_{0}^{^\circ }\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right).$Рассчитанное значение теплоемкости ($\Delta {{C}_{p}}$) твердого ${\text{TlInT}}{{{\text{e}}}_{2}}$ с учетом справочных данных незначительно отличается от суммы теплоемкостей компонентов: ${{C}_{p}}\left( {{\text{Tl}}} \right)~$ + ${{C}_{p}}\left( {{\text{In}}} \right)$ + ${{C}_{p}}\left( {{\text{T}}{{{\text{e}}}_{2}}} \right)$. Это соответствует правилу Неймана–Коппа, согласно которому теплоемкость химического соединения при комнатной температуре равна сумме теплоемкостей составляющих его элементов. Если вклады ${{C}_{p}}$ в уравнении (2а) принимать равными нулю, то энтальпию образования ${\text{TlInT}}{{{\text{e}}}_{2}}$ при T можно выразить как изменение внутренней энергии ${{\Delta }_{f}}U_{0}^{^\circ }$ (${\text{TlInT}}{{{\text{e}}}_{2}}$)
(2б)
${{\Delta }_{f}}H_{T}^{^\circ }\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right) = {{\Delta }_{f}}U_{0}^{^\circ }\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right) = E_{{{\text{tot}}}}^{^\circ }\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right) - \left[ {E_{{{\text{tot}}}}^{^\circ }\left( {{\text{Tl}}} \right) + ~E_{{{\text{tot}}}}^{^\circ }\left( {{\text{In}}} \right)~ + 2E_{{{\text{tot}}}}^{^\circ }\left( {{\text{Te}}} \right)} \right],$DFT-GGA + U рассчитанная таким образом энтальпия образования ${{\Delta }_{f}}H_{{298}}^{{\text{o}}}\left( {{\text{TlInT}}{{{\text{e}}}_{2}}} \right)$ составляет –1.523 эВ, которая согласуется с данными [21]. Также наблюдается согласие результатов расчетов и экспериментов по определению других параметров кристалла на основе TlInTe2 (табл. 1).
Таблица 1.
Рассчитанные нами параметры тетрагонального кристалла на основе TlInTe2 (пр. гр. $D_{{4h}}^{{18}} - I4{\text{/}}mcm$)
| Параметр | DFT-GGA + U расчет (TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}})$ | Литература (TlInTe2) |
|---|---|---|
| ${{E}_{{\text{g}}}}$ , эВ | 0.97 | 0.963 $E \bot c$, 0.976 $E\parallel c$$T$ = 290 K [5] 0.72 [2], 0.650 [21], 0.66 [22] |
| a и c, Å | 8.111 и 7.177 | 8.494 и 7.181 [1, 5], 8.704 и 7.325 [3] 7.160 и 7.160 [21] |
| $ - {{\Delta }_{f}}H_{{298}}^{^\circ },~$ эВ | 1.523 | 1.452 [21] |
3.2.1. Тепловые свойства
Легированные полупроводники, как известно, являются эффективными термоэлектриками [23]. Добротность термоэлектрических материалов $ZT~ = \frac{{\sigma {{S}^{2}}}}{k}T$, где $\sigma $ – электропроводность, $S$ – коэффициент Зеебека, $k$ – теплопроводность, $T$ – абсолютная температура. Здесь $\sigma = \frac{1}{\rho } = en\mu $, где $e$ – заряда электрона, $n$ – концентрация основных носителей заряда, $\mu $ – подвижность. Параметр $ZT$ зависит от различных факторов, в частности, от ширины запрещенной зоны. Для прямозонных материалов ${{E}_{{\text{g}}}}$ больше $6{{k}_{{\text{B}}}}T$ [24], где ${{k}_{{\text{B}}}}$ – постоянная Больцмана. При значении ${{E}_{{\text{g}}}} < 6{{k}_{{\text{B}}}}T$ в системе появляются неосновные носители заряда. А уровень Ферми должен находиться вблизи запрещенной зоны.
Принимается, что теплопроводность материала состоит из двух частей: $k = {{k}_{{\text{e}}}} + {{k}_{{\text{l}}}},$ где ${{k}_{{\text{l}}}}$ – теплопроводность упругих колебаний решетки (или фононная теплопроводность ${{k}_{{{\text{ph}}}}}$) и ${{k}_{{\text{e}}}}$ – теплопроводность свободных электронов. Решеточная теплопроводность в кристаллических телах в основном осуществляется фононами, тогда как диффузионные явления считаются важной колебательной единицей в аморфных твердых телах.
Учет сильного фононного ангармонизма взаимодействия атомов в кристалле может приводить к появлению взаимодействия фононов. Такие процессы могут дать вклад в ограничение теплопроводности материала.
Путем замещения в катионной и/или анионной подрешетках в TlInTe2 возможно изменить влияние неосновных носителей заряда на термоэлектрические свойства. На рис. 6а, б представлены зависимости электронной и фононной теплопроводности при различных значениях $n$ (концентрация носителей) и Т. Из рис. 6а, б следует, что кристаллы TlInTe2p- и n-типа имеют низкую решеточную теплопроводность от 0.37 до 0.6 В/(м K)) при комнатной температуре. Таким образом, низкую решеточную теплопроводность TlInTe2 при комнатной температуре связывают с сильным фононным ангармонизмом структуры [3, 4].
Необычное поведение решеточной теплопроводности кристаллов TlXTe2 (X = Ga, In) согласно [26] не могут быть охарактеризованы только фононами или диффузонами явлениями. Расчетное значение ${{k}_{{{\text{ph}}}}}$, основанное на первопринципах теории функционала плотности и квазиклассическом уравнении переноса Больцмана (БТЕ), составляет лишь половину экспериментального значения. Предлагается, что слабая связь между атомами Tl и цепочками XTe2 приводит к сильному колебательному ангармонизму, который подавляет длину свободного пробега большой части фононных мод ниже предела Иоффе–Регеля. Такой ангармонизм нарушает условие квазиклассического БТЭ. Низкий ${{k}_{{{\text{ph}}}}}$ TlXTe2 (X = Ga, In) можно объяснить с помощью двухканальной транспортной модели.
3.2.2. Электрические свойства
На рис. 7 представлена экспериментально полученная температурная зависимость проводимости кристалла р-TlInTe2 вдоль кристаллографической c-оси в области температур 148–430 К [5].
Рис. 7.
Температурная зависимость проводимости кристалла р-TlInTe2 вдоль кристаллографической c-оси.

Указанная зависимость состояла из трех участков. По наклону высокотемпературной ветви зависимости $\sigma \left( {{{{10}}^{3}}{\text{/}}T} \right)$ в TlInTe2 мы определили энергию активации проводимости, которая соответствовала значению ширины запрещенной зоны в р-TlInTe2 ${{E}_{g}}$ = 0.94 эВ. В области температур 210–300 К проявлялся мелкий примесный уровень с энергией активации 0.1 эВ. При Т < < 210 К температурная зависимость проводимости р-TlInTe2 ослабевала и имела наклон примерно 0.04 эВ. Такой характер поведения проводимости в р-TlInTe2 при низких температурах присущ прыжковому механизму переноса заряда с переменной длиной прыжка.
В вышеуказанном случае в р-TlInTe2 ток переносится носителями заряда, находящимися в локализованных вблизи уровня Ферми состояниях. Такого типа проводимость наблюдается, в частности, в легированных оловом TlInS2 [19]. В запрещенной зоне таких материалов вблизи уровня Ферми имеется энергетическая полоса с высокой плотностью состояний. По этим состояниям осуществляются прыжки носителей заряда из одного локализованного состояния в другое. Это так называемая активационная прыжковая проводимость.
Прыжковая проводимость в полупроводниковых материалах проявляется обычно при низких температурах, когда для наблюдения примесной, а тем более собственной проводимости еще не достигнута нужная температура. Температурная зависимость прыжковой проводимости подчиняется закономерности Мотта [27]:
(3)
$\sigma \propto {\text{exp}}\left[ { - {{{\left( {{{T}_{0}}{\text{/}}T} \right)}}^{{1/4}}}} \right],$Построенный нами график зависимости ${\text{lg}}{\kern 1pt} \sigma $ от ${{T}^{{ - 1/4}}}~~$ для образца р-TlInTe2 в температурной области 148–210 К представлен на рис. 8. Из наклона зависимости ${\text{lg}}{\kern 1pt} \sigma $ от ${{T}^{{ - 1/4}}}$ определили значение $~{{T}_{0}}$ = 3.6 × 106 К. По экспериментально найденному значению ${{T}_{0}}$ из формулы (4) определили плотность локализованных состояний вблизи уровня Ферми в р-TlInTe2: ${{N}_{F}}$ = 6.5 × 1018 эВ–1 см–3. При этом для радиуса локализации взято значение $a$ = 20 Å.
Рис. 8.
Низкотемпературная зависимость ${\text{lg}}{\kern 1pt} \sigma $ от ${{T}^{{ - 1/4}}}~~$ для полупроводника р-TlInTe2.
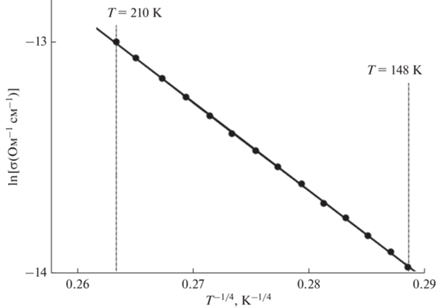
По формуле [27]:
в TlInTe2 определено расстояние прыжков при различных температурах. Так, при $T$ = 148 К значение $R$ составляло 94 Å, а при $T$ = 210 К $R$ = 86 Å, т.е. среднее расстояние прыжков $\left( {{{R}_{{{\text{av}}}}}} \right)$ в р-TlInTe2 составляло 90 Å. Значение ${{R}_{{{\text{av}}}}}$ в 4.5 раза превышало среднее расстояние между центрами локализации носителей заряда в р-TlInTe2.По формуле [27]:
оценили энергетический разброс ловушечных состояний вблизи уровня Ферми (${{\Delta }}E$). Значение ${{\Delta }}E$ составляло 100 мэВ. Именно в этой энергетической полосе ${{\Delta }}E$ в запрещенной зоне TlInTe2 происходит прыжковый перенос заряда. При этом среднее значение энергии активации прыжков ($\Delta W$) в TlInTe2, определенное по формуле [28]:(7)
$\Delta W = \frac{{{{{\left( {kT} \right)}}^{{3/4}}}}}{{{{{\left[ {{{N}_{F}}{{a}^{3}}} \right]}}^{{1/4}}}}},$Нами оценена также концентрация локализованных состояний (${{N}_{t}}$), ответственных за перенос заряда в р-TlInTe2 на постоянном токе:
Значение ${{N}_{t}}$ составляло 6.5 × 1017 см–3.
4. ВЫВОДЫ
DFT-моделирование зонной структуры, общей и парциальной плотности состояний (PDOS) позволили анализировать электронные свойства суперъячейки узкозонного полупроводника TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$, состоящей из 32 атомов и вакансий индия (${{{\text{V}}}_{{{\text{In}}}}}$). Расчетные параметры релаксированной решетки суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ с вакансией индия аналогичны данным для кристалла TlInTe2 с тетрагональной сингонией: $a$ = 8.111 Å, $c$ = 7.177 Å, пр. гр. $P{{6}_{{3~}}}{\text{/}}mmc$, (194). Установлено, что зонная структура суперъячейки TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ с вакансией индия, как и объемных кристаллов TlInTe2, имеет непрямую энергетическую зону. Применение функционала GGA + U позволяет корректировать несоответствия между DFT-расчетными и экспериментальными значениями ширины запрещенной зоны ${{E}_{{\text{g}}}}$ в TlInTe2. За счет учета d-состояний атомов TlInTe2 в PDOS завышается вклад ковалентной химической связи и энергетической зазор ${{E}_{{\text{g}}}}$ сужается от 1.21 до 0.97 эВ. DFT-расчетная энергия образования нейтральной вакансии индия в суперъячейке TlInTe2 составляет 1.17 эВ. Расчетная энтальпия образования TlInTe2$ - {{{\text{V}}}_{{{\text{In}}}}}$ согласуется с данными для TlInTe2.
При комнатной температуре p- и n-типа TlInTe2 имеют низкую решеточную теплопроводность, которая связана с сильным фононным ангармонизмом структуры. При температурах 148–210 К проводимость кристаллов р-TlInTe2 соответствует прыжковому механизму переноса заряда с переменной длиной прыжка. Определена плотность локализованных состояний вблизи уровня Ферми в р-TlInTe2: ${{N}_{F}}$ = 6.5 × 1018 эВ–1 см–3. Вычисленное среднее расстояние прыжков в р-TlInTe2 составляло 90 Å, а энергетический разброс ловушечных состояний вблизи уровня Ферми $\Delta E$ = 100 мэВ. Значение $\Delta E$ согласуется с оцененным средним значением энергии активации прыжков ($\Delta W$) в р-TlInTe2, которое составляло $\Delta W$ = 80 мэВ. Оцененная концентрация локализованных состояний в запрещенной зоне р-TlInTe2 составляла ${{N}_{t}}$ = = 6.5 × 1017 см–3.
Список литературы
Muller D., Eulenberger G., Hahn H. Uber ternare Thalliumchalkogenide mit Thalliumselenidstruktur // Zeitschrift Fur Anorganische Und Allgemeine Chemie, 1973. V. 398. № 2. P. 207–220. https://doi.org/10.1002/zaac.19733980215
Al-Ghamdi A.A., Nagat A.T., Al-Hazmi F.S., Al-Heniti S., Bahabri F.S., Mobarak M.M., Alharbi S.R. Growth and Electrical Characterization of TlInTe2 Single Crystal // Journal of the King Abdulaziz Univ. Sci. 2008. V. 20. P. 27–38.
Ding G., He J., Cheng Z. X., Wang X., Li S. Low lattice thermal conductivity and promising thermoelectric figure of merit of Zintl type TlInTe2 // Journal of Materials Chemistry C. 2018. V. 6. P. 13269-13274. https://doi.org/10.1039/c8tc034
Jana M.K., Pal K., Warankar A., Mandal P., Waghmare U.V., Biswas K. Intrinsic Rattler-Induced Low Thermal Conductivity in Zintl Type TlInTe2 // Journal of the American Chemical Society. 2017. V. 139. № 12. P. 4350–4353. https://doi.org/10.1021/jacs.7b01434
Madelung O. Semiconductors: Data Handbook. Springer-Verlag, Berlin, Heidelberg, New York. 3rd edition. 2004. 691 c. ISBN 978-3-642-62332-5
Asadov M.M., Mustafaeva S.N., Mamedov A.N. Dielectric Properties and Heat Capacity of (TlInSe2)1–x(TlGaTe2)x Solid Solutions // Inorganic Materials. 2015. V. 51. № 8. P. 772–778. https://doi.org/10.1134/S0020168515080051
Asadov M.M., Mustafaeva S.N., Guseinova S.S., Lukichev V.F. Ab Initio Calculations of the Electronic Properties and the Transport Phenomena in Graphene Materials // Physics of the Solid State. 2020. V. 62. № 11. P. 2224–2231. https://doi.org/10.1134/S1063783420110037
Asadov M.M., Mustafaeva S.N., Guseinova S.S., Lukichev V.F. Ab initio modeling of the location and properties of ordered vacancies on the magnetic state of a graphene monolayer // Physics of the Solid State. 2021. V. 63. № 5. P. 797–806. https://doi.org/10.1134/S1063783421050036
Perdew J.P., Burke K., Ernzerhof M. Generalized gradient approximation made simple // Physical Review Letters. V. 77. P. 3865–3868. https://doi.org/10.1103/PhysRevLett.77.3865
Monkhorst H.J., Pack J.D. Special points for Brillouin-zone integrations // Physical Review B. 1976. V. 13. № 12. P. 5188–5192. https://doi.org/10.1103/physrevb.13.5188
Mustafaeva S.N., Asadov M.M., Guseinova S.S., Dzhabarov A.I., Lukichev V.F. Electronic, dielectric properties and charge transfer in a TlGaS2:Nd3+ single crystal at direct and alternating current // Physics of the Solid State. 2022. Vol. 64. No. 4. P. 432–439. https://doi.org/10.21883/PSS.2022.04.53497.251
Hubbard J. Electron Correlations in Narrow Energy Bands. Proceedings of the Royal Society A: Mathematical, Physical and Engineering Sciences. 1963. V. 276. № 1365. P. 238–257. https://doi.org/10.1098/rspa.1963.0204
Peles A. GGA + U method from first principles: application to reduction–oxidation properties in ceria-based oxides // Journal of Materials Science. 2012. V. 47. № 21. P. 7542–7548. https://doi.org/10.1007/s10853-012-6423-1
Born M., Mayer J.E. Zur Gittertheorie der Ionenkristalle // Zeitschrift für Physik. 1932. Vol. 75. No 1-2. P. 1–18.https://doi.org/10.1007/bf01340511
Mustafaeva S.N., Gasymo Sh.G., Asadov M.M. Electrical properties of TlGaTe2 single crystals under hydrostatic pressure // Journal of Physics and Chemistry of Solids. 2011. V. 72. № 6. P. 657–660. https://doi.org/10.1016/j.jpcs.2011.02.007
Mustafaeva S.N., Gasymo Sh.G., Asadov M.M. DC-Electrical Properties of TlGaTe2 Single Crystals under Hydrostatic Pressure // Physics Research International. 2011. Article ID 513848. P. 1–5. https://doi.org/10.1155/2011/513848
Mustafaeva S.N., Gasymo Sh.G., Asadov M.M. Conductivity anisotropy of a TlGaTe2 chain single crystal under hydrostatic pressure // Physics of the Solid State. 2012. Vю 54. № 1. P. 44–47. https://doi.org/10.1134/s1063783412010246
Mustafaeva S.N., Asadov M.M., Ismaĭlov A.A. Effect of gamma irradiation on the dielectric properties and electrical conductivity of the TlInS2 single crystal // Physics of the Solid State. 2009. V. 51. № 11. P. 2269–2273. https://doi.org/10.1134/s1063783409110122
Мустафаева С.Н., Асадов М.М., Гусейнова С.С., Гасанов Н.З., Лукичев В.Ф. Ab initio расчеты электронных свойств, частотная дисперсия диэлектрических коэффициентов и край оптического поглощения монокристаллов TlInS2$\left\langle {{\text{Sn}}} \right\rangle $ // Физика твердого тела. 2022. Т. 64. Вып. 6. С. 628–638. 10.21883/FTТ.2022.06.52388.299
Job G., Rüffler R. Physikalische Chemie. Vieweg + Teubner Verlag. Springer Fachmedien Wiesbaden GmbH. 2011. ISBN 978-3-8351-0040-4
TlInTe2. ID:mp-22791 // https://materialsproject.org/ materials/mp-22791/
Wakita K., Shim Y., Orudzhev G., Mamedov N., Hashimzade F. Band structure and dielectric function of TlInTe2 // Phys. Status Solidi A, 2006. V. 203. № 11. P. 2841–2844. https://doi.org/10.1002/pssa.200669566
Thermoelectrics Handbook. Macro to Nano. Ed. D.M. Rowe. CRC. Taylor & Francis Group, LLC. Boca Raton, US. (2006). 954 p. ISBN13: 978-0-8493-2264-8.
Sofo J.O., Mahan G.D. Optimum band gap of a thermoelectric material // Physical Review B. 1994. V. 49. № 7. P. 4565–4570. https://doi.org/10.1103/PhysRevB.49.4565
Matsumoto H., Kurosaki K., Muta H., Yamanaka S. Systematic investigation of the thermoelectric properties of TlMTe2 (M = Ga, In, or Tl) // Journal of Applied Physics, 2008. V. 104. № 7. P. 073705–4. https://doi.org/10.1063/1.2987471
Wu M., Enamullah, Huang L. Unusual lattice thermal conductivity in the simple crystalline compounds TlXTe2 (X = Ga, In) // Physical Review B. 2019. V. 100. № 7. P. 075207–. https://doi.org/10.1103/PhysRevB.100.075207
Mott N.F., Davis E.A. Electronic Processes in NonCrystalline Materials, 2nd ed. (Oxford Univ. Press, New York, 2012). ISBN 978-0-19-964533-6
Shklovskii B.I., Efros A.L. Electronic Properties of Doped Semiconductors. Springer Series in Solid-State Sciences. Heidelberg. 1984. 388 p. ISBN 978-3-662-02405-8
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника






