Российские нанотехнологии, 2021, T. 16, № 2, стр. 195-201
СИНТЕТИЧЕСКИЕ АНТИФЕРРОМАГНИТНЫЕ СТРУКТУРЫ В ТЕХНОЛОГИИ УСТРОЙСТВ СПИНТРОНИКИ
В. В. Амеличев 1, Д. В. Васильев 1, *, А. И. Крикунов 1, Ю. В. Казаков 1, Д. В. Костюк 1, Е. П. Орлов 1, Д. А. Жуков 1, П. А. Беляков 1
1 Научно-производственный комплекс “Технологический центр”
Москва, Россия
* E-mail: 29diman05@mail.ru
Поступила в редакцию 29.07.2020
После доработки 26.08.2020
Принята к публикации 25.09.2020
Аннотация
Рассмотрены синтетические антиферромагнитные (САФ) структуры и их влияние в фиксированном слое спин-туннельного перехода на величину магниторезистивного эффекта и температурную стабильность. САФ-структура состоит из двух ферромагнитных (ФМ) слоев, между которыми расположена немагнитная пленка. Обменное взаимодействие ионов двух ФМ-слоев имеет осциллирующий характер и зависит от толщины немагнитного слоя, шероховатости поверхности ФМ-слоев. Рассмотрен механизм перемагничивания САФ с фиксацией антиферромагнитным слоем и при ее отсутствии, а также влияние последовательности напыления слоев в САФ-структуре на ее свойства. Приведено описание основных применений САФ-структур в составе устройств спинтроники.
ОГЛАВЛЕНИЕ
Введение
1. Магнитные свойства САФ
2. Особенности формирования САФ-структур
3. Применение САФ для MRAM и преобразователей магнитного поля
Заключение
ВВЕДЕНИЕ
Исследования последних десятилетий в области взаимодействия многослойных магнитных наноструктур привели к ряду открытий и важным практическим применениям. Результаты исследования характера взаимодействия двух тонких ферромагнитных (ФМ) слоев, разделенных немагнитным металлическим (НМ) слоем, являются значимыми и актуальными в области создания приборов и устройств на основе гигантского магниторезистивного (ГМР) эффекта.
Взаимодействие двух ФМ-слоев, разделенных НМ-слоем, имеет осциллирующий характер и является физической основой функционирования многих устройств на основе ГМР-эффекта. Осциллирующий характер взаимодействия позволяет реализовать структуры с антипараллельным состоянием ФМ-слоев. Такие трехслойные структуры называют синтетическими антиферромагнетиками (САФ), они обладают рядом уникальных свойств и используются как в элементах энергонезависимой памяти, так и в сенсорных устройствах, в основном на спин-туннельном магниторезистивном (СТМР) эффекте.
Использование САФ позволяет повысить эффективное поле обменного смещения, снизить магнитостатическое поле опорного слоя, повысить термостабильность структур, увеличить магниторезистивный эффект [1, 2]. В элементах памяти на основе STT (spin-transfer torque) MRAM САФ позволяет снизить пороговые значения токов и время переключения [3, 4]. В памяти на основе Toggle MRAM САФ является базовым элементом конструкции [5]. САФ в преобразователях магнитного поля на основе СТМР-эффекта после термомагнитной обработки формирует скрещенную магнитную конфигурацию, что приводит к снижению коэрцитивности свободного слоя до единиц эрстед [6].
Во всех случаях для успешной имплементации САФ в устройства спинтроники необходимо тщательное изучение магнитных свойств САФ и конструктивно-технологических параметров разрабатываемого устройства, наибольшее значение имеют: зависимость взаимодействия ФМ-слоев САФ от толщины НМ-слоя, влияние процессов роста и последующих термомагнитных обработок на магнитные свойства САФ.
1. МАГНИТНЫЕ СВОЙСТВА САФ
Как правило, САФ состоит из двух ФМ-слоев, разделенных НМ-слоем, для которых характерно взаимодействие Рудермана–Киттеля–Касуя–Иосиды (РККИ-взаимодействие).
Энергия взаимодействия имеет знакопеременный осциллирующий характер как функция от расстояния между взаимодействующими ионами: в зависимости от расстояния между ионами материал может проявлять ФМ- или антиферромагнитные (АФ) свойства [7], данный эффект широко применяется в спиновых клапанах на основе ГМР- и СТМР-эффектов.
В [8] представлен подход Рудермана–Киттеля к объяснению осциллирующей обменной связи между ФМ-слоями, разделенными НМ-слоем, рассмотрена роль дефектов (дислокаций и межфазной шероховатости) на РККИ-взаимодействие. На расстоянии отсечки связь между магнитными слоями подавляется воздействием дислокаций, эта величина зависит от несоответствия параметров решетки между ФМ- и НМ-слоями. Влияние шероховатости проявляется в двух аспектах [8]: толщина разделительного слоя колеблется с некоторыми отклонениями около среднего значения, поэтому при расчете взаимодействия необходимо учитывать данные флуктуации; также шероховатость разрушает плоскостную трансляционную инвариантность структуры. Отклонения толщины разделительного слоя влияют на период осциллирующей связи, второй фактор влияния изменяет колебания независимо от их периода.
В рамках упрощенной модели Мейклджона и Бина [10] полная энергия САФ-структуры, отнесенная к единице площади, может быть записана как
(1)
$\begin{gathered} \hfill E~ = - {{{{\mu }}}_{0}}H{{M}_{F}}{{t}_{F}}(\cos ({{\theta }} - {{\beta }}) + \cos ({{\theta }} - {{\alpha }})) + \\ \hfill \, + {{K}_{F}}{{t}_{F}}({\text{si}}{{{\text{n}}}^{2}}({{\alpha }}) + {\text{si}}{{{\text{n}}}^{2}}({{\beta }})) - {{J}_{{{\text{РККИ}}}}}{\text{cos}}({{\beta }} - {{\alpha }}), \\ \end{gathered} $Рис. 1.
Соотношение между углами и направлениями основных магнитных векторов САФ-структуры, ОЛН – ось легкого намагничивания, ОТН – ось трудного намагничивания [10].
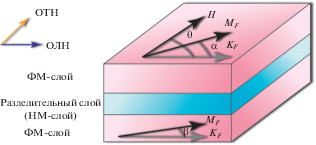
Минимизация общей энергии относительно α и β в случае, когда магнитокристаллической анизотропией в ФМ-слоях можно пренебречь, позволяет представить кривую намагничивания САФ-структуры таким образом, как это показано на рис. 2.
При нулевом поле ФМ-слои связаны антиферромагнитно. При увеличении поля в том или ином направлении вектор намагниченности слоев следует за направлением поля вплоть до коллинеарного состояния. Величина поля Hsat соответствует состоянию, при котором внешним воздействием преодолевается межслойное РККИ-взаимодействие САФ-наноструктуры, а энергия РККИ-взаимодействия определяется как
где Ms и t – намагниченность насыщения и толщина ФМ-слоев соответственно.В СВМР (спин-вентильных магниторезистивных) и СТМР-наноструктурах один из слоев САФ выполняет функцию опорного слоя самостоятельно или в составе ФМ многослойной структуры. В этом случае необходима фиксация САФ посредством его контакта с АФ-слоем. Возникающее при этом обменное смещение приводит к однонаправленной магнитной анизотропии [11]. В том случае, когда САФ связан механизмом обменного смещения с АФ-слоем, полная энергия системы на единицу площади может быть представлена как
(3)
$\begin{gathered} E = - {{{{\mu }}}_{0}}H{{M}_{F}}{{t}_{F}}(\cos ({{\theta }} - {{\beta }}) + \cos ({{\theta }} - {{\beta }})) + \\ \, + {{K}_{F}}{{t}_{F}}({\text{si}}{{{\text{n}}}^{2}}({{\alpha }}) + {\text{si}}{{{\text{n}}}^{2}}({{\beta }})) - \\ \, - {{J}_{{{\text{РККИ}}}}}\cos ({{\beta }} - {{\alpha }}) - {{J}_{{EB}}}\cos ({{\beta }}), \\ \end{gathered} $Минимизация общей энергии структуры САФ/АФ в отношении углов α и β при условии отсутствия магнитокристаллической анизотропии позволяет представить кривую намагничивания САФ/АФ как на рис. 4 [12].
При слабых магнитных полях на кривой имеется плато, обусловленное фиксированием нижнего слоя САФ через обменное смещение. При этом верхний слой САФ также фиксирован через РККИ-взаимодействие.
При росте поля в отрицательном направлении более Н1 преодолевается РККИ-связь между ФМ-слоями САФ и происходит разворот ФМ-слоев в направлении поля вплоть до состояния насыщения Hsat1. При росте поля в положительном направлении для перемагничивания ФМ-слоев необходимо преодолеть поле обменного смещения и РККИ-связь ФМ-слоев САФ. При этом
(5)
${{H}_{2}} = \frac{{{{J}_{{{\text{РККИ}}}}} + {{J}_{{EB}}}}}{{{{{{\mu }}}_{0}}{{M}_{F}}{{t}_{F}}}}.$Расчетные зависимости позволяют выявить наиболее общие закономерности формирования кривой перемагничивания АФ/САФ при определенных упрощающих допущениях.
При этом один из ФМ-слоев САФ находится в контакте с АФ-слоем и связан с ним обменным взаимодействием, а второй ФМ-слой граничит со спейсером (НМ-слой в СВМР или барьерный слой в СТМР) и выполняет роль опорного слоя. На рис. 5 представлены два типа структур и соответствующие им кривые перемагничивания [13]. Как видно, в структуре, не содержащей САФ, петля перемагничивания свободного слоя смещена относительно нуля, что обусловлено магнитостатическим взаимодействием свободного и опорного слоев.
Рис. 5.
Типичные СВМР-наноструктуры и кривые намагничивания: а – СВМР-наноструктура с обычным АФ-слоем, б – СВМР-наноструктура с САФ в фиксированном слое [13].

В структуре, содержащей САФ, замкнутая магнитная конфигурация ФМ-слоев САФ значительно ослабляет взаимодействие свободного и опорного слоев. В структуре, содержащей САФ, наблюдается минимальное смещение петли перемагничивания [14].
При определенной величине магнитного поля HSF САФ переходит в спин-флоп-состояние [15]. Угол между векторами намагниченности ФМ-слоев, разделенных слоем Ru, из-за РККИ-взаимодействия составляет 180°. Векторы намагниченности отклоняются на угол, близкий к 90° от направления приложенного поля.
Спин-флоп-переход происходит в АФ при сравнительно большом значении внешнего магнитного поля, приложенного вдоль оси антиферромагнетизма, при котором направление намагниченности поворачивается перпендикулярно направлению внешнего магнитного поля [16]. При температурах, значительно меньших температуры Нееля, восприимчивость вдоль оси антиферромагнетизма меньше восприимчивости в поперечном направлении, при определенном значении магнитного поля (HSF) разность магнитных энергий перпендикулярна оси антиферромагнетизма и вдоль нее сравнивается с энергией анизотропии, что влечет за собой резкое изменение направления намагниченности на угол 90° [15].
Спин-флоп-эффект применяется для снижения перекрестной анизотропии в устройствах, где не только опорный слой связан с АФ-пленкой, но и чувствительный слой. Снижение перекрестной анизотропии осуществляется изменением направления обменной анизотропии САФ путем фиксации его в спин-флоп-состоянии, в то время как намагниченность свободного слоя расположена в направлении поля магнитной термообработки.
2. ОСОБЕННОСТИ ФОРМИРОВАНИЯ САФ-СТРУКТУР
В зависимости от последовательности напыления слоев, кристаллической структуры слоев, толщин ФМ-пленок и НМ-слоя, режимов термомагнитной обработки магнитные свойства САФ-структуры могут значительно изменяться [17–19].
Направление фиксации АФ/САФ зависит от соотношения толщин ФМ-слоев, а также от последовательности их напыления. При фиксации снизу (рис. 6) в зависимости от разницы в толщинах слоев Р1 и Р2, определяемой как Δt = tP2 – tP1, намагниченность всей структуры САФ может быть различной. При Δt < 0 намагниченность Р1 устанавливается параллельно ростовому полю и фиксируется обменным смещением с АФ-слоем. Намагниченность слоя Р2 устанавливается антипараллельно Р1 в соответствии с РККИ-взаимодействием, которое, как правило, существенно превосходит влияние ростового поля. При Δt > 0 суммарный магнитный момент САФ изменит знак и произойдет разворот Р2 в направлении ростового поля.
Рис. 6.
Соотношение направлений намагниченности слоев САФ в процессе роста: а – Δt < 0, б – Δt > 0 [13].
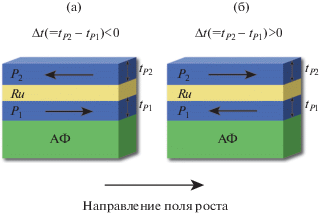
Зарождение и рост слоя Р2 происходят в условиях конкуренции ростового поля и РККИ-взаимодействия. Поскольку система в каждый момент времени находится в состоянии равновесия, то в процессе роста слоя Р2 его намагниченность будет дрейфовать в направлении ростового поля. Следствием этого является отклонение направления фиксации от направления ростового поля.
Технологически возможны два варианта фиксации САФ сверху (top) и снизу (bottom) по отношению к спейсеру (рис. 7). В том или ином случае необходимо учитывать соответствие кристаллической структуры на границе раздела АФ-слоя и фиксируемого слоя САФ. Соответствие кристаллической структуры определяется степенью преимущественной ориентации кристаллитов обоих слоев в определенном направлении и малой величиной рассогласования межатомных расстояний в плоскости границы раздела АФ/САФ.
В случае реализации варианта top-стека нанесение АФ-слоя осуществляется на сформированную САФ-структуру с наведенной анизотропией. В большинстве случаев в качестве слоя, граничащего с АФ, используется пленка CoFe. Слои CoFe, полученные методом магнетронного распыления, характеризуются ГЦК-решеткой и высокой степенью преимущественной ориентации кристаллитов (текстуры) в направлении (111). Для напыленных АФ-слоев, таких как FeMn, IrMn, PtMn, характерны схожие структурные параметры и близкие значения параметров кристаллической решетки. В данном случае не возникает проблемы для формирования структурно-когерентной границы раздела АФ/САФ [13, 20, 21].
При реализации bottom-варианта стека АФ-пленка напыляется на затравочный слой, близкий по своим структурным параметрам к АФ, наблюдается хорошо выраженная текстура (111) как для подслоев Cu, NiFe, Ru, так и для IrMn [13].
В [22] исследовалась взаимосвязь между отношением СТМР-эффекта и кристаллизацией слоя CoFeB путем термомагнитной обработки в спин-туннельных переходах (СТП) с барьером MgO с ориентацией (001), свободными слоями CoFeB и фиксированными слоями САФ CoFe/Ru/CoFeB. Обнаружено, что кристаллизация в высокоориентированную ОЦК-структуру (001) в закрепленном слое CoFeB, нанесенном на разделительный слой Ru, способствует достижению высокого СТМР-эффекта посредством термомагнитной обработки при высоких значениях температуры.
Анализ наноструктур с САФ и кристаллическим АФ с помощью рентгеновской дифракции [22] показал, что барьер MgO действует в качестве шаблона для кристаллизации как свободных слоев CoFeB, так и закрепленного слоя CoFeB в структуре с САФ, тогда как в кристаллизации закрепленного слоя CoFeB в наноструктуре с кристаллическим АФ преобладала затравка слоя CoFe под ним, который находился в прямом контакте со слоем CoFeB, в результате чего CoFeB наследовал ту же текстуру [22]. Вставка Ru между слоями CoFe и CoFeB предотвращает наследование текстуры из нижнего слоя CoFe, вызывая кристаллизацию свободного аморфного слоя CoFeB со стороны MgO. Также важно, что слой Ru уменьшил шероховатость поверхности, вызванную свойствами нижележащих слоев.
3. ПРИМЕНЕНИЕ САФ ДЛЯ MRAM И ПРЕОБРАЗОВАТЕЛЕЙ МАГНИТНОГО ПОЛЯ
Структуры с САФ применяются в преобразователях магнитного поля, запоминающих устройствах с произвольным доступом с различными способами записи информации.
В основе Toggle MRAM лежит САФ-структура в свободном слое, которая обеспечивает перемагничивание комбинацией импульсов тока в шинах, при этом импульс тока в одной шине не может переключить ячейку.
В первоначальном состоянии два ФМ-слоя находятся в антипараллельном состоянии вдоль длинной оси эллиптического элемента СТП. В начальный момент времени при подаче тока в одну из шин, например в строку, создается магнитное поле, необходимое для перехода САФ в спин-флоп-состояние. Далее подается ток одновременно в обе шины, результирующее магнитное поле поворачивается на 45°, на следующем шаге ток подается только в столбец, результирующее поле разворачивается еще на 45°. После отключения шин в отсутствие магнитного поля ФМ-слои возвращаются в антипараллельное состояние [23]. Таким образом, последовательность импульсов тока в шины повернула свободный слой на 180°, изменив логическое состояние ячейки.
Toggle MRAM имеет срок хранения информации более 10 лет, цикл чтения–записи составляет 35 нс. За счет радиационной стойкости микросхемы Toggle MRAM могут входить в состав космической аппаратуры, но энергопотребление данного вида памяти достаточно высоко из-за необходимости подавать импульсы тока для записи величиной 50 мА.
САФ-структуры входят в состав преобразователей магнитного поля на основе СВМР- и СТМР-наноструктур. Для применения СВМР- и СТМР-наноструктур в качестве магниточувствительных элементов требуются структуры с высоким магниторезистивным эффектом и низкополевой петлей гистерезиса свободного слоя [6, 24]. Уменьшение величины коэрцитивности свободного слоя достигается формированием скрещенной конфигурации магнитной анизотропии – ось однонаправленной анизотропии (ООА) перпендикулярна оси легкого намагничивания (ОЛН). Скрещенную конфигурацию магнитной анизотропии возможно сформировать двумя режимами термомагнитной обработки: в магнитном поле, эквивалентном полю перехода в спин-флоп-состояние, направление внешнего магнитного поля параллельно ОЛН; в магнитном поле, превышающем поле насыщения, направление которого перпендикулярно ОЛН [25].
В [6] рассмотрены спиновые клапаны вида Ta 50 Å/NiFe 30 Å/CoFe 35 Å/Cu 28 Å/CoFe 35 Å/Ru 8 Å/CoFe 25 Å/FeMn 100 Å/Ta 20 Å с САФ-структурой CoFe/Ru/CoFe, где первоначально была сформирована параллельная конфигурация ОЛН и ООА. Скрещенную конфигурацию получали термомагнитной обработкой в различных режимах: в первом случае образец нагревали до температуры блокировки и охлаждали в магнитном поле, перпендикулярном ОЛН и превышающем поле насыщения. Во втором варианте величина магнитного поля соответствовала спин-флоп-состоянию, на рис. 9 представлены низкополевые части магниторезистивных кривых спинового клапана с параллельной и скрещенной конфигурацией анизотропии, полученной двумя способами термомагнитной обработки [6].
Рис. 9.
Магниторезистивные кривые спинового клапана с параллельной (штриховая линия) и скрещенной конфигурацией магнитной анизотропии, сформированной термомагнитной обработкой при поле спин-флоп-состояния (темные символы) и поле насыщения (светлые символы) [6].

Применение САФ в фиксированном слое позволяет получить низкокоэрцитивную петлю перемагничивания с незначительным снижением магниторезистивного эффекта. На основе данных структур могут быть изготовлены преобразователи магнитного поля с высокой чувствительностью и низкой нелинейностью.
ЗАКЛЮЧЕНИЕ
Обзор исследований САФ-структур показал перспективность применения данных материалов в устройствах спинтроники. Интеграция САФ в спиновых клапанах изменяет механизм кристаллизации, улучшает термостабильность, повышает магниторезистивный эффект наноструктур.
При фиксации САФ-структуры петля перемагничивания свободного слоя симметрична относительно нуля, что обусловливается отсутствием магнитостатического взаимодействия свободного и опорного слоев и является одним из главных требований для устройств памяти.
САФ-структуры обеспечивают формирование скрещенной конфигурации магнитной анизотропии для снижения коэрцитивности свободного слоя и последующей линеаризации выходной характеристики преобразователя магнитного поля на основе СВМР- или СТМР-эффекта в области нуля.
В основе Toggle MRAM лежит спин-туннельный переход с САФ-наноструктурой в свободном слое, перемагничивание которого осуществляется с помощью вращающегося магнитного поля, создаваемого последовательностью импульсов тока ортогонально расположенных токовых шин. Вероятность переключения состояния ячейки одной шиной низка, за счет чего обеспечивается значительно лучшая селективность.
Список литературы
van den Berg H.A.M., Clemens W., Gieres G. et al. // IEEE Trans. Mag. 1996. V. 32. № 5. P. 4624.
Leal J.L., Kryder M.H. // J. Appl. Phys. 1998. V. 83. № 7. P. 3720.
Hayakawa J., Ikeda S., Lee Y.M. et al. // Jpn Soc. Appl. Phys. 2006. V. 45. P. 37.
Bergman A., Skubic B., Hellsvik J. et al. // Phys. Rev. 2011. V. 83. P. 6.
Savtchenko L., Engel B., Rizzo N. et al. Method of writing to scalable magnetoresistance random access memory element. US6545906B1L. G11C11/16. 2003.
Чернышова Т.А., Миляев М.А., Наумова Л.И. и др. // Физика металлов и металловедение. 2017. Т. 118. № 5. С. 439.
Stöhr J., Siegmann H.C. Magnetism: from fundamentals to nanoscale dynamics. Springer, 2006. 822 p.
Bruno P., Chappert C. // Phys. Rev. 1992. V. 46. № 1. P. 11.
Bruno P., Chappert C. // Phys. Rev. Lett. 1991. V. 67. № 12. P. 1602.
Bloemen P.J.H. Metallic multilayers, experimental investigation of magnetic anisotropy and magnetic interlayer coupling. Eindhoven University of Technology. 1993. 202 p.
Forrester D.M., Kovacs E., Kurten K.E., Kusmartsev F.V. // Int. J. Mod. Phys. B. 2008. V. 23. № 20. P. 4021.
Deen L.D.P. The temperature and field stability of exchange biased magnetic multilayers containing a synthetic antiferromagnet. Eindhoven University of Technology, 2015. 78 p.
Kim Y.K., Lee S.R., Park J.S., Park G.H. // J. Korean Phys. Soc. 2003. V. 43. № 3. P. 396.
Fruchart O., Dieny B. // J. Magn. Magn. Mater. 2012. V. 324. № 4. P. 365.
Миляев М.А., Наумова Л.И., Чернышова Т.А. и др. // Физика металлов и металловедение. 2016. Т. 117. № 12. С. 1227.
Negulescu B., Lacour D., Hehn M. et al. // J. Appl. Phys. 2011. V. 109. P. 103911.
Pinzaru C., Stoleriu L., Stancu A. // IEEE Trans. Magn. 2014. V. 50. № 7. P. 6733284.
Duine R.A., Lee K.J., Parkin S.S.P., Stiles M.D. // Nat. Phys. 2018. V. 14. № 3. P. 217.
Tadisina Z.R., Gupta S., LeClair P., Mewes T. // J. Vac. Sci. Technol. 2008. V. 26. № 4. P. 735.
Rizwan S., Han X.F., Zhang S., Zhao Y.G. // Appl. Phys. Lett. 2012. V. 101. № 8. P. 082414.
Guo Z.B., Zong B.Y., Qiu J.J. et al. // Solid. State. Comun. 2010. V. 150. № 1. P. 45.
Lee Y.M., Hayakawa J., Ikeda S. // Appl. Phys. Lett. 2006. V. 89. № 4. P. 17.
Dieny B., Goldfarb R.B., Lee K.J. Introduction to magnetic random-access memory. IEEE Magnetics, 2017. 255 p.
Guedes A., Mendes J.M., Freitas P.P. // J. Appl. Phys. 2006. V. 99. P. 08B703(1-3).
Наумова Л.И., Миляев М.А., Проглядо В.В. и др. // Естественные и технические науки. 2015. № 10. С. 92.
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии